Сравнительное исследование сегнетоэлектрических характеристик тонких пленок Hf0.5Zr0.5O2, осажденных атомным слоем, с использованием прекурсоров тетракис (этилметиламино) и тетракис (диметиламино)
Аннотация
Химические, физические и электрические свойства атомного слоя нанесенного Hf 0,5 Zr 0,5 О 2 сравниваются тонкие пленки с использованием прекурсоров тетракис (этилметиламино) (ТЕМА) и тетракис (диметиламино) (TDMA). Лиганд металлорганических предшественников сильно влияет на остаточную концентрацию углерода, размер зерна и получаемые сегнетоэлектрические свойства. Внесение Hf 0,5 Zr 0,5 О 2 пленки с предшественниками TDMA приводят к более низкой концентрации C и немного большему размеру зерна. Эти результаты полезны для выращивания пленки с преобладанием сегнетоэлектрической фазы, что смягчает ее пробуждающий эффект. Из пробуждения TDMA-Hf 0,5 Zr 0,5 О 2 пленка с циклическим полем 2,8 МВ / см, нежелательный эффект пробуждения был хорошо подавлен до 10 5 циклов с достаточно высоким значением двойной остаточной поляризации ~ 40 мкКл / см 2 . Также фильм показал надежное переключение до 10 9 циклы с циклическим полем 2,5 МВ / см без эффекта пробуждения, но с типичным утомляемым поведением.
Введение
Атомный слой нанесен Hf 1- x Zr x О 2 (HZO, x ~ 0,5) тонкие пленки были ведущим претендентом на роль сверхтонкого сегнетоэлектрического (СЭ) слоя в области полупроводниковых устройств для запоминающих устройств и логических приложений. Это связано с тем, что пленка FE HZO со структурой флюорита может быть уменьшена даже ниже 10 нм и гомогенно нанесена на трехмерные наноструктуры с использованием методов осаждения зрелых атомных слоев (ALD). Кроме того, он совместим с обычным электродом из TiN [1, 2], чего трудно достичь с помощью обычных сегнетоэлектриков со структурой перовскита. Несмотря на значительное улучшение обработки пленок HZO и изготовления устройств с использованием тонких пленок на основе ALD в последние годы, существует несколько нерешенных недостатков. Особенно сомнительна надежность сегнетоэлектриков со структурой флюорита. В настоящее время наиболее серьезными проблемами считаются пробуждающий эффект и ограниченное количество выносливости [3]. Обычно кривые поляризация – электрическое поле (P – E) в исходном состоянии защемлены, что свидетельствует о том, что коэрцитивное поле (E c ) пространственно неоднородна, а несколько СЭ-доменов закреплены [4]. После циклирования электрического поля с напряженностью поля выше E c можно получить более симметричные и квадратные кривые P – E, явление, известное как эффект пробуждения. В некоторых случаях такой процесс пробуждения длится 10 4 –10 5 циклов, что является типичным циклом выносливости ок. флэш-память, усложняющая работу устройства и системы [5]. Ограниченное количество выносливости - еще одна важная проблема, если она предназначена для использования в качестве рабочей памяти (выносливость> 10 15 требуется). Для конструкции конденсатора металл-сегнетоэлектрик-металл максимальный заявленный ресурс составляет менее 10 11 [6], а для стека затворов металл-сегнетоэлектрик-полупроводник в сегнетоэлектрическом полевом транзисторе срок службы ограничен до 10 5 раз [3, 7].
В литературе высказывались предположения о различном происхождении эффекта пробуждения. Предлагаемые механизмы включают закрепление доменных границ дефектами, такими как примеси, кислородные вакансии, и наличие нефегнетоэлектрической фазы (кубической или тетрагональной) на границах раздела, прилегающих к электродам или полупроводниковому каналу в исходном состоянии [5, 8 , 9,10]. Ожидается, что концентрация сайтов пиннинга будет уменьшаться во время повторяющегося переключения поляризации. Кроме того, циклирование электрического поля преобразует межфазные тетрагональные или кубические фазы в орторомбическую фазу FE [5]. Это исследование в основном было сосредоточено на улучшении электрических характеристик пленки HZO или устранении эффекта пробуждения за счет использования альтернативных прекурсоров Hf и Zr во время процесса ALD, что может привести к более низкой концентрации примесей, особенно примеси углерода.
Для процессов ALD с использованием металлорганических прекурсоров почти неизбежно образование остаточных примесей, таких как C, N и H, в выращенной пленке, которые, скорее всего, происходят из органических лигандов. Kim et al. [11, 12] показали, что при изменении температуры осаждения HfO 2 и пленки HZO можно контролировать полиморфизм и возникающие в результате электрические свойства. По данным электронной оже-спектроскопии (AES), концентрация C в тонкой пленке ALD HZO увеличивается с понижением температуры осаждения, что может быть результатом несовершенных реакций обмена лигандов [11, 12]. Кроме того, поперечный диаметр зерна уменьшался с увеличением концентрации C. Образование нестабильных или метастабильных фаз (тетрагональной, орторомбической и кубической), а не стабильной моноклинной фазы в таких пленках со структурой флюорита тесно связано с эффектом размера зерна [13,14,15,16]. Таким образом, контроль концентрации примесей имеет решающее значение для достижения желаемой фазы (FE орторомбической), а также для повышения электрической надежности пленки.
Для ALD тонких пленок FE HZO наиболее часто используемыми металлоорганическими прекурсорами Hf и Zr являются тетракис [этилметиламино] гафний (TEMAH) и тетракис [этилметиламино] цирконий (TEMAZ) [11, 12, 17]. Эти предшественники были разработаны для химического осаждения металлоорганических соединений из паровой фазы с целью легкого разложения лиганда посредством передачи электрического заряда между метильной и этильной группами [18,19,20]. Однако этот тип термически индуцированного разложения лиганда и последующее удаление (фрагментов) органических лигандов отрицательно влияет на легкую реакцию ALD, приводящую к включению примесей (C, H и N) в пленку [11,17,18, 19,20].
Напротив, предшественники тетракис [диметиламино] гафния (TDMAH) и тетракис [диметиламино] циркония (TDMAZ), которые также использовались для осаждения пленок FE HZO [21,22,23,24], имеют только метильные группы. лиганды. Следовательно, такой вредный эффект не может быть серьезным, хотя полное подавление термического разложения не может быть гарантировано.
В этом исследовании был проведен сравнительный анализ пленок HZO, выращенных с помощью процессов ALD с использованием двух различных металлических прекурсоров; TEMAH / TEMAZ и TDMAH / TDMAZ. Последний процесс привел к более низкой концентрации C в пленке, что значительно улучшило электрические характеристики пленки HZO. В оптимизированных условиях циклического переключения практически не было достигнуто эффекта пробуждения, в то время как переключаемая поляризация оставалась на уровне ~ 40 мкКл / см 2 .
Методы / экспериментальные
Подготовка Hf 0,5 Zr 0,5 О 2 Тонкие пленки
В этой работе изучалось влияние типов металлорганических прекурсоров на структуру и электрические характеристики Hf 0,5 , осажденного атомным слоем. Zr 0,5 О 2 тонкие пленки. Тонкие пленки HZO были нанесены с использованием термического реактора ALD диаметром 4 дюйма с TDMAH (или TEMAH), TDMAZ (или TEMAZ) и озоном (190 г / м 3 концентрации) в качестве прекурсора Hf, прекурсора Zr и источника кислорода соответственно. Оптимизированный процесс ALD с прекурсорами TEMAH / TEMAZ был таким же, как и в предыдущих исследованиях авторов [5, 9, 11,12,13,14,15,16]. Тонкие пленки HZO с прекурсорами TDMAH / TDMAZ были получены термическим методом ALD при температуре подложки 260 ° C. Для электрического испытания было выбрано соотношение Hf:Zr 50:50, поскольку состав, как сообщается, показывает самую большую остаточную поляризацию (P r ) значение в предыдущих исследованиях [17, 25, 26]. Тонкие пленки HZO с прекурсорами TDMAH / TDMAZ были осаждены с соотношением циклов ALD 1:1 прекурсоров Hf и Zr на TiN / Ti / SiO 2 / Si подложка. Один цикл ALD состоял из подпитки источника (2 с) - продувки источника (20 с) - подачи озона (3 с) - процесса продувки озоном (10 с). Скорость роста пленки HZO составляла 0,13 нм за цикл, а тонкие пленки HZO толщиной 10 нм были приготовлены с использованием предшественников TDMAH / TDMAZ для экспериментов. Оптимальные условия могут варьироваться в зависимости от объема камеры ALD. В таблице 1 показано сравнение физических свойств источников TEMA и TDMA. Пленки TiN (50 нм) и Ti (5 нм) были нанесены с использованием распыления с мощностью распыления 5 кВт на термически окисленные подложки Si p-типа с использованием промышленного инструмента для распыления (Endura, Applied Materials). Осажденные пленки HZO являются лишь частично кристаллическими или аморфными в состоянии осаждения, поэтому последующий отжиг для кристаллизации проводился с использованием быстрого термического процесса (RTP) при 450 ° C в N 2 атмосфера.
Характеристика химических / физических свойств Hf 0,5 Zr 0,5 О 2 Тонкие пленки
Кристаллические структуры осажденных пленок анализировали с помощью рентгеновского дифрактометра (XRD, X’pert pro, Panalytical) в геометрии скользящего падения с углом падения 0,5 °. Микроструктуры образцов были проанализированы с помощью сканирующей электронной микроскопии (SEM, S-4800, Hitachi), а распределение зерен по размерам было проанализировано с использованием программного обеспечения Gwyddion [29] методом водораздела. Химический состав осажденной пленки HZO был проанализирован с помощью рентгеновской флуоресценции (XRF, Quant'X, Thermo SCIENTIFIC), а глубокие вариации химического состава, включая примеси, такие как C, были проанализированы с использованием временного интервала. летная оже-электронная спектроскопия (AES, PHI-700, ULVAC-PHI).
Характеристика электрических свойств Hf 0,5 Zr 0,5 О 2 Тонкие пленки
Для анализа электрических свойств пленок HZO на верхние электроды из TiN наносили реактивное напыление с мощностью 100 Вт при 92,6% -Ar / 7,4% -N 2 Атмосфера. На верхних электродах из TiN был нанесен рисунок с использованием теневой маски с круглыми отверстиями диаметром 300 мкм. P – E-характеристики анализировали с помощью сегнетоэлектрического тестера (TF Analyzer 2000, Aixacct systems) при частоте измерения 1 кГц. Испытание на долговечность проводилось с помощью прямоугольных биполярных импульсов с высотой и шириной 2,8 ~ 3,8 МВ / см и 10 мкс, соответственно, генерируемых генератором импульсов (81110A, Agilent) и сегнетоэлектрическим тестером (TF Analyzer 2000, Aixacct systems). Вольт-фарадные характеристики (C – V) измерялись с помощью анализатора импеданса (4194A, Hewlett-Packard) под синусоидальными импульсами переменного тока с частотой 10 кГц и высотой 50 мВ в сочетании с постоянным смещением. Диэлектрические постоянные пленок HZO рассчитывали из измеренной емкости, а также площади электродов, измеренной с помощью оптической микроскопии, и толщины, измеренной с помощью спектроскопической эллипсометрии (ESM-300, J. A. Woollam). Характеристики плотности тока и электрического поля (J-E) были проанализированы с помощью анализатора параметров полупроводников (4155B, Hewlett-Packard) при постоянном смещении с временем задержки 1 с.
Результаты и обсуждение
На рис. 1а показаны картины дифракции рентгеновских лучей при скользящем падении (GIXRD) Hf 0,5 толщиной 10 нм. Zr 0,5 О 2 тонкие пленки, нанесенные с использованием TDMAH / TDMAZ (TDMA-HZO, черная кривая) и TEMAH / TEMAZ (TEMA-HZO, красная кривая) с углом падения 0,5 °. Эталонные образцы, взятые из литературы для моноклинной, тетрагональной и орторомбической фаз, добавлены в нижней части. На обеих картинах GIXRD пленок TDMA и TEMA HZO интенсивности дифракционных пиков от моноклинной фазы были незначительны, и не удалось обнаружить заметной разницы в форме и интенсивности пиков. Таким образом, никаких существенных различий в кристаллографической структуре между TDMA и TEMA HZO не было экспериментально подтверждено GIXRD.

(а) Картины GIXRD тонких пленок HZO, осажденных с использованием TDMAH / TDMAZ (черная кривая) и TEMAH / TEMAZ (красная кривая), эталонные картины, взятые из литературы для моноклинной, тетрагональной и орторомбической фаз, прикреплены к нижним панелям. ( б) Плоское СЭМ-изображение пленок TDMA HZO и ( c) гранулометрический состав TEMA (красный; воспроизведен из [15]), TDMA (черный) HZO. ( г) Профиль глубины тонких пленок TDMA HZO проанализирован с помощью времяпролетной оже-электронной спектроскопии, и ( e) увеличенная область низких концентраций части пленки HZO. Представлена средняя концентрация C в TDMA (черная штрих-пунктирная линия), TEMA (красная пунктирная линия; воспроизведена из [12]), HZO
Микроструктура, включая поперечный размер зерна, является еще одним критическим фактором, который может сильно повлиять на FE-свойства тонких пленок HZO [13,14,15,16,30]. Таким образом, микроструктуры пленок TDMA и TEMA HZO были проанализированы с помощью сканирующей электронной микроскопии (СЭМ). На рис. 1б показано плоское СЭМ-изображение пленок TDMA HZO. В различных предыдущих исследованиях сообщалось, что тонкие пленки HZO, осажденные с использованием термического ALD, демонстрируют столбчатую зернистую структуру, что позволяет предположить, что размер зерна по вертикали равен толщине пленки [1, 5, 11, 31]. Распределение поперечного размера зерна, проанализированное с помощью вышеупомянутого программного обеспечения [29], было подогнано к функции Гаусса. Гранулометрический состав TEMA HZO (красная кривая) был взят из предыдущего исследования [15] и нанесен на график вместе с таковым для TDMA HZO (черная кривая) на рис. 1c. Как показано на рис. 1c, средний поперечный диаметр зерна TDMA HZO (8,5 нм) был больше, чем у TEMA HZO (7,1 нм). Это могло быть основной причиной улучшенных характеристик FE TDMA HZO. Согласно предыдущим сообщениям, образование метастабильных фаз, таких как орторомбическая и тетрагональная фазы, обусловлено кинетическим происхождением, а тетрагональная и ромбическая фазы предпочтительны в области малых размеров зерна [13, 16]. Зерна гораздо большего размера предпочитают быть моноклинными фазами, зерна меньшего размера предпочитают тетрагональную фазу, а зерна немного большего размера предпочитают ромбическую фазу. Практически перекрытие положений пиков двух фаз (тетрагональной и орторомбической) на дифрактограммах не позволило однозначно идентифицировать основную фазу в двух пленках. Однако SEM и сопутствующий анализ размера зерна показали, что пленка TDMA HZO может иметь более высокую долю орторомбической фазы по сравнению с пленкой TEMA HZO.
Разные размеры зерен могут возникать в результате разного уровня концентрации примеси C в двух пленках. Концентрация примесей может сильно повлиять на микроструктуру и связанные с ней сегнетоэлектрические свойства тонких пленок HZO [11, 12, 32]. Поэтому химический состав тонких пленок TDMA и TEMA HZO был проанализирован с использованием времяпролетного AES, и полученные в результате глубокие концентрации различных атомов, таких как Hf, Zr, O, C, Ti и N, в TDMA HZO пленка как функция времени распыления изображена на рис. 1г. На рис. 1д показана увеличенная область низких концентраций на рис. 1г (красная пунктирная рамка) в части пленки HZO. Средняя концентрация C в пленке TDMA HZO (черный квадрат) составляла ~ 2,4%, что на ~ 38% меньше, чем концентрация (~ 3,9%) в пленке TEMA HZO (красный треугольник) [12], данные AES которой приведены в предыдущее исследование авторов [12]. Все остальные концентрации, включая N, не показали каких-либо заметных различий.
Cho et al. предположили, что остаточные примеси C, образующиеся во время процесса ALD, замедляют рост зерна и приводят к небольшому размеру зерна окончательно осажденных пленок [32]. Аналогичная тенденция наблюдалась для сегнетоэлектрика Hf 0,5 Zr 0,5 О 2 тонкие пленки и чистый HfO 2 фильмы Кима и др. при понижении температуры осаждения с 280 до 200 ° C [11, 12]. Юнг и др. использовали компьютерное моделирование, чтобы показать, что разница в свободной энергии между тетрагональной и моноклинной фазами уменьшается с увеличением концентрации C в HfO 2 , предполагая, что включение примеси C увеличивает стабильность метастабильной тетрагональной фазы [33]. Kuenneth et al. также исследовали влияние концентрации C на значения свободной энергии HfO 2 . Однако они сообщили, что увеличение концентрации C не привело к уменьшению разности свободных энергий между орторомбической и моноклинной фазами [34]. В работе Куеннета и др. Рассматривались замещающие дефекты C, хотя примеси C обычно известны как дефекты внедрения в HfO 2 [33, 35]. Таким образом, теоретические расчеты четко не показали, что примеси C могут уменьшать разницу свободных энергий между тетрагональной и орторомбической фазами. Однако эксперименты подтвердили, что увеличение содержания примесей C может увеличить долю тетрагональной фазы в тонких пленках ALD HZO [11, 12, 33].
Более низкая концентрация примеси C в пленке TDMA HZO может быть приписана различной природе термического разложения лигандов TDMA и TEMA. Крайние атомы углерода в лигандах ТЕМА склонны к термической диссоциации и остаются на поверхности пленки во время процесса ALD [11, 12], чего может не быть в случае лиганда TDMA.
На следующем этапе обсуждается влияние концентрации C и результирующей микроструктуры на сегнетоэлектрические свойства. На рис. 2a и b показаны зависимости P – E конденсаторов MFM с пленками TDMA HZO и TEMA HZO соответственно, измеренные в исходном состоянии и в усталостном состоянии, переключенном на 10 2 , 10 3 , 10 4 , и 10 5 раз с использованием биполярных прямоугольных импульсов высотой 3,8 МВ / см и шириной 10 мкс. Из кривых P – E на рис. 2a и b (исходное состояние) видно, что кривая P – E конденсатора TEMA HZO (черная кривая, рис. 2b) более сильно защемлена в исходном состоянии по сравнению с конденсатором TDMA HZO (черный кривая, рис. 2а). На рис. 2b отчетливо видны выступы на исходной кривой P – E конденсатора TEMA HZO, чего нет на исходной кривой P – E конденсатора TDMA HZO. Горбы на кривой P – E возникают из-за расщепления пиков тока переключения, которое обычно возникает из-за пространственной неоднородности внутреннего электрического поля и / или коэрцитивного поля. На рисунке 2c показаны изменения 2P r . значения конденсаторов TDMA и TEMA HZO в зависимости от усталостных импульсов. 2P r значения после 10 5 время электрических импульсов по сравнению с изначальным 2P r Значения конденсаторов TDMA и TEMA HZO составляют ~ 80 и ~ 69% соответственно. Это говорит о том, что пленка TEMA HZO имеет более высокие характеристики пробуждения по сравнению с пленкой TDMA HZO.

Кривые поляризация – электрическое поле (P – E) для ( a ) TDMA HZO и ( b ) Конденсаторы TEMA HZO (воспроизведены из [5]), измеренные в исходном состоянии и в усталостном состоянии с импульсами 10 2 , 10 3 , 10 4 , и 10 5 раз при биполярных прямоугольных импульсах высотой 3,8 МВ / см и шириной 10 мкс. ( в) Изменения в 2P r значения конденсаторов TDMA (черный) и TEMA (красный) HZO в зависимости от импульсов усталости. Кривые диэлектрической проницаемости – электрического поля ( d ) TDMA HZO и ( e ) Конденсаторы TEMA HZO (воспроизведены из [5]) с верхним и нижним электродами из TiN, измеренными в исходном и усталостном состояниях. ( е) Изменение значений диэлектрической проницаемости с увеличением количества импульсов усталости для конденсаторов HZO TDMA (черный) и TEMA (красный)
На рисунках 2d и e показаны значения диэлектрической проницаемости и электрического поля (ε r - E) кривые конденсаторов TDMA HZO и TEMA HZO, измеренные в исходном состоянии и в усталостном состоянии, переключенном на 10 2 , 10 3 , 10 4 , и 10 5 раз с использованием биполярных прямоугольных импульсов высотой 3,8 МВ / см и шириной 10 мкс. Ε r Значения конденсатора TDMA HZO значительно ниже, чем у конденсаторов TEMA HZO во всех условиях испытаний. На рисунке 2f показаны изменения ε r . значения с увеличением количества циклов усталостного переключения для конденсаторов TDMA и TEMA HZO. Ε r значения были рассчитаны путем усреднения ε r значения, измеренные при максимальном и минимальном электрических полях на рис. 2d и e. Судя по картинам GIXRD на рис. 1а, доли моноклинной фазы в обеих пленках пренебрежимо малы. Таким образом, разница в ε r Значение может определяться относительной долей тетрагональной и орторомбической фаз или концентрацией дефектов, которая, как ожидается, приведет к уменьшению средней диэлектрической проницаемости с локальными искажениями решетки. Ε r значение тетрагональной фазы (35–40) было выше, чем у ромбической фазы (25–30). Таким образом, высокое ε r Значение конденсатора TEMA HZO указывает на то, что он имеет более высокую долю тетрагональной фазы по сравнению с конденсаторами TDMA HZO. С увеличением количества импульсов усталости ε r емкость конденсаторов TEMA HZO и TDMA HZO уменьшается, как показано на рис. 2f. Величина уменьшения ε r значение в течение 10 5 Время переключения поляризации для конденсатора TDMA HZO (от 26,8 до 25,3) было меньше, чем для конденсатора TEMA-HZO (от 32,2 до 29,6) на ~ 42%. Это соответствует поведению при пробуждении, показанному на рис. 2c.
Разница в долях тетрагональной фазы и получаемые в результате разные ε r Стоимость тонких пленок TDMA и TEMA HZO можно понять по разнице в концентрации C. По данным Kim et al. Согласно [12], увеличение концентрации C снижает свободную энергию тетрагональной фазы по сравнению с таковой для орторомбической фазы (тетрагональная фаза еще более выгодна по сравнению с ромбической). В результате ожидается, что с увеличением концентрации C доля тетрагональной фазы будет увеличиваться. Поскольку концентрация C в пленке TDMA HZO ниже, чем в пленке TEMA HZO, ожидается, что доля тетрагональной фазы в пленке TDMA HZO будет ниже, чем в пленке TEMA HZO. Разница в размере зерен, показанная на рис. 1c, также подтверждает ту же тенденцию в относительных долях кристаллической фазы. По данным Materlik et al. [30], свободная поверхностная энергия тетрагональной фазы (2,5 Дж / м 2 ) ниже, чем это (2,9 Дж / м 2 ) орторомбической фазы, хотя эти свободные поверхностные энергии были оценены для объяснения экспериментальных наблюдений в тонких пленках HZO различной толщины и концентрации Zr. Batra et al. [36] рассчитали свободную поверхностную энергию различных кристаллических фаз с различной ориентацией и показали, что свободная поверхностная энергия тетрагональной фазы ниже, чем у орторомбической и моноклинной фаз. Принято считать, что энергия высокоугловых границ зерен составляет примерно 1/3 свободной поверхностной энергии [37]. Таким образом, энергия границ зерен тетрагональной фазы является самой низкой по сравнению с ромбической и моноклинной фазами, что делает ее наиболее стабильной фазой при наименьшем размере зерна. Это согласуется с идеей о том, что меньший размер зерна TEMA HZO имеет тенденцию включать в себя большую часть нефегнетоэлектрической тетрагональной фазы по сравнению с пленкой TDMA HZO, которая имела больший средний размер зерна. Таким образом, экспериментально наблюдаемая концентрация C и размер зерна неизменно подтверждают различную кристаллическую структуру и результирующие электрические свойства тонких пленок TDMA и TEMA HZO.
Чтобы выяснить механизм, стоящий за эффектом пробуждения, измерение импульсного переключения, которое может оценить межфазную емкость (C i ), происходящие из несегнетоэлектрического слоя вблизи электродов, проводилась на конденсаторах TDMA HZO и TEMA HZO [5]. На рисунках 3a и b показаны изменения в C i . , контактное сопротивление (R c ) и E c значения с увеличением количества импульсов усталости для конденсаторов TDMA HZO и TEMA HZO соответственно. Подробный метод измерения и результаты включены в интерактивную вспомогательную информацию. Данные для конденсатора TEMA HZO были взяты из предыдущей работы Кима и др. [5], где C i значение увеличивается с увеличением числа циклов электрического поля [5]. В исходном состоянии C i (37,6 мкФ / см 2 ) значение конденсатора TDMA выше (21,1 мкФ / см 2 ) конденсатора TEMA HZO на ~ 75%, что свидетельствует о том, что толщина несегнетоэлектрического межфазного слоя в TDMA HZO намного меньше, чем в пленке TEMA HZO. С другой стороны, разница в E c Значение в исходном состоянии конденсаторов TDMA и TEMA HZO составляет всего 13%, что позволяет предположить, что основная причина разницы в исходных характеристиках P – E конденсаторов TDMA и TEMA HZO заключается в разной толщине нефегнетоэлектрических межфазных слоев. Поскольку R c значение сильно зависит от контактного сопротивления для электрической испытательной установки, оно может иметь меньшее значение по сравнению с двумя другими факторами. Следовательно, различные характеристики P – E в исходном состоянии конденсатора TDMA и TEMA HZO могут быть последовательно поняты на основе предыдущей модели пробуждения, предложенной Кимом и др. [5]. Согласно предыдущим исследованиям, концентрация кислородных вакансий вблизи электродов из TiN выше, чем в объемной области пленки в исходном состоянии. По данным Hoffmann et al. Согласно [38], увеличение концентрации кислородных вакансий увеличивает стабильность тетрагональной фазы по сравнению с орторомбической фазой. Во время периодического переключения поляризации при испытании на долговечность межфазная тетрагональная фаза, по-видимому, превращалась в ромбическую фазу FE за счет диффузии кислородных вакансий в объемную область пленки. Приложенное поле также индуцировало фазовый переход межфазной не-FE-фазы в FE-фазу. Поскольку толщина межфазного слоя конденсатора TDMA-HZO меньше, чем у конденсаторов TEMA-HZO в исходном состоянии, эффект пробуждения во время циклирования поля можно уменьшить.
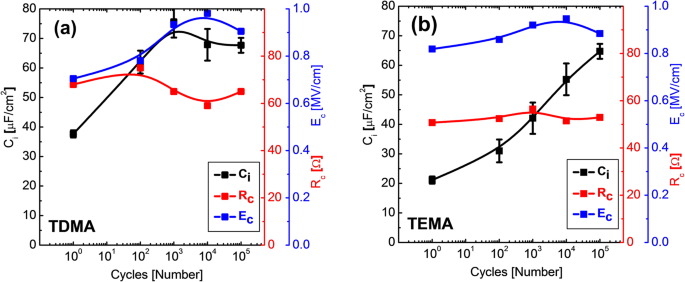
Изменения ( a ) TDMA HZO и ( b ) TEMA HZO (воспроизведено из [5]) в межфазной емкости (C i ), контактное сопротивление (R c ) и коэрцитивное поле (E c ) значения с увеличением количества усталостных импульсов
Кроме того, амплитуда импульса усталости является еще одним решающим фактором, который может сильно повлиять на явление пробуждения сегнетоэлектриков со структурой флюорита [6, 8]. Поэтому пробуждающий эффект конденсатора TDMA HZO был исследован с использованием усталостных импульсов с различными амплитудами:2,8, 3,1, 3,5 и 3,8 МВ / см. На рис. 4a, b и c показаны кривые P – E, измеренные во время пробуждения с высотой импульса усталости 2,8, 3,1 и 3,5 МВ / см соответственно. Изменения в 2P r во время пробуждения были приведены на рис. 4d. Как и результат теста с активным возбуждением, показанный на рис. 2а, измерение P – E было проведено при измеренном электрическом поле 3,8 МВ / см после определенного количества циклов срабатывания с заданной амплитудой поля. Изменения гистерезиса P – E уменьшаются с уменьшением амплитуды импульсов усталости, как показано на рис. 4a – c. На рисунке 4d показана сводка изменений в 2P r . значение во время испытания на выносливость с импульсами усталости амплитудой 2,8, 3,1, 3,5 и 3,8 МВ / см. Как видно на рис. 4d, величина 2P r увеличивается после 10 5 время циклирования поля составляло 0,41, 5,18, 9,93 и 9,94 мкКл / см 2 для разной амплитуды поля усталости, которые соответствуют изменениям на ~ 1, ~ 13, ~ 26 и ~ 24% соответственно. Этот результат означает, что эффект пробуждения незначителен при применении импульса усталости с амплитудой 2,8 МВ / см, когда достаточно высокое 2P r значение (~ 40 мкКл / см 2 ) все еще может быть достигнуто.
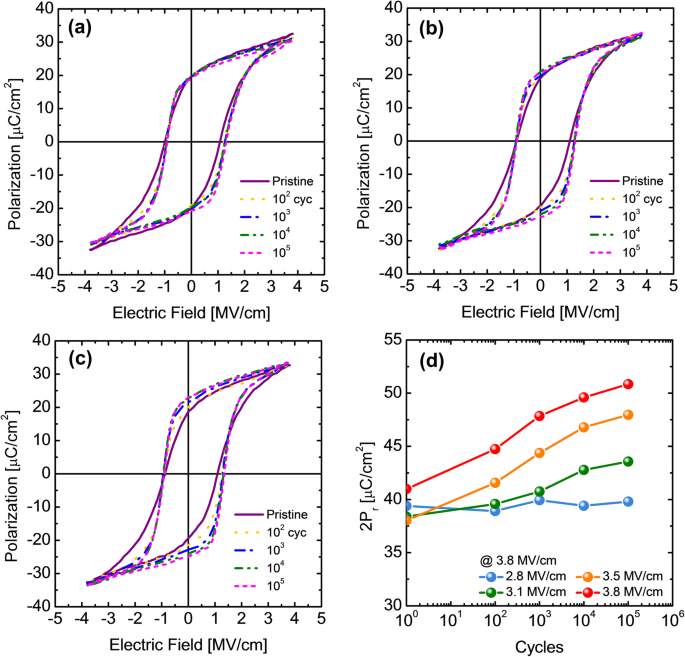
Кривые поляризация – электрическое поле (P – E), измеренные во время пробуждения с высотой импульса усталости ( a ) 2.8, ( b ) 3.1 и ( c ) 3,5 МВ / см. ( г) Изменения в 2P r значение во время испытания на выносливость с импульсами усталости 2,8, 3,1, 3,5 и 3,8 МВ / см
Эффект пробуждения во многом связан с дрейфом кислородных вакансий и возникающим в результате фазовым переходом из тетрагональной фазы в орторомбическую, в основном в межфазном слое [9, 10]. На дрейф кислородных вакансий должна сильно влиять амплитуда импульсов усталости, и соответственно более низкая амплитуда поля для испытания на усталость (в данном случае 2,8 МВ / см) может в значительной степени смягчить такой неблагоприятный эффект. Хотя достижимый максимум 2P r значение было уменьшено с ~ 51 мкКл / см 2 (при 3,8 МВ / см) до ~ 40 мкКл / см 2 (при 2,8 МВ / см), ~ 40 мкКл / см 2 по-прежнему является достаточно высокой ценностью для сегнетоэлектрических запоминающих устройств. В случае пленки TEMA HZO аналогичная стратегия может быть применена для смягчения проблемы пробуждения, но ее изначально низкий 2P r значение (~ 30 мкКл / см 2 ) может быть потенциальной проблемой для такого метода.
Влияние концентрации C было дополнительно подтверждено тестом на выносливость до 10 9 циклов, как показано на рис. 5a и b, которые показывают изменения P r при амплитуде поля 2.5 и 3.0 МВ / см для пленок ТЕМА и ТДМА HZO соответственно. В обоих случаях P r значения были оценены петлями P – E с максимальным электрическим полем, равным напряженности циклическому полю, поэтому расчетное значение P r значения обычно меньше, чем значения на рис. 4, где испытания P – E проводились при 3,8 МВ / см. Когда максимальное поле (3,8 МВ / см) для испытания P – E, показанного на рис. 4, использовалось для испытаний на долговечность, пленки были преждевременно разрушены, что запрещало испытания на долговечность вплоть до максимального количества циклов. Эти два фильма показали последовательные тенденции в эволюции P r по сравнению с циклическим поведением:пленка TEMA HZO продолжала увеличивать P r значений, тогда как тенденция была намного ниже для пленки TDMA HZO. На пленке ТЕМА ХЗО был показан неустойчивый P r изменения до выхода из строя на ~ 10 7 и ~ 10 9 циклов с использованием полевого цикла 3,0 и 2,5 МВ / см соответственно. Напротив, пленка TDMA HZO не показала признаков пробоя до ~ 10 7 и ~ 10 9 циклы при 3,0 МВ / см и 2,5 МВ / см, и наблюдалась резкая поломка. П r значение немного уменьшилось после ~ 10 7 при напряженности велосипедного поля 2,5 МВ / см, что соответствует истинному усталостному поведению. Аналогичный распад в P r Характеристики с циклами переключения широко описаны для обычных перовскитных сегнетоэлектриков, которые обычно связывают с закреплением доменных границ из-за увеличения плотности дефектов [40, 41]. В предыдущих исследованиях тонких сегнетоэлектрических пленок на основе HZO такое истинное усталостное поведение практически не наблюдалось из-за наличия значительного пробуждения и раннего пробоя, что также имело место на рис. 5а. Данные, представленные на рис. 5b, показывают, что пленка HZO также может страдать от усталостного эффекта, известного в перовскитной сегнетоэлектрической пленке, при условии, что пробуждение и ранний пробой должным образом учтены.
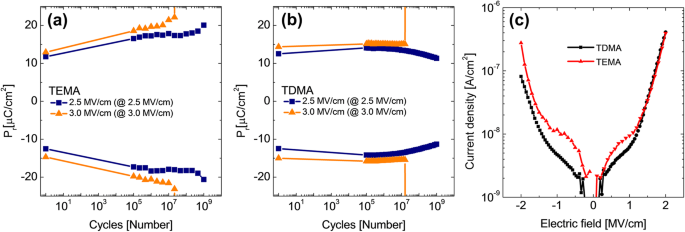
Результаты испытаний на выносливость ( a ) TEMA HZO (воспроизведено из ссылки 39) и ( b ) TDMA HZO с чередованием электрического поля и амплитудой импульсного поля 2,5 и 3,0 МВ / см. Частота прямоугольного двойного импульса для испытания на выносливость была зафиксирована на уровне 100 кГц. ( в) Кривые плотности тока – электрического поля для TDMA HZO (черный) и TEMA HZO (красный; воспроизведено из [39])
На рисунке 5c показано сравнение характеристик плотности тока утечки для двух типов пленок. Из-за более низкой концентрации C пленка TDMA HZO имела более низкий ток утечки, чем пленка TEMA HZO при напряженности поля <~ 1,5 МВ / см, где туннелирование с помощью ловушек может доминировать. В результате улучшения тока утечки в TDMA HZO пленка не показала пробоя до 10 9 циклов при относительно низкой напряженности поля 2,5 МВ / см.
Однако в области более высокой напряженности поля разница становится меньше, что может указывать на то, что ток утечки в сильном поле в большей степени определяется свойством межфазного барьера Шоттки, и такое свойство барьера было менее чувствительным к концентрации C. Дальнейшие исследования будут выполнены для более точного определения механизма тока утечки в последующей работе. Подобные токи утечки в области сильного поля совпадают с незначительной разницей в количестве циклов переключения до пробоя при 3,0 МВ / см, показанной на рис. 5a и b.
Заключение
В заключение, в этой работе изучалось влияние типов металлорганических прекурсоров на структуру и электрические характеристики Hf 0,5 , осажденного атомным слоем. Zr 0,5 О 2 тонкие пленки. Принятые предшественники Hf и Zr содержат лиганды TEMA или TDMA, причем первый более склонен к термическому разложению по сравнению со вторым. Процесс ALD с использованием прекурсоров с лигандами TDMA привел к более низкой концентрации примеси C (~ 2,4 атомных% против ~ 3,9 атомных%) в пленке HZO, что привело к немного большему размеру зерна (~ 8,5 нм против ~ 7,1 нм). . Поскольку для немного большего размера зерна предпочтительнее иметь сегнетоэлектрическую орторомбическую фазу, а не несегнетоэлектрическую тетрагональную фазу, пленка TDMA HZO превзошла пленку TEMA HZO, особенно по характеристикам пробуждения. Когда цикл пробуждающего поля составлял 2,8 МВ / см, пленка TDMA HZO почти не показывала эффекта пробуждения, в то время как высокий 2P r значение ~ 40 мкКл / см 2 может быть достигнуто. Это значительное преимущество перед сильным пробуждающим действием пленки ТЕМА HZO. Пленка TDMA HZO также содержала меньшую часть межфазной нефегнетоэлектрической фазы с электродами из TiN по сравнению с пленкой TEMA HZO. Из-за более низкой концентрации C пленка TDMA HZO показала более низкий ток утечки в области слабого поля (<~ 1,5 МВ / см), но поведение тока утечки в сильном поле было аналогичным. В результате количество циклов переключения до пробоя было аналогичным, когда поле циклирования достигало 3,0 МВ / см (~ 10 7 циклов), но его можно увеличить до 10 9 циклов, когда поле циклирования было ниже (2,5 МВ / см) для случая пленки TDMA HZO. Пленка TDMA HZO показала, что типичное усталостное поведение, то есть уменьшение P r значение с увеличением циклов переключения, можно было наблюдать через ~ 10 7 циклов при 2,5 МВ / см, что может быть связано с закреплением доменной стенки накопленными дефектами, как и для обычных перовскитных сегнетоэлектрических пленок.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой статьи, включены в статью и ее Дополнительный файл 1.
Сокращения
- TEMA:
-
Тетракис (этилметиламино)
- TDMA:
-
Тетракис (диметиламино)
- TEMAH:
-
Тетракис [этилметиламино] гафний
- ТЕМАЗ:
-
Тетракис [этилметиламино] цирконий
- TDMAH:
-
Тетракис [диметиламино] гафний
- ТЕМАЗ:
-
Тетракис [диметиламино] цирконий
- TDMA HZO:
-
Hf 0,5 Zr 0,5 О 2 тонкие пленки, нанесенные с использованием TDMAH / TDMAZ
- TEMA HZO:
-
Hf 0,5 Zr 0,5 О 2 тонкие пленки, нанесенные с использованием ТЕМАХ / ТЕМАЗ
- ALD:
-
Осаждение атомного слоя
- AES:
-
Электронная оже-спектроскопия
- RTP:
-
Быстрый термический процесс
- XRD:
-
Рентгеновский дифрактометр
- GIXRD:
-
Дифракция рентгеновских лучей при скользящем падении
- SEM:
-
Сканирующая электронная микроскопия
- HZO:
-
Hf 1-x Zr x О 2 , x ~ 0,5
- FE:
-
Сегнетоэлектрик
- P r :
-
Остаточная поляризация
- E c :
-
Принудительное поле
- P – E:
-
Поляризация – электрическое поле
- C – V:
-
Емкость – напряжение
- J – E:
-
Плотность тока – электрическое поле
- C i :
-
Межфазная емкость
- R c :
-
Контактное сопротивление
Наноматериалы
- Раскрытие атомной и электронной структуры углеродных нановолокон с набором чашек
- Иерархические антибактериальные полиамидные 6-ZnO нановолокна, полученные путем осаждения атомных слоев и гид…
- Исследование первых принципов стабильности и STM-изображения борофена
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Изготовление тонких пленок SrGe2 на подложках Ge (100), (110) и (111)
- Изучение силы адгезии и стеклования тонких пленок полистирола с помощью атомно-силовой микроскопии
- Исследование углеродных нановолокон и активного углерода как симметричного суперконденсатора в водном элек…
- Получение и термоэлектрические характеристики ITO / PtRh:PtRh тонкопленочной термопары
- Исследования TEM и STEM морфологии поперечного сечения двух- / трехслойных широкополосных антиотражающих пленок…
- Сравнительное исследование электрохимических, биомедицинских и тепловых свойств природных и синтетических…



