Эффект отрицательного дифференциального сопротивления в устройстве RRAM на основе Ru, изготовленном методом атомного осаждения
Аннотация
В данной работе устройства RRAM на основе Ru с атомным слоем осажденного AlO y / HfO x Функциональный слой изготовлен и исследован. В процессе установки напряжения наблюдали отрицательное дифференциальное сопротивление (NDR) и исследовали его физическое происхождение. Основываясь на понимании физики резистивного переключения, считается, что измеренное поведение NDR связано с частично униполярным эффектом сброса, который возникает из-за рекомбинации между кислородными вакансиями и термически высвобождаемыми ионами кислорода из RuO 2 интерфейсный слой. Измеренные электрические характеристики и результаты рентгеновской фотоэлектронной спектроскопии (XPS) подтвердили физическую интерпретацию.
Введение
Как одна из наиболее многообещающих энергонезависимых запоминающих устройств, резистивная оперативная память (RRAM) широко изучалась с точки зрения оптимизации материалов, повышения производительности и интеграции устройств [1,2,3,4]. Благодаря значительным преимуществам, таким как простая структура ячеек, высокая скорость работы, низкое энергопотребление и несравнимый потенциал миниатюризации [5], RRAM широко применяется в нейроморфных вычислениях, вдохновляемых мозгом, и реконфигурируемой булевой логике [6,7,8,9 , 10], а также демонстрирует большой потенциал для приложений памяти класса хранения (SCM) [11]. Однако, как указано в Международной дорожной карте для устройств и систем 2017 (https://irds.ieee.org/images/files/pdf/2017/2017IRDS_ES.pdf), проблемы, включая масштабируемость, надежность устройств и совместимость процессов, по-прежнему мешают Разработки RRAM. Следовательно, создание CMOS-совместимых устройств RRAM с превосходной производительностью имеет большое значение для приложений, основанных на структуре 1T1R ячейки RRAM [12,13,14]. Согласно предыдущему исследованию [15], устройство RRAM на основе Ru демонстрирует большой потенциал по сравнению с устройствами на основе Pt, в то время как отрицательное дифференциальное сопротивление (NDR) было продемонстрировано во время процесса установки напряжения. Явления NDR, сопровождающиеся резистивным переключением, были исследованы в других структурах RRAM, которые в основном были связаны с захватом / захватом электронных носителей между глубоко локализованными состояниями, индуцированными имплантированными металлическими наночастицами [16, 17], или накоплением дефектов, вызванных переустановкой перехода. [18]. Хотя появление NDR в ячейке RRAM на основе Ru при большом токе все еще не решено, в этой работе оценивались электрические характеристики устройства RRAM на основе Ru, изготовленного методом осаждения атомного слоя (ALD). На основе анализа характеристик рентгеновской фотоэлектронной спектроскопии (XPS) и электрических измерений с различными стимулами, явление NDR в RRAM на основе Ru можно объяснить в рамках модели проводящего филамента с кислородными вакансиями.
Методы
Принципиальная схема структуры устройства и изготовленного массива RRAM показаны на рис. 1а, б соответственно. Ru / AlO y / HfO x Устройство / TiN RRAM было изготовлено на термически окисленном 300 нм SiO 2 субстрат. Тонкая пленка Ru 80 нм была нанесена на адгезионный слой Ti толщиной 20 нм в качестве нижнего электрода магнетронным распылением постоянного тока (Angstrom Engineering NEXDEP) с использованием металлической мишени Ru. SiO 2 выращенный путем плазменного химического осаждения из паровой фазы (PECVD), служит диэлектриком для изоляции электродов и формирования переходных отверстий. Затем резистивный слой 2 нм AlO y и 3 нм HfO x был нанесен с помощью системы осаждения атомных слоев (PICOSUN R200) при 300 ° C с использованием предшественников триметилалюминия (TMA) и тетракис [этилметиламино] гафния (TEMAH). После этого TiN с длиной волны 80 нм подвергали реактивному напылению с использованием мишени из Ti и травили для формирования рисунков верхнего электрода. Также было выполнено еще одно сухое травление, чтобы обнажить нижний электрод для электрического контакта.
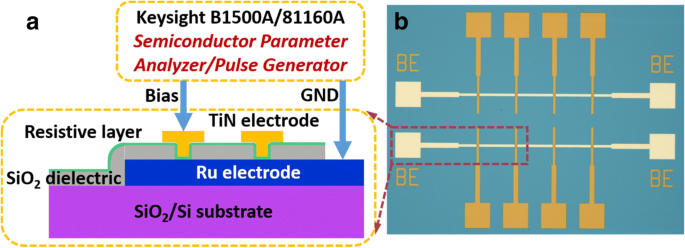
а Принципиальная схема устройства на основе Ru. б Изготовлен массив RRAM
Элементный анализ выполняли с помощью системы рентгеновской фотоэлектронной спектроскопии (XPS) (Thermo Scientific ESCALAB 250Xi) с использованием свежего образца без верхнего электрода. Перед измерением перед измерением проводилась очистка поверхности плазмой Ar, чтобы исключить влияние C. Положение пика Al 2p использовалось для калибровки. Электрические измерения проводились при комнатной температуре с помощью анализатора полупроводниковых приборов (Agilent B1500A) и генератора произвольной импульсной функции (Agilent 81160A).
Результаты и обсуждение
Типичные ВАХ устройств RRAM на основе Ru показаны на рис. 2а. После гальванопластики было приложено положительное напряжение (2,5 В) для процесса настройки, чтобы переключить ячейку из состояния с высоким сопротивлением (HRS) в состояние с низким сопротивлением (LRS) с током согласования 1 мА, чтобы предотвратить постоянный пробой во время проводящего образование нити (CF). После установленного перехода отрицательное напряжение (-2,3 В) использовалось для переключения устройства с LRS на HRS с постепенно уменьшающимся током. Чтобы оценить изменчивость сопротивления от устройства к устройству, произвольно были выбраны 10 ячеек RRAM на основе Ru. Как показано на рис. 2b, статистические результаты демонстрируют превосходную однородность HRS и LRS с окном сопротивления более 10 3 , который может быть многообещающим кандидатом для логических приложений на основе NVM. По сравнению с ранее описанными устройствами на основе платины [2], стоит отметить, что во время процесса установки наблюдалось явление NDR, когда ток уменьшается с увеличением напряжения (установленная фаза 1) в ограниченной шкале напряжения с последующим увеличением на соответствие току (установка-фаза 2).

а Характеристики постоянного тока. б Статистические распределения HRS / LRS для 10 устройств RRAM на базе Ru
Изменчивость от цикла к циклу устройств RRAM на основе Ru также была исследована в импульсном режиме для изучения равномерности цикла. Импульсы для заданного (2,4 В, 15 нс) и импульса (-3 В, 100 нс) используются для переключения устройства между LRS и HRS с напряжением считывания 0,1 В после каждого импульса. Как показано на рис. 3а, устройство на 1000 циклов имеет равномерное распределение со стандартными отклонениями 379 Ом и 3 × 10 5 . Ω для LRS и HRS, что приводит к стабильному окну памяти, превышающему 100. Никакого снижения выносливости не происходит даже после 10 6 циклы переключения, как ранее сообщалось в Ref. [15]. Кроме того, устройство также демонстрирует отличную удерживающую способность, как показано на рис. 3b. Сопротивление как LRS, так и HRS поддерживает постоянное значение более 10 5 . с при 120 ° C без сбоев.

а 1000 циклов выносливости. б Устойчивость Ru / AlO y при высоких температурах / HfO x / Устройство TiN RRAM
Чтобы изучить феномен NDR, I – V Кривые были измерены как в режиме развертки по напряжению, так и в режиме развертки по току. На рис. 4а показан процесс формирования пяти случайно выбранных свежих ячеек RRAM. Ток постепенно увеличивается, после чего следует прерывание, что указывает на формирование CF, при этом NDR не наблюдалось. После гальванопластики в одной и той же ячейке проводятся операции набора в различных режимах развертки, чтобы наблюдать изменение тока, как показано на рис. 4b. Для установки, управляемой током, ток медленно увеличивается с внезапным уменьшением напряжения, демонстрируя переход сопротивления от HRS к LRS. Это поведение отличается от характеристики, управляемой напряжением, которая может быть связана с индуцированным различными стимулами джоулевым нагревом на КФ. Более того, последовательные операции установки / сброса при разном смещении были выполнены для исследования состояния промежуточного сопротивления в области NDR. Соответствующее напряжение остановки 1 В было приложено во время процесса установки, как показано на рис. 4c, чтобы завершить развертку на дне впадины. Энергонезависимое состояние сопротивления было получено после снятия напряжения, которое показало униполярное резистивное переключение. Таким образом, это явление NDR предположительно связано со вторым сбросом CF во время процесса установки.
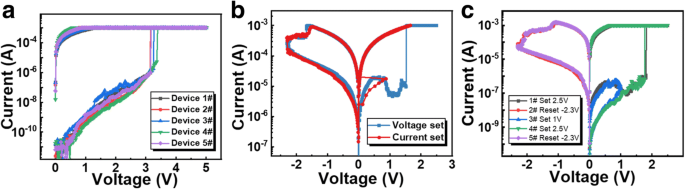
а Формирование напряжения пяти устройств RRAM на основе Ru. б Управляемый напряжением и управляемый током набор процессов в одной ячейке RRAM. c Неполный процесс настройки с остановочным напряжением в нижней части текущей долины
В сочетании с измерениями в различных режимах и процессах изготовления устройств, а также свойствами RuO 2 была предложена физическая причина явления NDR, как показано на рис. 5. Предыдущее исследование [19, 20] показало, что генерация и рекомбинация обедненной электронами кислородной вакансии ( V о ) и ион кислорода (O 2− ) при разных полярностях несут ответственность за обычный HfO x биполярные устройства RRAM, аналогичные процессам установки фазы 2 и сброса. Однако, в отличие от обычного процесса отверждения, происходит второй разрыв CF, отсоединяющий электрод Ru от CF и приводящий к NDR. Обычно атомы кислорода диссоциируют на V о и O 2− в электрическом поле с дрейфом O 2− к верхнему электроду, оставляя V о чтобы сформировать CF, который используется для транспорта электронов. Но из-за джоулева нагрева, вызванного электрическим полем, образовавшийся RuO 2 интерфейсный слой медленно разлагается при ~ 600 ° C и выделяет O 2- который мог бы рекомбинировать с обедненным электронами V о ( V о 2+ ) рядом с Ru электродом (установочная фаза 1) [21], что приводит к уменьшению тока. Этот процесс также можно рассматривать как процесс частичного униполярного сброса. При дальнейшем увеличении напряжения CF между TE и BE будет восстановлен путем накопления V о как показано на этапе установки 2, и ячейка RRAM переключается на LRS. Во время сброса одновременно происходят два процесса:(1) O 2- высвобождаемый из электрода TiN, быстро рекомбинирует с положительно заряженным V о из-за расширенной секции захвата (2) O 2- дрейфуя в сторону BE, реагирует с Ru и реформирует RuO 2 межфазный слой за счет локального джоулева нагрева [22]. В этом состоянии ячейка RRAM переключается на HRS.

Физические процессы резистивной коммутации в RRAM на основе Ru. а Эффект NDR (установка фазы 1). б Общие процессы SET (установочная фаза 2). c ПЕРЕЗАГРУЗИТЬ процесс устройства
XPS-анализ RuO 2 интерфейсный слой, который был сформирован в процессе изготовления устройства, также поддерживает предложенное объяснение эффекта NDR. На рис. 6а показан полный спектр XPS образца, который включает уровни ядра O 1s, Ru 3d, Al 2p и Hf 4f. Все остальные немаркированные пики соответствуют этим элементам с разными электронными орбитами. Подгоночная кривая на рис. 6b идеально соответствует экспериментальным данным и разделена на четыре пика, которые соответствуют Ru 3d 5/2 (280,01 эВ для Ru и 280,75 эВ для RuO 2 ) и Ru 3d 3/2 (284,3 эВ для Ru и 285,26 эВ для RuO 2 ) основных уровней, демонстрируя сосуществование Ru и RuO 2 в тонкой пленке [23]. Низкая интенсивность Ru 3d 5/2 пик указывает на то, что образовавшийся RuO 2 слой интерфейса очень тонкий, как мы и ожидали.

XPS-спектры a Ru / AlO y / HfO x тонкая пленка и б Ru 3-й базовый уровень. РуО 2 тонкая пленка между Ru и AlO y формы в процессе ALD [18]
Заключение
В этом исследовании CMOS-совместимый Ru / AlO y / HfO x Изготовлено устройство / TiN RRAM. Превосходные коммутационные характеристики были достигнуты за счет равномерного сопротивления между устройствами и большого окна сопротивления, а также благодаря хорошему удерживанию при высоких температурах. На основе электрических измерений и анализа XPS явление NDR в установленном процессе можно объяснить рекомбинацией кислородных вакансий и ионов кислорода, высвобождаемых из RuO 2 межфазный слой из-за индуцированного электрическим током Джоулева нагрева.
Сокращения
- ALD:
-
Осаждение атомного слоя
- CF:
-
Проводящая нить
- HRS:
-
Состояние высокого сопротивления
- LRS:
-
Состояние низкого сопротивления
- отчет о недоставке:
-
Отрицательное дифференциальное сопротивление
- PECVD:
-
Плазменное химическое осаждение из паровой фазы
- RRAM:
-
Резистивная память с произвольным доступом
- SCM:
-
Память класса хранения
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
Наноматериалы
- Что такое скин-эффект?
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на по…
- Межфазные, электрические характеристики и характеристики совмещения полос стопок HfO2 / Ge с прослойкой SiO2, сфор…
- Влияние сульфат-анионов на сверхтонкое зародышеобразование титана
- Иерархические антибактериальные полиамидные 6-ZnO нановолокна, полученные путем осаждения атомных слоев и гид…
- Фотокаталитические свойства порошков TiO2 с покрытием Co3O4, полученных методом плазменного осаждения атомного …
- Настройка уровня Ферми пленок ZnO посредством суперциклического осаждения атомного слоя
- Влияние вариаций травления на формирование каналов Ge / Si и производительность устройства
- Влияние температуры на механические свойства электропряденых полиуретановых нановолокон



