Самокатализирующийся рост вертикальных нанопроволок GaSb на стержнях InAs путем осаждения из паровой фазы металлоорганических соединений
Аннотация
Мы сообщаем о первом самокаталитическом росте высококачественных нанопроволок GaSb на стержнях InAs с использованием химического осаждения из газовой фазы (MOCVD) на подложках Si (111). Чтобы добиться роста вертикальных нанопроволок гетероструктуры InAs / GaSb, используются двухступенчатые скорости потока триметилгаллия (TMGa) и триметилсурьмы (TMSb). Сначала мы используем относительно низкие скорости потока TMGa и TMSb, чтобы сохранить капли Ga на тонких стержнях InAs. Затем скорости потока TMGa и TMSb увеличиваются для увеличения скорости осевого роста. Из-за более медленной скорости радиального роста GaSb при более высокой температуре роста нанопроволоки GaSb, выращенные при 500 ° C, имеют больший диаметр, чем нанопроволоки, выращенные при 520 ° C. Однако, что касается осевого роста, из-за эффекта Гиббса-Томсона и уменьшения пересыщения капли с увеличением температуры роста нанопроволоки GaSb, выращенные при 500 ° C, длиннее, чем нанопроволоки, выращенные при 520 ° C. Детальный анализ просвечивающей электронной микроскопии (ПЭМ) показывает, что нанопроволоки GaSb имеют идеальную кристаллическую структуру цинковой обманки (ZB). Представленный здесь метод роста может быть подходящим для выращивания других антимонидных нанопроволок, а осевые нанопроволоки гетероструктуры InAs / GaSb могут иметь большой потенциал для использования в производстве новых устройств на основе нанопроволок и в исследовании фундаментальной квантовой физики.
Фон
Полупроводниковые нанопроволоки III – V были признаны многообещающими кандидатами для наноразмерных электронных, оптических и квантовых устройств следующего поколения из-за их уникальных электронных, оптических и геометрических свойств [1,2,3]. Среди полупроводниковых материалов III – V из-за их уникальных преимуществ, таких как узкая прямая запрещенная зона, малая эффективная масса носителей и высочайшая подвижность носителей, III-антимониды имеют большой потенциал для использования в производстве средне- и длинноволнового инфракрасного излучения. фотоприемники [4], маломощные быстродействующие транзисторы [5,6,7] и при изучении фундаментальной квантовой физики [8,9,10]. Однако из-за их большой атомной массы, низкой летучести элементарного Sb и низкой температуры плавления соединений III-антимонида достижение роста нанопроволок на основе антимонида является чрезвычайно сложной задачей [11].
В частности, нанопроволоки GaSb, которые считаются чрезвычайно важными нанопроводами антимонида p-типа, выращивались в основном с помощью Au-катализаторов [12,13,14,15,16]. Однако введение Au может образовывать нежелательные центры рекомбинации на глубоких уровнях в запрещенной зоне Si и ухудшать электронные и оптические свойства нанопроволок AIIIBV [17,18]. Поэтому крайне желательно выращивать нанопроволоки GaSb без каких-либо посторонних катализаторов. Кроме того, для вертикального роста нанопроволок антимонида прямое зародышеобразование на подложке очень затруднено. Чтобы избежать проблемы зародышеобразования, всегда сначала выращивают короткий стержень из другого материала, чтобы способствовать росту вертикальных нанопроволок GaSb. Недавно самокаталитический рост нанопроволок GaSb на стержнях GaAs был реализован методом молекулярно-лучевой эпитаксии (МБЭ) [19], но, насколько нам известно, нет сообщений о выращивании высококачественных нанопроволок GaSb без использование зарубежных катализаторов на основе метода химического осаждения из газовой фазы (MOCVD). Здесь мы представляем самокаталитический рост нанопроволок GaSb с помощью стержней InAs с использованием MOCVD на подложках Si (111). С одной стороны, рост нанопроволок GaSb на стержнях нанопроволоки InAs по самокаталитическому механизму затруднен из-за перехода как анионов, так и катионов со стержня InAs на верхний GaSb. С другой стороны, из-за низкого рассогласования решеток, составляющего 0,6%, и уникального выравнивания зон, нарушенных по типу II, между InAs и GaSb, рост нанопроволок GaSb на стержнях InAs с образованием нанопроволок осевой гетероструктуры InAs / GaSb позволяет создать новую платформу для множество приложений, включая туннельные устройства [7, 14, 20, 21], высокоскоростные комплементарные металл-оксид-полупроводниковые (CMOS) транзисторы [22, 23], исследования электронно-дырочной гибридизации [9] и экситонно-дырочные гибридизации. спин-физика [24].
В этой статье высококачественные нанопроволоки GaSb с гладкими боковыми стенками были получены за счет тщательного контроля условий роста. Чтобы добиться роста вертикальных нанопроволок гетероструктуры InAs / GaSb, сначала были использованы относительно низкие скорости потока триметилгаллия (TMGa) и триметилсурьмы (TMSb) для сохранения капель Ga на стержнях InAs. Затем скорости потока TMGa и TMSb были увеличены, чтобы усилить осевой рост нанопроволок GaSb. Из-за более медленной скорости радиального роста GaSb при более высокой температуре роста нанопроволоки GaSb, выращенные при 500 ° C, имеют больший диаметр, чем нанопроволоки, выращенные при 520 ° C. Кроме того, из-за эффекта Гиббса-Томсона и уменьшения пересыщения капель с увеличением температуры роста нанопроволоки GaSb, выращенные при 500 ° C, имеют больший диаметр и длину, чем нанопроволоки, выращенные при 520 ° C. Подробный анализ просвечивающей электронной микроскопии (ПЭМ) показывает, что кристаллическая структура стержней InAs состоит из политипа структур вюрцита (WZ) и цинковой обманки (ZB), в то время как аксиально выращенные нанопроволоки GaSb имеют чистую кристаллическую структуру ZB, полностью свободную плоских дефектов.
Методы
Рост нанопроволоки
Нанопроволоки гетероструктуры InAs / GaSb выращивались с помощью системы MOCVD с моноблочной душевой головкой (AIXTRON Ltd, Германия) при давлении в камере 133 мбар. Триметилиндий (TMIn) и TMGa использовались в качестве предшественников группы III, а арсин (AsH 3 ) и TMSb были использованы в качестве предшественников группы V. Водород сверхвысокой чистоты (H 2 ) использовался в качестве газа-носителя, а общий расход H 2 было 12 слм. Нанопроволоки выращивались на подложках Si (111). Перед выращиванием подложки нагревали до 635 ° C для отжига, а затем охлаждали до 400 ° C в атмосфере AsH 3 . поток с образованием (111) B-подобных поверхностей [25]. Стебли InAs выращивали при 545 ° C в течение 45 с с TMIn и AsH 3 . расход 1,0 × 10 −6 моль / мин и 2,0 × 10 −4 моль / мин соответственно. Впоследствии потоки источников были переключены с TMIn и AsH 3 до TMGa и TMSb, а подложки охлаждались до температуры, определенной для осевого роста нанопроволок GaSb. Наконец, образцы охлаждали до комнатной температуры, используя TMSb в качестве защитного агента.
Методы характеризации
Морфология нанопроволок была охарактеризована с помощью сканирующей электронной микроскопии (SEM) (Nova Nano SEM 650), а ПЭМ (JEM2010F TEM; 200 кВ) в сочетании с рентгеновской энергодисперсионной спектроскопией (EDS) использовалась для исследования кристаллической структуры и распределение элементного состава соответственно. Для наблюдений с помощью просвечивающей электронной микроскопии выращенные нанопроволоки механически переносились с образцов на медные сетки, покрытые углеродной пленкой. Рамановские измерения были выполнены в геометрии обратного рассеяния при комнатной температуре с использованием лазера с длиной волны 532 нм в качестве источника возбуждения (Рамановская система Jobin-Yvon HR Evolution). Образцы возбуждали лазерной мощностью 0,36 мВт при размере пятна примерно 1 мкм.
Результаты и обсуждение
На рисунке 1 показана схематическая иллюстрация осевого роста нанопроволок GaSb на стержнях InAs и последовательности источника питания для роста нанопроволок. Нанопроволоки растут по самокаталитическому механизму, и каталитические капли постепенно изменяются с In на Ga после переключения потоков с TMIn и AsH 3 в TMGa и TMSb. По сравнению со стержневыми нанопроводами, нанопроволоки GaSb всегда имеют гораздо больший диаметр, а это означает, что размер каталитических капель Ga намного больше, чем размер капель In. Затем слишком быстрый сбор адатомов Ga каплями на тонких стержнях InAs может вызвать соскальзывание капель (как показано в Дополнительном файле 1:Рисунок S1). Чтобы капли катализатора имели достаточно времени для сбора адатомов Ga на этапе перехода от InAs к GaSb, мы сначала использовали относительно низкие скорости потока TMGa и TMSb для защиты капель Ga на стержнях InAs, как показано на рис.1. На первом этапе расходы TMGa и TMSb составляли 0,35 × 10 −6 . моль / мин и 2,0 × 10 −6 моль / мин, что соответствует соотношению V / III ~ 5.7, а процесс роста оставался 15 мин (область 2 на рис. 1). После этого, чтобы увеличить скорость осевого роста, расход TMGa и TMSb был увеличен до 0,7 × 10 −6 моль / мин и 4,0 × 10 −6 моль / мин для последующего роста нанопроволок GaSb (при сохранении постоянного отношения V / III) соответственно. Используя двухступенчатые скорости потока TMGa и TMSb, мы успешно реализовали вертикальный рост нанопроволок GaSb на стержнях InAs. Учитывая неизменное время роста нанопроволок GaSb с низкими скоростями потока, если не указано иное, времена роста нанопроволок GaSb, упомянутые в следующих параграфах, идентичны времени роста GaSb с высокими скоростями потока (область 3 на рис.1). .
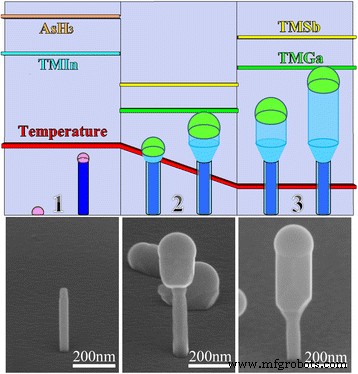
Иллюстрация осевого роста нанопроволок GaSb на стержнях InAs и последовательности источника питания для роста нанопроволок. Представленные здесь нанопроволоки GaSb были выращены при 520 ° C
Типичные СЭМ-изображения нанопроволок GaSb, выращенных на стержнях InAs при различных температурах 480, 500, 520 и 545 ° C, показаны на рис. 2a – d соответственно (стержни InAs до роста GaSb показаны в дополнительном файле 1:Рисунок S2). Время роста GaSb 10 мин. Наблюдается, что рост GaSb очень чувствителен к температуре роста. Очевидно, что при 480 ° C вместо осевого роста GaSb имеет тенденцию расти радиально вокруг стержней InAs или вдоль планарного направления (рис. 2а). Подробности о радиальном росте оболочек GaSb на ядрах InAs и планарном росте нанопроволок антимонида были описаны в других работах [26,27,28]. Однако ситуация меняется при повышении температуры роста GaSb до 500 или 520 ° C, когда аксиальный рост нанопроволок GaSb осуществляется на свободно стоящих стержнях InAs (рис. 2b, c). Капли Ga на концах нанопроволок указывают на автокаталитический механизм роста нанопроволок GaSb из пара-жидкости-твердого тела (VLS). Диаметр верхних сегментов GaSb обычно больше диаметра сегментов InAs, а увеличение ширины сегментов GaSb на границе раздела InAs / GaSb указывает на то, что размер каталитических капель Ga постепенно увеличивается на начальной стадии роста GaSb. Кроме того, более тонкие сегменты стержня на рис. 2c могут означать, что радиальный рост GaSb постепенно снижается с увеличением температуры роста от 500 до 520 ° C. Однако при дальнейшем повышении температуры до 545 ° C нанопроволоки GaSb кажутся растущими в плоском или наклонном направлении. Кроме того, большая часть стержней InAs исчезла, а диаметр остаточных стержней InAs очень тонкий (отмечен красными кружками на рис. 2d, а больше изображений SEM показано в дополнительном файле 1:рис. S3). Мы предполагаем, что стержни InAs серьезно разлагаются при высокой температуре роста 545 ° C, что приводит к опаданию нанопроволок GaSb в процессе роста. Следовательно, чтобы добиться вертикального роста нанопроволок GaSb на стержнях нанопроволок InAs, необходимо тщательно контролировать температуру роста нанопроволок GaSb.

СЭМ-изображения под углом 80 ° нанопроволок GaSb, выращенных на стержнях InAs при a 480 ° С, b 500 ° C, c 520 ° C и d 545 ° C в течение 20 мин. Условия роста стержней нанопроволоки InAs поддерживались постоянными. Вставки в б и c показать СЭМ-изображения с большим увеличением. красные круги через д отметьте остаточные основы InAs
На рис. 3 показаны статистические распределения диаметра и длины сегментов GaSb, показанные на рис. 2б, в, где температуры роста GaSb составляют 500 и 520 ° C соответственно. Ясно, что распределение размеров нанопроволок GaSb, выращенных при той же температуре (красные или синие точки на рис. 3), демонстрирует, что более толстые нанопроволоки имеют тенденцию быть длиннее. Об этом явлении также сообщалось для роста нанопроволок GaAsP, катализируемого Ga, с помощью МПЭ [29], а также для роста нанопроволок гетероструктур InAs / InSb с помощью химико-лучевой эпитаксии (CBE) [30] и нанопроволок InGaSb с помощью MOCVD [31]. ]. Причина в основном связана с более низким эффективным пересыщением (Δ μ ) в более мелких каталитических каплях. Для механизма роста VLS пересыщение Δ μ , представляющий собой изменение химического потенциала на пару III – V в каталитической капле и нанопроволоке, является основной движущей силой роста нанопроволоки. Во время самокаталитического процесса роста нанопроволоки растут в среде, богатой группой III, и концентрация атомов группы V, включенных в каталитическую каплю, доминирует над эффективным пересыщением. Для самокаталитического роста нанопроволок GaSb эффективное пересыщение Δ μ преобладает концентрация атомов Sb, включенных в каталитические капли Ga. Следовательно, эффективное пересыщение Δ μ можно представить в виде [32, 33]
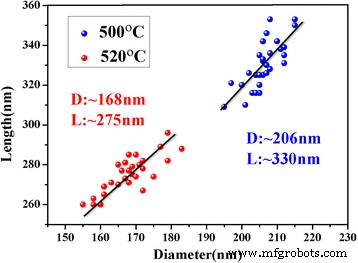
Статистические данные диаметра и длины нанопроволок GaSb, выращенных при 500 и 520 ° C
.
$$ \ varDelta \ mu ={k} _ {\ mathrm {B}} T \ ln \ left ({x} _ {\ mathrm {Sb}} / {x} _ {\ mathrm {Sb}, \ mathrm { eq}} \ right) $$ (1)где k B постоянная Больцмана, T абсолютная температура. x Сб и x Сб, экв представляют собой атомную долю Sb в каплях катализатора Ga в процессе роста нанопроволоки и в состоянии равновесия с кристаллом нанопроволоки GaSb, соответственно. Кроме того, согласно классической теории роста кристаллов, аксиальная скорость роста нанопроволоки ( v ) можно выразить как [34].
$$ v \ sim {\ left (\ varDelta \ mu / {k} _ {\ mathrm {B}} T \ right)} ^ 2 $$ (2)Очевидно, что скорость роста нанопроволоки сильно зависит от концентрации Sb x Сб в каплях Ga. Из-за эффекта Гиббса-Томсона давление пара Sb в каталитических каплях может значительно увеличиваться с уменьшением диаметра [35, 36]. Тогда более мелкие капли смогут легче десорбировать атомы Sb из каталитических частиц Ga, что приведет к более низкой концентрации Sb ( x Сб ) в более мелких каплях катализатора Ga. Как следствие, эффективное пересыщение в более мелких каплях ниже, чем в более крупных, что снижает скорость осевого роста нанопроволок GaSb за счет механизма самокаталитического роста.
Кроме того, при сравнении распределения по размерам нанопроволок GaSb, выращенных при 500 и 520 ° C, нанопроволоки GaSb, выращенные при 500 ° C (синие точки на рис. 3; средний диаметр и длина ∼206 и ~ 330 нм), имеют как большего диаметра, так и длины, чем у нанопроволок GaSb, выращенных при 520 ° C (красные точки на рис. 3; средний диаметр и длина ∼168 и ~ 275 нм). Более тонкие нанопроволоки, выращенные при 520 ° C, можно объяснить более медленной скоростью радиального роста GaSb при более высокой температуре роста. Однако для аксиального роста, кроме эффекта Гиббса-Томсона, повышение температуры роста может также уменьшить пересыщение капли и еще больше снизить скорость аксиального роста нанопроволок GaSb [29, 37]. Таким образом, нанопроволоки GaSb, выращенные при 500 ° C, больше как по диаметру, так и по длине, чем нанопроволоки GaSb, выращенные при 520 ° C.
Чтобы дополнительно определить преимущества использования стержневых нанопроволок, мы затем сравнили нанопроволоки GaSb, выращенные непосредственно на подложках Si и на коротких стержнях InAs, как показано на рис. 4. Нанопроволоки GaSb, показанные на рис. 4a, b, были выращены. при 500 ° C, а нанопроволоки GaSb, представленные на рис. 4c, выращивались при 520 ° C. Ясно, что стержни нанопроволок InAs играют решающую роль в успешном росте вертикальных нанопроволок GaSb. Как показано на рис. 4a, нанопроволоки GaSb, выращенные непосредственно на подложках Si (111), предпочитают расти в плоском направлении (больше изображений СЭМ доступны в дополнительном файле 1:рис. S4), и мы предполагаем, что эта проблема непосредственно связана с нанопроводами антимонида. зародышеобразование на подложках связано с поверхностно-активным действием адатомов Sb, которые могут уменьшать краевой угол между предварительно нанесенными каплями Ga и поверхностью подложки Si [38, 39]. Тогда как, как показано на рис. 4b, c, вертикальные нанопроволоки GaSb достигаются с помощью коротких стержней InAs. Отметим, что на рис. 4b, c время роста стержней нанопроволок InAs уменьшено до 20 с (в результате чего длина нанопроволок InAs обычно составляет менее 120 нм), в то время как время роста нанопроволок GaSb увеличено до 30 минут. Все нанопроволоки GaSb имеют чрезвычайно гладкие боковые стенки по всей длине без видимого сужения. Примечательно, что стержневые сегменты InAs имеют почти такой же диаметр, что и верхние нанопроволоки GaSb (как показано на вставке к рис. 4b, c), что указывает на то, что радиальная скорость роста GaSb вокруг стержней InAs выше, чем вокруг верхних нанопроволок GaSb. . Это различие может быть связано с тем фактом, что адатомы реагентов, диффундирующие с поверхности подложки, имеют тенденцию собираться вокруг боковых стенок тонких и коротких нанопроволок InAs, что приводит к локальному увеличению радиальной скорости роста GaSb вокруг стержней InAs. Наконец, при достаточном времени роста выращенные нанопроволоки имеют почти одинаковый диаметр в направлении роста; такое же поведение наблюдалось при выращивании нанопроволок InSb на основе коротких стержней InAs методом MOCVD [40].

СЭМ-изображения под углом 80 ° нанопроволок GaSb, выращенных без стержней InAs ( a ), а также на коротких стержнях InAs ( b , c ). Нанопроволоки GaSb, показанные на a и b были выращены при 500 ° C, а нанопроволоки GaSb в c выращивали при 520 ° C. Вставки в б и c показать изображения SEM с большим увеличением
Для изучения структурных характеристик полученных нанопроволок были проведены детальные ПЭМ-измерения. На рисунке 5a показано TEM-изображение низкого разрешения в светлом поле (BF) типичной нанопроволоки GaSb, выращенной на стержне из InAs при 520 ° C (как показано на рис. 2c). После последующего роста нанопроволоки GaSb более тонкая нанопроволока InAs имеет грубую морфологию. Это может быть связано с пиролизом InAs и неравномерным радиальным ростом GaSb в процессе роста нанопроволок GaSb. На рис. 5b – e представлены соответствующие изображения ПЭМ высокого разрешения (ПЭМВР), полученные из областей, отмеченных четырьмя красными прямоугольниками на рис. 5а. Микрофотография ПЭМВР и связанная с ней картина быстрого преобразования Фурье (БПФ) на рис. 5b показывают, что аксиально выращенная нанопроволока GaSb имеет чистую кристаллическую структуру ZB, полностью свободную от плоских дефектов, что обычно наблюдается при росте нанопроволок антимонида. Однако случайные плоские дефекты (двойниковые плоскости (TP) и дефекты упаковки (SF)), присутствующие на вершине и в области раннего роста нанопроволоки GaSb (рис. 5c, d), могут быть вызваны небольшими колебаниями условий локального роста во время возможный процесс охлаждения и начальная стадия перехода от InAs к верхнему GaSb. Кроме того, остаточные атомы As также могут играть роль в образовании плоских дефектов в переходной области (как показано в анализах EDS ниже). Напротив, как показано на рис. 5e, кристаллическая структура стержня InAs состоит из политипа структур WZ и ZB с большим количеством плоских дефектов вдоль направления его роста; из-за сосуществования структур WZ и ZB соответствующие пятна БПФ расщепляются и немного вытягиваются вдоль направления роста (вставка на рис. 5e). Было показано, что структурные дефекты в нанопроволоках могут вызывать нежелательное ингибирование подвижности носителей [41] и, следовательно, снижать транспортные свойства в системе гетероструктур InAs / GaSb. Недавно сообщалось, что включение Sb эффективно улучшает кристаллическое качество нанопроволок InAs [42, 43], тем самым значительно увеличивая потенциал кристаллофазной инженерии нанопроволок InAs без каких-либо посторонних катализаторов.
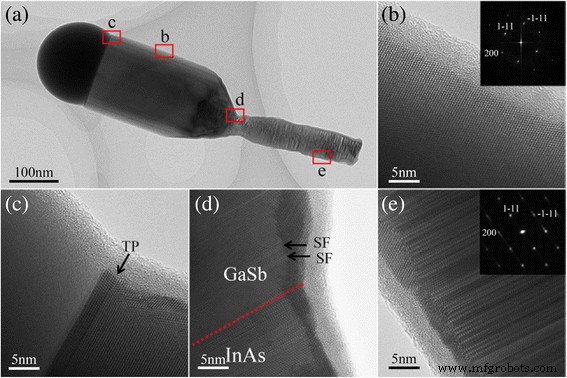
а ПЭМ-изображение типичного нанопроволока гетероструктуры InAs / GaSb с малым увеличением. б - е Изображения ПЭМ высокого разрешения (ПЭМВР), сделанные из областей, отмеченных красными прямоугольниками в ( a ) соответственно. Все изображения HRTEM получены от оси зоны 〈110〉. красная пунктирная линия через д указывает на границу раздела между стержнем InAs и верхней нанопроволокой GaSb. вставки в б и е представляют собой соответствующие шаблоны быстрого преобразования Фурье (БПФ) нанопроволоки GaSb и стержня InAs соответственно
На рис. 6a – f показано изображение ПЭМ другой нанопроволоки гетероструктуры InAs / GaSb и соответствующие результаты анализа EDS. Все измерения EDS используют сигналы излучения Lα In, As и Sb и сигнал излучения Kα Ga. Сканирование линии EDS в осевом направлении (рис. 6b) и элементарное отображение состава нанопроволоки (рис. 6c – f) показывают, что капля в основном содержит Ga и небольшое количество In, тогда как As или Sb практически не наблюдается, что напрямую подтверждает самокаталитический механизм роста нанопроволок GaSb (атомный процент из количественного точечного анализа EDS в пятне 1:Ga, 96,13%; In, 3,8%; As, 0; Sb, 0,07%, соответственно. EDS-спектры точечных анализов в двух точках показаны в дополнительном файле 1:Рисунок S5). Такая слабая концентрация индия в капле в основном объясняется растворением атомов индия в капле Ga на начальной стадии перехода от InAs к GaSb. Кроме того, согласно сканированию линии EDS на рис. 6b, рост нанопроволок GaSb начинается на стержнях InAs, а из точечного анализа EDS распределения элементного состава в пятне 2 (Ga, 48,86%; In, 0,91%; As, 0,70%; Sb, 49,53%), стехиометрическое соотношение атомов Ga и Sb в выращенном сегменте GaSb составляет примерно 1:1. Однако относительно высокие сигналы Ga и Sb в секции InAs возникают из-за радиального роста GaSb вокруг стержня InAs, а градиент элементов для сигналов In, As, Ga и Sb вблизи границы раздела может быть в первую очередь вызван остаточные In и As после TMIn и AsH 3 потоки отключены.

а Иллюстрация осевой нанопроволоки гетероструктуры InAs / GaSb и ПЭМ-изображение с малым увеличением выращенной нанопроволоки InAs / GaSb, выращенной при 520 ° C. б Линия развертки ЭЦП по красной линии отмечен в ( a ). c - е Составные карты EDS нанопроволоки в ( a ), показывающий распределение Ga, Sb, In и As. Две точки через а отметить позиции, где проводился точечный анализ EDS
Для анализа оптических свойств выращенных нанопроволок GaSb были выполнены рамановские измерения. На рисунке 7 показаны спектры комбинационного рассеяния света подложки GaSb (100) и нанопроволок GaSb, выращенных на коротких стержнях InAs. В спектре объемного GaSb наблюдаются два пика рассеяния примерно при 226,5 и 235,2 см −1 . (красная линия на рис. 7) и относятся к поперечной оптической (TO) и продольной оптической (LO) фононной моде GaSb соответственно. Для нанопроволок GaSb аналогичные два пика также четко наблюдались при примерно 225,0 и 233,6 см -1 . в рамановском спектре (синяя линия на рис. 7), что свидетельствует о высоком фотонном качестве полученных нанопроволок GaSb. В измерениях рамановского обратного рассеяния TO-фононная мода запрещена в направлении (100), небольшой пик TO-фононной моды для объемной подложки GaSb (100) может быть отнесен на счет небольшой неправильной ориентации подложки или ее несовершенства [44]. Однако для нанопроволок GaSb, поскольку нанопроволоки выращиваются в вертикальном направлении (111) и имеют шесть боковых стенок {110}, в спектре комбинационного рассеяния можно четко наблюдать как TO-, так и LO-фононные моды. Кроме того, по сравнению с объемным GaSb, TO- и LO-фононные моды нанопроволок GaSb демонстрируют слабый сдвиг вниз. В измерениях рамановского рассеяния и квантовое ограничение, и дефекты могут вызывать сдвиг частоты фононных пиков вниз [45]. Принимая во внимание, что из-за большого диаметра выращенных нанопроволок GaSb, который почти не показывает эффекта квантового ограничения, мы предполагаем, что это слабое понижение частоты фононов может быть связано с поверхностными дефектами нанопроволок GaSb. Благодаря двухступенчатой скорости потока TMGa и TMSb, мы реализовали вертикальный рост нанопроволок чистого ZB GaSb на стержнях InAs с помощью MOCVD без каких-либо посторонних катализаторов. Мы ожидаем, что путем дальнейшей оптимизации параметров роста, таких как температура роста и различные комбинации скоростей потока TMGa и TMSb в двухступенчатом процессе роста, можно будет получить нанопроволоки GaSb с более высоким соотношением сторон.

Рамановские спектры подложки GaSb (100) ( красная линия ) и нанопроволоки GaSb ( синяя линия ). зеленые линии являются результатами лоренцевой аппроксимации с несколькими пиками
Выводы
Таким образом, мы продемонстрировали самокаталитический рост нанопроволок GaSb на стержнях InAs с помощью MOCVD. Чтобы реализовать рост вертикальных нанопроволок гетероструктуры InAs / GaSb, мы сначала используем относительно низкие скорости потока TMGa и TMSb для сохранения капель Ga на стержнях InAs. Затем скорости потока TMGa и TMSb увеличиваются для улучшения скорости осевого роста. Из-за более медленной скорости радиального роста GaSb при более высокой температуре роста нанопроволоки GaSb, выращенные при 500 ° C, имеют больший диаметр, чем нанопроволоки, выращенные при 520 ° C. Однако для осевого роста из-за эффекта Гиббса-Томсона и уменьшения пересыщения капли с повышением температуры роста нанопроволоки GaSb, выращенные при 500 ° C, длиннее, чем нанопроволоки, выращенные при 520 ° C. Детальные измерения с помощью ПЭМ показывают, что кристаллическая структура стержней InAs представляет собой смесь структур WZ и ZB, в то время как верхние нанопроволоки GaSb имеют идеальную кристаллическую фазу ZB, а анализ комбинационного рассеяния указывает на высокое оптическое качество полученных нанопроволок GaSb. Представленный здесь метод роста может быть подходящим для выращивания других нанопроволок на основе антимонида. Более того, выращенные нанопроволоки GaSb на стержнях из InAs могут открыть новые возможности для применения в устройствах на основе нанопроволок и для изучения квантовой физики.
Сокращения
- CMOS:
-
Комплементарный металл-оксид-полупроводник
- EDS:
-
Энергодисперсионная спектроскопия
- БПФ:
-
Быстрое преобразование Фурье
- LO:
-
Продольный оптический
- MBE:
-
Молекулярно-лучевая эпитаксия
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- SEM:
-
Сканирующая электронная микроскопия
- SF:
-
Ошибка укладки
- ТЕМ:
-
Просвечивающая электронная микроскопия
- TMGa:
-
Триметилгаллий
- TMSb:
-
Триметилсурьма
- Кому:
-
Поперечный оптический
- TP:
-
Двойной самолет
- VLS:
-
Пар-жидкость-твердое вещество
- ZB:
-
Цинковая обманка
Наноматериалы
- Что такое химическое осаждение из паровой фазы?
- Материаловеды учат нанопроволоки "танцевать"
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Раскрытие морфологической эволюции и кинетики травления пористых кремниевых нанопроволок во время химическ…
- Иерархические антибактериальные полиамидные 6-ZnO нановолокна, полученные путем осаждения атомных слоев и гид…
- Пленка WS2 большой площади с большими одиночными доменами, образованными химическим осаждением из паровой фаз…
- Контроль роста высокоднородных нанопроволок селенида индия (In2Se3) с помощью процесса быстрого термического о…
- Характеристики одноосного намагничивания массивов текстурированных нанопроволок Fe, электроосажденных мето…
- Электрические свойства средневолновых и длинноволновых сверхрешеток InAs / GaSb, выращенных на подложках GaAs мето…
- Самосеянный рост MOCVD и значительно усиленная фотолюминесценция нанопроволок InGaAs / InP Core – Shell



