Электрические свойства средневолновых и длинноволновых сверхрешеток InAs / GaSb, выращенных на подложках GaAs методом молекулярно-лучевой эпитаксии
Аннотация
В настоящей работе мы сообщаем об электрических транспортных свойствах в плоскости средневолновых (MWIR) и длинноволновых инфракрасных (LWIR) сверхрешеток InAs / GaSb типа II (T2SL), выращенных с помощью системы молекулярно-лучевой эпитаксии (MBE) на GaAs (001). субстрат. Огромное рассогласование решеток между T2SL и подложкой GaAs уменьшено за счет роста буферного слоя GaSb на основе техники межфазной матрицы несоответствия (IMF). Чтобы компенсировать деформацию InAs / GaSb T2SL, мы использовали специальную последовательность заслонок, чтобы получить интерфейсы типа InSb и GaAs. Обнаружено, что MWIR InAs / GaSb T2SL демонстрирует p - и n -типа проводимости при низких и высоких температурах соответственно. Интересно отметить, что температура изменения проводимости зависит от температуры роста. С другой стороны, в проводимости LWIR T2SL преобладают только электроны. Важно отметить, что преобладающим механизмом рассеяния в LWIR T2SL при низких температурах является механизм рассеяния на шероховатости поверхности раздела.
Фон
Поскольку InAs / GaSb T2SL был разработан Sai-Halasz et al. [1] в 1977 г. исследованию этого полупроводникового материала было уделено большое внимание. Фотодетекторы на основе этого T2SL представляют теоретически более высокий потенциал по сравнению с теллуридом кадмия и ртути (HgCdTe) и современными системами инфракрасных материалов для следующего поколения инфракрасных (ИК) приложений [2, 3]. Интересно, что InAs / GaSb T2SL демонстрирует необычный ряд нарушенных запрещенных зон второго типа, где минимум зоны проводимости InAs расположен на 140 мэВ ниже потолка валентной зоны GaSb [1]. Следовательно, фундаментальный переход между подзонами тяжелых дырок и дном зоны проводимости зависит от толщины слоя InAs или GaSb [4]. Однако главным преимуществом такого выравнивания является снижение скорости оже-рекомбинации благодаря подавлению некоторых безызлучательных путей в валентной полосе [5]. Кроме того, межзонное туннелирование значительно уменьшается из-за больших эффективных масс (≈ 0,04 м 0 ) электронов и дырок [6]. Эти две последние функции позволяют снизить темновой ток, что приводит к высокой рабочей температуре (HOT) фотодетектора.
InAs / GaSb T2SL традиционно выращивают на подложке из GaSb с согласованной решеткой. Однако последнее дорогое и доступно в небольших размерах, менее 3 дюймов, что затрудняет реализацию широкоформатных решеток фокальной плоскости (FPA). Более того, подложки из GaSb не готовы к эпиграфии, а их ростовые поверхности содержат множество макроскопических дефектов [7]. Кроме того, коэффициент поглощения относительно высок в подложке GaSb (≈ 100 см −1 ) для ИК излучения более 5 мкм [8]. Благодаря своим многочисленным преимуществам, GaAs был предложен в качестве жизнеспособного кандидата для роста InAs / GaSb T2SL [9,10,11,12]. В самом деле, они готовы к эпиляции, экономичны и доступны в больших размерах до 6 дюймов. Кроме того, GaAs имеет коэффициент поглощения на два порядка ниже, чем у GaSb. К сожалению, существует огромное рассогласование решеток (~ 7,5%) между GaAs и InAs / GaSb T2SL, что приводит к высокой плотности дислокаций несоответствия (10 9 см −2 ) [13]. Следовательно, обязательно разработать новые методы роста, чтобы уменьшить напряжение и уменьшить плотность дислокаций. Среди этих методов - низкотемпературная нуклеация [14] и метод IMF [15, 16].
Чтобы улучшить характеристики фотоприемников на основе InAs / GaSb T2SL, необходимо лучшее понимание фундаментальных параметров. Одним из этих параметров является концентрация фоновых носителей, которая связана с временем жизни неосновных носителей заряда и длинами диффузии. Стоит отметить, что объемные материалы InAs и GaSb имеют противоположную полярность концентрации носителей. Действительно, материалы InAs и GaSb, выращенные с использованием молекулярно-лучевой эпитаксии (МЛЭ), остаточно n - и p -типа соответственно [17, 18]. Следовательно, проводимость InAs / GaSb T2SL, по прогнозам, будет зависеть от толщины каждого компонента.
В этой статье мы исследуем транспортные свойства в плоскости T2SL с 10 ML InAs / 10 ML GaSb и 24 ML InAs / 7 ML GaSb, предназначенных для регистрации в MWIR и LWIR областях соответственно, выращенных на полуизолирующем GaAs (001). подложки. Это исследование достигается путем выполнения температурно-зависимого измерения эффекта Холла с использованием метода Ван-дер-Пау. Кроме того, показано влияние температуры роста на проводимость InAs / GaSb T2SL.
Методы
Образцы InAs / GaSb T2SL были выращены на полуизолирующих подложках GaAs (001) в системе МПЭ с твердым источником RIBER Compact 21-DZ. Последний оборудован стандартными эффузионными ячейками для элементов III группы (индий (In) и галлий (Ga)) и ячейками с трещинами с клапанами для материалов группы V (мышьяк (As) и сурьма (Sb)). Температуру крекинга поддерживали на уровне 900 ° C для As и Sb с получением As 2 . и Sb 2 , соответственно. Термопара манипулятора (TC) и BandiT (BT) используются для контроля температуры роста. Последняя была откалибрована по температуре десорбции оксида GaAs. После раскисления подложек GaAs при 610 ° C (измерено BT), слой GaAs толщиной 250 нм был нанесен при 585 ° C (BT), чтобы получить гладкую исходную поверхность. Впоследствии буферный слой GaSb толщиной 1 мкм был выращен методом IMF при температуре BT 440 ° C [16, 19]. Этот метод заключается в формировании периодического массива дислокаций несоответствия 90 ° на границе раздела GaAs / GaSb, что приводит к низкой плотности дислокаций (≈ 10 6 см −2 ) [20]. После роста буферного слоя GaSb БТ больше не может использоваться из-за изменений излучательной способности, шероховатости поверхности и дополнительных механизмов поглощения излучения [21]. Таким образом, температура роста InAs / GaSb T2SL контролируется только TC. MWIR 10 ML InAs / 10 ML GaSb T2SL выращивают при различных температурах подложки, 330, 390 и 400 ° C (TC), чтобы исследовать влияние температуры роста на транспортные свойства. С другой стороны, LWIR 24 ML InAs / 7 ML GaSb T2SL был нанесен только при 390 ° C. Чтобы компенсировать деформацию между InAs и GaSb, использовалась специальная последовательность заслонок, которая, как сообщалось, приводила к лучшему структурному качеству [22, 23], следующим образом:рост InAs сопровождался выдержкой Sb в течение 8 с для образования InSb -подобные связи, тогда как рост GaSb сопровождался 2-секундной пропиткой As для роста GaAs-подобной границы раздела. Отношение потоков V / III составляет 8,3 и 4,6 для InAs и GaSb соответственно. Кроме того, как для InAs, так и для GaSb скорость роста составляет 0,5 ML / s. Рост контролировался in situ с помощью системы дифракции высокоэнергетических электронов (ДБЭО).
Выращенные образцы были оценены методом рентгеновской дифракции высокого разрешения (HRXRD) PANalytical X’Pert для исследования структурных свойств. Cu Kα 1 излучение ( λ ≈ 1.5406 Å), происходящих из фокуса линии, и монохроматора Ge (004) с четырьмя отскоками. Транспортные свойства оценивались путем измерения эффекта Холла с использованием метода Ван-дер-Пау в системе ECOPIA в диапазоне температур 80–300 К. Измерения проводились на квадратных образцах размером 6 × 6 мм 2 ; контакт осуществлялся точками индия в каждом углу. К образцам прикладывали магнитное поле напряжением 0,4 Тл по нормали.
Результаты и обсуждение
На рисунке 1 показаны измеренные и смоделированные HRXRD 2θ-ω кривые сканирования симметричного отражения (004) для MWIR и LWIR InAs / GaSb T2SL. Моделирование выполняется с помощью программного обеспечения «Эпитаксия», предоставленного PANalytical X’Pert. Как видно, есть спутники с хорошим разрешением с порядком до 4 для MWIR T2SL и до 7 для LWIR. Это свидетельствует о высоком структурном качестве выращенных слоев, особенно для LWIR T2SL. С другой стороны, полная ширина на полувысоте (FWHM) пика нулевого порядка, измеренная в ω-2θ направление составляет 107 и 99 угловых секунд для MWIR и LWIR T2SL соответственно. Период сверхрешетки ( L ) определяется по угловому расстоянию между двумя соседними спутниками (Δ θ ) следующим образом:

HRXRD 004 2θ-ω сканирование a MWIR b и LWIR InAs / GaSb T2SL. Экспериментальная (черная линия) и смоделированная (красная линия) HRXRD 2θ-ω сканирование на предмет (004) отражения a MWIR T2SL; есть хорошо разрешенные сателлиты порядка до 4, что является признаком хорошего качества сверхрешетки. Полная ширина пика нулевого порядка составляет 107 угловых секунд, b и LWIR InAs / GaSb T2SL; есть пики-сателлиты с порядком до 7, что подтверждает высокое кристаллическое качество. Полная ширина пика нулевого порядка составляет 99 угловых секунд. Период каждой сверхрешетки рассчитывается исходя из расстояния между соседними спутниками
$$ L =\ lambda / \ left (2 \ times \ Delta \ theta \ times \ mathit {\ cos} {\ theta} _ {SL} \ \ right) $$ (1)где λ - длина волны падающего рентгеновского луча, упомянутая ранее, а θ SL - угол Брэгга пика нулевого порядка сверхрешетки. Из рис. 1 период T2SL MWIR и LWIR составляет 6,74 ± 0,01 и 10,24 ± 0,02 нм соответственно. Подгоняя измеренную кривую к моделируемой, можно найти следующий состав одного периода MWIR T2SL:GaSb 3,4 нм (11,2 ML), GaAs 0,1 нм (0,2 ML), InAs 3,0 нм (10,1 ML) и InSb 0,2 нм (0,5 мл). Кроме того, толщины компонентов LWIR T2SL следующие:GaSb 2,3 нм (7,5 ML), GaAs 0,1 нм (0,2 ML), InAs 7,4 нм (24,7 ML) и InSb 0,4 нм (1 ML). Рассогласование решеток, определенное по углу между пиком нулевого порядка и буферным слоем GaSb, составляет 8,9 × 10 −3 . и 4,5 × 10 −3 для MWIR и LWIR T2SL соответственно. На рис. 2 представлена асимметричная (115) карта обратного пространства (RSM) для выращенных T2SL. В обоих образцах сателлиты сверхрешеток и пик GaSb выровнены по вертикали (у них одинаковая компонента вектора рассеяния Q x ), что позволяет сделать вывод, что оба T2SL практически полностью напряжены.

Асимметричный 115 RSM из a MWIR и b LWIR InAs / GaSb T2SL. Карта обратного пространства для асимметричного отражения (115) a MWIR и b LWIR InAs / GaSb T2SL. Пики в обеих сверхрешетках выровнены по вертикали (они имеют одинаковое значение вектора рассеяния Q x ). Следовательно, две сверхрешетки для MWIR и LWIR практически полностью деформированы
Электрические параметры в плоскости выращенных MWIR InAs / GaSb T2SL показаны на рис. 3. Как видно, непреднамеренно легированный InAs / GaSb T2SL демонстрирует воспроизводимое изменение типа проводимости. Несмотря на влияние буферного слоя GaSb ( p -типа) при измерениях эффекта Холла следует отметить, что изменение типа проводимости происходит только за счет слоя T2SL. Об этом изменении также сообщили несколько групп [6, 24, 25, 26]. T2SL демонстрирует p -типа проводимости ниже температуры, при которой происходит изменение ( T ч ) и n -типа проводимости выше T ч . Как упоминалось ранее, слои InAs и GaSb демонстрируют n -type и p -типа проводимости соответственно. Следовательно, остаточный фон InAs / GaSb T2SL с одинаковой толщиной для двух составляющих индуцируется компенсацией основных носителей от бинарных составляющих T2SL [27]. Для значения T ч , Mohseni et al. [6] сообщили о значении 140 K, Christol et al. [24] получили значение 190 К, а Хошахлаг и др. В работе [25] указано значение 200 К. Поведение концентрации и подвижности слоевых носителей определяется хорошо известными механизмами собственного фононного рассеяния (акустическим, пьезоэлектрическим, полярным и неполярно-оптическим). В исключительных случаях подвижность Холла увеличивается с увеличением температуры выше T ч (Рис. 3б); это вероятно из-за ионизированных ловушек из-за интерфейса InSb на границе раздела GaSb-on-InAs [6]. Т ч значение 145, 195 и 225 K для T2SL, выращенного при 330, 390 и 400 ° C соответственно (рис. 3); это связано с вероятно к высокой концентрации дырок при более высокой температуре роста, что сдвигает T ч снизить температуру. Высокая концентрация дырок обусловлена дефектами и ионизированными вакансиями при высокой температуре роста. InAs / GaSb T2SL, выращенный при 390 ° C, характеризуется концентрацией носителей 1,8 × 10 16 и 2,5 × 10 16 см −3 при 80 и 300 К соответственно. Этот результат лучше, чем у Mohseni et al. [6] (Холловская концентрация колеблется от 1,5 до 4 × 10 17 см −3 ) и практически такой же, как у Christol et al. [24] (Холловская концентрация 1,6 × 10 16 и 6 × 10 16 см −3 при 100 и 300 К соответственно). С другой стороны, мобильность Холла составляет 1300 ( p -типа) и 3200 см 2 / V s ( n -типа), при 80 и 300 К соответственно. Достигнутая мобильность намного выше, чем сообщается Christol et al. [24], у которых была подвижность Холла 100 и 1800 см 2 . / В при 100 и 300 К соответственно.

а Холловая концентрация и b Холловская подвижность MWIR InAs / GaSb T2SL, выращенного при различных температурах. Электрические параметры MWIR InAs / GaSb T2SL, выращенных при различных температурах. а Концентрация Холла:три T2SL демонстрируют изменение проводимости. Они p -типа при низких температурах и n -типа при высоких температурах. б Подвижность зала:есть две области тенденции мобильности. При низкой температуре подвижность уменьшается из-за различных механизмов рассеяния. При высоких температурах подвижность увеличивается за счет увеличения температуры, что можно объяснить ионизованными ловушками на InSb-подобном интерфейсе. Температура, при которой происходит изменение проводимости, увеличивается с увеличением температуры роста, что связано с высоким уровнем дефектов при более высоких температурах
Удельное сопротивление трех различных образцов показано на рис. 4. Можно заметить, что удельное сопротивление и температура имеют два четко определенных наклона. Для каждого образца две энергии термической активации можно извлечь из закона Аррениуса. Для n -типа область, энергия активации E и составляет 58, 72 и 68 мэВ для T2SL, выращенного при 330, 390 и 400 ° C соответственно. А для p -тип регион, E ap равна 7, 12 и 14 мэВ для InAs / GaSb T2SL, нанесенного при 330, 390 и 400 ° C соответственно. Для низких температур (ниже T ч ), T2SL показывает p -тип из-за p носители -типа, связанные с E ap которые доминируют в механизмах генерации и рекомбинации носителей. Для температур выше T ч , T2SL показывает n -типа проводимости из-за активации носителей глубокого уровня, связанной с высокой энергией активации E и . Источником этих глубоких уровней являются мелкие уровни в массивном InAs, которые являются результатом выстраивания зон между InAs и InAs / GaSb T2SL и действуют как глубокие уровни в InAs / GaSb T2SL [28].
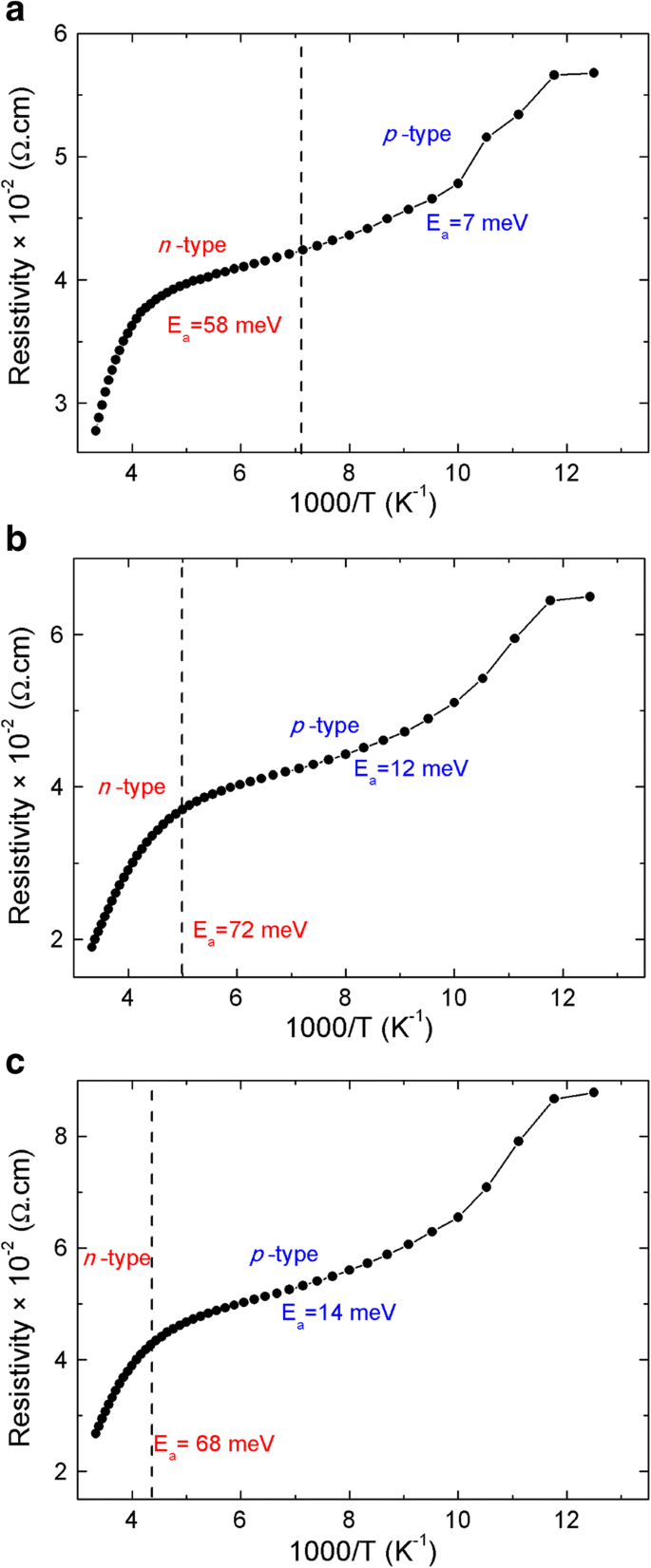
Холловское сопротивление MWIR InAs / GaSb T2SL, выращенного при a 330 ° С, b 390 ° C и c 400 ° С. Холловское сопротивление MWIR InAs / GaSb T2SL, осажденного при различных температурах роста, a 330 ° С, b 390 ° C и c 400 ° С. Для каждого графика есть два четко определенных наклона. Из закона Аррениуса можно выделить две тепловые энергии, что подтверждает существование двух примесных уровней. Один представляет n -типа носителей, а второй соответствует p -типа перевозчиков. Уровень глубокой примеси, связанный с n Несущие -типы являются результатом объединения полос между InAs и InAs / GaSb T2SL
Холловская концентрация, подвижность и удельное сопротивление LWIR InAs / GaSb T2SL представлены на рис. 5. В отличие от MWIR T2SL, в этом образце нет изменения типа проводимости. Этот T2SL показывает n -типа проводимости. Влияние p буферный слой GaSb (малоподвижные носители) типа при измерении эффекта Холла для этого n -типа T2SL (носители с высокой подвижностью) можно пренебречь, поскольку холловская подвижность пропорциональна квадрату подвижности носителей. Хошахлаг и др. [25] сообщили о таком же результате для 13 ML InAs / 7 ML GaSb T2SL. Кроме того, Szmulowicz et al. [29] указали, что LWIR T2SL, в котором слой InAs толще, чем GaSb, имеет тенденцию быть n -тип. Это n -типа проводимости обусловлена большой толщиной слоя InAs (остаточная n -допированный.) по сравнению с GaSb. Эти n Носители -типа связаны с энергией активации 33 мэВ (рис. 5б). Поведение холловской концентрации и подвижности типично для n полупроводники, за исключением диапазона температур ниже 95 К, где концентрация и подвижность носителей практически не зависят от температуры. Это свидетельствует о существовании не зависящего от температуры механизма рассеяния в этой области температур. Последний, как было продемонстрировано, является механизмом рассеяния шероховатости интерфейса (IRS) [30,31,32,33,34]. Этот механизм является доминирующим при низких температурах, когда рассеяние фононов «выморожено» [35]. Механизм IRS обусловлен наличием границ раздела, а также изменением толщины слоев, что приводит к изменению уровней энергии электронов; поэтому они действуют как источник рассеяния носителей заряда [35]. Более того, холловская подвижность, в которой доминирует механизм IRS, пропорциональна толщине InAs в шестой степени (\ (\ mu \ propto {d} _ {\ mathrm {InAs}} ^ {6.2} \)) [35].

а Концентрация Холла, подвижность Холла и b Холловское сопротивление непреднамеренно легированного LWIR InAs / GaSb T2SL. Транспортные свойства LWIR InAs / GaSb T2SL. а Концентрация Холла и подвижность:эта сверхрешетка показывает только n -типа проводимости для всего диапазона температур. Концентрация Холла увеличивается при повышении температуры, что вызвано эффектами ионизации. С другой стороны, поведение холловской подвижности определяется различными механизмами рассеяния (фононы и ионизированные примеси) для температур выше 95 К. Для температур ниже 95 К подвижность постоянна (как и холловская концентрация), что подтверждает существование другого механизма рассеяния, не зависящего от температуры. Это последний механизм шероховатости интерфейса. б Удельное сопротивление Холла:согласно закону Аррениуса существует только одна тепловая энергия, связанная с одним примесным уровнем
Выводы
Таким образом, T2SL InAs / GaSb были выращены на подложке GaAs с использованием буферного слоя GaSb на основе метода IMF. Более того, эти T2SL были продемонстрированы для областей обнаружения MWIR и LWIR. Было обнаружено, что MWIR T2SL демонстрирует изменение типа проводимости в виде p - до n -типа при повышении температуры. Кроме того, температура, при которой происходит изменение, увеличивается по мере увеличения температуры роста T2SL. Такое изменение типа проводимости объясняется существованием двух примесных уровней с двумя разными энергиями активации. С другой стороны, проводимость LWIR InAs / GaSb T2SL продемонстрирована как n -тип для всего диапазона температур. Доказано, что в дополнение к обычным механизмам рассеяния механизм IRS является доминирующим механизмом рассеяния при низких температурах. Эти результаты позволяют лучше понять физические свойства InAs / GaSb T2SL, что приводит к улучшению характеристик ИК-фотодетектора на основе этого материала.
Сокращения
- BT:
-
BandiT
- FPA:
-
Решетки в фокальной плоскости
- FWHM:
-
Полная ширина на половине максимальной
- ГОРЯЧИЕ:
-
Высокая рабочая температура
- HRXRD:
-
Дифракция рентгеновских лучей высокого разрешения
- IMF:
-
Массив межфазных несоответствий
- IR:
-
Инфракрасный
- IRS:
-
Рассеяние шероховатости границы раздела
- LWIR:
-
Длинноволновый инфракрасный
- MBE:
-
Молекулярно-лучевая эпитаксия
- MWIR:
-
Средневолновое инфракрасное излучение
- RHEED:
-
Дифракция электронов высоких энергий на отражение
- RSM:
-
Карта обратного пространства
- T2SL:
-
Сверхрешетка типа II
- TC:
-
Термопара
Наноматериалы
- Получение и магнитные свойства легированных кобальтом наночастиц шпинели FeMn2O4
- Наножидкости TiO2 - Часть 1:Приготовление и свойства
- Моделирование молекулярной динамики и имитация алмазной резки церия
- Оптические и электрические характеристики кремниевых нанопроволок, полученных методом химического травлен…
- Температурная зависимость ширины запрещенной зоны в MoSe2, выращенном методом молекулярно-лучевой эпитаксии
- Влияние толщины бислоя на морфологические, оптические и электрические свойства наноламинатов Al2O3 / ZnO
- Биполярные эффекты в фотоэдс метаморфных квантовых точечных гетероструктур InAs / InGaAs / GaAs:характеристика и кон…
- Получение и оптические свойства пленок GeBi с использованием метода молекулярно-лучевой эпитаксии
- Исследование структурных, электронных и магнитных свойств кластеров Ag n V (n =1–12)
- Зависимость токсичности наночастиц от их физических и химических свойств



