Самосеянный рост MOCVD и значительно усиленная фотолюминесценция нанопроволок InGaAs / InP Core – Shell
Аннотация
Мы сообщаем о росте и характеризации нанопроволок InGaAs / InP ядро-оболочка на подложках Si– (111) методом химического осаждения из газовой фазы (MOCVD). Деформация на границе ядро-оболочка, вызванная большим рассогласованием решеток между материалами ядра InGaAs и оболочки InP, оказывает сильное влияние на поведение роста оболочки InP, приводя к асимметричному росту оболочки InP вокруг ядра InGaAs и даже к изгиб нанопроволок. Измерения с помощью просвечивающей электронной микроскопии (ПЭМ) показывают, что оболочка InP когерентна с ядром InGaAs без каких-либо дислокаций несоответствия. Кроме того, измерения фотолюминесценции (ФЛ) при 77 К показывают, что пиковая интенсивность ФЛ нанопроволок ядро-оболочка InGaAs / InP демонстрирует увеличение в ~ 100 раз по сравнению с единственным образцом ядра InGaAs без оболочки InP из-за пассивации поверхностных состояний и эффективного удержание носителей в результате слоя оболочки InP. Полученные здесь результаты расширяют наше понимание динамики роста напряженных нанопроволок гетероструктуры ядро – оболочка и могут открыть новые возможности для применения в оптоэлектронных устройствах на основе нанопроволок InGaAs / InP на основе гетероструктуры на платформе Si.
Фон
Полупроводниковые нанопроволоки III – V были признаны многообещающими кандидатами в наноразмерные устройства следующего поколения благодаря их уникальным электронным, оптическим и геометрическим свойствам [1,2,3,4]. Среди полупроводниковых материалов AIIIBV тройная нанопроволока InGaAs чрезвычайно привлекательна для приложений фотоники и оптоэлектроники благодаря своим превосходным физическим свойствам, таким как большой регулируемый диапазон прямой запрещенной зоны, малая эффективная масса носителей и высокая подвижность носителей. Кроме того, интенсивно изучалась интеграция материалов III – V с платформой Si, которая позволяет сочетать преимущества уникальных физических свойств материалов III – V со зрелой технологией комплементарных металлооксидных полупроводников (CMOS). Из-за небольшого размера нанопроволоки дают возможность для интеграции материалов AIIIBV с Si, игнорируя большую разницу в параметрах решетки между материалами [5, 6]. К настоящему времени на кремниевых подложках созданы различные устройства на основе тройных нанопроволок InGaAs, в том числе маломощные быстродействующие транзисторы [7, 8], туннельные устройства [9, 10], светодиоды (светодиоды) [11 ], фотонные устройства [12, 13] и солнечные элементы [14, 15].
Однако из-за высокого отношения поверхности к объему одномерной нанопроволоки многочисленные состояния поверхности стали основным ограничением в создании высокопроизводительных оптоэлектронных устройств на основе нанопроволоки. С одной стороны, эти поверхностные состояния могут сильно ухудшить как электронные, так и оптические свойства материалов AIIIBV из-за рассеяния и процесса безызлучательной рекомбинации [16,17,18,19,20]. С другой стороны, для нанопроволок из некоторых узкозонных материалов (таких как InAs, InGaAs с высоким содержанием In) высокая плотность поверхностных состояний может привести к изгибу электронной зонной структуры вблизи поверхности нанопроволоки (эффект закрепления уровня Ферми на поверхности ). Такая неплоская зонная структура в дальнейшем вызовет перераспределение носителей заряда, что может сильно снизить производительность устройств на основе оптических нанопроволок [21]. Следовательно, устранение этих поверхностных состояний крайне необходимо. Для тройных нанопроволок InGaAs с более высоким составом In InP является желательным пассивирующим поверхность слоем, поскольку система материалов формирует выравнивание запрещенной зоны типа I, которое может эффективно ограничивать носители в InGaAs. Кроме того, для системы материалов InGaAs / InP, которая широко исследовалась в планарных структурах, длина волны излучения настраивается в диапазоне 1,31–1,55 мкм, что имеет многообещающие перспективы в оптоволоконной связи.
В этой работе мы выполнили выращивание и характеризацию нанопроволок InGaAs / InP ядро – оболочка на подложках Si– (111) с использованием химического осаждения из газовой фазы (MOCVD). Обнаружено, что деформация на границе раздела ядро-оболочка, возникающая в результате большого рассогласования решеток между материалами ядра и оболочки, оказывает сильное влияние на поведение роста оболочки InP. Большое несоответствие решеток между материалами сердцевины и оболочки может привести к неравномерному зарождению слоя покрытия InP вокруг нанопроволок сердцевины InGaAs и даже к изгибу нанопроволок. Оптимизируя условия роста, можно получить нанопроволоки InGaAs / InP ядро-оболочка с хорошей морфологией. Более того, измерения фотолюминесценции (ФЛ) при 77 К показывают, что пиковая интенсивность ФЛ нанопроволок ядро-оболочка InGaAs / InP демонстрирует примерно 100-кратное усиление по сравнению с голыми нанопроводами InGaAs из-за пассивации поверхностных состояний и эффективного удержания носителей заряда с помощью покрытия InP. слой.
Методы / экспериментальные
Рост нанопроволоки
Нанопроволоки InGaAs / InP ядро-оболочка выращивались с помощью системы MOCVD с моноблочной насадкой для душа (AIXTRON Ltd., Германия) при давлении 133 мбар. Триметилиндий (TMIn) и триметилгаллий (TMGa) использовались в качестве предшественников группы III, а арсин (AsH 3 ) и фосфин (PH 3 ) использовались в качестве предшественников V группы. Водород сверхвысокой чистоты (H 2 ) использовался в качестве газа-носителя, а общий расход H 2 было 12 слм. Перед выращиванием подложки Si– (111) нагревали до 635 ° C для отжига, а затем охлаждали до 400 ° C в атмосфере AsH 3 . поток с образованием (111) B-подобных поверхностей [22]. Нанопроволоки с сердцевиной InGaAs выращивали при 565 ° C в течение 15 мин. В процессе роста TMIn и AsH 3 расход 0,8 × 10 - 6 моль / мин и 1,0 × 10 - 4 моль / мин, при варьировании скорости потока ТМГа. Состав паровой фазы TMGa, Xv, который был определен как отношение расходов TMGa / (TMGa + TMIn), варьировался от 30 до 40%. Оболочка InP была выращена при 565 ° C в течение 10 минут с TMIn и PH 3 . расход 2 × 10 - 6 моль / мин и 8,0 × 10 - 4 моль / мин соответственно. После выращивания образцы охлаждали до комнатной температуры с помощью PH 3 как защитное средство.
Методы характеризации
Морфология нанопроволок была охарактеризована с помощью сканирующей электронной микроскопии (SEM) (Nova Nano SEM 650) и просвечивающей электронной микроскопии (TEM) (JEM2010F TEM; 200 кВ) в сочетании с рентгеновской энергодисперсионной спектроскопией (EDS). исследовать кристаллическую структуру и состав соответственно. Для ПЭМ-наблюдений нанопроволоки механически переносились с образцов на медные сетки, покрытые углеродной пленкой. Для исследования оптических свойств выращенных нанопроволок были выполнены измерения фотолюминесценции (ФЛ) с использованием лазера с длиной волны 532 нм в качестве источника возбуждения. Образцы возбуждали лазерной мощностью ~ 100 мВт на пятно диаметром примерно 150 мкм. Сигнал ФЛ подавали непосредственно в инфракрасный спектрометр с преобразованием Фурье (FTIR) и регистрировали детектором InSb, охлаждаемым жидким азотом. Подвижное зеркало в FTIR-спектрометре работало в режиме быстрого сканирования [23], в отличие от измерений модулированной ФЛ с пошаговой разверткой на нанопроводах InAs в средней инфракрасной области [24].
Результаты и обсуждение
На рисунке 1 показана схематическая иллюстрация роста нанопроволок InGaAs / InP ядро-оболочка на подложке Si– (111) и последовательности источник-источник для роста нанопроволок. Нанопроволоки InGaAs растут по самокаталитическому механизму [25]. Обратите внимание, что капли In будут потребляться под AsH 3 атмосферы (показана в области 3 на рис. 1). Разрастание оболочки InP было инициировано переключением AsH 3 в PH 3 поток и открытие потока TMIn одновременно.
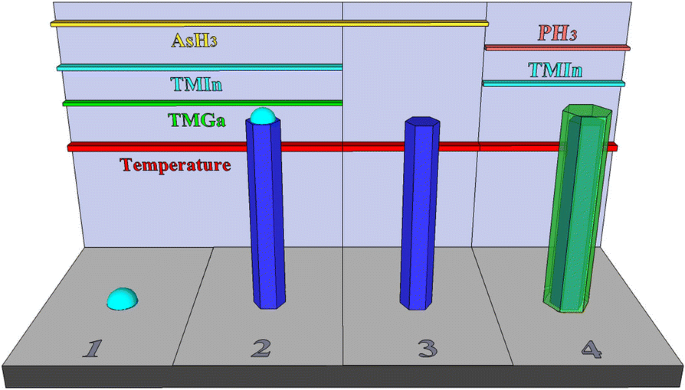
Схематическое изображение роста нанопроволок ядро-оболочка InGaAs / InP и последовательности источника-питания для роста нанопроволоки
На рис. 2а, б показаны типичные СЭМ-изображения голых нанопроволок InGaAs и InGaAs / InP ядро-оболочка с Xv =30% соответственно. Все нанопроволоки InGaAs выровнены вертикально на подложке Si с одинаковым диаметром по всей длине. После последующего роста оболочки InP нанопроволоки все еще имеют гладкие боковые грани, что указывает на оптимизацию параметров роста. Судя по статистическим распределениям диаметров голых нанопроволок InGaAs и InGaAs / InP ядро-оболочка, средний диаметр нанопроволок увеличивается с ∼ 65 до ∼ 95 нм после роста оболочки InP, что указывает на среднюю толщину оболочки InP примерно 15 нм. Однако нанопроволоки ядро-оболочка InGaAs / InP на рис. 2b заметно изогнуты, что вызвано напряжением в нанопроволоке сердцевины InGaAs, вызванным оболочкой InP из-за большого несоответствия решеток между материалами сердцевины и оболочки. На рис. 2c, d показаны СЭМ-изображения нанопроволок ядро-оболочка InGaAs / InP с Xv 35% и 40% соответственно. По сравнению с нанопроволоками на рис. 2b, изгиб нанопроволок InGaAs / InP ядро-оболочка с Xv 35% значительно уменьшился (рис. 2c). При дальнейшем увеличении Xv до 40% нанопроволоки становятся прямыми без видимого изгиба (рис. 2d). Это явление можно объяснить уменьшением рассогласования решеток между материалами ядра InGaAs и оболочки InP с увеличением состава Ga. Кроме того, исходя из статистических распределений диаметров нанопроволок ядро-оболочка InGaAs / InP, по мере увеличения состава Ga диаметр нанопроволоки одновременно увеличивается, что также может препятствовать изгибу сердцевинных нанопроволок InGaAs после покрытия InP.

а СЭМ-изображения под углом 30 ° нанопроволок InGaAs и нанопроволок InGaAs / InP ядро-оболочка с Xv b 30%, c 35% и d 40%
Чтобы исследовать кристаллическую структуру выращенных нанопроволок и подтвердить существование структуры ядро-оболочка после выращивания оболочки InP, были проведены детальные измерения ПЭМ. Как показано на рис. 3а, кристаллическая структура нанопроволоки InGaAs с Xv 35% состоит из политипа структур вюрцита (WZ) и цинковой обманки (ZB) с большим количеством дефектов упаковки (ДУ) по мере роста. направление, и из-за сосуществования структур WZ и ZB вместе со структурными дефектами, соответствующие выбранные области электронной дифракции (SAED) пятна расщепляются и немного вытянуты вдоль направления роста (вставка на рис. 3a). Эти плоские дефекты обычно наблюдаются при выращивании нанопроволок InAs или InGaAs без постороннего катализатора с помощью MOCVD [26,27,28]. На рис. 3b показано TEM-изображение низкого разрешения в светлом поле (BF) типичной нанопроволоки InGaAs / InP ядро-оболочка с Xv 35% (как показано на рис. 2c). После покрытия InP нанопроволока все еще остается прямой без сужения. Соответствующее электронно-микроскопическое изображение высокого разрешения (HR) показано на рис. 3c. Наблюдается четкая граница раздела между ядром InGaAs и оболочкой InP. Кроме того, не было обнаружено никаких дислокаций несоответствия при следовании плоскостям {111} на границе ядро-оболочка. Следовательно, выращенная оболочка InP когерентна с ядром InGaAs. Более того, из-за когерентного эпитаксиального роста слоя покрытия InP, кристаллическая структура оболочки InP будет полностью унаследовать структуру нанопроволоки сердцевины InGaAs, что подтверждается смешанной структурой WZ / ZB нанопроволоки ядро-оболочка InGaAs / InP на рис. . 3c. Это явление наблюдалось в нанопроволоках ядро-оболочка других систем материалов [29,30,31], и это поведение подчеркивает необходимость улучшения качества кристаллов самокатализирующихся нанопроволок InGaAs.
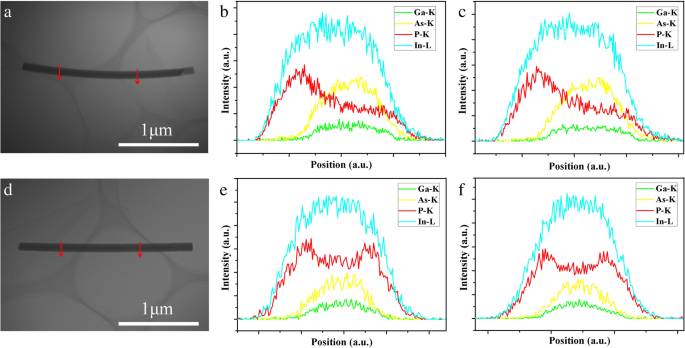
а HRTEM-изображение голой нанопроволоки InGaAs (Xv =35%), полученное от оси зоны <110>. На вставке - соответствующая электронограмма для выбранной области (SAED). б ПЭМ-изображение с малым увеличением нанопроволоки InGaAs / InP ядро-оболочка (Xv =35%). c HRTEM-изображение нанопроволоки, просматриваемое с оси зоны <110>. Красная пунктирная линия указывает на интерфейс между ядром и оболочкой
На рис. 4a – c показаны ПЭМ-изображение с малым увеличением и анализ EDS типичной нанопроволоки InGaAs / InP ядро-оболочка, показанной на рис. 2b. Согласно сканированию линии EDS через нанопроволоку, сигнал P может быть явно идентифицирован в спектрах, что указывает на существование оболочки InP вокруг ядра InGaAs. В то время как спектр EDS сигнала P асимметричен, что означает, что рост оболочки InP неоднороден вокруг нанопроволоки сердцевины InGaAs. Мы предполагаем, что это явление может быть в основном вызвано относительно большим рассогласованием решеток между материалами ядра и оболочки, и такое неравномерное зарождение оболочки InP будет в дальнейшем приводить к изгибу нанопроволок. Напротив, для прямой нанопроволоки ядро-оболочка InGaAs / InP (Xv =35%) на рис. 2c, анализ EDS на рис. 4e-f показывает симметричное распределение P-сигнала по всей нанопроволоке, что указывает на улучшенную однородность оболочки InP вокруг ядро InGaAs с увеличением содержания Ga здесь.
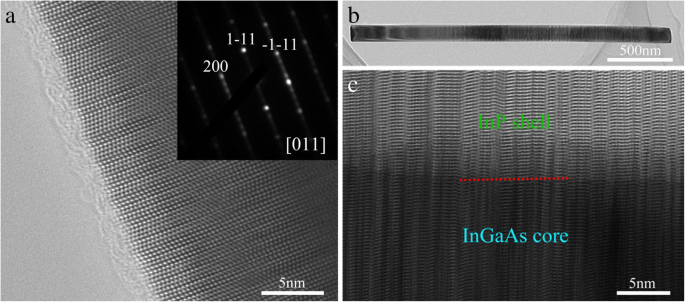
а ПЭМ-изображение с малым увеличением нанопроволоки InGaAs / InP (Xv =30%) ядро-оболочка. б , c Линия EDS проходит вдоль двух красных линий, отмеченных a . г ПЭМ-изображение с малым увеличением нанопроволоки InGaAs / InP (Xv =35%) ядро-оболочка. е , f Линия EDS проходит вдоль двух красных линий, отмеченных ( d )
Для исследования оптических свойств выращенных нанопроволок были проведены измерения фотолюминесценции (ФЛ). На рисунке 5 сравниваются типичные спектры ФЛ голых нанопроволок InGaAs и InGaAs / InP (Xv =30%) ядро-оболочка при 77 К. Спектр ФЛ голых нанопроволок InGaAs показывает гораздо более слабое излучение с максимумом при ∼ 0.73 эВ (синяя линия на рис. 5), в то время как спектр ФЛ нанопроволок ядро-оболочка InGaAs / InP демонстрирует очень сильное излучение с максимумом при ~ 0,78 эВ (красная линия на рис. 5), а интенсивность пика ФЛ показывает ~ 100-кратное усиление по сравнению с к голым нанопроводам InGaAs. Поскольку плотности нанопроволок из разных образцов сопоставимы, мы считаем, что такое резкое усиление излучения ФЛ нанопроволок InGaAs / InP ядро-оболочка вызвано эффективным подавлением поверхностных состояний и удержанием носителей слоем покрытия InP.
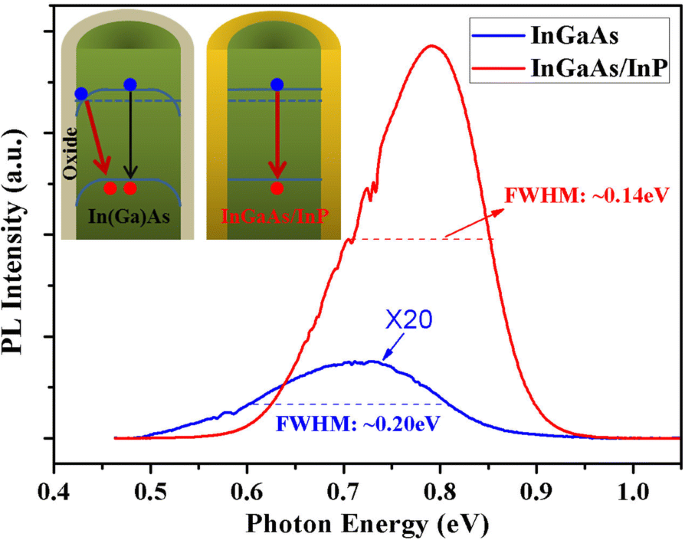
Спектры ФЛ голых нанопроволок InGaAs и InGaAs / InP (Xv =30%) ядро-оболочка при 77 К. На вставке схематически показаны зонные структуры голых нанопроволок InGaAs и InGaAs / InP ядро-оболочка
Другой интересной особенностью является небольшой сдвиг пика ФЛ InGaAs / InP в синий цвет (∼ 50 мэВ) по сравнению с голыми нанопроволоками InGaAs. Во-первых, мы приписываем это различное поведение изменению пути рекомбинации доминирующих носителей, когда ядро InGaAs покрыто оболочкой из InP. Как правило, для голых нанопроволок InAs или InGaAs с высоким содержанием In с поверхностями, покрытыми естественным оксидом, поверхностный уровень Ферми закрепляется в зоне проводимости, индуцированной многочисленными поверхностными состояниями, что вызывает изгиб зоны вниз вблизи поверхности нанопроволоки. Затем эта неплоская зонная структура приведет к перераспределению носителей, при котором электроны накапливаются возле поверхности нанопроволоки, в то время как дырки остаются в центре нанопроволоки. При освещении предпочтительным будет пространственно непрямый переход электрон-дырочной пары с более низкой энергией, как показано на вставке к рис. 5. Для голых нанопроволок InAs сообщалось, что разница в энергии между излучением около края зоны и поверхностным излучением. эмиссия составляет примерно ~ 35–45 мэВ [21]. Однако для нанопроволок InGaAs, поскольку изгиб поверхностных зон значительно уменьшается с увеличением состава Ga, эта разница в энергии будет уменьшаться одновременно, и тогда электроны будут меньше удерживаться вблизи поверхности нанопроволоки, а дырки будут менее локализованы в центре нанопроволоки. Таким образом, мы считаем, что спектр ФЛ голых нанопроволок InGaAs представляет собой смесь излучения, связанного с поверхностью, и излучения, близкого к краю зоны. Из-за пространственного разделения вероятность перехода через поверхность очень мала. Кроме того, многочисленные поверхностные состояния могут потреблять лишние электронно-дырочные пары в процессе безызлучательной рекомбинации. Таким образом, интенсивность ФЛ голых нанопроволок InGaAs чрезвычайно мала.
Однако ситуация изменится, если нанопроволоки с сердцевиной InGaAs будут покрыты оболочкой из InP. Поскольку поверхностные состояния сердцевинных нанопроволок эффективно удаляются, а оболочка InP действует как энергетический барьер, эффективно ограничивая носители в нанопроводах InGaAs, прямой переход вблизи края зоны с более высокой вероятностью перехода становится доминирующим, что подтверждается значительным усилением излучения ФЛ. Более того, из-за исключения излучения, связанного с поверхностью, спектр фотолюминесценции нанопроволок InGaAs / InP ядро-оболочка имеет более узкую полную ширину на полувысоте (FWHM) по сравнению с голыми нанопроводами InGaAs. Как упоминалось ранее, из-за полученного здесь облегченного изгиба поверхностных зон для нанопроволок InGaAs разница в энергии между излучением на краю полосы и излучением, связанным с поверхностью, должна быть намного меньше, чем ~ 50 мэВ, полученная здесь. Таким образом, помимо этого эффекта, мы предполагаем, что деформация является основной причиной наблюдаемого синего сдвига. Поскольку оболочка InP когерентно росла на ядре InGaAs, свободном от дислокаций несоответствия на границе раздела, ядро InGaAs испытывает сжимающую деформацию, которая может вызвать расширение запрещенной зоны нанопроволоки сердцевины InGaAs и объяснить синий сдвиг излучения пика ФЛ [ 32, 33]. Следовательно, при выращивании слоя покрытия InP пиковая энергия ФЛ нанопроволок InGaAs должна иметь синий сдвиг, а интенсивность излучения ФЛ может быть значительно улучшена.
На рисунке 6а показаны нормализованные спектры ФЛ нанопроволок ядро-оболочка InGaAs / InP с различным Xv при 77 К. Энергия пика ФЛ показывает непрерывный синий сдвиг (от ~ 0,78 эВ до ~ 0,86 эВ) с увеличением Xv в диапазоне от 30 до 40 %. Кроме того, по результатам измерений ФЛ при комнатной температуре, излучение нанопроволок InGaAs / InP ядро-оболочка имеет максимум в диапазоне длин волн 1,49–1,68 мкм, который имеет минимальное затухание мощности при оптоволоконной связи (область ~ 1,55 мкм). На рисунке 6b показаны температурно-зависимые спектры ФЛ для образца нанопроволоки ядро-оболочка InGaAs / InP с Xv =40%, а на вставке показан соответствующий температурно-зависимый сдвиг энергии пика ФЛ. Обычно в монокристаллическом массивном материале температурная зависимость люминесценции демонстрирует непрерывное красное смещение с увеличением температуры в соответствии с уравнением Варшни. Интересно, что, судя по вставке к рис. 6б, красное смещение можно наблюдать только в интервале температур 60–290 К. При температуре ниже 60 К энергия пика ФЛ практически не меняется. Учитывая высокую плотность структурных дефектов в выращенных нанопроволоках, мы предполагаем, что это явление, скорее всего, вызвано локализованными состояниями ловушек вблизи края зоны [34]. При низкой температуре в излучении преобладает ловушка. С повышением температуры захваченные носители возбуждаются из ловушечных состояний с меньшей энергией к краю зоны. Следовательно, энергия пика ФЛ в области низких температур не соответствует обычно наблюдаемому непрерывному красному смещению с температурой и имеет тенденцию занижаться по сравнению с точным краем полосы.
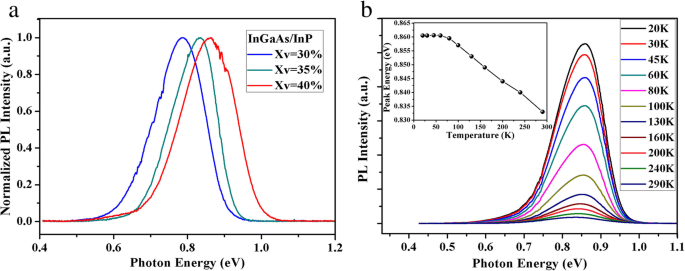
а Нормированные спектры ФЛ нанопроволок ядро-оболочка InGaAs / InP с различным Xv (Xv =30%, 35% и 40%) при 77 К. b Температурно-зависимые спектры ФЛ нанопроволок InGaAs / InP ядро-оболочка с Xv =40%. Вставка в b показывает соответствующий температурный сдвиг пиковой энергии ФЛ
Выводы
Таким образом, мы представили рост и характеристики нанопроволок InGaAs / InP ядро-оболочка на подложках Si– (111) с использованием MOCVD. Напряжение на границе раздела ядро-оболочка, вызванное большим рассогласованием решеток между материалами ядра и оболочки, оказывает сильное влияние на поведение роста оболочки InP, что приводит к асимметричному росту оболочки InP вокруг ядра InGaAs и даже к изгибу материала. нанопроволоки. Измерения с помощью просвечивающего электронного микроскопа показали, что оболочка InP когерентно растет на ядре InGaAs без каких-либо дислокаций несоответствия. По измерениям ФЛ при 77 К, пиковая интенсивность ФЛ нанопроволок InGaAs / InP ядро-оболочка показывает улучшение в ~ 100 раз по сравнению с голыми нанопроволоками InGaAs из-за пассивации поверхностных состояний и эффективного удержания носителей слоем покрытия InP. Такое значительное усиление эмиссии нанопроволок, покрытых InP, позволяет нам наблюдать эмиссию даже при комнатной температуре. В целом, полученные здесь результаты расширяют наше понимание поведения роста напряженных нанопроволок гетероструктуры ядро-оболочка и могут заложить основу для создания оптоэлектронных устройств на основе нанопроволок InGaAs.
Сокращения
- BF:
-
Светлое поле
- CMOS:
-
Комплементарный металл-оксид-полупроводник
- EDS:
-
Энергодисперсионная спектроскопия
- FTIR:
-
Инфракрасное преобразование Фурье
- FWHM:
-
Полная ширина на половине максимальной
- Светодиод:
-
Светодиод
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- PL:
-
Фотолюминесценция
- SAED:
-
Электронная дифракция в выбранной области
- SEM:
-
Сканирующая электронная микроскопия
- ТЕМ:
-
Просвечивающая электронная микроскопия
- TMGa:
-
Триметилгаллий
- TMIn:
-
Триметилиндий
- ZB:
-
Цинковая обманка
Наноматериалы
- Материаловеды учат нанопроволоки "танцевать"
- Нановолокна и нити для улучшенной доставки лекарств
- Получение и повышенная активность каталитического гидрирования наночастиц Sb / палигорскита (PAL)
- Самокатализирующийся рост вертикальных нанопроволок GaSb на стержнях InAs путем осаждения из паровой фазы метал…
- Оптические и электрические характеристики кремниевых нанопроволок, полученных методом химического травлен…
- Синтез и люминесцентные свойства водорастворимых наночастиц α-NaGdF4 / β-NaYF4:Yb, Er Core – Shell
- Эффективный и действенный дизайн нанопроволок InP для максимального сбора солнечной энергии
- Влияние повышенной термической стабильности опорного слоя из оксида алюминия на рост вертикально ориентиро…
- Механизмы образования нанопроволок InGaAs, полученных двухступенчатым химическим осаждением из паровой фазы и…
- 5G и проблема экспоненциального роста данных



