Рост и селективное травление многослойных структур кремний / кремний-германий, легированных фосфором, для применения в вертикальных транзисторах
Аннотация
Полевые транзисторы с вертикальным затвором и круговым движением (vGAAFET) рассматриваются как потенциальные кандидаты на замену FinFET для передовых технологий производства интегральных схем на 3-нм технологическом узле или за его пределами. Многослойный (ML) Si / SiGe / Si обычно выращивается и обрабатывается для формирования вертикальных транзисторов. В этой работе изучались включение фосфора в Si / SiGe / Si и вертикальное травление этих МС с последующим селективным травлением SiGe в латеральном направлении с образованием структур для vGAAFET. Для эпитаксии было предложено несколько стратегий, таких как продувка водородом, чтобы ограничить доступ атомов P к поверхности Si, и / или введение Si или Si 0,93 Ge 0,07 прокладки на обеих сторонах слоев кремния, легированного фосфором, и заменяя SiH 4 Автор:SiH 2 Cl 2 (DCS). Экспериментальные результаты показали, что сегрегацию и автолегирование можно также уменьшить, добавив 7% Ge в Si, легированный P. Структура имела хорошее качество решетки и практически не имела релаксации деформации. Селективное травление Si, легированного P (или Si, легированного P 0,93 Ge 0,07 ) и SiGe также обсуждались с использованием мокрого и сухого травления. Также сравнивались производительность и селективность различных методов травления. В этой статье представлены сведения о том, как справляться с проблемами или трудностями эпитаксии и травления слоев n-типа в вертикальной структуре GAAFET.
Введение
По мере того, как масштабирование комплементарного металлооксидного полупроводника (CMOS) достигает своего физического ограничения, эффекты короткого канала значительно ухудшают характеристики транзистора. Решением этих проблем являются новые конструкции транзисторов, например GAAFET (затворные полевые транзисторы), которые также рассматриваются как наиболее многообещающие кандидаты для наноразмерных транзисторов вплоть до технологического узла 3 нм [1,2,3 , 4,5,6]. Боковые и вертикальные нанопроволоки / нанолисты являются основными структурами согласно Международной дорожной карте для устройств и систем (IRDS) 2020 для замены FinFET [7]. Вертикальные GAAFET (или vGAAFET) имеют свободную гибкость конструкции по длине затвора и имеют большой потенциал для увеличения интегральной плотности [4, 8]. Существует две основные категории реализации вертикальных нанопроволочных структур:восходящая и нисходящая. В восходящем методе используется металлический катализатор, что может вызвать проблемы совместимости процесса [9, 10]. Нисходящий метод является основным в отрасли из-за лучшего контроля конфигурации нанопроволоки и совместимости с FinFET [4, 11,12,13,14]. Нисходящий метод изготовления вертикальных полевых транзисторов GAAFET привлекает большое внимание. Самовыравнивающийся затвор с точным контролем длины затвора был ключевой проблемой [15, 16]. Для достижения лучшего эффективного управления длиной затвора или уменьшения отклонений, длина затвора может в первую очередь определяться толщиной материала канала, эпитаксиально выращенного на нижней плоской поверхности, например Si / SiGe / Si, и SiGe был материалом канала [17, 18,19,20]. Более того, еще одна важная проблема интеграции заключается в легировании между каналом и областями S / D [16, 20, 21], особенно при резком контроле перехода [20]. По сравнению с традиционным процессом имплантации истока / стока, процесс эпитаксии упрощает процесс изготовления, снижает повреждение поверхности и обеспечивает однородный профиль легирования. Однако многослойная структура Si / SiGe / Si, легированная P, трудно эпитаксиально расти из-за явлений сегрегации, автолегирования и диффузии наиболее распространенных легирующих примесей n-типа, фосфора [22, 23], мышьяк [24, 25] и / или сурьма [26, 27] на границе Si / SiGe в системах химического осаждения из газовой фазы (CVD). Следовательно, сегрегированные донорные атомы, собранные на границе раздела Si / SiGe и слое SiGe, будут легированы, что может ухудшить характеристики транзистора из-за высокой утечки.
Одна из стратегий, препятствующих сегрегации легирующей примеси, состоит в применении очень низкой температуры роста. Имеется серия отчетов, в которых предпринимаются многочисленные попытки увеличить легирование n-типа методом молекулярно-лучевой эпитаксии (МБЭ) [28]; Между тем, этот метод не применялся при сердечно-сосудистых заболеваниях. Оборудование MBE в основном представляет собой однокристальную конструкцию, требующую высокого вакуума и низкой производительности. Более того, оборудование MBE несовместимо с промышленными пластинами размером более 8 дюймов. Следовательно, технология MBE не подходит для промышленного массового производства. Однако система RPCVD обладает мощными производственными мощностями и простой структурой оборудования, что подходит для индустрии IC [29]. Первая идея для роста RPCVD - регулировать поток водорода в камере, поскольку водород является газом-носителем и может влиять на кинетику газов-прекурсоров. Ли и др. . [23] сообщили, что водород изменяет структуру связи основных атомов на поверхности и снижает энергию сегрегации за счет применения низкой температуры роста в системе быстрого термического CVD (RTCVD). Однако влияние водорода на границе Si / SiGe в системе CVD пониженного давления (RPCVD) не исследовалось. Сувар и др. . [30] вставил 30-нм нелегированный Si разделительный слой между Si, легированным P и SiGe, чтобы снизить концентрацию P на границе раздела в 4 раза (с 8 × 10 19 см −3 до 2 × 10 19 см −3 ), но пик легирования P не может быть устранен. Беннетт и другие . [31] исследовали влияние деформации на легирование Si n-типа. Растворимость легирования в твердом состоянии была увеличена за счет введения в Si деформации растяжения. Кристенсен и др. . [32] не обнаружили существенной зависимости коэффициента диффузии P от содержания Ge в Si 1-x . Ge x (0 ≤ х ≤ 0,22). И коэффициенты диффузии P мало различались между релаксированным Si и SiGe, деформированным при двухосном сжатии. Зангенберг и др. . [33] наблюдали увеличение коэффициента диффузии в 2 раза при 825 ° C для релаксированного Si 0,88 . Ge 0,12 .
В этой статье было предложено несколько методов для улучшения включения P в Si в многослойном Si / SiGe / Si с использованием RPCVD. В экспериментах использовались различные стратегии, такие как продувка водородом, вставка нелегированных разделительных слоев, замена прекурсора Si из SiH 4 в SiH 2 Cl 2 (DCS), и модулируя профиль деформации, вводя Si 0,93 Ge 0,07 жертвенный слой по обе стороны от слоя SiGe. Кроме того, обсуждалось селективное травление SiGe для формирования тонкого слоя SiGe (предназначенного как канальный слой) [6, 34]. Также сравнивались характеристики травления инструментов для мокрого и сухого травления. Окончательная структура предназначена для использования в vGAAFET для технологического узла менее 10 нм в будущем.
Методы
Мультислои (МС) Si / SiGe / Si были выращены на 200-миллиметровых пластинах Si <100> с помощью оборудования RPCVD (ASM Epsilon 2000). Подложки Si очищали смешанным раствором H 2 SO 4 и H 2 О 2 с последующим разбавлением HF для удаления естественного оксида перед вставкой в загрузочные замки камеры эпитаксии. Образцы были очищены на месте путем отжига при 1050 ° C для удаления естественного оксида для получения поверхности Si высокого качества. Прекурсорами Si, Ge и P были SiH 4 (или SiH 2 Cl 2 ), 10% GeH 4 в H 2 , и 2% PH 3 в H 2 . Температура роста составляла 650 ° C, а давление в камере во время эпитаксии поддерживалось на уровне 80 Торр. В некоторых экспериментах давление в камере было снижено до 10 Торр для выращивания кремния, легированного фосфором 0,93 . Ge 0,07 слой в областях истока / стока (S / D). Содержание Ge в канале SiGe поддерживалось постоянным на уровне 0,22. Чтобы изучить характеристики селективного травления, нанесли 50 нм нитрид / 30 нм оксид в качестве жесткой маски для защиты нижних ML. Литография и сухое анизотропное вертикальное травление были выполнены для формирования отдельных кубовидных узоров. Эксперименты по селективному травлению проводились с помощью инструмента для влажного травления HF (6%):H 2 О 2 (30%):CH 3 COOH (99,8%) =1:2:4 и инструмент для сухого травления CF 4 :O 2 :He =4:1:5 [35].
МС Si / SiGe / Si были охарактеризованы методами просвечивающей электронной микроскопии высокого разрешения (Thermo Scientific Talos F200) (HRTEM), энергодисперсионной рентгеновской спектроскопии (EDX), дифракции рентгеновских лучей высокого разрешения (HRXRD). и карту обратной решетки высокого разрешения (HRRLM) от Bruker JV Delta-x, сканирующую электронную микроскопию (SEM) от Hitachi (Япония) и масс-спектроскопию вторичных ионов (SIMS).
Результаты и обсуждение
Эпитаксия МС Si / SiGe / Si, легированных P
В этом исследовании первоначально изучалось включение P в Si и SiGe. Структуры МЛ показаны на рис. 1а. МС Si, легированного P / нелегированного Si, с увеличением PH 3 поток был увеличен, и профили слоев были исследованы с помощью SIMS на рис. 1b. На рисунке видно, что концентрация P увеличивается и достигает наивысшего уровня 2,6 × 10 19 . см −3 . Еще два образца с профилем «Si / Si, легированный P 0,72 Ge 0,28 / Si, легированный P »и« Si / Si, легированный P 0,72 Ge 0,28 / Si ’, а P-профиль показан на рис. 1c, d соответственно. На рис. 1в наблюдается скопление скоплений на границах раздела Si / Si, легированного фосфором 0,72 . Ge 0,28 многослойные. Накопление P на границе раздела увеличивается с увеличением концентрации P снизу вверх в многослойных слоях, и максимальная концентрация составляет 1,6 × 10 20 . см −3 , что в 6 раз больше, чем концентрация на рис. 1б (2,6 × 10 19 см −3 ). В легированном Si 0,72 Ge 0,28 слоев (рис. 1d), концентрации P значительно выше, и нет пиков на границе раздела. Из-за легирования немного увеличивается процентное содержание Ge. Такое поведение связано с повышенной адсорбцией SiH 4 и GeH 4 при наличии PH 3 . Кроме того, из-за легирования толщины слоев на рис. 1в, г, которые имеют одинаковое время роста, различаются. Это означает, что легирование P увеличивает скорость роста Si 0,72 Ge 0,28 слоями и поглощением GeH 4 , в то время как скорость роста Si замедляется из-за адсорбции P. Эти явления согласуются с результатами, описанными в работах. [36,37,38]. Из вышесказанного, сегрегация P и явление автолегирования являются серьезными на границе Si / SiGe. Пик P-легирования на границе Si / SiGe вызывает непреднамеренное легирование в слое SiGe. Поскольку SiGe предназначен для использования в качестве канального слоя в транзисторах, неоднородный профиль легирования или высокие фоновые уровни легирования будут ограничивать применение устройства [39]. Некоторые методы устранения пика P будут рассмотрены ниже. Для лучшего сравнения все слои SiGe напряжены, а коэффициент расхода SiH 4 (SiH 2 Cl 2 ) и GeH 4 поскольку слой SiGe не изменялся на протяжении всех экспериментов.
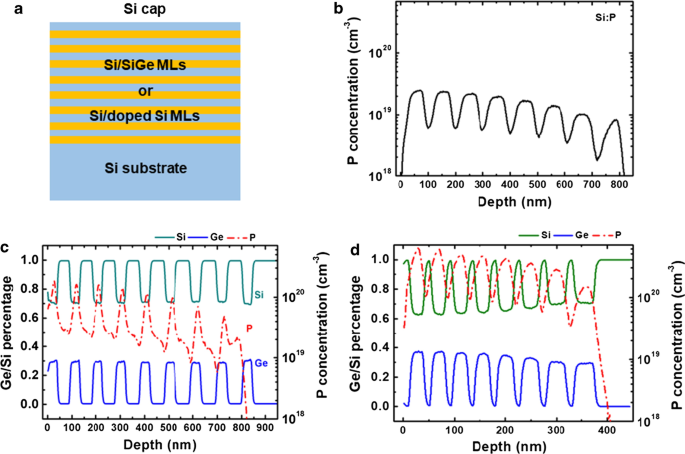
а Принципиальная схема МС Si / SiGe / Si, легированных фтором. б Концентрация легирования P нелегированных Si / МС Si, легированных P. Процент Ge / Si и концентрация P c нелегированный Si 0,72 Ge 0,28 / Si, легированный p, d нелегированный Si / Si, легированный P 0,72 Ge 0,28 MLs. Промывка и нелегированный разделительный слой не рассматривались
Влияние разделительных слоев
Между нижним легированным слоем Si и нелегированным слоем SiGe были вставлены спейсерные слои нелегированного Si для поглощения избытка атомов P. На рис. 2а показана схематическая диаграмма спроектированной структуры, а на рис. 2b – d показаны результаты профилей интегрированных кремниевых прокладок толщиной 3 нм (б), 5 нм (в) и 10 нм (г). Пики накопления P уменьшаются, в то время как процентное содержание Si / Ge и концентрация P в слоях Si остаются постоянными, как показано на рис. 2b – d. Уровень накопления снижен на 82%, с 4 × 10 19 . см −3 на рис. 2b - 7 × 10 18 см −3 на рис. 2г, когда толщина прокладки X b увеличился с 3 до 10 нм. Увеличение толщины нелегированных разделительных слоев Si увеличивает поглощение избыточных атомов P. На рис. 2d наклон P-профиля при Si 0,86 Ge 0,14 / Si составляет 15,9 нм / дек, а при Si / Si 0,86 Ge 0,14 интерфейс крутизна составляет 31,3 нм / дек. Между тем, слишком толстый разделительный слой Si не является подходящим решением, поскольку увеличивается сопротивление листа. Следовательно, для транзисторов необходимо найти компромисс между сопротивлением листа и неконтролируемым P-профилем. На рисунке 2 также показано влияние разделительного слоя между Si / Si 0,86 Ge 0,14 слои ( X b ) отличался от слоя между Si 0.86 Ge 0,14 / Si ( X t ). На рис. 2б, в показаны толщины прокладки между Si 0,86 Ge 0,14 / Si составляли 3 нм и 5 нм, в то время как на рис. 2d разделительный слой не вставлялся. Однако наклон P-профиля на уровне Si 0,86 Ge 0,14 / Si то же самое (около 15,9 нм / дек), хотя на рис. 2d верхний разделительный слой был удален, но никакого влияния на профиль легирования не наблюдалось. Из приведенных выше результатов, пик P был только при Si / Si 0,86 . Ge 0,14 граница раздела, что, возможно, было связано с пределом растворимости; избыток атомов P может образовывать димеры P – P на поверхности и встраиваться в покрывающий слой SiGe. Кроме того, происходит автоматическое легирование P во время роста SiGe после Si, легированного P. Поэтому ведется поиск методов, позволяющих удалить избыток атомов P или улучшить растворимость Si.
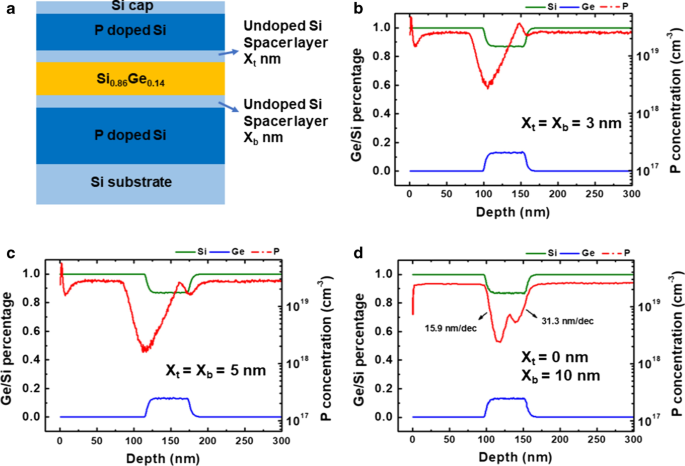
а Схема экспериментальных образцов с разными нелегированными дистанционными слоями. И профили Ge, Si и P для Si / Si, легированного P 0,86 Ge 0,14 / МО Si, легированный P, с нелегированными разделительными слоями Si из b 3 нм, в обоих интерфейсах, c 5 нм, в обоих интерфейсах, d 10 нм, только на одном интерфейсе с Si 0,86 Ge 0,14
Воздействие продувки водородом на границе раздела Si / SiGe / Si ML
В этом разделе разделительный слой Si был зафиксирован на длине 5 нм, и была введена продувка водородом, чтобы удалить избыток атомов P после роста Si, легированного P. Из рис. 3c, d видно, что увеличение потока водорода с 20 до 60 sccm и времени продувки с 2 до 10 минут не оказывает очевидного влияния на P-пик. Концентрация легирования в Si составляет 3 × 10 19 . см −3 , который аналогичен описанному в разделе «Влияние промежуточных слоев». Пиковая концентрация P на границе раздела такая же, как и концентрация в Si на рис. 3d. Толщина слоя одинакова при разных условиях продувки. Атомы P не могут быть очищены водородом; это можно объяснить образованием устойчивых комплексов P на поверхности. Было бы полезно изменить такие параметры, как температура, давление, время продувки [24, 40], но слишком долгое время продувки не подходит из-за затрат времени, а высокая температура (> 950 ° C) вызывает взаимную диффузию Si-Ge [41] .
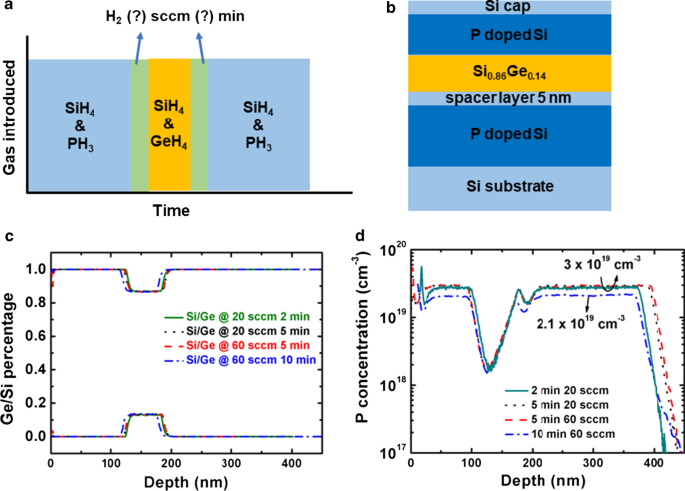
Принципиальные схемы а стратегия допинга H 2 условия продувки и b экспериментальная структура МС Si / SiGe / Si. c Профиль Ge / Si и d Концентрация P в Si / Si, легированном P 0,86 Ge 0,14 / ML Si, легированные p
Влияние химии роста на P-включение
В этих экспериментах прекурсор Si, SiH 4 , был заменен на SiH 2 Cl 2 (DCS). В этих образцах параметры роста были такими же, как и раньше, и структуры содержат спейсерный слой Si толщиной 5 нм, а время продувки составляет 5 мин при потоке 60 см3 / мин. Идея состоит в том, чтобы исследовать, может ли химия на основе Cl удалить избыточные атомы P с поверхности Si и могут ли происходить реакции P-Cl, Si-Cl или Ge-Cl [42]. Из рис. 4 пиковая концентрация P уменьшается в 2 раза (с 2,6 × 10 19 см −3 до 1,3 × 10 19 см −3 ), а концентрация P в слоях Si составляет 2,6 × 10 19 см −3 . Расчетное содержание Ge составляет 30%, что выше, чем у SiGe с SiH 4 . . Более высокое содержание Ge показывает, что Cl предпочтительно удаляет атомы Si в поверхностных реакциях. Этот результат также можно объяснить различным соотношением газового потока и концентрации Ge с SiH 4 и SiH 2 Cl 2 газообразные прекурсоры [32, 43]. Другое объяснение заключалось в том, что атомы Ge увеличивают десорбцию водорода, а затем увеличивают количество свободных центров зародышеобразования [44]. Наклон концентрации фосфора Si 0,7 Ge 0,3 / Si составляла 13,2 нм / дек, что было немного резче, чем Si 0,86 . Ge 0,14 / Si (15,9 нм / дек). Наклон P-профиля при Si / Si 0,7 Ge 0,3 интерфейс составлял 20 нм / дек. Следовательно, добавляя больше HCl или увеличивая газовое соотношение SiH 2 Cl 2 и GeH 4 сегрегированные атомы P на легированной поверхности Si могут быть травлены HCl с образованием димеров P-Cl, и пиковая концентрация P на Si / SiGe может быть ниже [38, 45].
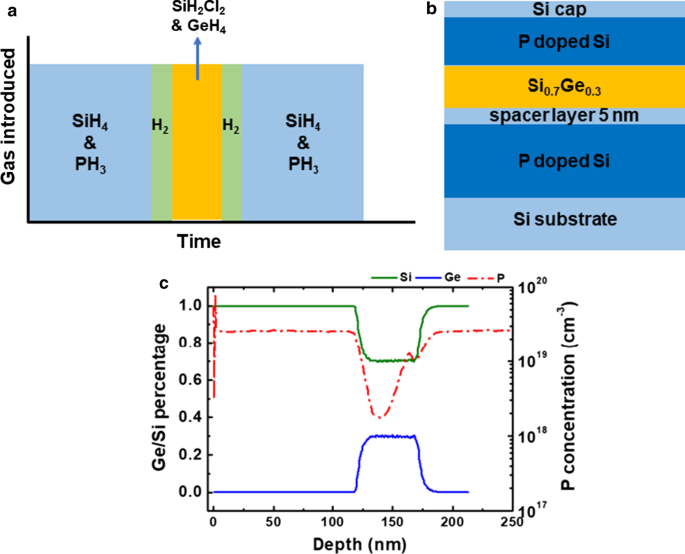
Принципиальные схемы а допинговая стратегия изменения химического состава роста, b экспериментальная структура МС Si / SiGe / Si. Слой SiGe был выращен с помощью DCS. Время продувки составляло 5 мин при расходе 60 sccm после легированного Si. Промежуточный слой из нелегированного Si составлял 5 нм между нижним легированным Si и нелегированным SiGe. c Профиль Ge / Si и концентрация фосфора в Si / Si, легированном фосфором 0,7 Ge 0,3 / ML Si, легированные p
Влияние содержимого Ge на P-профиль
Как мы обсуждали ранее, включение P в SiGe было значительно выше, чем в Si. Следовательно, это может вызвать идею добавления нескольких процентов Ge (7%) в прокладки Si (5 нм), которые могут улучшить включение P в Si. Здесь стоит упомянуть, что наша цель состоит не в том, чтобы существенно изменить характер кремния, легированного P, а в том, чтобы препятствовать сегрегации P в Si. В этих образцах давление в камере снижалось до 10 Торр при наращивании дистанционных слоев. При этом условии важны скорость роста, зависящая от легирования, и процентное содержание Ge. Из рис. 5b верхний и нижний слои имели толщину 110 нм Si 0,93 . Ge 0,07 с концентрацией фосфора 1 × 10 20 см −3 , средний слой был 40 нм Si 0,78 Ge 0,22 с концентрацией фосфора 3,5 × 10 19 см −3 . Наклон кривой концентрации P для кремния, легированного P 0,93 Ge 0,07 /Si0,78 Ge 0,22 составляла около 33 нм / дек. Наклон не был резким, потому что разница в процентном содержании Ge между двумя слоями была недостаточно большой. На рис. 5г три слоя кремния, легированного фосфором 0,93 Ge 0,07 /Si0,78 Ge 0,22 / Si, легированный p 0,93 Ge 0,07 МС была выращена для проверки однородности легирования, ее структурная схема показана на рис. 5в. Видно, что снизу вверх по слоям концентрация P снижалась, что можно объяснить эффектом памяти P. Остаточные атомы P в камере или диффузные атомы P накапливаются на поверхности пленки и блокируют свободные активные центры на ней. поверхность [38, 39]. Хотя P-пик был устранен, сегрегация между Si 0,78 Ge 0,22 и Si 0.93 Ge 0,07 все еще было серьезно.
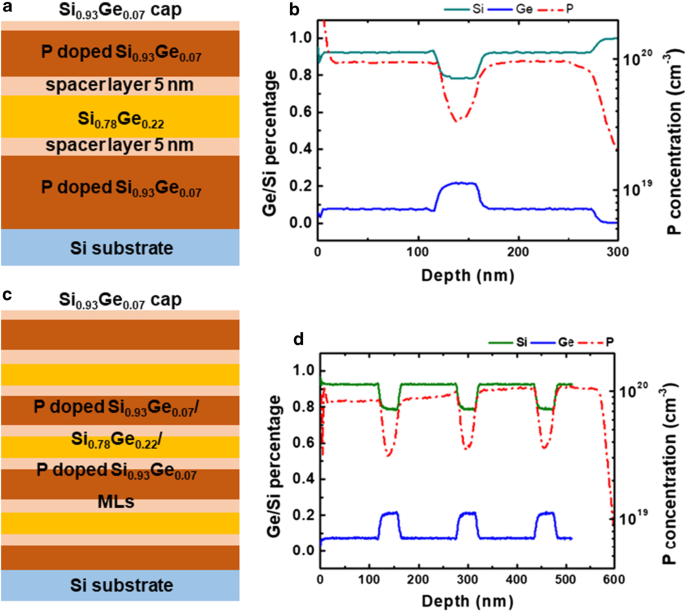
а Принципиальная схема, b Профиль Ge / Si и P в одном слое Si, легированного P 0,93 Ge 0,07 /Si0,78 Ge 0,22 / Si, легированный p 0,93 Ge 0,07 ML. c Принципиальная схема, d Профиль Ge / Si и P в трех слоях кремния, легированного P 0,93 Ge 0,07 /Si0,78 Ge 0,22 / Si, легированный p 0,93 Ge 0,07 ML
Характеристики селективного травления Si / SiGe / Si ML
Когда структура ML успешно выращена (с использованием вышеуказанных стратегий роста), ННК сформированы путем вертикального травления с использованием SiO 2 / SiN как маска. После этого слой SiGe необходимо избирательно протравить до Si в боковом направлении, чтобы сформировать канальный слой заданной ширины. В этих экспериментах были выбраны два типа ML-структур:Si / SiGe / Si, легированный P (образец 1, рис. 2c) и Si 0,93 , легированный P. Ge 0,07 /Si0,78 Ge 0,22 / Si, легированный p 0,93 Ge 0,07 (образец-2, на рис. 5б). Этот выбор сделан в соответствии с приведенными выше обсуждениями, в которых распространение P было (частично) подавлено, а также рассмотрены перспективы применения устройства.
Травление в вертикальном направлении производилось сухим травлением, а для бокового - селективным сухим или влажным травлением. Профили травления образца №1 показаны на рис. 6а, б. И изображение ПЭМ и отображение EDS на рис. 6a показаны на рис. 7. В этих экспериментах жесткая маска представляет собой оксид / нитрид. На рис. 6а показано после 11,5 с сухого травления CF 4 / O 2 /Он. Селективность травления Si 0,86 Ge 0,14 Si, легированный P, составляет 5,8. На рисунке 6b показано, что после 20 мин влажного травления HF (6%) / H 2 О 2 (30%) / CH 3 COOH (99,8%). Влажное травление удалило твердую маску (SiO 2 / SiN), в результате чего и защитный слой Si протравился на ~ 10 нм. Как обсуждалось в разделе «Влияние разделительных слоев», на Si / Si, легированном P 0,86 , наблюдается скопление P. Ge 0,14 интерфейс. Мокрое травление чувствительно к уровню легирования; поэтому первый интерфейс протравился быстрее. В результате передняя поверхность травления не является вертикальной, а имеет грань или угол. Средняя избирательность была менее 4,2. Сравнивая два метода травления, сухое травление чувствительно к процентному содержанию Ge с лучшей селективностью SiGe, в то время как влажное травление чувствительно к концентрации легирующей примеси. Травления образца-2 также исследованы на рис. 6в, г. Подобные явления наблюдались и в этом образце, но глубина селективного травления SiGe была больше (рис. 6а, в) из-за более высокого содержания Ge. При сухом травлении селективность Si 0,78 Ge 0,22 и кремний, легированный P 0,93 Ge 0,07 составляла 6,3, тогда как при влажном травлении средняя селективность была менее 2,5. Поэтому сухое травление было лучшим выбором с точки зрения однородности и селективности травления.
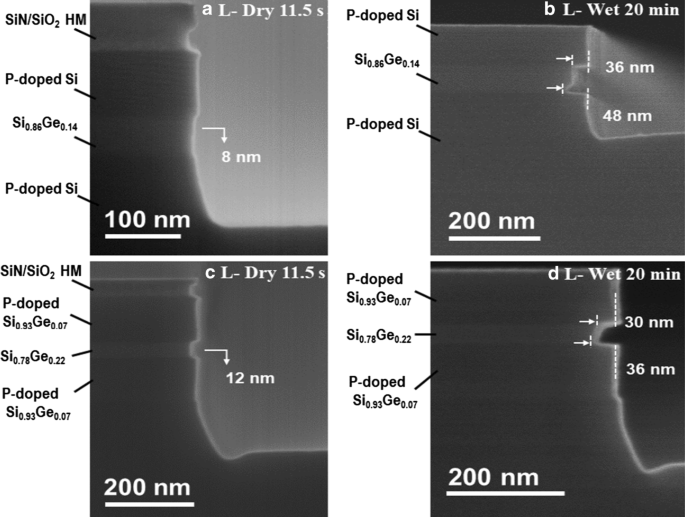
СЭМ-изображения Si / Si, легированного P 0,86 Ge 0,14 / P-легированный Si на фиг. 2c с a 11,5 сек. Сухое травление, b 20 мин мокрого травления, Si 0,93 , легированный P Ge 0,07 /Si0,78 Ge 0,22 / Si, легированный p 0,93 Ge 0,07 ML с c 11,5 сек. Сухое травление, d 20 мин мокрого травления. Сухое травление было CF 4 :O 2 :He =4:1:5, а влажное травление было HF (6%):H 2 О 2 (30%):CH 3 COOH (99,8%) =1:2:4
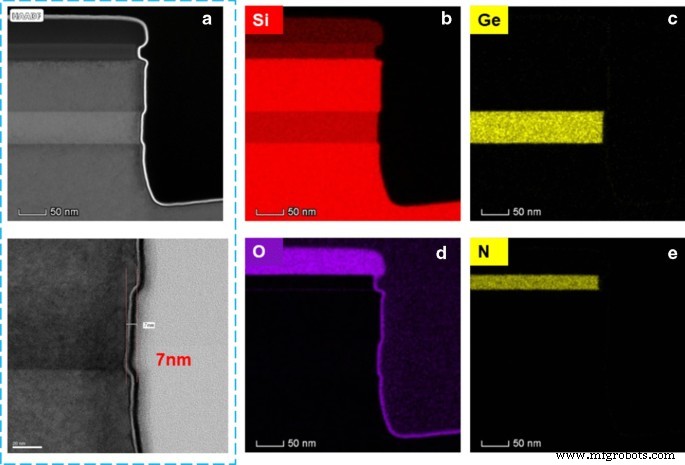
а Изображения TEM, b - е EDS-отображение Si / Si, легированного фтором 0,86 Ge 0,14 / P-легированный Si на рис. 6а с сухим травлением 11,5 с. Элементы в b это Si, в c это Ge, через d равно O, а в e это N
Дальнейшие анализы были выполнены для изучения деформации после этапов травления в образце-1 и образце-2. На рис. 8a – h показаны (004) кривые качания (КК) для этих образцов:в исходном состоянии, после вертикального травления и бокового травления SiGe с использованием влажного и сухого травления. В анализе RC уширение (полная ширина-полувысота или FWHM) является индикатором плотности дефектов, а положение пика SiGe по сравнению с Si определяет величину деформации в слое. Подчеркнем, что уширение пиков также может быть связано с малой толщиной слоя. Следовательно, будет трудно отличить от анализа RC вклад плотности дефектов, но мы можем сравнивать только FWHM в некоторых расширениях в этих анализах. В этих РЦ образец-1 (рис. 8a – d) имеет единственный слой SiGe; Между тем, образец-2 (рис. 8e – h) показывает два пика, представляющих 7% и 22% Ge. Для образцов, выращенных As, наблюдается интерференция рентгеновского луча, вызывающая появление полос толщины слоя. Появление этих полос показывает качественный интерфейс SiGe / Si. В RC образца 1 и 2 пик Ge смещен в сторону пика подложки Si, что указывает на релаксацию деформации. Дальнейшего сдвига пика Ge после бокового сухого травления SiGe не обнаружено. Это многообещающий результат для производительности транзистора, поскольку подвижность несущих в области канала зависит от напряжения. Между тем, для SiGe, подвергнутого влажному травлению, напряжение было более ослабленным, и наблюдался больший сдвиг в сторону пика подложки. Это показывает, что влажное травление не подходит для бокового травления SiGe, формирующего канальный слой.
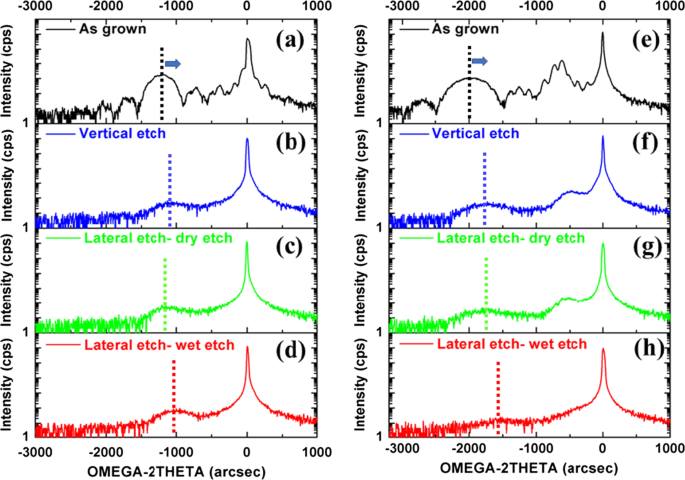
Кривая качания HRXRD вокруг (004) отражения образца-1, Si / Si, легированный P 0,86 Ge 0,14 / МО Si, легированный P, с разделительным слоем 5 нм в a - г , и образец-2, Si, легированный фтором 0.93 Ge 0,07 /Si0,78 Ge 0,22 / Si, легированный p 0,93 Ge 0,07 ML в e - ч . Оба образца имеют четыре панели:после выращивания, после вертикального травления, бокового влажного травления SiGe HF (6%) / H 2 О 2 (30%) / CH 3 COOH (99,8%) 20 мин и боковое сухое травление CF 4 / O 2 / He 11,5 с
Дальнейшие рентгеновские анализы были выполнены, чтобы узнать больше о плотности дефектов в образцах на рис. 9a – h. HRRLM, основанные на двумерных измерениях, были выполнены здесь, как показано на рис. 9a – h. Индикатором плотности дефектов в ДРЛМ является уширение слоя SiGe вдоль ω-направления (ω - угол падающего луча). Положение пиков Si и SiGe обеспечивает компоненты деформации параллельно и перпендикулярно направлению роста. В образце 1 и образце 2 только что выращенные слои SiGe показывают незначительное ω-уширение, и слой выровнен по Si, показывая полностью деформированные слои SiGe (см. Рис. 9a, e). На рис. 9b показан образец после вертикального травления, пик SiGe сместился в сторону подложки Si аналогичным образом в результатах RC на рис. 8b, что указывает на релаксацию деформации. Но удивительно, что боковой образец сухого травления (рис. 9c) показывает явное ω-уширение пика SiGe вместе со сдвигом в обратном пространстве, которое находится в направлении от совмещения с пиком Si. Однако образец влажного травления (на рис. 9d) полностью выровнен по деформации и имеет более низкую интенсивность слоя, чем образец после сухого травления (на рис. 9c). В этом случае ожидается, что генерируемые дефекты имеют различное происхождение в этих образцах, поскольку характер процесса травления различен. Образец-2 содержит два слоя SiGe; Si 0.93 Ge 0,07 пик сохраняется после травления как в вертикальном, так и в боковом направлениях, тогда как Si 0,78 Ge 0,22 исчезает после вертикального травления, показывая полную релаксацию деформации (рис. 8f – h). Плохая стабильность процесса образца 2 может быть связана с легированием фосфором, которое способствует образованию дислокаций несоответствия.

HRRLM Si / Si, легированного фтором 0,86 Ge 0,14 / МС Si, легированный P, с разделительным слоем 5 нм (образец-1) в a - г , и кремний, легированный фтором 0.93 Ge 0,07 /Si0,78 Ge 0,22 / Si, легированный p 0,93 Ge 0,07 ML (Образец-2) в e - ч . На обоих картах есть четыре панели:после выращивания, после вертикального травления, бокового влажного травления HF (6%) / H 2 О 2 (30%) / CH 3 COOH (99,8%) 20 мин и боковое сухое травление CF 4 / O 2 / He 11,5 с
Выводы
В данной работе исследовалась эпитаксия легированных P Si / SiGe / P-легированных Si ML, а также травление этих ML в качестве исходных структур для vGAAFET. Во-первых, было изучено внедрение P в МС Si / SiGe / Si. Были предложены различные стратегии для эпитаксии и структуры ML для устранения P-сегрегированного пика на границе гетероструктуры Si / SiGe. Согласно экспериментам, добавление нелегированного разделительного слоя могло уменьшить пик P. Продувка водородом для очистки избыточных атомов P не очень помогала, и стабильные димеры P-P не могли быть полностью удалены. Подставляем SiH 4 с SiH 2 Cl 2 в качестве прекурсора Si для введения химического состава Cl во время роста заметно уменьшал сегрегированный пик P из-за реакций на активной поверхности Cl. Воздействие Si 0.93 Ge 0,07 Спейсерные слои после кремния, легированного фосфором, также были исследованы. Результаты показали, что пик P на границе раздела SiGe исчез, а включение P в эти слои улучшилось на порядок. Во второй части исследования было выполнено вертикальное травление Si / SiGe / Si ML для формирования ННК, а позже в этих ННК SiGe подвергался селективному влажному или сухому травлению. Влажное травление было чувствительно к концентрации примеси; Между тем сухое травление было чувствительно к содержанию Ge. Сухое травление было более подходящим для структур n-типа с однородным профилем травления и более высокой селективностью. Для Si / Si, легированного P 0,86 Ge 0,14 / P-легированные Si ML селективность составила 5,8 для сухого травления и 4,2 для влажного травления. Селективность кремния, легированного фтором 0.93 Ge 0,07 /Si0,78 Ge 0,22 / Si, легированный p 0,93 Ge 0,07 MLs was 6.3 with dry etch and 2.5 with wet etch. The strain in SiGe was mostly preserved in Si/SiGe/Si after vertical and lateral etch; meanwhile, this strain in MLs with introduced Si0.93 Ge0.07 spacer layer had poor stability after etch process.
Доступность данных и материалов
The authors declare that the data supporting the findings of this study are available within the article.
Сокращения
- vGAAFET:
-
Vertical gate-all-around field-effect transistors
- ML:
-
Multilayer
- CMOS:
-
Дополнительный металлооксидный полупроводник
- MBE:
-
Молекулярно-лучевая эпитаксия
- RPCVD:
-
Reduced pressure chemical vapor deposition
- RTCVD:
-
Rapid thermal chemical vapor deposition
- S/D:
-
Source/drain
- HRTEM:
-
Просвечивающая электронная микроскопия высокого разрешения
- HRXRD:
-
Дифракция рентгеновских лучей высокого разрешения
- HRRLM:
-
High-resolution reciprocal lattice map
- SEM:
-
Сканирующая электронная микроскопия
- SIMS:
-
Secondary ion mass spectroscopy
- RC:
-
Rocking curve
- FWHM:
-
Full-width-half-maximum
- HM:
-
Hardmask
Наноматериалы
- Повышение производительности приложений для пользователей и клиентов в CyrusOne
- Воздушные прокладки для 10-нм чипов
- Прямое выращивание перьевидных структур ZnO с помощью простой техники решения для фото-детектирующего прилож…
- Оценка структур графен / WO3 и графен / CeO x как электродов для применения в суперконденсаторах
- Возобновляемый флуоресцентный зонд BHN-Fe3O4 @ SiO2 Гибридная наноструктура для Fe3 + и ее применение в биоимиджинге
- Выбор типа роботизированного сварочного процесса и оборудования для вашего приложения
- Деловые круги готовятся к большим техническим изменениям и вызовам 2019 года
- Вертикальный токарный станок для литья, ковки и токарной обработки
- Вертикальный токарный станок для литья, ковки и токарной обработки(2)
- VMC Machinery для производства и эффективности



