Высокопроизводительный детектор длинноволнового инфракрасного излучения на сверхрешетке из P + –π – M – N + InAs / GaSb с предварительной обработкой анодной вулканизацией
Аннотация
Сверхрешеточный инфракрасный детектор InAs / GaSb был разработан с огромными усилиями. Однако его характеристики, особенно длинноволновые инфракрасные детекторы (LWIR), по-прежнему ограничены электрическими характеристиками и оптической квантовой эффективностью (QE). Принуждение активной области к p -тип за счет правильного легирования может значительно улучшить QE, а метод стробирования может быть использован для значительного улучшения электрических характеристик. Однако напряжение смещения насыщения слишком велико. Уменьшение напряжения смещения насыщения имеет широкие перспективы для будущего применения устройств контроля напряжения затвора. В этой статье мы сообщаем, что закрытый P + - π –M – N + Детекторы длинноволнового инфракрасного излучения на сверхрешетке InAs / GaSb демонстрируют различные уровни легирования π-области, которые имеют пониженное минимальное смещение насыщения при -10 В с 200-нм SiO 2 слой после простой и эффективной предварительной обработки анодной вулканизацией. Напряжение смещения затвора насыщения намного ниже, чем -40 В, которое сообщалось с такой же толщиной 200-нм SiO 2 пассивирующий слой и аналогичная структура. Оптические и электрические характеристики показывают, что электрические и оптические характеристики устройства могут быть ухудшены из-за чрезмерной концентрации легирования. При 77 K длина волны отсечки 50% устройства составляет около 8 мкм, длина волны отсечки 100% составляет 10 мкм, максимальная квантовая эффективность составляет 62,4%, максимальная чувствительность составляет 2,26 A / Вт при 5 мкм, а максимальная РА устройства 1259,4 Ом · см 2 . Кроме того, удельная обнаруживающая способность детектора с примесью Be 780 ° C без электрода затвора имеет пик 5,6 × 10 10 . см Гц 1/2 / Вт при 5 мкм при обратном напряжении смещения 70 мВ, что более чем в три раза больше, чем у детектора, легированного Be 820 ° C. Более того, пиковая удельная обнаруживающая способность может быть дополнительно увеличена до 1,3 × 10 11 см Гц 1/2 / Вт на расстоянии 5 мкм с резервным напряжением смещения 10 мВ и смещением –10 В на электроде затвора.
Введение
Сверхрешетки с напряженным слоем II типа (T2SL) все чаще становятся объектом современных исследований после того, как Sai-Halasz et al. [1] предложил свою концепцию. Высокопроизводительные инфракрасные детекторы могут быть созданы путем тщательного проектирования полосовой структуры и деформации T2SL [2]. Сверхрешетка InAs / GaSb, хорошо изученный член T2SL, представляет собой превосходную материальную систему, открывающую широкие перспективы для использования в инфракрасном детекторе [3]. Сверхрешеточный инфракрасный детектор InAs / GaSb был разработан с огромными усилиями. Однако его характеристики, особенно длинноволновые инфракрасные детекторы (LWIR), по-прежнему ограничены электрическими характеристиками и оптической квантовой эффективностью (QE) [4]. Соответствующая температура окружающей среды (на земле) детектора LWIR составляет около 300 K, что соответствует максимальной длине волны 9,6 мкм (центр атмосферного окна пропускания LWIR) и имеет широкий спектр применений [5]. Он широко используется в различных областях, таких как обнаружение газа, ночное видение, инфракрасное раннее предупреждение, инфракрасное дистанционное зондирование и инфракрасное наведение, не только для военного использования, но и для жизни людей. Производство высокопроизводительных длинноволновых инфракрасных детекторов является чрезвычайно важным и сложным делом.
Конструктивная конструкция и технологическая подготовка детектора существенно влияют на характеристики LWIR-детектора. Увеличение толщины активной области казалось наиболее прямым и эффективным способом улучшения QE. Однако вместе с увеличением толщины вводится больше центров ловушек, что приводит к снижению электрических характеристик детектора. В детекторах LWIR и очень длинноволновых инфракрасных лучей (VLWIR) слой InAs имеет тенденцию быть толще, чем слой GaSb. Таким образом, материал n -типа (неосновные носители - дырки). Принуждение активной области к p -тип за счет правильного легирования может значительно увеличить QE без каких-либо изменений в размере области устройства [6]. Однако не чем выше концентрация легирования, тем больше улучшаются характеристики устройства. В частности, электрические [7] и оптические характеристики устройства могут быть ухудшены из-за чрезмерной концентрации легирования.
Помимо изменения концентрации легирования в π В последнее время метод стробирования был применен в детекторах средней длины волны (MWIR) и LWIR [8] для улучшения характеристик устройства. Однако для этого требуется очень высокое напряжение смещения затвора. Смещение затвора может быть выражено формулой. (1).
$$ \ sigma =\ varepsilon \ varepsilon_ {0} В / д, $$ (1)где \ (\ varepsilon \) обозначает относительную диэлектрическую проницаемость диэлектрического слоя, \ (\ varepsilon_ {0} \) обозначает диэлектрическую проницаемость вакуума, V относится к напряжению смещения затвора насыщения, d - толщина диэлектрического слоя, а σ обозначает плотность заряда на границе раздела. Смещение ворот было ослаблено на основе формулы с большим усилием; средства использования диэлектрика high-k, такого как Y 2 О 3 [9] для пассивирования или уменьшения толщины слоя [10] является эффективным. Однако исследований по снижению плотности заряда мало. В этой статье сначала выполняется анодирование, чтобы значительно уменьшить смещение насыщения. Смесь NaS 2 · 5H 2 О и этиленгликоль используется в качестве вулканизирующего раствора. Во время процесса анодного отверждения комбинация атомов серы и оборванных связей на поверхности устройства закрывает проводящие каналы на поверхности устройства [11], уменьшает поверхностную рекомбинацию устройства и ослабляет поверхностную плотность заряда устройство. Затем на поверхности устройства получается слой плотной и однородной элементарной серы. Затем поверхность слоя элементарной серы покрывается слоем 200 нм SiO 2 . Электрод затвора помещается на SiO 2 . слой. Напряжение смещения затвора насыщения уменьшается по мере уменьшения плотности заряда на границе раздела.
В данном исследовании LWIR P + , предварительно обработанный анодной вулканизацией - π –M – N + детекторы изготавливаются при низком насыщении напряжения смещения затвора на основе InAs / GaSb T2SL с различным легированием π регионы. Результаты показывают, что не чем выше концентрация легирования, тем больше улучшаются характеристики устройства. В частности, электрические и оптические характеристики устройства могут быть ухудшены из-за чрезмерной концентрации легирования. Кроме того, предварительная обработка анодной вулканизацией может значительно снизить смещение затвора при -10 В, что намного ниже, чем заявленное при той же толщине 200-нм SiO 2 слой пассивирования с напряжением около 40 В в аналогичной структуре.
Методы
Материалы и структура
Материалы производятся системой GEN 20 MBE с твердым источником на 2-дюймовом n подложки GaSb (001) типа. В данной работе высокопроизводительный детектор LWIR основан на P + - π –M – N + структура. Схема устройств, картины дифракции рентгеновских лучей высокого разрешения (HRXRD) и атомно-силовая микроскопия (АСМ) показаны на рис. 1 и 2. На рис. 1 показано, что структура состоит из P + толщиной 1300 нм. Буфер GaSb, за которым следует 8-ML InAs / 12-ML GaSb толщиной 500 нм (Be:примерно 1 × 10 18 см −3 ) P + область, 2000 нм слегка легированный фосфатом 12-ML InAs (Be:780 ° C 800 ° C 820 ° C) / 7-ML GaSb π область, 500 нм нелегированная 18-ML InAs / 3-ML GaSb / 5-ML AlSb / 3-ML GaSb M-область, 18-ML InAs / 3-ML GaSb / 5-ML AlSb толщиной 500 нм / 3-ML GaSb (Si:около 1 × 10 18 см −3 ) N + область и 30-нм N + Слой InAs Cap. А также показывает выравнивание полосы симуляции со структурой. Учитывая, что производительность P + - π –M – N + Детектор LWIR будет подвержен значительному влиянию легирования π области мы приготовили три образца с разными температурами легирования Be от 780 до 820 ° C.
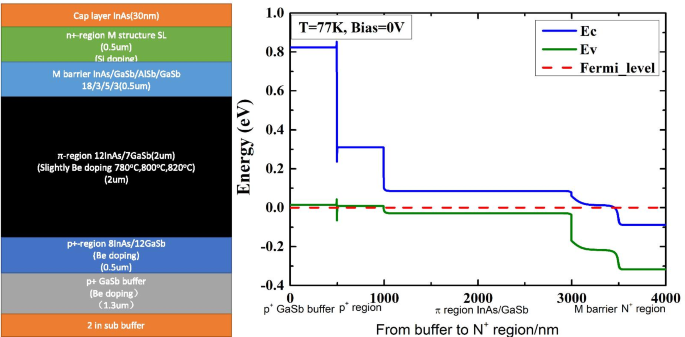
Эпитаксиальная структура и выравнивание полос материалов с различными уровнями легирования π-области

Кривые качания HRXRD для образцов с различными уровнями легирования π-области
Периоды сверхрешетки 59,3 Å, 58,4 Å и 89,5 Å для p -контакт, p -активная область и слой М-структуры с рассогласованиями решетки 60 угл. сек, 0 угл. сек и 0 угл. сек, соответственно, показаны на рис. 2. Полная ширина на полувысоте для SL в каждой области составляет 32 угл. угл. сек, 25 угл. сек и 12 угл. сек, что указывает на высокое качество материала на границах раздела.
На рисунке 3 показано, что атомные ступеньки появляются со среднеквадратичным значением шероховатости 1,87 Å на площади 10 × 10 мкм.
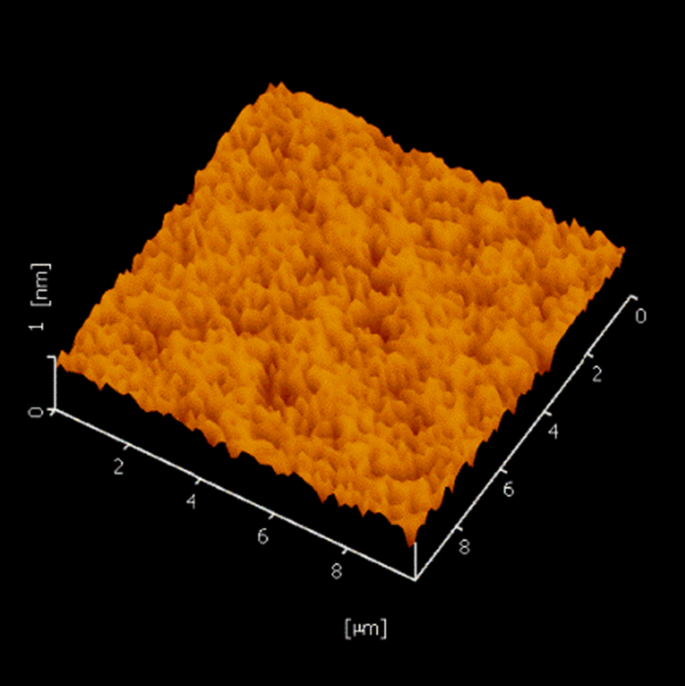
АСМ 10 × 10 мкм 2 площадь образца
Структура и изготовление устройства
Процесс аналогичен описанному в [12]. Сначала пластина покрывается SiO 2 как маска арк. Затем принимаются соответствующие стандартные этапы литографии. Затем мы открываем жесткую маску с помощью системы с индуктивно связанной плазмой (ICP). Затем меза получается с использованием системы с индуктивно связанной плазмой (ICP) с CH 4 / Cl 2 / Ar смесь. В частности, пластины вытравлены от верхнего слоя до P + контакт [12]. После этого оставшийся SiO 2 слой удаляется. Затем мы погружаем одну сторону пластины в смешанный раствор сульфида натрия и этиленгликоля, а затем подаем на пластину постоянный ток и устанавливаем пороговое напряжение. На поверхности пленки образуется слой атомов серы, и сопротивление изменится. Напряжение на пластине будет постепенно увеличиваться, пока не достигнет порогового значения, а затем вулканизация завершится. Затем слой элементарной серы покрывается слоем 200 нм SiO 2 . Кроме того, снова выполняется фотолитография, чтобы открыть окно через слой SiO 2 и элементарная сера в качестве участков контакта металла верхнего и нижнего металлических электродов. Кроме того, проводится еще одна фотолитография с двумя формами электродов; одна форма электрода предназначена для закрытого диода (GD), а другая - для закрытого диода (UGD). Ti (50 нм) / Pt (50 нм) / Au (300 нм) осаждается электронным лучом, наносимым на металлические электроды. Наконец, верхний, нижний и затворный электроды снимаются металлическим отрывом.
Рисунок 4 иллюстрирует структуру GD. Как мы знаем, угол наклона травления материала можно регулировать, изменяя мощность ICP, мощность RF, поток газа и давление в камере. В этом исследовании фактический угол наклона боковой стенки составляет от 80 до 85 °, чтобы упростить контакт отсадочного затвора с боковой стенкой. Электрод затвора размещен на боковой стенке SiO 2 слой.
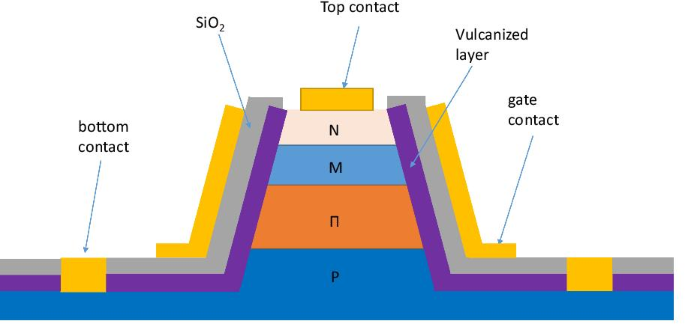
Структурная схема устройства GD
Рисунок 5 демонстрирует, что полудиоды размещаются в виде заземлителей в трех кристаллах (легирование Be при 780 ° C, 800 ° C и 820 ° C). Тогда можно получить как стробирующий диод (GD), так и незащищенный диод (UGD). В конечном итоге, образец A (780 ° C GD), образец B (780 ° C UGD), образец C (800 ° C GD), образец D (800 ° C UGD), образец E (820 ° C GD) и образец F. (820 ° C UGD) можно получить.

Изображение устройства под оптическим микроскопом
Результаты и обсуждение
В инфракрасных детекторах определенная обнаруживающая способность ( D *) обычно используется для характеристики характеристик детектора, которые рассчитываются по формуле. (2).
$$ D ^ {*} =\ frac {Ri} {{\ sqrt {2qJ + 4 \ frac {kT} {{RA}}}}} $$ (2)где q обозначает количество электронного заряда; К относится к постоянной Больцмана; Т - температура Кельвина; Ri относится к чувствительности инфракрасного детектора; Дж - плотность темнового тока прибора при определенном смещении; и RA относится к произведению значения сопротивления и площади кристалла. Дж и RA характеризуют электрические характеристики устройства. А Ri можно преобразовать в QE по формуле:
$$ QE =\ frac {hC} {{q \ lambda}} Ri $$ (3)где \ (h \) - постоянная Планка, \ ({} C \) - скорость света, q обозначает количество электронного заряда, \ ({} \ lambda \) - конкретную длину волны, а QE и Ri характеризуют оптические характеристики устройства. На рисунке 6 представлены оптические характеристики образцов с разными π уровни легирования области при 77 К. Все образцы имеют одинаковую длину волны отсечки 50%, равную 8 мкм, и длину волны отсечки 100%, равную 10 мкм при 77 К. Хотя QE и чувствительность устройства можно увеличить, изменив тип легирования на p -тип π области, не чем выше температура, тем выше QE и чувствительность. Однако QE и чувствительность значительно снижаются с увеличением концентрации легирования. Для сверхрешеток с напряженным слоем II типа (T2SL) температура легирования во время роста критична для концентрации легирования. Чем выше температура, тем выше концентрация легирования. QE 780 ° C достигает максимального значения 62,4%, что в 1,5 раза больше, чем QE 820 ° C. Это связано с тем, что с увеличением концентрации легирования вводится слишком много примесей, что приводит к уменьшению времени жизни избыточных носителей / длины диффузии и снижению QE и чувствительности [6]. Они, кроме того, вызывают спектроскопическое красное смещение на рис. 6а. На рисунках 6a и b показано, что 780 ° C является наилучшей температурой легирования материалов для оптических характеристик с максимальной чувствительностью 2,26 A / Вт при 5 мкм и пиком QE 62,4%.
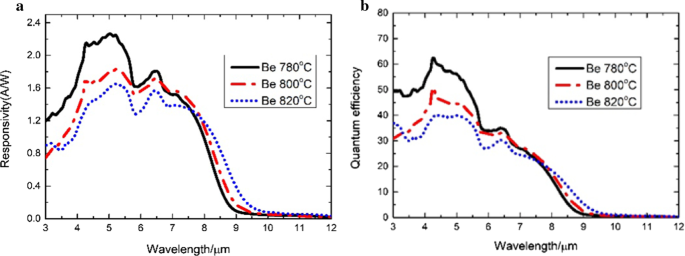
Оптические характеристики образцов с разным уровнем легирования π-области при 77 К
На рисунке 7 показаны электрические характеристики образцов УГД с разными значениями π уровни легирования области при 77 К. Электрические характеристики устройства сильно зависят от различных значений π концентрации легирования в области [7]. С увеличением уровня легирования π-области произведение значения сопротивления и площади кристалла (RA) при определенном смещении становится меньше, и плотность темнового тока соответственно становится больше. Подобно ссылке [6], RA достигает своего максимума при почти 0 В с мягким пробоем при увеличении обратного смещения, предполагая, что устройство имеет режим туннельного темнового тока. Мы достигаем максимума прямого восхождения 1259,4 Ом · см 2 . Be, легированный 780 ° C при -200 мВ, что почти в 40 раз больше, чем Be, легированный 820 ° C. Рисунок 7b показывает, что плотность темнового тока аналогична при отрицательном смещении в диапазоне от -0,1 до 0 В, а плотность темнового тока для Be, легированного 780 ° C, немного меньше по сравнению с другими. Темновой ток 4,9 × 10 −3 А / см 2 для прибора с Be, легированным 780 ° C при -70 мВ.
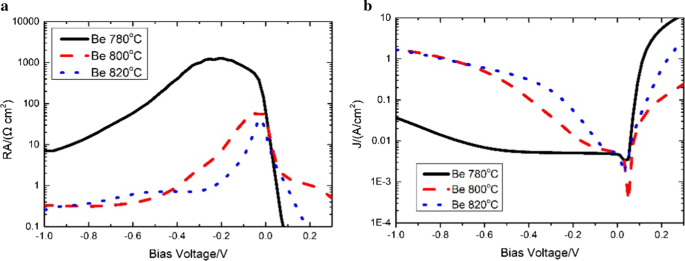
Электрические характеристики образцов УГД с разными π уровень легирования в области 77 К
Соответствующий D * можно рассчитать, взяв конкретное значение Ri, J , и значения RA при разных напряжениях смещения при 77 К. На рисунке 8 показана обнаружительная способность образцов УГД с разными π регионы. При -30 мВ пиковая обнаруживающая способность составляет 5,6 × 10 10 . см Гц 1/2 / Вт при 5 мкм с Be, легированным при 780 ° C, а это 3,8 × 10 10 см Гц 1/2 / Вт с Be, легированным 820 ° C. Пиковая обнаруживающая способность Be, легированного 780 ° C, в 1,5 раза больше, чем Be, легированного 820 ° C. Следовательно, соответствующая концентрация легирования чрезвычайно важна. Однако слишком высокая концентрация легирования ухудшит характеристики устройства.

Корреляция между удельной обнаружительной способностью при 77 K образцов УГД с π уровни легирования области и длина волны
На рисунке 9 представлены электрические характеристики образца GD с Be, легированным 760 ° C при 77 К. В отличие от обычных устройств управления напряжением на затворе, в данном исследовании сначала выполняется предварительная обработка анодной вулканизацией, чтобы значительно снизить напряжение смещения затвора насыщения. Кроме того, смесь NaS 2 · 5H 2 О и этиленгликоль используется в качестве вулканизирующего раствора. Метод пассивации анодной вулканизации применяется для образования слоя плотной и однородной элементарной серы на поверхности устройства. Во время электрохимической реакции атомы серы объединяются с оборванными связями на поверхности устройства, способствуя закрытию электронных каналов, генерируемых поверхностными оборванными связями, и изолирует механизм поверхностной электронно-дырочной рекомбинации устройства [11]. Затем поверхность слоя элементарной серы покрывается защитным слоем 200 нм SiO 2 . , а электрод затвора размещен на боковой стенке SiO 2 слой. Как сообщалось в предыдущем исследовании, корреляция между смещением насыщения и толщиной диэлектрического слоя устройства почти линейна. На рисунке 9 показано, что смещение насыщения устройства может быть уменьшено примерно до -10 В за счет простой и эффективной предварительной обработки вулканизацией; это приведенное значение в других исследованиях составляет около 40 В и в четыре раза больше в устройствах аналогичной конструкции с такой же толщиной SiO 2 слой [10]. Кроме того, RA достигает максимального значения 25 Ом · см 2 . при напряжении около 0 В. Тенденция к снижению значительно замедлилась, когда мы применили отрицательное напряжение смещения около -10 В. Когда мы прикладываем напряжение смещения -10 В к электроду затвора, RA составляет 10 Ом см 2 при - 0,3 В, что в 40 раз больше, чем при отсутствии напряжения смещения. Кроме того, он почти на два порядка ниже, чем при напряжении без смещения при -0,6 В. Рисунок 9b показывает, что темновой ток достигает минимального значения 2 × 10 –4 . А / см 2 около 0 В, и оно уменьшается на порядок при -0,3 В. Как мы знаем, ВАХ не изменится при смещении затвора при 0 В, когда напряжение смещения положительное. Кроме того, РА прибора значительно увеличивается при увеличении напряжения смещения от 0 до - 10 В; при этом темновой ток устройства соответственно уменьшается. При изменении напряжения смещения от -10 до -20 В RA устройства немного уменьшается, а темновой ток устройства соответственно увеличивается. При высоком резервном смещении (например, -1 В) между верхним и нижним электродами темновой ток уменьшается со смещением затвора, а затем немного увеличивается до значения -12 В. Это в основном для характеристики смещения затвора. Дальнейшее введение показано на рис. 10. Для низкого обратного смещения (например, -0,1 В) темновой ток кажется возрастающим по мере увеличения смещения затвора, что полностью отличается от такового при -1 В. Для другого обратного смещения мы подозреваем, что основной механизм утечки другой. Для низкого запаса смещения высокое смещение затвора оказывает отрицательное влияние, поскольку влияет на поверхностное рассеяние электронов и горячих электронов. А при высоком обратном смещении утечка уменьшается, так как ток утечки на ее поверхности уменьшается. Так что это другое.

Электрические характеристики образцов GD с 780 ° C Be, легированным при различных напряжениях смещения затвора и напряжения смещения на верхнем и нижнем электродах
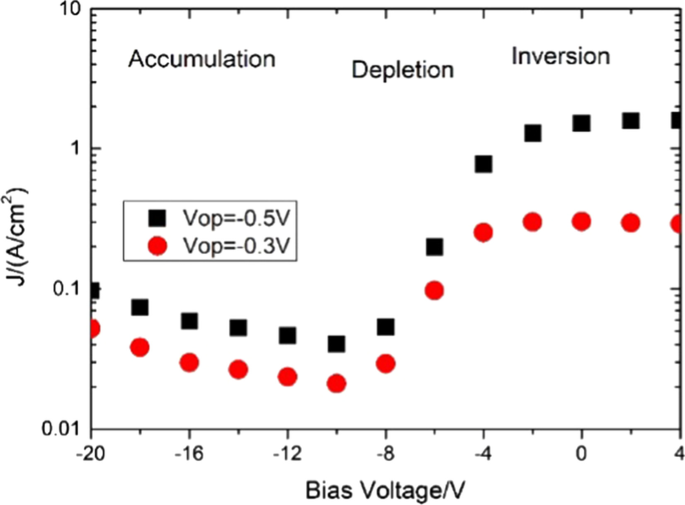
Корреляция между плотностью обратного темнового тока и смещением затвора образца GD с 780 ° C Be, легированным при различных рабочих смещениях диода
Как показано на рис. 10, при высоком резервном смещении (например, -1 В) между верхним и нижним электродами темновой ток уменьшается с смещением затвора, а затем немного увеличивается до значения -12 В; мы можем видеть, что устройство существует в три этапа с изменением напряжения смещения на 77 К [10]. Согласно ссылке [13], P + и N + регионы для P + –Π – M – N + структурные устройства сильно легированы, а область M представляет собой область большой полосы с большей эффективной массой по сравнению с π и P + область; следовательно, смещение затвора имеет гораздо большее влияние на π регион по сравнению с другими [13]. Используя аналогичный метод с Ченом [10], анализируются три стадии процесса высокого отрицательного напряжения смещения (от -20 до -10 В), приложенного к электроду затвора; результаты показывают, что боковая стенка мезы находится в плоском состоянии или накапливается [8], а плотность темнового тока немного увеличивается с увеличением смещения затвора из-за границы раздела вулканизации. Подозреваемый для вулканизации интерфейса слегка неоднородность плотности, где-то недостаточная плотность немного нарушается. При приложении отрицательного напряжения смещения (от –10 до –2 В) боковая меза истощается, и темновой ток плавно увеличивается. Кроме того, ширина обеднения, индуцированного полем, достигает своего максимума и образование инверсионного слоя происходит при приложении напряжения смещения при -2 В к положительному смещению затвора; таким образом, плотность темнового тока остается постоянной. Согласно ссылке [14], объясняется, почему ток поверхностной генерации-рекомбинации (G – R) при -0,5 В больше, чем при -0,3 В.
На рисунке 11 показано, что при смещении затвора на -10 В D * для образца GD с примесью 780 ° C Be достигает максимальной обнаружительной способности 1,3 × 10 11 см Гц 1/2 / Вт при 5 мкм, что более чем в два раза больше, чем при отсутствии напряжения смещения при 780 ° C, легированном Be, и более чем в три раза выше, чем при отсутствии напряжения смещения при 820 ° C Be, легированном при 77 К. Это указывает на то, что применение соответствующего отрицательного смещения может значительно повысить производительность устройства.
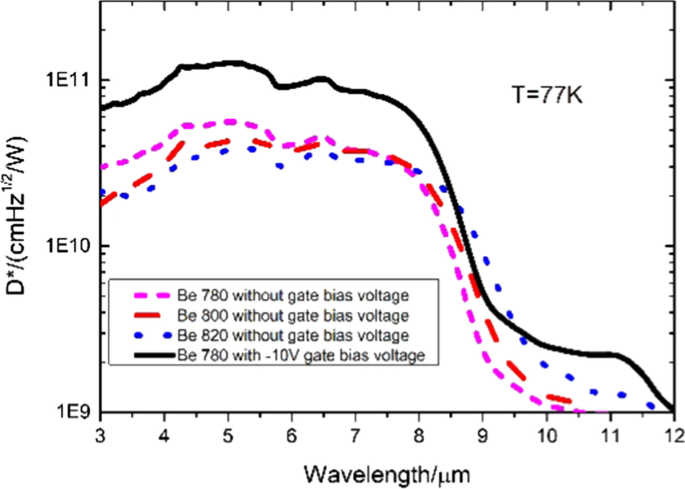
Корреляция между обнаруживающей способностью образца GD с легированием Be при 780 ° C и образцов UGD с различными уровнями легирования π-области и длиной волны при 77 K
Выводы
2017 Северо-Западный университет сообщил о длинноволновых инфракрасных (LWIR) фотодетекторах nBn на основе InAs / InAs 1− x Sb x сверхрешетки типа II. Устройство имело длину волны отсечки ~ 10 мкм при 77 К с максимальной чувствительностью 2,65 А / Вт, что соответствует квантовой эффективности 43% и RA 664 Ом · см 2 . и плотность темнового тока 8 × 10 5 А / см 2 при напряжении смещения 80 мВ при 77 К; фотоприемник показал удельную обнаруживающую способность 4,72 × 10 11 см Гц 1/2 / Вт [5]. Пиковая чувствительность этого устройства составляет 1,3 × 10 11 . см Гц 1/2 / Вт при 5 мкм и 0 В с напряжением смещения затвора - 10 В, что сопоставимо с устройством nBn. Но слабым местом является единообразие RA устройства, которое влияет на производительность устройства.
В заключение, заставляя активную область быть p -типа через допирование в π область может эффективно улучшить производительность сверхрешетки LWIR InAs / GaSb P + - π –M – N + детектор [6]. Однако не чем выше концентрация легирования, тем больше улучшаются характеристики устройства. В частности, электрические и оптические характеристики устройства могут быть снижены из-за чрезмерной концентрации легирования. Оптические характеристики при 77 K показывают, что мы получаем максимум QE 62,4% при 4,26 мкм и максимум 2,26 A / Вт при 5 мкм для Be, легированного при 780 ° C. Электрические характеристики показывают, что максимальное сопротивление прямого восхождения 1259,4 Ом · см 2 с Be, легированным 780 ° C. Удельная обнаруживаемая способность достигает максимального значения 5,6 × 10 10 . см Гц 1/2 / Вт при 5 мкм с Be, легированным при 780 ° C. Более того, смещение насыщения устройства может быть значительно уменьшено с помощью простой и эффективной предварительной обработки анодной вулканизацией. Предварительная вулканизационная обработка может снизить напряжение смещения затвора. Электрические характеристики показывают, что смещение насыщения составляет всего -10 В, в то время как в других исследованиях без предварительной вулканизационной обработки в аналогичной структуре с такой же толщиной SiO 2 оно составляло 40 В. слой. Кроме того, производительность устройства может быть значительно улучшена путем приложения надлежащего отрицательного смещения к электроду затвора. Максимум 1,3 × 10 11 см Гц 1/2 / Вт достигается при 5 мкм и 0 В с напряжением смещения затвора - 10 В для Be, легированного при 780 ° C при 77 К. В зависимости от экспериментального оборудования и условий эксперимента мы выбираем SiO 2 в качестве диэлектрического слоя, но в дальнейшем предполагается использовать среду Hi – K для дальнейших экспериментов. Теоретически напряжение смещения затвора можно дополнительно снизить.
Доступность данных и материалов
Авторы заявляют, что материалы и данные доступны читателям в кратчайшие сроки без чрезмерных требований к соглашениям о передаче материалов. Все данные, полученные или проанализированные в ходе этого исследования, включены в эту статью.
Сокращения
- LWIR:
-
Детекторы длинноволнового инфракрасного излучения
- QE:
-
Квантовая эффективность
- T2SL:
-
Сверхрешетки напряженного слоя II типа
- VLWIR:
-
Детекторы сверхдлинноволнового инфракрасного излучения
- MWIR:
-
Средневолновые инфракрасные детекторы
- HRXRD:
-
Дифракция рентгеновских лучей высокого разрешения
- AFM:
-
Атомно-силовая микроскопия
- ICP:
-
Индуктивно-связанная плазма
- GD:
-
Стробируемый диод
- UGD:
-
Незамкнутый диод
- D *:
-
Специфическая обнаруживаемость
- RA:
-
Произведение значения сопротивления и площади кристалла
- Ri:
-
Срабатывание инфракрасного детектора
- G – R:
-
Генерация – рекомбинация
Наноматериалы
- Интервью с экспертом:Oxford Performance Materials »Скотт ДеФелис об эволюции высокоэффективных полимеров для 3D-печати
- Простой синтез гетероструктурированных WS2 / Bi2MoO6 как высокоэффективных фотокатализаторов, управляемых видим…
- Самокатализирующийся рост вертикальных нанопроволок GaSb на стержнях InAs путем осаждения из паровой фазы метал…
- Повышенная биосовместимость в массивах анодных TaO x нанотрубок
- Видимые световые фотокаталитические характеристики нанокомпозитов ZnO / g-C3N4, легированных азотом
- Подготовка и фотокаталитические характеристики фотокатализаторов LiNb3O8 с полой структурой
- Новый фотокатализатор на гетеропереходе Bi4Ti3O12 / Ag3PO4 с улучшенными фотокаталитическими характеристиками
- Повышенная производительность нового анодного катализатора PdAu / VGCNF для электроокисления в глицериновом топ…
- Высокопроизводительный автономный УФ-детектор на основе массивов наночастиц SnO2-TiO2
- Автоматическая оценка производительности рентгеновского детектора



