Теоретические исследования InGaAs / InAlAs SAGCM лавинные фотодиоды
Аннотация
В этой статье мы даем подробное представление о лавинообразных фотодиодах с раздельным поглощением, градуировкой, зарядом и умножением на основе InGaAs / InAlAs (ЛФД SAGCM) и строим теоретическую модель ЛФД. Благодаря теоретическому анализу и двумерному (2D) моделированию полностью понятно влияние слоя заряда и туннельного эффекта на ЛФД. Конструкция зарядового слоя (включая уровень легирования и толщину) может быть рассчитана с помощью нашей прогнозной модели для различной толщины умножения. Мы обнаружили, что с увеличением толщины зарядового слоя подходящий диапазон уровней легирования в зарядовом слое уменьшается. По сравнению с более тонким зарядным слоем, характеристики ЛФД значительно варьируются из-за отклонений в несколько процентов концентраций легирования в более толстом зарядном слое. Кроме того, скорость генерации ( G btt ) межзонного туннеля и проанализировано влияние туннельного эффекта на лавинное поле. Мы подтверждаем, что лавинное поле и коэффициент размножения ( M n ) при умножении будет уменьшаться из-за туннельного эффекта. Теоретическая модель и анализ основаны на InGaAs / InAlAs APD; однако они применимы и к другим системам материалов APD.
Фон
В 0,53 Ga 0,47 Как (далее именуемые InGaAs) лавинные фотодиоды (APD) являются наиболее важными фотодетекторами для обнаружения коротковолнового инфракрасного излучения. Они важны в традиционных областях, таких как оптоволоконная связь, приложения для разведки и дистанционное зондирование. InP и In 0,52 Al 0,48 As (далее именуемые InAlAs) имеют такой же период решетки, что и InGaAs, и отличные характеристики лавинного пробоя; следовательно, они являются подходящими материалами слоя умножения для InGaAs APD в традиционных приложениях. В последние годы, из-за быстрого развития однофотонного обнаружения в квантовом распределении ключей [1], спектроскопии с временным разрешением [2], проверки оптических схем СБИС [3] и трехмерного лазерного определения местоположения [4], ЛФД в качестве ключевого компонент в этих приложениях привлекает все большее внимание [5, 6]. Пеллегрини и др. описал дизайн, изготовление и характеристики устройств InGaAs / InP планарной геометрии, которые были разработаны для однофотонного детектирования с эффективностью однофотонного детектирования (SPDE) 10% на длине волны 1550 нм (200 K) [7]. Tosi et al. представили критерии разработки нового однофотонного лавинного фотодиода (SPAD) InGaAs / InP с высоким SPDE (30%, 225 K), низким уровнем шума и низким временным джиттером [8]. При моделировании модель устройства, основанная на экспериментальных данных, была построена для прогнозирования темновой скорости счета (DCR) и SPDE для InGaAsP / InP SPAD в [9], а также интегрированная платформа моделирования, которая может оценить характеристики квантового распределения ключей InGaAs с ложным состоянием. / InP SPAD был построен в [10]. Acerbi et al. представил критерии проектирования однофотонных ЛФД InGaAs / InP с помощью специального симулятора SPAD [11]. Для InGaAs / InAlAs APD было продемонстрировано, что меза-структура SPAD InGaAs / InAlAs обеспечивает SPDE 21% (260 K); однако наблюдался высокий DCR, который был приписан чрезмерному туннельному току [12]. Затем [13] использовал толстый лавинный слой InAlAs в ЛФД InGaAs / InAlAs для улучшения SPDE (26%, 210 K) и уменьшения DCR (1 × 10 8 Гц). При моделировании ЛФД на основе InAlAs была создана модель устройства, основанная на методе Монте-Карло, для изучения основных характеристик ЛФД InGaAs / InAlAs в [14], а также влияния зарядового слоя и слоя умножения на пробивное напряжение и пробой. напряжение было исследовано с помощью стационарного 2D численного моделирования в [15].
По сравнению с APD на основе InAlAs, исследования APD на основе InP являются более полными и глубокими с точки зрения теории и моделирования. Однако APD на основе InAlAs все чаще используется вместо InP, поскольку он имеет большую запрещенную зону, которая может улучшить характеристики пробоя как в APD, так и в SPAD [16]. Отношение коэффициентов ионизации электрона (α) к дырке (β) в InAlAs больше по сравнению с InP, и, следовательно, он имеет низкий коэффициент избыточного шума и высокое произведение коэффициента усиления на ширину полосы. Более того, InAlAs демонстрирует большое увеличение вероятности пробоя с увеличением коэффициента смещения, что делает InAlAs SPAD более низким DCR [17]. Некоторые важные свойства и выводы относительно ЛФД на основе InAlAs были получены из предыдущих исследований, например, низкий избыточный шум может быть достигнут в структурах InAlAs как с толстыми, так и с тонкими участками лавины [18]. Пороговое электрическое поле туннелирования в поглощении (InGaAs) составляет 1,8 × 10 5 В / см, и туннельный ток становится доминирующей составляющей темнового тока в сильном поле [14]. Структура с вертикальным освещением имеет больший оптический допуск, но имеет более серьезный компромисс между временем прохождения несущей и чувствительностью [19]. Более того, теоретическая модель, структура (толщина и легирование), электрическое поле и другие параметры ЛФД на основе InAlAs были изучены в [20,21,22]. Однако эти исследования были сосредоточены только на влиянии общих параметров структуры ЛФД, таких как толщина поглощающего слоя, толщина умножения и уровень легирования зарядового слоя. Взаимосвязь между параметрами структуры и производительностью APD на основе InAlAs еще не полностью изучена и оптимизирована.
В этой статье были исследованы теоретическое исследование и анализ численного моделирования на основе вертикальной структуры InGaAs / InAlAs для обнаружения на длине волны 1,55 мкм. Мы построили теоретическую модель для изучения влияния параметров структуры на устройство и детальной взаимосвязи каждого слоя в APD. Были проанализированы и смоделированы конструкция зарядового слоя с различной толщиной умножения, влияние толщины на уровень легирования в заряженном слое и туннельный эффект на лавинное поле при умножении.
Методы
В этом разделе была построена математическая зависимость между параметрами устройства и распределением электрического поля в устройстве, которая использовалась для анализа слоя заряда и туннельного эффекта. Одновременно была построена имитационная модель, которая включала имитационную структуру, параметры материала и базовые физические модели. Модель теоретического анализа и имитационная модель были основаны на вертикальной структуре ЛФД SAGCM InGaAs / InAlAs.
Теоретическая модель и анализ уровня заряда
Параметры устройства, такие как уровень легирования, толщина, материалы и структура, были использованы для построения математической модели для расчета распределения электрического поля в ЛФД. Основные физические теории, которые включают уравнение Пуассона, модель обедненного слоя и модель PN-перехода полупроводникового прибора, можно найти в главах 1, 2 и 4 в [23] и [24]. Уравнение коэффициента размножения перехода можно найти в [25], а материальные параметры полупроводника взяты из [26]. Представленная модель использует уравнение Пуассона, уравнение плотности туннельного тока, модель обедненного слоя, модель теории переходов и локальную модель лавинного усиления. Упрощенная математическая система координат ЛФД, которая включает основные параметры структуры (материалы, толщину, легирование и диэлектрическую проницаемость), представлена на рис. 1. Это упрощенная структура ЛФД SACM, которая игнорирует градиентный слой. Материалы контактного слоя, зарядового слоя и слоя умножения - InAlAs, а поглощающего слоя - InGaAs. Стыки слоев разделены знаком X n , 0, X м , X c , и X а и X p по x координировать. Уровни допинга обозначены N 0 , N 1 , N 2 , N 3 , и N 4 , толщина слоя выражается как w 0 , w 1 , w 2 , w 3 , и w 4 , а диэлектрическая проницаемость выражается через ε s0 , ε s1 , ε s2 , ε s3 , и ε s4 контакта A, умножения, заряда, поглощения и контакта B соответственно.
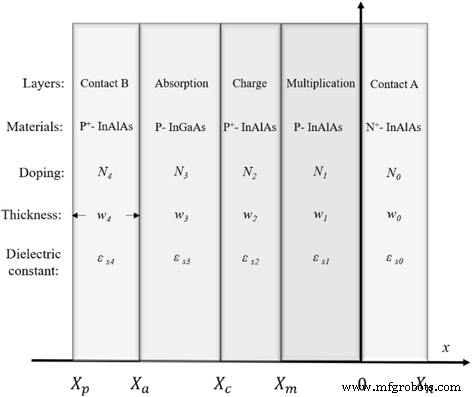
Упрощенная математическая система координат SACM InGaAs / InAlAs APD. Представлены упрощенные структуры APD, который используется для построения теоретической модели. Упрощенная математическая система координат ЛФД, которая включает основные параметры структуры (материалы, толщину, легирование и диэлектрическую проницаемость)
Уравнение 1 - это уравнение Пуассона, которое может решить распределение электрического потенциала с использованием плотности заряда ρ . В этом уравнении ρ равен легирующему иону N в модели слоя истощения w равна толщине обедненного слоя, а ε - диэлектрическая проницаемость материала. В общей модели распределения электрического поля PN-перехода ρ - переменная, зависящая от толщины истощенного слоя w и легирующий ион N . В этой модели она меняется после учета туннельного эффекта. Однако, прежде чем рассматривать эффект туннелирования, мы сначала построили распределение электрического поля, используя общий метод.
$$ \ frac {d \ xi} {d x} =\ frac {\ rho} {\ varepsilon} =\ frac {q \ times N} {\ varepsilon} $$ (1)Решая уравнение Пуассона с параметрами устройства, получают математическое выражение максимального электрического поля. Это выражение определяется изменением толщины проникновения в обедненном слое, показанным в формулах 2 и 3. В этом выражении параметры, которые включают уровни легирования ( N ), толщины истощающего слоя ( w ) и диэлектрической проницаемости ( ε) различных слоев можно найти на рис. 1.
$$ {\ xi} _ {\ max (w)} ={\ sum} _ {k =1} ^ 4 \ left (- \ frac {q \ times {N} _k \ times {w} _k} {\ varepsilon_ {sk}} \ right) $$ (2) $$ {\ xi} _ {\ max (w)} =\ frac {q \ times {N} _0 \ times {w} _0} {\ varepsilon_ {s0 }} $$ (3)Затем распределение электрического поля может быть получено во всех точках с использованием формул 4 и 5. Граничное условие игнорирует встроенный потенциал V br в Формуле 6; следовательно, можно рассчитать математическую зависимость между толщиной обедненного слоя и напряжением смещения.
$$ {\ xi} _ {\ left (x, w \ right)} ={\ xi} _ {\ max (w)} + {\ sum} _ {k =1} ^ 4 \ left (\ frac { q \ times {N} _k \ times \ left | x \ right |} {\ varepsilon_ {sk}} \ right) \ left ({X} _pИсходя из модели, как только граница обедненного слоя достигает области контакта, формулы 7–11 можно использовать для анализа электрического поля в каждом слое. В практическом APD поглощающие и умножающие слои непреднамеренно легируются собственными слоями. N 3 и N 1 меньше N 2 . Таким образом, формула 9 приблизительно равна формуле 12. Это причина того, что слой заряда может управлять распределением электрического поля в устройстве.
$$ {\ displaystyle \ begin {array} {l} \ xi \ left (x, {V} _ {\ mathrm {bias}} \ right) ={\ xi} _ {\ max \ left ({V} _ {\ mathrm {bias}} \ right)} + \ frac {q \ times {N} _1 \ times {w} _1} {\ varepsilon_ {s1}} + \ frac {q \ times {N} _2 \ times { w} _2} {\ varepsilon_ {s2}} + \ frac {q \ times {N} _3 \ times \ left | x- {X} _c \ right |} {\ varepsilon_ {s3}} \\ {} \ kern4em \ приблизительно {\ xi} _ {\ max \ left ({V} _ {\ mathrm {bias}} \ right)} + \ frac {q \ times {N} _2 \ times {w} _2} {\ varepsilon_ { s2}} \ left ({X} _ {\ mathrm {c}} \ ge x \ ge {X} _a \ right) \ end {array}} $$ (12)В формуле 8 разница электрического поля между размножением и поглощением определяется с использованием произведения N 2 и w 2 . N 2 - уровень легирования в зарядовом слое и w 2 - толщина слоя заряда. Для подходящего распределения электрического поля в ЛФД InGaAs / InAlAs электрическое поле в поглощающем слое (InGaAs) должно находиться в интервале значений 50–180 кВ / см, которые обеспечивают достаточную скорость для фотоиндуцированных носителей и избегают туннельного эффекта. в поглощающем слое [10]. То есть лавинное поле при размножении должно уменьшаться до 50–180 кВ / см при поглощении зарядовым слоем. Таким образом, мы можем использовать Формулу 8 для нахождения оптимального расчетного уровня легирования и толщины зарядового слоя. Когда слой умножения составляет 200 нм (поле лавины E в умножении 6,7 × 10 5 В / см при толщине слоя умножения 200 нм [27]); Расчетные значения уровня легирования и толщины в зарядовом слое сравниваются с результатами из [28,29,30,31,32,33] на рис. 2. Область теоретических значений хорошо согласуется с экспериментальными данными. Этот результат доказывает, что формулу 8 можно использовать для прогнозирования уровня легирования с различной толщиной в зарядовом слое, когда толщина умножения определена.
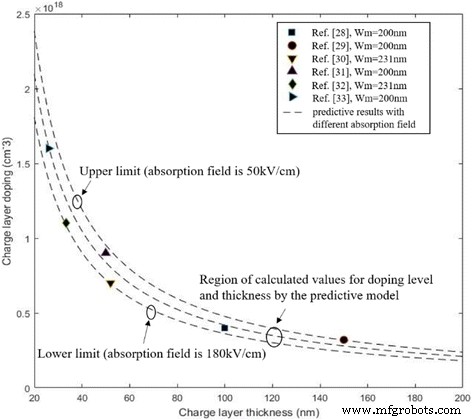
Сравнение теоретических результатов и данных экспериментов из различных отчетов ( w м =200 нм). Закрашенные символы:уровень легирования и толщина слоя заряда с толщиной умножения 200 нм (черный квадрат, черный круг, черный треугольник, черный треугольник, указывающий вправо) и 231 нм (черный ромб, черный треугольник, направленный вниз) в справочниках. Представлены расчетные значения заряда слоя (уровень легирования и толщина) по формуле 8 (поле поглощения 50–180 кВ / см). Когда поле поглощения составляет 50 кВ / см, может быть получен верхний предел уровня легирования в заряженном слое. Когда поле поглощения составляет 180 кВ / см, можно получить нижний предел уровня легирования в зарядовом слое. Мы сравниваем теоретические результаты и данные экспериментов из различных отчетов. Область теоретических значений хорошо согласуется с экспериментальными данными. Пунктирными линиями рассчитаны значения уровня легирования и толщины по формуле
Мы вычисляем оптимальный уровень легирования для разной толщины зарядового слоя с размножающим слоем 300, 500 и 700 нм, и результаты представлены на рис. 3. Этот результат показывает, что допуск на уровень легирования в зарядовом слое составляет связанных с его толщиной, а диапазон уровня легирования уменьшается с увеличением толщины зарядового слоя. То есть, если мы применим толстую область заряда, только небольшой диапазон уровня легирования в зарядовом слое будет существовать, чтобы удовлетворить оптимальное электрическое поле. В результате производительность APD значительно варьируется из-за отклонений в несколько процентов концентраций легирования в более толстом слое заряда. В разделе «Результаты и обсуждение» были смоделированы практические структуры ЛФД для изучения и проверки теоретического анализа, который включает влияние толщины слоя заряда на диапазон уровней легирования в слое заряда и разнообразие характеристик для различной толщины слоя заряда в APD.

Оптимальный уровень легирования и толщина слоя заряда для разных слоев умножения. Сплошная линия: w м =300 нм. Пунктирная линия: w м =500 нм. Пунктирная линия: w м =700 нм. Представляет рассчитанные значения заряда слоя (уровень легирования и толщина) по формуле, в то время как поле поглощающего слоя подходит. Толщина слоя умножения составляет 300, 500 и 700 нм. Когда толщина слоя умножения определена, мы можем использовать формулу для определения оптимального уровня легирования и толщины слоя заряда
Теоретическая модель с учетом туннелирования
Вышеупомянутая модель анализа касается распределения электрического поля в устройстве и основана на предположении, что ρ - ион легирующей примеси в обедненном слое. Если внутри поглощающего слоя существует достаточно сильное электрическое поле, локальный изгиб зон может быть достаточным для туннелирования электронов [34]. Следовательно, может происходить электронное туннелирование. Из схематической диаграммы туннелирования на рис. 4 видно, что когда в поглощающем слое происходит туннелирование пробоя, туннельный эффект изменяет плотность заряда ρ , положительный заряд в поглощении увеличивается, а отрицательный заряд в слое умножения и заряда увеличивается. Таким образом, ρ не равна плотности заряда легирующего иона в обедненном слое, а возникает туннельный эффект. Формулы, которые обсуждались ранее, изменятся после учета эффекта туннелирования.

Процесс туннелирования и изменение плотности заряда в слоях умножения и поглощения. Представлена принципиальная схема процесса туннелирования в устройстве. Если внутри поглощающего слоя существует достаточно сильное электрическое поле, локальный изгиб полосы может быть достаточным для туннелирования электронов. Когда поглощающий слой имеет пробивное туннелирование, положительный заряд в поглощении увеличивается, а отрицательный заряд в слое умножения и заряда увеличивается. Таким образом, ρ не равна плотности заряда легирующего иона в обедненном слое, при этом появляется туннельный эффект
Скорость генерации G bbt межполосного туннеля описывается формулой 13 [35, 36].
$$ {G} _ {bbt} ={\ left (\ frac {2 {m} ^ {\ ast}} {E_g} \ right)} ^ {1/2} \ frac {q ^ 2 {E_p} ^ {\ gamma}} {{\ left (2 \ pi \ right)} ^ 3 {\ hbar} ^ 2} \ exp \ left (\ frac {- \ pi} {4 {q \ mathit {\ hbar E}} _p} {\ left (2 {m} ^ {\ ast} \ times {E_g} ^ 3 \ right)} ^ {\ raisebox {1ex} {$ 1 $} \! \ left / \! \ raisebox {-1ex} {$ 2 $} \ right.} \ Right) =A \ times {E_p} ^ {\ gamma} \ times \ exp \ left (- \ frac {B} {E_p} \ right) $$ (13)В Формуле 13 E г ширина запрещенной зоны InGaAs, m * (равно 0,04 м e ) - эффективная приведенная масса, E p - электрическое поле пробоя в поглощающем слое, а γ - это определяемый пользователем параметр, который обычно ограничивается 1 ~ 2. A и B являются характеристическими параметрами. Мы вычисляем G bbt с разными γ , и результаты показаны на рис. 5. Можно обнаружить, что G bbt адаптирует тот же порядок величины для уровня легирования зарядового слоя, в то время как γ ограничено 1 ~ 1,5.

G btt для разных полей в поглощающем слое с разными γ . Значения γ равно 1,0 (черная звезда), 1,1 (черный треугольник, направленный вниз), 1,2 (черный ромб), 1,3 (черный треугольник), 1,4 (черный квадрат), 1,5 (черный круг). Представляет рассчитанные результаты G btt по формуле 13. Когда поле поглощения превышает 19 кВ / см, G bbt постепенно увеличивается. Также можно обнаружить, что G bbt адаптирует тот же порядок величины для уровня легирования зарядового слоя, в то время как γ ограничено 1 ~ 1,5
В результате плотность заряда ρ является переменной и определяется туннельным эффектом и легирующим ионом в туннеле поглощения. В этом случае Формула 1 будет изменена на Формулу 14, а электрическое поле в слое умножения будет описываться Формулой 15. w туннель - эффективный слой обеднения туннельного процесса [35]. Таким образом, изменение поля лавины можно описать формулой 16, и поле лавины будет уменьшаться в умножении с эффектом туннелирования.
$$ \ frac {d \ xi} {dx} =\ frac {\ rho} {\ varepsilon} =\ frac {q \ times \ left (N + {G} _ {btt} \ right)} {\ varepsilon}, {E} _p> 1,8 \ times {10} ^ 5V / cm $$ (14) $$ \ xi \ left (x, {V} _ {\ mathrm {bias}} \ right) ={\ xi} _ { \ max \ left ({V} _ {\ mathrm {bias}} \ right)} + \ frac {q \ times \ left ({N} _1 \ times \ left | x \ right | + {G} _ {bbt } \ times {w} _ {\ mathrm {tunnel}} \ right)} {\ varepsilon_ {s1}} \ left (0 \ ge x \ ge {X} _m \ right) $$ (15) $$ \ delta \ xi \ left (x, {V} _ {\ mathrm {bias}} \ right) =\ delta E =\ frac {q \ times {G} _ {btt} \ times {w} _ {\ mathrm {tunnel }}} {\ varepsilon _ {\ mathrm {s} 3}} $$ (16)Коэффициенты ионизации электронов и дырок описываются формулами 17 и 18 в [18]. E поле лавины при умножении.
$$ \ alpha ={a} _n {e} ^ {\ raisebox {1ex} {$ - {b} _n $} \! \ left / \! \ raisebox {-1ex} {$ E $} \ right.} $$ (17) $$ \ beta ={a} _p {e} ^ {\ raisebox {1ex} {$ - {b} _p $} \! \ Left / \! \ Raisebox {-1ex} {$ E $ } \ right.} $$ (18)Эффект лавины носителей учитывается моделью ударной ионизации. Учитывая чрезвычайно низкую плотность носителей в слое умножения по сравнению со слоем заряда, разумно предположить, что электрическое поле однородно во всем слое умножения. Следовательно, коэффициент умножения ( M n ) может быть выражено следующим уравнением. 19. Здесь w м - толщина слоя умножения, а k коэффициент ударной ионизации, определяемый как α / β . Поскольку k очень медленно меняется в зависимости от электрического поля, k приблизительно постоянна для небольшого изменения w м [37].
$$ {M} _n =\ frac {k-1} {k \ times {e} ^ {- \ alpha \ left (1- \ raisebox {1ex} {$ 1 $} \! \ Left / \! \ Raisebox { -1ex} {$ k $} \ right. \ Right) {w} _m} -1} $$ (19)Предполагая константу w м и напряжение смещения, дифференцирование M n относительно коэффициентов ионизации электронов находится в формулах 20 и 21.
$$ \ delta {M} _n \ left | {} _ {w =const \ &V =const} \ right. ={M_n} ^ 2 {e} ^ {- \ alpha \ left (1- \ raisebox {1ex} {$ 1 $} \! \ Left / \! \ Raisebox {-1ex} {$ k $} \ right. \ Right) {w} _m} \ times {w} _m \ delta \ alpha $$ (20) $$ \ delta \ alpha =\ frac {\ delta \ alpha} {\ delta E} ={\ alpha} _n {b} _n {e} ^ {\ frac {- {b} _n} {E}} \ frac {1 } {E ^ 2} $$ (21)В формулах 20 и 21 δα / δE положительный. Предполагается, что 20% от общего обедненного абсорбирующего слоя составляет w туннель толщина абсорбирующего слоя составляет 400 нм. Решая Формулу 16, соотношение между δE и поле поглощения с разными γ представлен на рис. 6. Можно найти, что δE адаптирует тот же порядок величины для поля лавины при умножении. Таким образом, туннельный эффект влияет на поле лавины и M n будет уменьшаться с эффектом туннелирования. При анализе мы предположили, что отрицательный заряд не умножается при умножении, и модель будет более строгой после его рассмотрения. Чтобы проверить и проанализировать влияние эффекта туннелирования на практическую структуру ЛФД, мы подробно смоделировали взаимосвязь между эффектом туннелирования и полем лавины умножения в разделе «Результаты и обсуждение».

δE для разных полей в поглощающем слое с разными γ . Значения γ равно 1,0 (черная звезда), 1,1 (черный треугольник, направленный вниз), 1,2 (черный ромб), 1,3 (черный треугольник), 1,4 (черный квадрат), 1,5 (черный круг). Представлены результаты расчета δE по формуле 16. Когда поле поглощения превышает 19 кВ / см, δE постепенно увеличивается. Также можно найти, что δE адаптирует тот же порядок величины для поля лавины при умножении. Таким образом, туннельный эффект влияет на лавинное поле с туннельным эффектом
Структура и имитационная модель
Для моделирования и анализа использовалось моделирование полупроводникового прибора TCAD. Этот механизм моделирования определяет физические модели в моделировании, и результаты имеют физический смысл [20]. Основные физические модели были представлены следующим образом. Модели дрейфа-диффузии, включая уравнения Пуассона и неразрывности носителей, использовались для моделирования распределения электрического поля и диффузионного тока I DIFF . Модель межполосного туннелирования использовалась для межполосного туннельного тока I B2B , а модель туннелирования с помощью ловушек использовалась для туннельного тока с помощью ловушек I TAT . Ток генерации-рекомбинации I GR описывалась рекомбинационной моделью Шокли – Рида – Холла, а оже-рекомбинационный ток I AUGER описывалась моделью оже-рекомбинации. Темновой ток четко описывался этими механизмами [38]. Размножение лавины описывалось моделью ударной ионизации Сельберхерра. Для имитационной модели использовались другие базовые модели, включая статистику носителей Ферми-Дирака, зависимость от концентрации носителей, подвижность с малым полем, насыщение скорости и методы трассировки лучей, и была построена строгая имитационная модель.
Структуры устройств в моделировании были аналогичны экспериментальным структурам в [13]. Схематическое сечение подсвечиваемого сверху ЛФД SAGCM InGaAs / InAlAs показано на рис. 7. Структуры сверху вниз последовательно именуются как контактный слой InGaAs, слой оболочки InAlAs, слой выравнивания InAlGaAs, слой поглощения InGaAs, градация InAlGaAs. слой, слой заряда InAlAs, слой умножения InAlAs, слой оболочки InAlAs, контактный слой InP и подложка InP. Толщина и легирование каждого слоя также представлены на рис. 7. Чтобы избежать влияния толщины на результаты моделирования, мы выбрали две модели моделирования. Одна структура моделирования называется APD-1 (слои умножения и поглощения составляют 800 и 1800 нм соответственно), а другая структура моделирования называется APD-2 (слои умножения и поглощения составляют 200 и 600 нм соответственно).
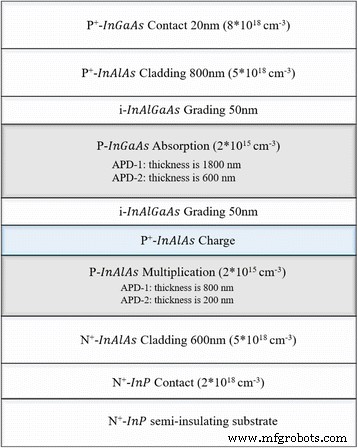
Структура моделирования и параметры APD. Представлено схематическое поперечное сечение подсвеченных сверху SAGCM InGaAs / InAlAs APD-1 и APD-2. Он включает структуру, материалы, легирование и толщину
Для проверки имитационной модели данные эксперимента [13] сравнивались с результатами моделирования. В данном моделировании мы использовали ту же структуру, что и эталон, и были приведены вольт-амперные характеристики устройства. На рисунке 8 показаны результаты нашего моделирования и результаты эксперимента в справочнике. У них одинаковое пробивное напряжение В pt и напряжение пробоя В br . Более того, результаты моделирования и эксперимента хорошо согласуются. Таким образом, модель в нашем моделировании точна. Упомянутые выше параметры перечислены в таблице 1.
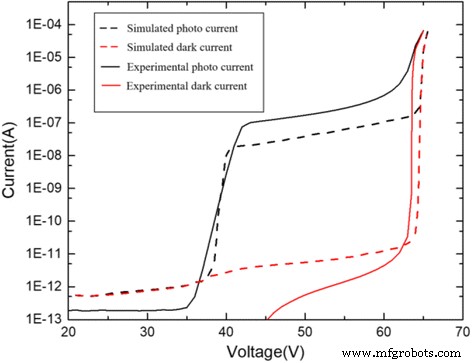
Результаты моделирования сравниваются с результатами эксперимента (фототок и темновой ток). Черная пунктирная линия:смоделированный фототок. Красная пунктирная линия:имитация темнового тока. Черная сплошная линия:экспериментальный фототок. Красная сплошная линия:экспериментальный темновой ток. Представлено сравнение результатов моделирования и результатов экспериментов. В имитационной модели используются те же параметры из эксперимента, что и в справочнике
Результаты и обсуждение
В этом разделе теоретический анализ и выводы были подробно изучены путем моделирования. Во-первых, в разделе «Влияние толщины зарядового слоя» изучалось влияние толщины слоя заряда на допуск уровня легирования в слое заряда. Затем связь между эффектом туннелирования и полем лавины размножения была проанализирована и проверена в разделе «Эффект туннелирования на распределение электрического поля».
Влияние толщины слоя заряда
Из [14], подходящее распределение поля в InGaAs / InAlAs APD должно соответствовать этим правилам. Гарантия V pt < V br и V br - V pt должен иметь запас прочности для обработки изменений температурных колебаний и рабочего диапазона. В слое поглощения электрическое поле должно быть больше 50–100 кВ / см, чтобы обеспечить достаточную скорость для фотоиндуцированных носителей. При этом электрическое поле должно быть меньше 180 кВ / см, чтобы избежать туннельного эффекта в поглощающем слое. Распределение электрического поля сильно влияет на работу устройства. Выбор электрического поля в поглощающем слое обеспечивает баланс между малым временем прохождения, темновым током и высокой чувствительностью к практическим требованиям.
In the simulation, we used the structure of APD-1 (multiplication is 800 nm thick) and adjusted the charge layer thickness from 50 to 210 nm to study the influence of charge layer thickness on doping level range and verify the theoretical conclusions in analytical model. In the simulation, we selected different doping level ranges in the charge layer so that the electric field distribution complies with the rules. The simulation results on the relationship between thickness and doping level range in the charge layer are presented in Fig. 9a. As the charge layer thickness increases, the suitable doping level range in charge layer decreases. A relatively large doping level range exists in the thin charge layer, and under this doping level range, the device will have a suitable electric field distribution. Apparently, the doping level range is determined by charge layer thickness. The simulation result of APD-2 (with a thickness of multiplication of 200 nm) is presented in Fig. 9b, which has a similar result. Moreover, it can be found that the calculated results of Fig. 2 and simulation results of Fig. 9b match well as shown in Fig. 9c. The small difference between the calculated results and simulation results is caused by the different values of avalanche field in the simulation and calculation. The avalanche field in simulation engine is used 6.4 × 10 5 V/cm, while in the calculation, we use the value of 6.7 × 10 5 V/cm from [27].

а Relationship between suitable doping level and thickness of charge layer (APD-1). The thickness of charge layer is 50 nm (black square), 90 nm (black circle), 130 nm (black triangle), 170 nm (black down-pointing triangle), 210 nm (black diamond). а presents the suitable doping level region for different thickness of charge layer. As the charge layer thickness increases, the suitable doping level range in the charge layer decreases. A relatively large doping level range exists in the thin charge layer, and under this doping level range, the device will have a suitable electric field distribution. Apparently, the doping level range is determined by charge layer thickness. б Relationship between suitable doping level and thickness of charge layer (APD-2). The thickness of charge layer is 50 nm (black square), 70 nm (black circle), 90 nm (black triangle), 110 nm (black down-pointing triangle), 130 nm (black diamond), and 150 nm (black pentagon). The figure description of b is similar to a . c Comparison of calculated results in Fig. 2 and simulated results in Fig. 9b. Dashed line:calculated results. Closed symbols:simulated results (black square). c presents the comparison of calculated results in Fig. 2 and simulated results in Fig. 9b. The calculated results and simulated results correspond well
The charge layer thicknesses of 210 and 50 nm (APD-1) were selected to show the simulation details and the influence of doping level on the electric field distribution. Figure 10a, c shows the current simulation results of different doping levels in thicknesses of 210 and 50 nm, respectively. Figure 10b, d shows the electric field distribution simulation results using the same structure. The simulation results show that thicknesses of 210 and 50 nm have doping level ranges of 1.0 × 10 17 –1.3 × 10 17 см −3 and 3.9 × 10 17 –5.7 × 10 17 см −3 соответственно.

а Photocurrent and dark current with different doping level (thickness of charge layer is 210 nm). Solid line:doping level in the charge layer is 1.3 × 10 17 см −3 . Dashed line:doping level in charge layer is 1.15 × 10 17 см −3 . Dashed dot line:doping level in charge layer is 1.0 × 10 17 см −3 . а Presents the simulation results of currents with different doping level. The device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influence the punch-through voltage, breakdown voltage, and current-voltage characteristic. б Avalanche field with different doping level (thickness of charge layer is 210 nm). Solid line:doping level in charge layer is 1.3 × 10 17 см −3 . Dashed line:doping level in charge layer is 1.15 × 10 17 см −3 . Dashed dot line:doping level in charge layer is 1.0 × 10 17 см −3 . б Presents the simulation results of fields with different doping level. The device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influenced the electric field distribution. c Photocurrent and dark current with different doping level (thickness of charge layer is 50 nm). Solid line:doping level in charge layer is 5.7 × 10 17 см −3 . Dashed line:doping level in charge layer is 4.8 × 10 17 см −3 . Dashed dot line:doping level in charge layer is 3.9 × 10 17 см −3 . c Presents the simulation results of currents with different doping level. The device with a charge layer thickness of 50 nm has a relatively wide and suitable doping level. A minimal change in the doping level has a small influence on the current-voltage characteristic. г Avalanche field with different doping level (thickness of charge layer is 50 nm). Solid line:doping level in charge layer is 5.7 × 10 17 см −3 . Dashed line:doping level in charge layer is 4.8 × 10 17 см −3 . Dashed dot line:doping level in charge layer is 3.9 × 10 17 см −3 . г Presents the simulation results of fields with different doping level. The device with a charge layer thickness of 50 nm only has a relatively wide and suitable doping level. A minimal change in the doping level has a small influence on the electric field distribution
Clearly, the device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influence the current-voltage characteristic and electric field distribution. As a result, the performance of APD varies significantly via several percent deviations of doping concentrations in the thicker charge layer. This conclusion is the same as the theoretical analysis. Concurrently, when designing APD structures, choosing a thin charge layer will give a high level of doping tolerance, as well as confer APD with good controllability.
Finally, the relationship between charge layer and multiplication thickness was simulated. Figure 11a presents the avalanche field with multiplication region thicknesses of 100, 200, and 300 nm in the APD-2 structure (with a charge layer thickness of 70 nm). Figure 11b presents the charge layer doping range with different multiplication thicknesses at the suitable electric field distribution condition. The charge layer thicknesses are 50, 70, and 90 nm. Clearly, a high avalanche field exists in the thin multiplication layer. As the multiplication region thickness decreases, the electric field difference between multiplication and absorption layers increases. As a result, a thin multiplication layer needs a high product of the charge layer doping level and thickness to reduce the high avalanche field.

а Avalanche breakdown electric field with different multiplication thicknesses. Solid line:w м = 100 nm. Dashed line:w м = 200 nm. Dashed dot line:w м = 300 nm. а Presents the simulation results of electric field distribution with different w м . As the w м decreases, the avalanche field in the multiplication increase. б Relationship between multiplication thickness and charge layer. The thickness of multiplication is 300 nm (black square), 200 nm (black circle), 100 nm (black triangle). б Presents the relationship between multiplication thickness and charge layer. A thin multiplication layer needs a high product of the charge layer doping level and thickness to reduce the high avalanche field
Tunneling Effect on the Electric Field Distribution
The simulation in this part will study the tunneling effect on the electric field in the device. From the theoretical analysis, the tunneling effect has an influence on the avalanche field in multiplication. Thus, the simulation will design to study the influence of electric field in the absorption layer that exceeds the tunneling threshold value. First, group A, with the structure of APD-1, charge layer thickness of 90 nm, and different charge layer doping levels of 1.4 × 10 17 –2.4 × 10 17 см −3 , was simulated for electric field distribution when the device avalanche breaks down. The result is shown in Fig. 12a. When the charge layer doping level exceeds 2.0 × 10 17 см −3 , the field in the absorption layer becomes lower than the tunneling threshold field and the avalanche field in the multiplication layer reaches the same value. However, when the doping level is less than 2.0 × 10 17 см −3 , the field in the absorption layer exceeds the tunneling threshold field and the avalanche field in the multiplication layer decreases with the decrease of the doping level in charge layer. Similar results were observed in the APD-2 structure (with a charge layer thickness of 90 nm and doping level of 2.2 × 10 17 –3.6*10 17 см −3 ) (Fig. 12b). That is, if the electric field in the absorption layer exceeds the tunneling threshold value at or over the breakdown voltage, then the breakdown electric field in the multiplication will decrease.

а Avalanche breakdown electric field with different doping levels (APD-1). Thickness of charge layer is 90 nm. Red dashed lines:the field of absorption is larger than the tunneling threshold field. Black solid lines:the field of absorption is less than the tunneling threshold field. а Presents the simulation results of electric field distribution with different doping level while avalanche breakdown. When doping level of charge layer exceeds 2.0 × 10 17 см −3 , the field in the absorption layer becomes lower than the tunneling threshold field, and the avalanche field in the multiplication layer reaches the same value with different doping level. However, when the doping level is less than 2.0 × 10 17 см −3 , the field in the absorption layer exceeds the tunneling threshold field, and the avalanche field in the multiplication layer decreases with the decrease of the doping level. Thus, if the electric field in the absorption layer exceeds the tunneling threshold value at or over the breakdown voltage, then the breakdown electric field in the multiplication will decrease. Thus, the electric field in the absorption should be less than the tunneling threshold value to maintain the high field in the multiplication layer when the device avalanche breaks down. б Avalanche breakdown electric field with different doping levels (APD-2). Thickness of charge layer is 90 nm. Red dashed lines:the field of absorption is larger than the tunneling threshold field. Black solid lines:the field of absorption is less than the tunneling threshold field. The figure description of b is similar to a . c Relationship between field and bias voltage in multiplication and absorption (APD-1). Thickness of charge layer is 90 nm. Electric field of multiplication (black square). Electric field of absorption (red triangle). c Presents the relationship between the electric field and bias voltage in multiplication and absorption layers. When the electric field in the absorption layer reaches the tunneling threshold value, the avalanche breakdown electric field in the multiplication gradually decreases. Moreover, the absorption field slope increases when the electric field in the absorption layer exceeds the tunneling threshold. г Relationship between field and bias voltage in multiplication and absorption (APD-2). Thickness of charge layer is 90 nm. Electric field of multiplication (black square). Electric field of absorption (red triangle). The figure legend of d is similar to a
Groups B (APD-1 thickness of 90 nm, doping level of 2.4 × 10 17 см −3 in charge layer and APD-2 thickness of 90 nm, doping level of 3.6 × 10 17 см −3 ) were designed to demonstrate the relationship between the threshold electric field in the absorption layer and avalanche field in the multiplication layer. The multiplication and absorption electric fields vary with the bias voltage on the device. As shown in Fig. 12c, d, when the electric field in the absorption layer reaches the tunneling threshold value, the avalanche breakdown electric field in the multiplication gradually decreases. Moreover, when the absorption field exceeds the tunneling threshold, the avalanche breakdown electric field in the multiplication layer plummets. Furthermore, the absorption field slope increases when the electric field in the absorption layer exceeds the tunneling threshold.
The phenomenon in Fig. 12 can be explained by the theoretical analysis that tunneling has an influence on the charge density in the “Methods” section. When the electric field reaches the tunneling threshold value in the absorption layer, the charge density ρ becomes unequal to the dopant ion. The multiplication field will decrease as the negative ion increases, and the absorption field will increase as the positive ion increases. Concurrently, the absorption field slope will increase due to the tunneling effect. As a result, the electric field in the absorption should be less than the tunneling threshold value to maintain the high field in the multiplication layer and the low dark current when the device avalanche breaks down.
Выводы
In summary, we have presented a theoretical study and numerical simulation analysis involving the InGaAs/InAlAs APD. The mathematical relationship between the device parameters and electric field distribution in the device was built. And the tunneling effect was taken into consideration in the theoretical analysis. Through analysis and simulation, the influence of structure parameters on the device and the detailed relationship of each layer were fully understood in the device. Three important conclusions can be obtained from this paper. First, the doping level and thickness of the charge layer for different multiplication thicknesses can be calculated by the theoretical model in the “Methods” section. Calculated charge layer values (doping and thickness) are in agreement with the experiment results. Second, as the charge layer thickness increases, the suitable doping level range in charge layer decreases. Compared to the thinner charge layer, the performance of APD varies significantly via several percent deviations of doping concentrations in the thicker charge layer. When designing APD structures, choosing a thin charge layer will give a high level of doping tolerance, as well as confer APD with good controllability. Finally, the G btt of tunneling effect was calculated, and the influence of tunneling effect on the avalanche field was analyzed. We confirm that the avalanche field and multiplication factor (M n ) in the multiplication will decrease by the tunneling effect.
Сокращения
- 2D:
-
Двумерный
- APD:
-
Avalanche photodiode
- DCR:
-
Dark count rate
- SACM APDs:
-
Separate absorption, charge, and multiplication avalanche photodiodes
- SAGCMAPDs:
-
Separate absorption, grading, charge, and multiplication avalanche photodiodes
- SPAD:
-
Single-photon avalanche photodiode
- SPDE:
-
Single-photon detection efficiency
- SRH:
-
Shockley–Read–Hall
Наноматериалы
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Дизайн эмиссионного слоя для электронных умножителей
- Фотокаталитические свойства порошков TiO2 с покрытием Co3O4, полученных методом плазменного осаждения атомного …
- Теоретическое исследование двухосно-деформированных германиевых нанопроволок
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Настройка уровня Ферми пленок ZnO посредством суперциклического осаждения атомного слоя
- Исследование солнечного элемента из кристаллического кремния с черным слоем кремния на задней панели
- Межзонная фотопроводимость метаморфных квантовых точек InAs / InGaAs в окне 1,3–1,55 мкм
- Теоретическое моделирование радиационного отклика сверхрешетки Si, Ge и Si / Ge на низкоэнергетическое облучение…
- Самосеянный рост MOCVD и значительно усиленная фотолюминесценция нанопроволок InGaAs / InP Core – Shell



