Межзонная фотопроводимость метаморфных квантовых точек InAs / InGaAs в окне 1,3–1,55 мкм
Аннотация
Фотоэлектрические свойства метаморфического InAs / In x Ga 1 - x В качестве квантовых точек (КТ) наноструктуры изучались при комнатной температуре с использованием спектроскопии фотопроводимости (ПК) и фотолюминесценции, электрических измерений и теоретического моделирования. Четыре образца с разной стехиометрией In x Ga 1 - x По мере наращивания плакирующего слоя:содержание индия x было 0,15, 0,24, 0,28 и 0,31. InAs / In 0,15 Ga 0,85 Поскольку структура квантовых точек оказалась светочувствительной в телекоммуникационном диапазоне до 1,3 мкм. Как x увеличивается, красное смещение наблюдалось для всех образцов, структура с x =0,31 оказался чувствительным вблизи 1,55 мкм, т.е. в третьем телекоммуникационном окне. Одновременно было зафиксировано лишь небольшое уменьшение QD PC при увеличении x , что подтверждает хороший фотоответ, сравнимый с фотоответом In 0.15 Ga 0,75 Как структуры, так и наноструктуры КТ на основе GaAs. Также уменьшение ПК коррелирует с аналогичным уменьшением интенсивности фотолюминесценции. Путем теоретического моделирования квантовой энергетической системы и локализации носителей заряда в квантовых точках мы получили представление о механизме ПК и смогли предложить причины уменьшения фототока, связав их со специфическим поведением дефектов в структурах такого типа. Все это означает, что метаморфические КТ с высоким x являются подходящими конструкциями для оптоэлектронных инфракрасных светочувствительных устройств.
Фон
Метаморфический InAs / In x Ga 1 - x Поскольку наноструктуры с квантовыми точками вызвали большой интерес в последнее десятилетие благодаря множеству преимуществ [1,2,3,4,5,6,7]. Их наиболее привлекательная особенность заключается в том, что, выращивая квантовые точки на метаморфном буфере (МБ) InGaAs, можно добиться значительного снижения энергии перехода между уровнями квантовых точек [8] по сравнению с обычными структурами квантовых точек In (Ga) As / GaAs. . Это происходит из-за уменьшения ширины запрещенной зоны квантовых точек InAs в результате уменьшения рассогласования решеток между квантовыми точками InAs и буфером InGaAs и, следовательно, деформации в квантовых точках [9,10,11]. Так, применение МБ в качестве ограничивающего материала позволяет смещать значение длины волны излучения вглубь инфракрасного (ИК) диапазона, в частности, в телекоммуникационные окна на 1,3 и 1,55 мкм, сохраняя при этом высокий КПД [4, 12, 13]. Кроме того, метаморфические КТ показали интересные свойства, такие как (i) высокая плотность квантовых точек [14], (ii) возможность широко настраивать уровни QD и смачивающего слоя (WL) [10, 15] и (iii) хорошие характеристики активные элементы в светоизлучающих устройствах [16]. Однако недавние исследования глубоких уровней в метаморфических КТ показали, что, несмотря на InAs / In 0,15 Ga 0,85 Поскольку структуры с квантовыми точками имеют общую плотность дефектов, близкую к слою квантовых точек, сравнимую с таковой псевдоморфных квантовых точек InGaAs / GaAs, метаморфические структуры с более высокими x продемонстрировали более высокую плотность дефектов [17, 18].
Метаморфные структуры квантовых точек InAs нашли успешное применение в разработке и производстве фотонных и светочувствительных устройств ИК-диапазона, таких как лазеры [19, 20], источники однофотонных фотонов [3, 7, 21, 22] и солнечные элементы [23]. , 24,25]. Фотодетекторы In (Ga) As с квантовыми точками, основанные на межзонных и межподзонных переходах, в настоящее время активно исследуются для улучшенного обнаружения из ближнего ИК-диапазона в длинноволновый ИК-диапазоны из-за их реакции на облучение при нормальном падении [26,27,28,29,30] . Например, межподзонные переходы электронов между квантово-ограниченными уровнями и состояниями континуума могут быть спроектированы путем встраивания квантовых точек InAs в слои InGaAs [29,30,31,32], поскольку эта конструкция позволяет настраивать длину волны пика обнаружения, чтобы контролировать отклика на приложенное извне смещение и для уменьшения темнового тока [33, 34]. На сегодняшний день нет работ о реализации метаморфных структур квантовых точек в фотоприемниках.
Ключевой ролью для развития этой области является сохранение высокой эффективности излучения и фоточувствительности метаморфных структур с квантовыми точками, которые должны быть, по крайней мере, сравнимы с таковыми для традиционных структур InAs / GaAs с квантовыми точками [1, 5, 35]. Было проведено множество исследований в фундаментальных и прикладных областях для разработки конструкции структуры [6, 14, 21], для улучшения фотоэлектрических свойств [5, 13], а также для контроля / уменьшения деформационных дефектов в гетероструктурах [4, 36, 37].
Следовательно, InAs / In x Ga 1 - x В качестве метаморфных наноструктур КТ представляют интерес наноструктуры, которые позволяют иметь излучение или светочувствительность в ИК-диапазонах 1,3 и 1,55 мкм [1,2,3,4,5,6,7]. Кроме того, ранее нами сообщалось, что вертикальный InAs / In 0,15 Ga 0,75 Поскольку структуры с квантовыми точками могут сохранять фоточувствительность, сравнимую с структурами на основе GaAs [5]. Однако такие метаморфические структуры редко изучаются в фотоэлектрических измерениях с латеральной геометрией, когда фототок протекает через перенос носителей в плоскости через каналы между двумя верхними контактами. Обычно слои квантовых точек вместе с ассоциированной ЛС образуют эти каналы проводимости в структурах на основе GaAs с латеральной геометрией [38]. Считается, что благодаря такому своеобразному типу проводимости фотоприемники на КТ с боковым транспортом обладают потенциалом для высокой светочувствительности [39, 40]. Углубленное исследование метаморфных наноструктур квантовых точек InAs / InGaAs в латеральной конфигурации может предоставить фундаментальные знания о механизме фотопроводимости (ФП) и эффективности транспортировки носителей заряда. В нашей недавней работе, посвященной дефектам в метаморфных структурах с квантовыми точками [17], мы сообщили об измерениях бокового ФП при низких температурах, рассматривая только края ИК-спектров, обусловленные дефектами. Однако мы полагаем, что правильное определение характеристик и фундаментальное исследование структуры при комнатной температуре может дать ценные сведения для дальнейшего совершенствования новых светочувствительных устройств, таких как фотодетекторы ближнего ИК-диапазона, линейные матрицы и матрицы камер, за счет реализации метаморфных квантовых точек.
В настоящей работе мы исследовали плоские фотоэлектрические свойства метаморфического InAs / In x Ga 1 - x Как наноструктуры КТ, выращенные методом молекулярно-лучевой эпитаксии с различным составом In x с использованием спектроскопии ПК и фотолюминесценции (ФЛ), боковых электрических измерений и модельных расчетов. В частности, мы сосредоточились на наблюдении возможного красного смещения фотоотклика слоя КТ в сторону ИК диапазона за пределами 1,3 мкм при сохранении такой же фоточувствительности для In 0,15 Ga 0,85 Светочувствительные структуры с квантовыми точками As и GaAs. Высокая светочувствительность в ближнем ИК-диапазоне длин волн при комнатной температуре свидетельствует о том, что эти наноструктуры могут быть полезны не только для устройств, основанных на межзонных переходах, но и для межподзонных фотоприемников, работающих за пределами 10 мкм.
Методы
Подготовка образца и описание
Исследуемые структуры, схематически представленные на рис. 1, были выращены методом молекулярно-лучевой эпитаксии. Сначала полуизолирующая подложка (100) GaAs была покрыта буфером GaAs толщиной 100 нм при 600 ° C, а затем нанесен нелегированный InGaAs MB толщиной 500 нм при 490 ° C. Затем, после предварительного прекращения роста на 210 с для охлаждения подложки, 3,0 МС (монослоя) InAs были выращены при 460 ° C. Наконец, эти самоорганизованные КТ были покрыты 20 нм нелегированного In x Ga 1 - x Как с той же стехиометрией МБ. Четыре образца с разной стехиометрией In x Ga 1 - x По мере изготовления облицовочного слоя:В содержимом x было 0,15, 0,24, 0,28 и 0,31.
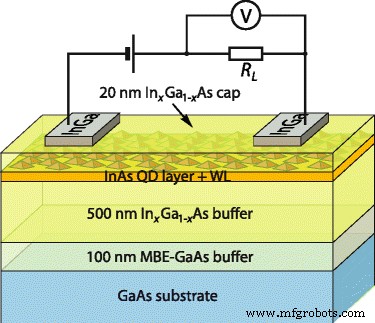
Раскрасьте онлайн. Схема метаморфического InAs / In x Ga 1 - x Как структуры квантовых точек и их подключение для фотоэлектрических измерений
Теоретическое моделирование
Для проектирования метаморфической структуры, а также понимания энергетического профиля, расчеты квантовой энергетической системы, состоящей из квантовых точек In (Ga) As, нелегированного МБ и защитного слоя, были выполнены с использованием программного обеспечения Tibercad [41], которое мы продемонстрировали на быть адекватным для моделирования оптических свойств полупроводниковых низкоразмерных наноструктур [2, 15, 42].
Мы рассматриваем КТ InAs с формой усеченного конуса и размерами, взятыми из экспериментальных данных атомно-силовой микроскопии [14]; мы включаем наличие InAs WL, параметры которого зависят от In x Ga 1 - x Как свойства метаморфического слоя [15].
Сначала выполняются расчеты деформации конструкции путем вычисления компонент тензора деформации КТ, вызванной несоответствием f QD между QD и MB, определяемым как
$$ {f} _ {\ mathrm {QD}} =\ left [{a} _ {\ mathrm {InAs}} \ hbox {-} {a} _ {\ mathrm {MB}} (x) \ right ] / {a} _ {\ mathrm {MB}} (x) $$ (1)где a МБ ( x ) - параметр решетки In x Ga 1 - x Как MB и a InAs - параметр решетки InAs. Затем профили полос для КТ и встраиваемых слоев зависят от деформационных потенциалов соответствующих материалов (InAs для КТ и ШП и релаксированного InGaAs для МБ).
Наконец, уравнение Шредингера
$$ \ boldsymbol {H} \ psi =E \ psi $$ (2)решается в приближении огибающей функции однозонным подходом эффективной массы для электронов и 6-зонным k • p подходом для дырок, где трехмерный гамильтониан равен
$$ \ widehat {H} =- \ frac {\ upeta ^ 2} {2} {\ nabla} _ {\ mathbf {r}} \ left (\ frac {1} {m \ left (E, \ mathbf { r} \ right)} \ right) {\ nabla} _ {\ mathbf {r}} + V \ left (\ mathbf {r} \ right), $$ (3)с V ( г ), являющийся трехмерным потенциалом.
Такое приближение считается удовлетворительным при проведении расчета основного состояния КТ [2]. Таким образом, получаются основные уровни для электронов и тяжелых дырок, а также их плотности вероятности. Энергия излучения фотолюминесценции была получена из разницы энергий между ограниченными уровнями для электронов и тяжелых дырок, уменьшенной на 20 мэВ для учета экситонных эффектов.
Более подробное описание модельных расчетов можно найти в [5]. [2].
Фотоэлектрические характеристики
Для боковых фотоэлектрических измерений два эвтектических поверхностных контакта InGa были нанесены на куски структур размером 5 × 2 мм. Измеренный линейный I - V Характеристики, приведенные на рис. 2, подтвердили омичность контакта. Ток, протекающий через образцы, измерялся мультиметром Siglent SDM3055 с использованием стандартного метода измерения постоянного тока [43, 44] как падение напряжения на последовательном сопротивлении нагрузки R L 1 МОм, что намного меньше сопротивления образца. Фототок возбуждался светом галогенной лампы мощностью 250 Вт, рассеянным призматическим монохромером, и спектры ФК регистрировались в диапазоне от 0,6 до 1,6 эВ [44,45,46]. Спектры нормированы на число квантов возбуждения источника света. Спектры ФЛ были получены с использованием лазера с длиной волны 532 нм в качестве источника возбуждения с плотностью мощности 5 Вт / см 2 . . Все измерения проводились при комнатной температуре (300 К).

Раскрасьте онлайн. Я - V характеристики InAs / In x Ga 1 - x Как структуры с x =0,15 ( a ), 0,24 ( b ), 0,28 ( c ) и 0,31 ( d ) для темноты (черный) и при освещении 350 мкВт / см 2 (цвет) при энергиях пика спектра ФЛ (возбуждение КТ) и 1,3 эВ (эффективное поглощение в InGaAs). На вставках:зависимости фототока от напряжения смещения
Результаты и обсуждение
Спектры ПК изученных метаморфических InAs / In x Ga 1 - x На рис. 3 показаны структуры КТ при комнатной температуре вместе с полосами ФЛ, которые показывают оптические переходы между основными состояниями КТ. Относительные интенсивности и положение полос ФЛ также показаны на рис. 4б. На кривых ПК наблюдаются особенности, связанные с КТ, ограничивающими слоями InGaAs и нижними слоями GaAs. Сигнал фототока при энергиях ниже начала полосы ФЛ может быть связан с дефектами структуры, обнаруженными ранее [17].

Раскрасьте онлайн. Спектры ПК метаморфического InAs / In x Ga 1 - x Как структуры при комнатной температуре и напряжении смещения 11 В для x =0,15 ( a ), 0,24 ( b ), 0,28 ( c ) и 0,31 ( d ). Интенсивности возбуждения для черной, красной и синей кривых при 1,3 эВ соответствуют 88, 350 и 1400 мкВт / см 2 . , соответственно. Приведены спектры ФЛ в условных единицах для энергетического позиционирования переходов в основное состояние КТ. Вертикальными стрелками отмечены запрещенные зоны InGaAs (ε g ) рассчитано согласно Paul et al. [48] и спектральные позитоны, где были измерены зависимости ПК от интенсивности возбуждения (приведены на рис. 5)

Раскрасьте онлайн. Моделирование расчетов для метаморфических InAs / In x Ga 1 - x В виде структур QD: a профили полос в конструкциях с разными x по оси роста; б реальные полосы ФЛ КТ и их расчетные положения пиков (пунктирные вертикали); и c плотности вероятности удерживаемых электронов и дырок для InAs / In 0,15 Ga 0,85 Как QD. Все расчеты моделируемых конструкций проводились на 300 тыс.
Исследованные метаморфические InAs / In 0.15 Ga 0,85 Структура квантовых точек оказалась светочувствительной в телекоммуникационном диапазоне при 0,95 эВ (1,3 мкм) (рис. 3а). Как x увеличилось, красное смещение наблюдалось для всех образцов:структура с x =0,31 оказался чувствительным вблизи 0,8 эВ (1,55 мкм) (рис. 3d), то есть в третьем телекоммуникационном окне [47]. Сдвиг связан с уменьшением рассогласования решеток материалов InAs QD и In x Ga 1 - x В качестве буфера с увеличением x и, как следствие, уменьшение деформации в КТ. Это приводит к сужению запрещенной зоны КТ InAs и, в свою очередь, к красному смещению полосы ФЛ, а также к началу фотоотклика в ИК-область [1,2,3,4,5,6,19,35]. P>
Одновременно было зафиксировано лишь незначительное уменьшение сигнала фототока КТ, что подтвердило сохранение хорошей светочувствительности, сравнимой с таковой у In 0.15 Ga 0,75 Как образец. Как мы недавно обсуждали [5], метаморфические структуры КТ с x =0.15 показывают фотоотклик, очень похожий на фотоотклик псевдоморфных наноструктур InAs / GaAs с квантовыми точками. Кроме того, уменьшение PC коррелирует с уменьшением PL, как это видно на рис. 3.
Такой эффект для наших образцов оказался наиболее заметным на рис. 2, где I - V показаны зависимости в темноте и при освещении в различных характерных спектральных точках от напряжения смещения, а также зависимости фототока на вставках. Как и на рис. 3, значение фототока подразумевает только фотоиндуцированную часть тока, полученную из полного тока при освещении путем вычитания значения темнового тока. Эти спектральные точки представляют собой максимумы полос ФЛ и 1,3 эВ, где происходит эффективное межзонное поглощение в InGaAs MB. Как и для темного I - V характеристик, эти зависимости имеют линейный характер в пределах экспериментальной ошибки.
Наилучший фотоотклик был получен в структуре с минимальным содержанием индия в ограничивающих слоях. У него также был самый низкий темновой ток. Значение фототока на уровне приложенного возбуждения (350 мкВт / см 2 ) в InAs / In 0,15 Ga 0,85 При накачке МБ структура As в два-три раза превышала темновой ток. Фотоотклик при возбуждении КТ был сопоставим с темновым током; Однако следует учитывать, что в наших структурах был только один слой квантовых точек. Изготовление многослойных структур с квантовыми точками обязательно приведет к значительному увеличению ИК-фотоотклика. Другие конструкции с более высоким x выявлены более низкие сигналы фототока; зарегистрированные величины в обеих спектральных точках были примерно на порядок ниже значений темнового тока в широком диапазоне приложенного напряжения. Самый низкий фотоотклик был обнаружен для InAs / In 0,31 Ga 0,69 Как структура с максимальным содержанием МБ.
Скорее всего, это снижение светочувствительности связано с увеличением плотности дефектов МБ с x , который был определен ранее для этих структур с помощью спектроскопии термостимулированного тока на глубоких уровнях [17], что хорошо коррелировало со структурным анализом таких наноструктур [1]. Мы сообщали, что InAs / In 0,15 Ga 0,85 Поскольку структура квантовых точек имела общую плотность дефектов, близкую к слою квантовых точек, сравнимую с InGaAs / GaAs, тогда как другие структуры с более высоким содержанием индия демонстрировали более высокие плотности дефектов, такие как известные комплексы точечных дефектов, связанные с GaAs, EL2, EL6, EL7, EL9 и EL10 рядом со слоем квантовых точек и три уровня, приписываемые протяженным дефектам, распространяющимся через буфер.
Что касается формы спектра (рис. 3), выше возбуждения КТ поглощение света и, следовательно, генерация носителей происходит в основном в МБ при энергиях выше ширины запрещенной зоны ограничивающего слоя InGaAs ε g , значения которого для разных x оценивались по эмпирической формуле [48]. Однако следует отметить, что увеличение энергии фотонов выше ε g приводит к небольшому снижению фотоотклика. Естественно, это подтверждает, что метаморфические КТ, несмотря на то, что они являются эффективными центрами рекомбинации [1, 2, 12, 22], вносят более эффективный вклад в фототок, чем МБ [5, 6, 23].
Чтобы понять механизм PC этой особенности, следует взглянуть на рис. 4а, где показаны рассчитанные профили полос КТ вдоль направления роста для наших образцов. Расчеты подтверждаются результатом квантовых уровней энергии для электронов и дырок:ожидаемые энергии излучения ФЛ согласуются с экспериментально измеренным переходом основного состояния КТ ФЛ (рис. 4b). На рис. 4c мы показываем смоделированные плотности вероятности для ограниченных электронов и дырок, полученные с помощью волновых функций носителей, рассчитанных с помощью модели Tibercad, которые указывают на более высокий уровень локализации тяжелых дырок по сравнению с электронами.
Чтобы внести свой вклад в сигнал фототока, электронно-дырочные пары, генерируемые межзонным поглощением КТ, должны уходить из КТ путем термоэмиссии. В предыдущем исследовании [49] было установлено, что в метаморфных КТ электроны и тяжелые дырки одновременно покидают КТ в виде коррелированных пар. Более того, было также продемонстрировано, что энергия активации для такого процесса соответствует сумме энергий активации для двух частиц [50].
При исследовании теплового тушения излучения ФЛ метаморфных КТ [10, 51] мы доказали, что такие энергии активации равны сумме энергетического расстояния от уровней WL и состояний КТ и идут от 250 мэВ для x =0,15 до 150 мэВ для x =0,31. Как широко обсуждается в работе. Согласно [51], эти значения вызывают сильное тушение излучения ФЛ при комнатной температуре за счет теплового выхода ограниченных носителей.
На этом основании можно сделать вывод, что носители, возбужденные в КТ, могут термически уходить в WL и MB:там электроны и тяжелые дырки разделены изгибом зон в окрестности КТ (рис. 4а), что способствует обратному захвату дырок в КТ. и, являясь барьером для электронов, тем самым эффективно подавляет их излучательную рекомбинацию. Как следствие, тяжелые дырки концентрируются на периферии КТ (рис. 4c), тогда как электроны могут свободно перемещаться вдоль потенциальной ямы WL и MB, способствуя проводимости. Стоит отметить, что в работе Ref. В [49] обсуждается, что, несмотря на корреляцию во время процесса ухода, носители не могут рассматриваться как экситоны при комнатной температуре; отныне их можно легко разделить по изгибу зон в окрестности квантовых точек.
В противном случае при возбуждении МБ в ограничивающих слоях образуются неравновесные дырки, которые рекомбинируют с электронами. Здесь следует упомянуть, что WL, как известно, является каналом проводимости для наноструктур на основе GaAs [52], а в наших боковых структурах с поверхностными контактами отсутствует гетеропереход, поэтому носители эффективно собираются вблизи плоскости поверхности.
На рис. 3 падение сигнала ПК чуть выше ε g превратился в рост при более высоких энергиях, например, выше 1,3 или 1,1 эВ для образца с x 0,15 или 0,31 соответственно. Вероятно, это было вызвано оптическим поглощением ближе к поверхности и слою квантовых точек, что привело к вовлечению более мелких ловушек. Как было установлено для этих структур методами термостимулированной токовой спектроскопии и нестационарной спектроскопии глубоких уровней [17, 18], более глубокие электронные ловушки расположены в основном в слое InGaAs MB, тогда как более мелкие сосредоточены вблизи поверхности (по отношению к этим образцам, вблизи слоя КТ). Электроны, захваченные более мелкими ловушками, легче уходят обратно в зону проводимости при комнатной температуре. Таким образом, свободные электроны вблизи слоя КТ более подвижны, чем электроны, возбужденные глубже в МБ, и, следовательно, дают больший вклад в перенос заряда. Кроме того, электроны, генерируемые вблизи поверхности, могут свободно переходить в канал проводимости WL.
Наблюдалось аналогичное падение фототока после увеличения запрещенной зоны GaAs (около 1,4 эВ). Этот эффект может быть связан с генерацией носителей вблизи границы раздела InGaAs / GaAs, которая, как известно, имеет более высокую плотность дефектных состояний, являющихся ловушками и центрами рекомбинации.
Относительный вклад различных оптических переходов в фотоотклик структуры менялся в зависимости от интенсивности накачки. Это лучше видно на рис.5, где показаны значения фототока в зависимости от интенсивности возбуждения в различных характерных спектральных точках:начало полосы ФЛ (резонансное возбуждение ансамбля квантовых точек) или эффективное межзонное поглощение в InGaAs. (1,3 эВ) и GaAs (1,5 эВ).
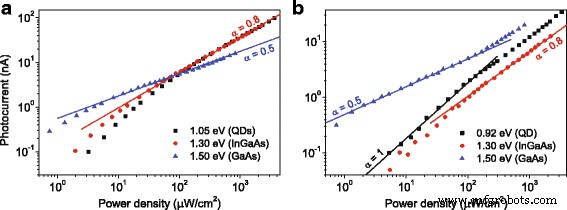
Раскрасьте онлайн. Фототок в зависимости от интенсивности возбуждения для InAs / In x Ga 1 - x Как структуры с a x =0,15 и b 0,31. Линии подгоняются функциями f ( x ) ~ x α
Структуры с различным содержанием индия в ограничивающих слоях демонстрировали сходные зависимости в эквивалентных спектральных диапазонах. Таким образом, межзонное возбуждение в GaAs (1,5 эВ) демонстрирует квадратичную зависимость при большинстве значений интенсивности. Это типично для межзонной рекомбинации неравновесных носителей заряда, например, когда они сильно преобладают под равновесными носителями [53]:этого можно ожидать в наших нелегированных структурах. Зависимости при возбуждении в удерживающих слоях КТ и InGaAs очень похожи друг на друга, но отличаются от таковых для GaAs. Они линейны при низких интенсивностях возбуждения и становятся сублинейными при более высоких интенсивностях. Такое поведение, очевидно, указывает на рекомбинацию носителей с участием центров Шокли-Рида:линейная зависимость становится сублинейной, так как некоторые центры насыщаются при более высоких скоростях генерации носителей [54]. Эти результаты зависящих от интенсивности измерений четко указывают на эффективную генерацию основных носителей заряда при относительно низкой скорости рекомбинации в слоях встраивания квантовых точек и гораздо более высокой плотности центров рекомбинации в слоях GaAs. Например, при возбуждении квантовых точек в аналогичных характеристиках светочувствительные структуры с квантовыми точками InGaAs / GaAs показали зависимость от интенсивности как PC ( Я ) ~ Я 0,25 , что происходило из-за высокой скорости безызлучательной рекомбинации через уровни дефектов наряду с излучательной рекомбинацией КТ [40, 55]. Однако стоит отметить, что структура InGaAs / GaAs была многослойной, состоящей из семи слоев квантовых точек.
На основе этих измерений и их интерпретации можно выделить некоторые показания для использования метаморфических квантовых точек для обнаружения ИК-излучения:(i) при использовании x > 0,15, следует использовать усовершенствованные разработки, позволяющие управлять деформационными дефектами, аналогично тому, как это было сделано для создания метаморфических квантовых точек [19, 20, 37]; 2) многослойные стопки квантовых точек (минимум из 10 слоев) необходимы для получения ПК с квантовыми точками выше темнового тока [27, 56]; и (iii) поскольку более высокое ограничение тяжелых дырок благоприятно для фототока, получаемого при возбуждении квантовых точек, можно рассмотреть усовершенствованные конструкции с более высокозонными барьерами для тяжелых дырок [51, 57]. Следовательно, эти результаты могут быть очень полезны для дизайна метаморфных квантовых точек, нацеленных на обнаружение инфракрасного излучения, и разработки метаморфных фотоприемников на основе квантовых точек.
Выводы
Фотоэлектрические свойства метаморфического InAs / In x Ga 1 - x Поскольку наноструктуры КТ изучались при комнатной температуре с использованием спектроскопии ПК и фотолюминесценции, электрических измерений и моделирования на теоретической модели. Изученные метаморфические InAs / In x Ga 1 - x Поскольку наноструктуры с квантовыми точками оказались светочувствительными в телекоммуникационных окнах при 1,3 ( x =0,15) и 1,55 мкм ( x =0,31). Однако КПД QD PC, а также эффективность ФЛ структур с более высоким содержанием In в МБ были оценены ниже и, тем не менее, сопоставимы с эффективностью InAs / In 0,15 Ga 0,85 Как структура, которая имеет чувствительность, аналогичную структурам с квантовыми точками InGaAs / GaAs. Это снижение светочувствительности связано с увеличением плотности дефектов МБ с x . Кроме того, благодаря модельным расчетам мы предоставили представление о механизме ПК в исследуемом типе структур с квантовыми точками. Все это означает, что метаморфические КТ с высоким x являются допустимыми структурами для оптоэлектронных устройств, чувствительных к инфракрасному свету, при условии, что некоторые проблемы решаются путем оптимизации конструкции наноструктуры.
Сокращения
- ε g :
-
Ширина запрещенной зоны ограничивающего слоя InGaAs
- E c и E v :
-
Энергия проводимости и валентные зоны
- IR:
-
Инфракрасный
- МБ:
-
Метаморфический буфер
- ML:
-
Монослой
- ПК:
-
Фотопроводимость
- PL:
-
Фотолюминесценция
- QD:
-
Квантовая точка
- R L :
-
Сопротивление нагрузки
- WL:
-
Смачивающий слой
Наноматериалы
- N, N-диметилформамид, регулирующий флуоресценцию квантовых точек MXene для чувствительного определения Fe3 +
- Яркий однофотонный источник на 1,3 мкм на основе двухслойной квантовой точки InAs в Micropillar
- Синтез обогащенных пиридином N, S-углеродных квантовых точек как эффективных имитаторов ферментов
- Обнаружение пространственно локализованного экситона в самоорганизованных сверхрешетках из квантовых точе…
- Квантовые точки висмута в отожженных квантовых ямах GaAsBi / AlAs
- Биполярные эффекты в фотоэдс метаморфных квантовых точечных гетероструктур InAs / InGaAs / GaAs:характеристика и кон…
- Простой подход к синтезу флуоресцентных квантовых точек углерода из сточных вод тофу
- Синтез водорастворимых квантовых точек сульфида сурьмы и их фотоэлектрические свойства
- Простой одностадийный сонохимический синтез и фотокаталитические свойства композитов на квантовых точках г…
- Полный обзор шины данных:соедините точки!



