Совместное дозирование озона и деионизированной воды как окислителей-предшественников роста тонкой пленки ZnO путем осаждения атомного слоя
Аннотация
Характеристики тонких пленок ZnO, выращенных методом атомно-слоистого осаждения (ALD), на сапфировых подложках с трехимпульсным озоном и без него (O 3 ) в качестве прекурсора окислителя и термического отжига (ТА) после осаждения. Температура осаждения и толщина эпитаксиальных слоев ZnO составляют 180 ° C и 85 нм соответственно. Термический отжиг после осаждения проводят при 300 ° C в атмосфере кислорода (O 2 ) в течение 1 ч. С сильным окислителем O 3 и TA после осаждения при выращивании ZnO, собственная деформация и напряжение снижаются до 0,49% и 2,22 ГПа, соответственно, с чрезвычайно низкой фоновой концентрацией электронов (9,4 × 10 15 см −3 ). Это происходит из-за более низкой плотности термически активированных дефектов при анализе термического тушения интегральной интенсивности спектров фотолюминесценции (ФЛ). TA дополнительно облегчает рекристаллизацию с образованием большего количества бездефектных зерен, а затем снижает деформационное и напряженное состояние, вызывая заметное снижение концентрации электронов и улучшение шероховатости поверхности.
Введение
При выращивании ZnO используются несколько окислителей. В их состав входит вода (H 2 O), перекись водорода (H 2 О 2 ), кислород (O 2 ) и озон (O 3 ) [1,2,3,4,5,6]. H 2 О является обычно используемым окислителем при выращивании ZnO с осаждением атомного слоя (ALD). ALD - это послойный самоограничивающийся механизм роста. Реакции обмена специфических поверхностных лигандов с последовательной пульсацией соответствующих предшественников. Поверхностные реакции прекращаются и насыщаются, когда реактивные участки поверхности полностью истощены. Рост тонких пленок методом ALD имеет такие преимущества, как превосходное конформное осаждение на поверхности и боковые области, превосходное покрытие ступенек краев, высокая однородность на большой площади, точность контроля толщины слоя и пригодность для низких температур осаждения [7,8,9] .
Сильные окислители влияют не только на структуру материала, но и на оптоэлектрические характеристики ZnO, осажденного методом ALD. H 2 О 2 окислитель обеспечивает более богатые кислородом условия, чем обычно используемый H 2 O прекурсор для пассивирования дефектов кислородных вакансий (V O ) и цинка (Zn i ) в пленках ZnO, выращенных методом ALD, при низких температурах роста от 80 до 150 ° C. Столбчатая морфология поверхности с предпочтительной ориентацией плоскости роста (002) возникла, когда использование окислителя изменено с H 2 От O до H 2 О 2 [2]. H 2 О 2 окислитель увеличивает скорость роста примерно на 70% по сравнению с использованием O 3 газовый реагент ZnO, выращенного методом ALD, при 200 ° C. Увеличение плотности гидроксильных (ОН) групп на растущей поверхности пленок приводит к увеличению скорости роста [3]. Увеличение скорости роста ZnO примерно на 60% при использовании чистого O 2 вместо H 2 O также упоминается как окислитель [4].
О 3 является эффективным окислителем оксидных материалов, выращенных методом ALD. Высокий электрохимический потенциал O 3 приводит к быстрым скоростям реакции при низкой температуре роста. О 3 более изменчив, чем H 2 О, Н 2 О 2 , и O 2 , и его легче очистить. Таким образом, можно сократить время продувки в каждом цикле. Отсутствие водорода в O 3 молекула приводит к меньшему загрязнению водородом и гидроксилами в росте. Менее однородная толщина из-за рекомбинантной потери ZnO на поверхности показана для 10 с O 3 . время выдержки при росте при 200 ° С [5]. Полученные методом ALD нелегированные пленки ZnO с O 3 окислители показывают двойной коэффициент термоЭДС по сравнению с образцами с H 2 О окислитель. H 2 O- и O 3 -растущие пленки ZnO имеют одинаковые уровни дефектов V O но разные уровни дефектов, связанных с цинком. Достаточная окислительная способность O 3 приводит к более низкому содержанию собственного Zn i и, следовательно, больший коэффициент термоэлектрической мощности. Сильный окислительный эффект O 3 повышает термоэлектрические характеристики нелегированных пленок ZnO [6]. Совместное дозирование O 3 и H 2 O может улучшить однородность и конформность тонкой пленки ZnO для правильных процессов ALD [5].
Собственные и внешние деформации существуют в пленке ZnO, выращенной естественным образом на сапфировой подложке. Собственная деформация возникает из-за кристаллографических дефектов высокой плотности в ZnO. Кристаллографические дефекты включают водородные комплексы, межузельные частицы цинка (Zn i ), кислородные вакансии (V O ), пронизывающие дислокации (TD) и границы зерен (GB) [10,11,12,13,14,15,16,17,18,19,20,21]. Внешняя деформация возникает из-за большого несоответствия постоянных решетки и коэффициентов теплового расширения между эпитаксиальным слоем ZnO и сапфировой подложкой. Применяются различные способы уменьшения внутренней и внешней деформации материалов ZnO на сапфирах. Тонкий буферный слой MgO может уменьшить внешнюю деформацию, уменьшить шероховатость поверхности на 58,8% и подавить поверхностные трещины на тонкой пленке ZnO на сапфире [22]. Внешняя деформация ZnO на сапфире полностью релаксирована с толщиной, достигающей 30 нм, полученной методом магнетронного напыления при 550 ° C [23]. Показана релаксация сжимающего напряжения с 1,77 до 1,47 ГПа пленок ZnO, осажденных методом распылительного пиролиза, при повышении температуры стеклянной подложки от 350 до 450 ° C [24].
ALD ZnO, выращенный при 180 ° C с одноимпульсными прекурсорами (DEZn и H 2 O) показывает фоновую концентрацию электронов ~ 10 18 см −3 даже с ТА после осаждения [25]. Обычно используется одноимпульсный H 2 О-предшественники процессов ALD не образуют идеального монослоя атомов кислорода. Трехимпульсные прекурсоры (DEZn и H 2 O) может вызвать множественные удары или столкновения молекул-предшественников с поверхностным лигандом, чтобы повысить вероятность реакции для ALD ZnO, выращенного при низкой температуре 100 ° C. Выбор «трех» импульсов помогает обеспечить правильное расположение реагентов в открытом месте хемосорбции или реакции. Чрезвычайно низкая фоновая концентрация электронов 8,4 × 10 14 см −3 , высокая дрейфовая подвижность электронов 62,1 см 2 [26] В нескольких отчетах показано улучшение качества материала тонких пленок ZnO и множественных квантовых ям ZnO / ZnMgO с термическим отжигом [27, 28]. В этом отчете трехимпульсный O 3 и последующие одноимпульсные H 2 O в качестве окислителей на цикл ALD используются для выращивания тонких пленок ZnO при 180 ° C. Термический отжиг (ТА) после осаждения применяется для улучшения кристаллического качества образцов. Исследованы особенности микро- и наноструктуры материала, фотолюминесценции и эффекта Холла тонких пленок ZnO, выращенных методом ALD.
Экспериментальные методы
Эпитаксиальные слои ZnO наносятся на обычный сапфир c-образной формы (c-Al 2 О 3 ) подложек с помощью системы ALD Cambridge NanoTech Savannah 100. При выращивании тонких пленок ALD ZnO прекурсоры, включая деионизированный (DI) H 2 О, О 3 и диэтилцинк (DEZn, Zn (C 2 H 5 ) 2 ) используются. Таблица 1 демонстрирует условия количества импульсов O 3 и TA после осаждения трех образцов, названных A, B и C. Схематическая диаграмма последовательности импульсов со временем на цикл ALD образцов показана на рисунке 1. На этом рисунке один цикл ALD содержит шесть последовательных шагов. Первым шагом является введение одноимпульсного деионизированного (DI) H 2 O в реактор метрового размера для образования поверхности с концевыми гидроксильными группами (ОН) на сапфире или для реакции с оборванными этильными группами (C 2 H 5 ), образующие цинк-кислородные (Zn – O) мостики на поверхности Zn с гидроксильными поверхностными группами. Создается один атомный слой кислорода (O). Второй этап - продувка газообразным азотом высокой чистоты (N 2 ) для удаления избыточных молекул прекурсоров и летучих побочных продуктов и предотвращения смешивания последующих прекурсоров после каждого воздействия реагентов. Третий этап - введение трехимпульсного O 3 в реакторы, чтобы облегчить сокращение собственных дефектов. Четвертый этап - продувка камеры N 2 газ. Пятый этап - это введение одноимпульсного DEZn в реакторы для получения одного атомного слоя цинка (Zn) на кислородном слое. Заключительным этапом также является продувка камеры N 2 газ. Прекурсоры поступают в реакционную камеру через газ-носитель N 2 при давлении в камере 4 × 10 -1 Торр. Оптимальные условия выдержки реагентов DI H 2 О, О 3 , а DEZn составляет 0,01, 0,5 и 0,015 с соответственно. Время импульса вакуумирования камеры 5 с. Толщина тонких пленок ZnO составляет 85 нм с 500 циклами ALD для каждого образца. Другие благоприятные условия наплавки параметров показаны в предыдущих отчетах [29]. ТА после осаждения при 300 ° C в атмосфере O 2 в течение 1 ч в печи обрабатывается на пробу С.
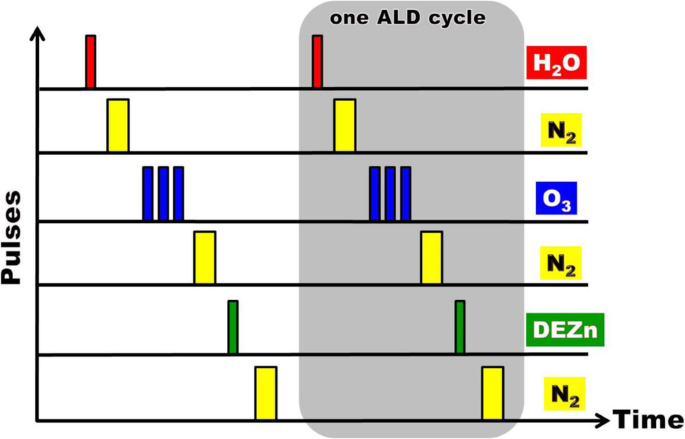
Пленки ZnO, выращенные методом ALD, на сапфировых подложках с последовательностью импульсов H 2 O / N 2 / O 3 / N 2 / ДЕЗн / N 2 используя деионизированную воду, O 3 , и Zn (C 2 H 5 ) 2 как предшественники
Структурные, оптические и электрические свойства материалов образцов определяют с помощью следующих измерений. Картины дифракции рентгеновских лучей (XRD) измерены с углом дифракции (2 θ ) в диапазоне от 33 до 38 ° и длине волны 0,154 нм медного Kα-излучения с помощью прибора D2 phaser (Bruker Corporation). Для измерения эффекта Холла используется система Ecopia HMS-3000, и образцы разрезаются на квадраты размером 0,7 × 0,7 см 2 . Четыре угла образцов припаяны небольшими пятнами индия с омическими контактами в конфигурации Ван-дер-Пау. Измеряются плотность несущих пластин, подвижность и удельное сопротивление пленок. Спектры фотолюминесценции (ФЛ) снимаются от 10 до 300 К при длине волны возбуждения 325 нм и мощности 55 мВт He – Cd-лазера. Проанализировано термическое гашение интегральной интенсивности спектров ФЛ при повышении температуры. Текстура поверхности и шероховатость образцов, исследованных с помощью изображений с высоким разрешением, полученных с помощью атомно-силового микроскопа (АСМ), получены с помощью прибора Veeco Dimension 3100.
Результаты и обсуждение
Рисунок 2 демонстрирует кристаллическую природу образцов путем измерения дифрактограмм. Два брэгговских дифракционных пика (002) и (101) соответствуют гексагональной вюрцитной структуре ZnO. Интенсивность самого сильного пика на рентгенограммах нормализуется для сравнения интенсивности пика между образцами. Две зеленые стрелки, указанные на верхней горизонтальной оси, показывают углы дифракции 34,4 ° и 36,2 ° для (002) и (101), соответственно, свободного от деформации объемного ZnO, полученного из наборов данных по материалам, выпущенных организацией Объединенного комитета по порошковой дифракции. Стандарты (JCPDS). На рисунке можно наблюдать пики (002) и (101) в образцах B и C, которые приближаются и затем приближаются к углам дифракции (002) и (101) объемного бездеформационного ZnO.

Рентгенограммы пленок ZnO с ориентацией кристаллов вдоль направлений (002) и (101) образцов. Стрелки указывают углы дифракции 34,4 ° и 36,2 ° для (002) и (101) объемного ZnO соответственно
Двухосная деформация вдоль c -ось эпитаксиальных слоев может быть получена путем сдвига рентгенограмм вдоль (002) в отличие от объемного ZnO без деформации. Средняя деформация ( ε z ) в решетке пленок ZnO оценивается по параметрам решетки с помощью следующего выражения.
$$ {\ varepsilon} _z =\ frac {c- {c} _0} {c_0} \ times 100 \% $$ (1)где c и c 0 постоянные решетки вдоль c - ось, рассчитанная по углам дифракции Брэгга пиков (002) пленок ZnO и объема. Среднее напряжение ( σ ) в плоскости пленок можно рассчитать с помощью модели двухосной деформации:
\ (\ sigma =\ frac {2 {c} _ {13} ^ 2- {c} _ {33} \ left ({c} _ {11} + {c} _ {12} \ right)} {c_ {13}} \ times {\ varepsilon} _z =-453,6 \ times {\ varepsilon} _z \ left (\ mathrm {GPa} \ right) \) (2) где c 11 =209,7 ГПа, c 12 =121,1 ГПа, c 13 =105,1 ГПа и c 33 =210,9 ГПа - константы упругой жесткости объемного ZnO. В таблице 1 деформации / напряжения ( ε z / σ ) образцов A, B и C составляют 1,08% / 4,90 ГПа, 0,74% / 3,37 ГПа и 0,49% / 2,22 ГПа соответственно. Напряжение / напряжение снижены и еще больше уменьшены в образцах B и C.
Спектры ФЛ при различных температурах от 10 до 300 К образцов представлены на рис. 3. В спектрах ФЛ всех образцов преобладает сильная ближняя излучательная рекомбинация экситонов со спектральной энергией пика около 3,34 эВ. Оптическое излучение с продольно-оптическими (LO) фононами наблюдается на нижнем энергетическом плече спектров ФЛ образцов. На рис. 4а – в показан график Аррениуса интегральной интенсивности спектров ФЛ в зависимости от обратной температуры. Термическое гашение интегральной интенсивности ФЛ при повышении температуры можно описать следующей формулой Аррениуса.
$$ I (T) =\ frac {A} {1+ {D} _ {nr1} \ exp \ left (\ frac {- {E} _ {A1}} {k _ {\ mathrm {B}} T} \ right) + {D} _ {nr2} \ exp \ left (\ frac {- {E} _ {A2}} {k _ {\ mathrm {B}} T} \ right)} $$ (3)где I ( Т ) представляет собой интегральную интенсивность ФЛ. А является константой. Д № 1 и D № 2 - константы, связанные с плотностью центров безызлучательной рекомбинации. E А 1 и E А 2 - энергии активации, соответствующие процессу безызлучательной рекомбинации донорных связанных экситонов при низкой температуре и свободных экситонов при высокой температуре соответственно. к B - постоянная Больцмана. Метод наименьших квадратов в регрессионном анализе используется для подбора данных, показывающих параметры D № 1 , D № 2 , E А 1 , и E А 2 с красными подгоночными кривыми в таблице 2 и на рис. 4a – c. Результат подгонки показывает, что варианты D № 1 , E А 1 , и E А 2 среди образцов есть свет. Д № 2 равны 132,7, 153,6 и 110,8 образцов A, B и C соответственно, что показывает большую разницу в величине плотности дефектов. Наименьшее значение D № 2 предполагает наименьшую плотность термически активированных дефектов в образце С.
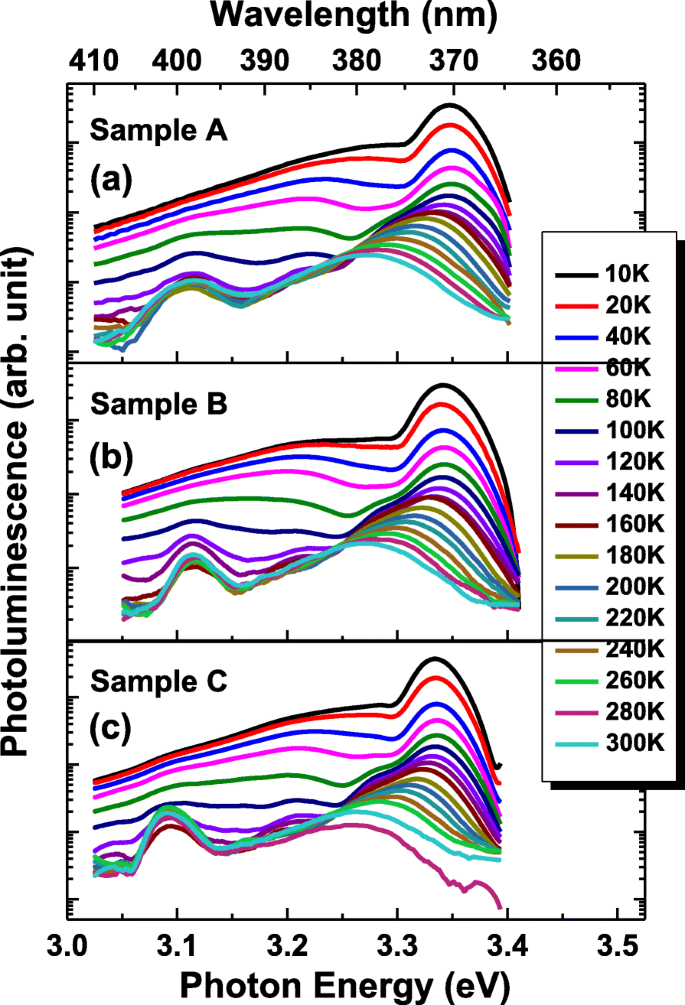
а - c Температурно-зависимые спектры ФЛ образцов
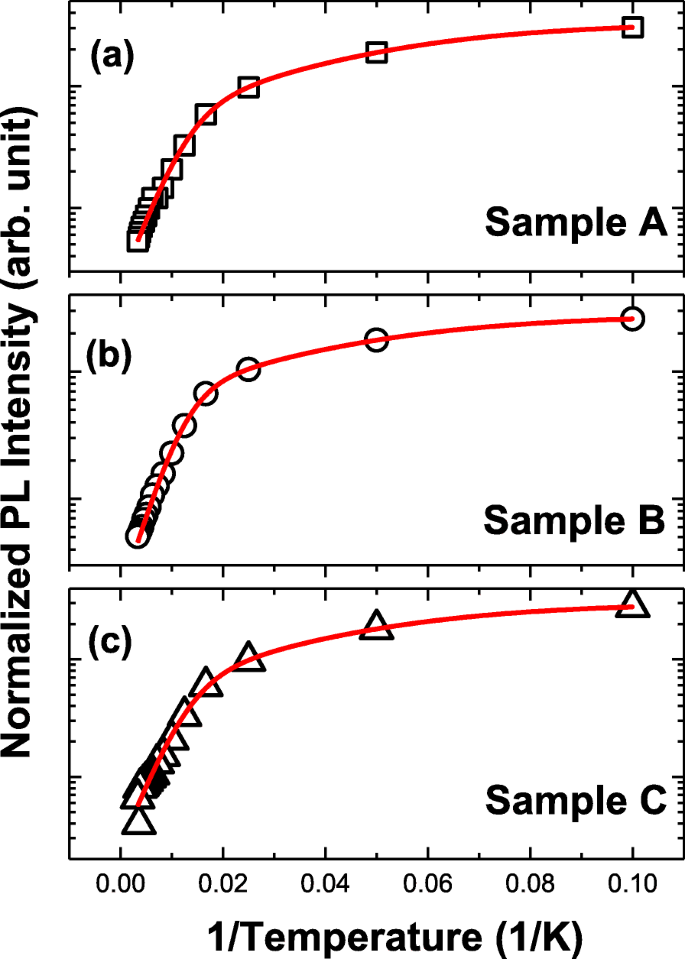
а - c Графики Аррениуса термического тушения интегральной интенсивности спектров ФЛ и красные аппроксимирующие кривые образцов
Фоновая концентрация электронов, подвижность и удельное сопротивление образцов, измеренных на эффекте Холла, приведены в таблице 2. В образце B показано уменьшение концентрации носителей заряда на два порядка величины с уменьшением подвижности по сравнению с образцом A. Дальнейшее резкое уменьшение концентрации носителей. до самого низкого значения 9,4 × 10 15 см −3 и повышение подвижности до 6,1 см 2 / Vs наблюдаются в образце C по сравнению с образцом B. Наименьшая концентрация электронов обусловлена наибольшей релаксацией деформационных / напряженных состояний и значительным снижением плотности собственных дефектов в образце C.
Рисунки 5a – c и d – f представляют собой 2D- и 3D-изображения образцов, полученные с помощью АСМ. Среднеквадратичная шероховатость (RMS) для A, B и C составляет 1,92, 4,30 и 2,18 нм соответственно, как показано в таблице 2. Наименьшая шероховатость текстуры поверхности наблюдалась в образце A. При использовании O 3 прекурсор в образце B, шероховатость поверхности увеличивается. Уменьшение пространственной однородности пленок ALD ZnO происходит из-за поверхностной потери O 3 [21]. Потеря поверхности O 3 связан с переходом от роста, ограниченного реакцией, к росту, ограниченному рекомбинацией, и может составлять первичный канал потерь атомов для разрушения пленок, что приводит к плохой однородности толщины. Это коррелирует с уменьшением интенсивности дифракционного пика вдоль (002) в образце B на фиг. 2. При обработке ТА после осаждения в образце C однородность поверхности улучшается. При этом достигается резкое снижение фоновой концентрации электронов и увеличение подвижности. Термический отжиг вызывает миграцию в кристаллической решетке; таким образом, происходит металлургическая перекристаллизация. Рекристаллизация сопровождается снижением прочности при деформации / напряжении и внутренних дефектов кристаллической решетки; следовательно, достигается лучшее качество тонкой пленки ZnO. Этот результат согласуется с увеличением интенсивности двух дифракционных пиков на рентгенограмме в образце C. Стоит отметить, что на подвижность электронов могут влиять источники рассеяния, такие как примеси, решетки и дефекты. Эти источники рассеяния могут изменить среднюю скорость электронов. Как правило, уменьшение плотности дефектов и, следовательно, уменьшение концентрации электронов приводит к увеличению подвижности. В этом отчете увеличение шероховатости текстуры поверхности из-за действия дозирования прекурсора озона может вызвать более низкую подвижность электронов в образце C, чем в образце A. На рис. 6 пирамидальная диаграмма, содержащая три треугольника разного цвета, иллюстрирует три ключевых растущих и условия обработки для получения высококачественных эпитаксиальных слоев ALD ZnO в этом отчете.
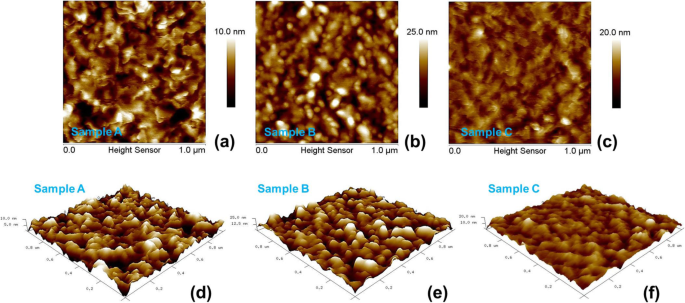
а - c 2D и d - е Трехмерные АСМ изображения образцов. Масштаб высоты в 2D-изображениях представлен на правой цветной панели

Диаграмма пирамиды. В пирамиде четыре треугольника показаны разными цветами. Три треугольника на краях пирамиды показывают основные условия выращивания и обработки ZnO. Комбинация этих трех важнейших компонентов в росте способствует качеству эпитаксиальных слоев ALD ZnO, показанных треугольником в центре пирамиды
Выводы
Одноимпульсный H 2 O и трехимпульсный сильный окислитель O 3 Предшественники в процессах ALD могут уменьшить деформацию / напряжение и, следовательно, заметно снизить концентрацию электронов в тонкой пленке ZnO, но увеличить шероховатость поверхности. ТА после осаждения при 300 ° C в атмосфере кислорода (O 2 ) в течение 1 часа может дополнительно способствовать формированию большего количества бездефектных зерен с более низкой деформацией / напряжением, более низкой концентрацией фоновых электронов и уменьшением шероховатости поверхности после роста с использованием трехимпульсного O 3 предшественники. Самая низкая деформация / напряжение и фоновая концентрация электронов, которые составляют 0,49% / 2,22 ГПа и 9,4 × 10 15 см −3 соответственно, за счет резкого уменьшения собственного дефекта тонких пленок ZnO, выращенных методом ALD.
Доступность данных и материалов
Данные, подтверждающие выводы этого исследования, могут быть предоставлены соответствующим автором (Юнг-Чен Ченг) по разумному запросу.
Сокращения
- ALD:
-
Осаждение атомного слоя
- O 3 :
-
Озон
- TA:
-
Термический отжиг
- O 2 :
-
Кислород
- PL:
-
Фотолюминесценция
- H 2 О:
-
Вода
- H 2 О 2 :
-
Перекись водорода
- OH:
-
Гидроксил
- Zn i :
-
Цинк межклеточные
- V O :
-
Кислородные вакансии
- TD:
-
Перенос вывихов
- ГБ:
-
Границы зерен
- NBE:
-
Ближний край запрещенной зоны
- c-Al 2 О 3 :
-
c-образный сапфир
- DI:
-
Деионизированный
- C 2 H 5 :
-
Этильные группы
- N 2 :
-
Газообразный азот
- Zn:
-
Цинк
- XRD:
-
Рентгеновская дифракция
- AFM:
-
Атомно-силовой микроскоп
- RMS:
-
Среднеквадратичное значение
Наноматериалы
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на по…
- Межфазные, электрические характеристики и характеристики совмещения полос стопок HfO2 / Ge с прослойкой SiO2, сфор…
- Иерархические антибактериальные полиамидные 6-ZnO нановолокна, полученные путем осаждения атомных слоев и гид…
- Фотокаталитические свойства порошков TiO2 с покрытием Co3O4, полученных методом плазменного осаждения атомного …
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Настройка уровня Ферми пленок ZnO посредством суперциклического осаждения атомного слоя
- Изучение силы адгезии и стеклования тонких пленок полистирола с помощью атомно-силовой микроскопии
- Получение и термоэлектрические характеристики ITO / PtRh:PtRh тонкопленочной термопары
- Удобный и эффективный метод нанесения тонкой пленки nc-Si:H с низкой плотностью дефектов от PECVD



