Дизайн квантовых точек GeSn / GeSiSn с механической деформацией для прямой ширины запрещенной зоны в среднем ИК-диапазоне на подложке Si
Аннотация
Созданные методом деформации самоорганизующиеся квантовые точки GeSn / GeSiSn в матрице Ge были численно исследованы с целью изучения их способности к прямому излучению из запрещенной зоны в среднем ИК-диапазоне. Использование сплава GeSiSn в качестве окружающей среды для квантовых точек (КТ) GeSn позволяет регулировать деформацию вокруг КТ путем изменения состава Si и / или Sn. Соответственно, рассогласование решеток между квантовыми точками GeSn и окружающим слоем GeSiSn регулировалось в пределах от - 2,3 до - 4,5% за счет изменения состава барьера Sn для разных размеров куполообразных квантовых точек. Полученные результаты показывают, что длина волны излучения, удовлетворяющая определенным критериям направленности квантовых точек, может быть последовательно настроена в широком среднем ИК-диапазоне от 3 до 7 мкм, что открывает новые перспективы для лазерных источников группы IV, полностью интегрированных в кремниевые фотонные системы для зондирования.
Фон
Недавно демонстрация материалов группы IV с прямой запрещенной зоной посредством легирования Ge [1, 2] и SiGe [3, 4] с оловом стимулировала интенсивную исследовательскую деятельность благодаря реальным и практически реализуемым возможностям в области фотоники и электроники, эффективных на кристалле. интеграция. Действительно, было показано, что сплав GeSn демонстрирует прямую запрещенную зону за пределами определенного состава за счет более быстрого уменьшения Γ по сравнению с L-долиной [5,6,7,8]. Хотя опубликованные результаты очень обнадеживают, свойства материала и возможности применения еще не полностью изучены. Действительно, основной реально существующий путь увеличения рабочей длины волны полупроводниковых лазеров на основе GeSn в сторону окна прозрачности атмосферы, которое перекрывается с линиями поглощения различных газов [9], включает увеличение содержания Sn в слоях GeSn [10, 11 ]. Однако из-за большого рассогласования решеток между Ge и Sn (14%) сохранение кристаллографического качества материала является основной проблемой, препятствующей достижению этой цели [12, 13]. Потенциально интересное решение для увеличения длины волны излучения и обеспечения лучшего удержания носителей заряда в структурах с меньшими размерами, таких как нанопроволоки [14,15,16], наностержни [17] и квантовые точки [18]. В рамках конкретных критериев прямолинейности длина волны прямого межзонного излучения в запрещенной зоне теоретически ограничена 4,3 мкм [19]. Чтобы преодолеть эти ограничения, необходимо ввести дополнительную степень свободы в концепцию квантовых структур на основе IV группы. Этого можно добиться, используя тройной слой GeSiSn [20,21,22] в качестве окружающего материала для квантовых точек GeSn, предлагая возможность инженерии деформации путем включения соответствующих составов Si и Sn . Соответственно, ожидается, что использование слоя инженерии деформации GeSiSn вокруг квантовых точек GeSn обеспечит более широкий диапазон доступных длин волн прямого запрещенного излучения.
В этом контексте мы сообщаем о теоретическом исследовании влияния инженерии деформации путем изменения состава Sn в слое GeSiSn, окружающем КТ GeSn, на длину волны прямого межзонного излучения в запрещенной зоне.
Методы
Поскольку смещения зон между бинарными и тройными Sn-содержащими сплавами IV группы и Ge экспериментально не известны, относительное выравнивание зон между различными полупроводниками IV группы, участвующими в данной работе, оценивается по отношению к краю валентной зоны Ge. используя упрощенную теорию смещения зон Яроса [23], подробно описанную D'Costa et al. [24]. Эффекты деформации, возникающие из-за несоответствия решеток между подложкой Ge и слоем GeSiSn, а также между квантовыми точками GeSn и окружающим материалом GeSiSn, были оценены для краев зоны проводимости и валентной зоны.
Действительно, край зоны проводимости сдвинут на \ (\ delta {E} _c ^ i \), а край валентной зоны на δE v как показано в формуле. (1) и (2):
$$ \ delta {E} _c ^ i ={a} _c ^ i \ left ({\ varepsilon} _ {xx} + {\ varepsilon} _ {yy} + {\ varepsilon} _ {zz} \ right) $ $ (1) $$ \ delta {E} _v ={a} _v \ left ({\ varepsilon} _ {xx} + {\ varepsilon} _ {yy} + {\ varepsilon} _ {zz} \ right) + b \ left ({\ varepsilon} _ {xx} - {\ varepsilon} _ {zz} \ right) $$ (2)где i обозначает L или Γ долину, a c и a v - потенциал деформации зоны проводимости и валентной зоны соответственно, а b - потенциал деформации сдвига. \ ({\ varepsilon} _ {xx} ={\ varepsilon} _ {yy} =\ varepsilon =\ left (\ frac {a_s- {a} _ {\ mathrm {l}}} {a _ {\ mathrm {l }}} \ right) \) - деформация в плане, а \ ({\ varepsilon} _ {zz} =- 2 \ frac {C_ {12}} {C_ {11}} {\ varepsilon} _ {xx} \) - деформация в направлении роста. а s и a l - соответственно параметр решетки подложки и деформированного слоя. C 11 и C 12 - константы жесткости.
Параметры материала бинарных и тройных сплавов выводятся из параметров Ge, Si и Sn с помощью линейной интерполяции. Эти параметры взяты из ссылки [11].
Деформированные запрещенные зоны, зависящие от состава, могут быть оценены путем добавления соответствующих сдвигов энергии, генерируемых деформацией, к запрещенной запрещенной зоне недеформированного материала, указанной в формуле. (3) для GeSn и уравнения. (4) для GeSiSn:
$$ {E} _g ^ i \ left ({\ mathrm {Ge}} _ {1- {X} _d} {\ mathrm {Sn}} _ {X_d} \ right) =\ left (1- {X} _d \ right) {E} _g ^ i \ left (\ mathrm {Ge} \ right) + {X} _d {E} _g ^ i \ left (\ mathrm {Sn} \ right) - {b} ^ i { X} _d \ left (1- {X} _d \ right) $$ (3) $$ {\ displaystyle \ begin {array} {l} {E} _g ^ i \ left ({\ mathrm {Ge}} _ {1- {x} _b-y} {\ mathrm {Si}} _ y {\ mathrm {Sn}} _ {x_b} \ right) =\ left (1- {x} _b-y \ right) {E} _g ^ i \ left (\ mathrm {Ge} \ right) + {x} _b {E} _g ^ i \ left (\ mathrm {Sn} \ right) + {yE} _g ^ i \ left (\ mathrm {Si } \ right) - {b} _ {\ mathrm {Ge} \ mathrm {Sn}} ^ i {x} _b \ Big (1- {x} _b - \\ {} y \ Big) - {b} _ {\ mathrm {Si} \ mathrm {Sn}} ^ iy \ left (1- {x} _b-y \ right) - {b} _ {\ mathrm {Ge} \ mathrm {Si}} ^ i {x} _by \ end {массив}} $$ (4)где b - соответствующий параметр изгиба запрещенной зоны бинарных сплавов, приведенный в Таблице 1.
Чтобы определить ограниченные состояния носителей и вывести энергии межзонных переходов, однозонное уравнение Шредингера для эффективной массы было решено в декартовых координатах методом конечных элементов, предоставленным программным обеспечением COMSOL Multiphysics [25]:
$$ - \ frac {{\ mathrm {\ hslash}} ^ 2} {2} \ nabla \ left (\ frac {1} {m ^ {\ ast} \ left (\ overrightarrow {r} \ right)} \ mathrm {\ nabla \ uppsi} \ left (\ overrightarrow {r} \ right) \ right) + V \ left (\ overrightarrow {r} \ right) \ uppsi \ left (\ overrightarrow {r} \ right) =E \ uppsi \ left (\ overrightarrow {r} \ right) $$ (5)E представляет энергию носителя, а ψ - соответствующая волновая функция. м * эффективная масса носителя, ћ - приведенная постоянная Планка, \ (\ overrightarrow {r} \) - трехмерный вектор координат, а V - потенциал удержания носителя (разрыв полосы). Чтобы упростить процедуру расчета электронной структуры КТ, мы приняли приближение постоянной деформации [26, 27] вместо дорогостоящего в вычислительном отношении подхода атомного моделирования, который, очевидно, мог бы дать большую точность в профиле распределения деформации [28, 29]. Действительно, мы считаем, что потенциал ограничения носителей в КТ, деформированной при сжатии, достаточно глубок, чтобы минимизировать влияние неоднородности деформации на состояния, ограниченные электронами [27]. Кроме того, края зоны проводимости, которые являются наиболее важными параметрами в этой работе, позволяющими исследовать прямолинейность запрещенной зоны, смещаются только из-за гидростатической деформации, поскольку они менее чувствительны к неоднородности деформации, особенно когда рассматривается относительно низкое рассогласование решеток. [30].
Результаты и обсуждение
Поскольку нас в основном беспокоит влияние деформации вокруг КТ GeSn, содержание Sn в КТ зафиксировано на уровне 28%, а состав Si в GeSiSn - на уровне 35%; поэтому исследование сосредоточено на влиянии барьерного состава Sn ( x б ) колебание от 6 до 22%. Результирующая деформация в плане либо в слое GeSiSn, либо в КТ GeSn показана на рис. 1а.
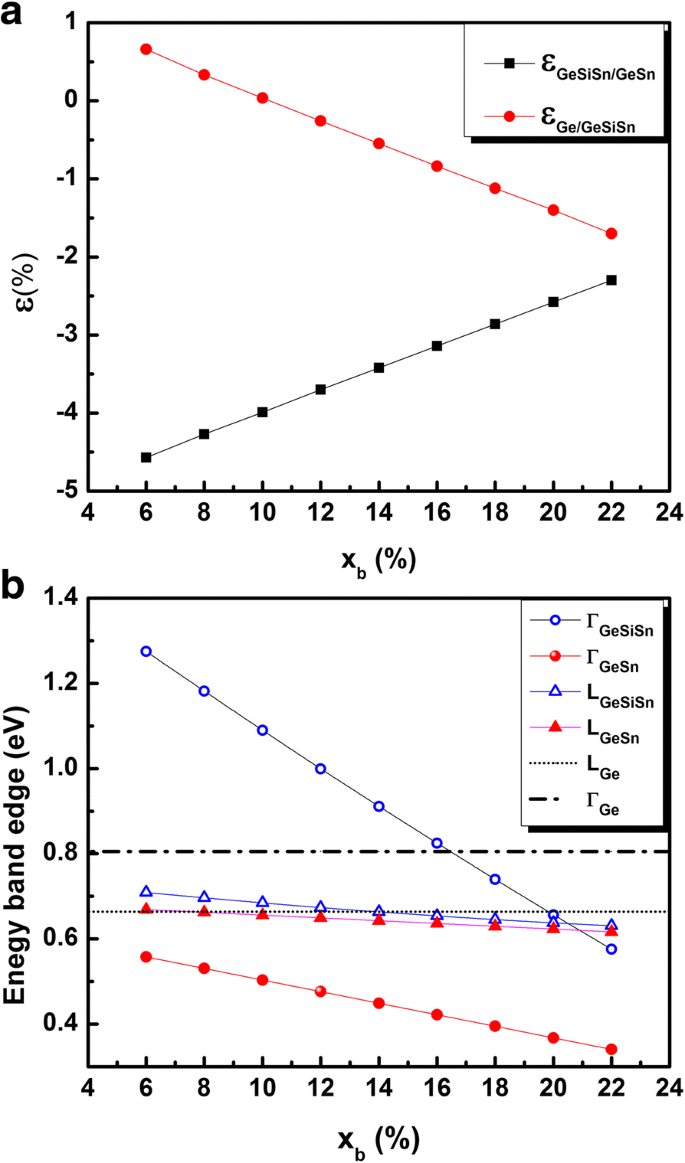
а Несоответствие решеток Ge 0,65- xb Si 0,35 Sn xb и Ge (закрашенные кружки) и между Ge 0,72 Sn 0,28 и Ge 0,65- xb Si 0,35 Sn xb (закрашенные квадраты) как функция от x б . б Края полос в впадинах L и G для Ge 0,65- xb Si 0,35 Sn xb , Ge 0,72 Sn 0,28 , и Ge как функция от x б
Деформация в плане в двумерном слое материала GeSiSn колеблется в пределах 0,6% ( x б =6%) и - 1,7% ( x б =22%). Мы предполагаем, что этот слой остается псевдомеорфно напряженным, что позволяет сохранить экспериментальную реализуемость разработанной структуры. GeSn выбирается для деформации сжатия в окружающем материале GeSiSn с рассогласованием решеток от - 2,3 до - 4,5%, обеспечивая благоприятные условия для образования самоорганизованных квантовых точек GeSn.
На рис. 1б показана зависимость деформированной запрещенной зоны в точках L и Γ от Ge 0,72 Sn 0,28 и Ge (0,65- xb ) Si 0,35 Sn xb как функция от x б . Долина Γ Ge 0,72 Sn 0,28 Материал остается ниже L долин, что свидетельствует о его типе I для всего исследованного диапазона оловянного барьерного состава. Между тем, когда учитывается ограничение электронов, эффективная ширина запрещенной зоны увеличивается, и размерный эффект квантовых точек становится решающим [18], особенно для сильно напряженных квантовых точек. Действительно, при наличии размерного квантования вместо минимума Γ-зоны следует рассматривать энергию основного состояния. Соответственно, ожидается, что квантовые точки меньшего размера будут иметь более высокие ограниченные уровни энергии в Γ-долине, которые могут превышать L-долину (и / или уровень энергии электронов основного состояния в L-долине). Поэтому важно исследовать диапазон размеров квантовых точек в соответствии с конкретными критериями непосредственности.
Смоделированная структура схематично представлена на рис. 2. Ge 0,72 Sn 0,28 Считается, что КТ имеет форму купола с круглым основанием диаметром D . от 15 до 40 нм и фиксированное отношение высоты к диаметру, равное 0,25. КТ расположена внутри слоя GeSiSn толщиной 15 нм, имеющего состав Si 35% и регулируемый состав Sn. Эта структура должна быть сформирована на подложке с буфером Ge и покрыта слоем Ge.
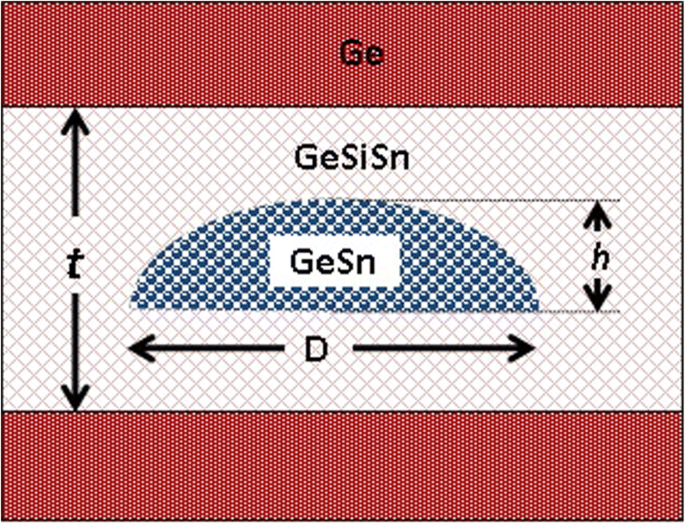
Схематическое изображение смоделированной КТ GeSn высотой ( h ) и диаметром ( D ) внутри деформационного слоя GeSiSn в матрице Ge
Чтобы обеспечить согласованный дизайн квантовых точек для лучшей работы светоизлучающего устройства, был введен подходящий параметр прямолинейности, учитывающий энергетический интервал между нижним положением ограниченного уровня энергии квантовых точек в L- и G-долинах [18]. Этот параметр обозначается GS L -GS Γ и должна быть выше тепловой энергии при комнатной температуре, чтобы избежать потери носителей при термической активации, где GS L (GS Γ ) представляет собой уровень энергии основного состояния электрона в L-долине (Γ-долине) относительно максимума валентной зоны. Оценка GS L -GS Γ схематично проиллюстрировано на вставке к рис. 3.
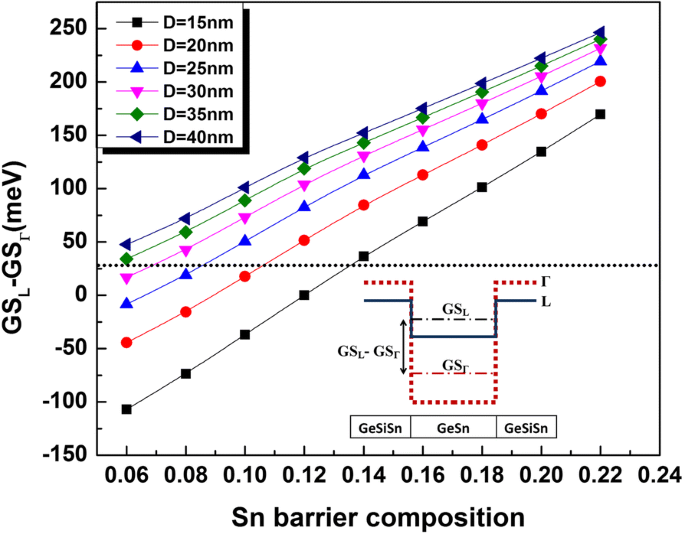
Параметр непосредственности (GS L -GS Γ ) как функция Ge 0,72 Sn 0,28 Размер КТ и Sn-состав Ge 0,65- x Si 0,35 Sn x окружающий слой. Пунктирная линия указывает тепловую энергию при комнатной температуре. Вставка представляет собой схематическое определение параметра непосредственности
Расчет уровней энергии электронов КТ GeSn в долинах Γ и L для разных диаметров в зависимости от состава Sn в GeSiSn позволяет получить соответствующий параметр прямолинейности (GS L -GS Γ ). Результаты представлены на рис. 3. Для заданного x б , значение GS L -GS Γ в основном определяется размером квантовых точек. Соответственно, для меньших точек с явно более высокими ограниченными энергетическими состояниями требуется меньшая энергия запрещенной зоны за счет уменьшения деформации для выполнения критериев прямолинейности. Как показано на рис. 3, большие точки ( D > 25 нм) удовлетворяют требованиям GS L -GS Γ > 26 мэВ для x б выше 8%. Однако обнаружено, что эффективная прямая запрещенная зона из квантовых точек небольшого размера обеспечивается для более высоких значений x б ( x б ≥ 14% для D =15 нм).
В пределах параметров, принятых в этой работе, и особенно параметров изгиба бинарных материалов, увеличение содержания Sn в материале GeSiSn уменьшает пятно вокруг КТ, а также уменьшает ширину запрещенной зоны окружающего материала. Действительно, как показано на рис. 1b, увеличение x б от 6 до 22% уменьшает разрыв зоны проводимости в Γ-долине с 0,72 эВ до 0,23 эВ. Действительно, как показано на рис. 4, где квадрат волновой функции \ ({\ left | \ uppsi \ left (\ overrightarrow {r} \ right) \ right |} ^ 2 \) электрона в основном состоянии в квантовых точках Диаметр 35 нм показан в плане xy для барьерного состава Sn 6% и 22%, электроны оказываются полностью локализованными внутри КТ независимо от состава барьера (неоднородность зоны проводимости). Сильно ограниченные электроны указывают на более высокую надежность исследуемой КТ как активной среды для светоизлучателей на подложке Si.

Квадратная волновая функция основного состояния электрона для Ge диаметром 35 нм 0,72 Sn 0,28 QD для a Xb =6% и b Xb =22%
Ограничивая размеры QD для данного x б Для тех, кто обеспечивает эффективное прямое запрещенное излучение, мы оценили длину волны межзонного излучения в основном состоянии КТ. Результаты показаны на рис. 5, где длина волны излучения отложена в зависимости от x . б для разных размеров КТ. Стоит отметить, что наибольший размер КТ, рассмотренный в данной работе ( D =40 нм) показал небольшое энергетическое разделение между основным состоянием электрона и первым возбужденным состоянием (ниже 26 мэВ) и поэтому не учитывался в данном исследовании. Тем не менее, рассчитанная длина волны излучения как функция от x б сохранен на рис. 5 пунктирной линией.
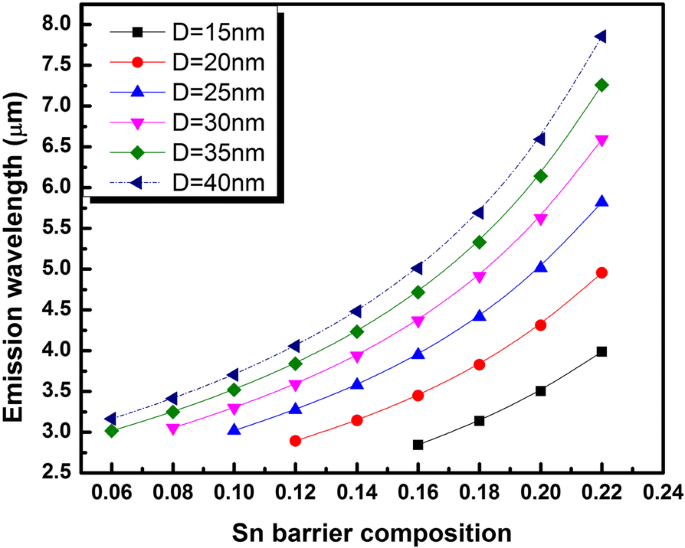
Длина волны излучения в основном состоянии при комнатной температуре из прямой запрещенной зоны Ge 0,72 Sn 0,28 КТ как функция размера и состава Sn в Ge 0,65- xb Si 0,35 Sn xb окружающий слой
Предполагаемый диапазон длин волн, охватываемый предлагаемой конструкцией квантовых точек, составляет от 3 до 7 мкм. Полученный диапазон чрезвычайно важен для измерения газа. Экспериментальная реализация этой структуры может дать возможность впервые покрыть весь средний ИК-диапазон полностью совместимым материалом с существующей микроэлектронной технологией, открывая путь к новым перспективам в оптоэлектронике среднего ИК-диапазона на основе КМОП-совместимых квантовых точек.
Выводы
КТ GeSn в слое инженерии деформации GeSiSn на матрице Ge были исследованы в зависимости от размера КТ и рассогласования кристаллической решетки с окружающим материалом. Было обнаружено, что уменьшение деформации вокруг КТ GeSn путем изменения состава Sn в барьерном материале GeSiSn увеличивает длину волны излучения типа I с прямой запрещенной зоной с 3 до 7 мкм. Разработанная структура открывает новые перспективы для излучателей среднего ИК-диапазона, полностью совместимых с технологией Si.
Сокращения
- CMOS:
-
Комплементарный металл-оксид-полупроводник
- GS L :
-
Уровень электронов в основном состоянии в L-долине
- GS Γ :
-
Уровень электронов в основном состоянии в Γ-долине
- QD:
-
Квантовые точки
Наноматериалы
- N, N-диметилформамид, регулирующий флуоресценцию квантовых точек MXene для чувствительного определения Fe3 +
- Дизайн эмиссионного слоя для электронных умножителей
- Синтез квантовых точек ZnSe / CdS / ZnS Core / Shell с подавленной реабсорбцией и их применение для иммуносорбентного ана…
- Синтез обогащенных пиридином N, S-углеродных квантовых точек как эффективных имитаторов ферментов
- Квантовые точки висмута в отожженных квантовых ямах GaAsBi / AlAs
- Биполярные эффекты в фотоэдс метаморфных квантовых точечных гетероструктур InAs / InGaAs / GaAs:характеристика и кон…
- Зеленый синтез квантовых точек InP / ZnS Core / Shell для применения в светоизлучающих диодах, не содержащих тяжелых м…
- Простой подход к синтезу флуоресцентных квантовых точек углерода из сточных вод тофу
- Дизайн для производства печатных плат
- Советы по проектированию для 3D-печати с прямым лазерным спеканием металла



