Квантовые точки висмута в отожженных квантовых ямах GaAsBi / AlAs
Аннотация
Сообщается об образовании нанокристаллов висмута в слоях GaAsBi, выращенных методом молекулярно-лучевой эпитаксии при температуре подложки 330 ° C и постростовых отжигах при 750 ° C. Сверхрешетки, содержащие чередующиеся слои GaAsBi и AlAs толщиной 10 нм, выращивались на полуизолирующей подложке GaAs. Слои AlAs служили диффузионными барьерами для атомов Bi, и размер нанокластеров, зародившихся после отжига образца, коррелировал с толщиной слоев висмида. Измерения энергодисперсионной спектроскопии и комбинационного рассеяния света показали, что наночастицы преимущественно состоят из атомов Bi. После отжига наблюдался сильный сигнал фотолюминесценции с длинами волн фотонов от 1,3 до 1,7 мкм; его амплитуда увеличивалась с увеличением количества слоев GaAsBi. Наблюдаемая полоса фотолюминесценции может быть связана с излучением нанокристаллов Bi. Проведенные теоретические оценки подтверждают это предположение. Они показывают, что из-за квантового размерного эффекта наночастицы Bi переходят в прямозонное полупроводниковое состояние.
Фон
Гетероструктуры на основе GaAsBi имеют большой потенциал для оптоэлектронных приложений в широком спектральном диапазоне от ближнего до среднего инфракрасного диапазона. GaAsBi представляет собой полупроводниковое соединение III – V группы, которое активно исследуется для создания излучателей инфракрасного излучения на основе GaAs [1] и детекторов [2,3,4,5]. Светодиоды с активными слоями GaAsBi, излучающими на длинах волн ~ 987 нм (при содержании Bi 1,8%), были описаны Lewis et al. [6]; о электрически инжектированном лазере на висмиде с ~ 6% Bi в многоквантовой яме (МКЯ) GaAsBi / GaAs сообщалось в [4]. [7]. Основная трудность в этой области заключается в увеличении плотности центров безызлучательной рекомбинации из-за низких температур подложки, необходимых для молекулярно-лучевой эпитаксии (МЛЭ) роста слоев GaAsBi с содержанием Bi более 5%. Одной из стандартных технологических процедур, позволяющих снизить скорость безызлучательной рекомбинации, является постростовой отжиг при более высоких температурах, чем те, которые используются для роста МЛЭ. Однако в случае GaAsBi эффект отжига неоднозначен. Ранее нашей группой было показано [8, 9], что отжиг при температурах выше 600 ° C приводит к нескольким новым особенностям, наиболее нетривиальной из которых является появление в некоторых образцах достаточно интенсивной фотолюминесценции (ФЛ). в диапазоне длин волн от 1,35 до 1,5 мкм, этот процесс сопровождается существенными изменениями эпитаксиального слоя GaAsBi - уменьшением содержания Bi в кристаллической решетке и появлением кластеров нанометрового размера [9].
Рост наноструктур - нанопроволок, напряженных квантовых ям или квантовых точек (КТ) - является популярным способом устранения несоответствия решеток между подложкой и эпитаксиальным слоем, выращенным на ней. Наиболее широко изученными примерами квантовых точек на основе соединений AIIIBV являются квантовые точки на основе InGaAs- [10] и InGaN- [11], выращенные методом Странского – Крастанова [12]. В случае GaAsBi такой механизм роста до сих пор не реализован. Зарождение связанных с Bi кластеров в отожженных эпитаксиальных слоях GaAsBi и их структурные характеристики систематически исследовались в [4]. [13]. Показано, что нанокластеры различной кристаллической структуры и состава - ромбоэдрические As и Bi, а также нанокластеры GaAsBi с цинковой обманкой - зарождаются в слоях висмида при отжиге; их размер колеблется от 5 до 20 нм. Ромбоэдрические кластеры чистого висмута наблюдались в GaAsBi с относительно большим содержанием Bi (4,7%), выращенном при низкой температуре (200 ° C) [13]. В нашей предыдущей работе [9] сообщалось об образовании кластеров Bi нанометрового размера в высокотемпературном отожженном GaAsBi с содержанием Bi более 6%. Более того, предполагалось, что из-за эффектов размерного квантования нанокластеры висмута становятся полупроводниковыми, а не полуметаллическими (как в случае объемных кристаллов Bi), и что излучательная рекомбинация, происходящая в кластерах Bi, может быть ответственны за длинноволновое излучение, наблюдаемое в отожженных образцах GaAsBi [9].
В настоящей работе сообщается об образовании нанокристаллов Bi в отожженных квантовых ямах GaAsBi / AlAs. Слои AlAs служили барьерами как для удержания носителей заряда, так и для предотвращения диффузии Bi из слоев GaAsBi во время процедуры отжига. Наличие слоев AlAs обеспечивает зарождение наночастиц Bi более контролируемым образом - их распределение по размерам было более узким, а их плотность была выше, чем в отожженных объемных слоях [9]. Полученные образцы были охарактеризованы методами просвечивающей электронной микроскопии высокого разрешения (ПЭМВР), ФЛ и спектроскопии комбинационного рассеяния света. Результаты этих экспериментов указывают на присутствие чистых нанокристаллов Bi в отожженных гетероструктурах. Выполненные теоретические оценки подтверждают, что нанокристаллы Bi могут быть преобразованы с помощью эффектов размерного квантования в прямозонные полупроводники.
Методы
Структуры МКЯ GaAsBi / AlAs были выращены на полуизолирующих подложках GaAs (100) с использованием реактора МЛЭ SVT-A, оснащенного металлическими источниками Ga, Al и Bi, а также двухзонным источником крекинга для получения As 2 . Использовалась следующая схема роста МБЭ. Во-первых, буферный слой GaAs (около 100 нм) и первый барьер AlAs были выращены с использованием стандартного режима роста МЛЭ при высокой температуре 600 ° C. Затем рост прерывался и температура подложки понижалась для роста квантовых ям GaAsBi и барьеров AlAs. Для осаждения AlAs использовался режим миграционно-усиленной эпитаксии (MEE) при следующей последовательности роста:один монослой (ML) Al, перерыв на 5 с для миграции атомов III группы, затем подача 1 ML As [14, 15 ]. Наконец, структура МКЯ была покрыта покровным слоем GaAs толщиной 5 нм. Содержание Bi в слоях GaAsBi было определено по (200) -рефлексу ω-2Θ XRD-сканирования и составило около 7% для образцов после выращивания.
Для измерений были выбраны два разных образца МКЯ. Образец MQW A содержит три квантовые ямы GaAsBi толщиной 10 нм и одну квантовую яму GaAsBi (выращенные методом МПЭ при 330 ° C), разделенные барьерами из AlAs толщиной 20 нм (выращенные MEE при той же температуре). Образец MQW B содержит 20 квантовых ям со слоями GaAsBi шириной 10 нм, разделенными барьерами AlAs толщиной 4 нм, выращенными в условиях, аналогичных тем, которые использовались для роста образца A. Высокотемпературная обработка обоих образцов проводилась в печи быстрого термического отжига (RTA) при температуре 750 ° C в течение 180 с в атмосфере азота. Чтобы предотвратить потерю мышьяка из поверхностного слоя во время отжига, образцы были покрыты жертвенной пластиной из GaAs.
Анализ поверхности с помощью атомно-силовой микроскопии продемонстрировал отсутствие капель на поверхности как выращенных, так и отожженных структур МКЯ. Шероховатость покровного слоя GaAs была менее 1 нм. Структурные измерения наночастиц с высоким разрешением, образовавшиеся в МКЯ после отжига образцов, проводились с помощью ПЭМ FEI Tecnai G2 F20 X-TWIN с модулем STEM, оснащенного детектором рентгеновской энергодисперсионной спектроскопии (EDS) для элементной картографирование и детектор кольцевого темного поля под большим углом (HAADF) для получения изображений с Z-контрастом. Для подготовки образцов для ПЭМ-измерений использовался двухлучевой микроскоп FEI Helios Nanolab 650, оснащенный манипулятором Omniprobe.
На рис. 1 показано изображение A-образца методом STEM. На изображении явно видны многочисленные наночастицы, которые образовались в слоях квантовых ям (КЯ) GaAsBi после отжига. На изображении прослеживается очевидная корреляция между размером наночастиц и шириной слоев квантовых ям. Корреляция свидетельствует о том, что слои AlAs (наиболее темные области) эффективно действуют как барьеры, препятствующие диффузии атомов Bi из слоев GaAsBi. Элементное отображение EDS выбранной области образца, полученное одновременно с визуализацией HAADF, показывает (рис. 2), что сформированные нанокристаллы преимущественно состоят из атомов висмута.
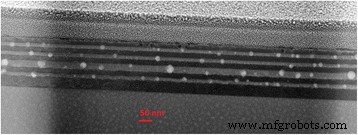
STEM-изображение A-образца с тремя квантовыми ямами GaAsBi толщиной 10 нм и одной толщиной 20 нм, выращенными методом МЛЭ, и барьерами из AlAs толщиной 20 нм после отжига при температуре 750 ° C в течение 180 с

Z-контрастное изображение HAADF – STEM нанокристаллов Bi в структурах МКЯ GaAsBi / AlAs ( выше ). Изображения EDS ( ниже ) представляют собой элементарное отображение интенсивностей Ga, Al, Bi и As, измеренных на отмеченной области изображения STEM
Результаты
Рамановская спектроскопия
Рамановские спектры исследованных образцов МКЯ GaAsBi регистрировались в геометрии обратного рассеяния на спектрометре Via Raman (Renishaw), оборудованном термоэлектрически охлаждаемой (−70 ° C) CCD-камерой и микроскопом. Для фотовозбуждения использовалась линия излучения твердотельного лазера с диодной накачкой на длине волны 532 нм. Для записи спектров комбинационного рассеяния использовались объектив с числовой апертурой 50 × / 0,75 и решетка 1800 линий / мм. Время накопления 400 с. Во избежание повреждения образца мощность лазера на образце была ограничена до 0,06 мВт. Рамановские частоты калибровали с использованием кремниевого стандарта (линия 520,7 см -1 ). Параметры колебательных мод определялись путем аппроксимации экспериментальных спектров компонентами гауссово-лоренцевой формы с использованием программы GRAMS / A1 8.0 (Thermo Scientific).
Рамановские спектры выращенного и отожженного образца GaAsBi / AlAs MQW A представлены на рис. 3. Интенсивный дублет, наблюдаемый в исходном образце (рис. 3, зеленая кривая) при 269 и 290 см -1 соответствует GaAs-подобным поперечным оптическим (TO) и продольным оптическим (LO) фононным модам соответственно [16,17,18]. В геометрии обратного рассеяния TO-полоса симметрично запрещена для идеального кристалла GaAs [17,18], но индуцированный Bi беспорядок кристаллической структуры нарушает симметрию кристаллической решетки GaAs и активирует TO-моду. Две другие широкие Bi-индуцированные колебательные моды видны вблизи 227 и 181 см −1 можно отнести к GaBi-подобным колебательным модам [18]. Присутствие барьеров из AlAs можно распознать в рамановском спектре по резкой моде гетеродина при 402 см −1 . [19].
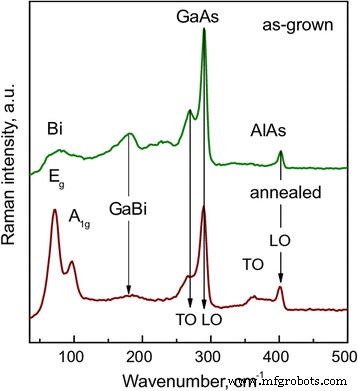
Рамановские спектры выращенного растения ( зеленая кривая ) и отожженные ( красная кривая ) GaAsBi MQW A-образец
Относительно короткий (180 с) термический отжиг образца при 750 ° C вызывает существенные изменения в спектре комбинационного рассеяния:(i) появляются интенсивные низкочастотные полосы при 72 и 96 см −1 , (ii) интенсивность полос около 269, 227 и 181 см −1 уменьшается, и (iii) широкая деталь около 361 см −1 появляется в спектре отожженного образца. Две низкочастотные полосы на 72 и 96 см −1 хорошо соответствуют E g и A 1 г моды кристаллического висмута [20,21,22,23,24]. Появление этих полос вместе с уменьшением интенсивности GaBi-подобных полос, индуцированных Bi, при 269 и 181 см −1 Показано, что термический отжиг приводит к изъятию висмута из узлов решетки GaAsBi и его агломерации в нанокристаллы Bi. Более того, образование нанокристаллов висмута также влияет на кристаллическую структуру слоев AlAs, что очевидно из роста широкой дефектной особенности TO около 361 см −1 [25].
Измерения фотолюминесценции
Измерения температурно-зависимой фотолюминесценции (ФЛ) проводились с помощью монохроматора с фокусным расстоянием 500 мм (Andor SR-500i) вместе с фотоприемником InGaAs, охлаждаемым жидким азотом. В качестве источника возбуждения использовался твердотельный лазер с диодной накачкой на длине волны 532 нм при мощности возбуждения 38 мВт. Образцы устанавливались на холодном пальце гелиевого криостата замкнутого цикла, соединенного с регулятором температуры, что позволяло проводить измерения в диапазоне температур 3–300 К.
Спектры ФЛ отожженного A-образца, содержащего три квантовые ямы GaAsBi толщиной 10 нм и одну квантовую яму GaAsBi толщиной 20 нм, измеренные при различных температурах, представлены на рис. 4а. Можно выделить два основных набора спектральных особенностей ниже запрещенной зоны GaAs. Сильный высокоэнергетический пик около 1,35 эВ может быть отнесен к излучательным переходам в квантовых ямах GaAsBi. Положение пика близко к тому, что наблюдается в GaAs 0.979 Bi 0,021 / GaAs [26] и коррелирует с данными XRD, которые показали содержание Bi 2,1% в слоях квантовой ямы GaAsBi A-образца после его отжига. Спектральные особенности в области низких энергий 0,6–1,05 эВ появляются в спектрах ФЛ после термического отжига образца и, следовательно, могут быть отнесены к оптическим переходам в нанокристаллах Bi. Полоса низкоэнергетической ФЛ имеет внутреннюю структуру, проявляющуюся при низких температурах. А именно на T =3 К можно выделить компоненты ФЛ при 0.67, 0.88 и 0.98 эВ. Как видно из рис. 4а, при температуре жидкого гелия сигнал ФЛ от квантовых ям GaAsBi на два порядка больше, чем полоса низкоэнергетической ФЛ. Однако пик высокоэнергетической ФЛ быстро уменьшается с повышением температуры, а пик низкоэнергетической ФЛ начинает преобладать при T > 100 тыс.

Температурно-зависимые спектры ФЛ отожженного a A-образец, состоящий из трех квантовых ям GaAsBi / AlAs шириной 10 нм и одной шириной 20 нм и b B-образец, состоящий из 20 квантовых ям GaAsBi / AlAs шириной 10 нм
Спектры ФЛ образца B, содержащего двадцать квантовых ям GaAsBi толщиной 10 нм, разделенных барьерами AlAs толщиной 4 нм, представлены на рис. 4б. Перед термическим отжигом, как и в случае с образцом A, образец B проявлял только более высокоэнергетичную полосу фотолюминесценции, связанную с квантовой ямой. Сильный низкоэнергетический пик ФЛ около 0,85 эВ наблюдался после термического отжига и, следовательно, можно предположить, что он может быть связан с излучением нанокристаллов Bi. Интенсивность низкоэнергетического пика в B-образце выше, чем в A-образце, и увеличивается с увеличением количества квантовых ям. При низких температурах можно проследить три компонента пика, которые хорошо разрешены в A-образце. Однако в B-образце в пике низкоэнергетической ФЛ преобладает ее составляющая 0,85 эВ во всем исследованном диапазоне температур. Положение пика ФЛ с более высокой энергией, связанного с квантовой ямой, немного смещено в сторону более низких энергий относительно его положения в A-образце в соответствии с данными XRD, которые указывают на 2,8% Bi в слоях квантовых ям B-образца после его термический отжиг. В B-образце пик ФЛ, связанный с КЯ, показывает его внутреннюю структуру. Пик состоит из связанной компоненты, связанной с экситоном, при примерно 1,27 эВ, которая доминирует при низких температурах, и компоненты, связанной с делокализованными экситонами, которая расположена при примерно 1,35 эВ и доминирует при более высоких температурах. Внутренняя структура пика, связанного с КЯ, приводит к характерной температурной зависимости S-типа положения пика ФЛ (сплошные точки на рис. 5), которая наблюдалась ранее как в объемных GaAsBi [27], так и в квантовых ямах GaAsBi / GaAs. [26]. Пик ФЛ, расположенный при низких энергиях фотонов, показывает гораздо более слабую температурную зависимость (светлые точки и кривая на рис. 5), которую можно описать функцией Варшни E ( Т ) = E (0) - αT 2 / ( β + Т ) с параметрами α и β равными 10 −4 эВ / град и 100 К соответственно. Следует отметить, что значение параметра α, ответственного за изменение запрещенной зоны с температурой, намного меньше, чем его стандартные значения для большинства полупроводников, 3 ° 10 −4 –5 ° 10 −4 эВ / град. Это делает матрицу нанокристаллов Bi важной потенциальной системой для источников света, излучающих на длинах волн в телекоммуникационных сетях и обладающих низкой температурной чувствительностью.

Температурные зависимости спектрального положения полос высокоэнергетической и низкоэнергетической ФЛ для отожженного B-образца, состоящего из двадцати квантовых ям GaAsBi / AlAs шириной 10 нм
Обсуждение
Измерения HRTEM, EDS и рамановской спектроскопии, проведенные в настоящем исследовании, показывают, что нанокристаллы Bi (квантовые точки) выделяются в слоях GaAsBi после термического отжига образцов GaAsBi / AlAs MQW, выращенных методом низкотемпературной MBE. Можно предположить, что эти нанокристаллы ответственны за длинноволновую полосу фотолюминесценции, которая проявляется в отожженных образцах. Хотя объемный висмут является полуметаллическим, небольшие эффективные массы носителей заряда Bi приводят к раннему проявлению эффектов квантового ограничения в наноструктурах на основе Bi. Фактически, одно из первых экспериментальных наблюдений эффектов размерного квантования было зарегистрировано для тонких слоев Bi [28]. Переход от полуметалла к полупроводнику в тонких пленках Bi, d <30 нм, экспериментально наблюдалось в [5]. [29]. Переход был обнаружен также в нанопроволоках Bi диаметром менее 65 нм [30, 31]. В обоих случаях полупроводниковое состояние было идентифицировано по измерениям электрических характеристик, зависящих от температуры. Квантовый размерный эффект в наночастицах висмута был впервые исследован с помощью спектроскопии потерь энергии электронов [32], а переход от полуметалла к полупроводнику был обнаружен в наночастицах Bi диаметром менее 40 нм. Недавно сообщалось о переходе в прямое полупроводниковое состояние [33] для коллоидных наночастиц Bi размером 3,3 нм.
В чистом Bi основные долины электронов и дырок расположены на L и T точки зоны Бриллюэна и соответствуют эллипсоидальным изоэнергетическим поверхностям (табл.1). Основное состояние электронов (дырок) эллипсоидальной долины в сферической квантовой точке можно приблизительно оценить как
$$ W =\ frac {\ pi ^ 2 {\ hslash} ^ 2} {2 \ overline {m} {r} _0 ^ 2} \. $$ (1)Здесь r 0 - радиус КТ, а \ (\ overline {m} \) - средняя обратная эффективная масса,
$$ \ frac {1} {\ overline {m}} =\ frac {1} {3} \ left (\ frac {1} {m_1} + \ frac {1} {m_2} + \ frac {1} { m_3} \ right), $$ (2)м 1 , м 2 , и м 3 - главные эффективные массы эллипсоидальной долины.
Феноменологическая формула (1) дает близкую оценку основного уровня энергии ε 1 в бесконечно глубокой сферической КТ при произвольных соотношениях эффективных масс. В самом деле, это точно, ε 1 = Вт , в случае сферической изоэнергетической поверхности ( m 1 = м 2 = м 3 ), предсказывает ε 1 энергия с точностью до 12%, ε 1 ≈ 0,88 Вт , и 25%, ε 1 =0,75 Вт , в предельных случаях сильно вытянутой сфероидальной долины ( м 1 = м 2 , м 3 → ∞) и сильно сплюснутой сфероидальной ( m 1 = м 2 , м 1 → ∞) соответственно. Следовательно, при произвольных значениях основных эффективных масс формула (1) аппроксимирует основную энергию КТ с точностью лучше 25%.
Формула (1) позволяет легко вычислить эффективные энергетические щели в квантовых точках висмута, E g, eff = E g + W e + W h , где E g - запрещенная зона в массивном кристалле и W e и W h - энергии размерного квантования электронов и дырок (1). Расчетная эффективная T и L энергетические щели графически представлены на рис. 6. (Масса электронов и дырок при обоих значениях T и L предполагалось, что баллы равны.)

Эволюция энергетического спектра КТ Bi с уменьшением ее размера ( r 0 и d - радиус и диаметр КТ)
В массивном полуметаллическом висмуте минимум зоны проводимости L долина на 38 мэВ ниже T максимум валентной зоны. Когда размер частиц Bi уменьшается, ширина запрещенной зоны эффективной энергии на уровне L точка увеличивается быстрее, чем в точке T точки из-за меньших эффективных масс L -долина, что в конечном итоге приводит к переходу от полуметалла к полупроводнику ( i -точка пересечения на рис. 6). Сначала нанокристалл висмута становится непрямым полупроводником с самым низким минимумом зоны проводимости на L точке и наивысшего максимума валентной полосы при T точка. При дальнейшем уменьшении размера КТ края валентной зоны и зоны проводимости будут выходить на T указывает на то, что Bi QD становится прямозонным полупроводником ( d -точка пересечения на рис. 6).
Следует отметить, что на рис. 6 представлена лишь грубая схема энергетического спектра, поскольку в схеме не учитываются эффекты непараболичности и предполагаются бесконечные энергетические барьеры для квантовых точек. Отклонение от параболического закона дисперсии существенно для L -долина (см., например, [34]). Действительно, эффективные массы на L -центры долин примерно в пять раз меньше их значений при энергии Ферми (которые использовались для расчета энергетического спектра, представленного на рис. 6). С другой стороны, эффекты непараболичности слабее при T точки, где ширина запрещенной зоны больше, и, следовательно, представленное эффективное T энергетический зазор (рис. 6) можно рассматривать как его соответствующую оценку.
Выше мы предположили, что низкоэнергетический пик ФЛ при ~ 0,85 эВ обусловлен оптическими переходами, происходящими в нанокристаллах Bi диаметром около 10 нм. Представленные расчеты для d =10 нм квантовые точки предсказывают E g, eff =0,76 эВ, что находится в разумном согласии с экспериментом и, следовательно, поддерживает гипотетическое предположение о происхождении пика низкоэнергетической ФЛ.
Выводы
Таким образом, множественные многослойные структуры с квантовыми ямами GaAsBi / AlAs были выращены с помощью смешанного процесса MBE / MEE на подложках GaAs. После послеростового термического отжига структур при 750 ° C в квантовых ямах GaAsBi зародились многочисленные относительно низкодисперсные наночастицы. Измерения HRTEM, EDS и рамановской спектроскопии показывают, что нанокристаллы преимущественно состоят из висмута. Проведенные измерения фотолюминесценции выявляют дополнительный низкоэнергетический пик ФЛ ≈0,85 эВ, который появляется в отожженных образцах. Пик низкоэнергетической ФЛ предположительно может быть связан с оптическими переходами в нанокристаллах Bi, которые за счет квантово-размерных эффектов переходят в прямозонное полупроводниковое состояние. Проведенные оценки энергетического спектра квантовых точек Bi подтверждают это предположение. Для однозначного ответа требуется дальнейшая и более подробная экспериментальная и теоретическая работа.
Сокращения
- EDS:
-
Энергодисперсионная спектроскопия
- HAADF:
-
Кольцевое темное поле с большим углом
- HRTEM:
-
Просвечивающая электронная микроскопия высокого разрешения
- MBE:
-
Молекулярно-лучевая эпитаксия
- MEE:
-
Эпитаксия с миграционным усилением
- PL:
-
Фотолюминесценция
- QD:
-
Квантовая точка
- QW:
-
Квантовая яма
- RTA:
-
Быстрый термический отжиг
- STEM:
-
Сканирующая просвечивающая электронная микроскопия
- TO и LO:
-
Поперечные оптические и продольные оптические фононные моды соответственно
Наноматериалы
- N, N-диметилформамид, регулирующий флуоресценцию квантовых точек MXene для чувствительного определения Fe3 +
- Синтез обогащенных пиридином N, S-углеродных квантовых точек как эффективных имитаторов ферментов
- Зеленый синтез квантовых точек InP / ZnS Core / Shell для применения в светоизлучающих диодах, не содержащих тяжелых м…
- Простой подход к синтезу флуоресцентных квантовых точек углерода из сточных вод тофу
- Синтез водорастворимых квантовых точек сульфида сурьмы и их фотоэлектрические свойства
- Простой одностадийный сонохимический синтез и фотокаталитические свойства композитов на квантовых точках г…
- Устранение бимодального размера в квантовых точках InAs / GaAs для изготовления лазеров на квантовых точках 1,3 мк…
- Зависимость межчастичного переноса энергии от толщины оболочки в квантовых точках ZnSe / ZnSe, допированных евро…
- Межзонная фотопроводимость метаморфных квантовых точек InAs / InGaAs в окне 1,3–1,55 мкм
- Синтез и свойства водорастворимых квантовых точек CdTe, излучающих синий, Mn



