Зависимость структурных и электронных свойств четвертичного InGaNBi от состава
Аннотация
InGaNBi представляет собой привлекательный сплав, который может использоваться в фотонных устройствах видимого света и среднего инфракрасного диапазона для реализации возможной инженерии зонной структуры и, следовательно, повышения эффективности люминесценции. В настоящем исследовании структурные, электронные свойства, такие как ширина запрещенной зоны, энергия спин-орбитального расщепления и деформация подложки InGaNBi по сравнению с составами In и Bi, изучаются с использованием расчетов из первых принципов. Параметры решетки практически линейно увеличиваются с увеличением составов In и Bi. За счет легирования висмутом ширина запрещенной зоны четвертичного InGaNBi может охватывать широкий диапазон энергий от 3,273 до 0,651 эВ для Bi до 9,375% и In до 50%, что соответствует диапазону длин волн от 0,38 до 1,9 мкм. Расчетная энергия спин-орбитального расщепления составляет около 0,220 эВ для 3,125%, 0,360 эВ для 6,25% и 0,600 эВ для 9,375% Bi, соответственно. Мы также показали деформацию InGaNBi на GaN; это указывает на то, что путем корректировки составов In и Bi, InGaNBi может быть сконструирован на GaN с приемлемой деформацией.
Введение
В последние годы вюрцит (WZ) В x Га 1– x Сплавы N и квантовые ямы (КЯ) InGaN / GaN привлекли широкое внимание из-за их большого потенциала для разработки солнечных элементов, высокоэффективных светодиодов (LED) и лазерных диодов (LD) [1–10]. Обычно используемые [0001] -ориентированные In x Га 1– x КЯ N / GaN испытывают сильное встроенное электрическое поле, вызванное двухосным сжимающим напряжением In x Га 1– x N [11], что приводит к уменьшению энергии излучения квантовой ямы и силы осцилляторов электронно-дырочных пар. Кроме того, в In наблюдается высокая плотность геометрических дефектов. x Га 1– x Сплавы N, включая дефекты упаковки и продольные дислокации (ПД) [12]; эти ПД имеют большую корреляцию с центрами безызлучательной рекомбинации. Дефекты, утечка электронов и оже-рекомбинация - три источника падения эффективности In x Га 1– x N светодиодов, основной причиной которых является оже-рекомбинация [13].
Аналогичным образом, для инфракрасных диодов на основе GaAs уже предлагалось, что легирование висмута является эффективным методом уменьшения ширины запрещенной зоны ( E г ), а также усилить спин-орбитальное (SO) расщепление для достижения подавления процесса оже-рекомбинации [14]. Самый большой элемент группы V висмута обнаруживает привлекательные эффекты на физические свойства сплавов висмида. Изменения в зонной структуре сплавов висмида были исследованы как экспериментально, так и теоретически для различных материалов тройных сплавов, таких как AlNBi [15], GaNBi [16, 17], GaSbBi [18, 19], InPBi [20, 21], и InSbBi [19, 22–24]. Ширина запрещенной зоны модифицируется в основном из-за большой деформации, вызванной атомом Bi при высокой концентрации в InPBi. Включение Bi возмущает валентные зоны (VB) из-за взаимодействия примесных состояний Bi с зонами тяжелых / легких дырок и спин-орбитальными отщепленными зонами [21]. В последнее время большое внимание привлекли сплавы четвертичного бисмида (например, GaAsNBi [25–27], InGaAsBi [28, 29], GaAsPBi [30]). Локальные искажения вокруг атомов P и Bi вносят значительный вклад в запрещенную модификацию GaAsPBi. Требование к составу Ga As 1– x - г P y Би x для достижения более низкой степени оже-рекомбинации, чем у GaAs [30]. Комбинирование висмута и других атомов III или V увеличивает объем инженерии зонной структуры, включая контроль запрещенной зоны, спин-орбитальное расщепление, проводимость (CB) и смещения валентной зоны, а также деформацию [25]. Поэтому представляет значительный интерес описать влияние замещения Bi на [0001] In x Га 1– x N / GaN, настраивая структурные и электронные свойства и, следовательно, эффективность люминесценции. В настоящем исследовании с использованием расчетов из первых принципов [31] структурные, электронные свойства, такие как запрещенная зона, энергия спин-орбитального расщепления ( Δ ТАК ), а также субстратный штамм InGaNBi в сравнении с составами In и Bi. Принимая во внимание большое рассогласование решеток и низкое качество для содержания In выше 55–60% в образце InGaN [32], а также низкую растворимость висмута в сплавах с разбавленным висмидом, концентрации In и Bi контролируются до 50% и 9,375% соответственно. Работа организована следующим образом. В разделе «Методы» мы представляем подробные вычислительные методы. Структурные, электронные свойства и деформация подложки приведены в разделе «Результаты и обсуждение». Наконец, подведем краткое изложение.
Методы
Наши теоретические расчеты основаны на теории функционала плотности (DFT) [31], реализованной в коде VASP [33, 34]. При расчетах структурных свойств электрон-ионные и обменно-корреляционные взаимодействия обрабатываются с помощью метода расширенных волн проектора (PAW) [35, 36] и приближения обобщенного градиента (GGA) Perdew-Burke-Ernzerhof (PBE) [37] соответственно. Конфигурации валентных электронов для атомов In, Ga, N и Bi используются как 4 d 10 5 с 2 5 п 1 , 3 д 10 4 с 2 4 п 1 , 2 с 2 2 п 3 , и 5 d 10 6 с 2 6 п 3 , соответственно. Чтобы преодолеть недооценку потенциала PBE в запрещенной зоне электронных свойств, мы используем модифицированный обменный потенциал Беке-Джонсона в сочетании с корреляцией приближения локальной плотности (MBJLDA) [38]. Висмут имеет большой эффект спин-орбитальной связи (SOC), и поэтому SOC учитывается в электронных расчетах. Во всех расчетах структуры расслабляются до тех пор, пока силы, действующие на каждый атом, не станут меньше 0,02 эВ / Å, а максимальное изменение энергии не составит порядка 10 −4 . эВ. Ограничение плоской волны 450 эВ установлено для обеспечения точности расчетов. Пакет Monkhorst 4 × 4 × 4 k Точечная сетка принята в первой зоне Бриллюэна.
Результаты и обсуждение
Структурные свойства
Суперячейки состоят из 4 × 2 × 2 примитивной ячейки WZ-GaN, включающей 64 атома. Мы исследуем 36 композиций I нет y Га 1– y N 1– x Би x с 0≤ x ≤0,09375,0≤ y ≤0,5 на основе недавних экспериментов, в которых образец InGaN демонстрирует большое рассогласование решеток и низкое качество при содержании индия выше 55–60% [32], а также низкую растворимость висмута в сплавах с разбавленным висмидом. Рассмотрена одна типичная конфигурация, в которой атомы In и Bi распределены равномерно. Мы суммировали рассчитанные параметры решетки тройного In y Га 1– y N и четвертичный In y Га 1– y N 1– x Би x сплавов вместе с другими теоретическими и экспериментальными данными на рис. 1. Для чистого GaN параметры решетки a =3,211, c =5,235 Å, что хорошо согласуется с другими теоретическими расчетами a =3,155,3,22 Å, c =5,144,5,24 Å [39–41] и экспериментальные данные 3,19 Å для a , 5,19 Å для c [42]. Параметры решетки ( a , c ) из In y Га 1– y N повышается при увеличении состава In и показывает почти линейное изменение, как показано на рис. 1a. Настоящие расчеты предсказывают a =3,304 Å, c =5,365 Å для In 0,25 GaN и a =3,397 Å, c =5,509 Å для In 0,5 GaN, все они хорошо согласуются с предыдущими результатами a =3,33 Å, c =5,39 Å для In 0,25 GaN и a =3,43,3,485 Å, c =5,55,5,488 Å для I нет 0,5 GaN [39, 40, 43, 44]. В случае четверных сплавов In y Га 1– y N 1– x Би x Насколько нам известно, экспериментальных и теоретических значений структурных свойств не существует. На рис. 1б полученные параметры решетки также почти линейно увеличиваются с увеличением составов In и Bi. Из-за того, что ионные радиусы In и Bi больше, чем у атомов Ga и N, замена In на Ga и Bi на N приводит к увеличению параметров решетки InGaNBi.

Параметры решетки для a тройные сплавы In y Га 1– y N , с 0≤ y ≤0,5 и b четвертичные сплавы In y Га 1– y N 1– x Би x , с 0≤ x ≤0,09375, 0≤ y ≤0,5. Для сравнения добавим некоторые другие расчеты и экспериментальные данные из [5]. [39–44] на рис. 1а. Сплошная линия представляет a а пунктирная линия - c
Включение In и Bi нарушит периодичность кристаллов и внесет геометрическую деформацию в сильно легированную структуру. Выбираем In 0,25 GaN Би 0,0625 в качестве примера для статистики четырех химических связей, как показано на рис. 2; средние длины связей Ga-N, In-N, Ga-Bi и In-Bi составляют 2,009, 2,195, 2,592 и 2,704 Å соответственно. Обратите внимание, что длина связи Ga-N в исходном массивном GaN составляет 1,970 Å. Длина связи In-N больше, чем у Ga-N, что указывает на то, что атом In заметно отталкивает атом N. Точно так же большая длина связи Ga-Bi, чем Ga-N, означает, что атом Bi отталкивает атом Ga, обнаруживая хорошее соответствие с порядком ковалентных радиусов Ga (1,22 Å), In (1,42 Å), N (0,71 Å), и Bi (1,48 Å) [45]. Другие конфигурации демонстрируют аналогичное поведение. Деформация решетки и несоответствие электроотрицательности матрицы и допанта существенно влияют на электронные и оптические свойства.

Гистограмма длины облигации в дюймах 0,25 GaNBi 0,0625 . Значения на панели указывают среднюю длину четырех типов облигаций
Электронные ресурсы
Было показано, что функциональные или корректирующие потенциалы и эффект SOC сильно влияют на прогнозируемую точность ширины запрещенной зоны сплава III-V, валентной зоны и энергии спин-орбитального расщепления. Таким образом, мы подтверждаем наши результаты с использованием потенциала MBJLDA и сравниваем с другими теоретическими расчетами и экспериментами. Рисунок 3 представляет собой график зависимости энергии запрещенной зоны от состава In в In . y Га 1– y N, а также соответствие данным. Также нанесены на график некоторые значения ширины запрещенной зоны, полученные экспериментально, а также теоретические функционалы HSE06, mBJ и LMTO-CPA-MBJ. Прогнозируемая ширина запрещенной зоны GaN составляет 3,273 эВ, что хорошо согласуется с настоящими расчетами и экспериментами, 3,33 эВ по mBJ [40], 3,261, 3,23 эВ по HSE06 [39, 46] и 3,40–3,50 эВ по экспериментам [47–0]. 49]. Как отмечено в I нет y G а 1– y N, наши результаты DFT подтверждают, что E г значения I нет y G а 1– y N непрерывно уменьшается как y увеличивается с 0 до 50%. E г плавно уменьшается от 3,273 до 1,546 эВ. Это хорошо согласуется с теоретическими (HSE06, потенциалы mBJ) [39, 40, 46] и экспериментальными результатами [50, 51].
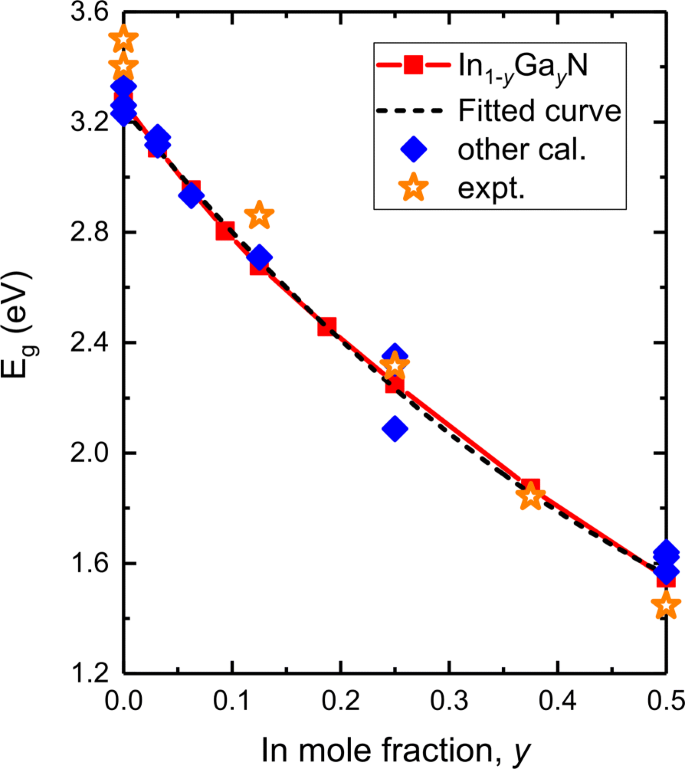
Прогнозируемая энергия запрещенной зоны ( E г , красная сплошная линия) как функция от состава In в I нет y G а 1– y N а также соответствие данным (черная пунктирная линия). Также нанесены другие теоретические [39, 40, 46] и экспериментальные [47–51] результаты.
Контурный график ширины запрещенной зоны четвертичного I нет y G а 1– y N 1– x Б я x Сплавы показаны на рис. 4. Ширина запрещенной зоны четверных сплавов демонстрирует нелинейный тренд в зависимости от состава, который уменьшается с увеличением содержания In и Bi. Из результатов мы находим, что запрещенная зона InGaNBi может охватывать широкий диапазон энергий от 3,273 до 0,651 эВ для Bi до 9,375% и In до 50%, что соответствует диапазону длин волн от 0,38 до 1,9 мкм, что указывает на их потенциальные оптоэлектронные приложения в прицел видимого света и среднего инфракрасного диапазона.

Контурный график значений ширины запрещенной зоны для I нет y G а 1– y N 1– x Б я x сплавы как функция Bi ( x ) и In ( y ) композиции
По сравнению с InGaN включение Bi вызывает более резкое уменьшение ширины запрещенной зоны. Но помимо этого, значительное увеличение Δ ТАК получается из-за сильного SOC-эффекта висмута, где развитое взаимодействие между электронным спином и орбитальным угловым моментом уменьшает энергию SO-зоны. Кроме того, улучшенный край валентной зоны, возникающий из-за антипересечения валентной зоны сплавов висмида, также в значительной степени увеличивает Δ ТАК [28]. Наше рассчитанное Δ ТАК значения составляют около 0,220 эВ для 3,125%, 0,360 эВ для 6,25% и 0,600 эВ для 9,375% Bi, соответственно, что незначительно варьируется в зависимости от доли индия. Предыдущие исследования показали, что различное расположение Bi имеет большое влияние на зонную структуру сплавов висмида, включая энергию спин-орбитального расщепления [21, 52]. Настоящие результаты показывают, что I нет 0,5 G а N Б я 0,09375 значение ширины запрещенной зоны (0,651 эВ) очень близко к значению Δ ТАК (0,577 эВ). Поскольку образец InGaN демонстрирует большое рассогласование решеток и низкое качество при содержании In выше 55–60% [32], а также низкую растворимость висмута в сплавах с разбавленным висмидом, мы установили содержание In до 50% и Bi до 9,375%. Мы полагаем, что более высокое содержание индия или висмута позволит достичь Δ ТАК > E г в четвертичном образце InGaNBi для повышения эффективности светодиодов и LD на основе InGaNBi.
Спроектированные зонные структуры и полная плотность состояний (TDOS) чистого GaN, I нет 0,25 GaN и I нет 0,25 G а N Б я 0,03125 Сплавы представлены на рис. 5. Вклады In и Bi выделены цветом:синий (красный) соответствует состоянию, происходящему из In (Bi). Замена In в I нет 0,25 GaN имеет большое влияние как на зону проводимости, так и на валентную зону, где минимум зоны проводимости (CBM) сдвигается к более низким энергиям относительно уровня Ферми и отражает более узкую запрещенную зону. В отличие от висмута, который вводит дефектную зону в запрещенную зону вблизи уровня Ферми, атомы In проявляют гибридизацию с глубоким уровнем VB. Для четвертичного сплава I нет 0,25 G а N Б я 0,03125 , можно ясно видеть, что уменьшение ширины запрещенной зоны является результатом как восходящего максимума валентной полосы (VBM), так и нисходящего CBM, а CBM изменяется более значительно по сравнению с I нет 0,25 GaN, что объясняется большей деформацией сжатия в InGaNBi из-за добавления висмута. Уровень дефекта, выделенный красным цветом, сильно взаимодействует с краем VB, что является результатом гибридизации, в основном, между Bi и ближними атомами Ga. TDOS на рис. 5e также отражает уровень локальных дефектов от -1,0 до -0,5 эВ.
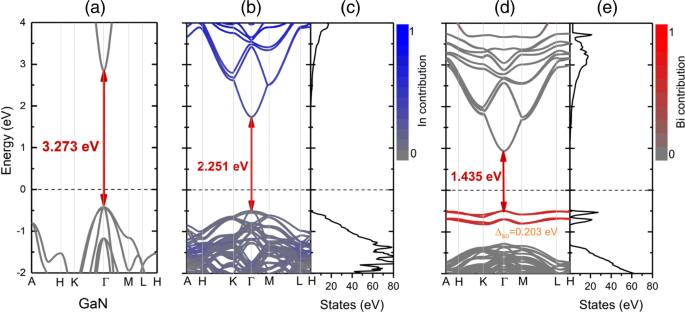
Спроецированные зонные структуры и соответствующая им полная плотность состояний (TDOS) a GaN, b , c Я нет 0,25 G а N , и d , e Я нет 0,25 G а N Б я 0,03125 . Черная пунктирная линия представляет уровень Ферми, равный нулю. Относительные вклады In и Bi выделены цветом:синий (красный) соответствует состоянию, происходящему из In (Bi)
Напряжение InGaNBi на GaN
[0001] -ориентированный I нет y G а 1– y Напряженные квантовые ямы N / GaN широко используются в современных светодиодных и LD-устройствах, в которых I нет y G а 1– y N-слои испытывают двухосное сжимающее напряжение. Локальные флуктуации состава и разные ковалентные радиусы атомов In и Ga вызывают деформации в I нет y G а 1– y N слоев [53]. На рис. 6 показана деформация InGaNBi на подложке из GaN. Поскольку атом индия больше атома галлия, атом висмута больше атома азота; таким образом, включение атомов In и Bi в InGaNBi вызывает деформацию сжатия InGaNBi на GaN. Показано, что при содержании 50% In и 9,375% Bi InGaNBi испытывает высокую деформацию сжатия 8,5%. Для фракции In в пределах 6,25% и фракции Bi в пределах 2,8% деформация InGaNBi на GaN находится в пределах 1%. То есть, регулируя составы In и Bi, InGaNBi может быть сконструирован на GaN с приемлемой деформацией.

Деформация сплавов InGaNBi на подложке GaN при различных значениях In (0–0,5) в зависимости от доли Bi. Положительные значения деформации указывают на то, что InGaNBi подвергается деформации сжатия
Выводы
Структурные, электронные свойства и деформация InGaNBi на GaN по сравнению с составами In и Bi исследованы на основе теории функционала плотности. Параметры решетки InGaNBi почти линейно увеличиваются с увеличением состава In и Bi. Поскольку атомы In и Bi имеют больший атомный радиус, чем атомы Ga и N, длины связей In-N и Ga-Bi больше, чем у Ga-N. Для электронных свойств мы показали контурный график ширины запрещенной зоны четвертичного I нет y G а 1– y N 1– x Б я x сплавы. Ширина запрещенной зоны четверных сплавов может охватывать широкий диапазон энергий от 3,273 до 0,651 эВ, для Bi до 9,375% и In до 50%, что соответствует диапазону длин волн от 0,38 до 1,9 мкм. Вычисленное Δ ТАК значения составляют около 0,220 эВ для 3,125%, 0,360 эВ для 6,25% и 0,600 эВ для 9,375% Bi, соответственно, что незначительно варьируется в зависимости от доли индия. Мы полагаем, что более высокий состав индия или висмута позволит достичь Δ ТАК > E г в четвертичном образце InGaNBi для повышения эффективности светодиодов и LD на основе InGaNBi. Анализ зонной структуры показывает, что индий имеет большое влияние как на CB, так и на VB, а висмут имеет сильное взаимодействие с краем VB. Наконец, мы исследуем деформацию InGaNBi на GaN. Регулируя составы In и Bi, InGaNBi может быть сконструирован на GaN с приемлемой деформацией.
Наноматериалы
- PPA, армированный углеродным волокном, для конструкционных автомобильных и электронных компонентов
- Структура и электронные свойства наноглины каолинита, легированной переходным металлом
- Модуляция свойств электронной и оптической анизотропии ML-GaS вертикальным электрическим полем
- Влияние контактной неравновесной плазмы на структурные и магнитные свойства шпинелей Mn Х Fe3 - X О4
- Оптические и электронные свойства фемтосекундных лазерно-индуцированных гипердопированных серой кремниевы…
- Структурные и оптические свойства в видимой и ближней инфракрасной области спектра TiO2, легированного хромом…
- Исследование структурных, электронных и магнитных свойств кластеров Ag n V (n =1–12)
- Зависимость токсичности наночастиц от их физических и химических свойств
- Свойства автомобильных печатных плат и рекомендации по проектированию
- Свойства и состав чугуна



