Многоуровневый мемристор на основе тонкой пленки HfO2, легированной алюминием
Аннотация
Энергонезависимая память (NVM) будет играть очень важную роль в цифровых технологиях следующего поколения, включая Интернет вещей. Металлооксидные мемристоры, особенно на основе HfO 2 , был одобрен многими исследователями из-за его простой структуры, высокой степени интеграции, высокой скорости работы, низкого энергопотребления и высокой совместимости с передовыми технологиями CMOS (комплементарный металл-оксид кремния). В этой статье 20-уровневое стабильное сопротивление состояний HfO 2 , легированного алюминием представлен мемристор на основе. Его продолжительность циклов, время сохранения данных и коэффициент сопротивления превышают 10 3 . ,> 10 4 s и> 10 соответственно.
Фон
Хотя явление отрицательного сопротивления было впервые обнаружено Хикмоттом в Al / Al 2 О 3 / Структура Au в 1962 г. [1], а концепция мемристора была предложена Чуа в 1971 г. [2]. Только после того, как Струков и др. Подготовили TiO 2 -на основе мемристоров в 2008 году [3], что люди начали обращать внимание на изучение мемристоров. В настоящее время исследователи подготовили мемристоры с более чем десятком активных резистивных материалов, включая множество сложных оксидов [4, 5], оксидов металлов, таких как ZnO [6], TiO x [7], TaO x [8], а также двумерные материалы [9, 10]. HfO 2 был использован в качестве диэлектрика затвора high-k в КМОП-устройствах благодаря своей высокой надежности, быстродействию и низкому энергопотреблению [11, 12]. Исследователи также предпочитают его как памятный материал [13,14,15].
Многоуровневый мемристор может широко использоваться в качестве хранилища данных [16,17,18], логического вычисления [19], электронного синаптического устройства [20,21,22,23] и так далее. Ван Ю. [16] и Гао Б. и др. [24] приготовили многоуровневые мемристоры путем допирования HfO 2 . с Cu и Gd, соответственно, но они могут создавать только 4-уровневое состояние хранения, что трудно удовлетворить требованиям приложений. Таким образом, исследование HfO 2 многоуровневые мемристоры имеют большое значение.
Методы
Ti / Al:HfO 2 Устройство / Pt было изготовлено, как показано на рис. 1а. Активная площадь ячейки определялась квадратным верхним титановым электродом (TE). Адгезивный слой Ti толщиной 20 нм был нанесен путем напыления на кремниевой подложке путем напыления на постоянном токе (DC), затем пленка Pt толщиной 100 нм была нанесена в качестве нижнего электрода (BE). HfO 2 , легированный алюминием с длиной волны 20 нм Функциональный слой наносился в реакторе осаждения атомных слоев (ALD) (R-150, Picosun, Espoo, Finland) при 300 ° C с MeCp 2 HfMe (OMe) (обозначается как HfD-04) как предшественник Hf, а H 2 O как источник кислорода [25]. Прекурсоры переносились высокочистым N 2 (> 99,999%) в камеру реактора. Пленки, легированные алюминием, получали нанесением за один цикл Al 2 О 3 каждые 8 циклов HfO 2 с триметилалюминием (ТМА) в качестве источника Al и H 2 O как источник кислорода. Атомная концентрация Al, равная 6,2%, определяется с помощью рентгеновской фотоэлектронной спектроскопии (XPS, Axis Ultra DLD, Kratos Analytical, Манчестер, Великобритания) на системе Theta 300 XPS от Thermo Fisher. Пленка Ti 50 нм в качестве TE и 100 нм Pt в качестве покрывающего слоя была нанесена методом напыления на постоянном токе. Устройства получают путем создания рисунка ТЕ с помощью оптической литографии и процесса отрыва. Рисунок 1b представляет собой оптическую микрофотографию устройств. Мы подготовили устройства с различной площадью от 5 мкм × 5 мкм до 500 мкм × 500 мкм.
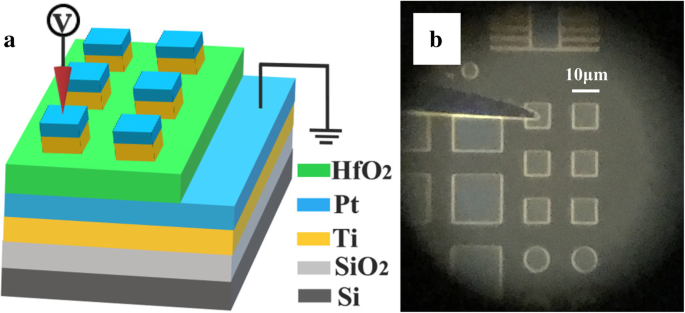
Состав устройств. а 3D модель мемристоров. б Оптическая микроскопия приборов
Результаты и обсуждение
На рис. 2 показаны РФЭС легированных и нелегированных устройств. По сравнению со спектрограммами нелегированных устройств, легированные алюминием устройства показывают отчетливый пик 74,1 эВ для Al 2p на рис. 2a, а энергия связи Hf 4f имеет некоторое увеличение на рис. 2b. Соотношение Hf 4f 5/2 в Hf 4f 7/2 также увеличился для легированных устройств. Это согласуется с другими сообщениями [14, 26, 27]. Атомы Al связываются со структурой HfO2 с образованием Hf-Al-O, что приводит к более слабым и более легко разрушаемым связям Hf-O.

РФЭС легированных и нелегированных устройств. а Al 2p и b Сравниваются Hf 4f
Для всех электрических измерений Ti TE был смещен, а Pt BE был заземлен. Свипирование по постоянному току выполняли с использованием анализатора параметров B1500A (Санта-Клара, Калифорния, США) с источником / измерительным блоком, также используются импульсные электрические измерения с помощью генератора сигналов / быстрого измерительного блока. Все устройства показывают высокоомное состояние (HRS) перед необходимым процессом электроформовки. На рис. 3а показаны характеристики формообразования для устройств размером 10 мкм × 10 мкм, легированных и нелегированных алюминием. Соблюдение силы тока во время формовки необходимо для защиты устройств от повреждения. Начальное сопротивление и формирующее напряжение у нелегированного устройства больше. Колебания в области низкого напряжения нелегированного устройства вызваны тем, что ток ниже предела измерения прибора. Процесс сброса после этапа формирования мотивируется приложением отрицательного напряжения, как показано на фиг. 3a, а затем активируется процесс первой установки. По мере увеличения амплитуды напряжения сброса ток обоих двух устройств увеличивается до максимального значения, превышающего ограниченный ток формования, а затем уменьшается. Токи HRS обоих устройств на несколько порядков больше, чем в исходном состоянии при том же напряжении. Это говорит о том, что все еще есть токопроводящая нить, которую нельзя полностью проплавить после сброса. Типичные вольт-амперные кривые установки / сброса на рис. 3b показывают, что оба этих устройства работают в биполярном режиме [28]. Коэффициент переключения и напряжение установки / сброса у легированного алюминием устройства меньше, чем у нелегированного устройства, но его процесс преобразования состояния сопротивления более щадящий и подходит в качестве многозначного запоминающего устройства.
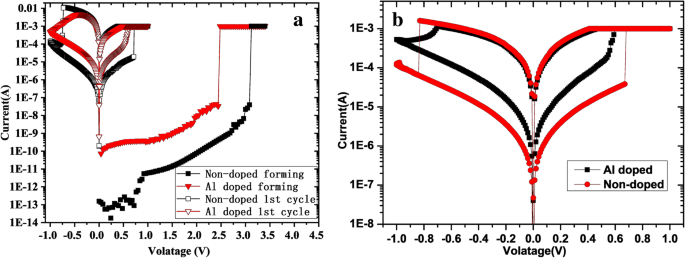
ВАХ устройств. а Процесс формирования и первый цикл. б Типичный процесс установки / сброса
Чтобы прояснить механизмы переключения устройств, ВАХ представлены в двойном логарифмическом масштабе на рис. 4. Для обоих типов устройств кривая низкого сопротивления демонстрирует линейное омическое поведение, что указывает на образование проводящих нитей в HfO 2 пленки во время их установки [29, 30]. Однако кривые высокого сопротивления для этих двух типов устройств сильно различаются. Для легированного устройства он состоит из трех областей:омической области (I∝V), области закона Чайлда (I∝V 2 ), и область резкого увеличения тока, которая соответствует типичной ВАХ для тока, ограниченного пространственным зарядом (SCLC), контролируемого ловушкой [31, 32]. Кривая высокого сопротивления нелегированного устройства состоит из двух областей:омической проводимости (I∝V) в области низкого напряжения и линейной аппроксимации lnI-V 1/2 в области высокого напряжения (вставка на рис. 4), подтверждая механизм эмиссии Шоттки [15, 33].
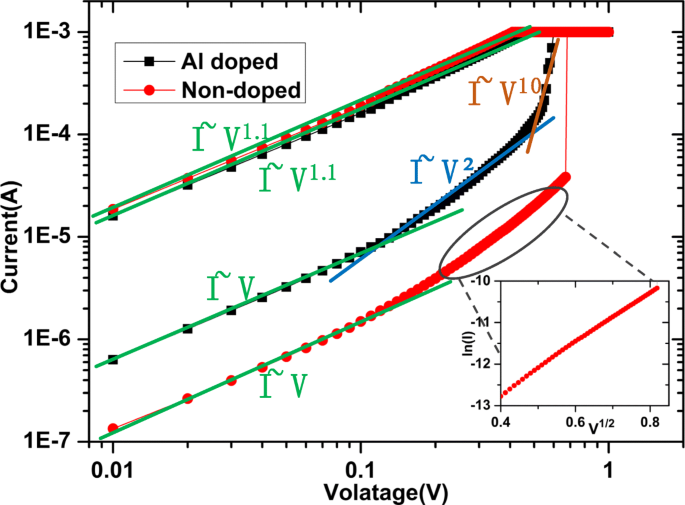
Подгонка кривой процесса SET в двойных логарифмических координатах
В соответствии с описанными выше особенностями микроскопические механизмы мемристоров можно кратко описать следующим образом. Для нелегированных устройств по мере увеличения положительного напряжения, приложенного к титановому электроду, в HfO 2 генерируется все больше и больше ионов кислорода. и двигаться к титановому электроду [34], производя оксид титана [35]. В то же время кислородные вакансии накапливаются на границе раздела между платиновым электродом и HfO 2 , постепенно образуя проводящие нити [36]. Следовательно, ток постепенно увеличивается с увеличением напряжения. Устройства переходят в низкоомное состояние (LRS), когда кислородные вакансии проводят нити, соединяющие TE и BE. Пока на титановый электрод подается отрицательное напряжение, ионы кислорода объединяются с кислородными вакансиями в HfO 2 / Pt [37], что приводит к меньшей концентрации кислородных вакансий и более высокому барьеру Шоттки. При достижении напряжения сброса проводящая нить накала разрывается, и устройство переключается на HRS.
Для устройств, легированных алюминием, атомы Al связываются со структурой HfO2 с образованием Hf-Al-O, что приводит к более слабым и более легко разрушаемым связям Hf – O. Снижена энергия образования кислородной вакансии. Следовательно, легирующие устройства имеют меньшее сопротивление и меньшее переходное напряжение. В нелегированных пленках кислородные вакансии имеют тенденцию накапливаться по границам зерен [38, 39]. В результате токопроводящих волокон мало и они толстые. Сопротивление устройств сильно зависит от проводимости и обрыва проводящих нитей. В легированных пленках кислородные вакансии легко образуются вблизи примесных атомов [35, 40, 41]. Равномерное распределение большого количества примесей в тонкой пленке делает более контролируемыми проводящие нити, образованные кислородными вакансиями. Следовательно, легче достичь нескольких значений сопротивления.
Устройства могут быть установлены в различные состояния устойчивого сопротивления, изменяя текущее соответствие установленного процесса. Двадцать стабильных состояний сопротивления получаются путем установки податливости тока от 0,5 мА до 10 мА с шагом 0,5 мА на рис. 5a. Поскольку состояния сопротивления устанавливаются с помощью развертки по постоянному току, потребление энергии велико, а работа усложняется. С другой стороны, значения сопротивления легко фиксируются в LRS, когда используется большая сила тока. Этот метод также не позволяет настроить HRS. Двадцать уровней сопротивления достигаются изменением амплитуды напряжения импульса установки и сброса. Чтобы избежать возможности перегрузки по току и сбоя при установке / сбросе, амплитуда напряжения ограничена между 1 В ~ 1,9 В для SET и - 1 В ~ - 1,9 В для сброса. Из прямоугольной диаграммы (рис. 5b) видно, что допустимый диапазон напряжений разделен на 20 значений, а выход устройства намного превышает уровень 3 σ (99,73%). Это обычное требование в производстве. Недостатком этого метода является то, что устройства нельзя настроить напрямую с одного HRS (LRS) на другой HRS (LRS), но необходимо сначала сбросить (установить) на LRS (HRS), а затем установить на целевой HRS (LRS). . Это увеличивает сложность и энергопотребление операции.

Многозначное хранилище устройств. а Преобразуйте состояния сопротивления, задав токи соответствия. б 20 стабильных состояний сопротивления, полученных путем установки амплитуды импульсного напряжения. Ширина и интервал импульса равны 500 мкс.
Более лучший подход показан на рис. 6. Проводимость устройства постепенно увеличивается или уменьшается с помощью последовательных импульсов. Длительность и интервал импульса составляют 10 мкс. Проводимость измеряется импульсом считывания 0,1 В после каждого импульса установки / сброса. Как видно на рис. 6, количество импульсов, необходимых для установки / сброса устройств на разные уровни, зависит от приложенного напряжения. Различные статуи сопротивления с 20 уровнями получаются путем установки и сброса путем выбора 0,5 В в качестве напряжения SET и -0,7 В в качестве напряжения сброса соответственно (рис. 7). Устройство сбрасывается на HRS 10–0,9 В последовательных импульсов каждый раз перед установкой в целевое состояние или устанавливается на LRS 10 последовательными импульсами 0,8 В перед настройкой. Учитывая тот же статус, присутствующий как в процессе установки, так и в процессе сброса, всего получается 35 различных статусов. Отклонение количества импульсов, необходимое для двух соседних состояний сопротивления установки (сброса), превышает уровень 3 σ. Недостатком является то, что если значения сопротивления устройств сильно изменятся, необходимое количество импульсов будет большим, а скорость работы будет низкой.
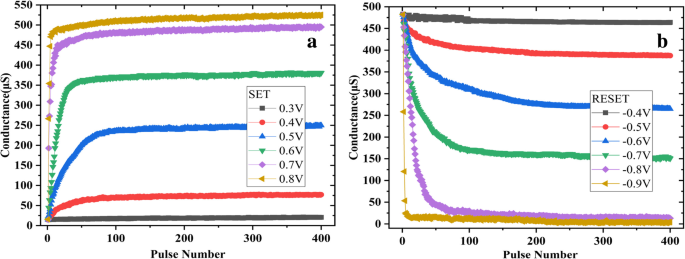
Сопротивление регулируется последовательными импульсами. а Установите процесс и b процесс сброса

Количество импульсов, необходимое для установки ( a ) или сбросить ( b ) устройств на 20 различных уровней
Чтобы проверить сохранение данных на устройствах, 20 устройств устанавливают / сбрасывают на серию различных значений сопротивления и держат их на нагревательном столе при температуре 85 ° C [42]. Значения сопротивления измерялись при напряжении 0,1 В каждые 100 с. Из рис. 8а видно, что сопротивление устройств остается стабильным после 10 4 с. Чтобы проверить циклическую надежность устройства, мы повторили операцию установки и сброса с установочным импульсом 1,8 В / 500 мкс и импульсом сброса - 1,8 В / 500 мкс. Через 10 3 циклов, коэффициент переключения устройства все еще больше 10 на рис. 8b.
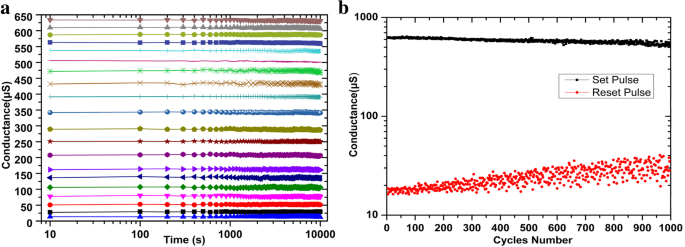
Тесты надежности устройств. а Характеристики сохранения данных после операций установки / сброса импульсов. б Кривые долговечности циклов для операций установки / сброса импульсов
Выводы
Предлагаемый HfO 2 , легированный алюминием мемристор показывает постепенную и стабильную установку / сброс. Подбирая кривую процесса отверждения для легированных и нелегированных алюминием устройств, было обнаружено, что в HRS нелегированные устройства следуют механизму эмиссии Шоттки, в то время как легированные алюминием устройства следуют проводящему механизму SCLC. Обсуждается также микроскопический физический механизм изменения сопротивления. Кроме того, многозначное запоминание устройства было подтверждено изменением тока согласования, регулировкой амплитуды напряжения импульса установки / сброса и использованием последовательных коротких импульсов. Наконец, мы проверили надежность устройств, чтобы доказать, что на них сохраняется более 10 4 данных. с (85 ° C) и коэффициент переключения больше 10 после 10 3 циклов.
Доступность данных и материалов
Все данные, полученные или проанализированные в ходе этого исследования, включены в эту опубликованную статью.
Сокращения
- ALD:
-
Осаждение атомного слоя
- BE:
-
Нижний электрод
- CMOS:
-
Дополнительный оксид металла кремний
- HfD-04:
-
MeCp 2 HfMe (OMe) Hf
- HRS:
-
Состояние высокого сопротивления
- LRS:
-
Состояние низкого сопротивления
- NVM:
-
Энергонезависимая память
- SCLC:
-
Ток, ограниченный пространственным зарядом
- TE:
-
Верхний электрод
- TMA:
-
Триметилалюминий
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
Наноматериалы
- Аутентификация устройства на основе X.509 в Eclipse Hono
- Нанографема, гибкая прозрачная память на основе кремния
- Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на по…
- Изготовление наноразмерных ямок с высокой производительностью на полимерной тонкой пленке с использованием…
- Получение и термоэлектрические характеристики ITO / PtRh:PtRh тонкопленочной термопары
- Сверхчувствительный датчик деформации на основе гибкой пьезоэлектрической пленки из поливинилиденфторида
- Повышенные энергетические характеристики на основе интеграции с наноламинатами Al / PTFE
- Дизайн бионического кохлеарного базилярного мембранного акустического датчика для частотной селективности…
- Ambarella, Lumentum и ON Semiconductor совместно работают над трехмерным зондированием на основе искусственного интеллекта д…
- Тонкопленочное покрытие из нитрида титана ниобия



