Влияние концентрации Ag, диспергированного в тонких пленках HfOx, на переключение порога
Аннотация
Ток скрытого пути - ток, проходящий через соседнюю ячейку памяти - является неотъемлемой и неизбежной проблемой в массиве перекладин, состоящем из ячеек мемристорной памяти. Эту серьезную проблему можно решить, последовательно подключив селекторное устройство к каждой мемристорной ячейке. Среди различных типов концепций селекторных устройств диффузионный селектор привлек значительное внимание из-за его превосходных характеристик. Этот селектор отличается изменчивым пороговым переключением (TS) с использованием динамики активных металлов, таких как Ag или Cu, которые действуют как электрод или легирующая добавка в твердом электролите. В данном исследовании диффузионный селектор на основе HfO, легированного серебром x производится с использованием системы совместного распыления. Поскольку концентрация Ag в HfO x слой меняется, наблюдаются разные электрические свойства и тем самым характеристики TS. Необходимость процесса гальванопластики (EF) для характеристики TS определяется надлежащей концентрацией Ag в HfO x слой. Это различие в процессе EF может существенно повлиять на параметры характеристик TS. Следовательно, для диффузионного селектора требуются оптимизированные условия легирования, чтобы обеспечить отличное поведение селекторного устройства и избежать процесса EF, который в конечном итоге может ухудшить характеристики устройства.
Введение
Память с резистивным переключением, также известная как мемристор, в течение десятилетий широко изучалась как многообещающий кандидат на энергонезависимую память следующего поколения. В последнее время мемристорные устройства были применены к искусственным синапсам и нейронам, напоминающим их механизм переключения, основанный на миграции ионов, для вычислений, вдохновленных мозгом [1,2,3]. Быстрая скорость переключения (<1 нс), экстремальная масштабируемость (<2 нм), довольно хорошая выносливость (до 10 11 программирование / стирание циклов), а трехмерная структура наложения уже доказана в индивидуальных мемристивных системах [4,5,6]. Кроме того, можно включить обработку изображений и распознавание образов, построив большой массив перекладин (CBA) [1, 3, 7, 8].
Однако структура CBA имеет неотъемлемую проблему в том, что ток скрытого пути через соседние ячейки памяти мемристора нарушает операции записи / чтения в выбранной или наполовину выбранной ячейке [9,10,11]. Чтобы подавить ток незаметного пути и проблему с половинным выбором, к каждой ячейке памяти можно последовательно подключить двухконтактное селекторное устройство. Существует много типов селекторных устройств с нелинейным вольт-амперным ( I - V ) вводимых характеристик, таких как диоды Шоттки, переходы металл – изолятор (MIT), овонные пороговые переключатели (OTS), селекторы туннельного барьера и диффузионные селекторы (также называемые диффузионными мемристорами) [9,10,11,12,13,14 , 15]. Среди них диффузионный селектор, основанный на диффузионной динамике металлических частиц (Ag или Cu) внутри диэлектриков, вызвал значительный интерес из-за его простой конструкции и превосходных характеристик, таких как чрезвычайно высокая нелинейность [14,15,16,17,18, 19,20,21,22]. Диффузионный селектор имеет летучий пороговый переключатель (TS), основанный на образовании и саморазрыве металлических нитей. К настоящему времени сообщалось о различных диффузионных селекторных системах и их динамических свойствах; однако понимание основного механизма работы остается трудным. Кроме того, необходимо установить диффузионную концентрацию и распределение металлических частиц для достижения превосходных характеристик TS, поскольку они могут значительно повлиять на свойства электропроводности и перехода.
Здесь мы изготовили HfO x , легированный Pt / Ag. / Pt стек как диффузионный селектор, в котором Ag и HfO x действуют как диффузионная металлическая легирующая добавка и диэлектрический материал соответственно. Мы исследовали электрические свойства устройств при различных концентрациях легирования, чтобы определить подходящие условия для характеристики TS. Характеристики ТС, требующие гальванопластики (EF-need) и без гальванопластики (EF-free), определялись концентрацией легирующей примеси в диффузионных селекторах. Чтобы объяснить разницу в процессе гальванопластики (EF) и последующих характеристиках TS, мы провели структурный и химический анализ диффузионных селекторных устройств. Наше исследование предполагает влияние концентрации примеси на характеристики TS диффузионного селектора и указывает направление для улучшения его характеристик.
Методы
На рисунке 1а показана система совместного распыления с Ag и HfO 2 . цель. Были изготовлены устройства, размещенные на подложке в четырех местах на расстоянии 0,5 см друг от друга. Позиции находились рядом с HfO 2 target в порядке устройства 1, 2, 3 и 4 (D1, D2, D3 и D4), как показано на рис. 1a. HfO, легированный серебром x коммутационный слой всех устройств был нанесен на Pt / Ti / SiO 2 / Si путем совместного распыления с мощностью распыления 10 Вт для Ag и 150 Вт для HfO 2 , соответственно. Перед процессом напыления базовое давление вакуумной камеры было сброшено до ~ 5 × 10 6 . Переключающий слой осаждали в течение 5 мин без вращения подложки при комнатной температуре в потоке Ar 20 sccm для поддержания плазмы Ar. Давление процесса составляло 10 мТорр. После этого верхний платиновый электрод был нанесен на предварительно осажденный переключающий слой с использованием теневой маски диаметром 200 мкм путем испарения электронным пучком. На рис. 1b и c показаны изображения в поперечном сечении и схематическая конструкция изготовленного устройства соответственно.
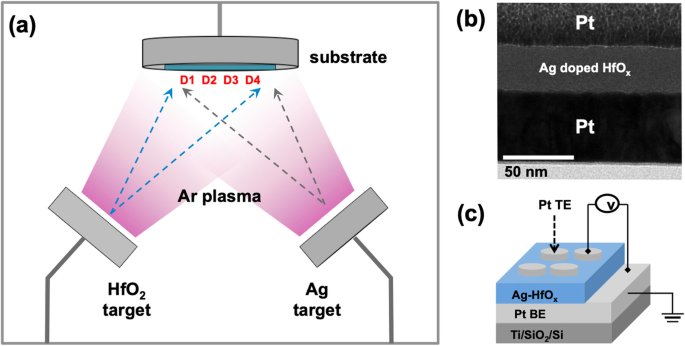
а Принципиальная схема системы совместного распыления. б Поперечное сечение изготовленного устройства с помощью ПЭМ. c Принципиальная схема устройства с системой электрических измерений
Толщину переключающего слоя, нанесенного путем совместного распыления, измеряли с помощью эллипсометра (FS-1, Film-Sense, США). Для анализа атомного состава HfO x слой. Для оценки электрических свойств устройства использовали анализатор параметров полупроводников (SPA; HP-4155A, Agilent, США) при комнатной температуре. Все измерения проводились путем приложения напряжения к верхнему электроду, в то время как нижний электрод был заземлен, как показано на рис. 1с. Поверхность устройств анализировали с помощью автоэмиссионного сканирующего электронного микроскопа (FE-SEM; JSM-6700F, JEOL, Япония) и атомно-силовой микроскопии (AFM; XE-100, Park system, Корея). Образцы поперечного сечения устройств были приготовлены с использованием процесса сфокусированного ионного пучка (FIB; Quanta 3D FEG, FEI, Нидерланды) и исследованы с помощью просвечивающего электронного микроскопа высокого разрешения (HR-TEM:JEM-2100F, JEOL, Япония. ). Химический состав был проанализирован с помощью энергодисперсионной рентгеновской спектроскопии (EDS).
Результаты и обсуждение
Одновременно мы изготовили четыре HfO x , легированных серебром. устройства для диффузионных селекторов в одном процессе. Во время процесса осаждения подложку не вращали, чтобы подтвердить влияние концентрации легирования на электрические свойства. Таблица 1 показывает толщину, соотношение катионов Ag:Hf и среднеквадратичную шероховатость для D1, D2, D3 и D4 соответственно. Состав Ag в переключающем слое выражали как соотношение катионов с использованием количества Ag и Hf, полученного в результате XRF-анализа. Как показано, каждое устройство имеет разную толщину и концентрацию Ag. При увеличении расстояния от HfO 2 мишени толщина переключающего слоя уменьшилась, а состав Ag в оксидном слое увеличился. С увеличением концентрации Ag, среднеквадратичные значения шероховатости немного увеличиваются (изображения АСМ показаны в Дополнительном файле 1:Рисунок S1).
Постоянный ток (DC) - напряжение ( I - V ) характеристики, измеренные со всех устройств, показаны на рис. 2a – d. D1 (35,3 нм, 7% Ag) изначально находился в хорошо изолирующем состоянии, и во время измерений постоянного тока не наблюдалось переключения порога (рис. 1a) из-за недостаточной концентрации Ag для создания проводящей нити, несмотря на толстый переключающий слой. Напротив, D2 (27,3 нм, 16% Ag) показал пороговое переключение из состояния с высоким сопротивлением (HRS) в состояние с низким сопротивлением (LRS) после процесса гальванопластики (EF) в исходном состоянии для создания работоспособного устройства. как показано на рис. 1b. Во время процесса EF ток увеличился с низкого уровня до допустимого ( I копия ) при напряжении -4,3 В. После этого D2 постоянно демонстрировал поведение TS при более низком рабочем напряжении, чем напряжение формирования, при обеих полярностях смещения. Точно так же D3 (24 нм, 39% Ag) показал типичное двунаправленное поведение TS; однако в исходном состоянии D3 процесс EF не требовался. Другими словами, D3 представляет поведение TS без EF. Напротив, D4 (18,8 нм, 58% Ag) изначально находился в состоянии с высокой проводимостью, вероятно, из-за перколяции Ag в тонком HfO x слой с высокой концентрацией Ag.

Электрические свойства изготовленных устройств. а I-V кривая D1 (сильно изолирующее состояние). б I-V кривая D2, показывающая процесс EF и последующее поведение TS. c I-V кривая D3, показывающая поведение TS без процесса EF. г I-V кривая D4 (проводящее состояние)
Морфология поверхности и размер зерна изменялись с увеличением концентрации Ag. Как отмечалось ранее, с увеличением концентрации Ag, среднеквадратичные значения шероховатости увеличивались, как показано в таблице 1. Размер зерна также оценивался с помощью SEM (дополнительный файл 1:рисунок S2). Увеличение размера зерна наблюдалось при увеличении концентрации Ag. Однако в случае D2 и D3, которые показывают несопоставимые характеристики TS, разница в шероховатости поверхности и размере зерна была довольно небольшой. Тем не менее, наблюдалась значительная разница в их электрических свойствах с точки зрения процесса EF и следующих характеристик TS. Таким образом, мы дополнительно сравнили характеристики TS D2 и D3 следующим образом.
На рис. 3 а и б показано повторяемое поведение TS, наблюдаемое в D2 и D3 при измерении постоянного тока. Для сравнения на рисунках показаны только характеристики ТС при отрицательном смещении. Оба устройства изначально показали уровни тока в несколько пА при -0,1 В ниже предела обнаружения. Поведение TS в D2 было очевидно после процесса EF при формовочном напряжении ~ - 3,5 В, в то время как ток податливости ( I копия ) для устройства было установлено значение 5 мкА, чтобы исключить серьезную поломку. После процесса EF устройство показало типичное поведение TS, как показано на рис. 3a. Когда приложенное напряжение превышает пороговое напряжение ( В th ) ~ - 1,1 В, ток внезапно достиг I копия 5 мкА; устройство перешло во включенное состояние из выключенного состояния. Однако состояние ВКЛ устройства восстановилось до состояния ВЫКЛ, когда приложенное напряжение уменьшилось до значения, меньшего, чем напряжение удержания ( В удерживать ). Хотя устройство вернулось в выключенное состояние, наблюдался более высокий ток выключения, чем у устройства до EF.
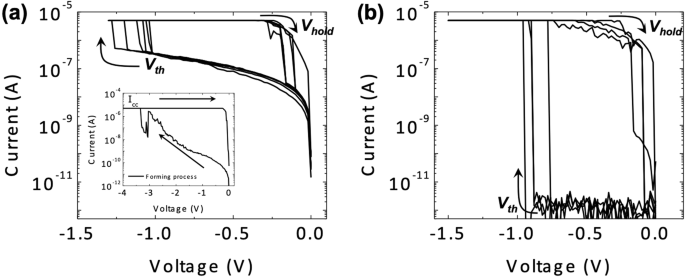
Сравнение характеристик ТС в D2 и D3. а Поведение TS с повышенным током выключения после процесса EF. На вставке показан процесс EF в устройстве после депонирования. б Поведение TS без процесса EF, поддерживающего низкий ток выключения и высокий NL
D3 также показал типичные характеристики TS, как показано на рис. 3b. Однако процесс EF не требовался для того, чтобы вызвать поведение TS в устройстве в исходном состоянии. Сила тока достигла I копия 5 мкА при напряжении V th ~ - 0,8 В, которое является состоянием ВКЛ, а затем самопроизвольно возвращается в исходное состояние ВЫКЛ при V th менее ~ - 0,2 В. Последующие D3 I - V петли были похожи на первый I - V петли. Более того, устройство стабильно показывало низкий ток выключения при низком рабочем напряжении по сравнению с таковым у D2. Кроме того, плотность тока выключенного состояния в D3 все еще оставалась меньше, чем у D2; разница составила примерно 10 5 А / см 2 . Следовательно, было подтверждено, что разница в концентрации Ag в HfO x слой определил необходимость процесса EF, и, в свою очередь, резко изменились характеристики TS.
Чтобы реализовать резистивную память с одним селектором и одним резистором (1S1R), селектору требуется низкий ток выключения для подавления тока утечки и высокий ток включения, соответствующий току сброса резистивной памяти [21, 22]. Для выполнения такого Я - V нелинейных характеристик, мы подтвердили нелинейность ( NL ) и избирательность ( S ) наших устройств и селекторов TS, о которых ранее сообщалось, для оценки их производительности в качестве селекторов [14, 18, 21,22,23]. Здесь мы определяем NL и S используя уравнения. (1) и (2), соответственно, следующим образом:
$$ NL =\ frac {I_ {V _ {\ mathrm {th}}}} {I _ {\ frac {1} {2} {V} _ {\ mathrm {th}}}} $$ (1) $$ S =\ frac {I _ {\ mathrm {ON}}} {I _ {\ mathrm {OFF}}} $$ (2)NL определяется как отношение тока при V th и половина V th . В схеме полусмещения в массиве перекладин V th применяется к целевой ячейке, а половина V th применяется к соседним наполовину выбранным ячейкам. Следовательно, NL критически важен для предотвращения сбоев в работе массива перекладин во время операций программирования / чтения. Напротив, S это соотношение тока в состоянии ВКЛ и ВЫКЛ при V th , представляющий производительность селектора на основе TS. Оба определения широко используются для сравнения производительности селекторных устройств. Таким образом, большой NL и S значения требуются для операции 1S1R для эффективного подавления тока незаметного пути.
Различные параметры переключения, включая NL и S в наших устройствах и селекторы TS в литературе показаны в таблице 2. В случае D2 увеличение тока выключения вызывает значительное уменьшение NL и S . Напротив, ток выключения D3 достаточно мал, так что более 10 6 NL и S были приобретены. Однако D2 и D3 могли показать характеристику TS только при низком I копия (<10 мкА), поскольку TS перешел на переключение памяти при более высоком I копия . Хорошо известно, что в большинстве селекторных устройств TS, использующих нить Ag, происходит переход энергонезависимой памяти при переключении I копия более 10–100 мкА [23,24,25,26]. Когда я копия выше 10–100 мкА, образуется прочная и стабильная металлическая нить, которую трудно спонтанно разорвать по сравнению с тонкой и нестабильной нитью, сформированной при более низком I копия [26, 27]. Поэтому различные методы, например многослойная структура (Ag / TaO x / TaO y / TaO x / Ag) и наноточки Ag, нанесенные в диэлектрик, были предложены для получения надежных характеристик TS при более высоких значениях I копия [21, 22].
Для наблюдения за размером и распределением атомов Ag внутри HfO x слоя, элементный анализ HR-TEM и EDS был выполнен на D2 и D3. На рис. 4 a и b (c и d) показаны изображения поперечного сечения высокочастотной электронной микроскопии D2 (D3). Согласно изображениям HR-TEM, вполне вероятно, что атомный размер Ag равномерно распределен в HfO x матрица. Никаких различимых частиц Ag или кластеров Ag размером несколько нанометров в обоих устройствах не наблюдалось. Кроме того, HfO x аморфная фаза была подтверждена с помощью изображения с быстрым преобразованием Фурье (БПФ), как показано на вставках к рис. 4b и d. Однако сигнал Ag в профилях линий указывает на присутствие Ag в HfO x слой. Таким образом, делается вывод, что Ag в HfO x будет распространяться в атомном масштабе. Область переключения, включая нанонити Ag, должна быть исследована; однако характеристики TS непостоянны, так что в будущем следует попытаться провести наблюдения с помощью ПЭМ на месте.
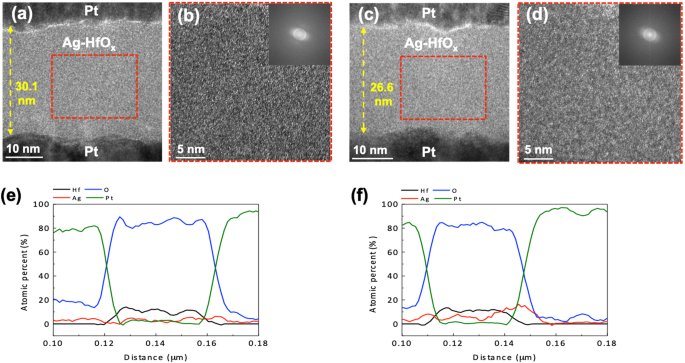
Микроструктурный и композиционный анализ. а Изображение D2 в поперечном сечении с помощью просвечивающего электронного микроскопа. б Увеличенное изображение D2 с помощью просвечивающего электронного микроскопа. На вставке - соответствующее изображение БПФ. c Изображение D3 в поперечном сечении с помощью просвечивающего электронного микроскопа. г Увеличенное изображение D3 с помощью просвечивающего электронного микроскопа. На вставке - соответствующее изображение БПФ. Профили элементарных линий EDS e D2 и f D3
Мы предлагаем следующий механизм поведения TS в наших устройствах, как показано на рис. 5 a и b. Заводской HfO, легированный серебром x коммутационные слои имеют равномерно распределенные атомы Ag в HfO x . Однако ожидается, что существует относительно большое расстояние между атомами Ag из-за низкой концентрации Ag в D2. На рис. 5а показан процесс EF из готового D2. Когда электрическое поле прикладывается к устройству в чистом состоянии, атомы Ag в HfO x может быть окислен до Ag + ионы, и они мигрируют вдоль направления поля. Окисленный Ag + ионы снова восстанавливаются до атомов Ag на другом Pt-электроде, где Ag-проводящая нить может непрерывно расти. Как только нить накала подсоединяется между двумя электродами, устройство переключается во включенное состояние из выключенного состояния. Во время процесса EF в D2 из-за сильного электрического поля могли образовываться более крупные кластеры Ag. Было обнаружено, что такого большого электрического поля достаточно для образования наночастиц Ag диаметром несколько нанометров из данных наблюдений in situ с помощью ПЭМ в литературе [14, 15]. После снятия приложенного электрического поля Ag в атомном масштабе диффундирует в HfO x матрица, указывающая, что устройство возвращается в состояние ВЫКЛЮЧЕНО. Однако более крупные кластеры Ag, которые не могут достаточно диффундировать, остаются на проводящем пути. Таким образом, эти остаточные кластеры Ag приводят к большему току выключения в последующем состоянии выключения. Напротив, в случае D3 в заводском состоянии, как показано на рис. 5b, нить Ag формируется без образования кластера Ag, потому что D3 работает в слабом электрическом поле, а это означает, что устройство может поддерживать низкий ток выключения. Аналогичным образом, когда приложенное электрическое поле снимается, устройство возвращается в выключенное состояние из-за спонтанного разрыва Ag-нити, что можно объяснить эффектом Томсона-Гиббса минимизации межфазной энергии между нитью и матрицей [15, 18 , 28]. Следовательно, двунаправленные характеристики TS могут быть достигнуты за счет повторяемой диффузионной динамики атома / иона Ag.
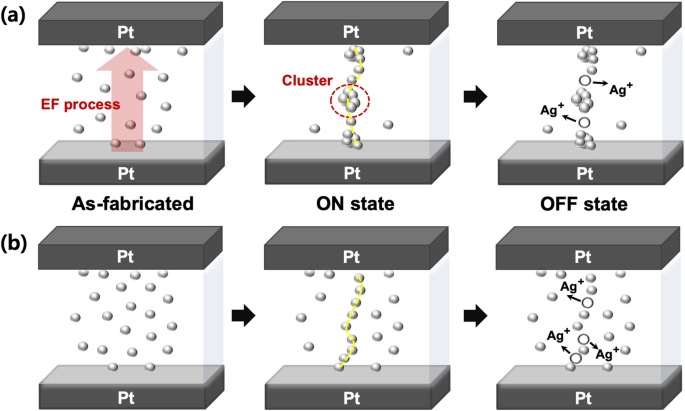
Предлагаемый механизм TS в устройстве HfOx, легированном серебром. Образование / разрыв первой нити Ag для поведения TS в a EF-необходимый (D2) и b Устройства без EF (D3)
Чтобы объяснить разницу во время процесса EF, мы предлагаем следующие уравнения. (3) и (4):
$$ D ={D} _0 \ mathit {\ exp} \ left (- \ frac {E _ {\ mathrm {mo}}} {kT} \ right) $$ (3)где D коэффициент диффузии, D 0 - предэкспоненциальный множитель, E mo - миграционный барьер при нулевом смещении, k постоянная Больцмана, а T - местная абсолютная температура. Чтобы сформировать Ag-нить внутри HfO x В слое ионы Ag должны преодолеть миграционный барьер, чтобы двигаться к отрицательно смещенному электроду. При приложении внешнего смещения электрическое поле может снизить миграционный барьер E м , что приводит к миграции ионов в направлении поля следующим образом:
$$ {E} _ {\ mathrm {m}} ={E} _ {\ mathrm {m} \ mathrm {o}} - \ frac {e \ bullet {V} _ {\ mathrm {bias}}} { Z _ {\ mathrm {box}}} \ bullet \ Delta z $$ (4)с зарядом электрона e , напряжение смещения В предвзятость , HfO x толщина слоя Z коробка , и расстояние прыжка Ag в z направление ∆z . Действительно, ионы Ag могут прыгать во всех направлениях при нулевом смещении. Однако мы учли прыжки по z направление в процессе EF, потому что устройство может быть включено в состояние под сильным электрическим полем, когда ионы Ag преимущественно прыгают вдоль направления электрического поля. Чтобы оценить E м , мы рассчитали расстояние прыжка Ag ( ∆z ) как 0,67 нм в D2 и 0,45 нм в D3 из наших экспериментальных результатов по концентрации Ag и толщине пленки. Барьер миграции при нулевом смещении, E mo =3.02 эВ, использовалось из литературы [29]. При первом формировании Ag-филамента в D2 требовалось ~ 1,6 МВ / см электрического поля, что снижало миграционный барьер на 0,11 эВ. Напротив, для первого переключения в D3 требовалось электрическое поле ~ 0,4 МВ / см, что снизило миграционный барьер на 0,04 эВ. Таким образом, диффузии Ag достаточно для формирования Ag-нити в D3, несмотря на более низкое снижение барьера из-за короткого расстояния прыжка и высокой концентрации Ag по сравнению с D2. Однако из-за относительно большого расстояния перескока в D2 требовалось большее уменьшение барьера для достаточной диффузии для образования Ag-нити. Как только нить сформируется, она должна быть самопроизвольно разорвана путем отключения напряжения; однако нить Ag не могла полностью диффундировать до исходного распределения, и, следовательно, расстояние прыжка ∆z уменьшается по сравнению с заводским D2. Следовательно, этот результат привел к уменьшению электрического поля (~ 0,4 МВ / см) при последующем переключении порога. Следует отметить, что толщина пленки значительно влияет на I - V характеристики устройства. Таким образом, мы подтвердили процесс ЭП в устройствах с аналогичной толщиной, но с разной концентрацией Ag. Аналогичным образом, устройства демонстрировали переход от характеристик, необходимых для EF, к характеристикам без EF по мере увеличения концентрации Ag. Таким образом, было продемонстрировано, что концентрация Ag существенно влияет на процесс EF, контролируя эффективное внутреннее электрическое поле. То есть, модулируя концентрацию Ag и, следовательно, расстояние прыжка в HfO x слой требуется для характеристик TS без EF с большим NL и S ценности.
Выводы
Диффузионные селекторные устройства на основе HfO, легированного серебром x Были изготовлены тонкие пленки и оценены их характеристики TS. Чтобы понять влияние концентрации Ag на электрические свойства, были оценены устройства с различными концентрациями Ag. Поведение ТС в устройствах можно описать образованием / саморазрывом Ag-нити из атомно-дисперсных атомов Ag в HfO x . Было подтверждено, что концентрация Ag может повлиять на процесс EF с образованием такой металлической нити. Устройство с низкой концентрацией Ag требовало прецедентного процесса EF для поведения TS, в то время как поведение TS без EF было доказано в устройстве с более высокой концентрацией Ag. Кроме того, устройство без EF показало лучшую производительность TS, чем устройство, необходимое для EF, с точки зрения нелинейности и тока выключения. Следовательно, для получения диффузионного селекторного устройства без EF требуется надлежащая концентрация примеси и контроль распределения, чтобы предотвратить снижение производительности в результате процесса EF.
Доступность данных и материалов
Все данные полностью доступны без ограничений.
Сокращения
- CBA:
-
Массив перекладин
- EF:
-
Электроформование
- HRS:
-
Состояние высокого сопротивления
- LRS:
-
Состояние низкого сопротивления
- NL :
-
Нелинейность
- S :
-
Избирательность
- TS:
-
Пороговое переключение
Наноматериалы
- Изготовление тонких пленок SrGe2 на подложках Ge (100), (110) и (111)
- Изучение силы адгезии и стеклования тонких пленок полистирола с помощью атомно-силовой микроскопии
- Эффект сегнетоэлектрического поля, индуцированный асимметричным резистивным переключением, в эпитаксиальн…
- Анализ импеданса тонких пленок органо-неорганических перовскитов CH3NH3PbI3 с контролем микроструктуры
- Золотые наночастицы круглой формы:влияние размера и концентрации частиц на рост корней Arabidopsis thaliana
- Влияние различных морфологий CH3NH3PbI3 на фотоэлектрические свойства перовскитных солнечных элементов
- Двойные функции устройства V / SiOx / AlOy / p ++ Si в качестве селектора и памяти
- Влияние двухслойных гетероструктур CeO2 − x / ZnO и ZnO / CeO2 − x и полярности электроформования на коммутационные свой…
- Влияние последующего термического отжига на оптические свойства пленок InP / ZnS с квантовыми точками
- Тонкие пленки аморфного оксида ванадия как стабильные работающие катоды литиевых и натрий-ионных батарей



