Двойные функции устройства V / SiOx / AlOy / p ++ Si в качестве селектора и памяти
Аннотация
В этом письме представлены двойные функции, включая селектор и переключение памяти в V / SiO x / AlO y / p ++ Si резистивное запоминающее устройство, просто контролируя соответствие предельному току (CCL). Однонаправленное переключение порога наблюдается после положительного формирования с низким CCL, равным 1 мкА. Сдвиги кислорода к стороне V-электрода образуют VO x слой, где пороговое переключение можно объяснить явлением перехода металл-изоляция. При более высоком CCL (30 мкА), приложенном к устройству, достигается биполярное переключение памяти, которое объясняется образованием и разрывом проводящей нити в SiO y слой. AlO y толщиной 1,5 нм слой с высокой теплопроводностью играет важную роль в снижении тока покоя для памяти и порогового переключения. Через температурную зависимость подтверждается высокоэнергетический барьер (0,463 эВ) в LRS, который может вызывать нелинейность в низкоомном состоянии. Чем меньше CCL, тем выше нелинейность, что обеспечивает больший размер массива в массиве точек пересечения. Сосуществование памяти и переключения порога в соответствии с CCL обеспечивает гибкость управления устройством для его предполагаемого использования.
Фон
Резистивная память с произвольным доступом (RRAM) является одним из многообещающих кандидатов для технологии энергонезависимой памяти следующего поколения из-за ее высокой скорости переключения [1, 2], низкого энергопотребления [3,4,5,6,7 , 8], многоуровневые возможности [9,10,11,12,13,14,15], высокая масштабируемость [16,17,18,19,20] и возможность наложения трехмерных изображений [21,22,23,24,25 ]. Эти свойства особенно подходят для памяти класса хранения (SCM), которая может заполнить пробел в производительности между динамической памятью с произвольным доступом (DRAM) в качестве основной памяти и твердотельным накопителем (SSD) в качестве памяти хранения. Несмотря на то, что устройство RRAM за последние годы добилось большого прогресса [1,2,3,4,5,6,7,8,9,10,11,12,13,14,15,16,17,18,19 , 20,21,22,23,24,25], однако остается главный недостаток:ток утечки через соседние ячейки возникает в массиве точек пересечения с высокой плотностью [26]. Устройство памяти с селекторным элементом должно обеспечивать нелинейные вольт-амперные характеристики (ВАХ) для решения этой проблемы [26,27,28,29,30,31,32,33,34,35]. До сих пор использовались различные устройства с нелинейными концепциями, такие как комплементарное резистивное переключение (CRS) [26], туннельный барьер [27,28,29,30,31,32,33], пороговое переключение на основе серебра [34], диодного типа селектор [35, 36], переключение овонного порога (OTS) [37, 38] и переход металл-изолятор (MIT) [39,40,41,42,43]. ВО x как один из типичных материалов MIT может быть широко использован в потенциальных приложениях как оптический и электрический переключающий компонент [40,41,42]. SiO 2 широко используется в качестве пассивирующего слоя в полупроводниковой промышленности. Кроме того, SiO x с высоким содержанием кремния ( x <2) может использоваться как слой изменения сопротивления в RRAM [44,45,46,47,48,49,50,51,52,53,54,55]. SiO x может быть предпочтительнее многих других материалов с точки зрения совместимости с процессами CMOS и низкой стоимости. SiO x Устройства на основе RRAM действуют как посредник в роли проводящих мостиков, просто используя электроды, такие как Cu и Ag, с высоким коэффициентом диффузии [44,45,46,47]. В другом случае переключение памяти вызвано эффектом изменения валентности внутри SiO x слой, который можно объяснить генерацией кислородных вакансий или моделью протонного обмена [48,49,50,51,52,53,54,55]. При униполярном переключении, когда операция установки предшествует сбросу, он чувствителен к окружающей атмосфере. Характеристики переключения в воздухе значительно ухудшаются [48,49,50,51,52,53]. С другой стороны, нитевидное переключение без эффектов обратного сканирования показывает типичное униполярное и биполярное переключение в различных SiO x устройства на базе RRAM [52,53,54].
Здесь мы представляем сосуществование порогового переключения и переключения памяти в V / SiO x / AlO y / p ++ Si устройство в зависимости от соответствия предельному току (CCL). Устройство с кремниевым нижним электродом (ВЭ) имеет ряд преимуществ по сравнению с обычным металлическим электродом. Устройство RRAM с памятью или пороговым переключением напрямую подключается к истоку или стоку в транзисторе, что является потенциальным применением для встроенной памяти и устройства с крутым наклоном. Ток перегрузки может быть уменьшен за счет последовательного сопротивления Si BE. Более того, наноструктура кремния BE посредством влажного травления и регулировки концентрации легирования на поверхности кремния может улучшить характеристики переключения. AlO y слой, который представляет собой большую запрещенную зону с изолированным свойством, помогает снизить рабочий ток во время переключения порога и памяти. SiO x слой действует как слой переключения памяти при высоком CCL, в то время как он служит для подачи кислорода в V TE при низком CCL, что обеспечивает переключение порога.
Методы
V / SiO x / AlO y / p ++ Устройство Si было изготовлено следующим образом:Во-первых, BF 2 ионы были имплантированы с энергией ускорения 40 кэВ и дозой 5 × 10 15 см −2 в Si-подложку в сильнолегированный Si BE. Повреждение решетки лечили отжигом при 1050 ° C в течение 10 мин. Сильнолегированный Si BE имел поверхностное сопротивление 30,4 Ом / □. Затем слой AlO y толщиной 1,5 нм слой был нанесен с помощью системы осаждения атомных слоев (ALD) с использованием H 2 O и Al (CH 3 ) 3 и SiO x толщиной 5,5 нм слой подвергся усиленному плазмой химическому осаждению из паровой фазы (PECVD) в результате реакции 5% SiH 4 / N 2 (160 sccm), N 2 O (1300 sccm) и N 2 (240 sccm) при 300 ° C. Затем был нанесен верхний электрод (TE) из ванадия (V) толщиной 50 нм и диаметром 100 мкм путем распыления на постоянном токе V-мишени газообразным аргоном (30 см3 / см3). Наконец, с помощью распыления постоянным током был нанесен Al толщиной 50 нм в качестве защитного слоя для предотвращения дальнейшего окисления V TE. Все электрические свойства были охарактеризованы с помощью режима развертки постоянного напряжения и импульсного режима с использованием анализатора полупроводниковых параметров Keithley 4200-SCS (SPA) и сверхбыстрого вольт-амперного модуля (I – V) 4225-PMU при комнатной температуре соответственно. Для работы устройства TiN BE был заземлен, а смещение Ni TE контролировалось.
Результаты и обсуждение
На рисунке 1а показана схематическая структура V / SiO x . / AlO y / p ++ Si устройство. Три аморфных V, SiO x , и AlO y слои и монокристаллический слой Si наблюдаются с помощью изображения поперечного сечения просвечивающей электронной микроскопии (TEM), как показано на рис. 1b. Толщина SiO x и AlO y слои составляют 5,5 и 1,5 нм соответственно. Для подтверждения соотношения составов двух диэлектрических пленок был проведен XPS-анализ (дополнительный файл 1). x значение SiO x и y значение AlO y равны 0,88 и 1,33 соответственно. Наши SiO x пленка с использованием PECVD по сравнению с SiO 2 осаждение с использованием сухого окисления осаждается при гораздо более низкой температуре и имеет гораздо больше дефектов, что делает их пригодными для резистивного переключения при относительно более низких напряжениях. На рисунке 2а показано типичное пороговое переключение V / SiO x . / AlO y / p ++ Si устройство. Первоначальное переключение с положительным процессом формования требует более высокого напряжения, чем последующее пороговое переключение, поскольку диэлектрические слои изначально имеют меньшие дефекты. К устройству прикладывают CCL в 1 мкА, чтобы избежать образования избыточных проводящих нитей в SiO x слой. Ток утечки очень низкий (100 пА при 1 В) по сравнению с ранее сообщенным пороговым переключением VO x . Это преимущество приписывается Al 2 О 3 с более высокой диэлектрической проницаемостью и теплопроводностью по сравнению с SiO 2 . В выключенном состоянии есть изолирующие свойства, потому что нити легко рвутся, и тогда нити не остаются. Возможным механизмом переключения порога является окисление V TE кислородом, поступающим из SiO x слой во время процесса позитивного формования, как показано на рис. 2b. Электрические свойства ВО x между V TE и SiO x слой может перейти из изолирующего состояния в металлическое, вызывая резкое изменение сопротивления. Низкого CCL в 1 мкА недостаточно для создания эффективных проводящих нитей внутри SiO x фильм. Следовательно, SiO x с изолирующими свойствами может быть еще одной причиной для уменьшения тока отключения. Для отрицательного процесса формирования V / SiO x / AlO y / p ++ Si устройство порога переключения не наблюдается (см. Дополнительный файл 1). Когда к V TE прикладывается отрицательное смещение, движение оксида перемещается к Si BE, так что V TE больше не может участвовать в пороговом переключении как VO x . На вставке к рис. 2а показано пороговое напряжение (V th ) и удерживать напряжение (V hold ) в течение 100 циклов. V th где ток резко увеличивается с почти бесконечной крутизной между 1,08 и 1,82 В, а V hold в этот момент ток, возвращающийся в состояние с высоким сопротивлением, составляет от 0,12 до 0,54 В. На рисунке 2c показаны ВАХ в открытом токе при различных температурах. При 25 ° C и 55 ° C они показывают почти одинаковое пороговое переключение, но ВАХ при более высокой температуре 85 ° C теряет свойство переключения порога. Хорошо известно, что VO x теряет свой MIT при высоких температурах. Таким образом, этот результат является еще одним доказательством того, что VO x является основной причиной переключения порога. На рисунке 2d показаны переходные характеристики для порогового переключения. Импульс с амплитудой 1 В контролировал ток чтения до и после записывающего импульса длительностью 1 мкс. Во время подачи на устройство импульса с большой амплитудой отслеживался высокий ток, а затем V / SiO x / AlO y / p ++ Устройство Si отключало ток сразу после снятия записывающего импульса. Свойства селектора, проанализированные выше, могут использоваться в сочетании с работой элементов памяти ниже 1 мкА [55, 56].
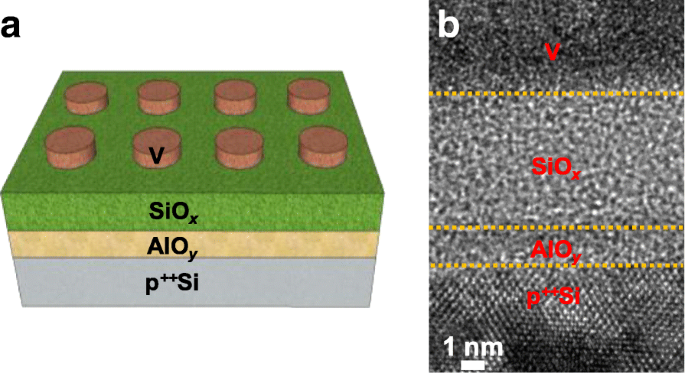
Конфигурация устройства V / SiO x / AlO y / p ++ Si. а Схематический рисунок и б Изображение ТЕА

Однонаправленное пороговое переключение V / SiO x / AlO y / p ++ Si, когда применяется позитивное формование с CCL 1 мкА. а Типичные ВАХ. б Схематическое изображение процесса формовки. c ВАХ по температурной зависимости. г Переходные характеристики
На рисунке 3а показано биполярное резистивное переключение V / SiO x . / AlO y / p ++ Устройство Si после положительного формования с CCL 100 мкА. Затем выполняется процесс сброса с быстрым увеличением сопротивления путем качания отрицательного напряжения, и устройство переключается в состояние высокого сопротивления (HRS). Процесс установки с быстрым уменьшением сопротивления затем происходит при положительном напряжении смещения, заставляя устройство вернуться в состояние низкого сопротивления (LRS). Чтобы понять свойства проводящей нити, мы наблюдаем нормированную проводимость и температурную зависимость. Проводимость в LRS - важный показатель, косвенно указывающий на свойства проводящей нити. На рисунке 3b показана нормализованная проводимость (G N ), которая определяется как динамическая проводимость (G d ) делятся на статическую проводимость (G 0 ) для ВАХ V / SiO x / AlO y / p ++ Si устройство в LRS с разными температурами. Независимо от температуры G N значение сходится к 1, когда напряжение равно нулю. Это позволяет нам исключить хорошо известный механизм проводимости, такой как эмиссия Шоттки, туннелирование Фаулера-Нордхейма и закон Чайлда (I ~ V 2 ) в токе, ограниченном пространственным зарядом (SCLC). Металлическую омическую проводимость также можно исключить, учитывая температурную зависимость, показанную на рис. 3c. Уменьшение сопротивления с повышением температуры говорит о том, что проводящая нить имеет полупроводниковые свойства. Таким образом, мы можем исключить проникновение V в SiO x слой для основной проводящей нити V / SiO x / AlO y / p ++ Si устройство в LRS. Следовательно, операция биполярной памяти V / SiO x / AlO y / p ++ В устройстве Si преобладает внутреннее переключение SiO x . Также подтверждено, что положительный и отрицательный токи не так сильно различаются, что позволяет предположить, что вместо интерфейса типа, такого как эмиссия Шоттки, преобладает объемная проводимость. Принимая во внимание вышеупомянутую нормированную проводимость, существует два возможных механизма основной проводимости. Первый - прыжковая проводимость по формуле:
$$ J ={qnav} _o {e} ^ {- q {\ o} _T / kT} {e} ^ {qaV / 2 dkT} $$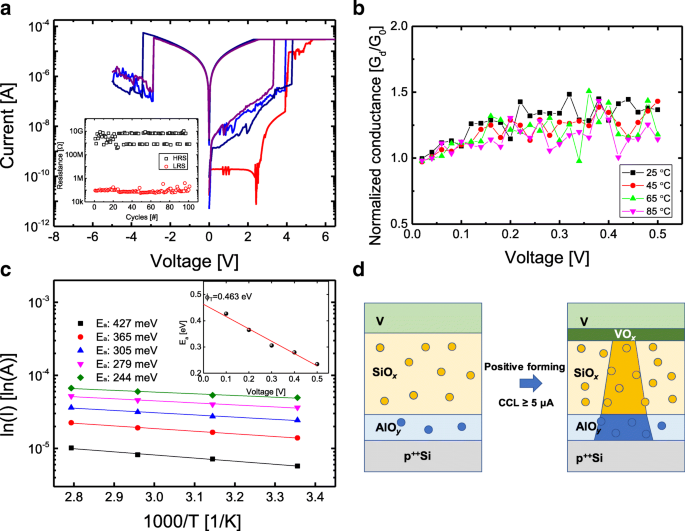
Переключение памяти V / SiO x / AlO y / p ++ Si, когда применяется позитивное формование с CCL 30 мкА. а Типичные ВАХ. б Нормализованная проводимость. c В (I) по сравнению с 1000 / T. г Схематическое изображение процесса формовки
где q , n , а , ø Т , v о , и d - электрический заряд, концентрация пространственного заряда, среднее расстояние прыжка, высота электронного барьера для прыжка, собственная частота колебаний и толщина диэлектрической пленки, соответственно. Значок ø Т рассчитанный из наклона линейного графика зависимости ln (I) от 1000 / T, составляет 0,463 эВ, как показано на рис. 3c. Значение, рассчитанное на основе отношения между E a и V составляет 5,17 нм, что указывает на проводящую нить, образованную в SiO x не является сильным и близким к состоянию HRS. Другой механизм проводимости, эмиссия Пула-Френкеля (P-F), описан в дополнительном файле 1. На основе приведенных выше результатов модель проводящей нити в операции памяти V / SiO x / AlO y / p ++ Устройство Si изображено на рис. 3d. В процессе позитивного формования процесс окисления происходил на стороне V TE, но из-за высокого CCL внутри SiO x может формироваться проводящая нить. и AlO y за счет движения кислородных вакансий. Во время процесса сброса электрическое поле, противоположное формируемому и застывшему, индуцирует кислород и рекомбинацию с кислородной вакансией, что приводит к разрыву проводящей нити. Замечено, что селектор и операции с памятью наблюдаются в одной и той же ячейке. Работа с памятью возможна после срабатывания порогового значения и полного выключения переключателя. Однако обратное направление невозможно, потому что переключение сброса операции с памятью не отключено полностью.
На рисунке 4а показаны нормированные ВАХ в LRS V / SiO x / AlO y / p ++ Устройство Si в низковольтном режиме (0 ~ 1 В) для различных условий CCL (5 мкА, 30 мкА и 1 мА). Здесь нормализованная ВАХ определяется как ток при каждом напряжении, деленный на ток при 1 В. Поскольку уровни тока LRS в зависимости от CCL варьируются, мы устанавливаем значение тока на 1 В, чтобы легко сравнить нелинейность. Можно заметить, что по мере уменьшения CCL ток подавляется в режиме более низкого напряжения. Чтобы получить более количественное соотношение, нелинейность определяется как отношение тока в V READ к тому, что на половине V READ . На рисунке 4b показан ток считывания при 1 В и нелинейность как функция CCL для V / SiO x . / AlO y / p ++ Si устройство. Уменьшение тока считывания из-за уменьшения CCL предполагает, что проводящая нить становится более тонкой, а затем увеличивается нелинейность. Пленка собственного оксида кремния демонстрирует высокую нелинейность даже в одном слое. Собственное нелинейное свойство обусловлено объемной природой оксида кремния, а не границей раздела кремния. Чем меньше CCL, тем меньше деградация происходит в SiO x , поэтому снижение уровня энергии ловушки в LRS по сравнению с HRS может быть минимизировано. Следовательно, более высокий энергетический барьер может максимизировать нелинейность в состоянии LRS, когда к устройству применяется более низкий CCL. Точно так же проводимость, описываемая излучением P-F в TaO x / TiO y стек обеспечивает высокую нелинейность [57]. Другая возможность состоит в том, что, поскольку диэлектрическая проницаемость оксида меньше, через оксидную пленку делается больше проходов из-за концентрации поля. Это может привести к снижению уровня энергии захвата оксидного слоя, который, как можно ожидать, будет служить туннельным барьером для Al 2 О 3 . Чтобы получить маржу чтения (∆V) в n × n Для массива точек пересечения мы используем упрощенную эквивалентную схему, показанную на рис. 4c. Принимая во внимание наихудший случай, соседние ячейки устанавливаются на LRS и сопротивление нагрузки (R L ) к сопротивлению LRS. ∆V рассчитывалась по разнице между V OUT в LRS и V OUT в HRS. На рисунке 4d показано ∆V как функция количества словарных строк ( n ) для V / SiO x / AlO y / p ++ Si устройство. Чем меньше CCL, тем больше ∆V, потому что нелинейность увеличивается. Когда обеспечивается 10% запас по чтению, массив может быть расширен примерно до более чем 10 × 10 для CCL 5 мкА и до 5 × 5 для CCL 1 мА. Размер массива, чтобы выдержать ток утечки недостаточен, но он поможет увеличить размер массива, когда устройство с функцией селектора подключено к V / SiO x / AlO y / p ++ Si устройство. По сравнению с показанием 0,5 В во всех CCL, он имеет более высокую нелинейность при чтении при 1 В. Хотя низкий V READ приводит к низкой статической мощности в операции чтения, значение нелинейности становится меньше, что связано с тем, что электрическое поле меньше на SiO x / AlO y слой в меньшем V READ .

Нелинейные характеристики V / SiO x / AlO y / p ++ Si для переключения памяти. а ВАХ с разными CCL. б Считайте ток и нелинейность как функции CCL. c Эквивалентные схемы массива точек пересечения. г Граница чтения как функция номера строки слов для различных CCL и напряжения чтения
Выводы
В этой работе V / SiO x / AlO y / p ++ Исследуется Si-устройство, имеющее как селектор, так и функцию памяти путем простого управления CCL. Когда применяется CCL 1 мкА или меньше, для селекторного применения наблюдается однонаправленное переключение порога. Положительное формование окисляет электрод V и явление MIT VO x может вызвать пороговое переключение. AlO y слой способен достичь высокой селективности 10 4 за счет снижения тока отключения. С другой стороны, когда применяется CCL 5 мкА или более, наблюдается переключение памяти, поскольку на SiO x образуются эффективные проводящие нити. слой. Чем ниже CCL, тем выше нелинейность, что помогает увеличить размер массива точек пересечения.
Сокращения
- ALD:
-
Осаждение атомного слоя
- BE:
-
Нижний электрод
- CCL:
-
Соответствие текущему пределу
- CRS:
-
Дополнительное резистивное переключение
- DRAM:
-
Динамическая память с произвольным доступом
- HRS:
-
Состояние высокого сопротивления
- I – V:
-
Ток – напряжение
- LRS:
-
Состояние низкого сопротивления
- MIT:
-
Металл-изолятор-переход
- OTS:
-
Пороговое переключение Овоник
- PECVD:
-
Химическое осаждение из паровой фазы с применением плазмы
- П-П:
-
Пул-Френкель
- RRAM:
-
Резистивная память с произвольным доступом
- SCLC:
-
Ток, ограниченный пространственным зарядом
- SCM:
-
Память класса хранения
- SPA:
-
Анализатор параметров полупроводников
- SSD:
-
Твердотельный накопитель
- TE:
-
Верхний электрод
- ТЕМ:
-
Просвечивающая электронная микроскопия
- V:
-
Ванадий
Наноматериалы
- Термины и концепции цифровой памяти
- Что такое операционная система и ее компоненты
- Управление памятью C++:создание и удаление
- Разделение памяти - введение и основные услуги
- Процессоры обращаются к конвергенции IoT и AI
- Двойное управление нелинейностью моды и дисперсионных свойств в плазмонном волноводе с графеном и диэлектри…
- Коллективное исследование моделирования и имитации резистивной оперативной памяти
- Производство IoT:определение, функции и примеры
- Детали долбежных машин и их функции
- Типы дифференциала и их функции



