Влияние ультрафиолетовой обработки озоном на монослои MoS2:сравнение тонких поликристаллических пленок, осажденных химическим паром, и механически расслоенных монокристаллических хлопьев
Аннотация
Мы сообщаем о различном поведении при окислении поликристаллического MoS 2 , подвергнутого химическому осаждению из паровой фазы, и механически расслоенного монокристалла MoS 2 . монослои обработкой ультрафиолетом и озоном. Поскольку время обработки ультрафиолетом и озоном увеличилось с 0 до 5 минут, фотолюминесценция и режимы комбинационного рассеяния света обоих MoS 2 исчезли, что свидетельствует о структурной деградации в результате окисления. Анализ с помощью оптического поглощения и рентгеновской фотоэлектронной спектроскопии показал образование MoO 3 в обоих MoS 2 после обработки озоном и ультрафиолетом. Кроме того, обработка ультрафиолетом и озоном могла привести к образованию кислородных вакансий, оксисульфида молибдена или сульфатов молибдена в химически осажденном из паровой фазы MoS 2 . Измерение электрического сопротивления после обработки озоном и ультрафиолетом позволило предположить преобразование MoS, осажденного из газовой фазы, 2 в легированный МоО 3 и механически расслоенного MoS 2 в незначительно легированный MoO 3 . Эти результаты демонстрируют, что кристалличность монослоя MoS 2 может сильно влиять на эффект обработки ультрафиолетом и озоном, оказывая важное влияние на интеграцию MoS 2 в устройство. и другие двумерные полупроводники.
Введение
Большой интерес вызывают дихалькогениды переходных металлов (ДПМ), такие как MoS 2 , поскольку они предлагают привлекательные возможности для различных приложений устройств, включая транзисторы, оптоэлектронные устройства, гетеропереходные структуры, датчики и электрокатализ [1, 2]. Наличие прямой запрещенной зоны в однослойных ДПМ делает эти двумерные полупроводники особенно перспективными для оптоэлектронных устройств [3, 4]. Однако критические проблемы при изготовлении оптоэлектронных устройств на основе TMD, таких как фототранзисторы, включают нанесение высоких k диэлектрики на TMD и легирование TMD. Из-за отсутствия оборванных связей на поверхности TMD сложно нанести высокие - k диэлектрики на ДПМ [5]. Более того, легирование TMD также является сложной задачей, поскольку легирование замещения, используемое для объемных полупроводников, таких как кремний, изменяет двумерную структуру и свойства однослойных TMD [6].
Чтобы преодолеть эти трудности, поверхностная функционализация TMD с помощью O 2 плазма [7, 8] или ультрафиолет-озон (UV-O 3 ) [9,10,11]. Хотя эти методы могут функционализировать поверхность MoS 2 путем окисления поверхности они могут одновременно влиять на структуру и свойства монослоя MoS 2 [12,13,14,15,16]. Например, окисление O 2 плазма или УФ-О 3 обработка изменила режимы комбинационных колебаний и излучение фотолюминесценции (ФЛ) монослоя MoS 2 [12, 16]. Однако, поскольку большинство исследований было основано на монослое MoS 2 в микрометровом масштабе хлопья, полученные механическим расслоением из объемных монокристаллов, мало что было известно об их взаимодействии с монослоем большой площади MoS 2 тонкие пленки, которые обычно являются поликристаллическими. Границы зерен в поликристаллическом монослое MoS 2 может обеспечить более высокую реактивность с УФ-О 3 чем у монокристалла, что приводит к другому поведению при окислении. Поэтому в этом исследовании мы исследуем эффект UV-O 3 обращение на MoS 2 монослоев путем прямого сравнения окислительного поведения тонких пленок поликристаллического химического осаждения из паровой фазы (CVD) и механически расслоенных монокристаллических чешуек. Мы систематически исследуем спектры ФЛ и комбинационного рассеяния как MoS 2 монослои для разной продолжительности УФ-О 3 воздействие. Мы также исследуем окислительное поведение как MoS 2 монослои во время УФ-О 3 лечение с помощью рентгеновской фотоэлектронной спектроскопии (XPS). Мы дополнительно измеряем электрическое сопротивление чистых и ультрафиолетовых лучей 3 -обработанный MoS 2 монослои, чтобы понять эффект УФ-О 3 обращение на MoS 2 монослои.
Методы
Однослойный MoS 2 тонкие пленки наносились на сапфировые подложки с ориентацией (0001) (~ 1,5 × 1 см 2 ) методом CVD в двухзонной трубчатой печи. МоО 3 (99,98%, Sigma-Aldrich) и S (99,98%, Sigma-Aldrich) порошки в двух отдельных Al 2 О 3 лодки использовались в качестве предшественников. МоО 3 порошок (14 мг) помещали перед зоной 1 (750 ° C), а порошок S (1,4 г) помещали перед входом в печь. Подложки помещали ниже по потоку в зоне 2 (700 ° C). МоО 3 порошок нагревали со скоростью 15 ° C мин -1 и подложки нагревали при 38 ° C мин -1 . После 30-минутного напыления печь медленно охлаждали до комнатной температуры. Во время осаждения поддерживали поток аргона 100 см3 / мин и давление ~ 0,5 торр. Однослойный MoS 2 хлопья были получены золотым методом эксфолиации [17] из объемного MoS 2 кристаллы (2D полупроводники) и перенесены на высоколегированные подложки Si с термически выращенным SiO 2 (300 нм). На рисунке 1 показаны схематические структуры обоих MoS 2 монослои на подложках. Толщина монослоя MoS 2 измеряли с помощью атомно-силовой микроскопии (AFM, Park Systems XE-100). Кристалличность объемного MoS 2 кристаллы и CVD MoS 2 Тонкие пленки исследовали методами рентгеновской дифракции (XRD, Bruker D8 Discover с Cu-Kα-излучением) и просвечивающей электронной микроскопии (ПЭМ, FEI Titan 80–300 при 300 кВ) соответственно.
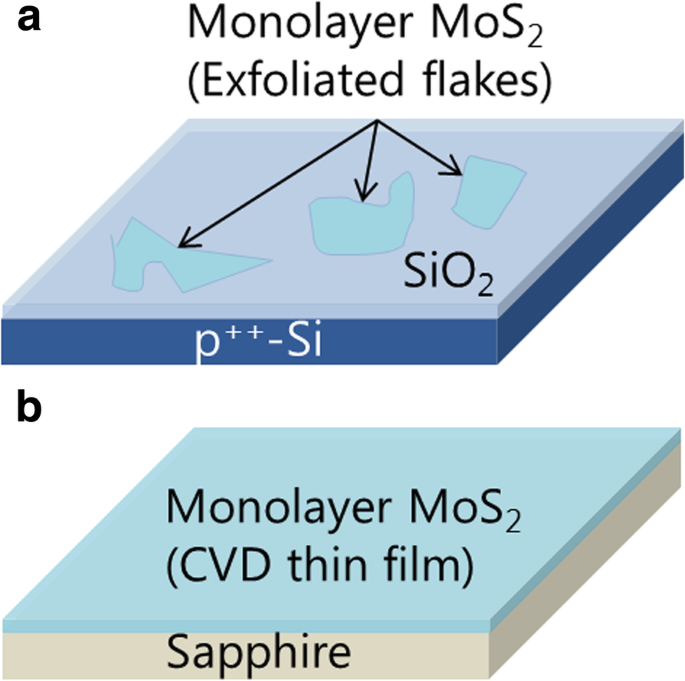
Схематические структуры MoS 2 монослои: а механически отслаивающиеся хлопья на SiO 2 / Si подложки и b Тонкие пленки CVD на сапфировых подложках
MoS 2 монослои подвергались УФ-О 3 (SEN LIGHTS PL16–110, 185 нм и 254 нм) в течение 0–5 мин при освещенности 58 мВт см −2 . Оптическое поглощение измеряли с помощью УФ-видимой спектроскопии (PerkinElmer Lambda 35). Рамановская / ФЛ спектроскопия (Horiba Jobin-Yvon LabRam Aramis) была измерена на чистом и УФ-O 3 -обработанный MoS 2 монослои с лазером с длиной волны 532 нм и мощностью луча 0,5 мВт. XPS (Thermo Scientific K-Alpha) выполняли с использованием монохроматического Al K α источник рентгеновского излучения ( hν =1486,7 эВ) с углом взлета 45 °, энергией прохождения 40 эВ и размером пятна 400 мкм в диаметре. Для всех образцов наблюдались C 1 и O 1, по-видимому, потому, что они подвергаются воздействию атмосферы перед загрузкой в камеру сверхвысокого вакуума для анализа XPS. Придаточный углерод (C 1s при 284,8 эВ) использовали в качестве эталона поправки заряда для спектров XPS. Энергетическое разрешение составляет 0,7 эВ, измеренное с использованием полной ширины на половине максимальной интенсивности Ag 3d 5/2 вершина горы. MoS 2 Образцы подвергались воздействию атмосферы, пока их доставляли к оборудованию XPS. Хотя анализ XPS на месте мог предоставить более точную информацию, в данной работе он отсутствовал. Для деконволюции пиков и вычитания фона использовалось программное обеспечение Thermo Scientific Avantage Data System. Для подбора спектров XPS использовались функции Гаусса.
Для измерения электрического сопротивления MoS 2 монослои, контакты Au (100 × 100 мкм 2 Толщиной 70 нм) наносили поверх MoS 2 электронно-лучевым испарением. Затем на фоторезисте с центрифугированием поверх слоя Au с помощью обычной фотолитографии формировали узор для образования открытых участков для последующего травления. После удаления Au из открытых участков методом влажного травления в царской водке оставшийся фоторезист удаляли в ацетоне. Затем устройства отжигали при 200 ° C в течение 2 часов в трубчатой печи (100 куб. См Ar и 10 куб. См H 2 ) для удаления остатков фоторезиста и уменьшения контактного сопротивления. Электрическое сопротивление рассчитывалось по вольтамперному напряжению ( I - V ) измерения (Keithley 4200-SCS) в атмосферных условиях.
Результаты и обсуждение
Помимо измерения АСМ, измеряются спектры ФЛ и комбинационного рассеяния, чтобы подтвердить образование MoS 2 монослои. Из-за своей прямой запрещенной зоны MoS 2 монослои допускают излучение ФЛ при ~ 1.88 эВ [3, 4]. Кроме того, разница частот между двумя характеристиками комбинационного рассеяния A 1g и E 1 2 г режимы MoS 2 монослоев меньше 20 см −1 [18]. На рис. 3 показано излучение ФЛ чистого MoS 2 при ~ 1,88 эВ означает, что оба MoS 2 являются монослоями. На рис. 4 исходный MoS 2 показывает разницу частот между 19,6 и 19,9 см −1 подразумевая однослойный MoS 2 . Анализ XRD и TEM показал монокристаллическую природу объемного MoS 2 кристаллы и поликристаллическая природа нашего монослоя MoS 2 тонкие пленки (дополнительный файл 1:Рисунок S1). Размер зерна монослоя MoS 2 тонких пленок составляет ~ 10 нм [19].
После UV-O 3 лечение, MoS 2 монослои меняют свой цвет и становятся прозрачными. На рис. 2a, b как расслоенные хлопья, так и тонкие пленки CVD становятся прозрачными после 5-минутного УФ-O 3 лечение. Спектр поглощения MoS 2 тонкие пленки на рис. 2в ясно показывают разницу после УФ-О 3 лечение. (Поглощение расслоенного MoS 2 хлопья не могли быть измерены с помощью УФ-видимой спектроскопии, поскольку размер чешуек был слишком мал.) Хотя чистый MoS 2 тонкие пленки показывают пики поглощения из-за экситонных переходов (A и B) [3, 4], 5-минутное УФ-O 3 -обработанный MoS 2 тонкие пленки вообще не показывают пиков поглощения для одного и того же диапазона длин волн. Потому что слегка желто-зеленый MoS 2 тонкие пленки становятся прозрачными для видимого света через 5 мин УФ-О 3 лечения, мы ожидаем, что запрещенная зона исходного монослоя MoS 2 (~ 1,88 эВ) станет шире после УФ-О 3 лечение (> ~ 3 эВ). Поскольку это хорошо согласуется с широкой запрещенной зоной МоО 3 (> 2,7 эВ) [20], прозрачный УФ-О 3 -обработанный MoS 2 предполагает образование MoO 3 через 5 мин УФ-О 3 лечение.
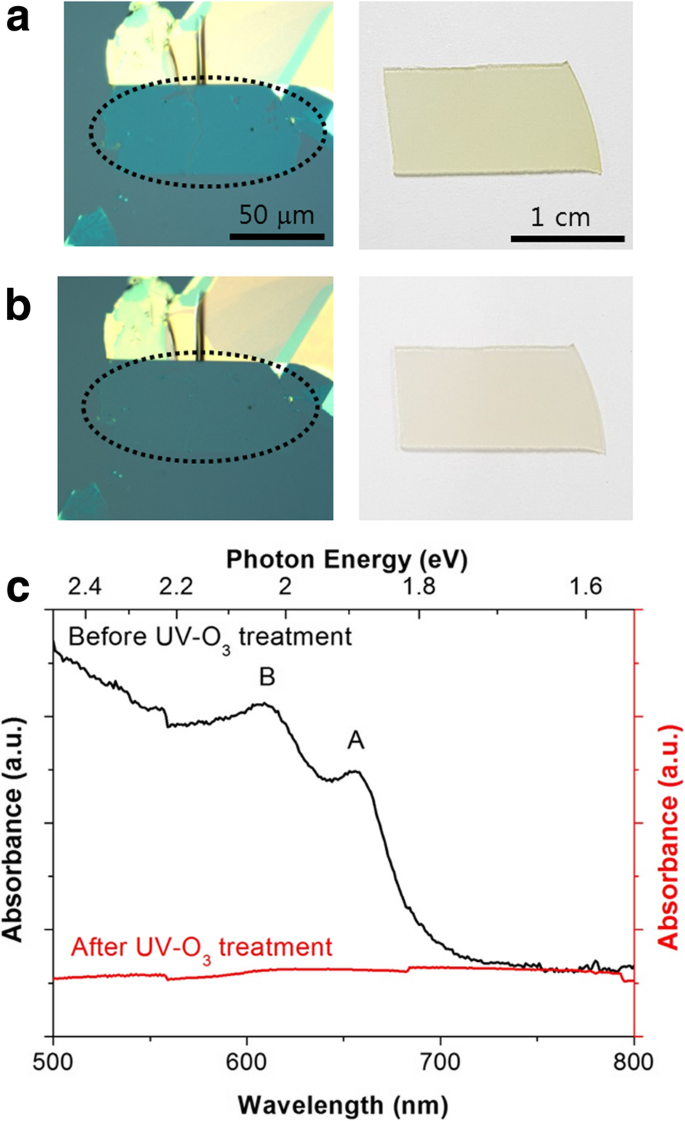
Механически расслоенные хлопья и тонкие пленки CVD MoS 2 монослои а до и б через 5 мин УФ-О 3 обработка (пунктирная область указывает монослой), c оптическое поглощение тонких пленок CVD до и после 5-минутного УФ-O 3 лечение
Затем мы исследуем эффект UV-O 3 обработка PL излучения MoS 2 монослои. На рис. 3 представлены спектры ФЛ CVD MoS 2 . тонкие пленки и расслоенный MoS 2 монокристаллические хлопья после УФ-О 3 выдержка в течение 0, 1, 3 и 5 мин соответственно. Интенсивность излучения ФЛ значительно уменьшается с УФ-О 3 время обработки и в конечном итоге PL полностью гасится для 5-минутного MoS 2 монослои. Эти результаты предполагают образование оксидов или дефектов, обеспечивающих безызлучательную рекомбинацию после УФ-О 3 лечение. Как MoS 2 монослои становятся прозрачными после УФ-О 3 лечение, формирование широкозонного полупроводника MoO 3 разумно ожидается. Энергия излучения ФЛ чистого MoS 2 составляет 1,88 эВ для отслоившихся чешуек и 1,86 эВ для пленок CVD. Это небольшое различие, вероятно, связано с влиянием нижележащих подложек, поскольку подложки могут сильно влиять на комбинационное излучение и излучение ФЛ [21]. Более широкая ширина пика излучения ФЛ в монослоях CVD свидетельствует о более высокой плотности дефектов. Интересно, что дальнейший отрицательный сдвиг пика излучения ФЛ наблюдается в монокристалле MoS 2 хлопьев (~ 50 мэВ), чем в тонких пленках CVD (~ 10 мэВ) после УФ-О 3 лечение. Поскольку отрицательный сдвиг излучения ФЛ сравним с энергией связи триона (10–40 мэВ) MoS 2 [22], это может быть связано с разной концентрацией триона (нейтральные экситоны, принимающие электрон или дырку), образованного окислительным легированием [23, 24]. (В данной работе монокристалл MoS 2 чешуйки более проводящие, чем CVD MoS 2 , предполагая более высокие уровни легирования в монокристалле MoS 2 .) Более высокий уровень легирования в монокристалле MoS 2 хлопья допускают высокую концентрацию трионов, рекомбинация которых будет доминировать в их ФЛ-излучении. Напротив, более низкий уровень легирования в CVD MoS 2 тонкие пленки позволят снизить концентрацию трионов. Следовательно, в их излучении ФЛ будет преобладать рекомбинация нейтральных экситонов. Однако, поскольку отрицательный сдвиг излучения ФЛ также может быть связан с влиянием лежащих в основе субстратов или штаммов, в будущем необходимы более систематические исследования.

Спектры ФЛ MoS 2 монослои а механически отслаивающиеся хлопья на SiO 2 / Si подложки и b Тонкие пленки CVD на сапфировых подложках после УФ-О 3 лечение в течение 0, 1, 3 и 5 мин
Затем, чтобы исследовать структурную деградацию под действием УФ-О 3 обработки, мы измеряем спектры комбинационного рассеяния света MoS 2 монослои после УФ-О 3 лечение в течение 0, 1, 3 и 5 мин соответственно (рис. 4). Интенсивность обоих E 1 2 г и A 1g режимов уменьшается по мере увеличения времени лечения. Хотя разница частот между E 1 2 г и A 1g режимы не меняются в течение 0–5 мин УФ-О 3 Время обработки, два режима комбинационного рассеяния почти полностью исчезают после 5-минутной обработки, что свидетельствует о серьезном структурном искажении и деградации. АСМ-анализ показывает увеличение шероховатости поверхности после УФ-О 3 (Дополнительный файл 1:Рисунок S2), что соответствует окислению MoS 2 [23].

Рамановские спектры MoS 2 монослои а механически отслаивающиеся хлопья на SiO 2 / Si подложки и b Тонкие пленки CVD на сапфировых подложках после УФ-О 3 лечение в течение 0, 1, 3 и 5 мин
Для дальнейшего исследования структурной деградации MoS 2 монослои УФ-О 3 обработки, мы измеряем XPS-спектры MoS 2 . Поскольку размер луча XPS намного больше, чем размер однослойного MoS 2 хлопья, РФЭС-спектры монокристалла MoS 2 хлопья получаются из MoS большой площади 2 монокристаллы (размером ~ 1 см и толщиной ~ 100 мкм). На рисунке 5 показаны XPS-спектры в областях Mo 3d и S 2p для массивного монокристалла и CVD MoS 2 . тонкие пленки соответственно. Существование Мо 4+ -состояние нетронутого MoS 2 можно наблюдать по энергии связи Mo 3d 3/2 и Mo 3d 5/2 орбитали. После UV-O 3 выдержка, интенсивность Мо 6+ -состояние при 235,9 эВ дополнительно увеличивается с УФ-O 3 время обработки, указывающее на расширенное образование связи Mo-O и MoO 3 . Есть четыре четких различия между рис. 5a и b в области Mo 3d. (1) На рис. 5b, Mo 6+ -состояние 235,9 эВ в чистом MoS 2 тонкие пленки, вероятно, связаны с остаточным оксидом, образовавшимся во время или после процесса CVD. (2) Интенсивность Мо 4+ и S 2 s пики уменьшаются в CVD MoS 2 тонкие пленки с более длинным УФ-О 3 воздействие. Однако интенсивность Mo 4+ и S 2 s пики не изменяются с UV-O 3 время обработки в большом MoS 2 монокристаллы, поскольку XPS все еще может обнаруживать Mo 4+ и S 2 s пики из MoS 2 под окисленной верхней поверхностью. (3) В монокристалле MoS 2 , энергия связи Mo 4+ -состояние показывает больший положительный сдвиг, чем в CVD MoS 2 тонкие пленки предполагают более высокое легирование n-типа [25]. Сдвиг пика после окисления MoS 2 в данной работе (0,41–1,09 эВ) сравнимо с литературными (0,6–1,1 эВ) [23, 24]. (Чтобы предотвратить эффект зарядки, который может вызвать аналогичный положительный сдвиг, мы использовали струйный пистолет во время измерения XPS.) (4) В CVD MoS 2 тонкие пленки, пики Mo 5+ -state также отображается с UV-O 3 обработка, предполагающая возможное образование кислородных вакансий [26] или оксисульфида молибдена MoO x S y [27]. Эти результаты можно понять по окислению Mo 4+ -состояние в MoS 2 в более высокие степени окисления (Mo 5+ и Мо 6+ ) с UV-O 3 воздействие. Это также согласуется с результатами XPS на поликристаллическом многослойном MoS 2 тонкие пленки после O 2 плазма или УФ-О 3 лечение [26, 28, 29].

XPS-спектры MoS 2 а массивный монокристалл и b Тонкие пленки CVD на сапфировых подложках после УФ-О 3 лечение в течение 0, 1, 3 и 5 мин
В области S 2p наличие S 2− -состояние можно наблюдать по энергии связи S 2p 1/2 и S 2p 3/2 орбитали в чистом MoS 2 . Энергия связи S 2− -состояние в монокристалле MoS 2 показывает больший положительный сдвиг, чем в CVD MoS 2 тонкие пленки предполагают более высокое легирование n-типа [25]. Хотя связь S-O наблюдается при ~ 165 эВ в УФ-O 3 -обработанный монокристалл MoS 2 , это ниже предела обнаружения в тонких пленках CVD. Вместо этого новый дублетный пик степени окисления серы появляется при более высокой энергии связи (~ 169 эВ) в тонких пленках CVD после УФ-О 3 лечение в течение 3 мин. Этот новый дублет соответствует пикам S 2p окисленной серы S 6+ , что позволяет предположить образование различных сульфатов молибдена Mo (SO 4 ) x [28]. Пока интенсивность S 2− дублет продолжает уменьшаться с увеличением UV-O 3 выдержка, интенсивность S 6+ дублет еще больше увеличивается после 5-минутного УФ-О 3 лечение, предполагающее дальнейшее преобразование S 2- в более высокую степень окисления (S 6+ ) путем окисления. Аналогично с Mo 4+ пиков, интенсивность S 2− пики не меняются с UV-O 3 время обработки в большом MoS 2 монокристаллы. Существование S 6+ -состояние после O 2 плазма или УФ-О 3 лечение противоречиво в литературе. Сообщалось о его существовании в поликристаллическом многослойном MoS 2 . тонкие пленки после O 2 плазменная обработка [28]. Однако этого не наблюдалось в других поликристаллических многослойных MoS 2 . тонкие пленки [26, 29] или монокристаллы [9, 16, 30] после O 2 плазма или УФ-О 3 лечение. Хотя это несоответствие может быть связано с зависимостью от дозы и времени MoS 2 окисления [30], необходимы более систематические исследования, чтобы прояснить это в будущем.
Различное поведение XPS может быть связано с различием состава и кристалличности между монокристаллами и тонкими пленками CVD. Состав Mo:S составляет 1:1,97 в объемных монокристаллах и 1:1,5 в тонких пленках CVD, что предполагает более высокую концентрацию вакансий S в тонких пленках CVD. Более высокая концентрация вакансий S в сочетании с наличием границ зерен в тонких пленках CVD может обеспечить более высокую реакционную способность по отношению к кислороду, чем в монокристаллах.
Чтобы лучше понять окисление MoS 2 монослои УФ-О 3 лечение, мы измеряем электрическое сопротивление чистых и УФ-O 3 -обработанный MoS 2 монослои. Поскольку существует изменение электрического сопротивления от образца к образцу, мы используем относительное отношение электрического сопротивления ( R После / R До ), где R После и R До - электрическое сопротивление до и после УФ-О 3 лечение соответственно. На рисунке 6 показан R . После / R До как функция UV-O 3 время лечения. Пока R После / R До расслоенного MoS 2 монокристаллические хлопья значительно увеличиваются при увеличении времени обработки, R После / R До CVD MoS 2 тонкие пленки уменьшаются с увеличением времени обработки. Эти результаты предполагают, что МоВ 3 образованный UV-O 3 лечение сердечно-сосудистых заболеваний MoS 2 тонкие пленки обладают более высоким уровнем легирования, чем у MoS 2 монокристаллические хлопья. Это подтверждается анализом XPS, предполагающим возможное существование кислородных вакансий, MoO x S y , или Мо (SO 4 ) x в CVD MoS 2 монослои. Это, по-видимому, противоречит более высокому уровню легирования в монокристалле MoS 2 . предложенный на рис. 5а. Однако, поскольку рис. 5а основан на объемных монокристаллах, мы не можем исключить возможность того, что он не дает точной информации о верхнем монослое. Следовательно, поверхностное окисление объемного MoS 2 монокристалл может обеспечивать легирование только MoS 2 монокристалл внизу, превращая верхнюю часть поверхности в пренебрежимо легированный MoO 3 . В соответствии с этими результатами, электрическое сопротивление также увеличивалось, когда однослойный MoS 2 монокристаллические чешуйки окислены O 2 плазма [12]. В виде монокристалла MoS 2 без границ зерен может быть более устойчивым к окислению, чем поликристаллический MoS 2 , эффект легирования, вызванного окислением, может быть сильнее в поликристаллическом MoS 2 чем в монокристалле MoS 2 . Однако необходимы дальнейшие исследования, чтобы понять эту разницу в будущем.

Коэффициент электрического сопротивления MoS 2 монослои как функция UV-O 3 время лечения ( R После :электрическое сопротивление после УФ-О 3 лечение, R До :электрическое сопротивление перед УФ-О 3 лечение)
Выводы
Таким образом, мы исследовали эффект UV-O 3 обработка поликристаллических CVD тонких пленок и монокристаллических хлопьев монослоя MoS 2 . Однослойный MoS 2 становится прозрачным после UV-O 3 лечение, предполагающее образование широкозонного полупроводника MoO 3 . Как UV-O 3 время обработки увеличивается, интенсивность спектров ФЛ и КР значительно снижается, что свидетельствует об образовании оксидов или дефектов. В обоих MoS 2 , XPS-анализ показал образование связей Mo-O и MoO 3 . Однако в CVD MoS 2 тонкие пленки, преобразование Mo 4+ -и S 2- -состояние в Mo 5+ - и S 6+ -состояние также наблюдалось после UV-O 3 обработка, предполагающая возможное существование кислородных вакансий, MoO x S y , или Мо (SO 4 ) x . Как электрическое сопротивление монокристалла MoS 2 монослои значительно увеличиваются при более длительном УФ-О 3 время обработки, окисление монокристалла MoS 2 в МоО 3 похоже, обеспечивает незначительный допинг. Напротив, электрическое сопротивление CVD MoS 2 монослои уменьшались с увеличением длины УФ-О 3 время обработки, предполагая, что окисление CVD MoS 2 в МоО 3 обеспечивает допинг. Эти результаты демонстрируют значительное влияние кристалличности на эффект УФ-О 3 обращение на MoS 2 монослоев, что дает, возможно, интересные последствия для создания структур гетероперехода на основе двумерных наноматериалов.
Доступность данных и материалов
Все данные и материалы могут быть предоставлены по разумному запросу.
Сокращения
- CVD:
-
Химическое осаждение из паровой фазы
- I-V:
-
Ток-напряжение
- R После :
-
Сопротивление, измеренное после обработки озоном и ультрафиолетом
- R До :
-
Сопротивление, измеренное до обработки озоном и ультрафиолетом
- TMD:
-
Дихалькогениды переходных металлов
- UV-O 3 :
-
Ультрафиолет-озон
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
Наноматериалы
- MoS2 с контролируемой толщиной для электрокаталитического выделения водорода
- Влияние отжига in situ на подвижность и морфологию органических полевых транзисторов на основе TIPS-пентацена
- К цепочкам с одним атомом и расслоенным теллуром
- Большой боковой фотоэлектрический эффект в гетеропереходе MoS2 / GaAs
- Зависящая от смещения фоточувствительность многослойных фототранзисторов MoS2
- Изготовление тонких пленок SrGe2 на подложках Ge (100), (110) и (111)
- Изучение силы адгезии и стеклования тонких пленок полистирола с помощью атомно-силовой микроскопии
- Токсичность наночастиц CoFe2O4, покрытых ПЭГ, с лечебным эффектом куркумина
- Влияние морфологии и кристаллической структуры на теплопроводность нанотрубок из диоксида титана
- Роль наноматериалов и нанотехнологий в очистке сточных вод:библиометрический анализ



