Большой боковой фотоэлектрический эффект в гетеропереходе MoS2 / GaAs
Аннотация
Дисульфид молибдена (MoS 2 ) наноразмерные пленки наносятся на подложки GaAs методом магнетронного распыления, а MoS 2 / Изготовлены гетеропереходы GaAs. Боковой фотоэлектрический эффект (LPE) изготовленного MoS 2 / Исследованы гетеропереходы GaAs. Результаты показывают, что большой LPE может быть получен в MoS 2 / н -GaAs гетеропереход. LPE демонстрирует линейную зависимость от положения лазерного излучения и довольно высокую чувствительность 416,4 мВ мм - 1 . Эта чувствительность намного выше, чем значения в других отчетах MoS 2 на базе устройств. Для сравнения, LPE в MoS 2 / p -GaAs-гетеропереход намного слабее. Механизмы LPE раскрываются путем построения выравнивания энергетических зон MoS 2 / GaAs-гетеропереходы. Превосходные характеристики LPE делают MoS 2 пленки в сочетании с полупроводниками GaAs являются перспективными кандидатами для применения в высокопроизводительных позиционно-чувствительных детекторах.
Фон
Благодаря своим превосходным свойствам дисульфид молибдена (MoS 2 ) исследуется как один из типичных двумерных материалов для разработки микроэлектронных устройств следующего поколения и оптоэлектронных устройств [1,2,3,4,5]. В отличие от графена, MoS 2 имеет очевидную ширину запрещенной зоны, и ее запрещенная зона уменьшается с увеличением числа слоев [6]. Наличие очевидной запрещенной зоны позволяет изготавливать MoS 2 транзисторы с отношением включения / выключения более 10 8 и фотоприемники с высокой чувствительностью [7, 8]. Недавно MoS 2 в сочетании с другими полупроводниками вызывает большой интерес, например, GaAs, Si и GaN [9,10,11,12,13]. Эти разработанные гетероструктуры обеспечивают возможный технический путь для MoS 2 материалы для разработки практически применимых оптоэлектронных устройств. Среди всех этих объемных полупроводников GaAs имеет подходящую прямую запрещенную зону ~ 1,42 эВ и высокую подвижность электронов (~ 8000 см 2 V -1 s −1 ). Lin et al. сфабрикованный MoS 2 / GaAs солнечные элементы с эффективностью преобразования энергии более 9,03% [9]. Кроме того, Xu et al. сообщил о MoS 2 / GaAs-автоприводной фотоприемник с чрезвычайно высокой детектирующей способностью 3,5 × 10 13 Джонс [10]. В предыдущих отчетах исследования MoS 2 / Гетероструктуры GaAs в основном ориентированы на применение в области солнечных элементов и фотоприемников. Однако MoS 2 О / GaAs в качестве позиционно-чувствительного детектора (PSD), основанного на боковом фотоэлектрическом эффекте (LPE), сообщалось редко. В отличие от обычного продольного фотоэлектрического эффекта, LPE возникает из-за боковой диффузии и рекомбинации генерируемых фотонами носителей в инверсионном слое на границе раздела [14,15,16,17,18]. В эффекте LPE может быть получено боковое фотоэдс (LPV), которое изменяется линейно с положением лазерного пятна на активной области поверхности устройства. Эти характеристики делают LPE очень полезными при разработке высокопроизводительных PSD и широко изучены в области робототехники, биомедицинских приложений, управления процессами, систем информации о местоположении и т. Д.
В этой работе MoS 2 на поверхность n наносятся тонкие пленки разной толщины. - / p -GaAs подложки методом магнетронного распыления. В изготовленном MoS 2 наблюдается большая ЖПД. / н -GaAs гетеропереход, а чувствительность достигла 416,4 мВ мм −1 . Наши результаты также показывают, что LPE демонстрирует очевидную зависимость от типов носителей в подложках GaAs и толщины MoS 2 фильмы. За счет построения выравнивания энергетических диапазонов на интерфейсе предлагаются механизмы LPE в устройствах.
Методы
MoS 2 Нанесение тонких пленок на подложки GaAs с ориентацией (100) осуществлялось методом магнетронного распыления на постоянном токе. MoS 2 порошки (чистота ~ 99%) прессовались в диск холодным прессованием под давлением 20,0 МПа. Готовый диск (Φ60,0 мм × 4,5 мм) использовался в качестве мишени при напылении. n- / p В наших экспериментах использовались подложки -GaAs соответственно. Перед нанесением подложки были последовательно очищены ультразвуком спиртом, ацетоном и деионизированной водой. Впоследствии MoS 2 тонкие пленки разной толщины ( d MoS2 =~ 10, 30, 50, 90 нм) выращивались на подложках GaAs при температуре 400 ° C соответственно. Во время напыления рабочее давление и мощность поддерживались на уровне 1,0 Па и 10,0 Вт соответственно. Для справки:MoS 2 тонкие пленки были также нанесены на собственный GaAs ( i -GaAs) в тех же условиях. Наконец, на MoS 2 были прижаты электроды примерно 300 мкм In и диаметром 0,5 мм в качестве электродов. фильм.
MoS 2 Пленки были охарактеризованы с помощью рамановской спектроскопии (HORIBA, HR800) с длиной волны возбуждения 488 нм. Поверхность образца сканировали с помощью атомно-силового микроскопа (АСМ). Рентгеновскую фотоэмиссионную спектроскопию (XPS) выполняли на спектрометре Kratos Axis ULTRA с монохроматическим источником рентгеновского излучения Al Kα. Скорость осаждения определялась по толщине с помощью сканирующего электронного микроскопа (SEM) поперечного сечения (дополнительный файл 1:Рисунок S1) и времени осаждения, затем каждая толщина пленки определялась скоростью осаждения и каждым временем осаждения. Спектры пропускания измеряли на спектрофотометре Shimadzu UV-3150. Ультрафиолетовая фотоэлектронная спектроскопия (UPS) проводилась с использованием нефильтрованной газоразрядной лампы He-I (21,22 эВ). LPV измеряли с помощью вольтметра Keithley 2000 и трехмерного электрического моторизованного предметного столика с лазером с длиной волны 650 нм в качестве источника освещения. Ток-напряжение ( I - V ) кривые были измерены с помощью измерителя источника Keithley 2400.
Результаты и обсуждение
На рисунке 1 показан спектр комбинационного рассеяния света MoS 2 . пленка на подложке GaAs. Помимо пика подложки GaAs на ~ 287,1 см −1 , два характерных MoS 2 Видны рамановские пики, A 1g мода на ∼ 406,7 см −1 и E 1 2 г мода на ∼ 378.9 см −1 . Две правые вставки показывают иллюстрацию атомной вибрации в MoS 2 . . А 1g мода соответствует атомам S, колеблющимся в противофазе вдоль направления вне плоскости, а E 1 2 г мода соответствует колебаниям атомов S и Mo в противофазе параллельно плоскости кристалла. Как показано на рисунке, пик комбинационного рассеяния, соответствующий A 1g для пленки преимущественно возбуждается мода. Согласно нашим измерениям, коэффициент интенсивности A 1g / E 1 2 г составляет около 2,1. Эти характеристики комбинационного рассеяния аналогичны другим опубликованным результатам для MoS 2 тонкие пленки [19]. На левой вставке показано топографическое изображение, полученное с помощью АСМ, 40-нм MoS 2 пленка, выращенная на подложке GaAs. Из рисунка видно, что поверхность пленки состоит из плотных конусовидных зерен. Согласно измерениям, среднеквадратичная шероховатость пленки составляет около 1,7 нм, а средний размер зерен составляет около 76,3 нм в диаметре. Эти зерна на поверхности могут уменьшить отражение поверхности от внешнего света и увеличить поглощение света изготовленным устройством.

Рамановский спектр MoS 2 пленка на GaAs. Правые две вставки показывают схематические иллюстрации колебательного режима E 1 2 г и A 1g , соответственно. Цветовой код атома:светло-сине-зеленый, Мо; желтый, S. На левой вставке показано изображение морфологии поверхности выращенного MoS 2 фильмы
На рисунке 2 показаны XPS-спектры MoS 2 . фильм. Как показано на рис. 2а, пики при 229,3 и 232,5 эВ относятся к Mo 3d 5/2 и Mo 3d 3/2 орбитали соответственно. Как показано на рис. 2b, S 2p 3/2 и S 2p 1/2 орбитали двухвалентных сульфид-ионов (S 2- ) наблюдаются при 162,2 и 163,3 эВ соответственно. Результаты хорошо согласуются с заявленными значениями для MoS 2 кристалл [17, 18].

XPS-спектры MoS 2 фильм для а Мо и b S элементы соответственно
На рисунке 3а показан продольный I - V кривая изготовленного MoS 2 / н -GaAs гетеропереходы. Два In-электрода диаметром около 0,5 мм прижимались к поверхности MoS 2 . пленка и задняя сторона GaAs соответственно. На вставке представлена принципиальная схема продольных измерений. Прямое напряжение определяется как положительное напряжение смещения, приложенное к верхнему In-электроду. Как показано на рисунке, изготовленный MoS 2 / н -GaAs-гетеропереход демонстрирует очевидное выпрямляющее поведение. Коэффициент выпрямления ( I + / Я - ) при ± 1,0 В составляет около 520. В наших экспериментах как In / MoS 2 и In / GaAs относятся к омическим контактам и их I - V кривые почти линейны. Таким образом, выпрямительный I - V характеристика в гетеропереходе в основном происходит от MoS 2 / GaAs-контакт. На рисунке 3b показано поперечное сечение I - V кривая изготовленного MoS 2 / н -GaAs гетеропереходы. Два In-электрода диаметром около 0,5 мм прижимались к поверхности MoS 2 . фильм. На верхней вставке показана принципиальная схема поперечных измерений. На рисунке I - V кривая показывает слегка нелинейный рост токов с увеличением напряжения. Это указывает на то, что инверсионный слой в MoS 2 / н -GaAs интерфейс сформирован [18]. На нижней вставке показан I - V кривые одиночного MoS 2 пленки на собственной подложке GaAs. Как видно из рисунка, почти линейный I - V можно увидеть кривую, дополнительно указывающую на омическую природу In / MoS 2 контакт. При напряжении +0,5 В ток одиночного MoS 2 составляет примерно 3,1 × 10 −2 мкА, что намного меньше, чем значение в MoS 2 / н -GaAs, около 2,3 мкА. Таким образом, по сравнению с MoS 2 пленка, инверсионный слой на MoS 2 / н -GaAs интерфейс обеспечивает путь с гораздо более низким удельным сопротивлением для транспортировки носителей во время поперечных измерений MoS 2 / н -GaAs гетеропереход.

а Продольный I - V кривая изготовленного MoS 2 / н -GaAs гетеропереходы. На вставке представлена принципиальная схема продольных измерений. б Поперечный I - V кривые изготовленного MoS 2 / н -GaAs гетеропереходы. На верхней вставке показана принципиальная схема поперечных измерений. На нижней вставке показан I - V кривые MoS 2 пленки на собственной подложке GaAs
На рисунке 4а показана принципиальная схема измерения LPE изготовленного MoS 2 . / GaAs-гетеропереход. Два In-электрода диаметром 0,5 мм прижимаются к поверхности MoS 2 . пленка для проведения измерений LPE. Расстояние (2 L ) между электродами составляет ~ 1,0 мм. Во время наших измерений электроды A и B были подключены к положительному и отрицательному щупам вольтметра Keithley 2000 соответственно. На рисунке 4b показаны кривые LPE MoS 2 . / н -GaAs и MoS 2 / p -GaAs гетеропереходы соответственно. Толщина MoS 2 пленки составляет ~ 30.0 нм. Когда поверхность MoS 2 пленка частично освещается лазерным пятном диаметром около 0,1 мм, в MoS 2 можно наблюдать большой LPE. / н -GaAs гетеропереход. Как показано на рисунке, LPE показывает приблизительно линейную зависимость от положения лазерного пятна, когда лазерное пятно перемещается между электродами A и B на MoS 2 поверхность. Из рисунка видно, что ЛПВ зависит от положения лазерного пятна. Это можно согласовать с теорией диффузии [16],
$$ \ mathrm {LPV} ={K} _0 \ Big [\ exp \ left (- \ frac {\ left | Lx \ right |} {d} \ right) - \ exp \ left (- \ frac {\ left | L + x \ right |} {d} \ right) $$где K 0 , 2 L , d , и x представляют собой коэффициент пропорциональности, расстояние между двумя электродами, длину диффузии носителей и положение лазерного пятна соответственно. Хорошо подогнанные результаты на рисунке ясно показывают, что LPE в MoS 2 / н -GaAs-гетеропереход возникает из-за бокового диффузного потока и рекомбинации возбужденных носителей вдали от положения лазера. Как показано на рисунке, значение LPV равно нулю, когда световое пятно находится в центре между двумя электродами, что может быть связано с диффузионной симметрией носителей. Когда световое положение близко к электроду А, LPV положительный, и наоборот. Это указывает на то, что LPE в MoS 2 / н -GaAs-гетеропереход обусловлен фотовозбужденными носителями дырочного типа. Максимальный LPV достигается, когда лазерное излучение находится ближе всего к электродам. Согласно нашим измерениям, максимальная боковая фотоэдс (LPV max ) составляет около 208,2 мВ в линейной области MoS 2 / н -GaAs гетеропереход. Для сравнения, LPV MoS 2 / p -GaAs-гетеропереход намного меньше и его LPV max составляет всего 7,3 мВ, как показано на рисунке. Из рисунка видно, что LPE MoS 2 / p -GaAs-гетеропереход определяется фотовозбужденными носителями электронного типа. Кроме того, нелинейные характеристики LPE MoS 2 / p -GaAs-гетеропереход можно увидеть на рисунке, когда лазерное пятно перемещается между электродами A и B.
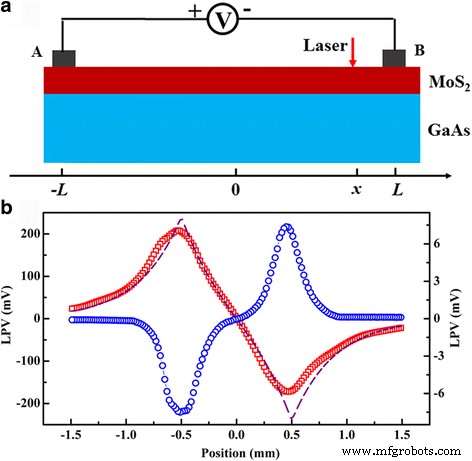
а Принципиальная схема измерения LPE. б Кривые LPE MoS 2 / н -GaAs и MoS 2 / p -GaAs гетеропереходы соответственно
На рисунке 5 показана чувствительность LPE MoS 2 . / н -GaAs-гетеропереход в зависимости от мощности и толщины лазера ( d MoS2 ) МОС 2 фильм. Чувствительность определяется S =LPV макс / L . Очевидно, что S сначала резко увеличивается с увеличением мощности лазера, но затем медленно насыщается при дальнейшем увеличении мощности. Это насыщение могло быть вызвано быстрым увеличением скорости рекомбинации фотовозбужденных дырок с увеличением интенсивности лазера в освещенной области [20]. Как показано на рисунке, очевидная LPE и высокая чувствительность могут быть получены даже при слабом лазерном освещении 100,0 мкВт. Из рисунка заметна значительная зависимость чувствительности от толщины MoS 2 фильмы можно посмотреть. Когда d MoS2 =~ 10,0 нм, S =165,4 мВ мм −1 при лазерной освещенности 100,0 мкВт. С увеличением толщины пленки S постепенно увеличивается. Когда d MoS2 =30,0 нм, S достигает 416,4 мВ мм −1 . Эта чувствительность намного выше, чем сообщаемый MoS 2 / Si устройства [17, 18]. Через d MoS2 > 30,0 нм, S уменьшается при дальнейшем увеличении MoS 2 толщина. Когда d MoS2 =90,0 нм, S = 283,3 мВ мм −1 . Таким образом, для получения максимальной LPE и чувствительности существует оптимальная толщина MoS 2 пленка в изготовленном MoS 2 / н -GaAs, около 30,0 нм.

Зависимость положительной и отрицательной чувствительности изготовленного MoS 2 / н -GaAs гетеропереход по мощности лазера соответственно
На рисунке 6а представлены спектры ИБП MoS 2 . пленка на подложке Si. Работа выхода ( W ) пленки можно рассчитать по разнице между отсечкой максимальной энергии связи и энергией фотонов возбуждающего излучения. На рисунке W =5,24 эВ. Расстояние (∆ E ) между валентной зоной ( E V ) и уровня Ферми ( E F ) MoS 2 пленка может быть извлечена из начальной энергии, как показано на вставке. ∆ E для MoS 2 пленки составляет около 0,51 эВ. Используя данные из спектра пропускания MoS 2 пленка на кварцевой подложке, ( αhν ) 2 график как функция энергии фотона hν , при этом h - постоянная Планка и ν - частота фотона. α коэффициент поглощения, рассчитываемый по формуле αd =ln (1 / T ) [21], где d и T - толщина и коэффициент пропускания пленки соответственно. Ширина запрещенной зоны ( E g ) пленки можно определить по пересечению линии на hν ось, E g =1,54 эВ, как показано на рис. 6б. На основе этих параметров энергетической зоны p -тип поведения MoS 2 пленка может быть определена, что может быть дополнительно подтверждено измерениями Холла. Результаты Холла показывают, что концентрация носителей дырочного типа и подвижность составляют примерно 3,8 × 10 15 см −3 и 11,2 см 2 V -1 s −1 соответственно.

а Спектры ИБП MoS 2 пленка на GaAs, показывающая уровень Ферми пленок и расстояние между уровнем Ферми и верхним краем зоны проводимости. б ( αhν ) 2 ~ hν кривая УФ-спектра MoS 2 пленка на кварцевой подложке при тех же условиях осаждения
Для выяснения механизмов LPE в MoS 2 / GaAs, зонные диаграммы на границе раздела построены на основе результатов, представленных на рис. 6. Здесь E g =1,42 эВ и E F =4,17 эВ для n -GaAs учитываются при построении зонной структуры [22]. Когда MoS 2 Если пленка нанесена на подложку GaAs, электроны перетекают из GaAs в MoS 2 пленка на интерфейсе из-за более высокого E F GaAs. Текущий процесс останавливается, когда уровни Ферми равны и MoS 2 / GaAs p - нет соединение изготовлено, как показано на рис. 7а. Следовательно, встроенное поле ( E би ) формируется на интерфейсе MoS 2 / GaAs-гетеропереход. E би =[ E F ( нет -GaAs) - E F (MoS 2 )] / e =1,07 В и указывает от GaAs к MoS 2 фильм. Таким образом, асимметричный продольный I - V кривая приведена на рис. 3а. Из-за наличия сильного E би , большое количество дырочных носителей накапливается вблизи границы раздела, и в n -GaAs подложка рядом с границей раздела, как показано на рис. 7b. Подобно двумерному дырочному газу (2DHG) [23], инверсионный слой может демонстрировать свойство высокой проводимости из-за высокой концентрации дырок в листе ( p + ). Из рис. 3b видно, что проводимость инверсионного слоя намного больше, чем у MoS 2 фильм. Таким образом, проводимость между двумя электродами на одной стороне MoS 2 В пленке преобладает инверсионный слой, а не MoS 2 фильм. Когда переход частично освещается лазером, свет поглощается и электронно-дырочные пары в MoS 2 пленка и GaAs могут быть индуцированы соответственно, как показано на рис. 7c. Однако можно ожидать, что большая часть лазера поглощается подложками GaAs из-за его гораздо большей толщины и меньшей ширины запрещенной зоны. При лазерном освещении электронно-дырочные пары могут возбуждаться только в освещенной области и пространственно разделены E би . Из-за ориентации E би указывает с GaAs на MoS 2 фотовозбужденные дырки текут к границе раздела и попадают в инверсионный слой в GaAs, как показано на рис. 7c. Фотовозбужденные отверстия в инверсионном слое диффундируют вбок от освещенного пятна к двум электродам. Концентрация возбужденных дырок, собранных двумя электродами, различна на разных расстояниях от освещенного пятна. Таким образом, между электродами образуется большой LPV, и LPE наблюдается в гетеропереходе. Это согласуется с результатами аппроксимации на рис. 3b и LPE в MoS2 / n -GaAs гетеропереходы в основном возникают в результате диффузии носителей заряда. Когда MoS 2 пленка наносится на p -GaAs субстрат, a p - p гетеропереход формируется, как показано на рис. 7г. E F ( p -GaAs) =5,32 эВ используется на зонной диаграмме [22]. E би из p - p Гетеропереход можно рассчитать, 0,08 В, и его направление указывает от пленки к подложке. Из-за E би , носители электронного типа накапливаются вблизи границы гетероперехода и формируется инверсионный слой. Таким образом, LPE, индуцированная диффузией фотовозбужденных электронов, получается в MoS 2 / GaAs p - p гетеропереход, как показано на рис. 4. Однако концентрация накопленных носителей в инверсионном слое может быть ниже из-за слабого V би всего 0,08 В в p - p гетеропереход по сравнению с p -MoS 2 / н -GaAs переход. Это увеличивает трудности транспортировки фотовозбужденных электронов в инверсионном слое. Серьезно, барьеры Шоттки могут быть образованы между n слой инверсии типа и p -MoS 2 пленка, как показано на рис. 7e. Эти характеристики p -MoS 2 / p -GaAs переход подавляет сбор фотовозбужденных электронов на электродах. В результате можно было значительно снизить LPE. Как показано на рис. 4b, LPV max для p - p переход составляет всего 7,3 мВ, в то время как он достигает 208,2 мВ в p - нет перекресток.

а Выравнивание диапазона энергий MoS 2 / н -GaAs гетеропереход и b соответствующий рисунок электрического контакта на интерфейсе. c Механизм LPE в MoS 2 / н -GaAs гетеропереход. г Выравнивание диапазона энергий MoS 2 / p -GaAs гетеропереход и e соответствующий рисунок электрического контакта на интерфейсе
Обычно в описанных СПМ типа гетероперехода LPE можно настраивать, изменяя толщину защитных слоев [20]. Это можно хорошо понять, рассматривая рекомбинацию фотовозбужденных носителей в пленке и эволюцию встроенного поля. В MoS 2 / GaAs p - нет перехода, рекомбинация генерируемых фотонами носителей может быть усилена из-за длинного пути транспортировки в толстом MoS 2 пленки до того, как они будут собраны электродами. Это снижает LPE гетеропереходов. И наоборот, более тонкая пленка может значительно уменьшить рекомбинацию, что приводит к увеличению LPE. Однако когда MoS 2 толщина меньше критического значения, E би на интерфейсе уменьшается с дальнейшим уменьшением MoS 2 толщина [24]. Это может уменьшить разделение генерируемых фотонами электронно-дырочных пар, и LPE уменьшается. Таким образом, существует оптимальная толщина MoS 2 пленка для получения максимальной LPE, около 30 нм.
Выводы
Таким образом, MoS 2 Тонкие пленки наносились на поверхность подложки GaAs методом магнетронного распыления. В изготовленном MoS 2 был получен большой LPE. / н -GaAs-гетеропереход, а зависимость LPV от положения лазерной засветки показала хорошую линейность. Из-за образования сильного встроенного поля на интерфейсе MoS 2 / н -GaAs-гетеропереход показал высокую чувствительность 416,4 мВ мм −1 , тогда как значение было всего 7,3 мВ мм −1 для MoS 2 / p -GaAs. Наши результаты также показали, что LPE демонстрирует очевидную зависимость от толщины MoS 2 пленки и около 30,0 нм была оптимальной толщиной MoS 2 пленка для получения самого высокого LPE в изготовленном MoS 2 / н -GaAs гетеропереходы. Механизмы LPE в MoS 2 / GaAs-устройства были уточнены на основе выравнивания энергетических зон на границе раздела.
Сокращения
- ∆ E :
-
Расстояние между E V и E F
- d MoS2 :
-
Толщина MoS 2 фильм
- E би :
-
Встроенное поле
- E C :
-
Уровень зоны проводимости
- E F :
-
Уровень энергии Ферми
- E g :
-
Ширина запрещенной зоны
- E V :
-
Уровень полосы валентности
- I - V :
-
Ток-напряжение
- LPE:
-
Боковой фотоэлектрический эффект
- LPV:
-
Боковое фотоэдс
- LPV max :
-
Максимальное боковое фотоэдс
- MoS 2 :
-
Дисульфид молибдена
- PSD:
-
Позиционно-чувствительный детектор
- ИБП:
-
Ультрафиолетовая фотоэлектронная спектроскопия
- W :
-
Рабочая функция
Наноматериалы
- Фотоэлектрические характеристики устройств с гетеропереходом GaSe / MoSe2
- MoS2 с контролируемой толщиной для электрокаталитического выделения водорода
- Температурная кристаллизация нанофлексов MoS2 на графеновых нанолистах для электрокатализа
- Многослойный композит MoS2 / ацетиленовый черный как эффективный анодный материал для литий-ионных батарей
- Зависящая от смещения фоточувствительность многослойных фототранзисторов MoS2
- Высокоэффективное определение H2 для многослойных гетеропереходов MoS2 / SiO2 / Si за счет декорирования поверхнос…
- Влияние различных морфологий CH3NH3PbI3 на фотоэлектрические свойства перовскитных солнечных элементов
- Оптимизация солнечных элементов с решеткой с нановолоконным GaAs с использованием гетеропереходов AlGaAs / GaAs
- Улучшенные фотоэлектрические свойства в солнечном элементе с плоским гетеропереходом Sb2S3 с подходом быстрог…
- Свойства переноса носителя асимметричного газового датчика MoS2 при барьерной модуляции на основе переноса за…



