Улучшенные сегнетоэлектрические характеристики пленок LiNbO3, легированных магнием, за счет идеального атомного слоя, осажденного слоем туннельного переключателя Al2O3
Аннотация
Двухслойные структуры из LiNbO, легированного 5% Mg 3 монокристаллические пленки и ультратонкий Al 2 О 3 слои толщиной от 2 до 6 нм были изготовлены с использованием техники ионного среза в сочетании с методом атомно-слоистого осаждения. Результаты измерения тока переключения переходной области показывают, что P-V Петли гистерезиса симметричны в режиме типа II с одиночным импульсом напряжения за цикл, что может быть связано со встроенным электрическим полем, образованным асимметричными электродами, и компенсацией внутреннего поля отпечатка. Кроме того, инкрустация Al 2 О 3 , как идеальный слой туннельного переключателя, включается во время переключения сегнетоэлектрика, но закрывается во время пост-переключения или без переключения под действием приложенного импульсного напряжения. Аль 2 О 3 слой блокирует побочные эффекты, такие как инжекция заряда у электрода, и улучшает усталостную выносливость LiNbO, легированного магнием 3 сегнетоэлектрические конденсаторы. Это исследование предоставляет возможный способ улучшить характеристики надежности сегнетоэлектрических устройств в энергонезависимой памяти.
Фон
Монокристаллические пленки ниобата лития (LN) благодаря своим превосходным физическим свойствам [1,2,3,4,5,6] широко используются в генераторах поверхностных акустических волн, электрооптических модуляторах и устройствах хранения данных на основе переключение домена. В последнее время масштабный пластинчатый ниобат лития на изоляторе (LNOI), который имеет большое потенциальное применение для интегральных схем высокой плотности в электрооптических, акустооптических устройствах и устройствах хранения данных, изготавливается с помощью технологии ионной имплантации и соединения пластин. . Эта технология позволяет использовать широкий спектр подложек, таких как LN, кремний и даже схему CMOS [3, 7,8,9]. Однако петля гистерезиса отпечатка возникла из-за предпочтительной ориентации, а низкая усталостная стойкость пленок LN из-за побочной инжекции заряда дестабилизирует сохранение инверсии поляризации, что ограничивает их применение в устройствах энергонезависимой памяти [10,11,12 , 13]. Предпочтительные ориентации связаны с межфазными пассивными слоями, образованными между слоями сегнетоэлектрика и электродами, которые могут индуцировать сильное поле деполяризации в противоположном направлении поляризации. Он может вытеснять введенные заряды после снятия приложенного напряжения или во время прерывистого времени последующего импульсного воздействия [11, 12]. С другой стороны, из-за наличия межфазных пассивных слоев усталостная износостойкость пленок LN будет улучшена за счет блокировки инжекции заряда с побочного электрода после переключения сегнетоэлектрика. Однако процесс утомления ускоряется, если время периодичности прикладываемых импульсов сокращается до менее 0,5 с. Это описывается вкладом межфазных пассивных слоев накопительного объемного заряда на определенных частотах [11]. Сообщается, что инкрустация Al 2 О 3 диэлектрическая пленка может играть роль туннельного переключателя в двухслойном диэлектрическом / сегнетоэлектрическом конденсаторе, например, в Al 2 О 3 / Pb (Zr, Ti) O 3 , и Al 2 О 3 / BiFeO, легированный Mn 3 двухслойные структуры [14,15,16]. Аль 2 О 3 Туннельный переключатель включается как проводник во время переключения поляризации, но выключается как изолятор, чтобы заблокировать инжекцию побочного заряда после завершения переключения поляризации или отсутствия переключения [14]. Следовательно, он может предотвратить нежелательные инжектируемые заряды и обратное переключение поляризации, а затем повысить надежность диэлектрического / сегнетоэлектрического двухслойного конденсатора.
В этой статье мы изготовили конгруэнтные монокристаллические тонкие монокристаллические пленки LN с Z-образным срезом толщиной 200 нм и 5% Mg, а затем нанесли ультратонкий Al 2 О 3 слои различной толщины (2–6 нм) на НС для формирования двухслойных конденсаторных структур. Аль 2 О 3 пленки в качестве слоев туннельного переключателя могут улучшить усталостную выносливость. Асимметричные электроды (электроды Au / Pt) предназначены для формирования встроенного электрического поля против поля деполяризации, индуцированного межфазными пассивными слоями. Электрические результаты демонстрируют симметризацию петли гистерезиса, передаваемую из переходных процессов тока переключения домена со временем. Между тем, это также доказывает, что инкрустация Al 2 О 3 Слой туннельного переключателя играет роль слоя туннельного переключателя, который может появиться во время переключения сегнетоэлектрика и закрываться после завершения переключения поляризации или без операции переключения.
Методы
Конгруэнтный LiNbO 3 , легированный 5% Mg Z-срез (LN) монокристаллические тонкие пленки отслаивались от их объемных кристаллов с использованием технологии ионной имплантации и соединения пластин, как описано в других работах [10, 11, 17, 18]. Более подробно, поверхностный слой объемного кристалла LN сначала был имплантирован ионами He на желаемой глубине путем управления энергией имплантации и дозой введенных ионов, а затем осаждается адгезионный слой Cr 5 нм и слой нижнего электрода Pt 100 нм с помощью постоянного тока. напыление (KJ Lesker PVD-75). Поверхностный слой был прикреплен к другой подложке LN, покрытой SiO 2 толщиной 1 мкм. буферный слой и отрезанный. Толщина пленки LN регулируется примерно до 200 нм с помощью химико-механической полировки. Впоследствии ультратонкий Al 2 О 3 пленки толщиной ( d ) размером 2–6 нм были нанесены на ALD (TFS-200, Beneq, Финляндия). В частности, газами-предшественниками являются диэтилцинк и деионизированная вода. Они подавались в реакционную камеру поочередно с длительностью импульса 50 мс и разделялись этапами продувки аргоном в течение 2 с при температуре реакции 200 ° C [19]. Наконец, верхние квадратные электроды из золота с площадью 1,0 × 10 −4 см 2 были нанесены через неглубокую металлическую маску.
Толщина Al 2 О 3 Слои, нанесенные на кремниевую пластину в качестве контраста, измеряли с помощью системы спектроскопической эллипсометрии (GES-5E, SOPRA, Курбевуа, Франция). Структура пленки была проанализирована методом рентгеновской дифракции (XRD) (Bruker D8 Advance) в режиме сканирования θ-2θ с Cu K α радиационная, а также сканирующая электронная микроскопия поперечного сечения (SEM, Sigma HD, Zeiss). Для исследования динамики переключения доменов на верхние электроды подавалось несколько прямоугольных импульсов с временем нарастания 10 нс с помощью одноканального генератора импульсов Agilent 8114A, нижние электроды которого были заземлены. В схеме ток переключения домена ( I sw ) на последовательно соединенных внутренних резисторах всех приборов, общее сопротивление контролировалось с помощью осциллографа LeCroy HDO6054. Значения обоих выходных сопротивлений генератора импульсов R W и входное сопротивление осциллографа R O равны 50 Ом соответственно.
Результаты и обсуждение
На рисунке 1а показан результат XRD тонкой пленки LN на Pt / Cr / SiO 2 / LN субстрат. Пленка имеет сильную (00 л ) рефлексов, индексированных по симметрии ромбоэдрической фазы. Кроме того, есть дифракционные пики от пленок Pt и Cr, отмеченные на рис. 1а. Отсутствие каких-либо других пиков подтверждает высокую кристалличность пленки LN без фазовой примеси. SEM-изображение поперечного сечения образца, показанного на рис. 1b, демонстрирует четкую структуру интерфейса с LN, Pt, Cr и SiO 2 наложение слоев.
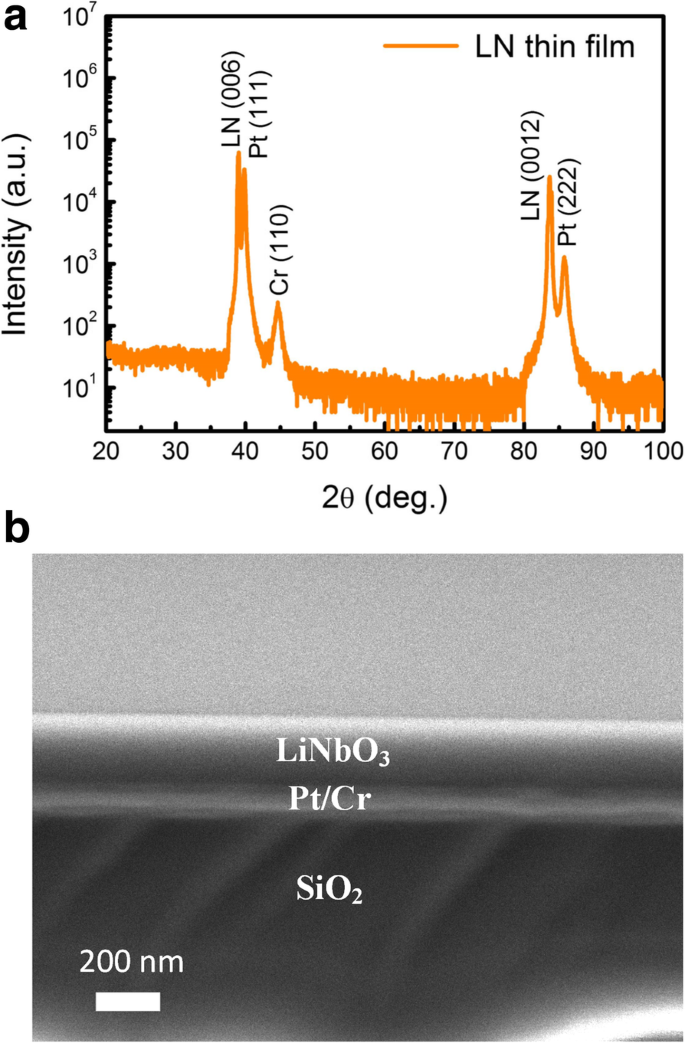
а Диаграмма XRD и b СЭМ-изображение поперечного сечения Z-среза LN / Pt / Cr / SiO 2 толщиной 200 нм / LN фильм
Для изучения кинетического механизма переключения доменов разработаны два типа режимов импульсного напряжения, как ясно показано на рис. 2a и b [11]. Тип I настроен как двойные импульсы противоположной полярности с временным интервалом 5 с. Первый импульс применяется для переключения состояния восходящей поляризации, указывающего на верхний электрод, а второй может переключать нисходящую поляризацию. Однако, ограниченный временем программирования генерации одноканального импульса, минимальный временной интервал слишком велик, чтобы уловить переходный процесс тока переключения домена, вызванный вторым импульсом, из-за предпочтительной ориентации домена. Чтобы уловить переходный процесс тока переключения домена, в типе II предлагается одиночный импульс, перекрывающий отрицательное базовое смещение постоянного тока, где начальное отрицательное смещение постоянного тока может переключать состояние восходящей поляризации, а положительный импульс устанавливает область вниз. Здесь ширина импульсов двух типов установлена на 1 мкс.

Схема двух режимов последовательного импульсного напряжения с a тип I (двойные импульсы двух противоположных полярностей) и b тип II (одиночный импульс переключения, перекрывающий отрицательное смещение постоянного тока). Переходные процессы тока переключения домена при различных V применен к исходному образцу в c тип I и d режимы типа II, где на вставках показана линейная аппроксимация зависимости плато тока переключения доменов от V . P - V петли гистерезиса при различных V перенесены из домена переключения текущих переходных процессов в e тип I и f тип II. Принципиальная схема структуры Au / LN / Pt и направления встроенного электрического поля E b и поле деполяризации E d на вставке e
На рисунках 2c и d показаны переходные процессы тока переключения домена в зависимости от времени ( t ) образца структуры Au / LN / Pt при различных приложенных напряжениях ( V ) в режимах типа I и типа II соответственно. Наблюдаются плато переходных процессов тока переключения домена, которые сужаются по ширине, но увеличиваются в высоту с V увеличивающийся после начального заряда конденсатора ток на 30 нс. Высота плато в двух режимах показывает линейную зависимость с увеличением V . и результаты суммированы на вставках путем аппроксимации данных сплошной линией [11, 13]. Коэрцитивное напряжение ( В c ) значение в двух режимах может быть получено примерно до 24,7 В из пересечения линии с осью напряжения. После окончания импульса переключения ток разряда конденсатора возникает через 1 мкс, что свидетельствует о том, что предпочтительной ориентацией домена является состояние восходящей поляризации, указывающее на верхний электрод.
P - V Петли гистерезиса при различных приложенных напряжениях в двух режимах могут передаваться непосредственно из соответствующих переходных процессов тока переключения домена на рис. 2c и d, а результаты показаны на рис. 2e и f соответственно [11, 20]. Определенное прямое коэрцитивное напряжение около 25 В, неизменное с V получается в двух типах импульсов. Коэрцитивное напряжение приближается к В c извлекается из линейного I sw - V график на вставке к рис. 2в и г. В отличие от нелегированной пленки LN, V c переменная величина, равная максимальному приложенному напряжению [10]. Для LN, легированного 5% Mg, определенное значение V c неизменен с V , как показано на рис. 2e и f. Это связано с тем, что легирование Mg может генерировать металлические вакансии в литиевых узлах и дефекты, связанные с кислородными вакансиями, [21,22,23], которые могут захватывать пространственные заряды и эффективно сокращать время деградации сопротивления в межфазных слоях между пленкой и верхним / нижним слоями. электроды [11]. Следовательно, токи переключения домена перекрываются с токами заряда конденсатора при увеличении скорости переключения домена с определенным V c , как показано на рис. 2c и d. Однако, ограниченное генератором импульсов, выходное базовое напряжение в режиме типа II не может быть смещено симметрично при увеличении приложенного импульсного напряжения более 32 В. По сравнению с отпечатанными петлями вдоль оси положительного напряжения на рис. 2e, симметризация петель достигнутые вдоль оси напряжения на рис. 2е, отличные от таковых в Pt / LiNbO 3 / Pt структуры, где P - V Петли гистерезиса либо в типе I, либо в типе II отпечатываются в направлении положительного напряжения [11]. Причина симметричного P - V петли на рис. 2е можно отнести к разработанным асимметричным электродам (здесь Au / Pt). Работа выхода Au электрода составляет 5,1 эВ, что несколько меньше, чем у Pt (5,65 эВ) [24]. Возникнет встроенное электрическое поле ( E b ) с направлением, указывающим от верхнего электрода к нижнему электроду, как показано на вставке к рис. 2e. Поле деполяризации ( E d ), индуцированная межфазными пассивными слоями, имеет направление, противоположное E b . E d может переключить поляризацию обратно за очень короткое время после окончания импульса переключения в типе II для симметричных электродов (Pt / Pt) [11]. В нашем эксперименте E b может частично экранировать E d и накапливают введенные заряды в качестве компенсации внутреннего импринт-поля [16], что может замедлить время обратного переключения. Следовательно, коммутируемый домен может поддерживать, а переходный ток обратного переключения будет захвачен импульсом типа II. Однако временной интервал двух импульсов с противоположной полярностью в режиме типа I слишком велик. После первого импульса захваченные введенные заряды на E b будет постепенно вытеснен из фильма E d до прихода второго импульса у I типа [11]. Чтобы доказать приписывание встроенного электрического поля симметризации петель, Pt / LiNbO 3 Был подготовлен образец симметричной структуры / Pt, и отпечатанные петли вдоль оси положительного напряжения были перенесены непосредственно из соответствующих переходных процессов тока переключения домена в Дополнительном файле 1:Рисунок S1a при положительном импульсе с напряжениями / шириной 30–40 В / 500 нс, показано в Дополнительном файле 1:Рисунок S1b.
На рисунках 3a и b показан ток переключения домена ( I sw ) переходные процессы в зависимости от времени ( t ) LN и Al 2 О 3 (6 нм) / образцы LN при разном приложенном напряжении ( V ) в режиме типа I. После плато переключения домена ток переключения I sw распадается и определяется по формуле:[13]
$$ {I} _ {\ mathrm {sw}} ={I _ {\ mathrm {sw}}} ^ 0 \ exp \ left (- \ frac {t- {t} _0} {R _ {\ mathrm {L}) } {C} _ {\ mathrm {i}}} \ right) \ \ left ({t} _0 \ le t \ le {t} _ {\ mathrm {sw}} \ right) $$ (1)где t 0 , t sw , R L , и C я - время начала переключения домена, время завершения переключения домена, полное сопротивление всех последовательно включенных резисторов в цепи и межфазная нефегнетоэлектрическая емкость, соответственно. Это описывает эффект захвата заряда, который можно смоделировать как межфазный пассивный слой, соединенный последовательно с идеальным сегнетоэлектрическим слоем. Я sw 0 определяется как ток переключения и определяется выражением:
$$ {I _ {\ mathrm {sw}}} ^ 0 =\ frac {V- {V} _ {\ mathrm {fc}}} {R _ {\ mathrm {L}}} $$ (2)
а , b Я sw - т зависимости в типе I при разных V применяется к Al 2 О 3 / LN бислой с Al 2 О 3 толщина d =0 и 6 нм, соответственно, подобраны серией параллельных пунктирных линий к формуле. (1). c Плато тока переключения домена в зависимости от приложенного напряжения при различных Al 2 О 3 толщины слоя, где сплошные линии показывают наилучшее соответствие данных уравнению. (2). г Аль 2 О 3 -толщина слоя d зависимость коэрцитивного напряжения ( В c ) извлечено из c . е , f Извлеченная межфазная емкость C я и контактное сопротивление R C как функции Al 2 О 3 толщина слоя d
Во время переключения домена напряжение, приложенное к слою сегнетоэлектрика, фиксируется на уровне коэрцитивного напряжения V . fc , и дополнительное напряжение ( В - V fc ) применяется к R L . R L также включены паразитные сопротивления цепи ( R P ) и контактного сопротивления ( R C ) между пленкой и электродами; следовательно, R L = R O + R W + R P + R C . Затухающая часть переходных процессов тока переключения в зависимости от времени может быть описана уравнением. (1). Постоянная времени R L C я можно оценить по наклону подобранных линий. На рисунке 3c показан I sw 0 - V участки с разным Al 2 О 3 толщины. R L и V C были оценены по наклонам и X -осевое пересечение линейных аппроксимирующих линий. Видно, что V C увеличивается линейно с увеличением Al 2 О 3 толщина d , как показано на рис. 3d. Здесь C я значения были оценены как границы ошибки для каждого V на рис. 3д [13]. Результаты показывают, что C я значение почти остается постоянным (1,4 ± 0,2) нФ с увеличением Al 2 О 3 толщина слоя от 0 до 6 нм.
Для расчета R C , верхний и нижний электроды закорочены, что может привести к возникновению R P (~ 2 Ом) с разными приложенными напряжениями, показанная как калибровка цепи открытыми символами на рис. 3c. Следовательно, R C соответствует d рассчитывается, и результат показан на рис. 3е. R C линейно возрастает от 3 ± 2,5 Ом при d =От 0 до 55 ± 10 Ом при d =6 нм. Почти d -независимый большой C я значения предполагают, что Al 2 О 3 слой работает как последовательный резистор во время переключения домена. Это означает, что Al 2 О 3 Туннельный переключатель был включен во время переключения FE.
Чтобы получить полную емкость бислоя при отсутствии переключения FE, переключение ( P sw ) и без переключения ( P nsw ) поляризации vesus V с d увеличились с 0 до 6 нм под действием импульсов в режиме I типа, и результат показан на рис. 4а. Целью выбора импульса типа I является получение кривой P nsw - V когда направление приложенного напряжения соответствует ориентации поляризации, от которой общая емкость ( C малыш ) бислоя можно вычислить из соотношения, C малыш = S · dP nsw / dV , где S - площадь электрода. Он может полностью исключить эффекты заряда посредством переключения FE в импульсном режиме типа I, но использование режима типа II не может достичь этого эффекта с отрицательной переключаемой поляризацией, которая может переключить обратно поляризацию, связанную с инжекцией зарядов. Разница между P sw и P nsw равно 2Pr, как показано на рис. 4а. Небольшое изменение с d от 0 до 6 нм, тогда как P nsw (открытые символы) сигналы слишком слабые, чтобы их можно было контролировать с помощью осциллографа. Чтобы доказать Al 2 О 3 слой туннельного переключателя, работающий как диэлектрический конденсатор, прямой C малыш измерения с использованием низкочастотного анализатора импеданса на частоте 100 кГц без дополнительного смещения постоянного тока были выполнены, и их результаты показаны на рис. 4b, которые могут быть аппроксимированы уравнением. (3):
$$ \ frac {1} {C _ {\ mathrm {tot}}} =\ frac {1} {C _ {\ mathrm {f}}} + \ frac {d} {\ varepsilon_0 {\ varepsilon} _ {\ mathrm {Al}} S} $$ (3)где ε Аль - диэлектрическая проницаемость Al 2 О 3 слой и ε 0 - вакуумная диэлектрическая проницаемость свободного пространства. C f и S представляют собой емкость сегнетоэлектрического слоя и площадь электрода соответственно. На рисунке 4b показан линейный 1 / C малыш по сравнению с d сюжет, который предполагает, что Al 2 О 3 слой становится хорошо изолирующей диэлектрической пленкой в условиях отсутствия переключения или после переключения. Можно вывести, что C f ≈ 14 пФ и ε Аль ≈ 7,9 из уравнения. (3). Следовательно, вставленный тонкий Al 2 О 3 слой зарекомендовал себя как диэлектрический конденсатор. Во время отсутствия переключения FE, а также после переключения FE, Al 2 О 3 Туннельный переключатель замыкается как изолятор.
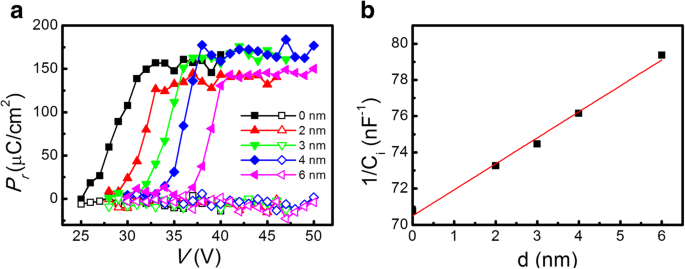
а Переключение ( P sw ) и без переключения ( P nsw ) поляризаций в зависимости от V с d увеличился с 0 до 6 нм под действием импульсов в режиме I типа. б Аль 2 О 3 -толщина слоя d зависимость 1 / C малыш измеряется анализатором импеданса при 100 кГц
На рисунках 5 показаны принципиальные схемы Al 2 . О 3 / LN двухслойная структура переключена в режим типа I или типа II. На рисунке 5a схематически изображена эквивалентная двухпозиционная схема последовательно соединенных резисторов и конденсаторов для Al 2 . О 3 туннельный переключатель. В исходном состоянии, как показано на фиг. 5b, предпочтительной ориентацией поляризации является состояние восходящей поляризации, указывающее на верхний электрод. Встроенное электрическое поле, индуцированное асимметричными электродами, направляется от Au-электрода к Pt-электроду. При подаче поляризационного напряжения происходит переключение FE. Подразумевается, что напряжение прикладывается обратно пропорционально емкости в цепи. В Al 2 О 3 / LN двухслойная структура, при переключении FE слой LN имеет большую емкость. Следовательно, большая часть внешнего приложенного напряжения применяется к Al 2 О 3 слой. Ультратонкий Al 2 О 3 слой нагнетается зарядом электрода. Он включается как резистор, когда приложенное напряжение превышает Al 2 О 3 порог туннелирования, как показано на рис. 5c. После завершения переключения FE или в случае отсутствия переключения емкость слоя LN очень мала и приложенное напряжение на Al 2 О 3 уменьшается ниже порогового напряжения туннелирования. На данный момент Al 2 О 3 слой играет роль изолятора и отключается, как показано на рис. 5d.
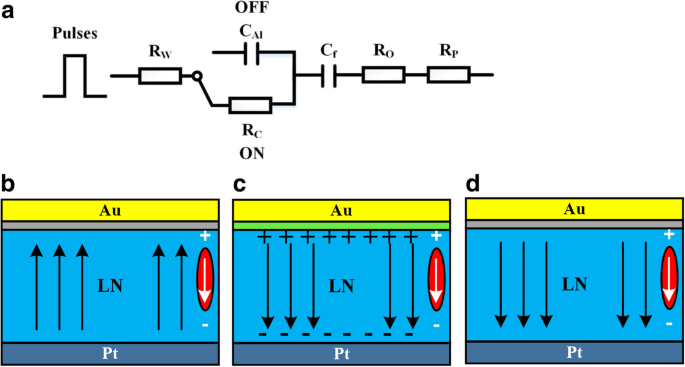
Принципиальные схемы Al 2 О 3 / LN двухслойная структура переключается на тип I или тип II. а Схема эквивалентной двухпозиционной схемы последовательно соединенных резисторов и конденсаторов для Al 2 О 3 туннельный переключатель. б Первоначальная предпочтительная ориентация поляризации и встроенное электрическое поле; c Аль 2 О 3 включение туннельного коммутатора и переключение домена; г Аль 2 О 3 выключение туннельного переключателя и сохранение поляризации
На рисунке 6 показаны зависимости числа циклов переключаемых поляризаций в Al 2 . О 3 / LN двухслойная структура толщиной Al 2 О 3 в диапазоне от 0 до 6 нм в режиме типа I. Длительность импульсов 1000 нс с периодичностью 0,5 с. Хорошо видно, что усталостная выносливость Al 2 О 3 Двухслойная структура / LN постепенно улучшается с увеличением содержания Al 2 О 3 толщиной более 10 4 циклы импульсного нагружения. Свойство усталости в режиме типа II аналогично результату в режиме типа I, который был показан в Дополнительном файле 1:Рисунок S2 вспомогательной информации. К сожалению, электрический пробой легко мог бы произойти в режиме типа II после длительной подачи постоянного напряжения с напряжением около 10 4 циклы импульсного нагружения. Данные могут быть подогнаны с использованием модели сосуществования пиннинга и депиннинга доменной стенки в пределах каждого цикла, как показано сплошными линиями на рис. 6, где физика усталости была отнесена к побочной инжекции заряда [13]. Когда Al 2 О 3 слой, вставленный между Au-электродом и слоем LN, он может блокировать путь заряда инжекции побочного электрода и повышать усталостную выносливость. Однако в двухслойной структуре следует рассмотреть некоторые вопросы. Например, при увеличении толщины Al 2 О 3 от 0 до 6 нм коэрцитивное напряжение увеличилось примерно с 25 до 34 В, что может быть уменьшено за счет улучшения качества Al 2 О 3 слой. Собственно, несколько атомных слоев Al 2 О 3 с высоким качеством или меньшим дефектом может эффективно блокировать заряды, вводимые электродами, что подтверждается в другом месте путем оптимизации условий обработки осаждения атомного слоя (таких как температура и время) [25].
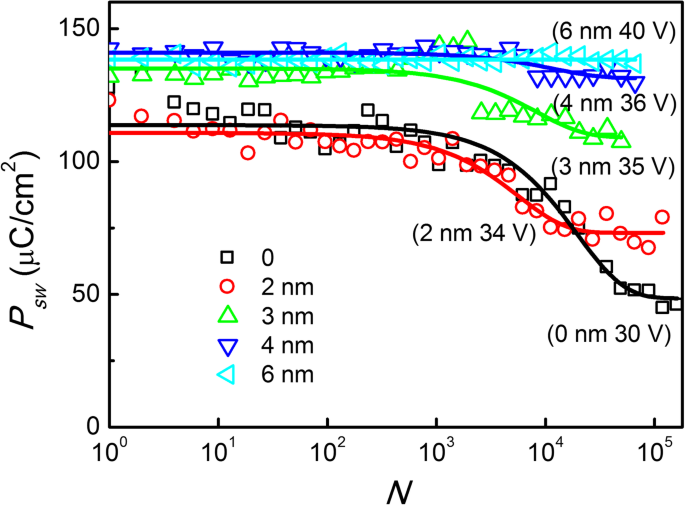
Зависимости числа циклов переключаемых поляризаций в Al 2 О 3 / LN двухслойная структура толщиной Al 2 О 3 от 0 до 6 нм менее 10 4 циклы импульсного нагружения. Ширина импульсов 1000 нс с периодичностью 0,5 с
Недавно в нашей следующей исследовательской работе [26, 27] были предложены сегнетоэлектрическая память на доменных стенках, основанная на стираемых проводящих заряженных доменных стенках и неразрушающем электрическом считывании состояний поляризации. Большая проводимость заряженных доменных границ в монокристаллах ниобата лития достигается после переключения доменов [28, 29]. Следовательно, более тонкие монокристаллические тонкие пленки ниобата лития на кремниевых подложках являются многообещающими материалами для интегральных сегнетоэлектрических запоминающих устройств на доменных стенках, а их удерживающие и усталостные свойства могут быть улучшены за счет конструкции Al 2 О 3 / бислой ниобата лития.
Выводы
Двести нанометров LiNbO 3 Монокристаллические пленки с 5% -ным легированием Mg получали ионным срезом поверхностных слоев объемных монокристаллов LN, а затем ультратонких Al 2 О 3 Пленки толщиной от 2 до 6 нм в качестве слоев туннельного переключателя были нанесены на пленку LN, легированную 5% Mg, с образованием двухслойных структур путем осаждения атомных слоев. Симметризованный P-V Петли гистерезиса вдоль оси напряжения наблюдаются при приложенных импульсных напряжениях в режиме типа II, что может быть связано со встроенным электрическим полем, индуцированным асимметричными электродами в Au / LiNbO 3 / Pt и компенсация внутреннего поля отпечатка. Ток переключения домена ( I sw ) переходные процессы и их перенесенные P-V петли гистерезиса показывают, что ультратонкий Al 2 О 3 слой играет роль переключателя туннеля идеи. Он включается во время переключения FE, но закрывается во время отсутствия переключения или после переключения FE, сводя к минимуму неблагоприятные помехи при переключении FE. Кроме того, усталостная износостойкость конденсатора FE постепенно улучшается с увеличением толщины слоя туннельного переключателя с 2 до 6 нм. Аль 2 О 3 Двухслойная структура / LN открывает путь к разработке надежных сегнетоэлектрических устройств, решающих проблему усталости за счет инжекции заряда электрода.
Сокращения
- ALD:
-
Осаждение атомного слоя
- CMOS:
-
Дополнительный металлооксидный полупроводник
- FE:
-
Сегнетоэлектрик
- LN:
-
Ниобат лития
- SEM:
-
Сканирующая электронная микроскопия
- XRD:
-
Рентгеновская дифракция
Наноматериалы
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на по…
- Фотокаталитические свойства порошков TiO2 с покрытием Co3O4, полученных методом плазменного осаждения атомного …
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Настройка уровня Ферми пленок ZnO посредством суперциклического осаждения атомного слоя
- Изготовление иерархических гетероструктур ZnO @ NiO Core – оболочка для улучшения фотокаталитических характерист…
- Зависимость толщины от межфазных и электрических свойств в атомарном слое, нанесенном на GaN c-плоскости
- Влияние вариаций травления на формирование каналов Ge / Si и производительность устройства
- Аналоговые / ВЧ характеристики Т-образного затвора с двойным источником туннельного полевого транзистора
- Улучшенные термоэлектрические характеристики эпитаксиальных тонких пленок BiCuSeO, легированных Ba, с осью c-ось…



