Аналоговые / ВЧ характеристики Т-образного затвора с двойным источником туннельного полевого транзистора
Аннотация
В этой статье предлагается и исследуется кремниевый туннельный полевой транзистор с двойным истоком и Т-образным затвором (TGTFET) с помощью моделирования TCAD. В качестве сравнительного исследования обсуждаются структура, характеристики и аналоговые / радиочастотные характеристики TGTFET, LTFET и UTFET. Перекрытие затвора, создаваемое затвором Т-образной формы, может повысить эффективность туннельного перехода. Области с двумя источниками в TGTFET могут увеличивать ток в открытом состоянии ( I ВКЛ ), предлагая удвоенную площадь туннельного перехода. Чтобы еще больше повысить производительность устройства, в TGTFET введен карман n + для дальнейшего увеличения скорости межполосного туннелирования. Результаты моделирования показывают, что I TGTFET ВКЛ и коэффициент переключения ( I ВКЛ / Я ВЫКЛ ) достигают 81 мкА / мкм и 6,7 × 10 10 при напряжении затвора 1 В к источнику ( В g ). Среднее подпороговое колебание TGTFET (SS avg , от 0 до 0,5 В В g ) достигает 51,5 мВ / дек, а минимальный подпороговый размах TGTFET (SS min , при 0,1 В В g ) достигает 24,4 мВ / дек. Более того, обнаружено, что TGTFET обладает высокой устойчивостью к эффекту снижения барьера, вызванного стоком (DIBL). Влияние концентрации легирования, геометрических размеров и приложенного напряжения на характеристики устройства исследуется с целью разработки рекомендаций по проектированию TGTFET. Кроме того, крутизна ( g м ), выходная проводимость ( g ds ), емкость затвора к истоку ( C GS ), емкость затвор-сток ( C gd ), частота среза ( f T ), а полоса пропускания усиления (GBW) TGTFET достигает 232 мкСм / мкм, 214 мкСм / мкм, 0,7 фФ / мкм, 3,7 фФ / мкм, 11,9 ГГц и 2,3 ГГц при 0,5 В напряжение сток-исток ( V d ), соответственно. Благодаря структурному преимуществу TGTFET имеет лучшие характеристики постоянного / переменного тока по сравнению с UTFET и LTFET. В заключение отметим, что высокая производительность превращает TGTFET в очень привлекательный выбор для следующего поколения маломощных и аналоговых / радиочастотных приложений.
Фон
Уменьшение размера полевых транзисторов металл-оксид-полупроводник (MOSFET) приводит к значительному улучшению энергопотребления интегральной схемы (ИС), характеристики переключения, функции схемы и плотности ИС [1, 2]. Но непримиримое противоречие между масштабированием напряжения питания и уменьшением токов утечки в закрытом состоянии ( I ВЫКЛ ) в конечном итоге приведет к неприемлемо высокому энергопотреблению [3]. В то же время ухудшение надежности, вызванное эффектами короткого канала (SCE), становится все более серьезным [4, 5]. Для решения этих проблем можно уменьшить подпороговое колебание (SS) и напряжение питания устройств. Основываясь на механизме межполосного туннелирования, туннельные полевые транзисторы (TFET) достигают подпорогового размаха (SS) менее 60 мВ / дек, и могут эффективно снижать напряжение питания [6,7,8,9,10] . Более того, из-за наличия туннельного перехода рядом с источником, TFET обычно имеет небольшую емкость затвора к истоку ( C GS ) [1, 11], что положительно сказывается на частотных характеристиках устройства.
Недавние исследования показывают, что TFET представляется многообещающим кандидатом для будущих приложений с низким энергопотреблением [12,13,14,15,16] и аналоговых / радиочастотных приложений [17,18,19]. Однако из-за небольшой эффективной площади туннелирования ограниченный туннельный ток становится неотъемлемым недостатком обычного транзистора P-I-N TFET, что приводит к низкому рабочему току в открытом состоянии ( I ВКЛ ). Чтобы улучшить характеристики TFET, в последние годы было предложено много новых структур [20,21,22,23,24,25]. Используя утопленный затвор, L-образный туннельный полевой транзистор (LTFET) [23, 24] и U-образный туннельный полевой транзистор (UTFET) [25] были предложены для получения высокого I ВКЛ с компактной конструкцией устройства. Однако есть еще много возможностей для улучшения LTFET и UTFET, и необходимо приложить больше усилий для изучения аналоговых / радиочастотных характеристик этих устройств.
В этой статье предложен туннельный полевой транзистор с Т-образным затвором и двойным истоком (TGTFET) с двойным истоком, который исследуется с помощью моделирования TCAD. Разработанный TGTFET может удвоить площадь туннельного перехода по сравнению с LTFET и UTFET. Перекрытие затвора, создаваемое спроектированным затвором Т-образной формы, может повысить скорость межполосного туннелирования (скорость BBT). Результаты моделирования показывают, что предлагаемый TGTFET имеет более высокое значение I . ВКЛ (8,1 × 10 - 5 А / мкм при V d =1 В), чем LTFET и UTFET при тех же условиях. Оба СС мин (при V g =0,1 В) и SS avg (0 ~ 0,5 В В g ) TGTFET ниже 60 мВ / дек (24,4 мВ / дек и 51,5 мВ / дек соответственно). TGTFET получает лучшую характеристику ввода / вывода ( g м =232 мкСм / мкм, г ds =214 мкСм / мкм), чем UTFET и LTFET. Кроме того, подробно обсуждаются емкостные характеристики TGTFET, UTFET и LTFET. Наконец, TGTFET получает лучшие аналоговые / ВЧ характеристики ( f T =11,9 ГГц и GBW =2,3 ГГц) по сравнению с UTFET и LTFET. В результате может быть получен TGTFET со значительно хорошими характеристиками. Структура этой статьи следующая:раздел «Методы» включает описание структуры и параметров TGTFET, LTFET [23, 24] и UTFET [25]. ], а также методы моделирования TCAD. Раздел «Результаты и обсуждение» включает описание результатов моделирования. В этом разделе изучаются механизм, характеристики и аналоговые / ВЧ характеристики TGTFET и сравниваются с LTFET и UTFET. Подробно проанализировано влияние параметров устройства на TGTFET. В разделе «Выводы» приводится заключение этой статьи.
Методы
Структура туннельного полевого транзистора с двойным истоком и Т-образным затвором (TGTFET) проиллюстрирована на рис. 1. Форма затвора аналогична букве алфавита «T» (зеленая область). Области двойного источника расположены с двух сторон от затвора (области сапфира). Два кармана n + (желтые области) вставлены для увеличения скорости туннелирования каналов [20,21,22]. Слив n + размещается внизу канала. Следовательно, Т-образный затвор перекрывает n + карманов как в вертикальном, так и в боковом направлениях. Таким образом, электрическое поле в верхней части туннельного перехода может быть увеличено. Увеличение электрического поля приводит к более крутому изгибу энергетической полосы. Наконец, скорость туннелирования электронов увеличивается за счет усиления углового электрического поля [26].
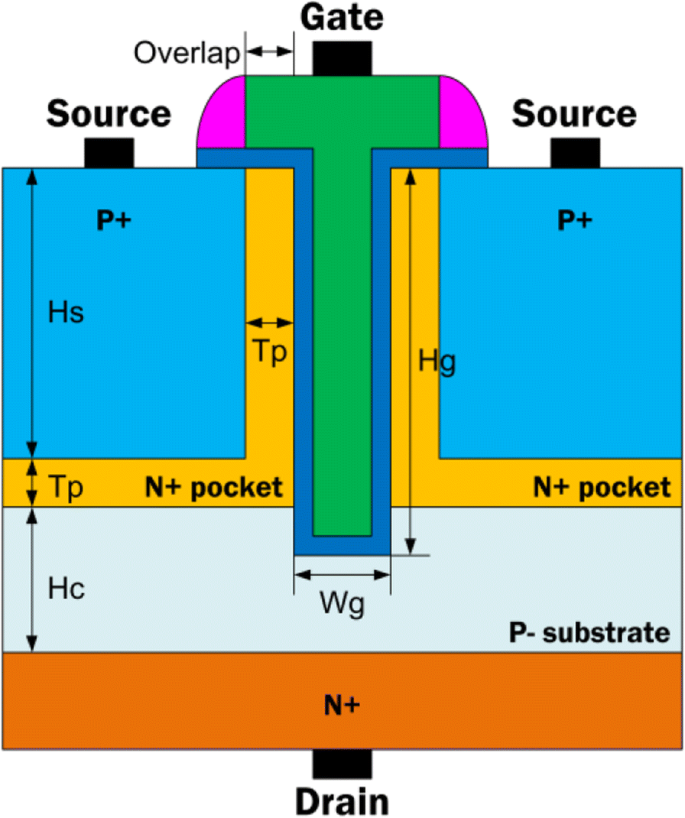
Схема предлагаемого туннельного полевого транзистора с двойным истоком и Т-образным затвором (TGTFET)
На рисунке 2 показана структура LTFET [23, 24], UTFET [25] и TGTFET. Перекрытие затвора может помочь повысить эффективность туннелирования TGTFET. Области с двумя источниками в TGTFET могут удвоить площадь туннельного перехода по сравнению с LTFET и UTFET.
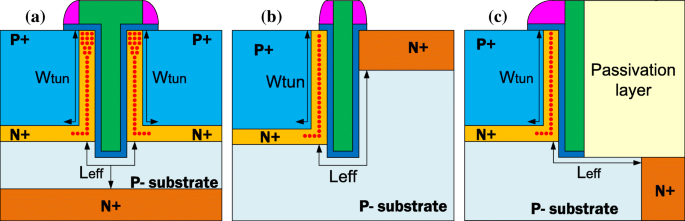
Сравнение а предлагаемый TGTFET, b UTFET и c LTFET
Параметры кремниевых TGTFET, UTFET и LTFET, используемых в моделировании, следующие:Hs =30 нм (высота области источника), Hg =40 нм (высота утопленного затвора), Wg =6 нм (ширина область затвора), Hc =15 нм (высота области канала), Tp =5 нм (толщина n + кармана), ϕ =4 . 33 эВ (работа выхода затвора), Tox =2 нм (толщина HfO 2 диэлектрик затвора), N S =1 × 10 20 см −3 (p + исходная концентрация допирования), N D =1 × 10 19 см −3 (n + сливная концентрация легирования), N sub =1 × 10 17 см −3 (p - концентрация легирования субстрата) и N P =5 × 10 18 см −3 (n + карманная концентрация легирования). Коэффициент ширины при моделировании по умолчанию равен 1 мкм.
Моделирование TGTFET, UTFET и LTFET выполняется в инструментах Silvaco Atlas TCAD. В этом моделировании вводится нелокальная модель BTBT, чтобы учесть пространственные вариации энергетической зоны, что может помочь повысить точность процесса туннелирования BTBT. Считается, что модель подвижности Ломбарди делает подвижность канала более точной (с учетом поверхностного рассеяния, включая поперечное поле и концентрацию легирования). Статистика Ферми и модель сужения запрещенной зоны учитываются для соответствия влиянию высоколегированных областей. Модель рекомбинации Шокли-Рида-Холла также принимается во внимание в этой статье.
Результаты и обсуждение
Механизм устройства и характеристики постоянного тока с различными параметрами
На рисунке 3a показаны передаточные характеристики TGTFET с перекрытием затвора и без него. С дополнительным перекрытием ворот I ВКЛ увеличивается с 7,5 × 10 −5 до 8,1 × 10 −5 A / μ м при V g = V d =1 В. На рис. 3b показаны кривые передаточных характеристик TGTFET, UTFET и LTFET. Чтобы сравнение было более точным, имитационные модели и геометрические размеры этих трех устройств должны быть идентичными. В результате у TGTFET примерно двукратное увеличение I ВКЛ по сравнению с LTFET и UTFET, как показано на рис. 3b. СС мин TGTFET составляет 24,4 мВ / дек при V g =0,1 В, и SS avg составляет 51,5 мВ / дек при 0 В < V g <0,5 В. Коэффициенты переключения ( I ВКЛ / Я ВЫКЛ ) равны 6,7 × 10 10 в V g = V d =1 В и 6,5 × 10 8 в V g = V d =0,5 В.
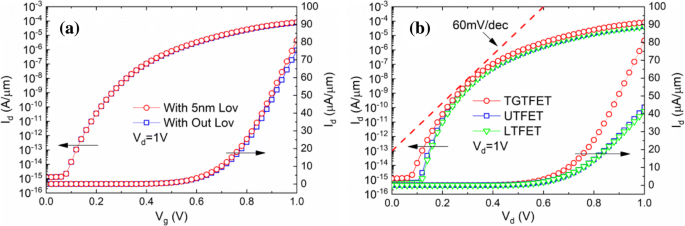
Смоделировано a передаточные характеристики TGTFET с / без перекрытия затвора и b передаточные характеристики TGTFET, UTFET и LTFET
На рис. 4a, b показана скорость BBT TGTFET с перекрытием затвора 5 нм и без него. Из Рис. 4c мы можем ясно видеть, что устройство с перекрытием затвора 5 нм имеет более широкую область туннелирования электронов под поверхностью устройства, что может привести к I ВКЛ увеличивается.
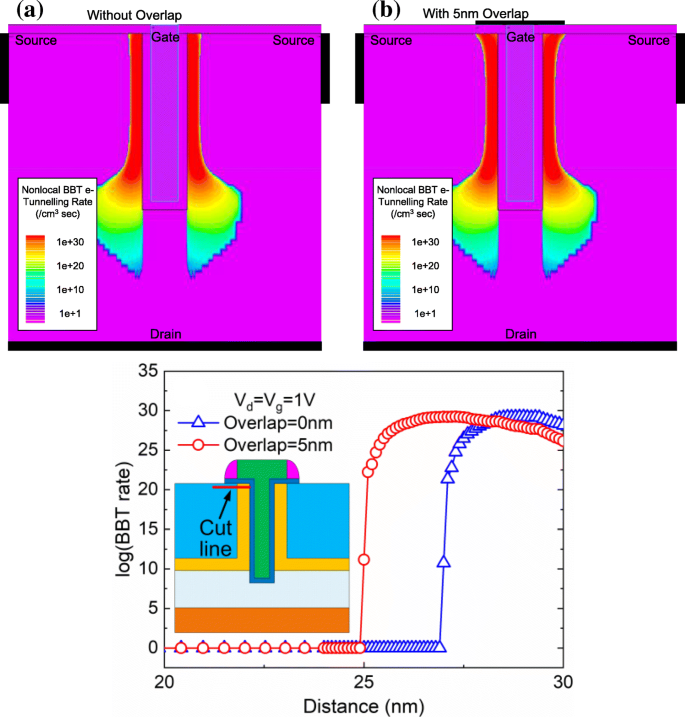
Смоделированные диаграммы скорости туннелирования электронов BBT a устройство без перекрытия ворот, b устройство с перекрытием затвора 5 нм, и c скорость туннелирования электронов BBT двух устройств на 1 нм ниже поверхности устройства; V g = V d =1 В
На рис. 5а, б показана трехмерная диаграмма электрических полей TGTFET с перекрытием затвора и без него. Два пика электрического поля появляются в TGTFET с перекрытием затвора 5 нм, как показано пунктирной окружностью на рис. 5a. На рис. 5б пик электрического поля отсутствует, что связано с отсутствием перекрытия затвора. На рисунке 5c показана структура энергетической зоны под поверхностью устройства. На вставке к рис. 5в показано положение линии разреза. При перекрытии ворот можно получить большее окно туннелирования. Таким образом, более высокая ставка BBT и I ВКЛ может быть достигнуто.
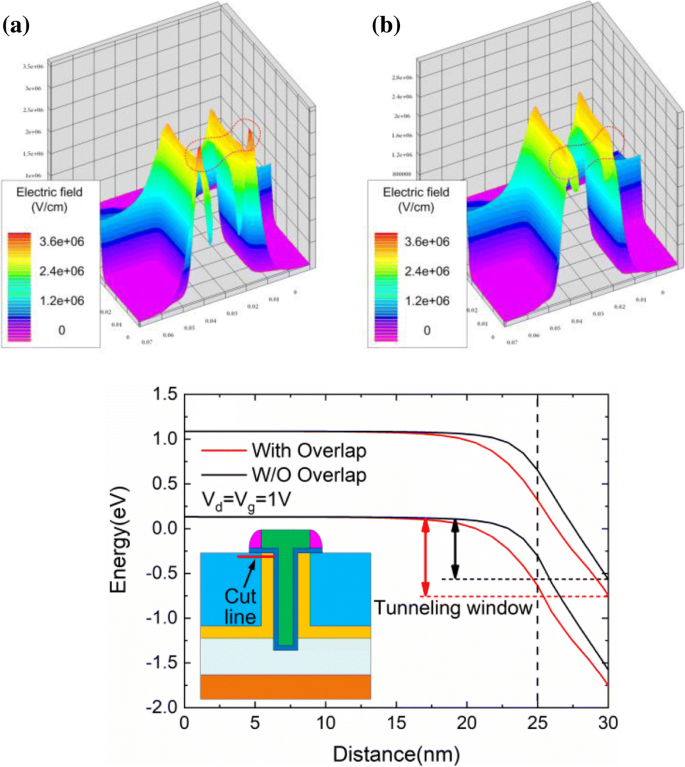
Трехмерная принципиальная схема электрических полей устройства а с перекрытием и b без нахлеста; смоделированный c диаграммы энергетических зон от источника до области кармана (на 1 нм ниже границы раздела оксидов)
На рисунке 6 показано влияние n + pocket на производительность TGTFET. Я ВЫКЛ быстро увеличивается с увеличением концентрации легирования n + карманов, как показано на рис. 6а. Нижняя СС и большая I ВКЛ можно получить, уменьшив толщину n + кармана (Tp) с 7 до 3 нм, когда N P =5 × 10 18 см −3 , как показано на рис. 6b. В то же время на рис. 6б значительного подпорогового тока не отмечено. На рис. 6а можно подтвердить, что относительно низкая концентрация легирования n + кармана поможет подавить подпороговый ток.
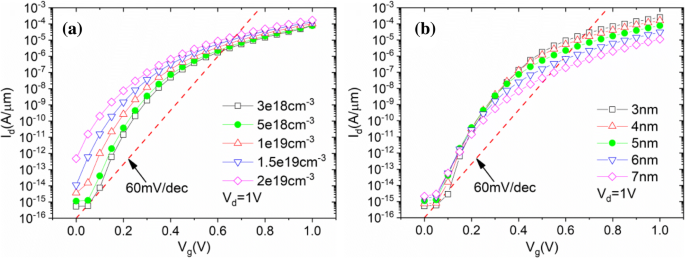
Смоделированные токи стока с разными n + карманами a концентрации и b толщина на V d =1 В
Влияние высоты затвора (Hg) и толщины канала (Hc) показано на рис. 7a, b отдельно. Маленький я ВКЛ и улучшение SS появляется при увеличении Hg. Потому что, когда Hg =35 нм, на пути тока в открытом состоянии появляется очевидный горб энергетической зоны, который становится определенным препятствием для удачливых электронов (электронов, прошедших туннельный переход), как показано на рис. 7c, что может привести к Я на снижаться. Когда Hg увеличивается, горб энергетической зоны ослабевает, что вызывает I ВКЛ и улучшение СС. Небольшой я ВКЛ улучшение достигается при уменьшении Hc, как показано на рис. 7b. Однако серьезное ухудшение подпороговой характеристики может наблюдаться, когда Hc уменьшается до 5 нм. Это можно объяснить увеличением подпорогового туннельного тока в углу кармана n +, как показано на рис. 8. На рис. 8а показано явное явление межзонного туннелирования в закрытом состоянии, когда Hc =5 нм, а на рис. 8b показано явное явление межзонного туннелирования. Я ВЫКЛ плотность тока при Hc =5 нм.

Смоделированные передаточные характеристики TGTFET с a разная Hg, b разные Hc и c горб зоны проводимости на пути тока
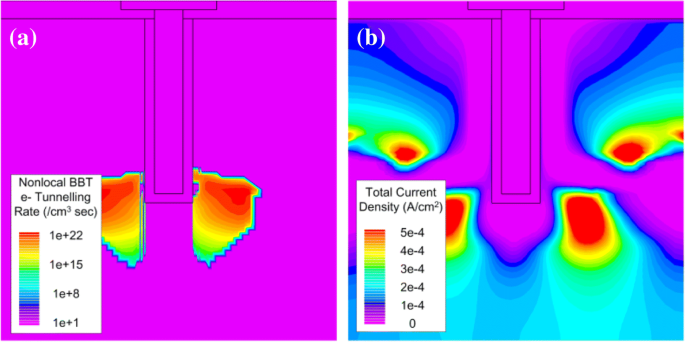
Смоделированные диаграммы выключенного состояния a Скорость туннелирования электронов BTBT и b плотность тока при Hc =5 нм
Как показано на рис. 9, влияние стока на напряжение истока ( В d ) также учитывается в данной статье. Для V d <0,6 В, I ВКЛ очевидно возрастает с увеличением V d , как показано на рис. 9а. Это объясняется тем, что потенциал p-канала медленно растет в ответ на увеличение V d и приводит к уменьшению сопротивления p-канала. Для V d > 1,8 В, как показано на рис. 9b, I ВКЛ почти не увеличивается с увеличением V d , но я ВЫКЛ значительно увеличивается. Это связано с тем, что подпороговый туннельный ток в углу кармана n + быстро увеличивается с увеличением V . d . Наконец, для 0,6 В < В d <1,8 В, TGTFET показывает хорошие и стабильные характеристики. В результате TGTFET устойчив к снижению барьера, вызванному стоком (DIBL), и демонстрирует хорошие и стабильные характеристики в более широком динамическом диапазоне приложенного напряжения.

Смоделированные токи стока для a V d ≤ 1 В и b V d ≥ 1 В
Аналоговые / радиочастотные характеристики TGTFET, UTFET и LTFET
На рисунке 10 показаны передаточные характеристики и кривые крутизны TGTFET, UTFET и LTFET при V . d =0,5 В. Крутизна ( g м ) можно получить из первой производной кривой передаточной характеристики, как показано в формуле. (1) [27,28,29]:
$$ {g} _ {\ mathrm {m}} ={dI} _ {\ mathrm {d} s} / {dV} _ {\ mathrm {gs}} $$ (1)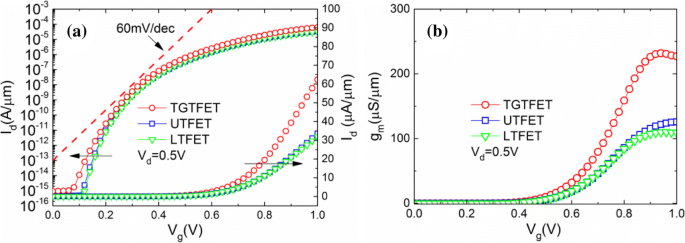
а Передаточные характеристики и б Кривые крутизны TGTFET, UTFET и LTFET при V d =0,5 В
В результате максимальная крутизна TGTFET (232 мкСм / мкм) примерно в два раза больше, чем у UTFET (120 мкСм / мкм) и LTFET (110 мкСм / мкм), как показано на рис. текущее усиление, обеспечиваемое перекрытием двойного источника и затвора.
На рисунке 11 показаны выходные характеристики, выходная проводимость ( g ds ) и выходное сопротивление ( R о ) кривые TGTFET, UTFET и LTFET. Как показано на Рис. 11a, можно ясно видеть, что выходной ток устройства увеличивается с увеличением V . d , но когда V d достигает значения выше 0,6 В, выходной ток стремится к насыщению. Путем наблюдения легко обнаружить, что выходной ток TGTFET в два раза больше, чем у UTFET и LTFET. На рисунке 11b показана выходная проводимость ( g ds ) и выходное сопротивление ( R о ) кривые TGTFET, UTFET и LTFET. g ds может быть получен путем вывода выходного тока, как показано в формуле. (2) [27, 29] в то время как R о может быть выражено как величина, обратная выходной проводимости.
$$ {g} _ {\ mathrm {ds}} ={dI} _ {\ mathrm {ds}} / {dV} _ {\ mathrm {ds}} $$ (2)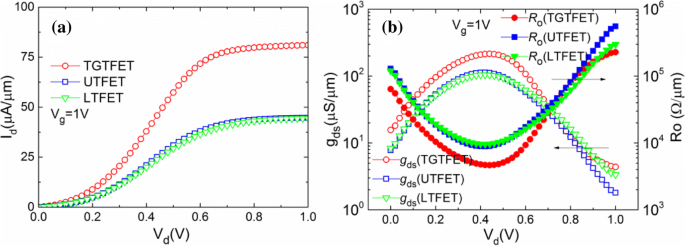
а Выходные характеристики, b выходная проводимость ( g ds ) и c выходное сопротивление ( R о ) кривые TGTFET, UTFET и LTFET
Благодаря преимуществам по выходному току, TGTFET получает самый высокий g ds и минимальный R о этих трех устройств. При условии смещения затвора 1 В, TGTFET получил максимальное значение g ds 214 мкСм / мкм и минимальное значение R о 4,6 кОм / мкм при 0,45 В В d . При одинаковых условиях смещения затвора UTFET и LTFET получили максимальное значение g ds 113 мкСм / мкм и 105 мкСм / мкм и минимальное значение R о от 9,0 кОм / мкм и 9,6 кОм / мкм при напряжении 0,4 В В d .
Более того, на рис.11 нетрудно выяснить, что линейная область выходных характеристик устройства демонстрирует некоторую нелинейность. Как показано на рис. 11a, R о сначала уменьшается, а затем увеличивается с увеличением V d . Некоторые исследовательские группы приводят соответствующий физический процесс об этом явлении [7, 30], но все еще остаются некоторые проблемы, которые четко не объяснены. Как известно, R о определяется сопротивлением области канала и туннельного перехода. Когда V d <0,4 В, R о уменьшается с увеличением V d . Рассмотрим следующие ситуации, когда V d =0 В и В g =1 В, ни один из удачливых электронов не может быть унесен на сторону стока, и почти все электроны захватываются в области канала относительно высоким барьером стока, как показано в рамке с красной пунктирной линией на рис. 12a, b. Когда 0 В < V d <0,4 В, при увеличении V d , дренажный барьер становится слабее (как показано на рис. 12b). Таким образом, электроны, захваченные в области канала, могут проходить через барьер стока, а затем собираться стоком. Это процесс теплового возбуждения электронов из канала в сток. Наконец, когда туннельный переход был полностью включен (когда V g =1 В) туннельный ток всегда находится в состоянии избытка, и сопротивлением, вносимым туннельным переходом, можно пренебречь. В настоящее время R о определяется сопротивлением канала и R о определяется процессом теплового возбуждения электронов через барьер стока. Таким образом, R о уменьшается с увеличением V d . Когда V d > 0,6 В эти три устройства постепенно входят в область насыщения и R о становится больше. Это потому, что когда V d большая, почти все электроны, проходящие через туннельный переход, уносятся на сторону стока под действием относительно высокого электрического поля. Туннельный ток становится пределом тока стока. В этом состоянии R о в основном определяется туннельным переходом. Однако эффективность туннелирования не может значительно увеличиться, пока V d повышается. V d оказывает небольшое влияние на структуру энергетической зоны туннельного перехода (сторона n + кармана), как показано на рис. 12b. В результате туннельный ток явно не может увеличиваться, и почти нет I ВКЛ увеличиваются с постоянно увеличивающимся V d (когда V d > 0,6 В), что означает увеличение импеданса. Более того, когда 0,4 В < V d <0,6 В, R о определяется как сопротивлением канала, так и туннельным переходом.
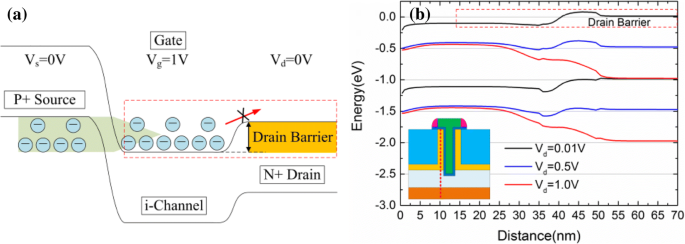
а Принципиальная диаграмма энергетической зоны при V d =0 В и В g =1 В. b Результаты моделирования зонной диаграммы при различных смещениях V d
Из приведенного выше анализа можно сделать вывод, что R о на TFET влияет как процесс туннелирования, так и процесс теплового возбуждения электронов в канале. Основные физические механизмы могут доминировать R о сдвигается с V d вариация. Наконец, R о сначала уменьшается, а затем увеличивается, вызывая нелинейность выходных характеристик. Между прочим, наблюдая за рис. 11b, легко обнаружить, что выходной импеданс TGTFET намного меньше, чем у UTFET и LTFET. Это связано с большей эффективностью туннелирования за счет структуры с перекрытием двойного источника и бокового затвора TGTFET.
На рисунке 13 показана структура энергетических зон TGTFET, UTFET и LTFET с разными приложенными напряжениями. Красные пунктирные линии на вставке представляют положение для рисования энергетической полосы (которая находится на 15 нм ниже поверхности, как раз на 1/2 высоты области источника). Видно, что с V d При увеличении от 0,1 до 0,5 В полосовая структура TGTFET, UTFET и LTFET имеет явную тенденцию к изгибу. Это связано с тем, что напряжение стока может понижать электрический потенциал туннельного перехода рядом со стороной стока. Это означает, что для TGTFET, UTFET и LTFET увеличение V d от 0,1 до 0,5 В способствует эффективности туннелирования. Однако когда V d > 0,5 В, изменение энергетической зоны на V d об увеличении не стоит и упоминать. Это согласуется с результатами анализа на рис. 12b.
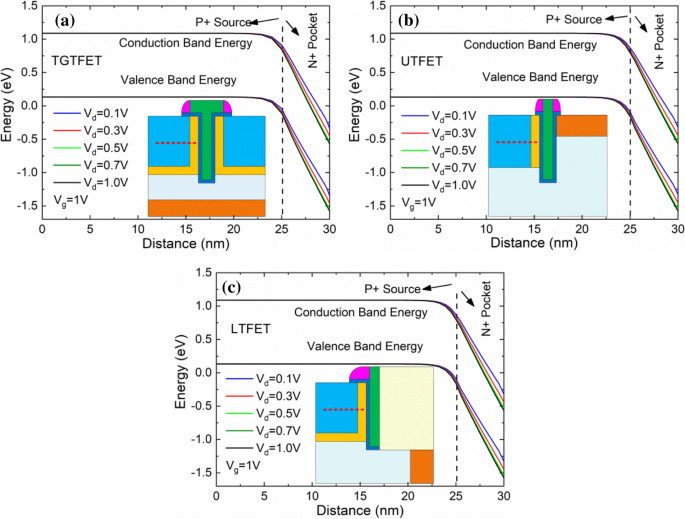
Зонная структура a TGTFET, b UTFET и c LTFET на V g =1
Как известно, емкость затвора ( C gg ) устройства могут сильно повлиять на частотные характеристики интегральных схем. Для TGTFET, UTFET и LTFET, C gg обычно состоит из C GS (емкость затвора относительно источника) и C gd (емкость затвора в сток). Следовательно, характеристика C gg , C GS , и C gd имеет большое значение для оценки частотных характеристик и возможности аналогового применения устройств. Емкостные характеристики TFET сильно отличаются от MOSFET. Из-за наличия туннельного перехода в области источника TFET обычно имеет небольшой C GS [1, 11]. Следовательно, C gg TFET в основном определяется C gd . На рисунке 14 показана зависимость емкости TGTFET, UTFET и LTFET от V . g под V d =0,5 В и В d =0 В отдельно.

Емкость TGTFET относительно В g под a V d =0 В и b V d =0,5 В. Емкость UTFET по сравнению с В g под c V d =0 В и d V d =0,5 В. Емкость LTFET по сравнению с В g под e V d =0 В и f V d =0,5 В
Наблюдая за рис. 14a, b, легко обнаружить, что C GS TGTFET при напряжении на затворе 1 В составляет 0,15 фФ / мкм при В d =0 В и 0,7 фФ / мкм при V d =0,5 В, что намного меньше, чем у C gd (5,8 фФ / мкм при V d =0 В и 3,7 фФ / мкм при V d =0,5 В). Таким образом, C gg TGTFET в основном определяется C gd . Когда V d =0 В, C gg и C gd быстро увеличиваются с увеличением V g , как показано на рис. 14а. Это потому, что с увеличением V g , электроны собираются на интерфейсе затвора в канале устройства, что приводит к быстрому увеличению емкости. Когда V d =0,5 В, C gd не увеличивается явно до V g увеличивается до более 0,6 В, как показано на рис. 14b. Это потому, что когда V g низкая, то лишь немногие удачливые электроны могут пройти через туннельный переход и войти в канал. Некоторые из этих удачливых электронов будут участвовать в процессе рекомбинации, а большая часть других будет быстро собрана стоком из-за напряжения стока 0,5 В. Поэтому этим удачливым электронам очень трудно оставаться в канале устройства. Однако с V g увеличиваясь, количество удачливых электронов быстро увеличивается. В этот момент ни сбор стока, ни процесс рекомбинации электронов и дырок не могут быстро истощить эти счастливые электроны. Таким образом, концентрация электронов в канале увеличивается, а емкость быстро растет. В результате кривая характеристики емкости имеет тенденцию сдвигаться вправо, пока V d увеличивается, как показано на рис. 14а, б. Приведенный выше анализ и явления также применимы к UTFET и LTFET, как показано на рис. 14c – f. Кроме того, емкость затвора UTFET при 0 В и 0,5 В В d достигала 6,2 фФ / мкм и 5,1 фФ / мкм соответственно, а у LTFET - 3,4 фФ / мкм и 2,7 фФ / мкм соответственно.
Поскольку нет прямого перекрытия между затвором и стоком LTFET, а расстояние между затвором и стоком относительно велико, LTFET имеет лучшие характеристики емкости и наименьшее значение C gg . Напротив, между затвором и стоком UTFET есть прямое перекрытие. Следовательно, электроны около стока легче контролируются затвором, что приводит к большому C gg UTFET. Для TGTFET, хотя расстояние между затвором и стоком небольшое, но имеется слегка легированная область канала, которая может изолировать затвор и сток. Таким образом, емкость TGTFET лучше, чем у UTFET, но немного уступает LTFET. На рисунке 15 показан C gd характеристики TGTFET, UTFET и LTFET по сравнению с V d под разными V g . Из наблюдений на рис. 15a – v нетрудно обнаружить, что C gd Характеристики этих трех устройств схожи. То есть для фиксированного V g , C gd уменьшается с увеличением V d . С другой стороны, при фиксированном V d , C gd увеличивается с увеличением V g .

C gd характеристики а TGTFET, b UTFET и c LTFET по сравнению с V d под разными V g
Как известно, обе частоты среза ( f T ) и ширина полосы пропускания (GBW) являются критериями оценки для оценки частотных характеристик устройств. е T зависит от соотношения г м до C gg , как показано в формуле. (3) [30, 31]. Для определенного коэффициента усиления постоянного тока, равного 10, GBW может быть выражено отношением g м до C gd , как показано в формуле. (4) [17]:
$$ {f} _T =\ frac {g _ {\ mathrm {m}}} {2 \ pi {C} _ {\ mathrm {gs}} \ sqrt {1 + 2 {C} _ {\ mathrm {gd} } / {C} _ {\ mathrm {gs}}}} \ приблизительно \ frac {g _ {\ mathrm {m}}} {2 \ pi \ left ({C} _ {\ mathrm {gs}} + {C } _ {\ mathrm {gd}} \ right)} =\ frac {g _ {\ mathrm {m}}} {2 \ pi {C} _ {\ mathrm {gg}}} $$ (3) $$ \ mathrm {GWB} ={g} _ {\ mathrm {m}} / 2 \ pi 10 {C} _ {\ mathrm {gd}} $$ (4)На рисунке 16 показаны характеристические кривые f T и GBW TGTFET, UTFET и LTFET. Благодаря преимуществам конструкции, таким как двойной источник и поперечное перекрытие затвора, обеспечиваемое Т-образным затвором, TGTFET имеет наиболее выдающиеся частотные характеристики по сравнению с UTFET и LTFET. При условии V d =0,5 В, f T и GBW TGTFET достигли максимальных значений 11,9 ГГц и 2,3 ГГц соответственно. Благодаря большому расстоянию между затвором и стоком и без перекрытия затвор / сток, LTFET имеет небольшой C gg и хорошие частотные характеристики. f T и GBW LTFET достигают 8,7 ГГц и 2,1 ГГц по отдельности. Емкостные характеристики UTFET хуже, чем у TGTFET и LTFET. Это потому, что прямой затвор / сток перекрывается. В результате максимальное значение f T а GBW UTFET может достигать только 4,1 ГГц и 0,5 ГГц по отдельности.
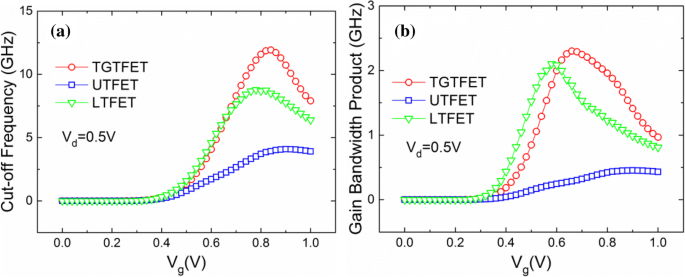
The characteristic curves of a е T и b GBW of TGTFET, UTFET, and LTFET versus V g at V d = 0.5 V
Выводы
In this paper, a T-shape gate dual-source tunnel field-effect transistor (TGTFET) with good performance is proposed and investigated. The structure, mechanism, and the influence of device parameter on the characteristic of TGTFET are discussed. In addition, the characteristics of TGTFET, UTFET, and LTFET are discussed and compared in this paper. The dual-source regions are introduced to double the area of the tunneling junction. The gate overlap and the n+ pockets can obviously enhance the tunneling efficiency of the tunneling junction in TGTFET. Finally, the TGTFET with impressive characteristics (I ВКЛ = 8.1 × 10 −5 A/μm, I ВКЛ / Я ВЫКЛ = 6.7 × 10 10 and SSmin = 24.4 mV/dec) is obtained. At the same time, TGTFET is robust to DIBL, which means TGTFET can exhibit a good and stable performance in a larger applied voltage dynamic range. Furthermore, the analog/RF performance of TGTFET is studied and compared with UTFET and LTFET. The key parameter such as input/output characteristics, capacitance characteristics, GBW, and f T are analyzed. Benefiting from the no direct overlap between the gate and drain, TGTFET obtains a relatively small C gd и C gg . Finally, TGTFET with remarkable frequency characteristics (f T = 11.9 GHz and GBW = 2.3 GHz) is obtained. As a conclusion, it is expected that TGTFET can be one of the promising alternatives for the next generation of device in low-power and analog/RF applications.
Сокращения
- C gd :
-
Gate to drain capacitance
- C gs :
-
Gate to source capacitance
- f T :
-
Cut-off frequency
- GBW:
-
Gain bandwidth
- g ds :
-
Output conductance
- g м :
-
Transconductance
- Hc:
-
Height of the channel layer
- Hg:
-
Height of the gate electrode
- Hs:
-
Height of the source layer
- LTFET:
-
L-shape gate tunnel field-effect transistor
- N D :
-
Doping concentration of n+ drain
- N P :
-
Doping concentration of n+ pocket
- N S :
-
Doping concentration of p+ source
- N sub :
-
Doping concentration of p− substrate
- R о :
-
Output impedance
- TGTFET:
-
T-shape gate dual-source tunnel field-effect transistor
- Tox:
-
Thickness of the HfO2 gate dielectric
- Tp:
-
Thickness of n+ pocket
- UTFET:
-
U-shape gate tunnel field-effect transistor
- V d :
-
Drain to source voltage
- V g :
-
Gate to source voltage
- Wg:
-
Width of the gate electrode
Наноматериалы
- Транзисторы, переходный полевой транзистор (JFET)
- Транзисторы, полевой эффект с изолированным затвором (IGFET или MOSFET)
- Переходные полевые транзисторы
- Полевые транзисторы с изолированным затвором (MOSFET)
- Соединительный полевой транзистор (JFET) в качестве переключателя
- Туннель
- Первый в мире сверхбыстрый полностью оптический транзистор для комнатной температуры
- Видимые световые фотокаталитические характеристики нанокомпозитов ZnO / g-C3N4, легированных азотом
- Подготовка и фотокаталитические характеристики фотокатализаторов LiNb3O8 с полой структурой
- Новый фотокатализатор на гетеропереходе Bi4Ti3O12 / Ag3PO4 с улучшенными фотокаталитическими характеристиками



