Исследование влияния структурных параметров и внутреннего механизма двустороннего S / D-симметричного и взаимозаменяемого двунаправленного туннельного полевого транзистора с управляемым затвором
Аннотация
В этой статье предлагается двусторонний S / D-симметричный и взаимозаменяемый двунаправленный туннельный полевой транзистор с управляемым затвором (B-TFET), который демонстрирует преимущества характеристик двунаправленного переключения и совместимости с интегральными схемами CMOS по сравнению с обычным асимметричным TFET. Влияние структурных параметров, например, концентрации легирования N + регион и P + регион, длина N + область и длина внутренней области, от характеристик устройства, например, характеристики передачи, I на - Я выкл передаточное число и подпороговое колебание, а также внутренний механизм подробно обсуждаются и объясняются.
Введение
Энергопотребление - одна из основных проблем индустрии интегральных схем. Если устройство работает во включенном состоянии, его ток проводимости должен достигнуть определенного критического значения; когда ток достигает критического значения, соответствующее напряжение затвора определяется как пороговое напряжение. Когда устройство находится в выключенном состоянии, соответствующее напряжение затвора должно отличаться от значения в критическом включенном состоянии, которое часто называют напряжением в выключенном состоянии. Концепция подпорогового размаха (SS) применима к устройству, которое работает между выключенным состоянием и критическим включенным состоянием, которое равно изменению напряжения затвора, когда ток увеличивается на порядок. Когда устройство хорошо спроектировано, критическое значение тока в открытом состоянии, пороговое напряжение и напряжение в закрытом состоянии устройства были определены; тогда меньшая SS соответствует более сильным изменениям тока в подпороговой области, меньшему статическому току устройства в выключенном состоянии и более низкому статическому энергопотреблению устройства. SS металлооксидных полупроводниковых полевых транзисторов (MOSFET), которые являются основными элементарными ячейками, широко используемыми в интегральных схемах, ограничивается физическим механизмом тока, генерируемого во время работы устройства, и не может быть ниже предельного значения 60 мВ / дек. Чтобы преодолеть это ограничение, в последние годы был предложен туннельный полевой транзистор (PIN или NIP TFET) на основе кремниевой технологии. Обычный TFET формируется путем добавления слоя собственных полупроводников с низким уровнем легирования между p - и n полупроводниковые материалы типа. По сравнению с MOSFET, TFET имеет преимущества высокой чувствительности и низкого статического энергопотребления [1]. TFET переключается путем модуляции квантового туннелирования через барьер вместо модуляции термоэлектронной эмиссии через барьер, как в традиционном MOSFET. Таким образом, TFET не ограничен термическим хвостом Максвелла – Больцмана носителей, который ограничивает SS MOSFET до 60 мВ / дек при комнатной температуре [2] (точно 63 мВ / дек при 300 K). Эта концепция была предложена Chang et al. во время работы в IBM [3]. Впервые Йорг Аппенцеллер и его коллеги из IBM продемонстрировали, что SS TFET может быть ниже 60 мВ / дек. TFET может использоваться в качестве энергоэффективных электронных переключателей [4], что позволяет преодолеть узкое место полевых МОП-транзисторов и значительно снизить энергопотребление ИС. Производственный процесс совместим с полевыми МОП-транзисторами. Вероятно, он заменит MOSFET-транзистор в качестве основного блока интегральных схем следующего поколения. Поэтому в последние годы TFET стали горячей темой [5, 6]. Для улучшения характеристик TFET с точки зрения SS, прямого проводящего тока и обратной утечки было проведено множество исследований по проектированию структуры и оптимизации устройств TFET, которые в основном сосредоточены на улучшении формы структуры канала устройства и электрода затвора [7 , 8,9,10,11,12] и материалы диэлектрика затвора с различными функциями выхода. Проведен анализ характеристик и оптимизация структуры диэлектрического материала затвора [13,14,15] и диэлектрика затвора с различными диэлектрическими постоянными [15,16,17,18,19,20]. В физике устройств аналитическое моделирование TFET со структурой с двумя затворами [21,22,23,24,25,26,27] и структурой с окружающими затворами [28,29,30,31,32,33] также имеет были широко выполнены. Одним из недостатков кремниевых TFET по сравнению с MOSFET является меньший прямой ток, а величина прямого тока определяется эффективностью генерации туннельного тока. Эффективность генерации туннельного тока может быть увеличена за счет уменьшения ширины запрещенной зоны между валентной зоной и зоной проводимости в области, которая используется для генерации межзонного туннельного тока, или за счет уменьшения толщины области туннелирования. Поэтому в материаловедении активно развиваются устройства TFET на основе узкозонных полупроводниковых материалов и туннельных структур гетеропереходов [34,35,36,37,38]. Между тем, введение двумерных материалов в TFET в качестве туннельных слоев сверхтонкой толщины широко изучается [39,40,41,42,43,44]. Кроме того, в некоторых статьях сообщалось о надежности TFET, например о влиянии легирования источника на туннельное перемежение запрещенной зоны [45], о влиянии туннелирования с помощью ловушек на подпороговые характеристики TFET [46] и о влиянии случайного легирование на нарушение рабочих характеристик устройства [47]. Тем не менее, текущие результаты исследований в основном нацелены на основные рабочие характеристики и принципы работы одиночных TFET, и наиболее важной фундаментальной целью исследований и разработок TFET является обеспечение базового структурного блока с более низким энергопотреблением и замена существующей структуры MOSFET. . Для достижения этой фундаментальной цели он должен быть установлен в специальной схеме, чтобы проверить его совместимость с технологией MOSFET. В настоящее время постепенно проводятся исследования стратегии проектирования схем на основе устройств TFET, таких как схемы аналоговых и смешанных сигналов [48,49,50], цифровые логические схемы [50, 51], схемы управления питанием [52]. Также проводятся исследования по созданию гибридных схем на основе полевых МОП-транзисторов и транзисторов на транзисторах [53]. Однако типы легирования области истока и области стока противоположны друг другу, что создает асимметрию области истока и области стока. Эта асимметричная структура делает невозможным полную замену MOSFET с симметрией истока / стока.
Возьмите n -введите TFET в качестве примера. Сторона с p примесь -типа используется как исходная область, а другая сторона с n В качестве области стока используется примесь -типа. Когда устройство работает, положительная разность потенциалов должна быть приложена от области стока к области истока. Если электрод истока и электрод стока поменять местами, т. Е. p Примесная область -типа имеет более высокий потенциал по сравнению с n -типа примесной области, то PN-переход, образованный p примесная область -типа и n Примесная область -типа всегда будет в состоянии положительного смещения, что вызывает сбой функции управления электродом затвора, TFET почти всегда будет во включенном состоянии и не может быть выключен. Другими словами, это вызывает сбой функции переключения TFET. Другими словами, функциональные модули схемы (такие как затворы передачи), которые для нормальной работы должны использовать характеристики двунаправленного переключения транзисторов, трудно реализовать с использованием обычных TFET с асимметричной структурой истока и стока, чтобы решить эти проблемы. , мы предложили симметричный и взаимозаменяемый двунаправленный TFET сток истока (B-TFET) [54], который демонстрирует преимущество характеристик двунаправленной коммутации и совместимости с интегральными схемами CMOS по сравнению с традиционными асимметричными TFET. В этой статье мы предложили модифицированный двусторонний B-TFET, управляемый затвором, с плоским каналом. Влияние ключевых структурных параметров, таких как легирующие концентрации N + регион и P + регион, длина N + область и длина внутренней области, от характеристик устройства, например, характеристики передачи, I на - Я выкл передаточное число и подпороговое колебание подробно объясняются на основе физического анализа. После этого эти ключевые структурные параметры оптимизируются.
Методы
На рисунке 1а показан схематический вид сверху двустороннего управляемого затвором B-TFET N-типа с плоским каналом. На рисунке 1b показан вид в поперечном разрезе двустороннего управляемого затвором B-TFET N-типа. В отличие от обычного TFET, предлагаемый B-TFET полностью симметричен, источник / сток взаимозаменяемы P + -дегированные области лежат на каждой стороне кремниевого тела, а электрод затвора лежит с обеих сторон кремниевого тела. Вся конструкция устройства симметрична. N + -допированная область находится в центральной части кремниевого тела. L и W составляют всю длину и всю ширину предлагаемого устройства соответственно. L я - длина собственной области; L N + длина N + область; L S / D и W S / D длина и ширина P + сменные области истока / стока соответственно; \ (T \) - толщина тела кремния; \ (t _ {{{\ text {ox}}}} \) - толщина оксида затвора; \ (t_ {i} \) - толщина внутренней области туннеля между областью S / D и оксидом затвора.
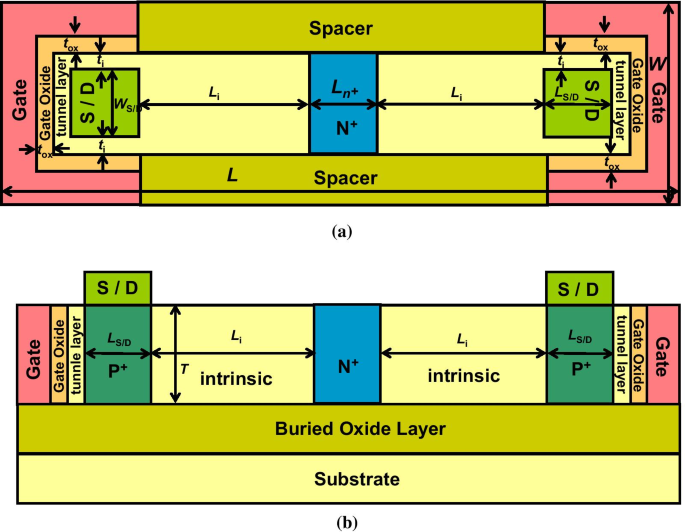
а Схематический вид сверху двустороннего управляемого затвором B-TFET N-типа с плоским каналом. б Вид в разрезе двустороннего блока управления затвором N-Type B-TFET
В этой статье включены все физические модели, такие как статистическая модель Ферми, модель подвижности CVT, модель оже-рекомбинации, модель сужения запрещенной зоны и стандартная модель межзонного туннелирования. Все параметры устройства в этой статье перечислены в таблице 1.
Результаты и обсуждение
На рис. 2а, б показаны передаточная характеристика, соотношение \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) и среднее значение SS с разными \ (N_ { D} \) (\ (10 ^ {18} \) - \ (10 ^ {21} \, {\ text {cm}} ^ {- 3} \)). На рис. 2a, \ (N_ {D} \) влияет на интенсивность обратно смещенного тока утечки сток-исток. С увеличением концентрации легирования ток утечки значительно подавляется, а прямой ток существенно не изменяется. На рис. 2b на SS и \ (I _ {{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) также влияет \ (N_ {D} \ ). С увеличением концентрации легирования, поскольку обратный ток утечки значительно подавляется, ток в статической рабочей точке уменьшается, поэтому средняя SS также уменьшается. Поскольку прямой ток подвержен гораздо меньшему влиянию, чем обратная утечка, соотношение \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) увеличивается с увеличением в концентрации допинга. На рис. 2c, d показаны двумерные распределения потенциала предлагаемого B-TFET с \ (N_ {D} \), равным 10 19 . см −3 и 10 21 см −3 , соответственно. Когда электрод затвора смещен в обратном направлении, между смещенным в прямом направлении электродом стока и электродом затвора с обратным смещением создается сильное электрическое поле, что приводит к сильному межполосному туннелированию вблизи области стока. Среди образовавшихся в результате электронно-дырочных пар электроны могут напрямую вытекать из электрода стока, в то время как дырки валентной зоны должны проходить через N + область, а затем внутренняя область на стороне источника и разряжаться электродом истока, чтобы сформировать непрерывный ток утечки. Чтобы минимизировать ток утечки, дырки, образовавшиеся в результате межзонного туннелирования, должны быть эффективно заблокированы от выхода из области N +. По сравнению с областью N + с более низкой концентрацией, область N + с более высокой концентрацией формирует большую разность потенциалов между областью P + и областью N +, т. Е. Значение потенциала на границе между внутренней областью и областью N + будет увеличиваться. с увеличением \ (N_ {D} \), потому что область N + с более высокой концентрацией может создавать большую разницу электронной концентрации между истоком и стоком. Затем большее количество электронов может диффундировать из области N + в собственные области по обе стороны от области N +, что увеличивает количество положительного заряда (в основном состоящего из донора) в области N + после ионизации и, следовательно, увеличивает потенциал разница между областью P + и областью N +. Именно потому, что область N + с более высокой концентрацией легирования имеет более высокий потенциал, чем стороны истока и стока после ионизации, дырки, генерируемые межзонным туннелированием вблизи области стока, могут быть более эффективно заблокированы, что более эффективно снижает ток утечки.
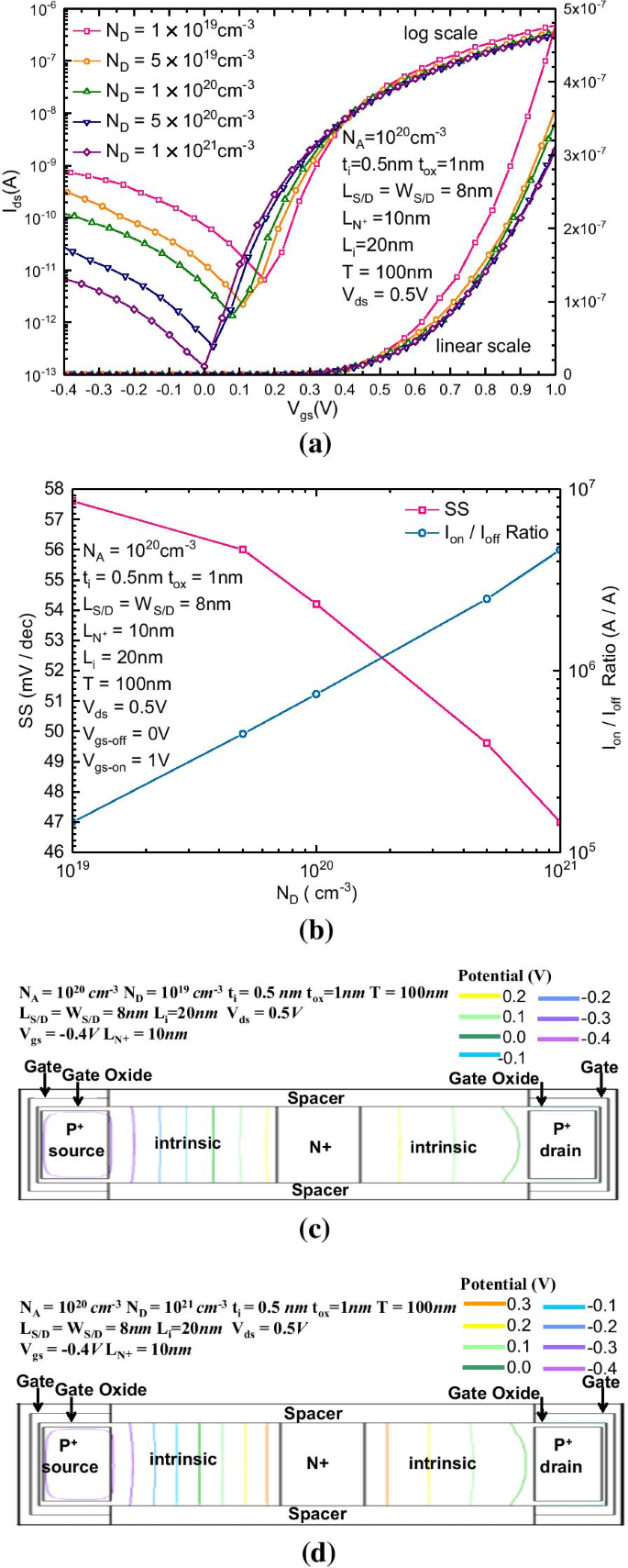
а \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}}} \) характеристики передачи и b изменение SS и соотношение \ (I _ {{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) предлагаемого B-TFET с разными \ (N_ {D } \); обратно смещенное двумерное распределение потенциала с c N Д =10 19 см −3 и d N Д =10 21 см −3
Помимо концентрации легирования в области N +, другим ключевым параметром области N +, который может существенно повлиять на ток утечки с обратным смещением, является длина области N +. На рис. 3a, b показаны переходные характеристики \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}} \) предлагаемого B-TFET с разными L N + . Обратно смещенный ток утечки значительно уменьшается с увеличением L N + . Как показано на рис. 2b, на подпороговое колебание и \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}}) также влияет L N + . При увеличении L N + Поскольку обратный ток утечки значительно подавлен, ток в статической рабочей точке и средняя SS также уменьшаются. Прямой ток подвержен гораздо меньшему влиянию, чем обратная утечка, а соотношение \ (I _ {{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) увеличивается с увеличением в L N + . На рис. 3c, d показано двумерное распределение концентрации дырок предлагаемого B-TFET с L N + равны 2 нм и 80 нм соответственно. Когда L N + равна 2 нм, минимальная концентрация дырок в области N + больше 10 17 см −3 , а когда L N + равна 80 нм, минимальная концентрация дырок менее 10 14 см −3 . Увеличение длины области N + увеличивает ее способность предотвращать прохождение дырок через область N +. В качестве неравновесного неосновного носителя в области N +, когда область N + длиннее, больше дырок будет рекомбинировано с электронами перед прохождением через область N +, поэтому увеличение длины области N + может также сформировать непрерывный обратносмещенный ток утечки. Среднее значение SS может быть уменьшено до 40,2 мВ / дек, а соотношение \ (I _ {{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) может превышать 10 10 .
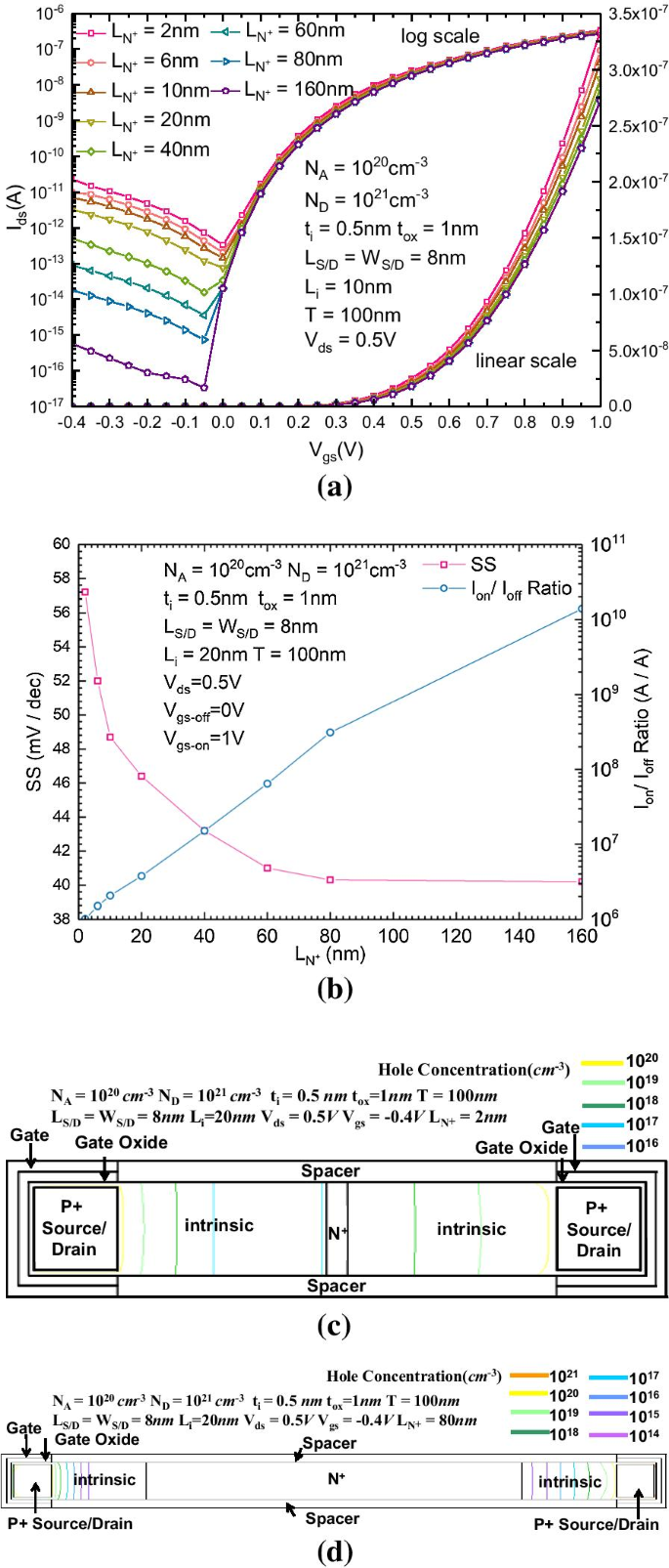
а \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}} \) характеристики; б вариация SS и соотношение \ (I _ {{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) предлагаемого B-TFET с другим L N + ; Двухмерное распределение концентрации дырок предлагаемого B-TFET при обратном смещении для L N + равно (3) 2 нм и (4) 80 нм
На рис. 4a, b показаны характеристики передачи \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}} \) и изменения в SS и \ (I _ {{{ \ text {on}}}} {-} I _ {{{\ text {off}}}} \) соотношение предлагаемого B-TFET с другим L я , соответственно. Прямой ток уменьшается с увеличением L я потому что сопротивление внутренней области пропорционально ее длине. Затем, чтобы максимизировать прямой ток, длина внутренней области должна быть минимизирована. Однако уменьшение длины собственной области увеличивает электрическое поле во внутренней области между областью P + источника и областью N +, поэтому изгиб зоны около этой области больше, чем собственная область около электрода стока, что вызывает ток утечки с обратным смещением. На рис. 4c, d показано двумерное распределение потенциала с обратным смещением предлагаемого B-TFET для L я равны 4 нм и 100 нм соответственно. Для самого короткого L я В случае (4 нм) электрическое поле во внутренней области между областью P + истока и областью N + около электрода истока намного сильнее, чем во внутренней области между областью P + стока и областью N + около сливной электрод. Тогда ток утечки почти остается постоянным, что не зависит от изменения напряжения затвора. На рисунке 4b показано, что оптимальный диапазон значений L я составляет примерно 7–10 нм, где SS уменьшается до минимального значения 41 мВ / дек, а \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}} } \) увеличивается до максимального значения почти 10 8 .
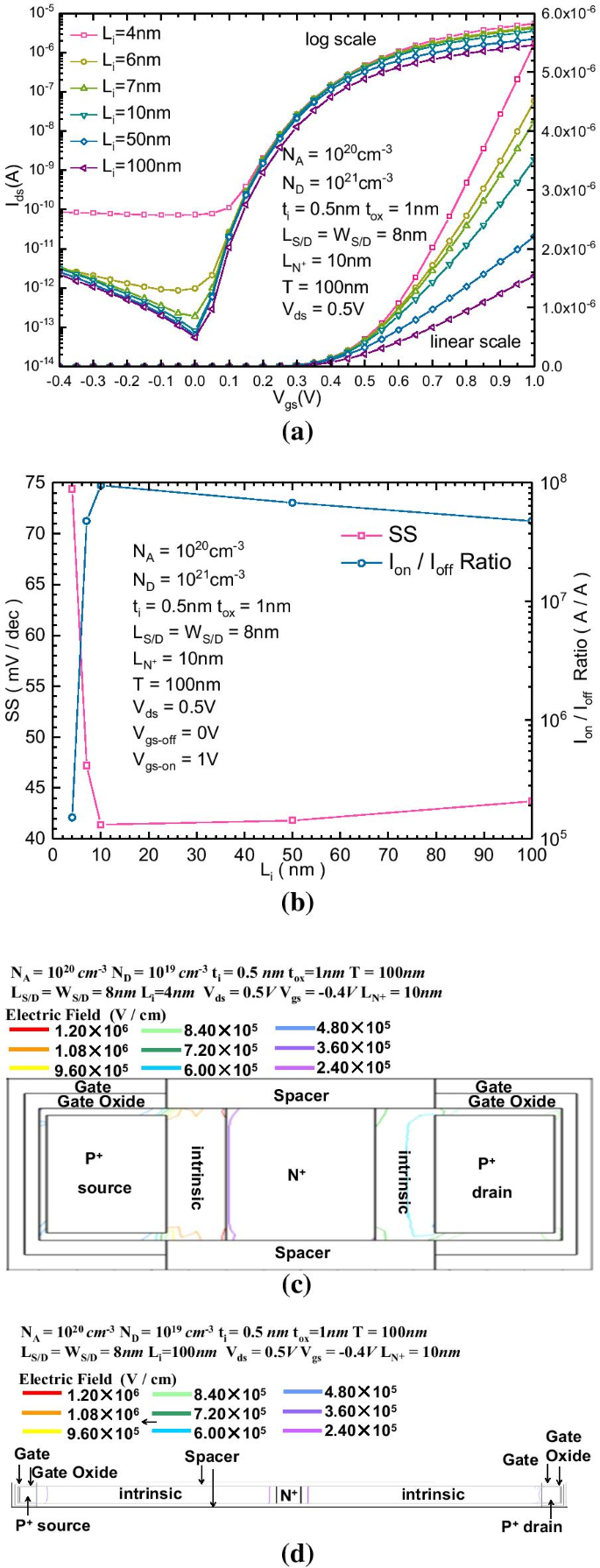
а \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}}} \) характеристики B-TFET и b вариация SS и соотношения \ (I _ {{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) с разными \ (L_ {i} \); Двумерное обратносмещенное распределение потенциала предлагаемого B-TFET для L я равно c 20 нм и d 100 нм
На рис. 5a, b показаны переходные характеристики \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {ds}}}} \) и изменение SS и \ (I _ {{{ \ text {on}}}} {-} I _ {{{\ text {off}}}} \) соотношение предлагаемого B-TFET с разными \ (N_ {A} \). Рисунок 5а показывает, что, увеличивая концентрацию области, легированной P +, мы можем получить меньше SS и больший прямой ток. На ток утечки с обратным смещением, очевидно, не влияет изменение \ (N_ {A} \), но прямой ток может быть увеличен с увеличением \ (N_ {A} \). На рис. 5b соотношение как SS, так и \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) можно улучшить, увеличив \ (N_ {A } \). На рис. 5c, d показано двумерное распределение электрического поля предлагаемого B-TFET с \ (N_ {A} \), равным 10 19 . см −3 и 10 21 см −3 , соответственно. Увеличение \ (N_ {A} \) увеличивает электрическое поле в собственной области туннеля; тогда большее количество электронно-дырочных пар может быть сгенерировано за счет межзонного туннелирования, что увеличивает прямой ток предлагаемого B-TFET.
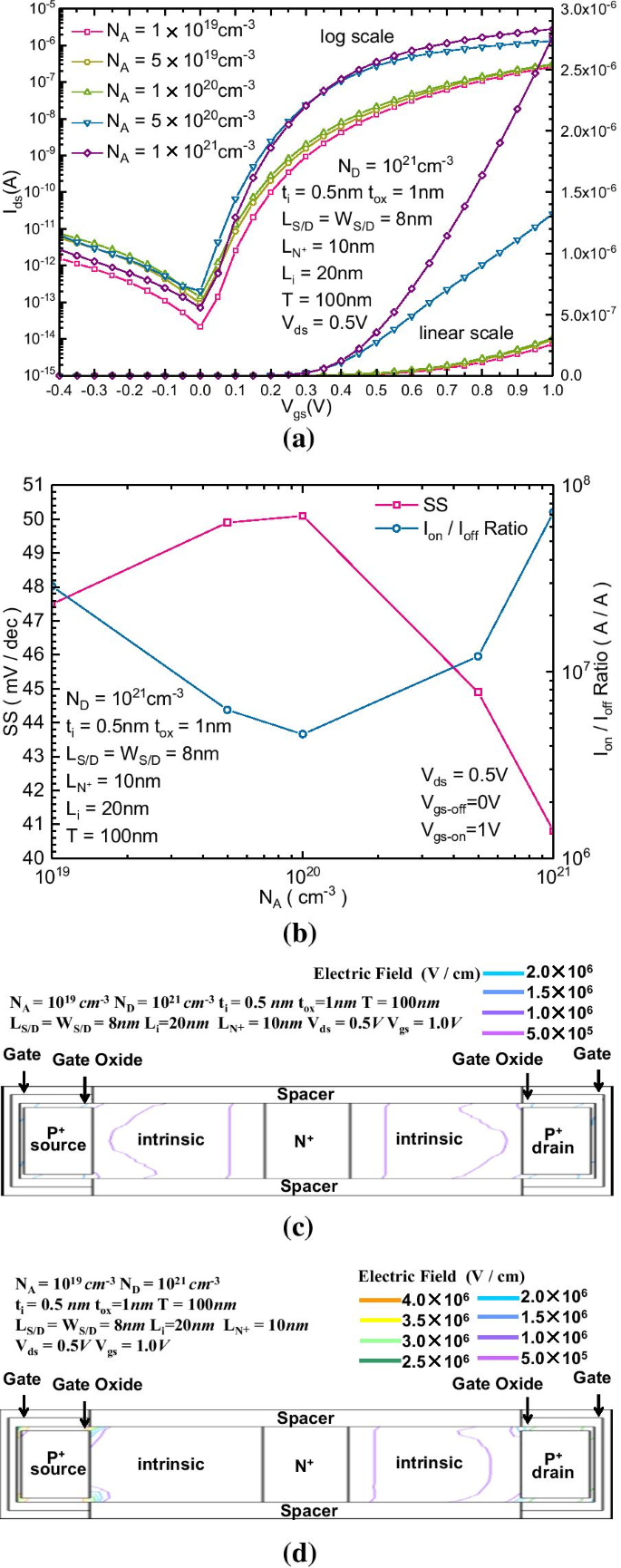
а \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}}} \) характеристики передачи, b вариация в SS и соотношении \ (I _ {{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) предлагаемого B-TFET с разными \ (N_ {A} \). Двумерное обратносмещенное распределение электрического поля предлагаемого B-TFET для \ (N_ {A} \), равного (3) 10 19 см −3 и (4) 10 21 см −3
Согласно приведенному выше обсуждению, как \ (N_ {D} \), так и \ (N_ {A} \) должны быть установлены на максимально возможное значение. Оптимальный диапазон значений L я составляет 7–10 нм. Однако существует компромисс между статическим энергопотреблением и L N + . На рисунке 6 показаны передаточные характеристики \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {ds}}}} \) оптимизированного B-TFET с разными L N + . L N + могут быть выбраны в соответствии с различными проектными требованиями к статическому энергопотреблению. В качестве компромисса, чтобы обеспечить соотношение \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) выше 10 8 , L N + рекомендуется быть выше 20 нм. Включенный ток увеличивается примерно до 6 × 10 –6 . A, а SS снижается до 38 мВ / дек.
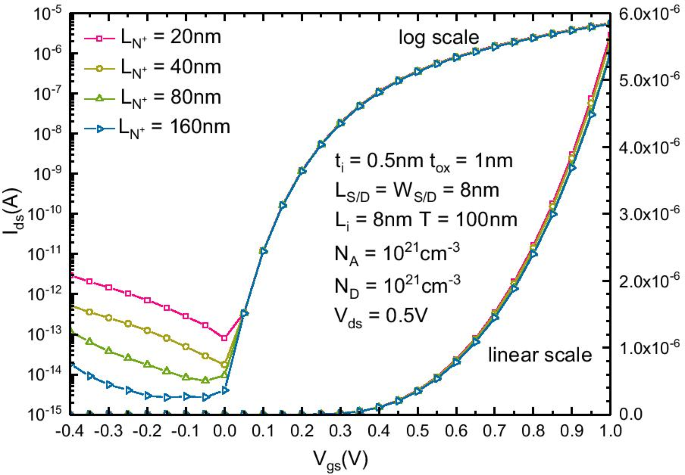
\ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {ds}}}}} \) передаточные характеристики оптимизированного B-TFET с разными L N +
Выводы
В этой статье анализируются эффекты структурных параметров и внутреннего механизма двустороннего S / D-симметричного и взаимозаменяемого двунаправленного туннельного полевого транзистора с управляемым затвором. Влияние ключевых параметров, таких как концентрация и длина области N +, длина внутренней области между областями P + и N + и концентрация области P +, обсуждались подробно. По сравнению с обычным TFET, B-TFET имеет преимущество в сильном сопротивлении обратносмещенному току утечки. После этого можно получить хорошую производительность, такую как более низкое среднее значение SS и более высокое соотношение \ (I _ {{\ text {on}}}} {-} I _ {{{\ text {off}}}} \). Более того, из-за структурной симметрии и характеристик взаимозаменяемости истока / стока и двунаправленного переключения, он более совместим со схемой CMOS.
Доступность данных и материалов
Мы включили заявление о доступности данных и материалов для нас самих и от имени наших соавторов в раздел «Конкурирующие интересы». Все имеющиеся данные и материалы являются оригинальной работой. Все данные четко представлены в рукописи без дополнительных данных и подтверждающих материалов.
Сокращения
- L :
-
Полная длина предлагаемого устройства
- W :
-
Полная ширина предлагаемого устройства
- L я :
-
Длина внутренней области
- L N + :
-
Длина N + регион
- L S / D :
-
Длина P + сменные области источника / стока
- W S / D :
-
Ширина P + сменные области источника / стока
- \ (T \):
-
Толщина кремниевого тела
- \ (t _ {{{\ text {ox}}}} \):
-
Толщина оксида затвора
- \ (t_ {i} \):
-
Толщина собственной туннельной области между областью S / D и оксидом затвора
- MOSFET:
-
Металлооксидный полупроводниковый полевой транзистор
- TFET:
-
Туннельный полевой транзистор
Наноматериалы
- Диод Шокли
- Исследование первых принципов стабильности и STM-изображения борофена
- Влияние распределения наночастиц золота в TiO2 на оптические и электрические характеристики сенсибилизирован…
- Влияние контактной неравновесной плазмы на структурные и магнитные свойства шпинелей Mn Х Fe3 - X О4
- Влияние отжига in situ на подвижность и морфологию органических полевых транзисторов на основе TIPS-пентацена
- Экспериментальное исследование характеристик потока и теплопередачи наножидкостей TiO2-вода в трубке со спир…
- Массивы нанотрубок TiO2:изготовлены с помощью мягко-твердого шаблона и зависимости характеристик эмиссии поля…
- Исследование многоуровневой памяти с переключением сопротивления и зависящей от состояния памяти фотоэдс в…
- Разработка и регулировка работы выхода графена с помощью размера, модификации, дефектов и легирования:исслед…
- Исследование углеродных нановолокон и активного углерода как симметричного суперконденсатора в водном элек…



