Обзор последних достижений в области вертикальных PN-диодов на основе GaN
Аннотация
Как типичный полупроводниковый материал с широкой запрещенной зоной, нитрид галлия (GaN) привлекает все большее внимание из-за его превосходных свойств материала (например, высокой подвижности электронов, высокой скорости насыщения электронов и критического электрического поля). Вертикальные устройства на основе GaN были исследованы, считаются одними из наиболее перспективных кандидатов для применения в силовой электронике и характеризуются способностью выдерживать высокое напряжение, большой ток и высокое напряжение пробоя. Среди этих устройств вертикальный диод с PN-переходом (PND) на основе GaN был значительно исследован и демонстрирует значительный прогресс в производительности благодаря высокому качеству эпитаксии и конструкции устройства. Однако качество его аппаратной эпитаксии требует дальнейшего улучшения. С точки зрения электрических характеристик устройства, эффект скопления электрического поля на краю устройства является актуальной проблемой, которая приводит к преждевременному выходу из строя и ограничивает высвобождение превосходства материала GaN, но в настоящее время смягчается за счет заделки края. В этом обзоре подчеркивается прогресс в технологиях эпитаксиального роста материалов и краевых выводов, за которым следует исследование текущих разработок GaN и потенциальных преимуществ перед кремниевым углеродом (SiC) для материалов и устройств, а также различия между GaN-диодами с барьером Шоттки (SBD) и PND в качестве касается механизмов и функций, а также преимуществ вертикальных устройств над их боковыми аналогами. Затем в обзоре дается общий обзор и раскрывается тенденция проектирования вертикальных GaN PND, используемых для энергосистемы, в том числе с еще только начинающейся вертикальной GaN PND.
Введение
Мировое потребление энергии растет намного быстрее, чем в последние несколько десятилетий, из-за быстрого роста промышленности и экономики. Следовательно, необходимы передовые энергосберегающие технологии для решения проблемы увеличения энергопотребления.
Устройства на основе кремния в настоящее время являются доминирующим типом среди силовых устройств [1]. Среди этих силовых устройств структуры биполярного транзистора с изолированным затвором (IGBT) играют важную роль и демонстрируют растущую тенденцию к замене силового биполярного переходного транзистора (BJT) и полевого транзистора на основе металлооксидного полупроводника (MOSFET) с момента изобретения IGBT в 1982 году [2]. В настоящее время IGBT являются важными элементами силовых электронных полей для преобразования и передачи [3]. Однако к настоящему времени силовые устройства на основе кремния достигли предела своих основных материальных возможностей и широко используются в электроэнергетике.
Благодаря своим выдающимся свойствам, GaN является одним из полупроводниковых материалов с широкой запрещенной зоной (включая SiC, GaN, Ga 2 О 3 и алмаз), позволяющие изготавливать силовые устройства с низкой емкостью и сопротивлением для заданного напряжения пробоя по сравнению с устройствами на основе Si. Таким образом, ожидается создание устройств на основе GaN с низким энергопотреблением, высокой плотностью мощности и высокой эффективностью преобразования для систем силовой электроники.
Как показано в Таблице 1, GaN имеет гораздо более высокий показатель качества по Балиге (BFOM), чем SiC (который был коммерциализирован), особенность, которая приписывается его более высокой скорости насыщения электронами и более высокому критическому электрическому полю. Однако SiC имеет лучшую теплопроводность. Кроме того, GaN обладает более высокой подвижностью носителей µ и более высокая теплопроводность, и достигли как p - и n -типа легирования по сравнению с Ga 2 О 3 . Между тем, для создания полупроводника с широкой запрещенной зоной - алмаза - должен быть достигнут значительный прогресс, чтобы достичь практической стадии. На сегодняшний день устройства на основе GaN, например трехконтактные устройства (полевые транзисторы с гетероструктурой (HFET) и MOSFET) и двухполюсные устройства (SBD и PND), стали ключевыми темами исследований, и в их разработке был достигнут большой прогресс. применения в выпрямлении и преобразовании энергии.
GaN против SiC
По своим свойствам материала GaN имеет несколько превосходящие преимущества перед SiC, включая более широкую запрещенную зону, более высокое критическое электрическое поле, более высокую скорость насыщения электронов и лучшую в 3–4 раза BFOM для силовых устройств [6]. Таким образом, с учетом своих выдающихся характеристик устройства на основе GaN должны превосходить аналоги на основе SiC. На практике вертикальные устройства на основе GaN необходимы для обеспечения высокой удельной мощности и высокой рабочей частоты (рис. 1) из-за их превосходных свойств материала.
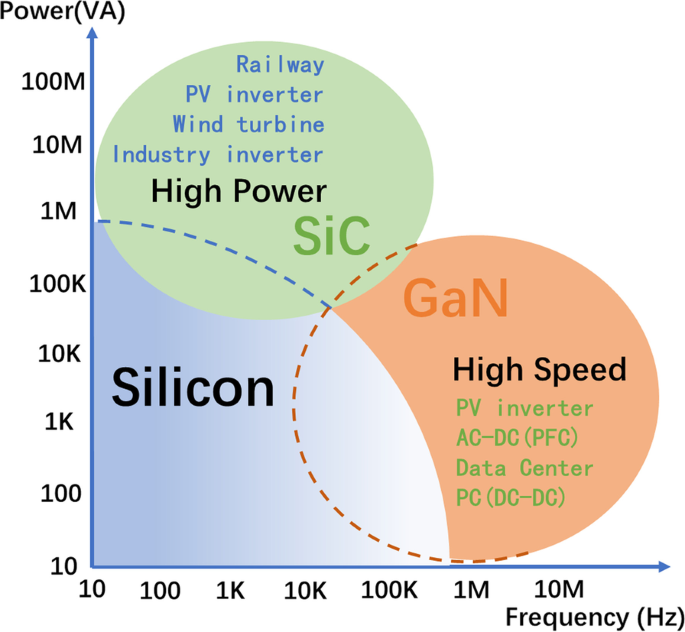
Возможные области применения силовых переключающих транзисторов на основе GaN и SiC [7]
Как наиболее зрелые широкозонные полупроводники, устройства на основе SiC за последнее десятилетие достигли значительных успехов и показали многообещающие характеристики с точки зрения высокого напряжения, низкого удельного сопротивления в открытом состоянии и высокой скорости переключения [8]. Учитывая глубокую исследовательскую базу с 1980 года и доступную большую подложку SiC с низким уровнем дефектов (<10 4 см −2 ), SiC SBD и переходные полевые транзисторы (JFET) были первыми коммерчески доступными устройствами на основе SiC с 2001 года. Другие силовые устройства на основе SiC, включая MOSFET и BJT, были успешно разработаны в области высокого напряжения и силовых приложений и продемонстрировали впечатляющие результаты. производительность [9].
По сравнению с SiC, устройства на основе GaN развивались очень медленно. Их неудовлетворительное качество материала не позволяет реализовать некоторые из их теоретически превосходных свойств. Учитывая отсутствие подложки GaN, большинство исследований устройств на основе GaN на данном этапе в основном основано на латеральной структуре (например, гетероструктуре AlGaN / GaN). Благодаря более высокой подвижности электронов 2000 см 2 / V s (двумерный электронный газ (2DEG) в AlGaN / GaN), 1000 см 2 / V s (объемный GaN) и более высокая скорость насыщения 2,5 × 10 7 см / с по сравнению с аналогами из SiC, устройства AlGaN / GaN предпочтительны для высокочастотных приложений и имеют низкую мощность в ваттах по сравнению с устройствами из SiC [10]. В высокочастотных полях SBD из AlGaN / GaN обладают превосходными характеристиками электрического переноса и больше подходят для микроволновых и миллиметровых волн на уровне ватт [11, 12]. SBD AlGaN / GaN представляет собой типичное устройство для SBD GaN. Высокая мобильность 2DEG означает, что SBD из AlGaN / GaN демонстрируют огромные преимущества в производительности в высокочастотных приложениях по сравнению с вертикальными SBD, а также поддерживают низкое напряжение включения. Недавно SBD из AlGaN / GaN послужили основой для выпрямительной схемы с частотой 5,8 ГГц с входной мощностью 6,4 Вт и напряжением включения 0,38 В с напряжением пробоя ( BV ) 3000 В [13, 14]. Максимальная частота отсечки близка к 1 ТГц при 0 В с расстоянием от анода до катода 70 нм [15].
Для силовых устройств на основе GaN подложка из GaN (объемный GaN) идеальна для эпитаксии, в которой можно использовать технологию гомоэпитаксии для устранения несоответствия. Низкая плотность дислокаций объемного GaN важна для эпитаксиальной подложки, поскольку высокая плотность дислокаций может повлиять на рабочие характеристики, такие как BV , ток обратной утечки, объем производства и надежность [16]. Развитие вертикальных устройств на основе GaN было продиктовано прогрессом в области подложки GaN в последние годы. Однако, учитывая относительно незрелую технологию вертикального триода, вертикальный GaN-диод стал горячей темой исследований на этом начальном этапе. По сравнению с SBD из AlGaN / GaN, вертикальные GaN SBD имеют аналогичные преимущества в частотных полях, таких как высокая скорость переключения с малым временем обратного восстановления и низкие потери проводимости; тем не менее, последний имеет большую плотность тока и меньший путь утечки, чем первый [17, 18].
Некоторые проблемы возникли с подложкой из GaN. Во-первых, в настоящее время доступны подложки из GaN с плотностью дислокаций 10 4 . –10 6 см −2 , но эти плотности дислокаций все же намного выше, чем у подложек Si и SiC [19]. Во-вторых, размер пластины 4–6 дюймов и разумная стоимость (10 евро / см 2 ) SiC, размером 2–3 дюйма и относительно высокой стоимостью (100 евро / см 2 ) подложки GaN препятствуют коммерциализации и продуктивности GaN в больших масштабах [20]. Помимо увеличения числа поставщиков, гетероэпитаксия на сторонних подложках (Si, сапфир или SiC) является альтернативным способом снизить стоимость подложки из GaN, но при этом необходимо решить проблему относительно высокого несоответствия и дефектов.
Помимо вышеупомянутых проблем с объемными материалами, задача GaN-диода заключается в достижении высокого качества p -типа материала. Что касается относительно продвинутых методов формирования p SiC типа имплантации ионами Al, незрелые p технология ионной имплантации и низкая активация акцепторов для p GaN-типа являются существенными препятствиями, которые ограничивают развитие структуры и производство устройств на основе GaN. Таким образом, для улучшения характеристик GaN-диода предлагаются различные виды структур торцевых оконечных устройств, которые составляют ключевую часть этого обзора.
Вертикальные устройства на основе GaN на подложке FS
Еще 10 лет назад большинство GaN-диодов, включая SBD и PND, изготавливались на сторонних подложках, образующих боковые или квазивертикальные структуры устройств из-за отсутствия массивной подложки GaN. Боковые или квазивертикальные диоды демонстрируют выдающиеся электрические характеристики, но им все же присущи недостатки, присущие конструкции устройства [21]. Во-первых, неизбежны несовпадения и недоработки. Затем для устройств на основе GaN на чужеродных подложках необходим буфер между дрейфовым слоем GaN и чужеродной подложкой. Таким образом, релаксация напряжений в буферном слое вызовет изгиб пластины, что приведет к уменьшению толщины слоев эпитаксии GaN [22]. Кроме того, большое тепловое граничное сопротивление (GaN с подложкой) оказывает серьезное влияние на характеристики устройства для устройств на основе GaN, работающих с высокой плотностью мощности [23].
В соответствии с развитием методов эпитаксии, отдельно стоящая подложка из GaN (FS-GaN) с низкой плотностью дислокаций, используемая для вертикальных устройств на основе GaN, достигла большого прогресса. Качество материала гомоэпитаксиального GaN на подложке FS-GaN заметно улучшилось и показывает потенциал для применения в энергетике. Вертикальные устройства из GaN могут смягчить недостатки боковых аналогов из GaN. Во-первых, более толстые эпитаксиальные слои GaN можно выращивать без какого-либо буфера, и более высокие значения BV (которые превышают таковые для боковых устройств из GaN) могут быть получены и определены толщиной дрейфового слоя. Между тем, максимальное электрическое поле находится во внутренней части устройств и далеко от поверхности устройства (устраняя эффект захвата электронов, который обычно возникает в боковых устройствах). Учитывая высокое качество подложки FS-GaN, вертикальные устройства из GaN изучаются с 2011 г. [24]. С тех пор вертикальные GaN PND с высоким BV и низкое сопротивление в открытом состоянии, обеспечивающие отличные характеристики.
PND по сравнению с SBD
Для практических приложений диоды являются важными компонентами для преобразования энергии и инверсии [25]. Благодаря отличным свойствам материала GaN, диоды на основе GaN (SBD и PND) демонстрируют выдающиеся характеристики, которые, как ожидается, будут удовлетворять требованиям силовых приложений. Как показано на рис. 2, PND имеют самый большой диапазон применения среди устройств на основе GaN с различной структурой и выдерживают напряжения от 600 до 5000 В, что указывает на более широкие сценарии применения.
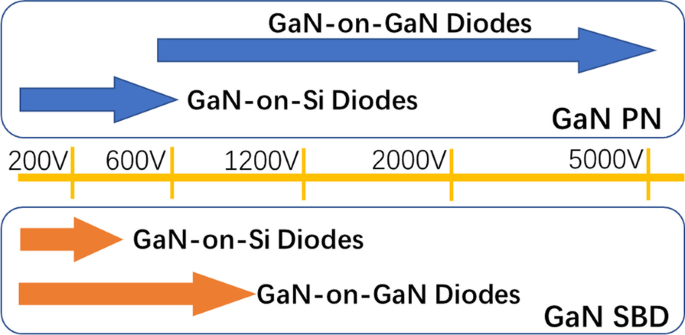
Обзор типов устройств, отчеты и классы напряжения основных вертикальных силовых устройств на основе GaN, опубликованные в последние годы [26]
По сравнению с PND, которые не имеют проблем с хранением неосновных носителей и имеют более низкую высоту барьера SBD, GaN SBD имеют низкое прямое напряжение включения ( V на ) и быстрое обратное восстановление, и эти характеристики указывают на то, что достоинства SBD проявляются в низких потерях проводимости / коммутации, высокочастотной работе, но более низком BV значение, чем у ПНД; кроме того, обратите внимание, что высокое напряжение включения может привести к большим потерям проводимости и ухудшить эффективность схем и систем [27, 28].
В полях большой мощности квазивертикальные или вертикальные SBD имеют превосходные преимущества перед SBD из AlGaN / GaN [29]. Кроме того, низкое напряжение включения (<0,5 В) достигается регулировкой высоты барьера с помощью металла с низкой работой выхода. Однако малая высота барьера может легко привести к сильному обратному току утечки и снижению BV . Следовательно, для улучшения рабочих характеристик предлагаются различные концевые оконечные конструкции. Благодаря разнообразным технологиям заделки кромок [27, 28, 30, 31], высокая плотность тока в кА / см 2 сорт с BV s более 1 кВ подтверждено. Между тем, вертикальные SBD также демонстрируют большие возможности для высоких частот, таких как 177–183 ГГц и максимальную частоту среза 902 ГГц при 0 В, особенность, которая ожидается для источников питания в системах беспроводной связи терагерцового диапазона [12, 32].
Что касается n -типа GaN, p GaN -тип, выращенный методом химического осаждения из газовой фазы (MOCVD) и молекулярно-лучевой эпитаксии (MBE), был введен с использованием Mg в качестве акцептора [33]. По сравнению с GaN SBD, GaN PND имеют много преимуществ, таких как низкое удельное сопротивление в открытом состоянии ( R на А ) и адекватная стабильность устройства и способность подавлять импульсные токи. Несмотря на высокое напряжение включения (> 3 В) и относительно низкую скорость переключения, сверхнизкий ток утечки из-за более высокой высоты барьера и высокого BV получается. Обратите внимание, что высокий BV от 0,6 до 5 кВ - это наиболее выдающиеся характеристики для PND на основе GaN. Таким образом, PND на основе GaN обладают большим потенциалом в качестве важных строительных блоков энергосистем следующего поколения для приложений большой мощности, которые требуют высокого КПД и низких потерь энергии [34]. Подобно вертикальным GaN SBD, краевые заделки для GaN PND также изготавливаются, чтобы уменьшить скопление электрического поля вокруг анода - особенность, которая будет подробно описана позже в этой статье.
В силовых устройствах PN-переход можно рассматривать как новую структуру перехода. Для использования высокого BV с низким током обратной утечки PND, высокой коммутационной способностью и одновременно низким напряжением включения SBD, новые конструкции устройств, включая переходной барьер Шоттки (JBS) и объединенный PN Schottky (MPS), создают комбинацию SBD и PND за счет формирование p области сетки типа в области контакта Шоттки. Устройства JBS или MPS обладают характеристиками прямой проводимости SBD и обратной блокировки PND и, как ожидается, будут иметь лучшие характеристики переключения и более высокое обратное напряжение, чем обычные PND и SBD соответственно [35].
Помимо их мощного применения, GaN PND также используются для оптоэлектронных устройств, таких как светодиоды (LED), фотодетекторы, а также для обнаружения пламени из-за низких темновых токов в несколько пА в фотодиодах с PN-переходом на основе GaN [36 , 37].
Цель этого обзора
Благодаря превосходным свойствам материала GaN, устройства на основе GaN широко исследуются и используются в приложениях силовой электроники как один из самых горячих полупроводниковых материалов. Среди устройств на основе GaN был значительно исследован вертикальный PND на основе GaN, который демонстрирует отличную BFOM. Краевые клеммы также важны для уменьшения скопления электрического поля вокруг анодной площадки.
В этом обзоре в качестве основных акцентов представлены достижения в технологиях выращивания эпитаксии материалов и краевых выводов, а также показаны текущие разработки GaN, различия между GaN SBD и PND с точки зрения механизмов и характеристик, а также преимущества вертикальных устройств перед боковыми. . Этот обзор дает представление и раскрывает тенденцию проектирования вертикальных GaN-PND, используемых в энергосистеме, включая новые вертикальные GaN-PND. Развитие эпитаксиального роста, соответствующего другому слою в вертикальных GaN PND, представлено в разд. 2. Технологии периферийных терминалов исследуются в разд. 3. В разд. 4 в качестве альтернативного метода демонстрируются вертикальные ПНД из GaN на подложке Si. Наконец, представлены выводы и перспективы будущего развития вертикальных GaN PND.
Рост эпитаксии материала
GaN-подложка вертикальных PND
Как основной эпитаксиальный процесс, эпитаксиальные слои вертикальных устройств в настоящее время в основном выращиваются методом MOCVD на проводящих подложках из GaN, изготовленных методом гидридной парофазной эпитаксии (HVPE). В этой структуре качество подложки напрямую влияет на следующую эпитаксиальную структуру. Многие механизмы отказа в устройстве происходят из-за качества эпитаксии подложки [38]. Должно быть получено высокое качество проводящей подложки GaN для дальнейшего улучшения прямого и обратного I - V характеристики, особенно обратный ток утечки и BV возможности.
Субстрат, выращенный с помощью HVPE, считается наиболее удобным методом для массового производства из-за его относительно низкой стоимости и воспроизводимости. Однако на ранней стадии технология незрелого роста означала, что подложка GaN, выращенная с помощью HVPE, имела высокую фоновую концентрацию носителей (> 10 19 см −3 ) и неудовлетворительное качество кристаллов. Поэтому HVPE не применялся для роста структуры устройства [39]. Благодаря быстрому развитию технологии выращивания эпитаксии, получение высококачественных объемных материалов GaN с помощью HVPE постепенно становится возможным [40, 41]. Помимо подложки, частично эпитаксиальный слой в устройстве теперь может быть выращен с помощью HVPE и может привести к более высокой однородности тока и устранению макроступенек на поверхности GaN за счет сочетания HVPE и эпитаксиального процесса MOCVD с безуглеродной технологией по сравнению с устройствами, выращенными исключительно MOCVD [42].
В настоящее время коммерческая подложка из GaN с минимальной плотностью дислокаций менее 10 4 см −2 доступен. Обработаны вертикальные ПНА GaN на подложке GaN с низкой плотностью дефектов. Однако изгиб пластины остается проблемой. В качестве многообещающего решения аммонотермический метод позволяет получить подложку из GaN с лучшим качеством эпитаксии. С помощью автоклавов высокого давления и сверхкритического аммиака резьбовое смещение может быть значительно уменьшено до 10 4 –10 5 см −2 [43]. При использовании аммонотермического метода низкое сопротивление 0,001 Ом см 2 в подложке GaN с высоколегированным n -тип (1 × 10 19 –1 × 10 20 см −3 ), а также BV 3 кВ [44]. Однако недостатком аммонотермического метода является низкая скорость роста, составляющая примерно 80–90 мкм / день, что неблагоприятно для практического производства. Повышение скорости роста и поддержание высокого качества материала также являются прибыльными направлениями для последующих исследований.
В дополнение к коммерческой подложке GaN, некоторые подложки также были исследованы на предмет отличительных характеристик, в том числе не-Ga-плоскости ( c -плоскость) подложки. Как правило, Ga-полярный (т. Е. c -плоскость) используется для вертикального устройства из GaN. Затем следующие эпитаксиальные слои демонстрируют резкий эффект поляризации. Однако в направлении, противоположном Ga-полярным аналогам, гомоэпитаксиальные слои вдоль N -полярное направление демонстрирует уникальные свойства устройства из-за более высокой температуры разложения и зависимости от полярности [45, 46]. С помощью N -полярная монокристаллическая подложка FS-GaN, электрическое поле 2,2 МВ / см без каких-либо торцевых заделок, а также BV 2,4 кВ с N 2 Плазменная обработка поверхности и полевая пластина (FP) [46, 47]. В качестве еще одной специальной подложки из GaN, m -плоскость также привлекает широкое внимание из-за своей неполярности, для которой соотношение Ga:N составляло 1:1 на м -плоскость только относительно Ga в c -полярный и только N в N -полярные подложки. Для этой неполярной подложки из GaN были получены характеристики PND с критическим электрическим полем 2,0 МВ / см и высоким отношением включения / выключения без FP или торцевого заделывания [48].
Эпитаксиальные методы N-GaN
До появления высококачественных проводящих подложек из GaN, GaN PND в основном изготавливались на сторонних подложках, включая Si, SiC и сапфир. Поэтому конструкция устройств всегда ограничивалась боковыми. Предложен метод, основанный на латеральной структуре, для улучшения качества эпитаксии. Учитывая низкую проницаемость дислокаций (TD) в области окна на боковых устройствах, эпитаксиальный слой GaN, растущий латерально через маску, может достичь гораздо более низкой плотности TD. Таким образом, для выращивания эпитаксиального слоя GaN на сапфировой подложке для латеральных ПНД было выполнено латеральное эпитаксиальное зарастание. Ток обратной утечки подавлялся на три порядка [49].
С развитием эпитаксиальной технологии появились высококачественные монокристаллические подложки GaN с низкой плотностью дислокаций 3 × 10 –6 см −2 стали доступны, а ПНД из GaN были изготовлены на подложках из GaN. В сочетании с верхними эпитаксиальными слоями, выращенными методом MOCVD, устройства демонстрируют низкий ток утечки и высокий BV от 600 В до 4 кВ, что соответствует толщине дрейфа от 6 до 40 мкм [16, 50]. Что касается устройства на сапфировой подложке, обратный ток утечки и BV значительно улучшено [51].
В случае подложки из природного GaN в эпитаксиальной структуре ПНД обычно не возникает специального буферного слоя, подобного таковому на чужеродной подложке. Влияние буферного слоя в PND на подложку GaN было исследовано в качестве эталона. Наличие буферного слоя означает, что дрейфовый слой имеет меньшую плотность дефектов. Между тем, более высокий BV может быть получен с более тонким дрейфовым слоем, но с более толстым буферным слоем. Также улучшен обратный ток утечки устройства. Эти параметры устройства сильно зависят от толщины буферного слоя, что незначительно влияет на характеристики устройства [52].
Верхние эпитаксиальные слои осаждаются с помощью MOCVD, парофазной эпитаксии из металлоорганических соединений (MOVPE) и MBE, как обсуждается в этой части. Эпитаксиальная структура PND включает высоколегированный n + -GaN слой и дрейфовый слой n - -Ган между основанием и p -GaN (рис. 3). Высоколегированный n + -Слой GaN действует как переходный слой на проводящей подложке GaN в некоторых отчетах.
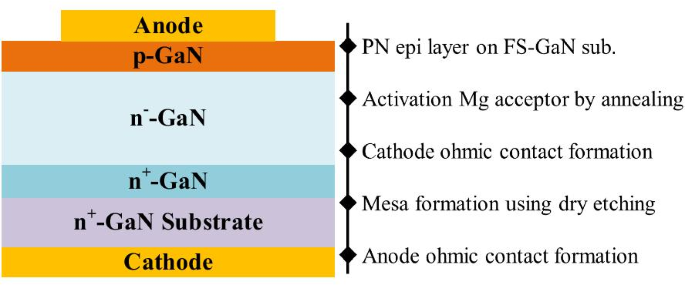
Схематическая структура и процесс изготовления GaN вертикального ПНД
В целом BV определяет сценарии применения устройств. Например, чем выше BV для устройства SiC по сравнению с устройством с GaN позволяет использовать устройство SiC в мощных и высоковольтных приложениях, таких как электромобили и сверхскоростные поезда (рис. 1). Точно так же PN-диоды обычно применяются при более высоких напряжениях по сравнению с диодом Шоттки и HEMT. В PNDs BV в основном осуществляется дрейфовым слоем (слаболегированный n - -GaN слой) с расширением обедненной области (как показано в уравнении 1 с приложенным напряжением V для которого V положительный / отрицательный для прямого / обратного смещения, когда устройство находится под обратным смещением. Причем пробой происходит при дальнейшем увеличении обратного смещения.
$$ {W _ {\ text {D}}} =\ sqrt {\ frac {{2 {\ varepsilon _ {\ text {s}}} \ left ({{V _ {{\ text {bi}}}} - V } \ right)}} {q} \ frac {{{N _ {\ text {A}}} + {N _ {\ text {D}}}}} {{{N _ {\ text {A}}} {N_ {\ text {D}}}}}} $$ (1)где S , q , V би , N D , и N A представляют собой площадь перехода, заряд электрона, встроенный потенциал, концентрацию донора и концентрацию акцептора соответственно [53].
По ширине истощения устройства можно разделить на непробивные [ W D > Вт Dm ( W Dm :максимальная ширина слоя истощения)] и сквозного ( W D < Вт Dm ). Учитывая проблемы структуры и кромки эпитаксии, большинство вертикальных устройств на основе GaN относятся к типу сквозных, т.е. их обедненные области выходят за пределы всего n - -GaN слой и достичь n + -GaN субстрат до разрушения.
Более того, как описано в формуле. (2), BV можно улучшить, увеличив толщину и уменьшив n -типа легирования концентрацией дрейфового слоя.
$$ {\ text {BV}} ={E _ {\ text {C}}} t - \ frac {{q {N _ {\ text {D}}} {t ^ 2}}} {{2 {\ varepsilon_0 } {\ varepsilon _ {\ text {r}}}}} $$ (2)где E C , q , t , N D , и ε r критическое электрическое поле, заряд электрона, n - -Толщина слоя GaN, чистая концентрация носителей n - -GaN и диэлектрическая проницаемость полупроводника соответственно [54]. К счастью, опыт показывает, что дрейфовый слой с большей толщиной и меньшим легированием способствует лишь небольшому увеличению сопротивления в открытом состоянии при прямой проводимости.
По сравнению с улучшением BV за счет увеличения толщины дрейфового слоя, уменьшения n концентрация легирования в n - -GaN слой в настоящее время сложен из-за высоких фоновых концентраций, включая Si, O и так далее. Для дальнейшего снижения концентрации легирования в n - -GaN, исследуется непреднамеренная концентрация легирования. Многие исследовательские группы представили номинальный i-GaN примерно 10 15 . –10 16 см - 3 связавшись с p -GaN для формирования p - я - нет структура для улучшения BV диодов [55].
Конечно, предварительным условием этих мер является высокое эпитаксиальное качество дрейфового слоя, поскольку TD могут увеличивать утечку в закрытом состоянии и ухудшать BV свойства [56].
Для дальнейшего улучшения эпитаксиального качества дрейфового слоя в вертикальных ПНД из GaN был исследован рост методом МПЭ на подложке из GaN. Ток утечки менее 3 нА / см 2 и электрическое поле 3,1 МВ / см были получены из-за очень низкой плотности дислокаций. Практически идеальные характеристики пробоя указывают на то, что МПЭ является эффективным методом выращивания эпитаксиальных слоев в вертикальных ПНД на основе GaN [56]. Однако, как и при аммонотермическом выращивании, скорость эпитаксии является другим недостатком.
Эпитаксия P-GaN
О P-GaN, важном компоненте вертикальных PND на основе GaN, сообщалось в 1989 г. с момента появления GaN методом HVPE в 1969 г. [57, 58]. Впервые он был использован для получения синего светодиода. Затем p -GaN постепенно использовался в области электрических устройств, таких как нормально выключенные устройства и PND. В вертикальных GaN PND, p -GaN составляет свет (около 10 19 см −3 ) и тяжелые (≥ 10 20 см −3 ) концентрация легирования, которая соответствует образованию слоя PN-перехода с дрейфовым слоем и облегчению омических контактов в качестве анодного электрода.
Как правило, эпитаксиальный рост p -GaN производится MOCVD при температуре около 1000 ° C и использует Mg 2+ как акцептор. Затем увеличившееся p -Слой GaN необходимо активировать при высоких температурах 700–800 ° C в N 2 при температуре окружающей среды или 400 ° C в O 2 окружающей среды, тем самым способствуя относительно высокой концентрации дырок [59,60,61]. Однако высокая энергия ионизации связи Mg-H (150–200 мэВ) означает p -GaN скорость активации всего 1–3%. Низкая скорость активации также связана с температурой. Легирующие добавки Mg могут быть повторно пассивированы при высоких температурах ≥ 600 ° C в NH 3 или окружающий водород [62]. Чтобы улучшить концентрацию дырок, невозможно только повысить концентрацию легирования, потому что более высокая концентрация легирования в p -GaN может привести к ухудшению кристаллического качества слоя и снижению плотности дырок за счет эффекта самокомпенсации [63]. В настоящее время максимум плотности дырок обычно достигается при концентрации акцепторов примерно 3 × 10 19 . см −3 [64]. Хотя есть некоторые проблемы для p -GaN, отчетов о расследованиях не так много. Это можно объяснить двумя причинами. Один из них - это ограничения внутренних свойств материала и эпитаксиального оборудования. Другое дело, что настоящее p -GaN может также получить сравнительную производительность устройства.
Однако оптимизация условий роста и новый эпитаксиальный процесс все еще исследуются. Например, в 2017 году неактивированный отросший p -GaN от MBE был предложен и имеет преимущество перед MOCVD. В среде с низким содержанием водорода BV 1,1 кВ и коэффициент идеальности 2,5 были достигнуты изготовленными вертикальными GaN-ПНД [65]. Еще один интересный p Метод изготовления -GaN представляет собой имплантацию ионов Mg с помощью процесса отжига при сверхвысоком давлении (UHPA). Результаты показывают, что высокий коэффициент активации 70% и подвижность дырок 24,1 см 2 V -1 s −1 достигались постимплантационным отжигом при температуре 1573–1753 К в N 2 давление 1 ГПа. Этот результат сопоставим с результатом эпитаксии методом MOCVD [66].
В заключение, в качестве подложки теперь доступна коммерческая подложка из GaN с низким уровнем дефектов. Между тем, эпитаксиальные технологии все еще развиваются, и это сильно влияет на производительность устройств. По сравнению с MOCVD, MBE может обеспечить превосходное эпитаксиальное качество, что приводит к отличным характеристикам устройства без каких-либо торцевых заделок. Однако его медленные темпы роста и высокая стоимость делают MBE непригодным для крупномасштабной производительности. Рост эпитаксии методом MOCVD до сих пор остается основным производственным методом на практике. Таким образом, улучшение качества эпитаксиальных слоев, выращенных методом MOCVD, является актуальной задачей, решение которой потребует значительного времени. Поэтому на данном этапе предлагается усовершенствованная конструкция структуры устройства или меры для обеспечения высокой производительности.
Методы пограничного завершения
Для вертикальных GaN PND, BV важный параметр. Almost all investigations on vertical GaN PNDs are centered on improving the withstanding voltage at reverse (i.e., BV ). However, due to the electric field crowding at the edge of PN junction, the depletion layer edge, or the electrode edge, premature breakdown often occurs. Therefore, to reduce the electric field crowding of the device, advanced device structure designs (i.e., edge termination techniques) are developed. Varied edge termination techniques have now been adopted to relax the electric field crowding at the edge of GaN PNDs for a higher BV . These techniques include mainly the field plate (FP), ion implantation and plasma treatment, and mesa etching in varied angle or steps and guard rings (GRs) [49, 67,68,69]. These features are discussed in this section.
Metal Field Plates
The FP has been widely utilized in GaN-based devices for transferring the peak electric field far from the edge of the gate, anode, or junction. This method has an identical feature to relax the intensity of the electric field at the PN edge under reverse bias. Moreover, the low leakage current and high breakdown voltage under reverse voltage can be achieved by using FP termination, which has a relatively simple fabricating process as well.
The merits of the FP structure include a simple fabrication process and compatibility with the device process. Simultaneously, the dielectric layer of FP is also the passivation layer of the device. As the earliest and most widely used edge termination for vertical GaN PNDs, the non-extended FP termination was initially used, as shown in Fig. 4a. For fabricating the FP structure, mesa structures were processed by inductively coupled plasma (ICP) dry etching. Then, to suppress the parasitic leakage currents from plasma damage, a passivation dielectric film was deposited all over the anode electrode and the entire mesa structure [70].
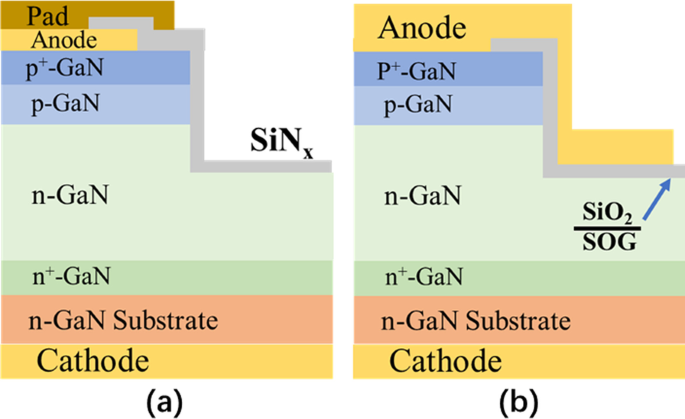
PNDs’ structures with a FP and extended passivation dielectric layer and b extended FP metal and passivation dielectric layer [70, 71]
To furtherly relax the electric field crowding at the periphery of the PN junction edge, the extended metal of the FP was utilized to cover the entire mesa to reduce the reverse leakage current and raise the BV [71]. This optimized FP structure is now widely employed in vertical GaN PNDs fabrications. As shown in Fig. 4b, the BV was raised over 3 kV with an extended FP structure. Meanwhile, the reverse leakage current was also suppressed to a quite low level at revere voltage of 3 kV.
As an essential component of the FP structure, the passivation layer has a considerable impact on the device characteristics. Thus, an appropriated passivation layer is essential. A passivation layer owned high-k permittivity is proposed by simulation, and uniform reverse current flow can be also obtained [50]. According to this theory, vertical GaN PNDs with FP termination using Ga2 О 3 (the dielectric permittivity of 10) as passivation film were reported. The BV had a large improvement from 200 to 550 V, thereby revealing that a high-k permittivity film such as Ga2 О 3 is promising as a passivation film of FP termination in vertical GaN PNDs for raising device characteristics [72]. However, some demerits arise for FP termination. The main issue is the defect during the dielectric layer deposition and interface between the dielectric and GaN, which result in carrier trapping. These would lead to the instability of device performance during long-term use. Therefore, the optimized deposition process of the dielectric layer must be investigated.
Mesa Termination
Mesa etching is an indispensable step to isolate adjacent devices in the fabrication of planar GaN-based devices. Given the simple process, this structure is popular for vertical GaN PND processes. Aside from a uniform electric field at the edge of PN junction, a high BV with nondestructive and avalanche characteristics can be achieved in PNDs. For instance, a simple but deep mesa structure can obtain great performance. As shown in Fig. 5a, with more than 10 µm depth of mesa structure in vertical PNDs, nondestructive BV and avalanche characteristics were confirmed [73].
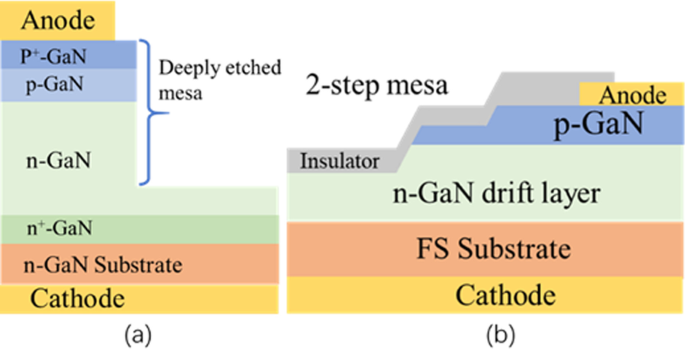
а PNDs with deeply etched mesa structure; б PNDs with two-step mesa [73, 74]
The novel mesa structures are investigated as shown in Fig. 5b. A multi-mesa (two-mesa) structure was adopted in vertical PNDs. With respect to the common single mesa structure, the two-mesa structure can shift the peak electric field from the edge of the PN junction to underneath the thinned p -GaN in the upper mesa because of the total depletion of holes in the thinned p -GaN layer. A high BV of 4.7–4.8 kV with nondestructive feature was successfully achieved by the two-mesa structure. Avalanche capability was obtained without lowering the forward I - V characteristics [74]. On the other hand, the two-mesa structure has the identical function for quasi-vertical PINDs [75]. The BV was enhanced from 665 to 835 V with the low leakage current simultaneously.
Besides the common perpendicular mesa structure, a mesa structure with negative bevel was recently proposed to mitigate the electric field crowding at edge of the PN junction. With the negative bevel mesa, the electric field at the edge has a decreasing trend when the bevel angle θ is lowered from 90˚. The peak electric field would be transferred into device inner. In [76], experimental investigation showed that beveled mesa structure (Fig. 6a) could induce a higher BV over 3 kV and a low leakage current with respect to BV of 3 kV in PNDs with steep mesa when using the same FP structure. Further investigation was performed by simulation using technology computer-aided design (TCAD). In vertical GaN PNDs with beveled mesa (Fig. 6b), the maximum electric field was determined by the acceptor concentration N A in p -GaN, donor concentration N D in n - -GaN drift layer, and θ of the beveled mesa. By theoretical analysis and simulation, the smaller θ could lead to higher E pp (parallel-plane breakdown field). At the same time, a lightly doped p -GaN is beneficial for achieving high BV for a fixed θ of the beveled mesa. Taking θ = 10° as an example, the experimental results support these findings. A parallel-plane breakdown field of 2.86 MV/cm was achieved, and this outcome is consistent with the simulation [77].
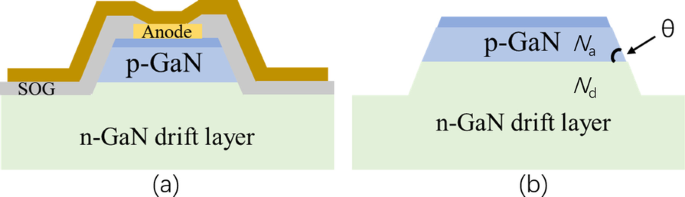
Schematic cross of PND structure with a bevel mesa and FP structure, b PND epitaxial structure is simulated by treating N A , N D и θ as variable [76, 77]
Similar with FP termination, the dry etching and/or insulator (or passivation film) is required in process of edge termination. Thus, the damage from dry etching must be considered and can cause a high reverse leakage current, even the premature breakdown. At the same time, it is a high demand to etched equipment for etched precision, and the etched depth is difficult to control. Meanwhile, the existence of damage generates a more complicated interface state between the insulator and the etched semiconductor, a situation that would affect device reliability. Consequently, reducing or alleviating damage is an inevitable issue. Now, some recipes (e.g., tetramethylammonium hydroxide (TMAH) and post-annealing that have the features of removing the damage by wet etching and repairing dry etching damage, respectively) have been adopted to treat etched surface to improve performance.
Ion Treatment
Ion implantation was employed to alleviate the electric field concentration near the edge. As a relatively simple termination structure, an implantation-based technique was investigated in GaN devices, which includes the compensating species (e.g., O, H, and Zn) or inert species (e.g., Ar, N, He, and Kr) to create deep-level traps in the termination regions [78,79,80,81,82]. Recently, for moderating the occurring of premature breakdown in vertical GaN PNDs, the ion implanted termination (e.g., N, F, Mg, and H) is also utilized. However, the mechanisms of these ion implanted terminations are different.
With respect to vertical GaN SBDs [83], N implantation in vertical GaN PNDs reveals a different mechanism, which entails creating the donor-like defects (N vacancy and N interstitial) to compensate for the p -type dopants. After processing by N implantation as shown in Fig. 7a and b, the conductivity of p -GaN can be reduced or eliminated (insulating) by N implantation [53]. To further improve the BV , a non-fully compensated layer was proposed, that is, a fully compensated layer coupled with a partially compensated counterpart in p -GaN. Thus, a higher BV was expected, and the mechanism was analyzed by simulation [84]. The experimental results show that N implantation with partially compensated p + -GaN could induce a BV of 1.68 kV without compromising the forward characteristics [85].
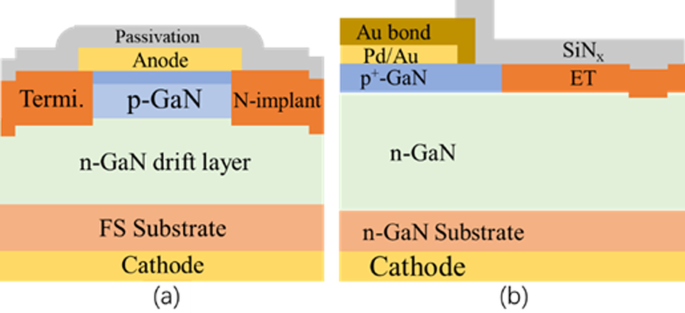
а Cross-sectional plot of the PNDs with N implantation termination, and b N implantation termination with fully and partially compensated [53, 84]
The hydrogen-plasma (H-plasma) edge termination can also reduce p -GaN conductivity, but with another mechanism. H-plasma treatment is an effective passivation method to transform the conductive p -GaN into a highly resistive one because of the strong bond of Mg-H in p -GaN. In contrast to N implantation, the H-plasma treatment is more appropriate for use in vertical GaN PNDs because of the low damage, low temperature, and simple operation involved. As shown in Fig. 8a, the PNDs exhibited an electric field of 3.0 MV/cm with just the H-plasma treatment. Simultaneously, the devices showed comparable forward I - V characteristics and a lower reverse leakage current [86].
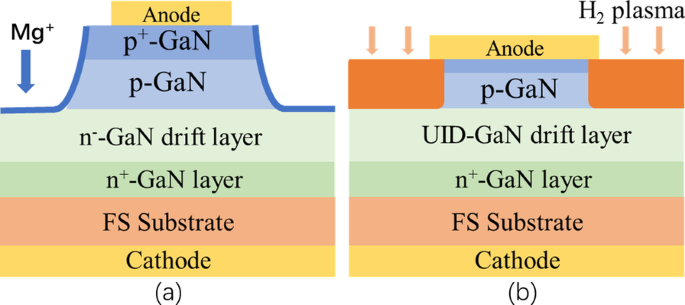
а Schematic view of PND structure by Mg ion treatment; б PNDs with H2 plasma treatment [86, 88]
At the same time, fluorine (F) ion also has the capability of modulating the peak electric field due to the negative fixed charges when the device is under a reverse bias. Nevertheless, if the F implanted edge termination is carried out in vertical GaN PINDs, strict design and structural optimization are needed [87].
In addition to the N, H, and F ion implantation as edge terminations, Mg ion implantation is also an alternative method to convert the surface/interface state, which originates from the damage of ICP dry etching. A novel Mg ion implantation coupled with moat mesa was recently adopted to compensate for the donor-like damage for GaN vertical PNDs (Fig. 8b). Then, a BV of 1.5 kV was achieved with a specific on-state R на of 0.7 mΩ cm 2 [88].
Ion implantation termination is an effective method for a high BV in vertical GaN PNDs. The ion implantation process is also relatively simple. However, crystal damage occurs during high-energy ion implantation. Moreover, post-annealing at high temperature is required in some of the ion implantation terminations for alleviating the crystal damage. The rectangle-shaped ion implantation profile is pursued, so the implantation depth must be controlled exactly. Finally, although the ion implantation process is simple, the equipment needed is costly due to usage of high energy ion.
Guard Rings
The use of floating guard rings (GR) as edge termination to improve BV is an effective method for vertical GaN PNDs, for which the reverse voltage has a voltage drop over the GR to relax the electric field crowding. At the same time, the GR fabrication process does not require a specialized step, which is synchronous with anode metal deposition. For a higher BV , a GR in the FP structure was fabricated in the PNDs (Fig. 9a), in which polyimide was set between the GR and anode portion as resistive device for a further voltage drop. Due to the resistance portion, an incremental 0.2–0.4 kV of BV to a maximum of 5.0 kV was obtained. Compared with normal PNDs without a GR structure, the device with a resistive GR exhibited a similar forward I - V characteristics with R на of 1.25 mΩ cm 2 , but a lower reverse leakage current with BFOM of 20 GW/cm 2 [69].
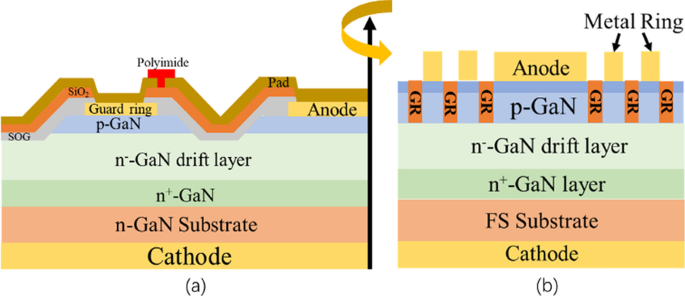
а Vertical GaN PNDs structure with floating GR termination; б PNDs structure with H-implanted GRs [69, 90]
Besides the floating GR, the H-plasma-based GR structure was also applied to form the edge termination. In addition to low damage, the low diffusivity of H-plasma could result in relatively ideal profile in GaN [89]. Owing to passivation effect of the H-plasma on p -GaN, the conductive p -GaN becomes highly resistive, and the GR structure was subsequently formed by the highly resistive p -GaN ring (Fig. 9b). The narrow GR width of 1–2 µm and decreasing spacing were used to improve the BV. GR structures with varied rings were measured. The PNDs with varied rings have similar forward characteristics with around 0.65 mΩ cm 2 and an ideality factor of 1.65 compared with those without GR. More GRs could further relax the electric field at the device edge. Thus, the devices exhibited a higher BV by increasing the number of rings after measurement. Consequently, the PNDs showed a BV of 1.7 kV with the highest electric field of 3.43 MV/cm 10 GRs [90].
The disadvantage of GR is its low area utilization rate, and the GR structure generally requires a large area, which is even bigger than anode. Then, the amount of GR raises the design difficulty such as the width and spacing of the GR. At present, two and more kinds of edge termination are adopted in single vertical GaN PNDs for a higher BV . These edge terminations typically include the FP, bevel mesa, and guard rings due to the relatively simple fabrications. On the other hand, these edge terminations are not meant to introduce the foreign element into the GaN crystal with respect to ion treatment, a feature that is beneficial for device performance. However, the quality of epitaxial layers still occupies a considerable proportion.
Vertical GaN PNDs on Si Substrate
To date, although vertical GaN-on-GaN devices exhibit excellent performance, the high cost and small diameter of GaN substrates still impede their large-scale market applications. Consider to the merit of a large scale and low cost of Si substrate, GaN-on-Si devices have attracted considerable many attentions at this stage.
For the quasi-vertical PND on Si substrate, high-quality buffer is essential. In [91], as shown in Fig. 10a, optimizing the AlN nucleation layer and the succeeding growth process, a GaN drift layer with a low threading dislocation density of 2.95 × 10 8 см −2 and high electron mobility of 720 cm 2 / Vs было получено. With the FP structure, the device has a BV of 820 V with R на of 0.33 mΩ cm 2 .
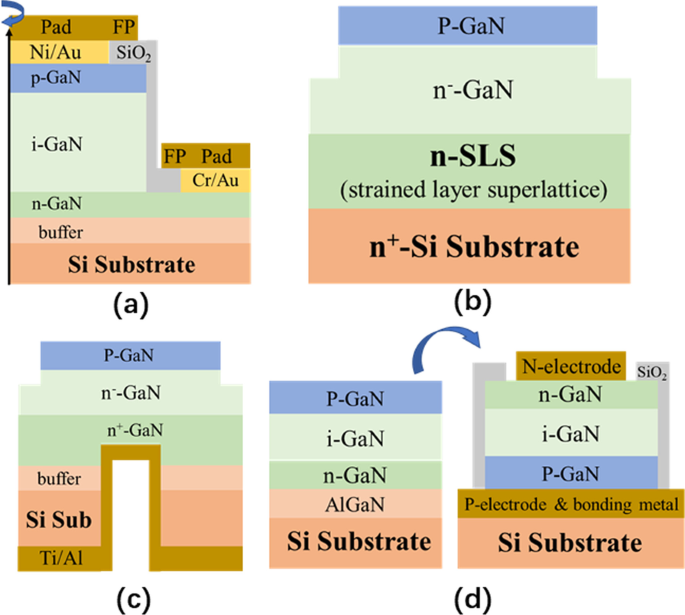
а Quasi-vertical PINDs with FP; б fully vertical PNDs by using the thin AlN and SLS superlattice structure on conductive Si substrate; c PNDs with trenched ohmic contact on back; г PNDs fabricated by layer transfer technology [91,92,93,94]
In addition to the challenge of materials mismatch, the conductive buffer layer and Si substrate are fundamental for fully vertical PNDs on Si substrate. In Fig. 10b, a n + -type Si substrate was first utilized as the cathode of vertical PNDs. Subsequently, the Si-doped thin AlN layer and GaN/AlN strained superlattice layer were employed to facilitate device performance [92]. Vertical PNDs on Si substrate are proposed with FP, and a BV of 288 V is confirmed with a drift layer of 1.5 µm. Moreover, a higher BV of 720 V in PNDs on Si with 5.7 µm drift layer is reported in Fig. 10c [93]. Unlike the conductive Si substrate method, the cathode ohmic on back approach was made by a trench, which reaches the n + -GaN layer through the selective removal of regular Si substrate and buffer layer.
Besides the conductive Si substrate and trenched ohmic contact on back, substrate removal technology is an alternative method to produce vertical GaN PNDs on Si substrates. In Fig. 10d, a layer transfer technology is used to process vertical PINDs on Si substrate. After Si substrate removal, transfer, n -electrode, and sidewall passivation, the devices exhibit a low R на of 3.3 mΩ cm 2 and BV of 350 V [94]. The high BFOM value of 37.0 MV/cm 2 in PINDs demonstrates that substrate removal technology is an effective way for GaN-based PIND fabrication on Si substrates. Relative to other technologies, however, the more complicated fabrication process and higher production cost are issues that must be addressed during the substrate removal part.
As an alternative technical route, PNDs on Si substrates are fabricated with quasi-vertical or vertical device structures. To mitigate the substantial material mismatch between the Si substrate and GaN epitaxial stacks, a more effective epitaxial technology must be investigated. For a higher BV , thicker drift layer is also essential for a higher BV . This fact presents another key issue to investigate because the drift layer thickness on Si substrate is approximately 5 µm.
Future Challenges and Conclusion
Vertical PNDs are essential to simultaneously obtain high current (> 100 A) with high voltages (> 600 V), which can meet the requirements of several applications including electric vehicles and recycled energy processing. Despite the great progress achieved, applications of vertical GaN PNDs remain several barriers such as cost and technical limitations.
For FS-GaN substrate, high epitaxial quality with low threading dislocation has been achieved by a common MOCVD. The small size and high cost of the FS-GaN substrate confine the applications of the vertical GaN PNDs within a narrow range, and the small size also raises the price of GaN. The commercial GaN substrate is only 2-inch and is much smaller than 4–6 inch SiC and 8–12 inch Si substrates. The primary challenge for vertical GaN PNDs is achieving high epitaxial quality, especially the high quality of the p -GaN layer with a high hole concentration. Recently, novel PNDs are proposed through replacing p -GaN with NiOx synthesized by thermal oxidation or sputtering; great performance is also demonstrated as replacement of p -GaN in vertical PND and guard ring in GaN SBD [95,96,97,98].
Vertical GaN PNDs, as one of the most promising power devices, are reviewed and summarized in this study. The recent progresses on vertical GaN PNDs, including comparison of different materials (SiC vs. GaN) and different device structures (SBD versus PND), material epitaxy growth and edge termination techniques (FP, MESA, ion implanted and GR edge terminations), are discussed. Значения R на versus BV by varied technologies are plotted in Fig. 11. Aside from the epitaxial technologies, edge termination technologies play a key role for vertical GaN PNDs to achieve high device performance at this stage. Despite its great progress in terms of device performance, the advantages of vertical GaN PNDs remain under-exploited. The characteristics of vertical GaN PNDs could be promoted by optimizing the device structure and epitaxial quality in succeeding studies. Then, commercialized vertical GaN PNDs will soon be available in the future with mature edge termination and epitaxial techniques.
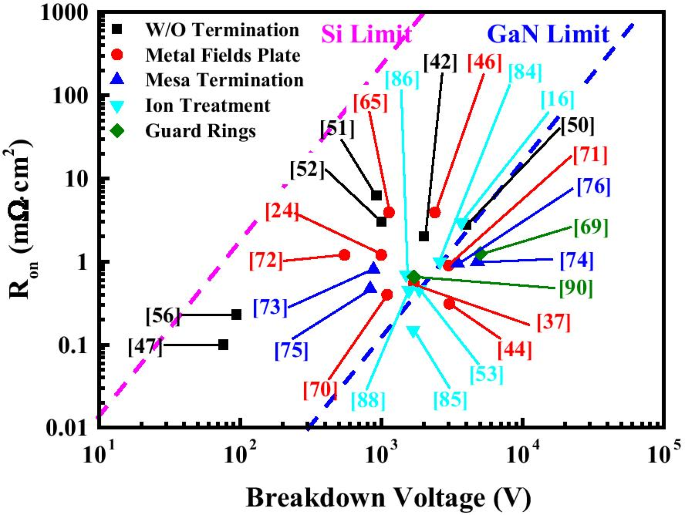
Benchmarking of the R на versus BV of quasi- or full-vertical GaN PNDs
Доступность данных и материалов
Наборы данных, использованные или проанализированные в ходе текущего исследования, можно получить у соответствующего автора по разумному запросу.
Сокращения
- GaN:
-
gallium nitride
- SiC:
-
silicon carbon
- PND:
-
PN junction diode
- PIND:
-
P-i-N junction diode
- SBD:
-
Диод с барьером Шоттки
- IGBT:
-
insulated gate bipolar transistors
- BJT:
-
bipolar junction transistor
- MOSFET:
-
metal oxide semiconductor field effect transistor
- BFOM:
-
Baliga’s figure of merit
- HFET:
-
heterostructure field-effect transistor
- JFET:
-
junction field-effect transistor
- 2DEG:
-
two-dimensional electron gas
- BV:
-
breakdown voltage
- FS:
-
free-standing
- MOCVD:
-
metalorganic chemical vapor deposition
- MBE:
-
molecular beam epitaxy
- JBS:
-
junction barrier Schottky
- MPS:
-
merged PN Schottky
- Светодиод:
-
light-emitting diode
- HVPE:
-
hydride vapor phase epitaxy
- FP:
-
field plate
- TD:
-
threading dislocation
- MOVPE:
-
metalorganic vapor phase epitaxy
- HEMT:
-
high electron mobility transistor
- UHPA:
-
ultra-high-pressure annealing
- GR:
-
guard ring
- ICP:
-
inductively coupled plasma
- TCAD:
-
technology computer-aided design
- TMAH:
-
tetramethylammonium hydroxide
Наноматериалы
- Источники энергии
- Устройства следующего поколения предоставляют улучшенные возможности PoE для устройств IoT
- Устройства увеличивают мощность PoE по сравнению с существующими коммутаторами и кабелями
- Наногенератор
- Безопасность Интернета вещей:чему мы можем научиться из недавних угроз
- Инженеры разрабатывают WiFi-радиостанции со сверхнизким энергопотреблением
- Как беспроводная энергия меняет производство
- Беспроводное питание нескольких носимых устройств от одного источника
- Использование солнечной технологии для питания интеллектуальных устройств в помещении
- Система собирает энергию радиоволн для питания носимых устройств



