Плазменное осаждение атомных слоев пленок кобальта с использованием Co (EtCp) 2 в качестве прекурсора металла
Аннотация
Для усовершенствованной технологии межсоединений Cu широко исследовались пленки Co, которые могут служить заменой футеровки и затравочного слоя из-за лучшей смачиваемости Cu, чем Ta. В этой статье пленки Co выращиваются путем плазменного осаждения атомных слоев с использованием Co (EtCp) 2 в качестве прекурсора, и влияние параметров процесса на характеристики пленок Co тщательно исследовано. Результаты показывают, что окно процесса составляет 125–225 ° C со скоростью роста ~ 0,073 Å / цикл. То есть соединение группы Et с лигандом Cp может обеспечить стабильный рост пленки при 125 ° C, в то время как соответствующая температура должна быть выше 200 ° C в пересчете на Co (Cp) 2 и Co (MeCp) 2 . Осажденные пленки содержат элементы N и O, помимо доминирующих Co и C. Кроме того, удлинение NH 3 Длительность импульса значительно увеличивает проводимость пленки Co, а низкое удельное сопротивление 117 мкОм · см может быть достигнуто с помощью NH 3 время импульса 40 с. Среднеквадратичная шероховатость меньше изменяется в зависимости от температуры осаждения и остается на низком уровне ~ 0,3 нм, что свидетельствует о плоской пленке Со.
Фон
Принимая во внимание обычный процесс соединения Cu в высокоскоростных сверхбольших интегральных схемах, барьерный слой, такой как TaN, необходим для предотвращения диффузии атомов Cu в окружающие межслойные диэлектрики (ILD) [1]. Помимо барьерного слоя, для усиления адгезии между барьерным слоем и Cu также необходим подкладочный слой, такой как Ta. Кроме того, прямое гальваническое осаждение линии Cu на облицовочный слой затруднено из-за слабого зарождения атомов Cu на поверхности Ta. Как следствие, необходимо нанести затравочный слой Cu на облицовочный слой до гальванического покрытия Cu. Другими словами, стопка затравочного слоя TaN / Ta / Cu должна быть вставлена между линией ILD и Cu. Кроме того, эта стопка нанесена на ILD в виде канавок и переходных отверстий. При уменьшении размера элемента устройства объем, доступный для соединительной линии Cu, неуклонно уменьшается. Для достижения более низкого сопротивления медных межсоединений широко исследуется бессемянный барьерный / подкладочный слой [2,3,4,5,6]. Например, TaN по-прежнему работает как барьерный слой, а Co заменяет Ta в качестве подкладочного слоя. Благодаря лучшей смачиваемости Co до Cu, чем Ta, Cu можно наносить гальваническим способом непосредственно на поверхность Co. Традиционно барьерный / облицовочный слой выращивают методом физического осаждения из паровой фазы. Однако нанесение высококачественного барьерного / облицовочного слоя является сложной задачей, поскольку PVD имеет низкую степень покрытия ступеней в канавках и переходных отверстиях с высоким соотношением сторон. Вместо этого можно получить сверхтонкие, сплошные пленки с хорошим покрытием ступеней с помощью метода атомно-слоистого осаждения (ALD) благодаря свойству самоограничения роста [7].
Что касается пленок ALD Co, широко изучалось большое количество предшественников Co, особенно на основе циклопентадиенильного лиганда (Cp), таких как бис-циклопентадиенилкобальт (CoCp 2 ) [8,9,10,11,12,13,14], бис (η-метилциклопентадиенил) кобальт [Co (MeCp) 2 ] [15] и циклопентадиенилизопропилацетамидинатокобальт [Co (CpAMD)] [16]. Использование CoCp 2 позволяет выращивать пленки Co с низким удельным сопротивлением и высокой чистотой; однако стабильный рост пленки ограничивается температурами выше 250 ° C. При добавлении метильной группы к лиганду Cp более низкий рост температуры может быть достигнут при 200 ° C, что объясняется более высокой реакционной способностью NH 3 радикал к лиганду MeCp по сравнению с лигандом Cp. На основе выращивания пленки Co с CoCp 2 и Co (MeCp) 2 в качестве предшественников окно процесса может быть перемещено в сторону более низких температур, то есть <200 ° C, если этильная группа связана с лигандом Cp.
В этой работе тонкие пленки Co были выращены с помощью плазменно-усиленной ALD (PE-ALD) с использованием бис (этилциклопентадиенил) кобальта [Co (EtCp) 2 ] и NH 3 плазма в качестве прекурсоров. Было тщательно исследовано влияние различных параметров процесса на характеристики пленок Co. В результате было успешно достигнуто рабочее окно 125–225 ° C. Кроме того, пленки Co имеют более низкое удельное сопротивление (~ 130 мкОм см).
Методы
Различные тонкие пленки Co были выращены методом PE-ALD на 200 нм SiO 2 пленка, которая была нанесена на кремниевые подложки p-типа методом термического окисления. Co (EtCp) 2 использовался в качестве прекурсора металла, который хранился в контейнере при 70 ° C и переносился в камеру осаждения с N 2 газ-носитель. NH 3 Плазма генерировалась удаленным плазменным генератором мощностью 2800 Вт, действующим в качестве восстановителя. Расход N 2 поддерживалась на уровне 50 см3 / мин, а рабочее давление составляло ~ 1000 Па во время роста пленки. Для исследования влияния температуры осаждения на рост пленки температура подложки изменялась от 100 до 270 ° C с шагом 25 ° C. Кроме того, для оптимизации параметров процесса время импульсов Co (EtCp) 2 и NH 3 плазма тоже была изменена соответственно. Кроме того, чтобы исследовать влияние постотжига на характеристики пленок Co, образцы, осажденные при различных температурах, были отожжены в формирующем газе (N 2 / 4% -H 2 ) при 400 ° C в течение 30 мин.
Толщина и плотность пленки были определены путем отражения рентгеновских лучей, а микроструктура пленки была определена путем дифракции рентгеновских лучей при скользящем падении (XRD) на дифрактометре (Bruker D8 Discover) с Cu K α радиация. Морфологию поверхности пленки наблюдали с помощью атомно-силовой микроскопии (AFM) (Bruker Icon) и сканирующего электронного микроскопа (SEM) (Zeiss SIGAMA HD). Элементный состав и химические связи пленки анализировали с помощью рентгеновской фотоэлектронной спектроскопии (XPS) (Kratos Axis Ultra DLD). Листовое сопротивление пленки измерялось четырехточечным зондом, а удельное сопротивление пленки рассчитывалось на основе толщины пленки и сопротивления листа.
Результаты и обсуждение
Оптимизация параметров процесса ALD
На рис. 1а показана зависимость скорости роста пленки Co от температуры подложки. Обнаружено, что скорость роста увеличивается при повышении температуры подложки до 125 ° C, а затем достигается относительно стабильная скорость роста 0,073 ± 0,02 Å / цикл между 125 и 225 ° C. Однако, когда температура субстрата поднимается до 250 ° C или выше, скорость роста увеличивается. Следовательно, диапазон температур 125–225 ° C можно рассматривать как подходящее окно процесса. По сравнению с Co (Cp) 2 и Co (MeCp) 2 , добавление группы Et к лиганду Cp позволяет переместить окно процесса к более низкой температуре осаждения, что указывает на более высокую реакционную способность лигандов EtCp с NH 3 плазма. Такой низкий рост температуры до 125 ° C способствует сокращению теплового баланса. Что касается температуры подложки ниже 125 ° C, относительно более медленный рост пленки следует объяснить отсутствием адекватной энергии активации химической реакции [7]. Такая высокая скорость роста при ≥ 250 ° C связана с термическим разложением металлического прекурсора [17]. Чтобы исследовать влияние Co (EtCp) 2 время импульса от скорости роста осаждаемой пленки, время импульса Co (EtCp) 2 постепенно увеличивается от 1 до 4 с с шагом 1 с, в то время как другие параметры процесса являются фиксированными. Как показано на рис. 1b, скорость роста увеличивается с ~ 0,06 до ~ 0,073 Å / цикл с увеличением Co (EtCp) 2 длительность импульса от 1 до 2 с, а затем поддерживает относительно стабильное значение. Это указывает на то, что поверхностная адсорбция Co (EtCp) 2 достигает насыщения при длительности импульса 2 с. Рисунок 1b также иллюстрирует влияние NH 3 -время импульса плазмы от скорости роста пленки. Скорость роста увеличивается с продлением NH 3 -время импульса плазмы; однако, когда время импульса плазмы превышает 20 с, скорость роста достигает значения насыщения ~ 0,12 Å / цикл.

Зависимость скорости роста пленки ALD от a температура основания, b Co (EtCp) 2 , и NH 3 время импульса
Характеристика размещенных совместных фильмов
На рис. 2 представлены обзорные РФЭС-спектры пленок, осажденных при 175 ° C. Осажденные пленки состоят из элементов Co, N, O и C. Стоит отметить, что для полного удаления поверхностного загрязнения все образцы были протравлены in situ бомбардировкой ионами Ar в течение 6 мин перед сбором спектров XPS. В таблице 1 приведены процентные содержания элементов в пленке, осажденной при 175 ° C со временем травления, а содержание C и O остается постоянным после 6 минут травления, что указывает на полное удаление поверхностных загрязнений. В таблице 2 приведено соотношение элементарных атомов пленок, выращенных при 100 и 175 ° C, соответственно, которые извлечены из спектров XPS высокого разрешения. При повышении температуры подложки от 100 до 175 ° C относительное содержание C уменьшается с 40 до 32%, а процентное содержание элементарного азота N увеличивается с 14 до 18%. Более того, относительный процент O показывает небольшое увеличение от 5 до 7%. Более высокое содержание углерода следует приписать частичному удалению лигандов EtCp [15, 16]. Поскольку в прекурсорах нет элемента O, атомы O в осажденных пленках, вероятно, происходят из кислорода в реакционной камере.
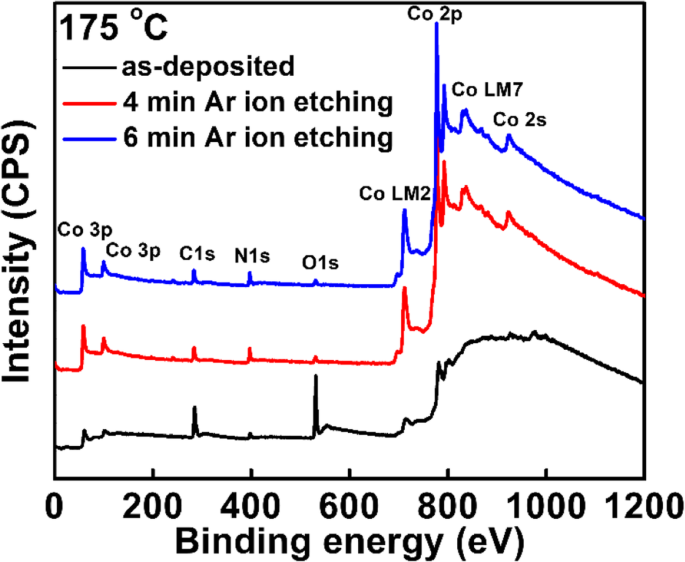
Обзорные спектры пленок Co, осажденных при 100 ° C, с разным временем травления
На рис. 3а представлены C 1s-спектры высокого разрешения пленок, осажденных при различных температурах. Спектр C 1s можно хорошо разделить на четыре компонента при 283,2, 284,7, 286,1 ± 0,1 эВ и 288,9 эВ, которые являются результатом C-Co [12], CC [12, 18], CN [15, 19] и CO [12] связи соответственно. При повышении температуры от 100 до 175 ° C относительное содержание связи C-C уменьшается с 61 до 56%, тогда как содержание C-Co, C-N и C-O увеличивается на 1%, 2% и 2% соответственно. Это показывает, что большее количество лигандов EtCp разложилось при более высокой температуре, что привело к снижению относительного процента C в пленке. На рис. 3б представлены N 1s-спектры высокого разрешения пленок, осажденных при различных температурах. Каждый спектр N 1s может быть хорошо разделен на две составляющие с помощью функции Гаусса-Лоренца. Пик, расположенный при 397,8 эВ, должен быть связан со связью N-Co [13], а пики с центром при 399,2 эВ должны соответствовать связи N-C [20, 21]. При повышении температуры подложки от 100 до 175 ° C относительное содержание N-Co снижается с 72 до 69%. Это связано с тем, что десорбция азота из пленки усиливается при более высокой температуре, что приводит к образованию меньшего количества связей N-Co. На рисунке 3c показан Co 2p 3/2 высокого разрешения. XPS-спектры пленок Co, осажденных при различных температурах. Что касается существования связей C-Co и N-Co, как показано на рис. 3a, b, разумно, что Co 2p 3/2 Спектр можно разделить на три составляющие, которые расположены при 778, 778,9 и 780,86 ± 0,34 эВ соответственно. Пик наименьшей энергии связи следует отнести к связи Co-Co [12, 22]. Кроме того, поскольку электроотрицательность по Полингу для C (2,55) меньше, чем для N (3,04), плотность положительного заряда на Co, связанном с N, больше, чем на Co, связанном с C. Следовательно, пики при 778,9 и 780,86 ± 0,34 эВ должны возникать из-за связей Co-C и Co-N соответственно. Когда температура осаждения увеличивается со 100 до 175 ° C, относительное содержание связи Co-N уменьшается с 48 до 32%, что согласуется с эволюцией связи N-Co на рис. 3b.

Высокое разрешение a Co 2p 3/2 , b C 1s и c XPS-спектры N 1s пленок, осажденных при 100 ° C и 175 ° C соответственно
Кристаллические свойства пленок Co охарактеризованы методом просвечивающей электронной микроскопии, как показано на рис. 4. Пленки Co, осажденные при 100 и 250 ° C, соответственно, являются кристаллизованными. На рис. 5 представлены АСМ-фотографии пленок Co, выращенных при различных температурах. При повышении температуры осаждения от 100 до 250 ° C среднеквадратичная шероховатость (RMS) показывает меньшие отклонения и сохраняет низкое значение ~ 0,3 нм, что указывает на плоскую пленку Co.
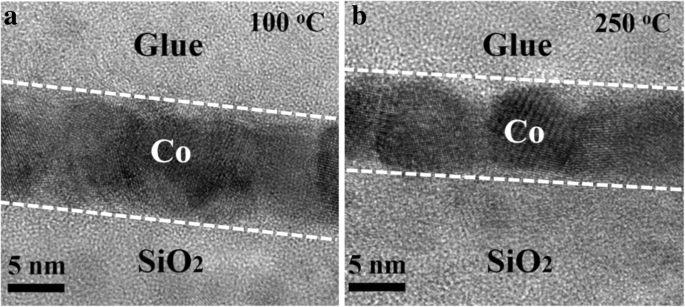
ПЭМ-изображения поперечного сечения пленок Co (1200 циклов), осажденных в a 100 ° C и b 250 ° С соответственно
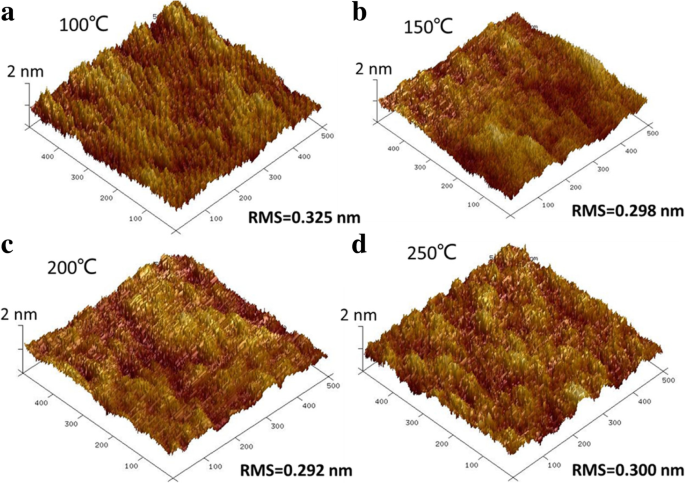
АСМ изображения пленок Co (1200 циклов), осажденных Co (EtCp) 2 длительность импульса 2 с и NH 3 длительность импульса плазмы 10 с при различных температурах: a 100 ° С; б 150 ° С; c 200 ° С; г 250 ° С
На рис. 6а, б показана зависимость удельного сопротивления пленок Co от температуры подложки и NH 3 время импульса. Удельное сопротивление пленки заметно снижается с 652 до 130 Ом · см, а затем остается постоянным при повышении температуры осаждения от 100 до 275 ° C. Полученные результаты следует отнести к увеличению относительного содержания металлического Со в пленке. Как NH 3 время импульса увеличивается с 10 до 40 с, удельное сопротивление пленок Co уменьшается с 158 до 117 мкОм · см (см. рис. 6б). На рисунке 7 показан Co 2p 3/2 Спектры РФЭС пленок Co, осажденных с различными NH 3 плазменные времена. Как NH 3 время плазмы увеличивается с 10 до 40 с, относительный процент связей Co-Co увеличивается с 31 до 34%, а относительное содержание связей Co-C уменьшается с 40 до 31%. Кроме того, содержание углерода уменьшается на 22% по мере того, как NH 3 время импульса плазмы увеличивается с 10 до 40 с. Это указывает на постепенно увеличивающееся удаление лигандов EtCp, что способствует снижению удельного сопротивления пленки Со.

Удельное сопротивление пленки Co как функция температуры роста ( a ) и NH 3 время импульса ( b ) соответственно
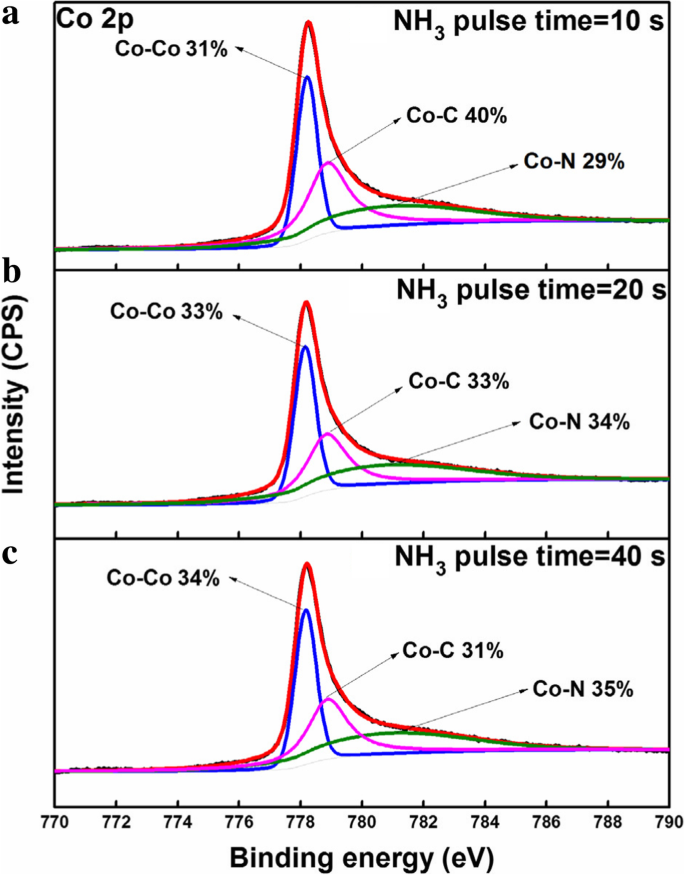
Спектры РФЭС пленок Co с различными NH 3 время плазмы: a 10 с; б 20 с; c 40 с
В таблице 3 показано сравнение характеристик пленок Co, выращенных с использованием различных прекурсоров. По сравнению с CoCp 2 и Co (MeCp) 2 , Co (EtCp) 2 позволяет наносить атомные слои пленок Co при более низкой температуре. Кроме того, использование металлического прекурсора Co (EtCp) 2 приводит к меньшей скорости роста. Теоретически процесс ALD - это рост монослоя за монослоем. Фактически, эффект стерических затруднений и поверхностная адсорбция прекурсоров влияют на рост пленки. Что касается эффекта стерического препятствия, это означает, что лиганды хемосорбированных видов предшественников металлов могут защищать частичную поверхность и предотвращать полную адсорбцию других видов предшественников металлов на поверхности подложки. Поскольку Co (EtCp) 2 имеет более крупный лиганд по сравнению с CoCp 2 и Co (MeCp) 2 , предполагается, что во время процесса ALD будет возникать значительный эффект стерических затруднений. Это может привести к росту субмонослоя, что приведет к меньшей скорости роста. С другой стороны, поскольку слой лайнера Co должен быть нанесен на барьерный слой TaN для будущих практических приложений, на пленке ALD TaN при 125 ° C было выращено 1200 циклов пленок Co. На рис. 8 показано поперечное сечение ПЭМ-изображения пленки Co, нанесенной на поверхность TaN. Замечено, что пленка Co является сплошной и однородной, демонстрируя превосходные характеристики роста. Кроме того, было обнаружено, что толщина (около 10 нм) пленки Co, нанесенной на пленку ALD TaN, аналогична толщине, полученной на SiO 2 поверхность.
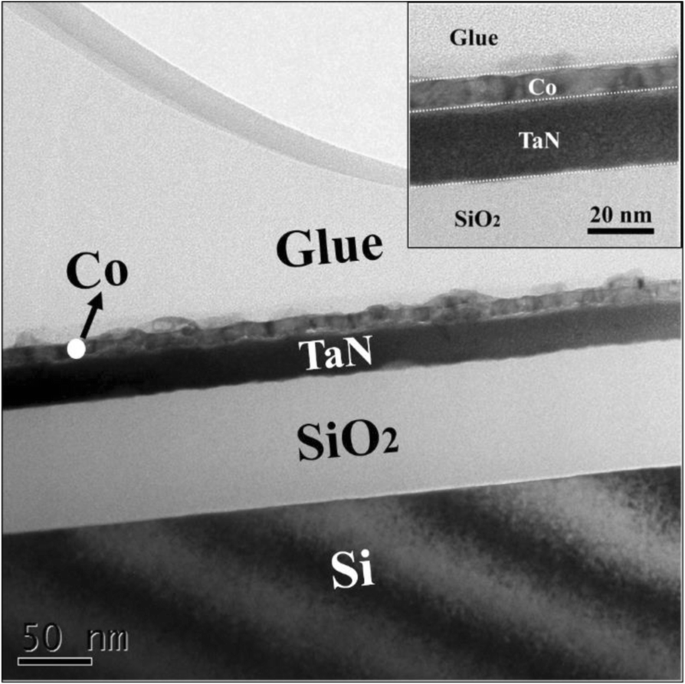
ПЭМ-изображение поперечного сечения пленки Co (1200 циклов), осажденной при 125 ° C на поверхность ALD TaN; вставка представляет собой увеличенное изображение
Выводы
Рост тонкой пленки Co осуществляется PE-ALD с использованием прекурсоров Co (EtCp) 2 , а также влияние технологических параметров на характеристики пленок Co. Добавление группы Et к лиганду Cp позволяет переместить окно процесса на более низкую температуру осаждения 125 ° C. Кроме того, пленки Co состоят из элементов Co и C вместе с некоторыми элементами N и O. При повышении температуры осаждения лиганды EtCp удаляются в большей степени, и относительное процентное содержание элементов C уменьшается. Как следствие, удельное сопротивление осажденных пленок Co снижается с 652 до 130 мкОм · см, а затем остается стабильным значением при повышении температуры подложки от 100 до 275 ° C. Для температуры осаждения 125 ° C удельное сопротивление постепенно уменьшается с увеличением NH 3 . длительность импульса и низкое удельное сопротивление 117 мкОм · см могут быть получены, когда NH 3 используется длительность импульса 40 с. Среднеквадратичная шероховатость меньше изменяется в зависимости от температуры осаждения и остается на низком уровне ~ 0,3 нм, что свидетельствует о плоской пленке Со.
Сокращения
- AFM:
-
Атомно-силовая микроскопия
- ALD:
-
Осаждение атомного слоя
- Co (CpAMD):
-
Циклопентадиенилизопропилацетамидинато кобальт
- Co (EtCp) 2 :
-
Бис (этилциклопентадиенил) кобальт
- Co (MeCp) 2 :
-
Бис (η-метилциклопентадиенил) кобальт
- CoCp 2 :
-
Бис-циклопентадиенилкобальт
- Cp:
-
Циклопентадиенил
- ILD:
-
Межслойный диэлектрик
- PE:
-
С плазменным усилением
- RMS:
-
Среднеквадратичное значение
- SEM:
-
Сканирующий электронный микроскоп
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
- XRD:
-
Рентгеновская дифракция
Наноматериалы
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на по…
- Межфазные, электрические характеристики и характеристики совмещения полос стопок HfO2 / Ge с прослойкой SiO2, сфор…
- Исследования сорбции ионов тяжелых металлов с использованием нанокомпозитов из модифицированного железом б…
- Иерархические антибактериальные полиамидные 6-ZnO нановолокна, полученные путем осаждения атомных слоев и гид…
- Фотокаталитические свойства порошков TiO2 с покрытием Co3O4, полученных методом плазменного осаждения атомного …
- Двухэтапное осаждение ZnO, легированного алюминием, на p-GaN с образованием омических контактов
- Настройка уровня Ферми пленок ZnO посредством суперциклического осаждения атомного слоя
- Измерение толщины слоя с помощью микроскопа
- Преимущества использования сплавов



