Влияние двухслойных гетероструктур CeO2 − x / ZnO и ZnO / CeO2 − x и полярности электроформования на коммутационные свойства энергонезависимой памяти
Аннотация
Устройства памяти с двухслойным CeO 2 − x / ZnO и ZnO / CeO 2-x гетероструктуры, помещенные между верхним титановым и нижним платиновыми электродами, были изготовлены методом высокочастотного магнетронного распыления при комнатной температуре. Полупроводниковые материалы N-типа использовались в гетероструктурах обоих устройств, но, что интересно, изменение гетероструктуры и полярности гальванопластики вызывало значительные изменения в свойствах резистивного переключения (RS). Результаты показали, что полярность гальванопластики оказывает большое влияние на как CeO 2 − x / ZnO и ZnO / CeO 2-x характеристики гетероструктуры, такие как напряжение гальванопластики, хорошая межцикловая износостойкость (~ 10 2 ) и соотношение ВКЛ / ВЫКЛ. Устройство с CeO 2 − x Гетероструктура / ZnO демонстрирует хорошие характеристики RS из-за образования барьера Шоттки на верхней и нижней границах раздела. Доминирующим механизмом проводимости состояния с высоким сопротивлением (HRS) была эмиссия Шоттки в области сильного поля. Характер температурной зависимости состояния с низким сопротивлением и HRS подтвердил, что RS вызывается образованием и разрывом проводящих нитей, состоящих из кислородных вакансий.
Фон
Обычные флэш-памяти сталкиваются со своими физическими и практическими ограничениями, поэтому поиск новых возможных кандидатов для приложений энергонезависимой памяти стал очень необходим. В связи с этим было предложено несколько новых типов памяти в качестве кандидатов в энергонезависимую память следующего поколения [1, 2]. Среди них резистивная память с произвольным доступом (RRAM) рассматривается как лучший кандидат для замены обычных запоминающих устройств из-за ее уникальных характеристик, таких как высокая возможность масштабирования, длительное время хранения памяти, меньший размер устройства, быстрая скорость переключения, низкое потребление энергии. , энергонезависимость и простая структура [3]. Ячейка памяти RRAM представляет собой конденсаторную структуру металл-оксид-металл (MOM). Поведение биполярного резистивного переключения (BRS) и униполярного RS (URS) между двумя состояниями сопротивления, т. Е. Состоянием низкого сопротивления (LRS) и состоянием высокого сопротивления (HRS) пленки резистора, может быть достигнуто путем подачи внешнего напряжения соответствующей величины и полярности [4,5,6].
Коммутационная способность устройства RS зависит от однородности SET-напряжения, RESET-напряжения и уровней тока в LRS и HRS [7]. На эти параметры переключения влияют пленочные диэлектрики, материалы электродов и технология изготовления / эксплуатации. К настоящему времени было предложено множество моделей для объяснения зависимости характеристик переключения от этих параметров. Поведение переключения можно разделить на ограниченное по объему или интерфейсом [8]. Для переключения с ограничением объема параметры переключения сильно зависят от диэлектрической проницаемости диэлектрических пленок [9]. Однако переключение, ограниченное электродом, происходит из-за электронной корреляции на границе раздела металл-диэлектрик и работы выхода материалов электродов [10]. Интерфейс между анодом и диэлектрической пленкой также может влиять на параметры RS запоминающего устройства [10, 11].
Среди нескольких оксидов церий (CeO 2 ) оказался многообещающим материалом для устройств памяти RS из-за его большой диэлектрической проницаемости (~ 26), более низкой свободной энергии Гиббса (-1024 кДж / моль), двух видов окисления (Ce + 4 кому:Ce + 3 ) состояний, а распределение вакансий (особенно вакансий кислорода) нестехиометрическое [12, 13]. С другой стороны, оксид цинка (ZnO) благодаря своим исключительным свойствам широко используется в различных областях. Отмечается, что ZnO используется в качестве диэлектрика из-за его оптической прозрачности, широкой запрещенной зоны, химической стабильности и высокого удельного сопротивления (10 5 Ом-см) [14]. Недавно были предложены двухслойные структуры памяти RS, которые демонстрируют превосходящие свойства по сравнению с однослойными устройствами с точки зрения снижения напряжений гальванопластики и / или SET / RESET, улучшения однородности переключения, длительного срока службы и самодостаточности [15]. Xu et al. [16] исследовали RS-поведение ZrO 2 . и двухслойные стопки ZnO, иллюстрирующие, что миграция кислородных вакансий зависит от высоты оксидного межфазного барьера. Поведение RS, наблюдаемое в двухслойном MnO / CeO 2 было предложено, чтобы структура была обусловлена реакцией окисления и восстановления CeO 2 как сообщает Hu et al. [17]. Ян и др. [18] показали хорошие характеристики резистивной коммутации двухслойных устройств на основе CuO / ZnO по сравнению с однослойными устройствами на основе ZnO. Park et al. [19] продемонстрировали более надежную и воспроизводимую операцию RS, наблюдаемую в Pt / TiO x / ZnO / Pt ячейки памяти, чем указано в ячейках памяти Pt / ZnO / Pt. Hsieh et al. [20] описали, что Ni / ZnO / HfO 2 Устройства / Ni демонстрируют биполярное резистивное переключение с многоуровневыми характеристиками во время процесса RESET. Все такие улучшенные характеристики RS послужили поводом для глубоких исследований бислоя ZnO / CeO 2 или как главный исполнительный директор 2 / ZnO-гетероструктуры, поскольку никаких исследований этих стеков и влияния полярности формирования на их характеристики RS и производительность памяти еще не проводилось.
В этой работе мы сообщили о влиянии двухслойной гетероструктуры, а также полярности гальванопластики на RS-свойства ZnO / CeO 2 − x и CeO 2 − x / Устройства памяти на основе ZnO. Результаты показали, что положительно электроформованный CeO 2-x / Устройства ZnO и ZnO / CeO с отрицательной электролитической формовкой 2 − x устройства демонстрируют более низкое напряжение гальванопластики и гораздо лучшую стойкость к переключению между циклами (~ 10 2 ) представление. Температурная зависимость сопротивлений LRS и HRS этих двухслойных устройств с противоположной полярностью смещения указывает на то, что наблюдаемый механизм RS можно объяснить проводящими каналами на основе кислородных вакансий.
Методы
Два вида Ti / CeO 2 / ZnO / Pt и Ti / ZnO / CeO 2 / Pt-гетероструктуры были подготовлены в данной работе для сравнительного исследования. Для изготовления первых Ti / CeO 2 / ZnO / Pt, активный слой тонкой пленки ZnO (~ 10 нм) был нанесен на промышленный Pt / Ti / SiO 2 / Si (Pt) подложек при комнатной температуре с помощью радиочастотного (RF) магнетронного распыления с использованием керамической мишени ZnO (чистота 99,99%). Во время напыления мощность ВЧ 75 Вт и давление ~ 10 мТорр в атмосфере Ar:O 2 Смесь (6:18) (скорость потока =24 sccm) поддерживали. Затем главный исполнительный директор 2 слой (5 нм) был нанесен на ZnO / Pt с помощью высокочастотного магнетронного распыления в тех же условиях с образованием двухслойного CeO 2 / Гетероструктура ZnO. Наконец, на обе эти гетероструктуры был нанесен верхний электрод Pt / Ti (TE) путем последовательного магнетронного распыления на постоянном токе (DC) с использованием металлической теневой маски. С помощью этого метода были получены круглые устройства (ячейки памяти) диаметром 150 мкм. Здесь Pt использовалась в качестве защитного слоя для защиты Ti TE от окисления. Таким же образом второй Ti / ZnO / CeO 2 Устройство с гетероструктурой / Pt также было изготовлено в тех же условиях, что и для Ti / CeO 2 / ZnO / Pt-гетероструктуры. Оба Ti / CeO 2 / ZnO / Pt и Ti / ZnO / CeO 2 Устройства памяти с гетероструктурой / Pt характеризовались анализатором параметров полупроводников Agilent B1500A с использованием стандартного двухзондового метода измерения. Двухслойная структура этих устройств была охарактеризована с помощью просвечивающей электронной микроскопии высокого разрешения (HRTEM-JEM 2001F).
Результаты и обсуждение
На рис. 1а, б показана схематическая конфигурация двухслойного Ti / CeO 2 . / ZnO / Pt и Ti / ZnO / CeO 2 / Pt гетероструктурные устройства памяти соответственно. На рис. 2a – d показаны типичные вольт-амперные характеристики ( I - V ) кривые Ti / CeO 2 − x / ZnO / Pt и Ti / ZnO / CeO 2-x / Pt-устройства памяти гетероструктуры, включая начальный процесс гальванопластики, с указанием типичных биполярных характеристик RS. Когда к TE применяли развертку +2 В, произошел внезапный скачок тока при 0,6 В, указывающий на образование проводящих путей между двумя электродами (рис. 2а). Устройство оставалось во включенном состоянии (LRS) после снятия положительного напряжения гальванопластики. На рисунке 2а также показано, что устройство успешно переключилось обратно на HRS с разверткой отрицательного напряжения от 0 до -1 В и снова на LRS с разверткой положительного напряжения от 0 до +1 В. Противоположная полярность, т. Е. Отрицательное напряжение гальванопластики, был также предоставлен для активации / инициирования режима переключения в той же ячейке памяти гетероструктуры. В связи с этим, когда к TE применялась развертка от 0 до -8 В, сопротивление устройства резко падало до -5,6 В, тем самым переводя его из выключенного состояния, называемого отрицательным гальваническим формованием (рис. 2b). После отрицательной гальванопластики устройство не смогло выполнить положительный СБРОС и отрицательный СБРОС из-за необратимой поломки. Следует отметить, что для инициирования характеристик RS требуются гораздо более высокие отрицательные напряжения гальванопластики, чем положительные напряжения гальванопластики. Однако после отрицательного гальванического формования гистерезиса переключения не наблюдалось, поскольку устройство оставалось во включенном состоянии независимо от приложения напряжений SET и RESET; этот факт указывает на образование постоянных токопроводящих нитей в процессе гальванопластики. Необратимый пробой при отрицательном гальванопластике может быть результатом разной высоты туннельного барьера, вызванного различием работы выхода верхнего и нижнего электрода [21]. Эти результаты показывают, что устройство с Ti / CeO 2-x Гетероструктура / ZnO / Pt может быть пригодна для энергонезависимых характеристик, только если она гальванически сформирована с положительной полярностью с последующими отрицательными и положительными полярностями соответствующих операций RESET и SET. Единственное отличие второго (Ti / ZnO / CeO 2 − x / Pt) и первый (Ti / CeO 2 − x / ZnO / Pt) - положение изолирующих слоев в многослойной гетероструктуре. Поэтому устройство с Ti / ZnO / CeO 2 − x Гетероструктура / Pt также может быть подвергнута гальванопластике как при положительной, так и при отрицательной полярностях потенциалов смещения, аналогично Ti / CeO 2 − x / ZnO / Pt-устройство гетероструктуры. На рисунке 2c показан типичный биполярный I-V кривые для такого положительного гальванопластика и последующего переключения. При развертке от 0 до +4 В устройство было подвергнуто гальванопластике, чтобы переключить его в состояние ВКЛ (резкое изменение сопротивления при + 3 В), как показано на рис. 2c. Затем устройство было включено при напряжении ниже + 2 В (положительный SET) и выключено при -1,5 В (отрицательный сброс) во время повторяемого цикла переключения. Точно так же устройство с той же гетероструктурой, гальванически сформированной отрицательно (при -3,5 В), показало положительный RESET (при + 1,5 В) и отрицательный SET (при -2,5 В), как видно из рис. 2d. Чтобы защитить оба устройства от необратимого выхода из строя, во время процессов гальванопластики и SET применялось соответствие по току 1 мА.
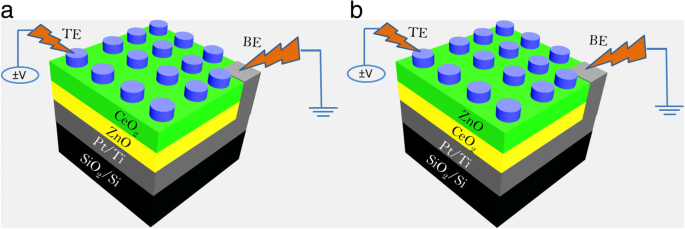
Схематическая конфигурация бислоя а Ti / CeO 2 / ZnO / Pt и b Ti / ZnO / CeO 2 / Устройства Pt
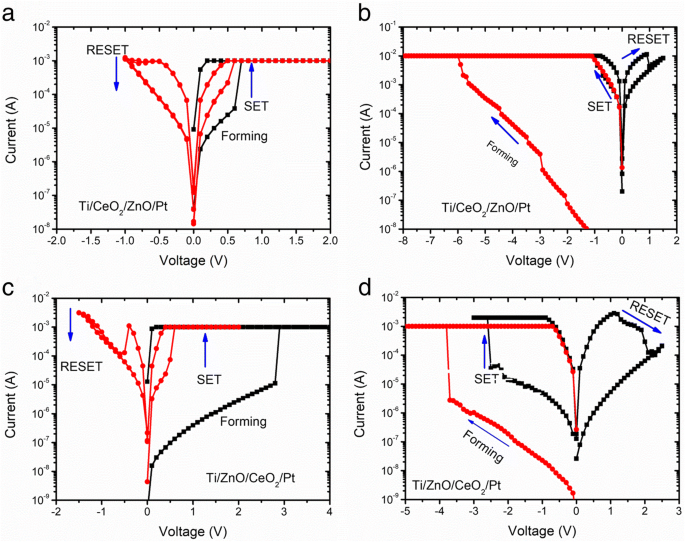
Устройства отображают типичное биполярное поведение. а Положительное (+ ve) формирование и последующая операция переключения и b отрицательная (−ve) операция формирования и переключения Ti / CeO 2 − x / ZnO / Pt-гетроструктуры. c + ve операции формирования и переключения и d −ve формирование и переключение Ti / ZnO / CeO 2 − x / Плата запоминающих устройств. Стрелки указывают направления переключения
Для проверки единообразия параметров переключения для обоих устройств памяти с гетероструктурой, накопленные вероятности рабочих напряжений (напряжения SET и RESET), отмеченные в различных циклах переключения, отображаются на рис. 3a, b. Ti / CeO 2 − x Устройство памяти с гетероструктурой / ZnO / Pt демонстрирует относительно более узкие вариации напряжений SET и RESET по сравнению с Ti / ZnO / CeO 2 − x / Платиновая гетероструктура запоминающего устройства. На рис. 3c, d показан статистический анализ средних напряжений SET, RESET и гальванопластики обоих устройств памяти с гетероструктурой. Ti / CeO 2 − x Установлено, что устройства / ZnO / Pt требуют гораздо более низких напряжений гальванопластики по сравнению с теми, которые необходимы для Ti / ZnO / CeO 2-x / Pt гетероструктурные запоминающие устройства, но напряжения SET и RESET демонстрируют лишь незначительные изменения. Меньшие колебания рабочего напряжения обоих устройств могут быть связаны с образованием и разрывом нитей, происходящих на интерфейсах. Лю и др. [22] предположили, что низкие напряжения SET / RESET и однородность переключения, отмеченные в WO x / NbO x Двухслойная структура может быть объяснена комбинированным эффектом миграции кислорода между двумя оксидными слоями и переходом металл-изолятор. Как свободная энергия Гиббса ΔG образования оксидов для ZnO и CeO x имеет огромную разницу около 706 кДж / моль (для CeO 2 , ΔG =- 1024 кДж / моль, а для ZnO - 318,52 кДж / моль) и возникает эффект локализованного нагрева, индуцируется обмен кислорода. Хорошо известно, что тонкий слой ZnO имеет много кислородных вакансий из-за низкой энергии образования [23]. Кроме того, многие исходные кислородные вакансии, присутствующие в слое ZnO, играют важную роль в проводимости через мелкие ловушки [24]. Кроме того, утверждается, что явление отсутствия образования в устройствах на основе ZnO можно объяснить высокой концентрацией кислородных вакансий, уже присутствующих в кристаллах ZnO [25]. Из всего вышеперечисленного можно сделать вывод, что в присутствии пленки ZnO, имеющей большое количество кислородных вакансий в обоих гетероструктурах (ZnO / CeO 2 − x и CeO 2 − x / ZnO) играет решающую роль в снижении рабочих напряжений. Кислородные вакансии в ZnO могут действовать как мелкие ловушки для электронов, а электроны в этих местах захвата могут быть легко захвачены или освобождены при малых значениях напряжений SET и RESET.

Кумулятивное распределение вероятностей рабочих напряжений от цикла к циклу в a Ti / CeO 2-x / ZnO / Pt и b Ti / ZnO / CeO 2-x Платиновые гетероструктурные устройства памяти. c Статистический анализ SET и RESET-напряжений Ti / CeO 2 − x / ZnO / Pt и Ti / ZnO / CeO 2-x Платиновые гетероструктурные устройства памяти. г Статистическая оценка напряжений гальванопластики для Ti / CeO 2-x / ZnO / Pt и Ti / ZnO / CeO 2-x / Платиновые гетероструктурные устройства памяти
Для исследования надежности гетероструктур обоих устройств были проведены испытания на долговечность при разной полярности потенциала смещения. Значения сопротивления HRS и LRS получены при 0,2 В из длительных коммутационных циклов постоянного тока. На рисунке 4а показаны характеристики выносливости Ti / CeO 2-x . / ZnO / Pt-устройство памяти на гетероструктуре. Видно, что положительно электроформованный Ti / CeO 2 Устройства памяти с гетероструктурой / ZnO / Pt показали хорошую выносливость с окном памяти ~ 10, что могло гарантировать четко различимые HRS и LRS. Формирование барьера Шоттки на Ti / CeO 2 − x возникает из-за разницы в работе выхода Ti TE и прилегающего слоя CeO 2 − x , что приводит к хорошим свойствам RS. Когда одно и то же устройство с гетероструктурой (Ti / CeO 2-x / ZnO / Pt) электроформовался отрицательно, устройство не могло быть изменено с LRS на HRS, как показано на рис. 4b. На рисунке 4c показаны характеристики выносливости электролитически формованных Ti / ZnO / CeO 2-x . Запоминающее устройство с гетероструктурой на платине с очень плохой стойкостью. Окно памяти кажется почти свернутым, поэтому состояния ВКЛ и ВЫКЛ практически неразличимы. Этот факт может быть объяснен неспособностью ZnO захватывать инжектированные носители из-за наличия высокой концентрации вакансий, что делает дорожку проводимости в направлении Ti TE, поскольку на границе Ti / ZnO не образуется барьер из-за незначительной разницы в работе выхода между Ti (4,33 эВ) и ZnO (4,35 эВ), что приводит к плохой стойкости [26]. Другой причиной может быть высокая плотность дефектов в ZnO / CeO 2 − x матрица создается в сильном электрическом поле, поскольку миграция кислородных вакансий значительно усиливается по протяженным дефектам. Кроме того, положительно заряженные кислородные вакансии, сегрегированные в местах дефектов, увеличивают поверхностную плотность состояний, что приводит к коллапсу отношения ВКЛ / ВЫКЛ. Это предполагает, что когда образуется блокирующий контакт Ti / ZnO, уровни Ферми выравниваются друг с другом из-за движения электронов от Ti к ZnO. В результате основная масса носителей собирается на поверхности оксидного слоя и барьер практически не образуется [26]. Рисунок 4d демонстрирует гораздо лучшие характеристики выносливости отрицательно сформированного Ti / ZnO / CeO 2-x . / Pt-устройство памяти на гетероструктуре по сравнению с положительно сформированным устройством. Zhu et al. [27] изготовили три различных типа устройств:(i) Ag / ZnO / NSTO / In, (ii) Ag / CeO 2 . / NSTO / In и (iii) Ag / CeO 2 / ZnO / NSTO / In. Двухслойное устройство (CeO 2-x / ZnO), по сравнению с однослойными, показали лучшее поведение RS с сохранением данных около 10 лет. Они связали лучшие КРС-характеристики двухслойных гетероструктур с интерфейсным барьером между CeO 2 − x / Двухслойная структура ZnO и наличие большого количества вакансий, действующих как центры захвата в пленках ZnO.
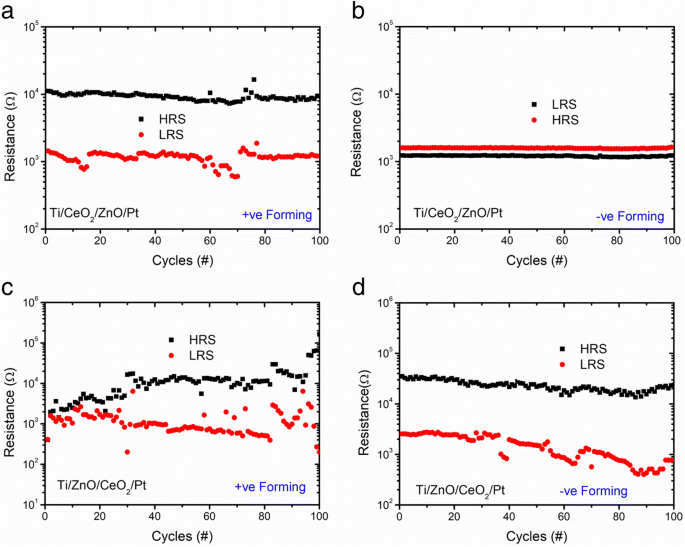
Прочностные характеристики а положительно гальванопластика и b отрицательно гальванопластика Ti / CeO 2 − x / ZnO / Pt-гетероструктурные устройства памяти. c Положительно гальванопластика и d отрицательно гальванопластика Ti / ZnO / CeO 2-x / Платиновые гетероструктурные устройства памяти
Удерживающая способность как CeO 2-x / ZnO и ZnO / CeO 2-x исследовались также двухслойные гетероструктуры. Время удерживания обоих гетероструктур было измерено при комнатной температуре с напряжением считывания 0,2 В, как видно из рис. 5a, b. Никакой электроэнергии не требовалось для поддержания постоянного сопротивления в любом заданном состоянии. До времени удерживания 10 4 s, сопротивления HRS и LRS не обнаруживают никаких признаков износа, что означает, что информация, хранящаяся в обоих гетероструктурных устройствах, может храниться гораздо дольше, чем 10 4 с.

Характеристики удержания a положительно гальванопластика Ti / CeO 2 − x / ZnO / Pt гетероструктурные устройства памяти и b отрицательно гальванопластика Ti / ZnO / CeO 2-x / Платиновые гетероструктурные запоминающие устройства при комнатной температуре
Чтобы исследовать механизм проводимости, преобладающий в области сильного поля обоих устройств памяти гетероструктуры, процедура аппроксимации кривой была выполнена при положительном (для CeO 2 − x / ZnO) и отрицательный (для ZnO / CeO 2 − x ) полярности смещающего потенциала. На рис. 6a, b показано, что аппроксимация линейной кривой экспериментальных данных хорошо согласуется с характеристиками излучения Шоттки для обоих устройств с гетероструктурой при их соответствующих полярностях смещения. Известно, что эмиссия Шоттки имеет место, когда электрод вводит термически активированные электроны через барьер в зону проводимости изолятора, поэтому это называется электродно-ограниченным механизмом. Обычно эмиссия Шоттки возникает, когда контакт электрода сильно инжектируется носителями. Линейная зависимость ln ( I ) против √ V указывает на то, что электроны набрали достаточное количество энергии для преодоления энергетического барьера. Омическая проводимость (ток пропорционален приложенному напряжению), возникающая в области слабого поля, показывает, что ток течет из-за термически генерируемых электронов (результаты здесь не показаны). Модель излучения Шоттки обычно описывается уравнением вида [28]:\ (\ ln (J) =\ ln {A} ^ {\ ast} {T} ^ 2-q \ left ({\ varPhi} _b- \ sqrt {\ frac {qV} {4 \ pi {\ varepsilon} _o {\ varepsilon} _rd}} \ \ right) / {k} _BT \), где J - плотность тока, А * - постоянная Ричардсона, T это температура, q электрический заряд, В - эклектическое напряжение, ε r диэлектрическая проницаемость, ε о диэлектрическая проницаемость свободного пространства, d - толщина пленки, а k B - постоянная Больцмана. Кроме того, зависящие от температуры значения сопротивления LRS и HRS были измерены при напряжении 0,2 В в диапазоне температур 200–300 K для обоих CeO 2 − x / ZnO и ZnO / CeO 2-x гетероструктурные запоминающие устройства, показанные на рис. 6в, г. Можно заметить, что электротранспортные свойства обоих устройств с гетероструктурой в низкоомном состоянии являются металлическими по своей природе, то есть сопротивление в LRS увеличивается с увеличением температуры. В отличие от этого, электрические транспортные свойства для обоих устройств в HRS являются полупроводниковыми по своей природе, то есть сопротивление в HRS уменьшается с повышением температуры. Значения энергии активации ( E а ) полученные из графиков Аррениуса ЛРП обоих устройств гетероструктуры (результаты не показаны) составляют ~ 0,092 эВ и сравнимы с энергией первой ионизации кислородных вакансий (~ 0,1 эВ) [25, 26, 29], что указывает на то, что первая ионизация кислородных вакансий отвечает за проводимость в HRS, что еще раз подтверждает преобладание излучения Шоттки как действующего механизма проводимости в HRS. Металлическое поведение в LRS и полупроводниковое поведение в HRS обоих гетероструктурных устройств является достаточным доказательством в поддержку поведения переключения в Ti / CeO 2 − x / ZnO / Pt и Ti // ZnO / CeO 2 − x / Платиновая гетероструктура запоминающих устройств, что она может быть связана с проводящим нитевидным механизмом на основе кислородных вакансий.
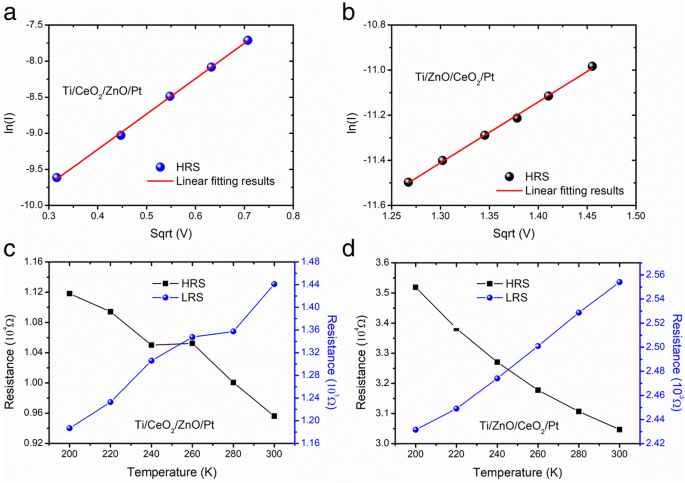
log I-V 1/2 характеристики в HRS SET-состояния. а Для Ti / CeO 2 − x / ZnO / Pt. б Для Ti / ZnO / CeO 2 − x Платиновые гетероструктурные устройства памяти. Температурная зависимость LRS и HRS от c Ti / CeO 2-x / ZnO / Pt и d Ti // ZnO / CeO 2 − x / Платиновые гетероструктурные устройства памяти
На рисунке 7 показана предложенная диаграмма энергетических зон CeO 2 . и полупроводниковые материалы ZnO n-n-типа в установившемся состоянии. Разница между работой выхода ZnO (4,35 эВ) и CeO 2 (3,33 эВ) равно 1,02 эВ для того же электронного перехода на кислородной вакансии [30]. Нижняя работа выхода CeO 2 (3,33 эВ), чем у ZnO (4,35 эВ), обеспечивает движение электронов из CeO 2 в ZnO, что приводит к их более высокой концентрации в матрице.
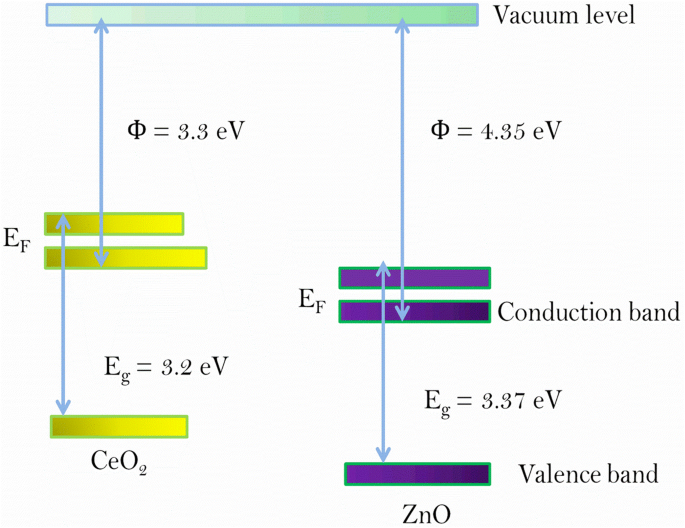
Зонная диаграмма CeO 2 и полупроводниковые материалы ZnO n-типа
Согласно нашему предыдущему исследованию [31], характеристики КРС однослойного Ti / CeO 2 − x / Pt были связаны с образованием межфазного слоя TiO, который играет ключевую роль в создании и разрыве проводящих нитевидных путей. Warule et al. предположили, что поведение RS в устройствах Ti / ZnO / Pt было вызвано созданием и отключением проводящих нитей на основе кислородных вакансий [32]. Кроме того, явление отсутствия формовки в устройствах Ti / ZnO / Pt связано с существованием значительного количества кислородных вакансий в готовых устройствах Ti / ZnO / Pt [32,33,34]. Барьер Шоттки на границе раздела ZnO / Pt может быть устранен наличием достаточного количества кислородных вакансий в пленке ZnO, что приводит к омическому контакту на границе раздела ZnO / Pt. Соответственно, образование межфазного слоя TiO может быть связано с эффектом RS в двухслойном ZnO / CeO 2 − x . и CeO 2 − x / ZnO-гетероструктуры. Хорошо известно, что Ti - металл с высокой реакционной способностью по отношению к атмосферному кислороду:поэтому он может легко образовывать слой TiO на границе раздела Ti / оксид [35]. В Ti / ZnO / CeO 2 − x Устройство памяти / Pt-гетероструктуры, ZnO является полупроводником n-типа и содержит много кислородных вакансий, поэтому на границе раздела Ti / ZnO образуется омический контакт [36]. Поскольку Ti и ZnO имеют примерно одинаковые функции выхода, Ti не может извлекать ионы кислорода из ZnO для создания межфазного слоя TiO. Сообщалось, что в пленках ZnO существуют нерешеточные ионы кислорода и атомы кислорода, связанные с дефектами решетки [37]. Из-за осаждения церия (CeO 2 ) путем высокочастотного распыления при комнатной температуре изготовили CeO 2 пленки имеют поликристаллический характер. Таким образом, пленки церия могут быть нестехиометрическими, как мы уже доказали в нашей предыдущей исследовательской работе, что оксид церия восстанавливается до CeO 2 − x [12]. Hu et al. [17] также сообщили о таком сокращении CeO 2 при осаждении на CeO 2 − x . Дефекты в CeO 2 − x пленки недостаточны для мобилизации ионов кислорода. Следовательно, CeO 2 − x слой служит резервуаром кислорода в Ti / ZnO / CeO 2 − x / Платиновая гетероструктура. Энергия Гибба для образования CeO 2 намного меньше (- 1024 кДж / моль), чем у ZnO (- 318,52 кДж / моль), как описано ранее, поэтому в ZnO существуют нерешетчатые атомы кислорода из-за его нестехиометрической природы, которые движутся в сторону CeO 2 слой даже при отсутствии внешнего смещения [37]. Следовательно, когда Ti TE наносится на ZnO, не ожидается образования межфазного слоя между Ti и ZnO, хотя энергия Гиббса образования TiO меньше, чем у ZnO. Когда на TE подается положительное напряжение, ионы кислорода притягиваются к CeO 2 − x Интерфейс / Pt и проводящие нити образуются из кислородных вакансий из-за их дрейфа и способности строить линии.
С другой стороны, в Ti / CeO 2 − x / ZnO / Pt гетероструктурные запоминающие устройства, очень тонкий межфазный слой TiO формируется на Ti / CeO 2-x интерфейс, как очевидно из изображения HRTEM (рис. 1c) и как было предложено нашим предыдущим исследованием [37]. Энергия Гиббса образования TiO (- 944 кДж / моль) относительно больше, чем у CeO 2-x (- 1024 кДж / моль); следовательно, хотя Ti из-за своего высокого сродства к кислороду захватывает ионы кислорода из CeO 2-x для образования межфазного слоя TiO часть ионов кислорода возвращается обратно в CeO 2 − x слой при отсутствии / наличии внешнего отрицательного поля [38]. Энергия Гиббса образования оксидов для TiO и ZnO составляет - 944 кДж / моль и - 318,52 кДж / моль соответственно. Соответственно, можно получить энергию Гиббса образования оксида для (1/2) CeO 2 =- 512 кДж / моль. По сравнению с ZnO сродство Ce к кислороду немного выше, чем у Zn, поэтому ионы кислорода диффундируют от ZnO к CeO 2-x слой, а затем в слой TiO, откуда эти ионы могут мигрировать в ТЕ, оставляя кислородные вакансии в оксидных слоях. Следовательно, все ионы кислорода собираются на верхней границе раздела, и между электродами образуются проводящие нити с кислородными вакансиями. При наличии противоположной полярности смещения ионы кислорода отправляются обратно в оксидные слои, что приводит к заполнению кислородных вакансий, что приводит к разрыву нити.
Работа выхода верхнего Ti и нижнего Pt электродов составляет 4,33 и 5,65 эВ соответственно [39]. Сродство к электрону и работа выхода ZnO (3,37 эВ и 4,35 эВ) выше, чем у CeO 2 (3,50 и 3,2 эВ) [40]. Таким образом, энергетический барьер на ZnO / CeO 2 − x интерфейс ожидается, как барьер Шоттки. В режиме положительного напряжения электроны не могут быть легко инжектированы через дефекты в CeO 2 нижним электродом из Pt в слой ZnO, поскольку работа выхода ZnO выше, чем у CeO 2 . Вот почему электроны менее способны дрейфовать от ZnO к верхнему электроду из Ti, поскольку Ti не может притягивать ионы кислорода из ZnO из-за их аналогичных рабочих функций. Высота барьера наверху Ti / ZnO и CeO 2 − x / Pt нижние границы раздела составляют соответственно 0,05 эВ и 2,45 эВ, высота барьера при CeO 2 Нижняя граница раздела / Pt выше, поэтому электроны не могут легко переходить от металла к диэлектрику, что приводит к образованию барьера Шоттки на нижней границе раздела [41].
Однако высота барьера верхней границы раздела Ti / ZnO пренебрежимо мала из-за аналогичных функций выхода, но она намного выше у нижней границы раздела CeO 2 − x / Pt, поэтому полярность смещающего поля недостаточна для уравновешивания высоты барьеров двух интерфейсов; следовательно, долговечность и характеристики переключения Ti / ZnO / CeO 2-x Гетероструктура / Pt не так хороша при положительной полярности приложенного смещения. Когда на верхний электрод из Ti подается развертка отрицательного напряжения, инжекция электронов из Ti TE не может управлять барьером на границе раздела Ti / ZnO, поскольку барьер Шоттки не образуется на верхней границе раздела Ti / ZnO в Ti / ZnO / CeO 2-х Гетероструктура / Pt, показанная на рис. 8а, б.
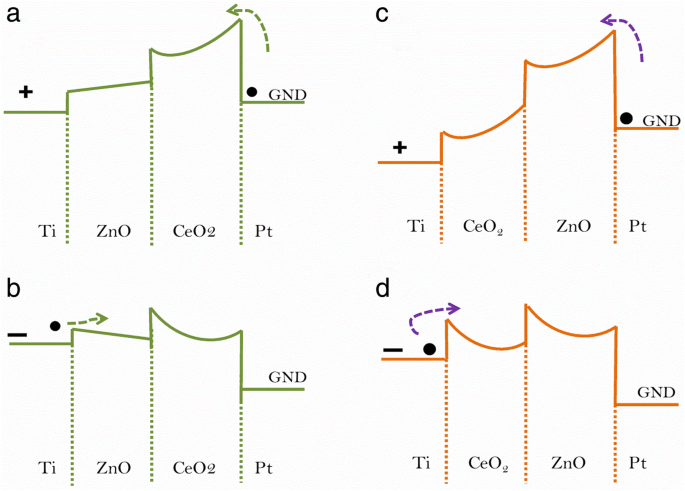
Принципиальные схемы смещения зоны проводимости a , b Ti / ZnO / CeO 2-x / Pt и c , d Ti / CeO 2-x / ZnO / Pt-гетероструктурные устройства памяти. Стрелки показывают направление дрейфа электронов в соответствии с полярностями переключения
С другой стороны, в области положительного напряжения электроны могут легко инжектироваться через дефекты в ZnO от Pt электрода к CeO 2 − x слой. Эти электроны затем уходят с CeO 2 − x слой к верхнему электроду Ti. Высота барьера верхнего слоя Ti / CeO 2 − x (1,13 эВ) и нижняя граница раздела ZnO / Pt (2,28 эВ) предполагают эмиссию Шоттки, как показано на рис. 8c, d. Когда отрицательное напряжение передается на верхний электрод из Ti, инжекция электронов с верхнего электрода контролируется этим барьером Шоттки на уровне Ti / CeO 2-x интерфейс, потому что явления захвата и освобождения от захвата могут легко возникнуть на нижнем барьере (1,13 эВ). Ионы кислорода могут мигрировать в Ti / CeO 2-x интерфейс путем подачи положительного напряжения. Механизм RS в Ti / CeO 2 − x Устройство памяти гетероструктуры / ZnO / Pt можно объяснить созданием и растворением проводящих нитей с кислородными вакансиями в оксидных слоях [41]. Это означает, что ионы кислорода могут перемещаться вперед и назад между Ti / CeO 2-x интерфейсных и оксидных слоев двумя противоположными полярностями внешнего смещения. Когда на Ti-электрод подается положительное напряжение, ионы кислорода уносятся от CeO 2-x / ZnO в Ti / CeO 2-x интерфейс. В оксидном слое образуются проводящие нити с кислородными вакансиями, и, следовательно, состояние сопротивления переключается с выключенного (HRS) на включенное состояние (LRS). Когда на Ti TE подается отрицательное напряжение, начинается процесс снятия ловушек и ионы кислорода собираются на Ti / CeO 2-x интерфейсы перемещаются обратно к нижнему электроду. Проводящие нити разрываются из-за миграции ионов кислорода. Таким образом, устройство снова переключается на HRS. Основываясь на текущих результатах, мы исследовали влияние гетероструктуры устройства, такой как CeO 2 − x / ZnO и ZnO / CeO 2-x и полярность гальванопластики при параметрах резистивного переключения для возможных применений в устройствах резистивной памяти с произвольным доступом. Мы заметили, что обе структуры устройства и их полярность гальванопластики оказывают значительное влияние на параметры переключения, такие как напряжение гальванопластики, окно памяти и однородность напряжений SET / RESET. Однако в будущих исследованиях требуется больше внимания для достижения более быстрого программирования / стирания, более высокой масштабируемости, устройств без гальванопластики и устройств с низким литьем. В частности, требуется работа по выбору подходящего материала электрода с использованием нанокристаллов или ионов металлов, встроенных в изолирующий слой, и изготовления устройства на структурах с буферным слоем.
Выводы
В заключение, были проведены глубокие исследования поведения RS путем изменения морфологии двухслойного ZnO / CeO 2 − x и CeO 2 − x Гетероструктуры ZnO и знак полярностей гальванопластики. Отмечено значительное влияние на производительность, характеристики износостойкости, напряжения гальванопластики и единообразие рабочих напряжений. Экспериментальные результаты показывают образование межфазного слоя TiO в Ti / CeO 2-x . Гетероструктура / ZnO / Pt при приложении смещения положительной полярности и CeO 2 − x слой во время отрицательной полярности служит резервуаром кислорода в Ti / ZnO / CeO 2 − x / Платиновые гетероструктуры. В совокупности это может сыграть важную роль в улучшении однородности и повторяемости параметров RS. Доминирующим механизмом проводимости в HRS была ограниченная электродом эмиссия Шоттки в области сильного поля. Температурная зависимость сопротивлений LRS и HRS позволяет сделать вывод, что наблюдаемый механизм RS основан на движении кислородных вакансий под действием приложенного напряжения.
Сокращения
- BRS:
-
Биполярное резистивное переключение
- DC:
-
Постоянный ток
- HRS:
-
Состояние высокого сопротивления
- HRTEM:
-
Просвечивающая электронная микроскопия высокого разрешения
- LRS:
-
Состояние низкого сопротивления
- MOM:
-
Металл-оксид-металл
- RRAM:
-
Резистивная оперативная память
- RS:
-
Резистивное переключение
- TE:
-
Верхний электрод
- URS:
-
Униполярное резистивное переключение
Наноматериалы
- Влияние контактной неравновесной плазмы на структурные и магнитные свойства шпинелей Mn Х Fe3 - X О4
- Парамагнитные свойства фуллереновых наноматериалов и их полимерных композитов:эффект резкого откачивания
- Гидротермальный синтез наночастиц In2O3, гибридные двойники, гексагональные дисковые гетероструктуры ZnO для по…
- Влияние толщины бислоя на морфологические, оптические и электрические свойства наноламинатов Al2O3 / ZnO
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Настройка уровня Ферми пленок ZnO посредством суперциклического осаждения атомного слоя
- Синтез нанокристаллов ZnO и применение в инвертированных полимерных солнечных элементах
- Синергетическое влияние графена и MWCNT на микроструктуру и механические свойства нанокомпозитов Cu / Ti3SiC2 / C
- Изготовление и характеристика ZnO Nano-Clips с помощью процесса, опосредованного полиолом
- Оптические свойства пленок ZnO, легированных алюминием, в инфракрасной области и их применения для поглощения



