Устранение бимодального размера в квантовых точках InAs / GaAs для изготовления лазеров на квантовых точках 1,3 мкм
Аннотация
Характеристики полупроводниковых лазеров на квантовых точках улучшились с развитием структур активного слоя. Самосборка сформированных квантовых точек InAs, выращенных на GaAs, активно продвигалась с целью создания лазеров на квантовых точках с превосходными характеристиками устройства. В процессе выращивания квантовых точек InAs / GaAs с высокой плотностью возникает бимодальный размер из-за большого рассогласования и других факторов. Бимодальный размер в системе квантовых точек InAs / GaAs устранен методом высокотемпературного отжига и оптимизирована температура отжига in situ. Температура отжига принята в качестве ключевых параметров оптимизации, и была получена оптимальная температура отжига 680 ° C. В этом процессе температура роста квантовых точек, осаждение InAs и давление мышьяка (As) оптимизируются для улучшения качества квантовых точек и длины волны излучения. Высокопроизводительный лазер на квантовых точках F-P с толщиной 1,3 мкм и пороговой плотностью тока 110 А / см 2 был продемонстрирован.
Введение
Десять лет назад был разработан лазер с квантовыми точками (КТ) 1,3 мкм; однако с тех пор и до сих пор не было заметного развития или прогресса в области роста квантовых точек. Лазер на квантовых точках 1,3 мкм снова стал горячей темой для изучения. Он стал одним из сильных конкурентов источника света для высокоскоростной оптической связи в локальной сети (LAN). Высокая плотность квантовых точек является важным фактором, приводящим к низкому энергопотреблению, высокотемпературной стабильности и высокой скорости. Как хорошо известно, лазер на квантовых точках InAs / GaAs 1,3 мкм должен показать отличные характеристики при пороговом токе, температурной стабильности и модуляционных характеристиках благодаря трехмерным квантовым ограничениям [1]. За последние 10 лет огромное количество лабораторий во всем мире достигли своей цели - значительно улучшить характеристики лазеров с квантовыми точками [2,3,4,5]. Однако бимодальный размер в системе квантовых точек InAs / GaAs все еще существует [6,7]. Качество квантовых точек можно повысить, если устранить бимодальный размер.
Гетероструктурам InAs / GaAs, выращенным методом молекулярно-лучевой эпитаксии (МБЭ), уделялось много внимания для создания низкоразмерных наноструктур, таких как самоорганизующиеся КТ из-за большого несоответствия решеток (~ 7%) между слоями InAs и подложкой GaAs [8] . Рост InAs на подложке GaAs (001) приводит к формированию трехмерной (3D) формы островка на InAs с режимом роста Странского-Крастанова (SK). Ожидается, что метод роста SK станет удобным методом изготовления когерентных квантовых точек с высокой плотностью и все еще остается открытой проблемой [9,10]. Однако у КТ SK есть некоторые проблемы, такие как большое неоднородное уширение энергетических уровней КТ и проблема бимодальных размеров [11,12,13,14,15]. Для выращивания квантовых точек высокой плотности методом МПЭ обычным способом является увеличение скорости осаждения InAs и снижение температуры роста. Цель этого подхода - снизить скорость миграции, которая может ускорить формирование острова. Однако низкотемпературный рост может снизить качество решетки эпитаксиального материала. С другой стороны, быстрый рост может увеличить плотность квантовых точек, но он также создает больше дислокаций. Соответственно, интенсивность фотолюминесценции квантовых точек InAs стала слабой, когда мы достигли высокой плотности квантовых точек InAs с помощью обычного подхода.
В этом письме однослойный высокотемпературный отжиг позволяет эффективно устранить дефекты материала крышки и изменить направление роста дислокаций. Размер и форма квантовых точек InAs SK демонстрируют высокую степень однородности за счет однослойного отжига, выращенного на подложках GaAs (001). Увеличилось осаждение InAs, что улучшило насыщение каждой КТ одновременно. Спектры ФЛ однородных квантовых точек InAs показали узкую ширину линии менее 26 мэВ. Изготовлены лазеры на КТ InAs / GaAs толщиной 1,3 мкм, которые обладают пороговым током генерации I th 220 мА и пороговая плотность тока 110 А / см 2 .
Оптимизация материалов
В данном исследовании структура квантовых точек выращена на подложках GaAs (001) (N +) в системе Veeco Gen 930 MBE. Температура отжига была исследована, и температуры отжига для этих четырех образцов (N170813, N170824A-N17084C) составляют 630, 680, 730 и 780 ° C соответственно. Параметры роста квантовых точек этих четырех образцов абсолютно одинаковы (таблица 1).
Измерения фотолюминесценции (ФЛ) проводились для четырех образцов. С повышением температуры отжига наибольшая интенсивность ФЛ была достигнута при температуре отжига 680 ° C (как показано на рис. 1). Это связано с тем, что мышьяк (As) и Ga десорбируются при повышении температуры отжига. В результате этого процесса может появиться больше дефектов, а решетка квантовых точек InAs изменилась при высокой температуре.
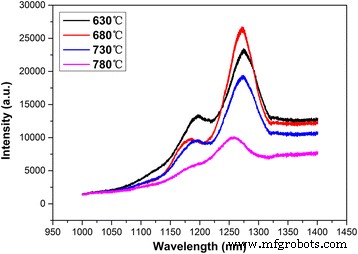
Сравнение спектров фотолюминесценции (ФЛ) эпитаксиальных пластин при разной температуре отжига
Активная область лазера на квантовых точках оптимизирована при низком давлении мышьяка 4 × 10 - 7 Торр [16] и низкая скорость роста 0,025 ML / s. После отжига мы обнаружили, что длина волны была меньше 1300 нм; поэтому мы оптимизировали условия выращивания. InAs толщиной 2,5 монослоя (МС) выращивали при 520 ° C и закрывали слоем In 0,15 толщиной 5 нм. Ga 0,85 Как деформационный слой при той же температуре. За этим слоем следовал слой GaAs толщиной 15 нм, который осаждали при более низкой температуре (LT) 520 ° C. Затем мы вырастили последний слой GaAs толщиной 20 нм при более высокой температуре (HT) 630 ° C (как показано на рис. 2а).
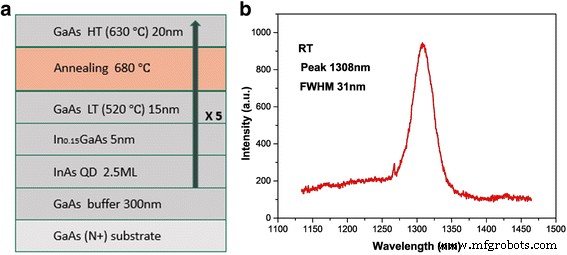
Структура активной области и спектр ФЛ. а Структура активной области нелегированного лазера на КТ. б Спектр ФЛ активной области лазера на КТ при комнатной температуре (КТ). Пик излучения составляет 1305 нм, а ширина на полувысоте около 31 нм
Для исследуемого образца были измерены спектр ФЛ и изображения поверхности КТ с помощью атомно-силовой микроскопии (АСМ). Пик излучения 1308 нм обусловлен переходом в основное состояние, а полная ширина полувысоты (FWHM) пика составляет около 31 нм (как показано на рис. 2b). Мы вырастили слой голых квантовых точек на скрытом слое из пяти слоев тестового образца для проведения АСМ-измерения. Условия выращивания точно такие же, как для скрытых квантовых точек, описанных ранее. АСМ-изображение поверхности КТ показывает, что плотность КТ отожженного образца составляет около 3,2 × 10 10 см - 2 (как показано на рис. 3а). Квантовая точка имеет среднюю высоту 8 нм. Напротив, размер и распределение неотожженных образцов квантовых точек неоднородны. Виден бимодальный размер, а плотность КТ составляет около 2,9 × 10 10 . см - 2 . Квантовая точка имеет высоту 5–7 нм (как показано на рис. 3b).
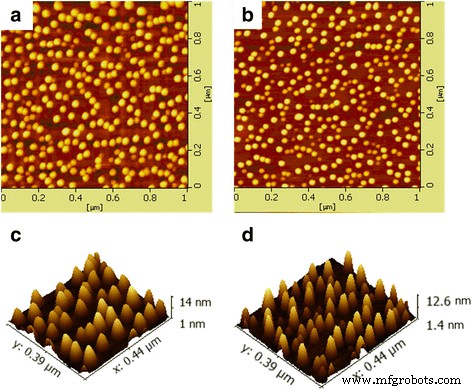
АСМ-изображения квантовых точек InAs / GaAs. а Однослойный высокотемпературный отжиг. б Без отжига. c Трехмерное изображение распределения малых площадей по размерам при высокотемпературном отжиге. г Трехмерное изображение распределения малых площадей без отжига
Во время эпитаксиального роста лазера с квантовыми точками 1,3 мкм бимодальный размер квантовых точек InAs может быть хорошо устранен за счет однослойного отжига для активной области лазера. По сравнению с образцом, выращенным без отжига (как показано на рис. 3c), образец, выращенный с температурой отжига 680 ° C (как показано на рис. 3d) имеет более высокую плотность квантовых точек и одинаковый размер квантовых точек. Это можно объяснить следующими причинами. Сначала покровный слой GaAs растет сразу после роста квантовых точек InAs, поэтому он может расти только при низкой температуре, что снижает качество решетки GaAs и приводит к появлению дефектов. Высокотемпературный отжиг может устранить дефекты и вырастить высококачественный верхний слой GaAs, используемый для продолжения роста квантовых точек InAs. Кроме того, дислокации генерируются во время гетероэпитаксии InAs / GaAs, однослойный отжиг in situ может устранить дислокации или изменить направление роста дислокаций, а затем улучшить качество квантовых точек InAs.
Разработка и подготовка устройства
Структура лазера состояла из слоя GaAs, залитого пятью слоями самоорганизующихся слоев сердцевины квантовых точек InAs. Слой n-волновода с длиной волны 200 нм и слой p-волновода выращивали сверху и снизу структуры КТ. Активная область квантовых точек и волноводный слой были зажаты двумя слоями алюминия 1,8 мкм p-типа (Be:4E18) и n-типа (Si:2E18) 0,45 Ga 0,55 Как слои. Для электрического контакта был нанесен слой p + GaAs (Be:3E19) толщиной 200 нм (как показано на рис. 4а).
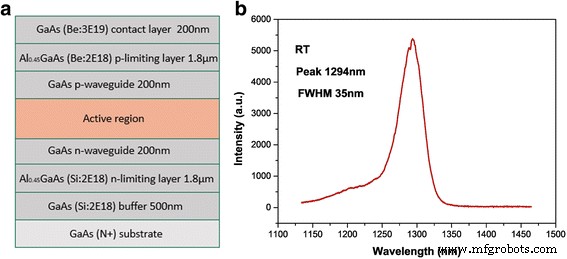
Структура устройства. а Эпитаксиальная структура широкополосного лазера F-P с квантовыми точками 1,3 мкм. б Спектр ФЛ эпитаксиальной структуры лазера на КТ при КТ. Центральная длина волны 1294 нм
Небольшая часть пластины протравливается химическим травлением для утончения верхнего слоя оболочки с помощью H 3 . ЗП 4 -H 2 О 2 -H 2 O (1:1:4) после завершения лазерной эпитаксиальной структуры [17, 18]. Видно, что спектр ФЛ этого образца имеет центральную длину волны 1294 нм (как показано на рис. 4b). Смещение центральной длины волны в синий цвет по сравнению с вышеупомянутым тестовым образцом (как показано на рис. 2а) связано с высокотемпературным ростом (650 ° C) во время стадии роста верхней оболочки со временем роста более 2 ч. . Он также может быть из индийского (In) компонента In 0,15 Порода покрывающего слоя GaAs дрейфует.
Пластина лазера с квантовыми точками InAs / GaAs была покрыта фоторезистом для определения структуры поверхности. Первое издание фотолитографии формирует гребневой узор размером 100 мкм. Гребневый волновод был изготовлен путем травления с индуктивно связанной плазмой (ICP) с глубиной травления 2 мкм с последующим плазменным химическим осаждением из паровой фазы (PECVD) с целью образования SiO 2 изоляция. На следующем этапе на выступе было сделано контактное окно шириной 90 мкм для ввода тока. Затем Ti / Pt / Au 51 нм / 94,7 нм / 1122 нм был нанесен в качестве электрода p-типа с помощью магнетронного распыления (как показано на рис. 5). Пластина была утончена до 120 мкм, и AuGeNi толщиной 50 нм (сплав 80:10:10 мас.%) Со слоем Au толщиной 300 нм был нанесен на заднюю часть пластины с использованием термического напыления для электрода n-типа. [19, 20]. Весь образец отжигался при 460 ° C в течение 10 с для образования омического контакта. В течение всего процесса изготовления образец последовательно очищали ацетоном и изопропиловым спиртом и промывали деионизированной водой.
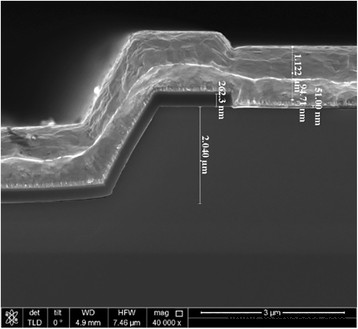
СЭМ-изображение поперечного сечения лазера. Широкоугольный лазер F-P со стандартным лазерным производством. Глубина травления GaAs / AlGaAs составляет около 2 мкм. PECVD сформировал SiO 2 составляет 260 нм
Электрические и оптические свойства устройства были измерены после завершения работы лазера. Мощность-ток-напряжение ( P - I − V ) характеристики широкополосных лазеров были испытаны в непрерывном режиме (CW) при КТ. Пороговая плотность тока лазера составляет 110 А / см 2 . (как показано на рис. 6a), а центральная длина волны спектра генерации составляет 1,3 мкм (как показано на рис. 6b). Из спектра генерации видно, что центральная длина волны лазера при комнатной температуре смещается в красную область из-за теплового эффекта работы лазера. В этом исследовании лазер может непрерывно генерировать генерацию при комнатной температуре и достигать хорошей пороговой плотности тока, а также хорошей выходной мощности без фацетного покрытия и удаления легирования в активной области, что свидетельствует о высоком качестве кристалла лазера. Метод однослойного отжига оказывает определенное влияние на систему квантовых точек бимодального размера. На основе этого будут проводиться дальнейшие исследования более глубокого уровня для дальнейшего улучшения плотности квантовых точек с целью достижения более низкого порогового тока, более низкого энергопотребления, более высокой выходной мощности и высокой характеристической температуры.
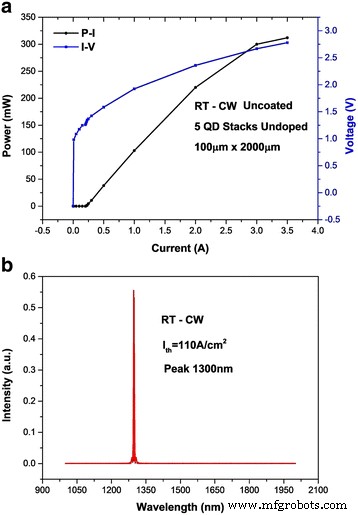
Измерения устройства. а ВАХ лазера на КТ. б Длина волны генерации 1,3 мкм
Выводы
Исследована серия оптимизаций параметров роста квантовых точек высокой плотности. Метод однослойного отжига был использован для успешного подавления образования бимодальной системы квантовых точек. Мы детально исследовали температуру отжига и положение отжигового слоя. Были получены оптимизированная температура отжига 680 ° C и расстояние от слоя квантовых точек 20 нм. Пороговая плотность тока 110 А / см 2 . было достигнуто для F-P-лазера на InAs / GaAs QD 1,3 мкм при комнатной температуре и в непрерывном режиме с длиной волны генерации 1,3 мкм.
Сокращения
- AFM:
-
Атомно-силовой микроскоп
- Отжиг T:
-
Температура отжига
- CW:
-
Непрерывная волна
- F-P:
-
Фабри – Перо
- FWHM:
-
Полная ширина на половине максимальной
- Рост T:
-
Температура роста
- HT:
-
Высокая температура
- LT:
-
Низкая температура
- MBE:
-
Молекулярно-лучевая эпитаксия
- PL:
-
Фотолюминесценция
- QD:
-
Квантовая точка
- RT:
-
Комнатная температура
- SEM:
-
Сканирующий электронный микроскоп
- WPE:
-
Эффективность розетки
Наноматериалы
- N, N-диметилформамид, регулирующий флуоресценцию квантовых точек MXene для чувствительного определения Fe3 +
- Композиты с квантовыми точками на S, N-графене / TiO2 для эффективного фотокаталитического производства водород…
- Яркий однофотонный источник на 1,3 мкм на основе двухслойной квантовой точки InAs в Micropillar
- Обнаружение пространственно локализованного экситона в самоорганизованных сверхрешетках из квантовых точе…
- Квантовые точки висмута в отожженных квантовых ямах GaAsBi / AlAs
- Биполярные эффекты в фотоэдс метаморфных квантовых точечных гетероструктур InAs / InGaAs / GaAs:характеристика и кон…
- Зеленый синтез квантовых точек InP / ZnS Core / Shell для применения в светоизлучающих диодах, не содержащих тяжелых м…
- Простой подход к синтезу флуоресцентных квантовых точек углерода из сточных вод тофу
- Получение наноразмерного CL-20 / оксида графена в один этап с помощью шаровой мельницы для значительного уменьш…
- Межзонная фотопроводимость метаморфных квантовых точек InAs / InGaAs в окне 1,3–1,55 мкм



