Настройка уровня Ферми пленок ZnO посредством суперциклического осаждения атомного слоя
Аннотация
Новый процесс суперциклического осаждения атомных слоев (ALD), сочетающий термический процесс ALD с O 2 in situ. В данной работе представлена плазменная обработка для нанесения тонких пленок ZnO с регулируемыми электрическими свойствами. Оба O 2 Время плазмы и количество термических циклов ALD в суперцикле можно отрегулировать для достижения точной настройки удельного сопротивления пленки и концентрации носителей до шести порядков без примесного легирования. Считается, что концентрация водородных дефектов играет важную роль в регулировании электрических свойств пленок ZnO. Результаты зондовой силовой микроскопии Кельвина явно показывают сдвиг уровня Ферми в различных пленках ZnO и хорошо связаны с изменением концентрации носителей заряда. Этот надежный и надежный метод, описанный здесь, ясно указывает на возможность использования этого метода для производства пленок ZnO с контролируемыми свойствами в различных областях применения.
Фон
Когда-то определено как будущий материал оксид цинка (ZnO) уже более полувека привлекает внимание научного сообщества благодаря своим превосходным оптическим и электрическим свойствам [1]. В последнее время стремительный рост производства прозрачных проводящих оксидов вновь возродил их применение в качестве прозрачных электродов в плоских дисплеях, сенсорных экранах, покрытиях с низким коэффициентом излучения, тонкопленочных солнечных элементах и т. Д. [2, 3]. Кроме того, ZnO нашел многочисленные применения в электронных устройствах, включая светодиоды, фотодетекторы и силовые устройства [4, 5]. Эти различные типы приложений требуют, чтобы пленки ZnO имели различные электрические параметры, а для некоторых приложений даже требуются многослойные пленки ZnO с различными электрическими свойствами [6]. Например, были предприняты многочисленные попытки разработать прозрачную резистивную оперативную память (TRRAM) для реализации полностью интегрированной прозрачной электроники [7, 8]. В качестве одного из наиболее многообещающих кандидатов, TRRAM на основе ZnO использует высокоомную пленку ZnO в качестве активного переключающего слоя, в то время как пленки ZnO с высокой проводимостью идеально подходят для работы в качестве прозрачных электродов [8,9,10]. Таким образом, ключевым требованием является возможность управления электрическими свойствами, такими как удельное сопротивление и концентрация носителей заряда в пленках ZnO. Легирование обычно используется, когда требуется изменение свойств, и для изменения свойств пленки ZnO применялись различные легирующие добавки [11,12,13]. Однако легирование всегда сложно и может привести к образованию вторичной фазы [14]. Поэтому модуляция электрических свойств нелегированного ZnO с помощью одного процесса осаждения может быть выгодной.
Осаждение атомных слоев (ALD) стало популярным методом для получения высококачественного ZnO с отличным контролем толщины пленки вплоть до нанометрового масштаба и однородностью на большой подложке [15, 16]. Температура роста ZnO обычно ниже 200 ° C, что делает его совместимым с рядом подложек, включая стекло и пластик. ALD ZnO обычно выращивают с использованием диэтилцинка (DEZ) в качестве прекурсора Zn и водяного пара (термический) или кислородной плазмы (усиленный плазмой) в качестве прекурсора кислорода. Основным способом настройки свойств пленки нелегированного ZnO в процессе термического ALD является изменение температуры роста [17, 18]. Хотя это позволяет наносить пленки с высокой проводимостью, высококачественные пленки ZnO трудно получить при низкой концентрации носителей. ALD с плазменным усилением предпочтительно использовать, когда требуется ZnO с низкой концентрацией носителя [19, 20]. Недавно мы сообщили о возможности настройки ZnO с помощью одного процесса ALD с плазменным усилением, который позволяет настраивать его удельное сопротивление и концентрацию носителей до трех порядков, используя разные O 2 плазменные времена [21]. Однако усиленный плазмой ALD может страдать от несамоограничивающегося роста, если короткий O 2 Время плазмы применяется для достижения необходимой концентрации носителя, что может привести к плохой однородности на большом субстрате. Поэтому был бы желателен настраиваемый процесс ALD в самоограничивающемся окне.
Помимо возможности настройки электрических свойств ZnO, определение этих свойств также остается сложной задачей. Измерение эффекта Холла - самый популярный метод измерения электрических свойств тонких пленок ZnO. Однако он может быть неправильно истолкован и затруднен в однозначном обнаружении действительной причины допинга [1]. Зондовая силовая микроскопия Кельвина (KPFM) - это неразрушающий поверхностный метод, который широко используется для характеристики наноразмерных структурных, динамических и электрических свойств полупроводниковых материалов и устройств [22, 23]. Путем прямого измерения контактной разности потенциалов ( V CPD ), то есть разницу между работой выхода иглы и образца, он может дать представление о типах примеси материала, концентрации носителей заряда и удельном сопротивлении, поскольку они влияют на положение уровня Ферми в запрещенной зоне. Однако о работах, которые коррелируют свойства ZnO с результатами KPFM, редко сообщают, и, насколько нам известно, нет ни одной работы, основанной на пленках ZnO, выращенных методом ALD [24,25,26].
В этой работе мы предлагаем новый суперциклический процесс ALD для настройки электрических свойств нелегированного ZnO. Сочетание термического процесса ALD с O 2 на месте плазменная обработка, этот процесс позволяет производить широкую, но точную настройку удельного сопротивления пленки ZnO и концентрации носителей. Что еще более важно, сдвиги уровня Ферми в пленках ZnO можно напрямую измерить с помощью KPFM и использовать для характеристики электрических свойств ZnO.
Методы
Все тонкие пленки ZnO были приготовлены в системе OIPT FlexAl ALD с использованием прекурсора диэтилцинка (DEZ). Каждый суперцикл процесса ALD состоит из m циклы термических процессов ALD (DEZ и H 2 O) и один O 2 плазменная ступенька, как показано на рис. 1а. В процессе термического ALD пар DEZ сначала вводился в камеру, а затем продувался потоком аргона, и H 2 Затем вводили пары O и продували аргоном. Через м циклы термических процессов ALD, O 2 Плазменная стадия была добавлена как стадия плазменной обработки in situ. О 2 плазменный шаг был установлен с использованием O 2 расход 60 см3, мощность ВЧ 300 Вт, давление 15 мТорр. Оба тепловых числа ALD ( м ) и O 2 время плазмы ( t 3 ) были использованы для контроля свойств пленки ZnO. Конкретные детали для одного суперцикла роста в процессе ALD приведены в Дополнительном файле 1:Таблица S1. Все пленки ZnO были нанесены на SiO 2 Si-подложки с покрытием (1 см × 1 см) при фиксированной температуре 190 ° C, а вся толщина пленки по прогнозам составляла 40 нм.

а Иллюстрация суперцикла однократного роста предлагаемого суперциклического процесса ALD. б Скорость роста ZnO в зависимости от O 2 время плазмы для суперциклического ALD с фиксированным тепловым циклом ( м =1) и плазменно-усиленные процессы ALD; пунктирные кривые - ориентиры для взгляда. c Скорость роста ZnO и линейная аппроксимация в зависимости от цикла термического процесса м с фиксированным O 2 время плазмы ( t 3 =1 и 8 с)
Толщину и оптические постоянные осажденных пленок ZnO измеряли эллипсометрией (VASE, J.A. Woollam Co. M-2000) и использовали модель Таука-Лоренца (TL). Электрические свойства были измерены измерениями Холла (Nanometrics HL5500PC) при комнатной температуре в магнитном поле 0,5 Тл. Особое внимание было уделено обеспечению линейного контакта между каждым медным зондом и образцом перед каждым отдельным измерением. Картины дифракции рентгеновских лучей (XRD) были получены при скользящем падении ( θ 1 =1 °) с помощью дифрактометра Rigaku Smartlab с Cu- K мощностью 9 кВт α источник. Данные рентгеновской фотоэлектронной спектроскопии (XPS) были получены с использованием Thermo Scientific Theta Probe System с Al- K α излучения (энергия фотона =1486,6 эВ). При необходимости поверхностное загрязнение устранялось с помощью ионного распылителя. Zn 2 p , O 1 с , и C 1 s спектры были собраны. Все данные относятся к C 1 s пик, которому присвоена энергия связи 284,6 эВ. Измерения KPFM проводились на Nanonics CV2000 с помощью наконечника Nanosensor ATEC, покрытого Pt-Ir, с резонансной частотой 65 кГц. Чтобы уменьшить влияние поверхностных загрязнений, измерения проводились сразу после того, как образцы были извлечены из вакуумной камеры.
Результаты и обсуждение
Предлагаемый суперциклический процесс ALD показан на рис. 1а с одним суперциклом, состоящим из m циклы термических процессов ALD (DEZ и H 2 O) и один O 2 плазменная ступень (O 2 плазма). Подробнее в разделе «Методы». На рисунке 1b сравниваются темпы роста ZnO в нашем суперциклическом процессе ALD, когда m =1 и обычный процесс ALD с плазменным усилением как функция O 2 плазменное время. Скорость роста в процессе ALD с плазменным усилением (красный) оказалась чувствительной к O 2 в плазме по мере увеличения от прибл. 1,4–1,7 Å / цикл при изменении времени плазмы от 2 до 4 с. Затем он насыщается на уровне ок. 1,7 Å / цикл при более продолжительном времени плазмы. Скорость ненасыщенного роста при более коротком O 2 плазменное время связано с недостатком кислорода в процессе. Хотя иногда это предпочтительно для получения пленок ZnO с высокой проводимостью, это не самоограничение и может привести к плохой однородности по всей подложке. С другой стороны, скорость роста оказалась стабильной на уровне ок. 1,69 Å / суперцикл в суперциклическом процессе ALD (черный) и близок к таковому в термическом процессе ALD ( t 3 =0 с) независимо от времени подачи плазмы. Причем увеличение теплового цикла м в одном суперцикле с фиксированным временем плазмы приводит к линейному увеличению скорости роста, как показано на рис. 1c. Рассчитанный градиент составляет 1,67 для обоих наростов с разным O 2 . плазменные времена, что также близко к скорости роста термического процесса ALD. Это предполагает, что в росте ZnO в нашем суперциклическом ALD преобладает термический процесс ALD и последующий O 2 Плазменная ступень служит только лечением.
Все пленки ZnO, выращенные с помощью суперциклического процесса ALD ( m =1) кристаллизуются в гексагональной структуре вюрцита и демонстрируют аналогичное распределение пиковых интенсивностей независимо от O 2 плазменное время, как показано на рис. 2а. По сравнению с теоретическим соотношением интенсивностей 0,44 между пиком (0 0 2) и (10 1) (рассчитанным из JCPDS-34-1451 для случайной ориентации кристаллитов) эти пленки демонстрируют сильную предпочтительную ориентацию вдоль c -ось с соотношением интенсивностей пиков (0 0 2) и (1 0 1) между 2 и 5, что свидетельствует о хорошем кристаллическом качестве пленок. Небольшое увеличение отношения пиков (0 0 2) к (1 0 1) наблюдается с увеличением O 2 время плазмы (показано в Дополнительном файле 1:Рисунок S1). Это предполагает более высокую степень предпочтительной ориентации при длительном воздействии плазмы. Сообщалось также о подобном поведении [27, 28]. Однако стоит отметить, что изменение соотношения интенсивностей в нашей работе довольно тривиально по сравнению с другими. Это также свидетельствует о стабильности нашего суперциклического процесса ALD для производства высококачественных пленок ZnO. Средний размер зерен был также оценен по формуле Шеррера [29] и оказался равным ок. 11 нм, что позволяет предположить, что размер зерна ZnO практически не зависит от O 2 плазменное время. Подобные закономерности наблюдаются также на пленках ZnO, выращенных из различных термических циклов ALD ( m ) с фиксированным O 2 время плазмы (1 с), как показано на рис. 2b.
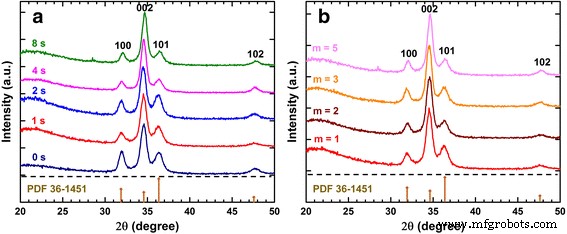
Картины XRD пленок ZnO, выращенных с помощью суперциклического процесса ALD с использованием a разные O 2 время плазмы с фиксированным тепловым циклом ( м =1) и b различные термические циклы с фиксированным O 2 время плазмы ( t 3 =1 с)
Помимо кристалличности, оптические свойства пленок ZnO, выращенных методом сверхциклической ALD, также были исследованы с помощью спектроскопической эллипсометрии (SE). Оптические константы ( n и k ) можно извлечь из результатов эллипсометрии с помощью модели Таука-Лоренца, которая обычно используется при подгонке пленок ZnO [28, 30, 31]. Подобно аналогичной кристалличности, оптические свойства пленок ZnO, осажденных с различным O 2 время плазмы и термические циклы также остаются неизменными, как показано в Дополнительном файле 1:Рисунок S2. Это согласуется с опубликованными работами о том, что изменение кристалличности всегда связано с изменением оптических свойств [28, 32]. Морфологические свойства пленок ZnO охарактеризованы методом АСМ. Было обнаружено, что все пленки одинаково гладкие, со средней шероховатостью примерно между 0,3 и 0,8 нм (дополнительный файл 1:Рисунок S3).
Электрические свойства пленок ZnO, выращенных с помощью суперциклического процесса ALD, исследуются с помощью системы эффектов Холла. Все фильмы оказались n полупроводникового типа, и удельное сопротивление увеличивается от прибл. 10 −3 до 10 3 Ом см при увеличении O 2 время плазмы и фиксированный тепловой цикл ( м =1), как показано на рис. 3а. Это связано со снижением концентрации носителя с прибл. 10 21 до 10 15 см −3 как O 2 время плазмы увеличивается от 0 до 8 с (рис. 3б). Напротив, подвижность электронов всех пленок ZnO оказалась довольно постоянной (примерно 3,0 ± 1,0 см 2 / В с) и не зависят от продолжительности плазмы. Подробный механизм проведения будет рассмотрен далее в разделе ниже. По сравнению с процессом ALD с плазменным усилением, о котором мы сообщали ранее [21], величина настройки удельного сопротивления была дополнительно улучшена в процессе сверхциклического ALD до более чем пяти порядков. Кроме того, предлагаемый процесс ALD предлагает более точный контроль над этими электрическими свойствами путем изменения теплового цикла ( m ) за один суперцикл, фиксируя O 2 время плазмы ( t 3 ). Это особенно полезно в случае t 3 =1 с, где настройка не может быть достигнута путем дальнейшего сокращения времени плазменной резки из-за ограничений оборудования ALD. Светлые точки на рис. 3a, b представляют собой удельные сопротивления и концентрации носителей заряда пленок ZnO, выращенных с помощью различных термических циклов ( m =2, 3, 5), когда t 3 =1 с (шкала погрешностей внутри точек). Можно заметить, что большее количество термических циклов приводит к получению менее резистивных пленок с более высокими концентрациями носителей. Это дает дополнительно три значения удельного сопротивления в диапазоне 10 −3 . до 10 1 Ом см.
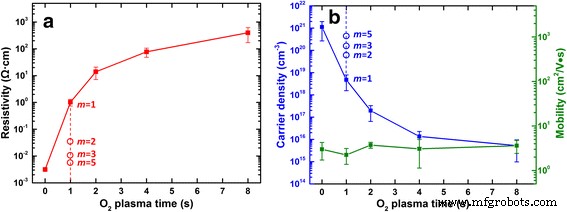
а Удельное электрическое сопротивление пленок ZnO, выращенных из различных O 2 время плазмы с фиксированным тепловым циклом м (сплошные точки) и различные термические циклы с фиксированным O 2 время плазмы (открытые точки) с помощью суперциклического процесса ALD. б Концентрация носителей (синий цвет) пленок ZnO, выращенных из различных O 2 время плазмы с фиксированным тепловым циклом (сплошные точки) и различные тепловые циклы с фиксированным O 2 время плазмы (открытые точки). Подвижность (зеленый цвет) пленок ZnO, выращенных из различных O 2 время плазмы с фиксированным тепловым циклом
KPFM-измерения были выполнены для понимания положения уровней Ферми пленок ZnO с изменяющимся сопротивлением. Он измеряет контактную разность потенциалов V CPD между проводящим наконечником и образцом, который определяется как:
$$ {V} _ {\ mathrm {CPD}} =\ frac {\ phi _ {\ mathrm {tip}} - {\ phi} _ {\ mathrm {sample}}} {q} $$ (1)где q - заряд электрона, а ϕ подсказка и ϕ образец - работа выхода иглы и образца соответственно. Когда два разных материала приводятся в электрический контакт, уровни Ферми выстраиваются в линию из-за потока электронного тока, который, следовательно, вызывает разность контактных потенциалов между зондом и образцом, как показано в Дополнительном файле 1:Рисунок S4. Подробный принцип работы KPFM представлен в дополнительном файле 1. Контактные разности потенциалов пленок ZnO, выращенных с помощью суперциклического процесса ALD из различных O 2 время плазмы с фиксированным тепловым циклом ( м =1) показаны на рис. 4. Хотя каждый V CPD изображение кажется однородным и относительно гладким, значительные различия в средних значениях V CPD могут наблюдаться значения (показаны на рис. 4f). Работа выхода наконечника ϕ подсказка остается неизменным для всех измерений; существенная разница в V CPD поэтому является следствием сдвига уровня Ферми в разных пленках ZnO. Общий сдвиг ок. 0,32 эВ получается между пленкой ZnO, выращенной при 0 и 8 с O 2 время плазмы, которое существенно по сравнению с шириной запрещенной зоны ZnO (приблизительно 3,22 эВ на основе результатов SE в этой работе, как показано в Дополнительном файле 1:Рисунок S2c). Для пленок ZnO, выращенных в различных термических циклах ( м =2, 3, 5) при фиксированном O 2 время плазмы ( t 3 =1 с), разные V CPD значения также были обнаружены, как показано на рис. 4f. Двумерные KPFM-изображения этих пленок можно найти в Дополнительном файле 1:Рисунок S5. Это означает, что изменение баланса электронов и дырок происходит по всей пленке, что может оказать значительное влияние на концентрацию носителей ZnO.
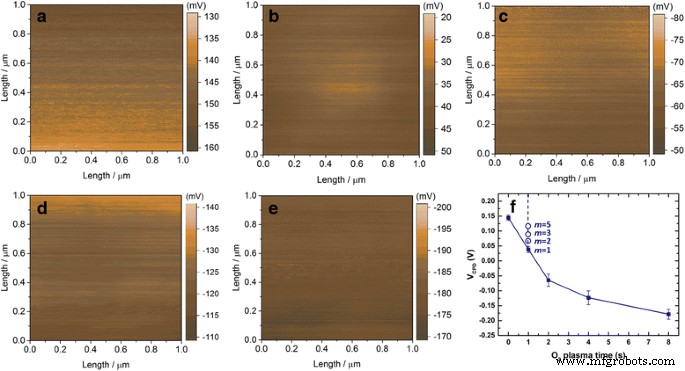
а - е Двумерная контактная разность потенциалов V CPD изображения измерений поверхностного потенциала суперциклированных пленок ZnO, выращенных методом ALD, с O 2 время плазмы ( t 3 ) от 0 до 8 с и фиксированный тепловой цикл ( м =1). е Среднее V CPD значения с разным O 2 время плазмы (сплошные точки) и термические циклы (незакрашенные точки)
Чтобы исследовать связь между уровнем Ферми и концентрацией носителей, мы используем модель электронной энергии, предложенную Мараглиано и др. для корреляции контактной разности потенциалов V CPD с концентрацией легирования в материале [26]. Предполагая эффективную концентрацию доноров n D значительно выше, чем собственная концентрация носителя, это можно записать как:
$$ {n} _ {\ mathrm {D}} \ приблизительно {N} _ {\ mathrm {C}} \ exp \ left (\ frac {q {V} _ {\ mathrm {C} \ mathrm {PD} } - {\ phi} _ {\ mathrm {tip}} + \ chi} {K_BT} \ right) $$ (2)где N C - эффективная плотность состояний, χ - сродство к электрону полупроводника, K B - постоянная Больцмана, а T это температура. Хотя значения эффективной плотности состояний N C , работа выхода наконечника ϕ подсказка , а сродство к электрону χ получить трудно, можно рассчитать относительную разницу концентраций носителей заряда для разных пленок ZnO, поскольку эти значения одинаковы во всех измерениях. Следовательно, соотношение концентраций носителей заряда между пленками, выращенными при 0 с O 2 Время плазменной резки данной пленки ZnO можно выразить как:
$$ \ frac {n_0} {n_x} =\ exp \ left (\ frac {V _ {\ mathrm {CPD} 0} - {V} _ {\ mathrm {CPD} x}} {K_BT / q} \ right) $$ (3)в котором n 0 и н x - концентрация носителей в пленке ZnO, выращенной с 0 и x s из O 2 время плазмы соответственно и V CPD0 и V Цена за день x - соответствующие контактные разности потенциалов. Расчетные отношения концентраций носителей показаны на рис. 5 как функция O 2 . плазменное время. Коэффициент концентрации рассчитывается для увеличения с увеличением O 2 . плазменное время (красный). Что еще более важно, тенденция к увеличению хорошо согласуется со значениями, полученными по результатам измерения эффекта Холла (черный цвет). Аналогичная тенденция наблюдалась и для пленок ZnO, выращенных в различных термических циклах ( m =2, 3, 5) при фиксированном O 2 время плазмы ( t 3 =1 с). Это, очевидно, предполагает, что сдвиг уровня Ферми пленки ZnO напрямую связан с уровнем концентрации носителей заряда.
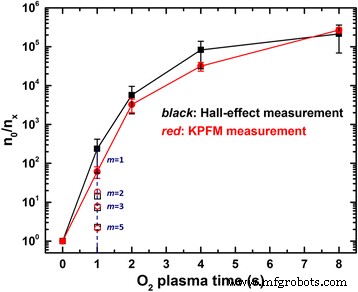
Эффект Холла и результаты измерения отношения концентраций носителей заряда между пленками ZnO, выращенными с различным O 2 , методом KPFM время плазмы (сплошные точки) и термические циклы (незакрашенные точки)
Измерения методом рентгеновской фотоэлектронной спектроскопии (XPS) были проведены, чтобы пролить свет на механизм проводимости путем изучения связывания и химического состояния суперциклических пленок ZnO, выращенных методом ALD. Химические состояния O 1 s показаны на рис. 6, где после подгонки по Гауссу можно идентифицировать два пика. Нижний пик энергии (A) расположен на уровне прибл. Предполагается, что 530,3 эВ составляет O 2- ионы в структуре вюрцита гексагонального Zn 2+ ионы [33,34,35]. Назначения компонента более высокой энергии связи на уровне ок. 532.2 (B) вызывают разногласия по поводу литературы [33,34,35,36,37,38]. Однако широко сообщается, что он связан с гидроксильной группой (например, Zn – OH) [33, 37,38,39] в пленке ZnO. Поэтому мы предварительно приписываем O B пик, наблюдаемый на рис. 6, для связей Zn-OH. С другой стороны, пик, связанный с кислородной вакансией, расположен на уровне прибл. 531,2 эВ [35] в данной работе не наблюдается. Пленка ZnO, выращенная методом термического ALD ( t 3 =0 с) характеризует доминантный O B пик в XPS-спектре (рис. 6а). Это предполагает наличие в этой пленке большого количества примесей, связанных с водородом. Этот высокий уровень дефектов служит механизмом самолегирования и приводит к высокой концентрации носителей заряда. Дополнительные O 2 плазменная ступенька ( t 3 ) уменьшает примеси, а O B пиковая интенсивность уменьшается с увеличением O 2 плазменное время (рис. 6е). Аналогичная тенденция наблюдалась также для пленок ZnO, выращенных из различных термических циклов, в которых большее количество термических циклов приводит к увеличению O B пиковая интенсивность, как показано на рис. 6f и в дополнительном файле 1:рис. S6.

а - е Спектры XPS и их гауссова аппроксимация O 1 s область суперцикличных пленок ZnO, выращенных методом ALD, с O 2 время плазмы ( t 3 ) от 0 до 8 с и фиксированный тепловой цикл ( м =1). е Доля связанного с водородом O B пик в пленках ZnO, выращенных с переменным O 2 время плазмы (сплошные точки) и термические циклы (незакрашенные точки)
Происхождение внутреннего n -тип проводимости в пленках ZnO до сих пор остается дискуссионным. Хотя общепринято считать эту проводимость естественным дефектом (т.е. кислородными вакансиями и межузельными атомами цинка) [18, 40,41,42,43,44], недавние расчеты из первых принципов поставили ее под сомнение [45]. Кислородные вакансии также вряд ли способствуют такому высокому уровню концентрации, поскольку многочисленные исследования показывают, что они являются глубокими, а не мелкими донорами и имеют высокую энергию образования в n -типа ZnO (и поэтому не образуются) [41,42,43,44]. Кроме того, кислородная вакансия O 1 s пик также не наблюдается в наших данных РФЭС, показанных на рис. 6. Хотя межузельные частицы Zn являются мелкими донорами, предполагается, что они имеют высокую энергию образования и являются более быстрыми диффузорами и, следовательно, вряд ли будут стабильными [41]. Спектры РФЭС Zn 2 p 3/2 состояние суперциклических пленок ZnO, выращенных методом ALD, с различным содержанием O 2 времена плазмы показаны на рис. 7. Все спектры характеризуются аналогичным пиком, расположенным примерно на отметке около 30 мин. 1021,5 эВ, что можно отнести к Zn 2+ связывание в ZnO [6, 34, 46]. Однако межузельная компонента Zn при несколько большей энергии связи [6, 47] наблюдается не во всех спектрах. Это говорит о том, что влияние внедрения Zn на проводимость пленки ZnO также может быть исключено в данной работе.

а - е XPS-спектры и их гауссова аппроксимация Zn 2 p 3/2 область суперцикличных пленок ZnO, выращенных методом ALD, с O 2 время плазмы ( t 3 ) от 0 до 8 с и фиксированный тепловой цикл ( м =1)
В последнее время предполагается, что примеси / дефекты, связанные с водородом, играют роль в n -типа проводимости в ZnO [33, 48]. Доказательства существования водородных связей в ZnO были продемонстрированы Janotti et al. [48], и было высказано предположение, что эти связи способны включаться в высоких концентрациях и вести себя как мелкие доноры [49,50,51]. Действительно, водород присутствует в нашем суперциклическом процессе ALD как предшественник, так и H 2 O содержат водород, и связь Zn-OH образуется в каждом полупериоде на этапе термической ALD. Это также подтверждается наблюдением связанных с гидроксильными группами O 1 s пик в XPS-спектрах (показан на рис. 6). Удельное сопротивление пленки ZnO и плотность носителей отложены в зависимости от доли этого пика на рис. 8. Высокая доля этих примесей водорода вызывает высокие концентрации носителей, что приводит к низкому удельному сопротивлению. Последующие O 2 плазменная стадия в каждом суперцикле снижает концентрацию носителей за счет эффективного удаления водородных связей. Это сопровождается уменьшением концентрации носителей заряда, а также увеличением удельного сопротивления. Об аналогичном поведении также сообщалось как при процессах ALD, так и при сердечно-сосудистых заболеваниях [33, 52].
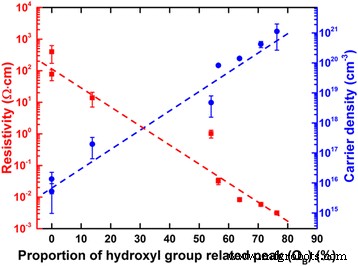
Удельное электрическое сопротивление и концентрация носителей в зависимости от O B , связанного с гидроксильной группой пиковая пропорция (пунктирные линии - ориентиры)
Выводы
Здесь сообщалось об осаждении нелегированных пленок ZnO с регулируемыми электрическими свойствами с использованием суперциклического процесса ALD, который сочетает в себе термический процесс ALD и in situ O 2 плазменная обработка. Регулировка удельного сопротивления пленки и концентрации носителей более чем на пять порядков была достигнута путем настройки O 2 плазменные времена. Более точная настройка свойств также может быть реализована путем изменения количества термических циклов ALD в суперцикле. Считается, что настройка этих электрических свойств связана с изменением концентрации водородных дефектов в пленке. Это непосредственно вызывает сдвиг уровней Ферми в пленках ZnO, что обнаружено с помощью зондовой силовой микроскопии Кельвина. Приняв простую модель электронной энергии, концентрации носителей, рассчитанные по сдвигам уровней Ферми, демонстрируют хорошее совпадение с результатами измерения эффекта Холла. Этот надежный и надежный метод, описанный здесь, ясно указывает на возможность использования этого метода для производства пленок ZnO с контролируемыми свойствами в различных областях применения.
Сокращения
- ALD:
-
Осаждение атомного слоя
- DEZ:
-
Диэтилцинк
- КПФМ:
-
Зондовая силовая микроскопия Кельвина
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
- XRD:
-
Рентгеновская дифракция
Наноматериалы
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на по…
- Межфазные, электрические характеристики и характеристики совмещения полос стопок HfO2 / Ge с прослойкой SiO2, сфор…
- Иерархические антибактериальные полиамидные 6-ZnO нановолокна, полученные путем осаждения атомных слоев и гид…
- Фотокаталитические свойства порошков TiO2 с покрытием Co3O4, полученных методом плазменного осаждения атомного …
- Двухэтапное осаждение ZnO, легированного алюминием, на p-GaN с образованием омических контактов
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Оптические свойства пленок ZnO, легированных алюминием, в инфракрасной области и их применения для поглощения
- Влияние различных морфологий CH3NH3PbI3 на фотоэлектрические свойства перовскитных солнечных элементов
- Свойства получения и антибиотикопленки композитных пленок из оксида цинка / пористого анодного оксида алюми…



