Межфазные, электрические характеристики и характеристики совмещения полос стопок HfO2 / Ge с прослойкой SiO2, сформированной in situ методом плазменного осаждения атомных слоев
Аннотация
SiO 2 , сформированный in situ был введен в HfO 2 затворные диэлектрики на подложке Ge в качестве промежуточного слоя путем плазменного осаждения атомных слоев (PEALD). Межфазные, электрические характеристики и характеристики выравнивания полос HfO 2 / SiO 2 Диэлектрические стеки затвора с высоким k на Ge хорошо исследованы. Было продемонстрировано, что прослойка Si-O-Ge формируется на поверхности Ge во время in situ PEALD SiO 2 процесс осаждения. Эта прослойка демонстрирует фантастическую термическую стабильность во время отжига без явного образования Hf-силикатов. Кроме того, он также может подавлять GeO 2 деградация. Электрические измерения показывают, что эквивалентная толщина емкости 1,53 нм и плотность тока утечки 2,1 × 10 −3 А / см 2 при смещении затвора V fb + 1 В было получено для отожженного образца. Смещение зоны проводимости (валентности) при HfO 2 / SiO 2 / Ge с КПК и без него составляют 2,24 (2,69) и 2,48 (2,45) эВ соответственно. Эти результаты показывают, что in situ PEALD SiO 2 может быть перспективным межфазным управляющим слоем для реализации высококачественных транзисторных устройств на основе Ge. Более того, можно продемонстрировать, что PEALD является гораздо более мощной технологией для нанесения сверхтонкого межфазного контрольного слоя, чем MOCVD.
Фон
С постоянным уменьшением размеров полевых транзисторов металл-оксид-полупроводник (MOSFET), MOSFET на основе Si приближается к своим физическим и техническим ограничениям. Материалы альтернативных каналов, такие как германий (Ge) [1, 2] и материалы III-V [3–5], в последнее время вызывают большой интерес для приложений с высокопроизводительными логическими устройствами. Среди них Ge имеет потенциал заменить кремний в качестве материала канала в MOSFET из-за присущей ему более высокой подвижности дырочных носителей [6]. Однако прямое нанесение диэлектриков затвора с высоким k на подложки из Ge часто приводит к высокой плотности захвата интерфейса (D it ) и нежелательное образование межфазного слоя между Ge и слоями диэлектриков с высоким k [7]. Следовательно, для создания высокоскоростных и маломощных полевых МОП-транзисторов на основе Ge очень важно добиться высокого качества k / Ge интерфейс. К счастью, было сообщено о множестве методов для улучшения качества интерфейса high-k / Ge [8], таких как введение SiO 2 [9], Si [10], GeO 2 [11], Al 2 О 3 [12, 13], GeO x N y [14, 15] и оксиды редкоземельных элементов [16, 17] в качестве межфазного контрольного слоя между подложкой Ge и высоким k затворные диэлектрики. В частности, GeO 2 Структура / Ge имеет превосходные свойства интерфейса, чрезвычайно низкую плотность состояний интерфейса (D it ) менее 1 × 10 11 см −2 эВ −1 может быть достигнуто [18]. Однако GeO 2 разлагается при температуре выше 425 ° C и растворяется в воде. В результате недопустимый D it всегда обнаруживается для конденсатора Ge-MOS (MOSCAP) [6]. К счастью, Kita et al. сообщил, что перекрывающий слой на GeO 2 может подавить GeO 2 деградация; однако выбор материала для верхнего слоя должен быть очень важным [19–21]. Например, Si или Y 2 О 3 работает более эффективно, чем HfO 2 для замедления десорбции Ge-O. Эти результаты указывают на важность выбора материалов с высоким k или межфазного контрольного слоя для ингибирования GeO 2 деградация. Накашима и др. сообщил, что очень тонкий SiO 2 / GeO 2 двухслойное нанесение методом физического осаждения из паровой фазы (PVD) является многообещающим межслойным слоем для пассивирования Ge, D it из 4 × 10 11 см -2 эВ −1 была достигнута около середины промежутка [22, 23]. Ли и др. представил SiO 2 прослойка на Ge методом химического осаждения из газовой фазы (MOCVD) и SiO 2 промежуточный слой может эффективно подавлять выход Ge во время HfO 2 рост и последующий процесс отжига после осаждения [9]. Следовательно, SiO 2 должен быть прекрасным межфазным контрольным слоем для подложки Ge. Однако по сравнению с PVD и MOCVD, PEALD может обеспечить гораздо более однородный пассивирующий слой, особенно для сверхтонких толщин. Следовательно, SiO 2 , образованный PEALD может быть многообещающим межфазным управляющим слоем для создания высокопроизводительных транзисторных устройств на основе Ge.
Здесь мы представили SiO 2 , сформированный методом PEALD. в HfO 2 / Ge складывается как межфазный слой. Межфазные, электрические характеристики и характеристики выравнивания полос ALD HfO 2 пленки на подложках Ge n-типа были тщательно исследованы. SiO 2 был впервые нанесен на подложки Ge в качестве межфазного контрольного слоя компанией PEALD. Затем HfO 2 Диэлектрик затвора наносился на месте методом термического ALD. Отжиг после осаждения (PDA) при 500 ° C в течение 60 с в N 2 было выполнено для HfO 2 / SiO 2 диэлектрические стеки затвора с высоким k на Ge. Анализ рентгеновской фотоэлектронной спектроскопии показывает, что прослойка Si-O-Ge и GeO 2 слой образуется на поверхности Ge в процессе PEALD SiO 2 осаждение. Эта прослойка Si-O-Ge не только демонстрирует фантастическую термическую стабильность, но также может подавлять термическое разложение GeO 2 . . Таким образом, были достигнуты хорошие электрические свойства HfO 2 / Si-O-Ge / GeO 2 / Ge стеки. По сравнению с MOCVD SiO 2 промежуточный слой, in situ PEALD SiO 2 демонстрирует значительно улучшенные электрические свойства. Таким образом, PEALD является гораздо более мощной технологией, чем MOCVD, в области изготовления полевых МОП-транзисторов, особенно для нанесения сверхтонкого межфазного контрольного слоя.
Методы
В качестве подложек использовался Ge (100), легированный Sb N-типа с удельным сопротивлением 0,2–0,3 Ом ∙ см. Подложки сначала очищали ультразвуком в ацетоне, этаноле, изопропаноле и деионизированной воде в течение 5 мин соответственно. Затем разбавленный раствор HBr (H 2 O / HBr =3:1) протравливали поверхность самородных оксидов в течение 5 мин. После влажной химической очистки подложки промывали деионизированной водой и сушили в чистом N 2 . . Впоследствии субстраты были немедленно перенесены в PEALD (Picosun SUNALE TM Р-200) камера. Перед стартом k HfO 2 напыление пленок, 10 циклов SiO 2 Пленка была осаждена при 250 ° C с помощью PEALD в качестве промежуточного слоя, где один цикл состоял из 1 с инжекции источника Si, 10 с N 2 продувка, впрыск окислителя 13,5 с, N 2 4 с продувка. Трис- (диметиламино) силан (TDMAS) и O 2 Плазма использовалась в качестве прекурсора Si и окислителя для SiO 2 осаждения соответственно. TDMAS хранили при комнатной температуре. Чистый O 2 газ (99,999%) использовался как O 2 источник плазмы. Мощность плазмы и O 2 расход газа составлял 2500 Вт и 160 см3 соответственно. Скорость роста PEALD SiO 2 было определено как ~ 0,7 Å / цикл эллипсометрией спектроскопии ex situ. Тогда HfO 2 толщиной ~ 4 нм Пленка была осаждена на месте при 250 ° C в течение 40 циклов с помощью термической ALD, где один цикл состоял из 0,1 с дозирования источника Hf, 4 с N 2 продувка, 0,1 с H 2 O дозирования и 4 с N 2 продувка. Тетракис- (этилметиламино) -гафний (TEMAH) и H 2 O использовались в качестве прекурсора Hf и окислителя для HfO 2 осаждения соответственно. TEMAH упаривали при 150 ° C и H 2 O хранили при комнатной температуре. Чистый N 2 (99,999%) использовался в качестве газа-носителя и продувочного газа. КПК был выполнен в N 2 при температуре окружающей среды 500 ° C в течение 60 с при атмосферном давлении с использованием быстрого термического отжига.
Межфазные структуры и химическое связывание пленок исследовали с помощью рентгеновской фотоэлектронной спектроскопии ex situ (XPS, Thermo Fisher K-Alpha) со стандартным источником рентгеновского излучения Al Kα (1486,7 эВ). Спектры XPS были получены при угле взлета 90 °. Шкала энергии связи откалибрована с помощью Ge 3d 5/2 пик при 29,4 эВ. Кроме того, спектры XPS были подогнаны с помощью функций Гаусса-Лоренца (G-L) после вычитания фона интеллектуального типа. Электроды Pt верхние площадью 1,55 × 10 −4 см 2 были нанесены на поверхность HfO 2 пленки с использованием теневой маски методом напыления для электрических измерений. Характеристики емкости-напряжения (C-V) и плотности тока утечки-напряжения (J-V) были измерены с помощью системы полупроводникового анализатора Keithley 4200 с платформой зонда (Cascade summit 12000B-M).
Результаты и обсуждение
Для тонкого PEALD SiO 2 (~ 0,7 нм) на Ge, Si 2p показывает пик при 102,4 эВ, соответствующий связи Si-O (рис. 1а), что меньше энергии связи идеального SiO 2 [24]. Оба субоксида кремния (SiO x ) осаждение и образование Si-O-Ge на поверхности Ge во время процесса PEALD может вызвать сдвиг Si 2p в сторону более низкой энергии. Поэтому был проведен также Si 2p-спектр толстого PEALD (~ 7 нм) на Ge. Было обнаружено, что он показывает основной пик при 103,6 эВ, соответствующий идеальному SiO 2 склеивание, как показано на рис. 1b. Итак, оксид кремния, нанесенный PEALD, здесь идеален SiO 2 . . Однако, помимо сильного пика Si-O-Si, имеется слабый пик, расположенный при ~ 102,4 эВ, который должен соответствовать связи Si-O-Ge на поверхности Ge. Таким образом, можно сделать вывод, что Si-O-Ge образуется на поверхности Ge в исходном PEALD SiO 2 рост. После in situ 4 нм HfO 2 При осаждении интенсивность пика Si 2p уменьшается без очевидного химического сдвига (102,3 эВ), как показано на рис. 1а. Кроме того, Si 2 p пик также не показывает очевидного химического сдвига (102,2 эВ) после 500 ° C PDA в N 2 , что свидетельствует о хорошей термической стабильности HfO 2 / SiO 2 интерфейс во время HfO 2 осаждение и процесс КПК. В спектре Hf 4f после осаждения HfO 2 / SiO 2 стеки затворов (рис. 1c), дублет при 16,5 и 18,2 эВ можно отнести к Hf 4f 7/2 и Hf 4f 5/2 пики HfO 2 с энергией спин-орбитального расщепления 1,7 эВ, что соответствует литературному значению HfO 2 [25]. После 500 ° C PDA спектр Hf 4f не показывает очевидных изменений, только 0,1 эВ сдвиг в сторону более высокой энергии. Это означает, что в процессе PDA не образуются явные силикаты Hf. На рис. 1d в 3d-спектре Ge осажденного образца наблюдаются дублетные пики при 29,4 и 30,0 эВ, которые можно отнести к пикам Ge 3d5 / 2 и Ge 3d3 / 2 подложки Ge с энергией спин-орбитального расщепления 0,6 эВ. За исключением сигнала подложки Ge, существует огромный пик при 32,7 эВ для связи Ge-O. Пик Ge-O должен быть результатом образования Ge-O-Si и GeO 2 . Гео 2 слой образовался плазменным окислением поверхности кислородом в процессе PEALD SiO 2 процесс осаждения. Следовательно, настоящая изготовленная структура здесь - HfO 2 / Si-O-Ge / GeO 2 / Ge стеки. Более того, спектр Ge 3d не показывает очевидных изменений после обработки PDA при 500 ° C, что указывает на термическую стабильность HfO 2 / Si-O-Ge / GeO 2 / Ge стеки без GeO 2 деградация. Об этом сообщили Kita et al. что некоторые покрывающие слои на GeO 2 может подавить GeO 2 разложение, такое как Si или La 2 О 3 [19]. Следовательно, PEALD, индуцированный прослойкой Si-O-Ge здесь, также может подавлять GeO 2 разложение. На основании приведенного выше анализа РФЭС можно сделать вывод, что на поверхности Ge формируется сверхтонкая прослойка Si-O-Ge. Более того, этот промежуточный слой демонстрирует фантастическую термическую стабильность без образования Hf-силикатов, он также может ингибировать GeO 2 деградация.
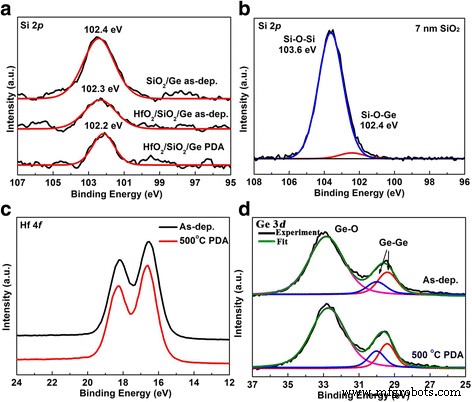
XPS-спектры SiO 2 / Ge и HfO 2 / SiO 2 / Ге конструкции. а Si 2p-спектры SiO 2 , после осаждения и отожженного HfO 2 / SiO 2 на Ge. б Si 2p-спектры толстого SiO 2 (7 нм) на Ge. c, d Спектры Hf 4f и Ge 3d после осаждения и отжига HfO 2 / SiO 2 / Ге конструкции
На рисунке 2а показаны высокочастотные (1 МГц) C-V кривые HfO 2 . / SiO 2 стеки затвора на Ge до и после КПК. Можно обнаружить, что напряжение плоской полосы ( В fb ) значения HfO 2 / SiO 2 / Ge до и после КПК составляют 0,42 и 0,27 В соответственно. Расчетный идеал V fb значение 0,55 В. Слегка отрицательное значение V fb сдвиг указывает на положительные фиксированные заряды, которые могут быть вызваны кислородными вакансиями в диэлектриках [26, 27]. Во время процесса отжига в инертной атмосфере может появиться больше кислородных вакансий, что приведет к слегка отрицательному V fb сдвиг. Во многих публикациях было продемонстрировано, что GeO 2 деградация во время отжига приведет к положительному V fb сдвиг. Считается, что процесс десорбции Ge-O генерирует дополнительные отрицательные заряды [28, 29]. Следовательно, можно также сделать вывод, что GeO 2 разложение подавляется прослойкой Ge-O-Si из V fb сдвиг. Накопительная емкость явно увеличивается с исходных 1,92 до 2,25 мкФ / см 2 . после КПК. Соответствующие значения эквивалентной толщины емкости (CET) МОП-конденсаторов могут быть рассчитаны из накопительных емкостей кривых C-V с использованием ε 0 ε r Кондиционер acc [30]. Следовательно, меньшая CET 1,53 нм получается после PDA по сравнению с образцом после осаждения 1,80 нм. Это можно объяснить тем фактом, что более плотный и тонкий слой high-k может быть получен после процесса PDA. На рисунке 2b показаны характеристики тока утечки HfO 2 . / SiO 2 фильмы на Ge до и после КПК. При напряжении смещения В fb + 1 В, плотность тока утечки составляет 2,1 × 10 −3 А / см 2 и 2.2 × 10 −4 А / см 2 для образца до и после КПК соответственно. Повышенную плотность тока утечки после КПК можно также объяснить уменьшением толщины диэлектрика затвора.
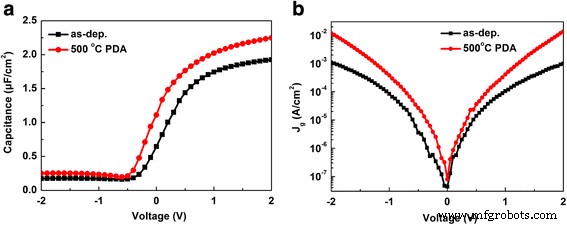
Электрические характеристики HfO 2 / SiO 2 стеки затворов на подложках Ge до и после КПК 500 ° C. а Высокочастотные (1 МГц) C-V кривые. б J-V кривые
Чтобы проверить качество интерфейса HfO 2 / SiO 2 / Ge количественно плотность состояний интерфейса ( D это ) определялась методом проводимости [31]. На рисунке 3 показано распределение D это ниже E c в запрещенной зоне, извлеченной методом проводимости при комнатной температуре для Pt / HfO 2 / SiO 2 / Ge до и после КПК 500 ° C. D это можно приблизительно рассчитать из D это =2,5 × ( G p / w ) макс / А q, где ( G p / w ) макс - пиковое значение кондуктометрической характеристики, f (= w / 2π) - частота, A - площадь электрода, а q это элементарный заряд. Следовательно, D это значения Pt / HfO 2 / SiO 2 Структуры / Ge без КПК и с ним составляют 4,05 × 10 12 эВ −1 см -2 и 5,37 × 10 12 эВ −1 см −2 в E-E v =0,38 эВ соответственно. Нижний D это значения 2,03 × 10 12 см −2 эВ −1 и 2,67 × 10 12 см −2 эВ -1 вблизи дна зоны проводимости наблюдаются для образцов без и с КПК соответственно.
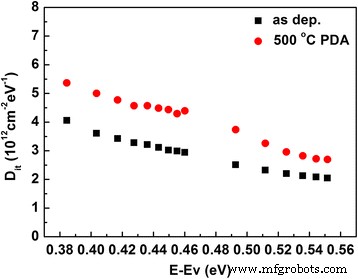
Распространение D it ниже E c в запрещенной зоне при комнатной температуре для Pt / HfO 2 / SiO 2 / Ge до и после КПК 500 ° C
На рисунке 4 показана плотность тока утечки ( Дж g ) -CET взаимосвязь МОП-конденсатора на основе германия с различным межфазным управляющим слоем [32, 33]. По сравнению с S-пассивированным Ge без прослойки, описанным в нашей предыдущей работе [34], HfO 2 / SiO 2 / Ge в этой работе демонстрирует значительно улучшенные свойства с меньшим CET (1,53 против 2,18 нм), плотностью тока утечки (2,1 × 10 −3 против 3,1 А / см 2 ) и D это (4,37 × 10 12 против 8,61 × 10 12 эВ −1 см −2 ). Это подразумевает, что SiO 2 , образованный на месте PEALD замечательный пассивирующий слой для Ge. Более того, по сравнению с SiO 2 , сформированным ex-situ прослойка методом MOCVD [9], образец с SiO 2 , сформированным in situ PEALD Промежуточный слой в этой работе показывает лучшие электрические характеристики как с меньшим CET (1,53 против 1,75 нм), так и с плотностью тока утечки (2,1 против 3,9 мА / см 2 ). Это можно объяснить тем, что SiO 2 осажденные PEALD более однородны, чем MOCVD, особенно для сверхтонкой толщины.
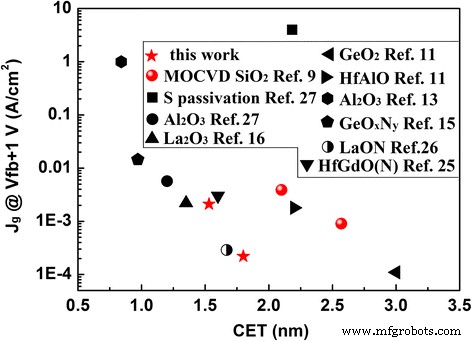
Зависимость плотности тока утечки (Jg) -CET для МОП-конденсаторов на основе Ge с различным межфазным контрольным слоем
Выравнивание полосы при HfO 2 / SiO 2 Граница раздела / Ge была также определена путем измерения смещения валентной зоны ∆E v (VBO) с использованием XPS. Значения VBO могут быть получены на основе предположения, что разность энергий между остовным уровнем и краем валентной зоны (VB) подложки остается постоянной при нанесении диэлектрических пленок или без него [35]. Здесь подложка Ge была выбрана в качестве эталона для определения VBO между стопкой диэлектриков затвора и подложкой Ge. На рисунке 5а представлены VB-спектры чистой подложки Ge после осаждения и отожженного HfO 2 . / SiO 2 Сумки / Ge определены методом линейной экстраполяции соответственно. Край VB чистой подложки Ge был определен как 0,10 эВ. И кромки VB непосредственно осажденного и отожженного HfO 2 / SiO 2 образцы оказались равными 2,55 и 2,79 эВ соответственно. Можно заметить небольшой хвост в спектрах VB для HfO 2 . / SiO 2 / Ge, что соответствует сигналу подложки Ge [36]. Передний край этого слабого хвоста составляет 0,10 эВ и совпадает с VB-краем подложки Ge. Следовательно, VBO в интерфейсе HfO 2 / SiO 2 / Ge с КПК и без него составляют 2,69 и 2,45 эВ соответственно. Смещение зоны проводимости ∆ E c (CBO) может быть получен путем вычитания VBO и ширины запрещенной зоны субстрата из запрещенной зоны HfO 2 :
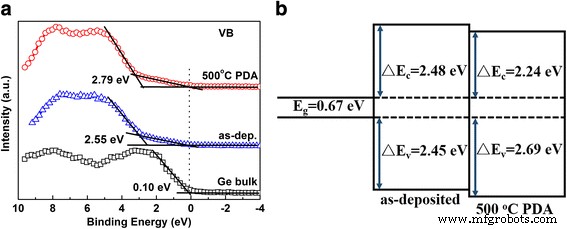
Выравнивание полос осажденного и отожженного HfO 2 / SiO 2 фильм по Ге. а Спектры валентной зоны подложки Ge после осаждения и отжига HfO 2 / SiO 2 фильмы. б Схема выравнивания полос осажденного и отожженного HfO 2 / SiO 2 фильм на Ge
где E г (HfO 2 ) и E г (Ge) - ширина запрещенной зоны HfO 2 и Ge соответственно. Ширина запрещенной зоны Ge и HfO 2 равны 0,67 и 5,6 эВ соответственно. Следовательно, значения CBO в интерфейсе HfO 2 / SiO 2 / Ge с КПК и без него оцениваются в 2,24 и 2,48 эВ соответственно. Значения CBO согласуются с ранее опубликованными данными 1,8–2,6 эВ [37]. На рис. 5b показано соответствующее выравнивание полос HfO 2 после осаждения и после отжига. / SiO 2 / Ге конструкции. Очевидно, HfO 2 / SiO 2 Диэлектрические стеки затвора с высоким k на Ge демонстрируют большие значения VBO и CBO с огромной высотой барьера для подавления тока утечки.
Выводы
Таким образом, SiO 2 прослойка была введена в HfO 2 затворные диэлектрики на подложках n-Ge успешно с помощью PEALD in situ. Мы исследовали межфазные, электрические свойства и выравнивание полос HfO 2 / SiO 2 / Ге МОС. Было продемонстрировано, что прослойка Ge-O-Si и GeO 2 слой образуется на поверхности Ge в процессе in situ SiO 2 осаждение. Этот промежуточный слой Ge-O-Si демонстрирует фантастическую термическую стабильность во время PDA без образования Hf-силикатов. Более того, прослойка Ge-O-Si может также ингибировать GeO 2 деградация в процессе отжига. HfO 2 / SiO 2 Образец / Ge после КПК показывает значение CET 1,53 нм с низкой плотностью тока утечки 2,1 × 10 −3 А / см 2 в V fb + 1 В. Значения VBO на HfO 2 / SiO 2 / Ge с КПК и без него составляют 2,69 и 2,45 эВ, а значения CBO равны 2,24 и 2,48 эВ, соответственно. По сравнению с SiO 2 , сформированным ex situ прослойка методом MOCVD, образец с SiO 2 , сформированным in situ PEALD прослойка в этой работе показывает улучшенные электрические характеристики, приписываемые тому факту, что SiO 2 депонированные PEALD более однородны, чем MOCVD. Таким образом, PEALD является гораздо более мощной технологией для нанесения ультратонкого межфазного контрольного слоя, чем MOCVD.
Наноматериалы
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Модель удержания TaO / HfO x и TaO / AlO x RRAM с характеристиками самовосстанавливающегося переключателя
- Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на по…
- Оптические и электрические характеристики кремниевых нанопроволок, полученных методом химического травлен…
- Иерархические антибактериальные полиамидные 6-ZnO нановолокна, полученные путем осаждения атомных слоев и гид…
- Фотокаталитические свойства порошков TiO2 с покрытием Co3O4, полученных методом плазменного осаждения атомного …
- Электрические свойства композитных материалов с выравниванием нанокарбоновых наполнителей с помощью элект…
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Настройка уровня Ферми пленок ZnO посредством суперциклического осаждения атомного слоя
- Зависимость толщины от межфазных и электрических свойств в атомарном слое, нанесенном на GaN c-плоскости



