Влияние пост-отжига на электрические характеристики поликристаллического фотодетектора Ga2O3 на сапфире
Аннотация
Влияние постотжига на физические и электрические свойства поликристаллического оксида галлия, не пропускающего солнечные лучи (Ga 2 О 3 ) исследованы ультрафиолетовые фотоприемники на сапфировой подложке. Размер зерна поли-Ga 2 О 3 становится больше при увеличении температуры постотжига (PAT) с 800 ° C до 1000 ° C, но становится меньше при дальнейшем повышении PAT до 1100 ° C. Наблюдается синий сдвиг на краю поглощения в спектрах пропускания Ga 2 . О 3 на сапфире по мере увеличения PAT из-за включения Al из сапфировой подложки в Ga 2 О 3 сформировать (Al x Ga 1– x ) 2 О 3 . Измерения дифракции рентгеновских лучей и спектров пропускания с высоким разрешением показывают, что замещающий состав Al и ширина запрещенной зоны (Al x Ga 1– x ) 2 О 3 отожженные при 1100 ° C могут быть выше 0,30 и 5,10 эВ соответственно. R макс образца, отожженного при 1000 ° C, увеличивается примерно на 500% по сравнению с устройством после осаждения, а образец, отожженный при 1000 ° C, имеет короткое время нарастания и время затухания 0,148 с и 0,067 с, соответственно. Эта работа может проложить путь к производству поли-Ga 2 О 3 ультрафиолетовый фотодетектор и найдите способ улучшить чувствительность и скорость отклика.
Фон
Фотодетекторы глубокого ультрафиолета (DUV), заслоняющие солнечные лучи, имеют широкий спектр применений, таких как мониторинг озоновых дыр и обнаружение пламени с неотъемлемым преимуществом сильной помехоустойчивой способности [1]. По сравнению с традиционными полупроводниковыми материалами, такими как кремний и германий, полупроводниковые материалы с широкой запрещенной зоной считаются идеальными материалами для солнцезащитных фотоприемников, которые имеют лучшую селективность по ультрафиолетовому свету и лучшую адаптируемость в суровых условиях [2]. Многие исследователи были сосредоточены на AlGaN, MgZnO и Ga 2 О 3 Солнечные фотоприемники DUV [2,3,4]. Ga 2 О 3 привлекает большое внимание благодаря своим превосходным оптическим свойствам, химической стабильности и высокой прочности с шириной запрещенной зоны 4,8 эВ, который является многообещающим материалом для солнечных слепых фотоприемников [5,6,7,8,9,10,11,12, 13]. Ga 2 О 3 тонкие пленки были получены на инородных подложках методами молекулярно-лучевой эпитаксии (MBE) [5, 6], радиочастотного магнетронного распыления (RFMS) [7], импульсного лазерного осаждения (PLD) [8, 9], осаждения атомных слоев (ALD). ) [10], парофазная эпитаксия галогенидов (HVPE) [11], химическое осаждение из паровой фазы металлоорганических соединений (MOCVD) [12] и золь-гель метод [13]. Среди этих методов осаждение RFMS широко используется для изготовления различных пленок из-за его преимуществ, заключающихся в простоте управления, высокой эффективности, безвредности и низкой стоимости. Поэтому мы использовали этот метод для выращивания Ga 2 О 3 тонкие пленки для солнцезащитных фотоприемников DUV.
В этой работе poly-Ga 2 О 3 Слепые фотоприемники изготавливались на сапфировой подложке. Показано, что атомы Al встраиваются из сапфировой подложки в Ga 2 . О 3 сформировать (Al x Ga 1– x ) 2 О 3 после посттермического отжига. Структурные свойства, замещающий состав Al x , оптические свойства и характеристики фотоприемника поли- (Al x Ga 1– x ) 2 О 3 были исследованы пленки с различными температурами постотжига (PAT).
Метод
В этом эксперименте поли-Ga 2 О 3 тонкие пленки выращивали на однополированных (0006) -ориентированных сапфировых подложках с помощью RFMS при 600 ° C с мощностью распыления 120 Вт. Рабочее давление поддерживали постоянным на уровне 5 мТорр, а поток аргона составлял 20 см3 на протяжении всего осаждения. Толщина пленок, нанесенных на сапфир, составила около 164 нм. После осаждения проводился посттермический отжиг в атмосфере воздуха в течение 1 ч при 800 ° C, 900 ° C, 1000 ° C и 1100 ° C. После отжига образцы охлаждали до комнатной температуры со скоростью 100 ° C / мин. Затем 30 нм Ti и 80 нм Ni были нанесены магнетронным распылением в качестве электрода. После формирования рисунка и травления встречно-штыревых электродов металлические контакты на Ga 2 О 3 были сформированы быстрым термическим отжигом при 470 ° C в атмосфере азота [14]. Изготовленный поли-Ga 2 О 3 Фотодетекторы для слепых солнечных лучей имеют встречно-штыревые электроды металл-полупроводник-металл (МСМ), как показано на рис. 1. Длина, ширина и расстояние между пальцами составляли 500 мкм, 6 мкм и 15 мкм соответственно, а общая длина пальцы 1,8 см.
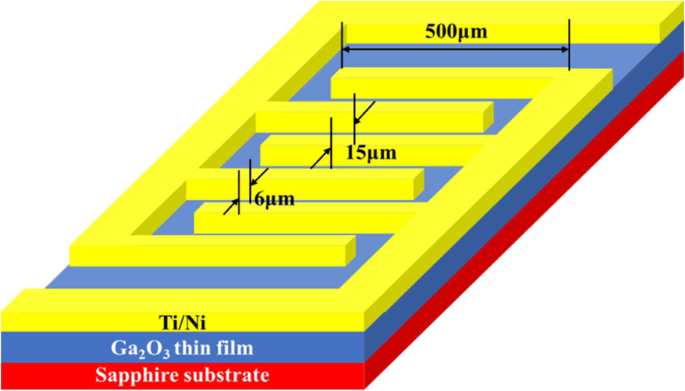
Схема фотоприемника на основе поли-Ga 2 О 3 тонкая пленка
Результаты и обсуждение
Структурные свойства Ga 2 О 3 Пленки исследовались методом рентгеновской дифракции высокого разрешения (HRXRD). На рис. 2 представлены кривые HRXRD для образцов после осаждения и отжига при различных температурах. Пики, соответствующие \ (\ left (\ overline {2} 01 \ right) \), (400), (111), \ (\ left (\ overline {4} 02 \ right) \), (600), ( 510) и \ (\ left (\ overline {6} 03 \ right) \) плоскости β-Ga 2 О 3 кристаллы [15] показывают, что Ga 2 О 3 пленка состоит из моноклинного β-Ga 2 О 3 поликристаллический со случайной ориентацией. Образец после осаждения демонстрирует более высокую интенсивность пика для плоскости (400) по сравнению с другими плоскостями. PAT приводит к улучшению интенсивности \ (\ left (\ overline {2} 01 \ right) \), (400), \ (\ left (\ overline {4} 02 \ right) \) и \ (\ left (\ overline {6} 03 \ right) \) самолеты.
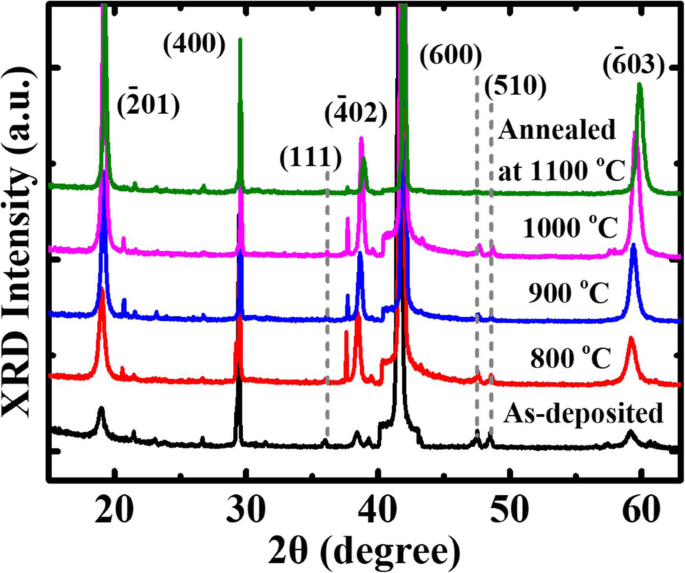
Пики XRD образцов без термического отжига и с последующим термическим отжигом при различных температурах
На рисунках 3a и b показаны пики HRXRD для плоскостей \ (\ left (\ overline {2} 01 \ right) \) и \ (\ left (\ overline {6} 03 \ right) \) соответственно. Полная ширина на полувысоте (FWHM) пика использовалась для расчета размера зерна путем решения формулы Дебая-Шеррера [16] для оценки зависимости кристаллического качества Ga 2 О 3 фильмы на ПАТ. Из таблицы 1 видно, что более высокая температура отжига дает больший размер зерна при увеличении PAT с 800 ° C до 1000 ° C, но размер зерна немного уменьшается при PAT 1100 ° C. Диффузия Al из Al 2 О 3 субстраты в Ga 2 О 3 пленки, прошедшие ПАТ выше 1000 ° C, широко наблюдались [17,18,19]. Как показано на рис. 3c, смещение пиков HRXRD в сторону более высокого угла дифракции связано с тем, что Al из сапфировой подложки диффундирует в Ga 2 О 3 пленка для формирования (Al x Ga 1– x ) 2 О 3 после отжига.
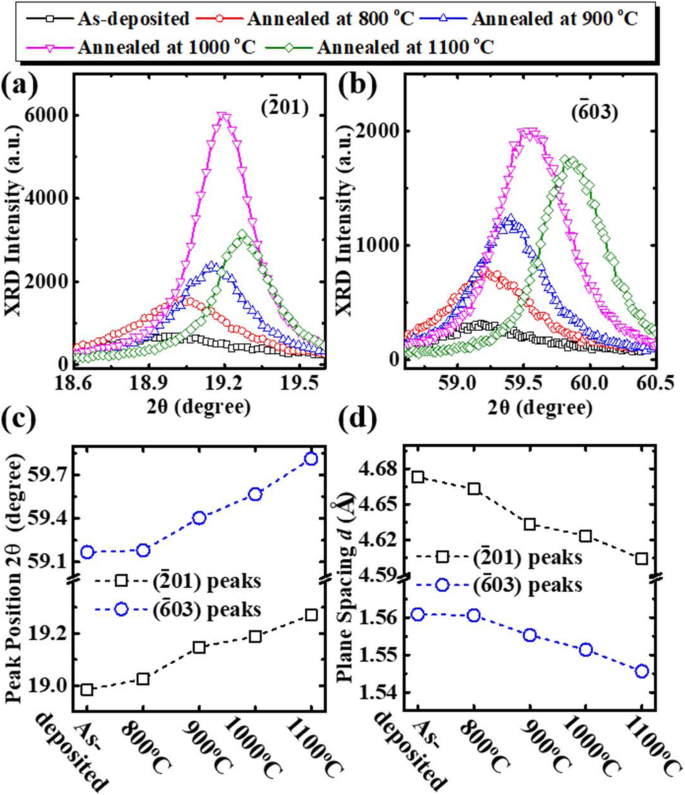
Пики XRD a \ (\ left (\ overline {2} 01 \ right) \) плоскость и b \ (\ left (\ overline {6} 03 \ right) \) плоскость образцов до и после отжига. c положение пика и d расстояние между плоскостями \ (\ left (\ overline {2} 01 \ right) \) и \ (\ left (\ overline {6} 03 \ right) \)
Согласно закону Брэгга, расстояние между плоскостями d плоскости \ (\ left (\ overline {2} 01 \ right) \) и \ (\ left (\ overline {6} 03 \ right) \) плоскости (Al x Ga 1– x ) 2 О 3 рассчитаны и показаны на рис. 3г соответственно. Согласно исх. [20], параметры решетки можно рассчитать с помощью a =(12,21–0,42 x ) Å, b =(3,04–0,13 x ) Å, c =(5,81–0,17 x ) Å, β =(103,87 + 0,31 x ) °. d из \ (\ left (\ overline {6} 03 \ right) \) выражается как [21]
$$ \ frac {1} {d ^ 2} =\ frac {h ^ 2} {a ^ 2 {\ sin} ^ 2 \ beta} + \ frac {k ^ 2} {b ^ 2} + \ frac { l ^ 2} {c ^ 2 {\ sin} ^ 2 \ beta} - \ frac {2 hl \ cos \ beta} {ac \ sin ^ 2 \ beta}, $$ (1)где h =-6, k =0 и l =3. На основании значений на рис. 3d, x поли- (Al x Ga 1– x ) 2 О 3 может быть достигнут. Ширина запрещенной зоны E g из (Al x Ga 1– x ) 2 О 3 можно рассчитать по
$$ {E} _ {\ mathrm {g}} (x) =\ left (1-x \ right) {E} _ {\ mathrm {g}} \ left [{Ga} _2 {O} _3 \ right ] + {xE} _ {\ mathrm {g}} \ left [{Al} _2 {O} _3 \ right] - nx \ left (1-x \ right), $$ (2)где E g [Ga 2 О 3 ] =4,65 эВ, E g [Al 2 О 3 ] =7,24 эВ, n =1,87 эВ [22]. Расчетный x и E g значения поли- (Al x Ga 1– x ) 2 О 3 показаны в Таблице 2. Знак x значение выше 0,30 достигается в образце после PAT при 1100 ° C.
Изображения, полученные с помощью атомно-силового микроскопа (АСМ) на рис. 4, показывают, что значения среднеквадратичной шероховатости поверхности осажденной пленки и образцов, отожженных при 800 ° C и 900 ° C, составляют 3,62 нм, 10,1 нм, и 14,1 нм соответственно. Рекристаллизация, вызванная высоким значением PAT, приводит к большему размеру зерна, что дополнительно подтверждается более шероховатой поверхностью.
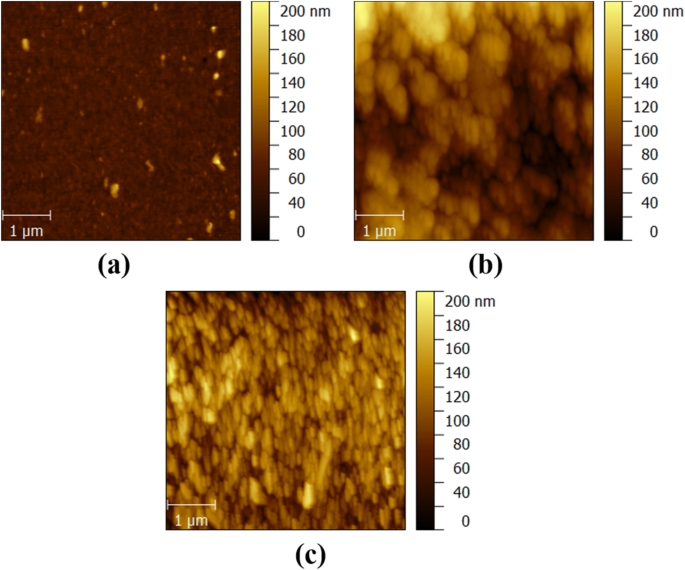
Изображения a , полученные с помощью АСМ как осажденный поли-Ga 2 О 3 на сапфире, b образцы отожжены при 800 ° C, и c 900 ° С
Значения E g из (Al x Ga 1– x ) 2 О 3 Тонкие пленки до и после отжига характеризовались измерением спектров пропускания. Как показано на рис. 5а, отожженные образцы имеют синий сдвиг на краю поглощения по сравнению с осажденным. Более короткий λ приобретается с увеличением PAT из-за включения Al. Га 2 О 3 образцы имеют очень низкий коэффициент пропускания даже в видимом диапазоне, что может быть связано с безызлучательным комплексным поглощением, вызванным дефектами в материалах. Коэффициент поглощения α пленок рассчитывается по [23, 24]
$$ \ alpha =\ left (1 / t \ right) \ ln \ left [{\ left (1-r \ right)} ^ 2 / T \ right], $$ (3)
а Спектры пропускания осажденного и отожженного поли- (Al x Ga 1– x ) 2 О 3 образцы b ( α h ν ) 2 по сравнению с h ν кривые для поли-Ga 2 О 3 образцы. Экстраполяция линейных областей на горизонтальную ось дает оценку E g значения
где T коэффициент пропускания, r - коэффициент отражения, а t толщина пленки. Связь между коэффициентом поглощения α и энергия падающего фотона h ν следует степенному закону формы
$$ \ left (\ alpha h \ nu \ right) =B {\ left (h \ nu - {E} _ {\ mathrm {g}} \ right)} ^ {1/2}, $$ (4)где B - параметр ширины края поглощения [23]. Используя эти формулы, соотношение между h ν и ( α h ν ) 2 можно получить, как показано на рис. 5б. Экстраполируя линейные области графика на горизонтальную ось, E g Значения образцов оцениваются как 4,65 эВ, 4,72 эВ, 4,78 эВ, 4,81 эВ и 5,10 эВ. Как показано в таблице 2, экспериментальный E g значения образцов согласуются с рассчитанными на основе результатов HRXRD.
Чтобы исследовать отзывчивость R и фототок I фото поли- (Al x Ga 1– x ) 2 О 3 фотоприемники, оптические измерения разная освещенность λ от 220 до 300 нм с P свет 0,5 мВт / см 2 . R рассчитывается по
$$ R =\ left ({I} _ {\ mathrm {photo}} - {I} _ {\ mathrm {dark}} \ right) / \ left ({P} _ {\ mathrm {light}} S \ справа), $$ (5)где I темный - темновой ток и S эффективная освещенная площадь. На рисунке 6 показан видимый синий сдвиг максимального значения R . отожженных образцов по сравнению с осажденной пленкой. Это доказывает, что чем больше E g поликристаллических образцов был получен после отжига с диффузией Al из сапфировой подложки в Ga 2 О 3 сформировать (Al x Ga 1– x ) 2 О 3 . R макс отожженного при 1100 ° C устройства составляет 35 мкА / Вт, что меньше, чем 0,037 А / Вт, 0,903 А / Вт и 1,13 мА / Вт, полученные методами МЛЭ [5], PLD [25] и золя -gel метод [26], соответственно, в связи с тем, что поли-Ga 2 О 3 имеет низкий коэффициент пропускания, как показано на рис. 5а. Но по сравнению с устройством на хранении, R макс отожженного при 1000 ° C устройства увеличивается примерно на 500%. Следует отметить, что R устройств уменьшается на длине волны короче, чем на R макс , аналогично [27]. Это может быть связано с потерей энергии в процессе релаксации носителей в случае энергии фотонов выше E g материалов. R макс возрастание с увеличением PAT с 800 ° C до 1000 ° C объясняется увеличением размера зерна пленки.
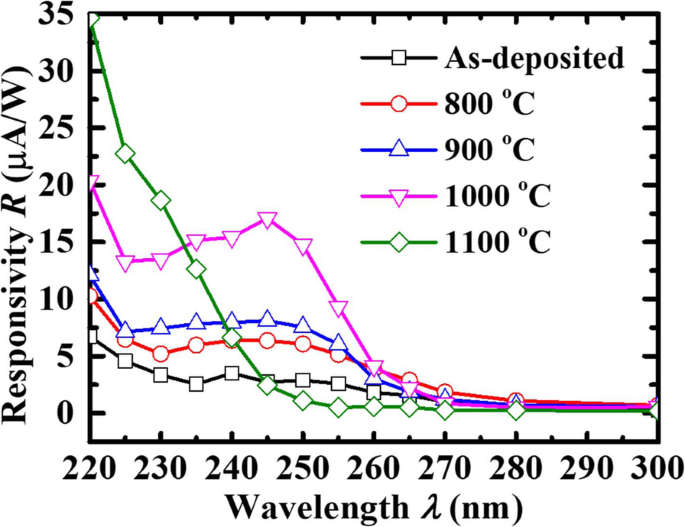
R по сравнению с оптическим освещением λ для поли- (Al x Ga 1– x ) 2 О 3 фотоприемники на V предвзятость от 5 В
На рисунке 7 показан фототок I фото , темновой ток I темный , и PDCR в зависимости от напряжения смещения В предвзятость для фотоприемников при интенсивности освещения 0,5 мВт / см 2 и λ 254 нм. Как показано на рис. 7a, I фото увеличивается почти линейно с V предвзятость . Кроме того, когда температура PAT повышается с 800 ° C до 1000 ° C, фотоприемники получают большее значение I . фото . Но я фото устройства, отожженного при 1100 ° C, ниже, чем у образца после осаждения, из-за того, что энергия фотона меньше, чем у образца, отожженного при 1100 ° C, который не может генерировать фотоносители. Отожженные образцы показывают более высокий I темный чем образец после осаждения, как показано на рис. 7b. Предполагается, что рекристаллизация увеличивает проводимость поли-Ga 2 О 3 , что привело к улучшению как I фото и я темный фотоприемников, а PDCR образца с PAT 1000 ° C выше, чем у других образцов. Можно отметить, что темновой ток образца, отожженного при 900 ° C, больше, чем у других, что может быть приписано увеличению носителей при увеличении PAT, но при дальнейшем увеличении PAT происходит взаимная диффузия Al и Ga. сапфировая подложка, тем самым нарушая проводимость пленки [17].
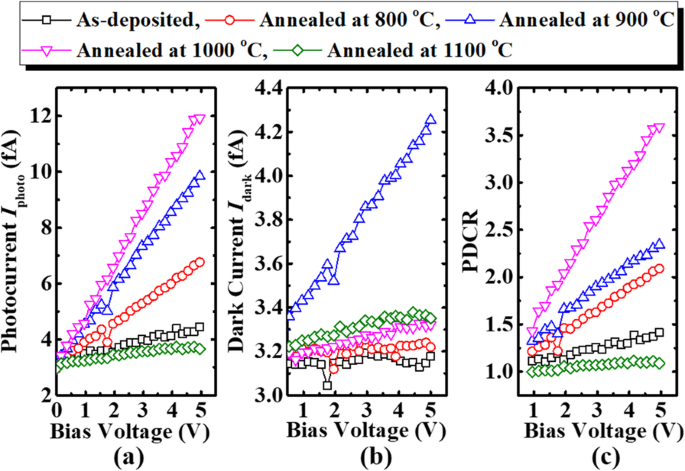
а Я фото - V предвзятость , b Я темный - V предвзятость , и c Характеристики PDCR наплавленного поли- (Al x Ga 1– x ) 2 О 3 пленка и образцы, отожженные при разных температурах при интенсивности освещения 0,5 мВт / см 2 и λ 254 нм
Характеристики фотоотклика фотоприемников показаны на рис. 8а. Освещение с λ 254 нм. P свет , V предвзятость , а период составлял 0,5 мВт / см 2 , 5 В и 5 с соответственно. Есть две процедуры процессов нарастания и затухания:быстрое и медленное. Как правило, компонент с быстрым откликом может быть отнесен к быстрому изменению концентрации носителей, как только включается / выключается свет [28], в то время как фотогенерируемые носители могут быть захвачены уровнями дефектов в запрещенной зоне, что может задерживают сбор носителей во время УФ-освещения и рекомбинации при выключении света, что приводит к компоненту медленного отклика. Для количественного сравнительного исследования фотоприемника, отожженного при различных температурах, процессы нарастания и затухания можно описать уравнением биэкспоненциальной релаксации следующего типа [29]:
$$ I ={I} _0 + {Ce} ^ {- t / {\ tau} _1} + {De} ^ {- t / {\ tau} _2}, $$ (6)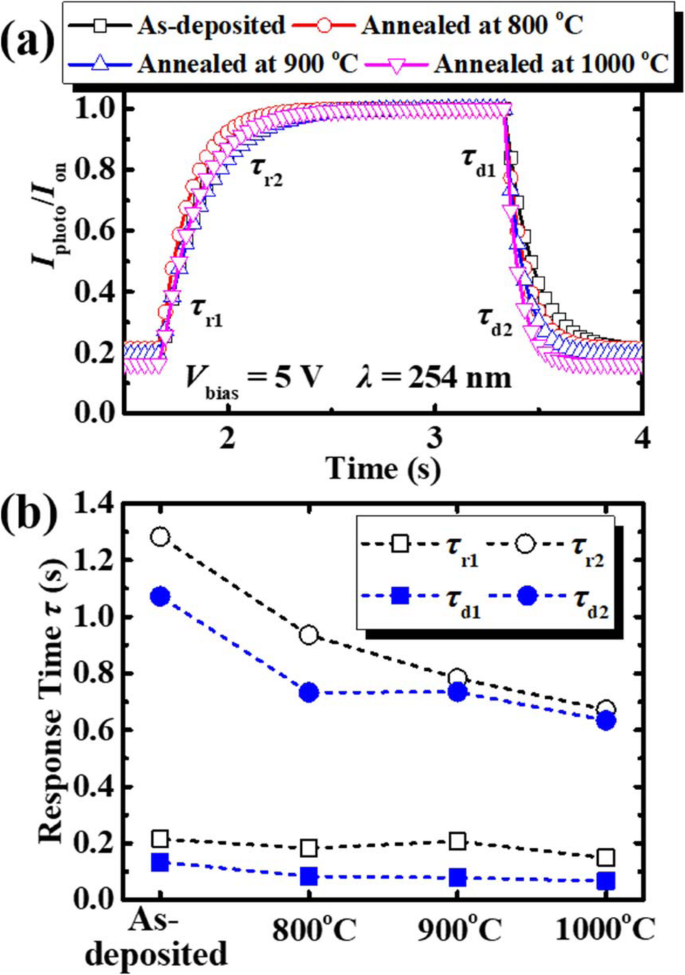
а Зависимость характеристик фотоотклика от времени b время нарастания и спада
где I 0 - установившийся фототок, t время, C и D - константа, τ 1 и τ 2 - две постоянные времени релаксации. Время нарастания τ r1 и τ r2 соответствуют быстрому и медленному отклику соответственно, а время затухания τ d1 и τ d2 каждого фотодетектора рассчитываются, как показано в Таблице 3. Хорошо видно, что время отклика уменьшается после процесса отжига. Время нарастания τ r1 уменьшается с 0,215 с до 0,148 с, а время затухания τ d1 уменьшено с 0,133 до 0,067 с. Это объясняется тем, что процесс отжига снижает концентрацию кислородных вакансий в поли-Ga 2 О 3 фильм [28]. Прямой переход становится основным источником фото-генерируемых несбалансированных несущих, поэтому время быстрого отклика уменьшается. Время затухания τ d2 уменьшается с 1,072 до 0,634 с, что указывает на меньшее количество кислородных вакансий и других дефектов в отожженных образцах, поскольку постоянная времени переходного распада обычно определяется этими ловушками. Кроме того, увеличенный размер зерна с помощью PAT может сократить время транспортировки фотоносителей, улучшая характеристики времени релаксации устройств.
В таблице 4 показано сравнение I темный , время нарастания ( τ r ) и время затухания ( τ d ) солнцезащитных фотоприемников на основе β-, α- и ε-Ga 2 О 3 тонкие пленки, синтезированные RFMS [30] и другими методами [2, 6, 26, 31,32,33,34]. Как видно, устройство имеет низкий темновой ток и быстрое время отклика, что затруднительно, но изготовленный нами фотодетектор обеспечивает низкий темновой ток и быстрое время отклика.
Выводы
Таким образом, мы депонировали поли-Ga 2 О 3 тонкая пленка магнетронным напылением на сапфировую подложку c-плоскости с последующим термическим отжигом при различной температуре; затем ультрафиолетовый поли-Ga 2 О 3 фотоприемник изготовлен. По сравнению с осажденным Ga 2 О 3 тонкая пленка, отожженные образцы имеют больший размер зерна и более широкую запрещенную зону из-за рекристаллизации и диффузии Al в Ga 2 О 3 . R макс Отожженного при 1000 ° C устройства увеличивается примерно на 500% по сравнению с устройством после осаждения, а образец, отожженный при 1000 ° C, показывает низкий темновой ток 0,0033 нА при смещении 5 В. Кроме того, фотодетектор с защитой от солнечных лучей изготовленная на пленке, отожженной при 1000 ° C, показывает быстрое время отклика с временем нарастания и затухания 0,148 с и 0,067 с, соответственно. Эти результаты полезны для изготовления фотоприемников DUV с низким темновым током и малым временем отклика.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой статьи, включены в статью.
Сокращения
- Ga 2 О 3 :
-
Оксид галлия
- PAT:
-
Температура после отжига
- DUV:
-
Глубокий ультрафиолет
- MBE:
-
Молекулярно-лучевая эпитаксия
- RFMS:
-
Радиочастотное магнетронное распыление
- PLD:
-
Импульсное лазерное напыление
- ALD:
-
Осаждение атомного слоя
- HVPE:
-
Эпитаксия из паровой фазы галогенидов
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- MSM:
-
Металл-полупроводник-металл
- HRXRD:
-
Дифракция рентгеновских лучей высокого разрешения
- FWHM:
-
Полная ширина на половине максимальной
- AFM:
-
Атомно-силовой микроскоп
- RMS:
-
Среднеквадратичное
Наноматериалы
- Влияние ESL на производительность конденсатора
- Влияние pH липосом в микросреде на химическую стабильность загруженного лекарства
- Влияние отношения Li / Nb на получение и фотокаталитические характеристики соединений Li-Nb-O
- Эффекты взаимодействия в сборке магнитных наночастиц
- Влияние толщины бислоя на морфологические, оптические и электрические свойства наноламинатов Al2O3 / ZnO
- Видимые световые фотокаталитические характеристики нанокомпозитов ZnO / g-C3N4, легированных азотом
- Фотодетектор с регулируемой длиной волны на основе одиночного нанопояса CdSSe
- Влияние вариаций травления на формирование каналов Ge / Si и производительность устройства
- Влияние последующего термического отжига на оптические свойства пленок InP / ZnS с квантовыми точками
- Основы ножниц:влияние качества ножей на производительность стрижки



