Однородные квантовые точки индия, выращенные на поверхности эпитаксиального слоя InGaN в результате двухэтапного охлаждения
Аннотация
Предложен новый метод выращивания квантовых точек индия (In QD) на поверхности эпитаксиального слоя InGaN методом MOCVD. Было обнаружено, что квантовые точки In однородного размера образуются на поверхности слоя InGaN при двухступенчатом процессе охлаждения. В результате анализа мы обнаружили, что образование квантовых точек In на поверхности происходит из-за реакции между поверхностным слоем, обогащенным In, и газом-носителем H 2 в период более низких температур в двухступенчатом процессе охлаждения. В то же время, поскольку плотность квантовых точек In во многом зависит от поверхностного слоя InGaN, это дает нам возможность напрямую изучить свойства поверхности слоя InGaN.
Введение
В последние годы материалы на основе (Al, In, Ga) N привлекли к себе большое внимание благодаря их успешному применению в светоизлучающих устройствах (LED) и лазерных диодах (LD) [1,2,3,4, 5]. InGaN имеет высокое поглощение, широкий спектральный охват и радиационную стойкость, и он всегда используется в качестве активного материала для изготовления оптоэлектронных устройств. Однако выращивание высококачественных материалов InGaN является большой проблемой из-за ряда проблем. Например, большая разница в постоянной решетки между InN и GaN приводит к образованию трещины в твердофазной смешиваемости [6,7]. Относительно высокое давление пара InN по сравнению с GaN приводит к низкому включению индия в сплав InGaN [8]. Кроме того, большая разница в энтальпиях образования InN и GaN вызывает сильную сегрегацию поверхности индия на фронте роста [9]. С другой стороны, в процессе роста слоя InGaN всегда существует слой, богатый In на поверхности из-за эффекта вытягивания, который будет влиять на качество последующего слоя множественной квантовой ямы (МКЯ) InGaN / GaN за счет введение атомов индия при последующем росте слоя GaN [10]. Чтобы добиться высокой производительности оптоэлектронных устройств на основе InGaN, мы должны преодолеть все эти препятствия. В ходе исследования рост одного слоя InGaN всегда используется для оптимизации параметра роста МКЯ InGaN / GaN. В этой статье мы иногда обнаруживали, что квантовые точки In однородного размера образуются на поверхности одного слоя InGaN при двухступенчатом процессе охлаждения, который заменяет обычный одноэтапный процесс охлаждения после роста одного слоя InGaN. Путем анализа мы обнаружили, что образование квантовых точек In связано с богатым In слоем, существующим на поверхности слоя InGaN, и это дает нам возможность непосредственно изучить поверхностный слой, богатый In.
Эксперимент
Образцы, использованные в этом исследовании, представляли собой одиночные слои InGaN, выращенные на сапфировой подложке с c-плоскостью с помощью AIXTRON 6 × 2 в реакторе для металлоорганического химического осаждения (MOCVD) в реакторе N 2 Атмосфера. Триметилгаллий (TMGa), триметилиндий (TMIn) и аммиак (NH 3 ) используются в качестве исходных прекурсоров Ga, In и N соответственно. Одиночные слои InGaN толщиной менее 60 нм и содержанием индия менее 15% были выращены на непреднамеренно легирующем слое GaN толщиной 2 мкм после выращивания буферного слоя GaN толщиной 25 нм на сапфировой подложке. Схема конструкции представлена на рис. 1. H 2 и N 2 используются в качестве газа-носителя в разные периоды процесса роста. Обычно N 2 используется в качестве газа-носителя в процессе роста слоя InGaN, поскольку H 2 оказывает коррозионное воздействие на слой InGaN, что значительно снижает эффективность включения In [11, 12]. Однако H 2 как газ-носитель может значительно улучшить поверхностную подвижность атомов и снизить концентрацию примесей. Следовательно, H 2 предпочтительно использовать в качестве газа-носителя во время роста слоя GaN для улучшения качества кристаллов. Обычно, когда рост слоя InGaN завершается, температуру сразу понижают до комнатной в атмосфере азота. Здесь мы называем такой процесс «одноэтапным охлаждением». В этой статье после роста слоя InGaN был применен так называемый двухэтапный процесс охлаждения, в котором температура была понижена до 400 ° C в атмосфере азота в первый период охлаждения, а затем снижена до комнатной температуры. в H 2 Атмосфера. Для характеристики образцов InGaN используются рентгеновская дифракция высокого разрешения (XRD), атомно-силовая микроскопия (AFM), сканирующий электронный микроскоп (SEM) и энергодисперсионный спектрометр (EDS).
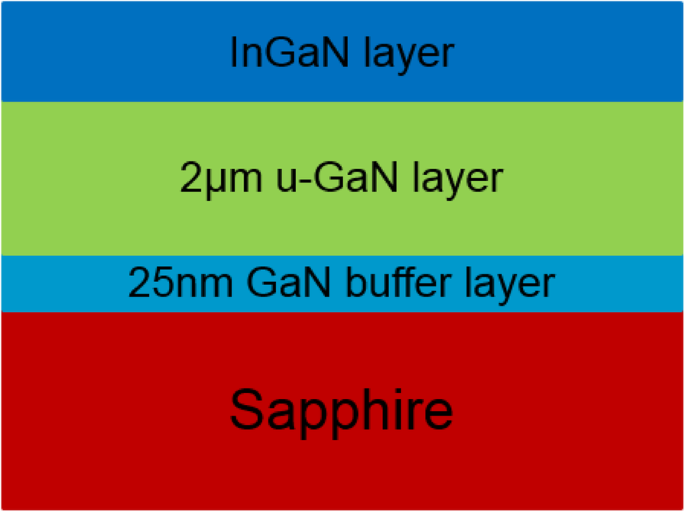
Структурная схема одиночного слоя InGaN, выращенного на шаблоне GaN с использованием сапфировой подложки
Результат и обсуждение
Аномальная топография поверхности слоя InGaN была обнаружена при выращивании на одном слое InGaN на шаблоне GaN с двухступенчатым процессом охлаждения. Морфология поверхности АСМ образцов InGaN с одностадийным и двухступенчатым охлаждением соответственно показана на рис. 2а и б. На рис. 2а показана типичная морфология поверхности эпитаксиального слоя InGaN, из которой мы можем обнаружить, что слой InGaN имеет четкие ступенчатые двухмерные потоки роста. В то же время на поверхности образца существует множество трехмерных островков, которые связывают с линиями винтовой дислокации в слое GaN. Также можно увидеть, что на вершине каждого трехмерного островка есть темная точка, которая, как было доказано, представляет собой V-образную ямку, образованную вдоль винтовой дислокации [13, 14]. В отличие от рис. 2а, кроме ступенчатой поверхности потока и трехмерных островков, на рис. 2б также имеется много квантовых точек одинакового размера (маленькие белые точки на рисунке). В сочетании со вставкой на рис. 2b в левом верхнем углу, которая представляет собой трехмерную диаграмму поверхности, мы можем получить средний размер этих квантовых точек примерно 100 нм × 100 нм, среднюю высоту примерно 20 нм и плотность около 1,6 × 10 8 см −2 . Следует отметить, что основное различие между этими двумя разными способами охлаждения образца заключается в том, что H 2 используется в качестве газа-носителя вместо N 2 во втором периоде охлаждения двухступенчатого процесса охлаждения. Следовательно, образование квантовых точек на поверхности слоя InGaN связано с газом-носителем H 2 в процессе низкотемпературного охлаждения.
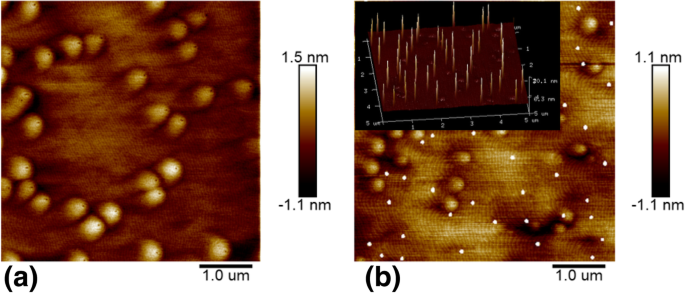
АСМ топография поверхности a Образец InGaN с одноступенчатым охлаждением и б Образец InGaN с двухэтапным процессом охлаждения, на вставке - трехмерная диаграмма поверхности
Чтобы понять, как это происходит при двухэтапном охлаждении образцов InGaN, мы проводим двухэтапный эксперимент по охлаждению на GaN вместо InGaN. Этот слой GaN был выращен при тех же условиях, что и образцы с одним слоем InGaN, которые исследовались в данной работе, то есть при относительно более низкой температуре роста 740 ° C и N 2 используется в качестве газа-носителя. Топография поверхности слоя GaN после двухступенчатого охлаждения показана на рис. 3а. Мы можем обнаружить, что на поверхности отсутствуют какие-либо квантовые точки, а поверхность такая же, как и образцы слоя GaN, выращенные методом одностадийного охлаждения MOCVD, о чем широко сообщалось [15]. Кроме того, мы проверили, что произойдет, если использовать двухэтапный процесс охлаждения для образца слоя InGaN с очень низким содержанием индия, в котором содержание индия составляет всего 1%. На рис. 3b показана морфология поверхности АСМ этого образца InGaN с низким содержанием индия после двухступенчатого процесса охлаждения. Обнаружено, что плотность квантовых точек имеет очень большое снижение по сравнению с образцом InGaN с высоким содержанием индия, упомянутым выше, в котором содержание индия составляет около 13%. Эти результаты означают, что образование квантовых точек на поверхности слоя InGaN в двухступенчатом процессе охлаждения коррелирует с атомом In, и эти квантовые точки могут быть одним из состояний In, которые образуются из-за реакции между InGaN. слой и газ-носитель H 2 в процессе второго охлаждения.
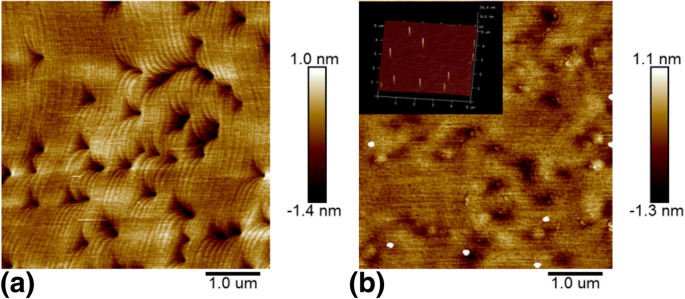
АСМ топография поверхности образцов с двухступенчатым охлаждением. а Слой GaN. б Слой InGaN с содержанием In 1%
Предыдущие исследования показали, что в процессе роста слоя InGaN существуют три различных состояния атомов In [16,17]. Первый - это атомы In в кристаллической решетке сплава InGaN, которая является основной частью и целевым продуктом роста слоя InGaN; второй - сплав InN, который всегда появляется на поверхности слоя InGaN; и третья - капля In, которая может появиться в некоторых особых условиях роста. Различные состояния атома In можно различить по спектрам XRD, поскольку они имеют разные дифракционные пики в режиме сканирования ω / 2θ. Чтобы определить, к какому состоянию In принадлежат эти точки, было проведено XRD-измерение образцов InGaN с одно- или двухступенчатым процессами охлаждения. На рис. 4 показаны типичные спектры XRD ω / 2θ для образцов с двухступенчатым охлаждением (красная линия) и одноступенчатым (синяя линия). Для образцов с двухступенчатым охлаждением обнаружено три характерных пика, а для образцов с одноступенчатым охлаждением - только два. Таким образом, дополнительный характеристический пик для образцов с двухступенчатым охлаждением может представлять собой квантовые точки, которые образуются на поверхности. Два характерных пика, которые обычно существуют в этих образцах, расположены около 33,5 ° и 34,5 °. Они принадлежат кристаллу InGaN и GaN соответственно. В то время как дополнительный характеристический пик, расположенный при 2θ =32,8 °, был подтвержден как исходящий от капли In [16, 17]. Таким образом, мы можем сделать вывод, что квантовые точки, которые мы наблюдали на поверхности InGaN при двухступенчатом процессе охлаждения, - это капля In. Чтобы подтвердить этот вывод, SEM-измерения были проведены на образцах с двухступенчатым процессом охлаждения, результат показан на рис. 5a, из которого мы также можем найти точки, существующие на поверхности. Чтобы идентифицировать эти точки, EDS была сделана в том же месте, на рис. 5b – d показано распределение атомов на поверхности для In, Ga и N, соответственно, из которого мы можем получить, что атомы Ga и N равномерно распределены на поверхность, в то время как концентрация атомов In на точках намного больше, чем в окружающей среде, что означает, что эти точки богаты In. Таким образом, в сочетании с приведенным выше анализом мы можем сделать вывод, что газ-носитель H 2 может реагировать со слоем InGaN при низкой температуре и образовывать капли In на поверхности.
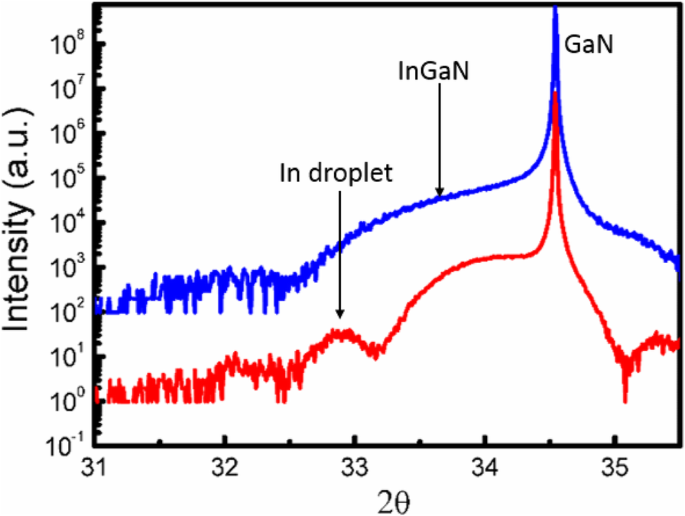
Спектры XRD для образца с двухступенчатым охлаждением (красная линия) и одноступенчатым охлаждением (синяя линия)
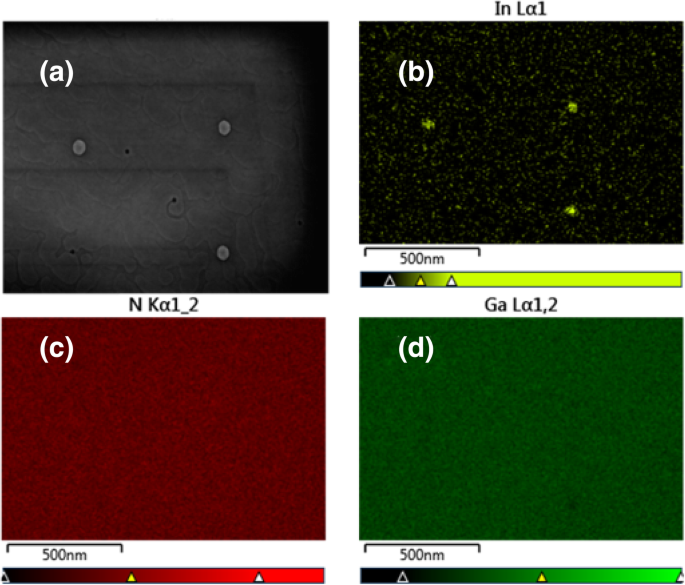
а СЭМ-фотография поверхности образца с двухэтапным процессом охлаждения, b - г - результат элементного анализа EDS для атомов In, N и Ga соответственно
Сообщалось, что на поверхности эпитаксиального слоя InGaN часто образуется богатый индием слой из-за эффекта поверхностного натяжения [10]. В нашем эксперименте образцы охлаждались непосредственно до комнатной температуры после роста одного слоя InGaN, что означает, что обогащенный In поверхностный слой все еще существует на поверхности в процессе охлаждения. Следовательно, есть две возможности происхождения атома In для наблюдаемых нами квантовых точек In:слой InGaN и поверхностный слой, обогащенный In, соответственно. Чтобы узнать, каково происхождение атома In квантовых точек In и как происходит реакция, были проведены дальнейшие эксперименты. Известно, что процесс отжига может стереть богатый In слой [18]. Поэтому мы берем процесс термического отжига для образцов InGaN перед двухступенчатым процессом охлаждения. Время процесса термического отжига установлено равным 60 с, а температура составляет около 800 ° C, что на 60 ° выше, чем температура роста слоя InGaN. АСМ-топография образца InGaN с процессом отжига перед двухступенчатым процессом охлаждения показана на рис. 6, очевидно, что на поверхности нет квантовых точек. Однако по сравнению с рис. 2а можно обнаружить большое изменение топографии поверхности, поверхность становится более шероховатой. Отсутствие квантовых точек In на поверхности показывает, что слой InGaN не будет образовывать квантовые точки In с H 2 во втором процессе охлаждения, поскольку термический отжиг может стереть только богатый In слой. Таким образом, формирование квантовой точки In на поверхности слоя InGaN в двухступенчатом процессе охлаждения происходит из-за реакции между поверхностным слоем, обогащенным In, и газом-носителем H 2 в низкотемпературном диапазоне.
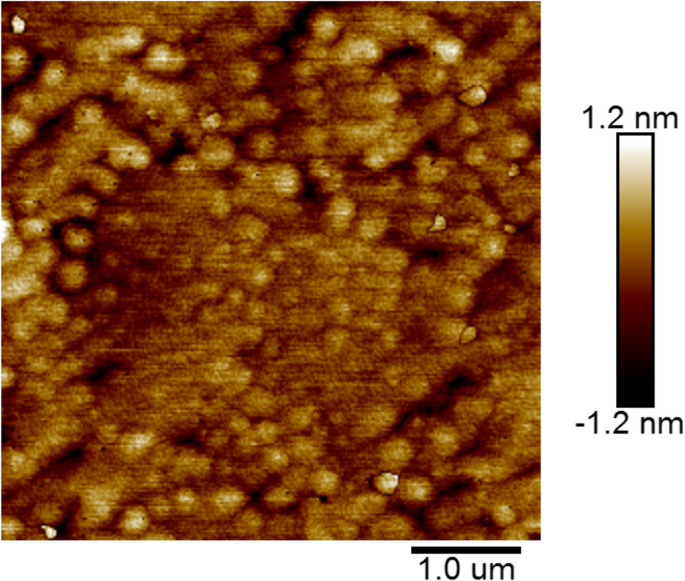
Топография поверхности слоя InGaN с помощью АСМ после термического отжига перед двухступенчатым охлаждением.
Разъедающее действие H 2 о росте слоя InGaN было много сообщений. Известно, что H 2 может препятствовать включению атомов In в решетку [19, 20], и это основная причина, почему обычно только N 2 используется в качестве газа-носителя при выращивании слоев InGaN методом MOCVD. Разъедающее действие H 2 на слое InGaN можно рассматривать как обратный процесс роста слоя InGaN, который может быть выражен следующей химической реакцией:
$$ {3 \ mathrm {H}} _ 2 + 2 \ mathrm {In} \ mathrm {N} \ to 2 \ mathrm {In} + {2 \ mathrm {NH}} _ 3 $$Образование квантовых точек In в двухступенчатом процессе охлаждения можно рассматривать как своего рода коррозионный эффект, но есть некоторые различия между высокой температурой (для выращивания InGaN с H 2 ) и низкой температуре (для охлаждения InGaN и формирования квантовых точек In с H 2 ). При высокой температуре атом In, образовавшийся в результате коррозионного воздействия на поверхность, имеет достаточно энергии, чтобы уйти через поверхностный пограничный слой, что снижает эффективность включения In. Однако при низкой температуре (ниже 400 ° C) наши результаты показывают, что H 2 оказывает коррозионное воздействие только на поверхностный слой с высоким содержанием инородных частиц, поскольку этот слой более нестабилен, чем слой InGaN. С другой стороны, поскольку температура ниже 400 ° C, атомы In, образующиеся на поверхности, могут гораздо реже выходить через границу поверхности вовремя, поэтому они будут мигрировать по поверхности образца, а затем образовывать капли In на поверхности.
В нашем исследовании, поскольку формирование квантовых точек In связано со слоем с высоким содержанием In на поверхности InGaN, они могут напрямую предоставить некоторую информацию о поверхностном слое InGaN, обогащенном In. Образцы слоя InGaN с различным содержанием и толщиной In используются для проведения экспериментов по двухступенчатой охлаждающей обработке. На рис. 7 показана топография поверхности слоев InGaN с различным содержанием и толщиной In. Содержание In составляет 7,65%, 8,45% и 9,6% соответственно для образцов A, B и C, а толщина слоя InGaN для этих трех образцов почти одинакова (около 13,4 нм). Из морфологии поверхности АСМ образцов A, B и C мы можем обнаружить, что плотность квантовых точек In увеличивается с увеличением содержания In в слое InGaN. А плотность КТ составляет около 2,4 × 10 7 см −3 , 4,8 × 10 7 см −3 , и 9,2 × 10 7 см −3 соответственно для образцов A, B и C, а размер квантовых точек для этих образцов практически одинаков. С другой стороны, образец D имеет такое же содержание In, что и образец A (7,65%), а его толщина составляет около 41 нм. Сравнивая поверхность для двух образцов A и D, становится ясно, что плотность квантовых точек In увеличивается с увеличением толщины слоя InGaN. Из нашего анализа, упомянутого выше, выяснилось, что образование этих квантовых точек In вызвано реакцией H 2 с богатым поверхностным слоем при низкой температуре. Таким образом, тенденция к изменению плотности квантовых точек In может отражать состояние обогащенного In поверхностного слоя, т. Е. Нестабильные атомы In, существующие в поверхностном слое, обогащенном In, они увеличиваются вместе с увеличением содержания In и толщины InGaN. слой. Этот результат согласуется с предыдущими теоретическими исследованиями, которые показали, что содержание In в поверхностном слое, обогащенном In, связано с содержанием In и толщиной слоев InGaN [21]. Это также доказывает, что механизм образования квантовых точек In действительно связан с поверхностью слоя, богатого In.
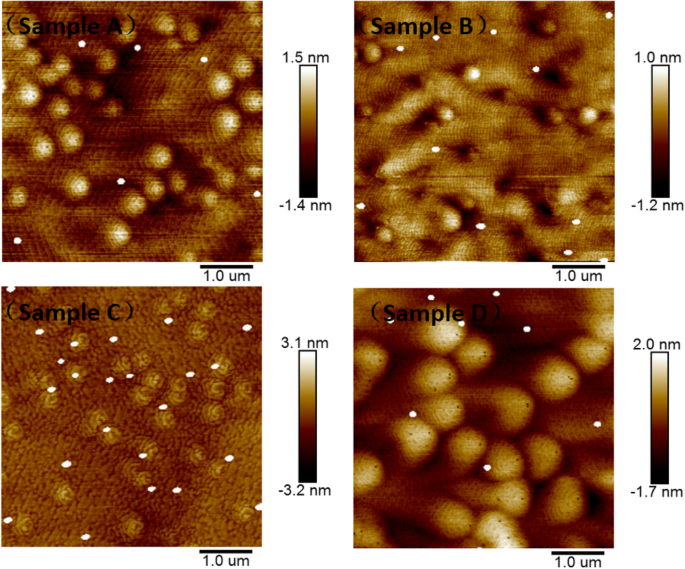
Топография поверхности слоев InGaN с помощью АСМ a , b , c , и d с разным содержанием и толщиной (см. текст)
Заключение
В этой статье мы представили новый метод получения квантовых точек In однородного размера на поверхности слоя InGaN. Мы обнаружили, что КТ In однородного размера формируются на поверхности слоя InGaN при двухступенчатом процессе охлаждения. Путем подробного анализа мы обнаружили, что образование квантовых точек In на поверхности происходит из-за реакции между поверхностным слоем, обогащенным In, и газом-носителем H 2 при низкой температуре. В то же время наши эксперименты показывают, что H 2 оказывает коррозионное воздействие на поверхностный слой, богатый In, только при температуре ниже 400 ° C, и этот коррозионный процесс будет формировать квантовые точки In на поверхности. С другой стороны, поскольку образование In QD тесно связано с богатым In слоем на поверхности, такой процесс может предоставить нам способ непосредственно изучить свойства этого слоя.
Метод
Цель данной статьи - представить новый метод получения In КТ однородного размера на поверхности слоя InGaN. Образцы, использованные в этом исследовании, были выращены на AIXTRON 6 × 2 в моноблочном реакторе для химического осаждения металлоорганических соединений (MOCVD). Для характеристики образцов InGaN используются дифракция рентгеновских лучей высокого разрешения (XRD), атомно-силовая микроскопия (AFM), сканирующий электронный микроскоп (SEM) и энергодисперсионный спектрометр (EDS). Все участники исследования - ученые из Университета Китайской академии наук Китая.
Доступность данных и материалов
Наборы данных, использованные и / или проанализированные в ходе текущего исследования, доступны у соответствующего автора по разумному запросу.
Сокращения
- AFM:
-
Атомно-силовая микроскопия
- EDS:
-
Энергодисперсионный спектрометр
- GaN:
-
Нитрид галлия
- В QD:
-
Квантовые точки индия
- InGaN:
-
Нитрид индия-галлия
- InN:
-
Нитрид индия
- LD:
-
Лазерный диод
- Светодиод:
-
Светоизлучающее устройство
- MOCVD:
-
Металлоорганическое химическое осаждение
- MQW:
-
Множественная квантовая яма
- NH 3 :
-
Аммиак
- QD:
-
Квантовые точки
- SEM:
-
Сканирующий электронный микроскоп
- TMGa:
-
Триметилгаллий
- TMIn:
-
Триметилиндий
- XRD:
-
Рентгеновская дифракция
Наноматериалы
- N, N-диметилформамид, регулирующий флуоресценцию квантовых точек MXene для чувствительного определения Fe3 +
- Дизайн эмиссионного слоя для электронных умножителей
- Квантовые точки висмута в отожженных квантовых ямах GaAsBi / AlAs
- Аморфные кремниевые нанопроволоки, выращенные на пленке оксида кремния путем отжига
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Дефекты на поверхности нанолюминофора MgAl2O4, легированного титаном
- Контроль роста высокоднородных нанопроволок селенида индия (In2Se3) с помощью процесса быстрого термического о…
- Изготовление и характеристика ZnO Nano-Clips с помощью процесса, опосредованного полиолом
- Межзонная фотопроводимость метаморфных квантовых точек InAs / InGaAs в окне 1,3–1,55 мкм
- Ключевые факторы, влияющие на результаты процесса шлифования поверхностей



