Влияние те-допинга на бескатализаторные нанопровода VS InAs
Аннотация
Мы сообщаем о росте нанопроволок InAs без катализатора, легированных Te, методом молекулярно-лучевой эпитаксии на кремниевых (111) подложках. При повышении уровня легирования наблюдались изменения морфологии проволоки, т.е. уменьшение длины и увеличение диаметра. Анализ кристаллической структуры, основанный на просвечивающей электронной микроскопии, а также на дифракции рентгеновских лучей, показывает увеличение соотношения сегментов цинковой обманки / (вюрцит + цинковая обманка), если Te предоставляется в процессе роста. Кроме того, электрические двухточечные измерения показывают, что повышенное легирование Те приводит к увеличению проводимости. Две сопоставимые серии роста, различающиеся только парциальным давлением As примерно на 1 × 10 −5 Торр, при сохранении всех остальных параметров постоянными, были проанализированы для различных уровней легирования Те. Их сравнение показывает, что кристаллическая структура сильно страдает, а усиление проводимости более отчетливо для проволоки, выращенной при сравнительно более высоком парциальном давлении As.
Фон
Нанопроволоки (НН) привлекли заметное внимание в течение последнего десятилетия, поскольку они считаются многообещающим строительным блоком для новых и будущих технологий. Их технические применения разнообразны:от полевых транзисторов и оптических устройств до солнечных элементов [1, 2]. Широкая применимость ННК основана на их замечательных характеристиках, таких как высокое удлинение, сверхнизкое рассеяние мощности и, в случае InAs, отсутствие барьера Шоттки на границе раздела с металлическими контактами [3,4,5] . Последнее связано с тем, что InAs имеет поверхностный слой накопления, обеспечивающий омический контакт [6]. С физической точки зрения ННК InAs обладают выдающимися свойствами, а именно высокой подвижностью электронов [7], низкой эффективной массой [8], большим g-фактором [9] и сильной спин-орбитальной связью Рашбы [10, 11]. Благодаря этому они стали важным элементом исследований, связанных с квантовой информацией [5, 12, 13, 14].
InAs ННК обычно выращивают методом выращивания пар-жидкость-твердое тело (VLS) с использованием капель золота в качестве катализатора. Использование Au имеет как минимум два недостатка. С одной стороны, он включает в себя непреднамеренную примесь в ННК, ухудшающую их свойства материала [2, 15, 16], с другой стороны, интеграцию уже продемонстрированных важных приложений, таких как ННК полевые транзисторы (FET) [17], Туннельные полевые транзисторы [18], фотоприемники [19] и т. д. по кремниевой технологии невозможны. Таким образом, в рамках данного сообщения был применен бескатализаторский рост в режиме пар-твердое тело (VS), разработанный ранее [20]. Часть фазы кубической цинковой обманки (ZB), которая является стабильной фазой в объемных материалах III-V, фаза гексагонального вюрцита (WZ) также присутствует в нанопроволоках. Часто сообщается о политипизме ZB-WZ и других дефектах, таких как двойники вращения и дефекты упаковки. Фазово-чистые, почти свободные от дефектов упаковки InAs ННК могут быть получены путем выращивания VLS с помощью золота [21, 22], но не с использованием метода VS без катализатора [23,24,25]. Эти дефекты отрицательно сказываются на транспортных [26, 27] и оптических свойствах [28].
Одним из способов противодействия уменьшению переноса заряда является использование легирования, то есть включение дополнительных носителей. Однако хорошо зарекомендовавшие себя методы легирования, используемые для полупроводниковых слоев соединений AIIIBV, нельзя просто перенести на проволочные структуры. Нанопроволоки имеют аксиальные и радиальные грани роста с различной ориентацией кристаллов и реконструкциями поверхности, что приводит к сильно анизотропному росту, который, как предполагается, влияет на включение примеси. Ситуация осложняется различными режимами роста, пар-жидкость-твердое тело (VLS) и VS, участвующих граней [29, 30] и своеобразным политипизмом кристаллической фазы [31]. Все эти специфические характеристики приводят к неоднородному распределению примеси как в осевом, так и в радиальном направлении [29, 32, 33]. Элемент Si группы IV обычно используется в качестве легирующей примеси n-типа для тонких пленок III-V, выращенных методом МПЭ. Однако известно, что Si проявляет амфотерное поведение, т.е. атомы Si могут быть включены в качестве доноров в узлы катионной решетки или акцепторов в узлах анионной решетки, в зависимости от ориентации подложки и условий роста [34, 35]. Такое поведение наблюдалось также в нанопроволоках, которые коррелировали с различной кристаллической ориентацией граней, участвующих в росте, механизмах роста и температуре роста [29, 36, 37]. С другой стороны, элемент Те группы VI является очень эффективной легирующей добавкой n-типа в эпитаксиальных слоях [38], не представляющей риска амфотерного поведения. Кроме того, Te имеет некоторые другие преимущества:более низкую энергию ионизации по сравнению с другими легирующими добавками n-типа, обычно используемыми в системах материалов III-V, что потенциально приводит к достижению более высоких уровней легирования [39]; более низкий коэффициент диффузии [40] и более слабый эффект памяти по сравнению с другими элементами VI группы, а именно S и Se, которые важны для резких границ раздела [41]. О легирующих свойствах Te исключительно n-типа сообщалось для нанопроволок GaAs, катализируемых Au [42], и самокатализируемых GaAs, показывая потенциал для получения высокой концентрации легирования, а также влияние на морфологию проволоки и кристаллическую структуру [43, 44]. .
В этом сообщении мы исследуем легирование Te в InAs NW, предоставляя информацию о влиянии легирования на морфологию NW и переключение между ZB и структурой WZ в процессе роста VS в присутствии Te. Исследования, основанные на сканирующей электронной микроскопии (СЭМ), показали сильное влияние Те на морфологию ННК. Измерения просвечивающей электронной микроскопии высокого разрешения (HR-TEM) [45] и дифракции рентгеновских лучей (XRD) свидетельствовали об изменении отношения ZB / (WZ + ZB), а электрические двухточечные измерения показали увеличение проводимости с увеличением повышение уровня допинга.
Методы / экспериментальные
ННК InAs выращивались в режиме VS без использования посторонних катализаторов на подложках Si (111) n-типа.
Подготовка субстрата
Перед выращиванием субстраты очищали HF и деионизированной водой. Последовательная обработка перекисью водорода в течение 45 с приводит к образованию пленки SiO2 толщиной в несколько ангстрем, содержащей микроотверстия, которые служат центрами зародышеобразования для роста ННК [20]. После окисления подложки сразу переносили в загрузочный фиксатор, в котором они нагревали до 200 ° C в течение 45 мин. После этого в подготовительной камере был проведен этап дегазации, в ходе которого образцы нагревали при 400 ° C в течение еще 45 минут.
Рост нанопроволок InAs
ННК выращивали при температуре подложки 475 ° C в течение 1:20 ч в камере молекулярно-лучевой эпитаксии (МЛЭ) Omicron Pro 100. Скорость роста 0,1 мкм / ч -1 использовался для роста NW. Мышьяк подавался через установку для крекинга As, а эквивалентное давление пучка As4 (BEP) было отрегулировано до значений 2,3 × 10 –5 Торр и 3,3 × 10 –5 Торр. Первая серия образцов (серия A) была выращена при более высоком парциальном давлении As по сравнению со второй серией выращивания (серия B) (см. Таблицу 1), при сохранении всех остальных параметров постоянными. Теллур подавался во время роста с использованием стехиометрического GaTe. Рабочая температура эффузионной ячейки изменялась от 401 ° C до 562 ° C на основе калибровок, проведенных на слоях GaAs, легированных Te, посредством измерений Холла. Температуры ячейки GaTe 401 ° C, 447 ° C, 500 ° C и 561 ° C соответствуют концентрации носителей около 1 × 10 15 . см −3 , 4 × 10 16 см −3 , 5 × 10 17 см −3 , и 6 × 10 19 см −3 соответственно, в слоях GaAs (100), используемых для калибровки.
Обработка устройства
Для обработки двухточечных контактов наночастицы механически переносились на предварительно структурированную подложку Si, покрытую 200 нм SiO2. Схематическая диаграмма этапов установления контакта представлена в Дополнительном файле 1:Рисунок S1. Перед напылением металла на проволоку было нанесено покрытие центрифугированием с помощью трехслойной системы резиста PMMA 50 K (AR-P639.04), 50 K и 950 K (AR-P679.04), на котором определялась форма контакта. с помощью электронно-лучевой литографии. После проявления область контакта пассивировали разбавленным 3,5% полисульфидом аммония (H 2 О:(NH4) 2 S 3 , 34:1) при 60 ° C в течение 30 мин. Электроды, состоящие из титана 100 нм и золота 40 нм, были нанесены с помощью электронно-лучевого испарителя.
Полный список образцов, исследованных с помощью SEM, TEM, XRD и электрических измерений, представлен в таблице 1. Здесь буквы A, B и C обозначают серию образцов, каждый из которых был выращен при различных парциальных давлениях As, но не считая этого. при равных условиях. Температура GaTe 0 ° C соответствует закрытой заслонке ячейки.
Результаты и обсуждение
Морфология
СЭМ-изображение использовалось для исследования влияния легирования Те на морфологию проволоки. Результаты представлены на рис. 1. Каждая точка данных на графиках представляет собой среднее значение не менее 40 проводов, а шкала ошибок - их стандартное отклонение.

Морфология нанопроволоки. Средняя длина и диаметр нанопроволоки при различных температурах GaTe-ячейки. а Серия A была выращена при парциальном давлении As около 3,3 × 10 –5 . Торр. б Серия B была выращена при парциальном давлении As 2.3 × 10 –5 . Торр. Пунктирные линии служат ориентиром для глаз. На сканирующем электронном микроскопе, показанном на вставке, показаны ННК нелегированного InAs, окруженные кристаллитами, образовавшимися в процессе роста. Масштабная линейка составляет 300 нм и 120 нм соответственно
На рисунке 1а показана морфология проволоки серии A, выращенной при парциальном давлении As около 3,3 × 10 −5 . Торр. Температура ячейки GaTe составляла от 0 ° C до 561 ° C. Принимая во внимание планку погрешности, не наблюдается четкой тенденции изменения диаметра и длины ННК до температуры ячейки 500 ° C. Однако при 561 ° C подача Те явно вредна, что приводит к сильному увеличению диаметра и уменьшению длины ННК. Серия роста B, изображенная на рис. 1b, была выращена при сравнительно более низком давлении As 2.3 × 10 −5 . Торр. На вставке показан примерный вид сбоку на сканирующем электронном микроскопе выращенного образца, показывающий ННК и кластеры InAs на поверхности подложки. Дополнительные изображения СЭМ серий A и B показаны в дополнительном файле 1:Рисунок S2. Здесь был исследован диапазон температур ячейки GaTe от 0 ° C до 462 ° C. Мы наблюдаем уменьшение длины при добавлении Те во время роста для серии B при температуре ячейки 401 ° C. Сравнивая измерения серий A и B в одном и том же температурном интервале, можно заметить, что, в частности, уменьшение длины NW более отчетливо при сравнительно более низких давлениях As (серия B). Однако общая тенденция, то есть уменьшение длины СЗ, наблюдается для обеих серий, а увеличение диаметра - для серии А.
Легирование Si аналогичным образом приводит к увеличению диаметра и уменьшению длины для InAs и GaAs, независимо от метода выращивания (МПЭ или газофазная эпитаксия из металлоорганических соединений (MOVPE)) [46, 47]. Такое же изменение размеров наблюдалось при легировании Te бескатализатором GaAs ННК, выращенных методом МЛЭ [44]. Кажется, что независимо от используемой системы материалов, то есть материалов IIIV, легированных материалами группы IV (InAs / Si, GaAs / Si) или материалами группы VI (GaAs / Te, InAs / Te), наблюдается одна и та же общая тенденция в отношении морфологии.
Te имеет довольно большой ковалентный радиус по отношению к атомам решетки-хозяина и поэтому может действовать как поверхностно-активное вещество [48, 49]. Таким образом, наблюдаемое поведение может быть вызвано пониженной диффузией атомов In из-за Те. Это, в свою очередь, может вызвать увеличение радиального роста и уменьшение длины, поскольку адатомы In задерживаются на пути к вершине ННК, где они контролируют рост [46]. Сравнивая рис. 1a (серия A) и рис. 1b (серия B), мы обнаруживаем, что давление As влияет на то, как добавление Te влияет на морфологию проволоки. Открытие предполагает, что можно было бы противодействовать уменьшающемуся влиянию Те на радиальный и осевой размер провода InAs, увеличивая давление As до определенной степени.
Кристаллическая структура
Влияние примесей Te на кристаллическую структуру исследовали с помощью ПЭМ и XRD. Принятие классификации, используемой Caroff et al. [49], последовательность укладки кристаллов была назначена сегменту ZB (см. Рис. 2a) или WZ (см. Рис. 2d), если последовательность укладки следовала точно за четырьмя бислоями атомов. Это означает, что ... ABCA ... засчитывалась как сегмент ZB, а ... ABAB ... как сегмент WZ. Это показано на рис. 2б, д. Здесь каждая буква представляет собой бислой атомов. Некоторые участки проволоки прерываются дефектами упаковки (ДУ), состоящими из недостающего или избыточного слоя в кристаллической последовательности, как показано на рис. 2c, f. Хотя это и наблюдается редко, ротационное двойникование также присутствует в некоторых сегментах (здесь не показано).
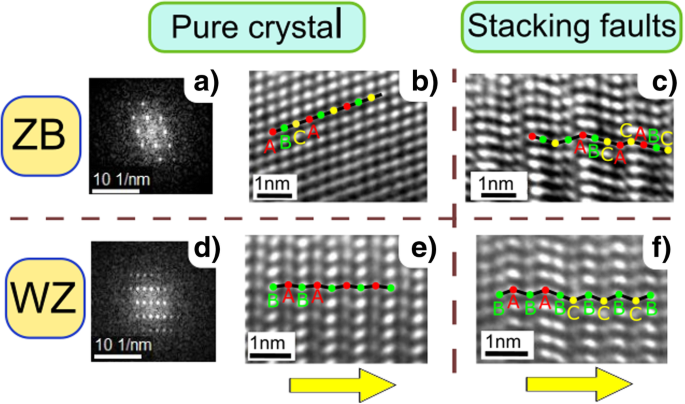
Анализ кристаллической структуры. Изображения ННК InAs с ВР-ПЭМ, иллюстрирующие кристаллические структуры ZB и WZ с дефектами упаковки и без них. Желтые стрелки указывают направление роста [111]. Цветные точки и черные линии служат ориентиром для глаз, чтобы проследить характеристику наложения. а Дифракционная картина БПФ для бездефектной ZB. б , c Структура ZB. г Дифракционная картина БПФ для бездефектных WZ и e - е Структура WZ
Срезы кристаллов идентифицировались как сегменты ZB или WZ только в том случае, если наблюдалась одна полная последовательность, состоящая из четырех бислоев атомов. Остальные разделы были отнесены к SF или ротационным близнецам.
Кристаллическая структура при трех различных уровнях легирования, оцененная в соответствии с объясненными характеристиками, показана на рис. 3. Выделены различные области WZ и ZB. Однако для анализа учитывались только отдельные сегменты. Чтобы количественно оценить влияние легирования Te на кристаллическую структуру ННК, была проанализирована и усреднена общая длина сегментов около 150 нм из 10 ННК для каждого уровня легирования (см. Рис. 3b – d). Отношение сегментов ZB / (WZ + ZB) определялось путем подсчета количества отдельных сегментов ZB и WZ. Образцы B1, B3, C1 и A4 при 0 ° C, 447 ° C и 500 ° C были проанализированы (см. Рис. 4) соответственно. Мы наблюдаем увеличение отношения сегментов ZB / (WZ + ZB) с увеличением температуры ячейки GaTe. Эта тенденция проиллюстрирована на рис. 4. Сравнивая первые две точки данных (0 ° C и 447 ° C), улучшенное соотношение обусловлено более сильным увеличением сегментов ZB по сравнению с увеличением сегментов WZ от нелегированного к нелегированному. самая низкая температура легирования (см. вставку на рис. 4). Оба типа структур улучшаются, а количество SF уменьшается. Однако для третьей точки тенденция иная. При сравнении самого высокого и самого низкого уровня легирования (500 ° C и 447 ° C) мы обнаруживаем, что количество сегментов WZ уменьшается, а количество сегментов ZB остается почти постоянным (см. Вставку на рис.4), в то время как количество сегментов SF увеличивается. Это приводит к повышенному коэффициенту. Тем не менее, секция ZB продвигается по сравнению с нелегированным футляром. Наконец, результаты показывают, что легирование Te действительно увеличивает соотношение сегментов ZB / (WZ + ZB). Однако это остается неоднозначным, если формирование сегментов ZB строго продвигается за счет включения Te.
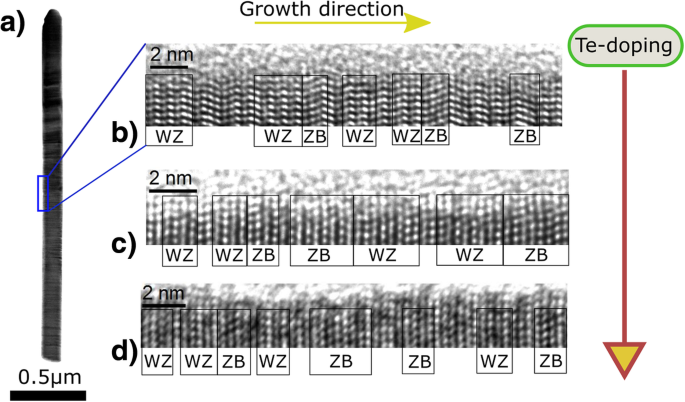
Влияние легирования Te на кристаллическую структуру. ПЭМ-изображения, показывающие кристаллическую структуру в нелегированных и легированных Te наночастицах InAs. а Вид сбоку на InAs NW. б - г ВР-ПЭМ-изображения кристаллической структуры InAs NW (изображение повернуто на 90 ° по часовой стрелке). Обозначены области WZ и ZB. Были выбраны следующие образцы и температуры GaTe-ячеек: b B1 (Как 4 -BEP =2,3 × 10 −5 Торр), без примесей, т.е. при 0 ° C. c B3 (Как 4 -BEP =2,3 × 10 −5 Торр), 447 ° С. г C1 (Как 4 -BEP =3,0 × 10 −5 Торр), 500 ° C

Соотношение сегментов ZB и WZ. Отношение количества сегментов ZB к общему количеству сегментов, обозначенных как WZ или ZB, в зависимости от температуры ячейки GaTe. Для первых двух измерений были проанализированы B1 и B3. При 500 ° C результаты проводов C1 и A4 были объединены, так как они были выращены с аналогичным As-BEP. Гистограмма на вставке показывает суммарную длину всех сегментов WZ и ZB, присутствующих в NW при указанной температуре ячейки, соответственно
Чтобы дополнить наблюдения, сделанные с помощью ПЭМ, были выполнены измерения XRD. Мы провели φ-сканирование с акцентом на кубический (220) и гексагональный [10,11,12,13,14,15] рефлексы. Эти рефлексы однозначно можно отнести к ZB- и WZ-структуре соответственно. Измерение соответствующих интенсивностей позволило выделить I ZB / ( Я ZB + Я WZ ) соотношение интенсивностей. Ф-сканирование, изображенное на рис. 5а, служило для определения относительной интенсивности пиков ZB и WZ при каждой температуре легирования ячейки GaTe. Для ZB-рефлекса возникают шесть пиков, хотя кубическая решетка должна приводить только к 3-кратной симметрии. Мы относим эти пики к симметричным двойникам в ZB-структуре. Шестикратные симметричные пики, возникающие при сканировании WZ, характерны для гексагональной кристаллической структуры и соответствуют нашим ожиданиям. Здесь предполагается, что интенсивность сигнала поверхностных кристаллитов InAs (см. Вставку на рис. 1) на два порядка меньше, чем сигнал ННК [50], и поэтому ею можно пренебречь. Соответствующее соотношение интенсивностей I ZB / ( Я ZB + Я WZ ) изображена на рис. 5б (цветные треугольники для серии А). Это показывает увеличение I ZB / ( Я ZB + Я WZ ) отношение интенсивностей с увеличением температуры GaTe-ячейки, которое становится очевидным после 401 ° C для серии A. Этот результат соответствует наблюдению, уже полученному из анализа ПЭМ. Обратите внимание, что данные отношения интенсивности не отражают действительную пропорцию ZB / WZ, но представляют собой качественный результат. Это связано с тем, что разные рефлексы имеют разную интенсивность в зависимости от структурного фактора, который явно не учитывался. Однако сравнение точек данных остается в силе. Такое же чувствительное к рефлексам измерение было проведено для серии B, выращенной при более низком давлении As, чем для серии A, представленной выше. Результаты, изображенные на фиг. 5b (черные точки), показывают аналогичную тенденцию, что и серия A, то есть увеличение отношения интенсивностей ZB / (WZ + ZB) при более высоких температурах ячейки. Однако влияние атомов Te на кристаллическую структуру менее отчетливо по сравнению с более высокими давлениями As, и явное увеличение наблюдается только при 462 ° C. Хотя серия B показывает только увеличение отношения интенсивностей ZB / (WZ + ZB) в XRD для самой высокой температуры ячейки GeTe, равной 462 ° C, серия A явно демонстрирует увеличение при температуре ячейки 447 ° C и 500 ° C. Это наблюдение предполагает, что атомы As облегчают включение атомов Te, что, в свою очередь, приводит к изменению кристаллической структуры. Следовательно, более сильное влияние на отношение ZB / (WZ + ZB) наблюдается при соответствующем более высоком давлении As. Уменьшение отношения интенсивностей при 447 ° C на рис. 5b могло быть связано с эффектами затенения, поскольку плотность NW для образца B3 была выше средней, хотя это еще не полностью изучено.

Рентгеноструктурный анализ структуры. а Сканы φ, полученные с помощью рентгеновских измерений на InAs ННК A1-A4. б Результат I ZB / ( Я WZ + Я ZB ) отношение интенсивностей в зависимости от температуры GaTe-ячейки. Треугольные точки данных извлекаются из измерений, изображенных на ( a ) для образцов A1 – A4. Черными точками обозначены точки данных образцов B1 – B4
Из результатов ПЭМ, представленных выше, можно сделать вывод, что ННК, которые были выращены с подачей Те, показывают увеличенное количество сегментов ZB и WZ и, следовательно, меньше СФ по сравнению с нелегированным случаем. Кроме того, измерения XRD показывают, что отношение интенсивностей ZB / (WZ + ZB) увеличивается с увеличением уровня легирования Te (при более высоких температурах), что качественно согласуется с измерениями ПЭМ. В отличие от обычных элементов, используемых для легирования материалов AIIIBV, таких как Si (InAs / Si [30], GaAs / Si), C (GaAs / C) или Be (GaAs / Be), Te явно влияет на кристаллическую структуру Северо-Запада. Стимулирование наблюдаемого образования ZB может происходить из-за изменения поверхностных энергий, что снижает энергетический барьер для зарождения ZB. Это также наблюдалось в нанопроволоках InP, легированных цинком [51], где использовался катализируемый Au рост VLS. Однако необходимы дальнейшие исследования, чтобы прояснить основной механизм.
Электрические измерения
Проводимость определяется как σ =A · R · L −1 w был извлечен из двухточечных измерений с использованием контактов Ti / Au. Здесь A - шестиугольное сечение провода с A =3√3 d 2 NW / 8 где d NW - максимальный диаметр, R сопротивление, а Lw - расстояние между электрическими контактами. L w и d NW были измерены индивидуально для каждого провода с помощью SEM-изображения. Примерные ВАХ нелегированных и легированных нанокристаллов InAs представлены на рис. 6a – d. Графики показывают ожидаемое омическое поведение из-за поверхностного слоя накопления InAs [6, 52]. Зависимость проводимости от уровня легирования определялась на основании ВАХ и геометрии ННК. Результирующая зависимость между проводимостью и температурой ячейки GaTe проиллюстрирована на рис. 6д. При каждой температуре было исследовано не менее 20 ННК для серии А. При сравнении нелегированных и легированных проволок наблюдается увеличение средней проводимости примерно на один порядок величины при самом высоком уровне легирования. При температуре ячейки GaTe 500 ° C была определена средняя проводимость около 80 См / см (по сравнению с примерно 8 См / см для 0 ° C). Хотя разброс в проводимости для более высоких уровней легирования довольно заметен, наши наблюдения показывают, что включение Те действительно имеет сильное влияние, приводя в среднем к повышенной проводимости. Сравнение XRD и измерения проводимости показывает, что ниже 401 ° C влияние Те на кристаллическую структуру и транспортные свойства играет лишь незначительную роль. О большом разбросе проводимости InAs ННК, упомянутом выше, также сообщалось в литературе [53]. Как и ожидалось, тенденции проводимости к изменению диаметра ННК или расстояния между контактами не наблюдалось [26]. Таким образом, мы исключаем различное соотношение сторон как источник ошибки. Мы выделяем три основные причины, ответственные за сильное различие в проводимости:(i) метод пассивации контактов с использованием полисульфида аммония может привести к неоднородному качеству контакта. (ii) Поверхность проволоки не пассивирована, и на состояние поверхности может влиять неоднородное насыщение оборванных связей на боковых гранях проволоки водой и кислородом, что в конечном итоге приводит к неравномерному окислению поверхности. Это, в свою очередь, оказывает сильное влияние на транспортные характеристики, приводя к большим ошибкам [54]. Одним из способов предотвращения этих неоднородных состояний поверхности является пассивация путем осаждения Al 2 на месте. О 3 [53, 55]. (iii) Неоднородное легирование вдоль ННК, наблюдаемое для легирования Si [26], также могло вызвать большой разброс данных, хотя мы пытались исключить это, размещая контакты по центру для каждой проволоки. Наконец, вариации длины ННК (см. Рис. 1) и плотности могут привести к эффектам затенения, препятствующим однородному включению Те по всему образцу. Однако необходимы более систематические исследования, чтобы определить причину наблюдаемой большой дисперсии. Кроме того, были проведены измерения проводимости для ННК серии B, выращенных при сравнительно более низком давлении As. Здесь для каждой температуры ячейки GaTe было измерено не менее шести проводов. Результаты, изображенные на рис. 6e, показывают поведение, аналогичное описанному выше для серии A. Проводимость InAs NW увеличивается при более высоких температурах ячейки GaTe. Однако эффект менее выражен по сравнению с серией А, выращенной при более высоком давлении As. Сравнивая проводимость обеих серий при 401 ° C и 447 ° C на рис. 6e, мы обнаруживаем, что значения для серии A примерно вдвое больше, чем значения, найденные для B. Результаты XRD, представленные выше (см. Рис. 5). ) иллюстрируют, что кристаллическая структура в серии A более сильно зависит от включения Te, чем в серии B. Комбинация обоих результатов указывает на то, что повышенная проводимость связана с изменением кристаллической структуры, т. е. повышенным ZB / (WZ + ZB) соотношение интенсивностей. Из литературы известно, что модификация кристаллической структуры InAs NW с преобладанием WZ в сторону ZB увеличивает проводимость [50, 53, 56]. На основе исследований с использованием ПЭМ на InAs 1 - x Сб x NWs, Sourribes et al. сообщили об увеличении проводимости в 1,5 раза при увеличении доли NW ZB с 20 до 80% [50]. Наши результаты ПЭМ (см. Рис. 4) показывают увеличение отношения ZB / (WZ + ZB) с 32% (нелегированные NW) до 43% (максимально легированные NW), в то время как среднее значение проводимости увеличивается примерно в 10 раз. Сравнение показывает, что измененная кристаллическая структура - не единственная причина увеличения проводимости. Хотя модификация кристаллической структуры влияет на транспорт носителей, наблюдаемый эффект, вероятно, также связан с увеличенной плотностью носителей, вызванной Те, действующим в качестве донора.
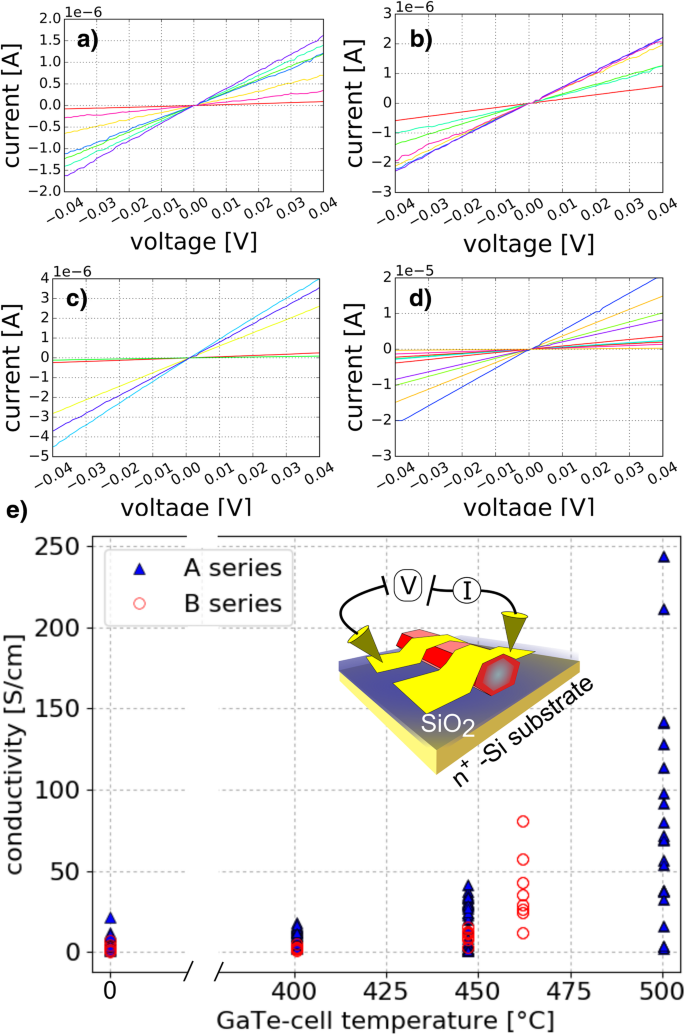
Электрические характеристики. а - г Примерные измерения ВАХ InAs NW при температуре ячейки GaTe 0 ° C, 401 ° C, 447 ° C и 500 ° C (серия A), измеренные через двухточечные контакты. е Определены значения проводимости ННК InAs, легированных Te, в зависимости от температуры ячейки GaTe для серий A (высокий As-BEP) и B (низкий As-BEP). На вставке показана схема конфигурации электрических измерений
Заключение
Таким образом, мы выращивали не содержащие катализатора ННК InAs на подложках Si (111) методом пар-твердого роста. Те был обеспечен ячейкой GaTe, позволяющей выращивать ННК InAs, легированные Te, при различных уровнях легирования путем регулирования температуры ячейки. Две серии образцов, выращенных при различных As-BEP, были охарактеризованы с помощью SEM, TEM, XRD и электрических измерений. Мы показали, что Те изменяет морфологию NW, приводя к общей тенденции к увеличению радиальной и уменьшенной скорости осевого роста. Воздействие сильнее при сравнительно более низких парциальных давлениях As. Измерения ПЭМ и XRD показали, что на кристаллическую структуру NW влияет добавление Te, что приводит к увеличению отношения ZB / (WZ + ZB) для обеих серий роста. Влияние на кристаллическую структуру ННК, выращенных при сравнительно более высоком ВОБ As-BEP, было более сильным, чем наблюдаемое для ННК, выращенных при более низком ВОП As-BEP. Электрические двухточечные измерения продемонстрировали увеличение средней проводимости проводов, выращенных при подаче Те. Это наблюдалось для двух серий роста, выращенных при разных давлениях As. Сравнение двух серий образцов показало, что кристаллические и электрические свойства нанокристаллов InAs сильнее зависят от добавления Te при более высоких давлениях As. Результат показывает, что улучшенная средняя проводимость сильно связана с изменением кристаллической структуры, то есть увеличением отношения ZB / (WZ + ZB). Мы приписываем улучшенные транспортные свойства как включенному элементу группы VI Te, действующему как донор, так и измененной кристаллической структуре. Эта работа является важным вкладом в расширение возможностей легирования NW, которое представляет большой интерес для противодействия ухудшению транспортных свойств SF.
Сокращения
- Как:
-
Мышьяк
- BEP:
-
Эквивалентное давление пучка
- C:
-
Углерод
- GaAs:
-
Арсенид галлия
- GaTe:
-
Теллурид галлия
- HR-TEM:
-
Просвечивающая электронная микроскопия высокого разрешения
- InAs:
-
Арсенид индия
- MBE:
-
Молекулярно-лучевая эпитаксия
- MOVPE:
-
Эпитаксия из паровой фазы металлоорганических соединений
- NW:
-
Нанопроволока
- SEM:
-
Сканирующая электронная микроскопия
- SF:
-
Ошибка укладки
- Si:
-
Кремний
- Te:
-
Теллур
- VS:
-
Твердый пар
- WZ:
-
Вюрцит
- XRD:
-
Рентгеновская дифракция
- ZB:
-
Цинковая обманка
Наноматериалы
- Поддержание роста Интернета вещей
- Рост CMMS малого бизнеса
- Материаловеды учат нанопроволоки "танцевать"
- О полупроводниковых наночастицах
- Исследования структур вакансий, связанных с их ростом, в листе h-BN
- Самокатализирующийся рост вертикальных нанопроволок GaSb на стержнях InAs путем осаждения из паровой фазы метал…
- Аморфные кремниевые нанопроволоки, выращенные на пленке оксида кремния путем отжига
- Теоретическое исследование двухосно-деформированных германиевых нанопроволок
- Контроль роста высокоднородных нанопроволок селенида индия (In2Se3) с помощью процесса быстрого термического о…
- Влияние упругой жесткости и поверхностной адгезии на отскок наночастиц



