Зависимая от температуры структурная эволюция интерфейса HfO2 / Si и ее механизм
Аннотация
В данной работе оксид гафния (HfO 2 ) тонкие пленки наносятся на подложки Si p-типа путем осаждения атомных слоев в удаленной плазме на Si p-типа при 250 ° C с последующим быстрым термическим отжигом в азоте. Влияние температуры после отжига на кристаллизацию HfO 2 фильмы и HfO 2 / Si исследуются интерфейсы. Кристаллизация HfO 2 фильмы и HfO 2 / Si изучается методами автоэмиссионной просвечивающей электронной микроскопии, рентгеновской фотоэлектронной спектроскопии, рентгеновской дифракции и атомно-силовой микроскопии. Результаты экспериментов показывают, что во время отжига кислород диффундирует из HfO 2 к интерфейсу Si. При температуре отжига ниже 400 ° C HfO 2 пленка и межфазный слой аморфные, последний состоит из HfO 2 и диоксид кремния (SiO 2 ). При температуре отжига 450-550 ° C HfO 2 пленка становится многофазной поликристаллической, а кристаллический SiO 2 находится в интерфейсе. Наконец, при температуре отжига выше 550 ° C HfO 2 В пленке преобладает однофазный поликристалл, а межфазный слой полностью превращается в кристаллический SiO 2 .
Введение
Оксид гафния (HfO 2 ) тонкая пленка представляет собой интересный материал для множества применений. Его можно использовать в многослойном оптическом покрытии [1], защитном покрытии [2], диэлектрике затвора [3], пассивирующем слое [4,5,6] и т. Д. Благодаря своим превосходным свойствам, таким как высокая плотность, высокий коэффициент преломления. индекс, широкая запрещенная зона и относительно высокая термическая стабильность. Для приготовления HfO 2 использовалось множество методов. тонких пленок, таких как электронно-лучевое испарение [7], осаждение из химического раствора [8], реактивное распыление [9], химическое осаждение металлоорганических соединений из паровой фазы [10], молекулярно-лучевая эпитаксия [11] и осаждение атомных слоев (ALD). ALD - перспективный метод получения тонких пленок с высокоточным контролем толщины и однородностью. Установлено, что пост-отжиг оказывает значительное влияние на ALD HfO 2 фильмы [12,13,14,15]. Согласно исследованию, HfO 2 тонкие пленки могут кристаллизоваться при температуре отжига выше 500 ° C [16,17,18]. Кристаллическая структура HfO 2 сильно влияет на оптические и электрические свойства. Например, структурное изменение HfO 2 переход от аморфной к моноклинной кристаллической фазе может привести к изменению показателя преломления от 1,7 до 2,09, оптической щели с 5,75 до 6,13 эВ и диэлектрической проницаемости с 24,5 до 14,49 [19, 20]. Для ALD HfO 2 осажденный на кремниевые подложки оксидный слой обычно наблюдается при HfO 2 / Si [21, 22]. Сообщается, что наличие этого межфазного слоя снижает диэлектрическую проницаемость [22]. Кроме того, Kopani et al. [23] представили структурные свойства 5-нм HfO 2 пленки после окисления азотной кислотой подложек кремния, легированного n-типа. Они обнаружили, что высокая температура отжига увеличивает скорость роста кристаллических зародышей. Однако их кристаллизационные свойства, особенно HfO 2 / подложка мало изучены. Следовательно, температура отжига, влияющая на кристаллизационные свойства HfO 2 тонкие пленки, полученные с помощью ALD, заслуживают дальнейшего изучения.
В этой работе HfO 2 Тонкие пленки изготавливались методом дистанционного плазменного атомного осаждения (RP-ALD) на кремниевые подложки p-типа. Последующий отжиг проводился с помощью системы быстрого термического отжига (RTA) при различных температурах. Структурные изменения и кристаллизационные свойства HfO 2 Тонкие пленки с помощью RTA были охарактеризованы с помощью атомно-силовой микроскопии (AFM), дифракции рентгеновских лучей при скользящем падении (GIXRD), рентгеновской фотоэлектронной спектроскопии (XPS) и просвечивающей электронной микроскопии высокого разрешения (HR-TEM). Температурно-зависимый HfO 2 Также исследуются структурная эволюция интерфейса / Si и ее механизм.
Метод
Использовались двухсторонние полированные (100) ориентированные p-образные пластины кремния Чохральского размером 2 дюйма 250 мкм и удельным сопротивлением 30 Ом · см. Перед нанесением кремниевые пластины очищали стандартным методом Radio Corporation of America с последующим погружением в разбавленный раствор фтористоводородной кислоты (5%) на 2 мин для удаления возможных случайных оксидов без окончательной промывки водой. После очистки все пластины были высушены чистым азотом (N 2 ) газа и закреплен на держателе подложки. Приблизительно 15 нм HfO 2 (168 циклов ALD) тонкие пленки были нанесены на пластины Si методом RP-ALD (Picosun R-200, Финляндия) с использованием тетракис (этилметиламино) гафния (TEMAH) и кислорода (O 2 ) в чередующемся импульсе с N 2 продувка реакционной камеры между импульсами. TEMAH и O 2 Плазма подавалась в реактор в следующей последовательности:TEMAH импульс 1,6 с; N 2 продувка 10 с; О 2 плазменный импульс 10 с, а N 2 продувка 12 с. После внесения HfO 2 Для тонких пленок быстрый термический отжиг проводился в N 2 окружающая среда на 10 мин. Температуры отжига варьировались от 400 до 600 ° C для исследования влияния на кристаллизацию HfO 2 тонкие пленки и HfO 2 / Si интерфейс. В таблице 1 перечислены типичные условия RPALD и пост-отжига.
АСМ-измерения были выполнены в режиме постукивания для исследования морфологии поверхности HfO 2 тонкие пленки. Изображения АСМ, представленные в этой работе, представляют собой сканы размером 2 мкм × 2 мкм с разрешением 256 точек × 256 линий. Структура HfO 2 Пленки были охарактеризованы методом дифракции рентгеновских лучей скользящего падения (GIXRD, Rigaku TTRAXIII, Япония) с использованием длиннофокусной рентгеновской трубки из Cu. Рентгеновское излучение с длиной волны 0,154 нм производилось при рабочем напряжении 50 кВ и токе 300 мА. Угол падения 0,5 ° был выбран для получения дифракционных картин в диапазоне 2 θ диапазон 20–60 °. Рентгеновскую фотоэлектронную спектроскопию (XPS, Thermo Fisher K-alpha) также выполняли с использованием монохроматического рентгеновского излучения Al Kα (hν =1486,6 эВ). Для анализа XPS использовалось пятно диаметром 100 мкм, и фотоэлектроны собирались под углом взлета 45 °. Сечения HfO 2 Тонкие пленки были получены методом вывода сфокусированного ионного пучка в системе Hitachi NX2OOO. Изображения поперечного сечения HfO 2 тонкие пленки исследовали с помощью автоэмиссионной просвечивающей электронной микроскопии высокого разрешения (HR-TEM, JEM-2100F, США).
Результаты и обсуждение
На рисунке 1 показаны изображения АСМ для HfO 2 . пленки, отожженные при разных температурах. Значения среднеквадратичной (RMS) и средней шероховатости поверхности (Ra) показаны для обозначения шероховатости поверхности. Среднеквадратичное значение для пленки после осаждения составляет 0,44 нм. Она незначительно увеличивается до 0,47 нм при повышении температуры отжига до 500 ° C. Дальнейшее повышение температуры отжига до 600 ° C приводит к значительному увеличению шероховатости поверхности с увеличением RMS до 0,69 нм. Такая же тенденция наблюдается и в значениях Ra. Увеличение шероховатости поверхности отожженных пленок может указывать на структурные изменения.
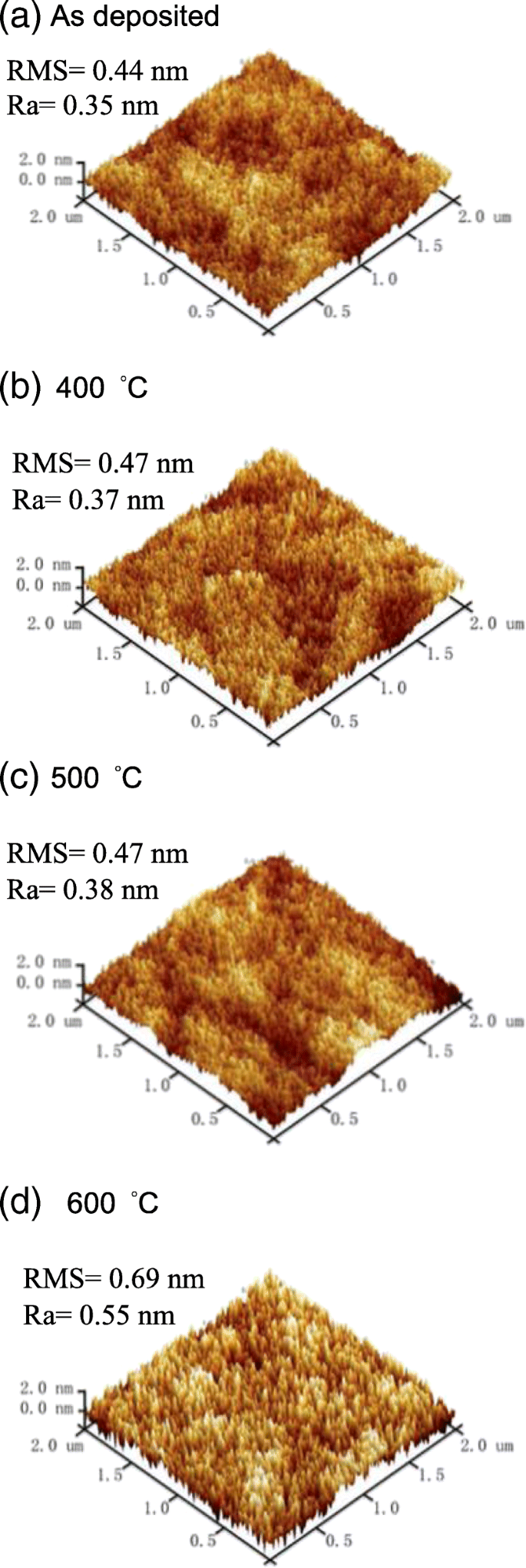
Изображения a , полученные с помощью АСМ как депонированный, b 400 ° C, отожженный, c Отожженный при 500 ° C и d Отожженный при 600 ° C HfO 2 фильмы
На рисунке 2 показаны температурно-зависимые GIXRD-спектры различных HfO 2 . тонкие пленки. В момент депонирования HfO 2 Пленка аморфна и остается аморфной после отжига при 400 и 450 ° C. При температуре отжига выше 500 ° C появляются дифракционные пики, указывающие на образование кристаллического HfO 2 . Пики при 1 / d =0,319 и 0,354 Å -1 соответствуют плоскостям - 111 и 111 моноклинной фазе (ICDD PDF # 34-0104, пространственная группа P21 / c) соответственно. Пик при 1 / d =0,340 Å −1 соответствует плоскости (111) орторомбической фазы (ICDD PDF # 21-0904, пространственная группа Pbcm). Другие пики около 1 / d =0,380 ~ 0,395 - это плоскости 200, 020 и 002 моноклинной фазы и плоскость 020 орторомбической фазы. Результаты также показывают, что моноклинная фаза уменьшается, а ромбическая фаза увеличивается с температурой отжига. Орторомбический HfO 2 доминирует в кристаллической структуре при более высоких температурах отжига. Однако дифракционные пики ромбического HfO 2 наблюдались при более низком 1 / d (меньшем d-интервале) по сравнению с таковым в ICDD PDF № 21-0904. Кроме того, сдвиг 1 / d =0,340 Å −1 в сторону более высокого значения указывает на то, что расстояние d уменьшается с увеличением температуры отжига.
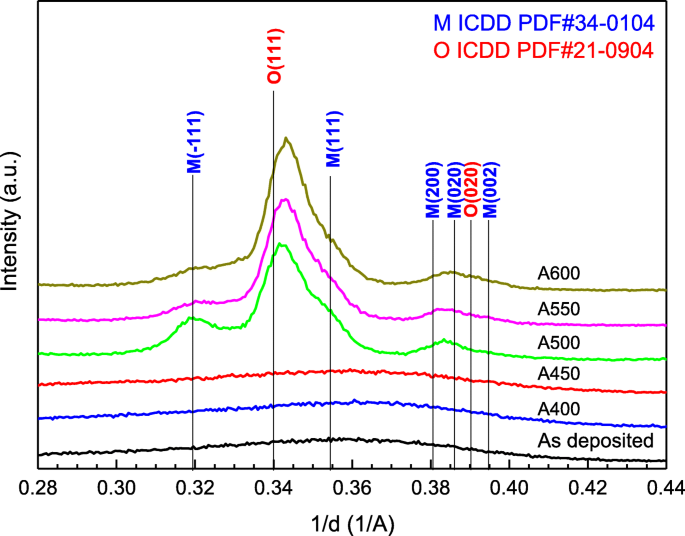
GIXRD-спектры HfO 2 тонкие пленки, отожженные при разных температурах
Концентрации Hf и O в HfO 2 пленки были измерены с помощью XPS с профилированием по глубине. На рис. 3 показано соотношение состава O / Hf для HfO 2 после осаждения и после отжига. фильмы. Отношение O / Hf уменьшается с 1,60 до 1,29 с увеличением температуры отжига. За счет использования N 2 во время отжига HfO 2 становится дефицит кислорода с температурой. Кислорододефицитный HfO 2 пленка также дает меньший d-интервал, как упоминалось ранее.

Атомное отношение кислорода к гафнию для HfO 2 тонкие пленки, отожженные при разных температурах
На рис. 4a, b, c, d, e и f показаны изображения с высоким разрешением поперечного сечения ПЭМ-ВР образцов после осаждения при 400 ° C, 450 ° C, 500 ° C, 550 ° C и Отожженный при 600 ° C HfO 2 тонкие пленки на подложках Si соответственно. Видно, что HfO 2 На этих изображениях отчетливо видны слой и подложка Si. Дополнительно тонкий слой толщиной 1-2 нм между HfO 2 а подложка Si может быть SiO 2 фильм. Как показано на рис. 4a, нет очевидной структуры решетки в непосредственно осажденном HfO 2 пленка, что указывает на то, что эта пленка аморфная. После отжига при 400 ° C, хотя большинство областей HfO 2 пленка все еще аморфна, мы можем наблюдать, что в этой пленке сформирована часть решеток со значениями d-зазора 2,82 и 3,12 Å. Эти два значения d-интервала проиндексированы как моноклинный HfO 2 (111) и моноклинный HfO 2 (- 111) соответственно, а пленка, отожженная при 400 ° C, демонстрирует нанокристаллическую структуру. При увеличении температуры отжига с 400 до 600 ° C кристаллическое качество HfO 2 фильм постепенно усиливается. Когда HfO 2 пленка отжигается при 500–550 ° C, основная структура решетки состоит из моноклинного HfO 2 (- 111), моноклинный HfO 2 (200) и ромбический HfO 2 (111) можно идентифицировать. Однако при дальнейшем увеличении температуры отжига до 600 ° C структура решетки орторомбического HfO 2 (111) все еще существует в пленке, а две другие решетки постепенно исчезают. С другой стороны, значения d-интервала орторомбического HfO 2 (111) плоскости для отожженного при 500 ° C, 550 ° C и 600 ° C HfO 2 пленки были определены как 2,93, 2,90 и 2,88 Å соответственно. Это хорошо согласуется с результатом XRD, согласно которому ромбический HfO 2 (111) дифракционный пик смещается в сторону больших углов при увеличении температуры отжига от 500 до 600 ° C. Результат показывает, что содержание кислорода в HfO 2 пленка постепенно уменьшается по мере увеличения температуры отжига. Другое интересное явление можно обнаружить в изменении кристаллической структуры и толщины SiO 2 слой. В состоянии после осаждения SiO 2 слой аморфный. Даже если образец отожгли при 400 ° C, тепловая энергия недостаточно высока для преобразования структуры SiO 2 слой от аморфного до кристаллического. Тем не менее, при увеличении температуры отжига с 450 до 600 ° C кристаллический SiO 2 слой (с кубическим SiO 2 (220)) и ее толщина увеличивается от 1,0 до 1,6 нм. Можно заметить, что аморфный SiO 2 слой полностью трансформируется в кубический SiO 2 структура после отжига образца при 600 ° C. При увеличении температуры отжига от 550 до 600 ° C значение расстояния d кубического SiO 2 (220) увеличивается с 2,48 до 2,56 Å. Это означает, что содержание кислорода в SiO 2 слой увеличивается за счет увеличения температуры отжига. Можно разумно предположить, что добавление содержания кислорода в SiO 2 слой объясняется диффузией атомов кислорода, происходящих из HfO 2 фильм. Более того, общая толщина уменьшается при температурах отжига 550 и 600 ° C и может быть связано с увеличением плотности пленки, вызванной кристаллизацией и удалением водорода.
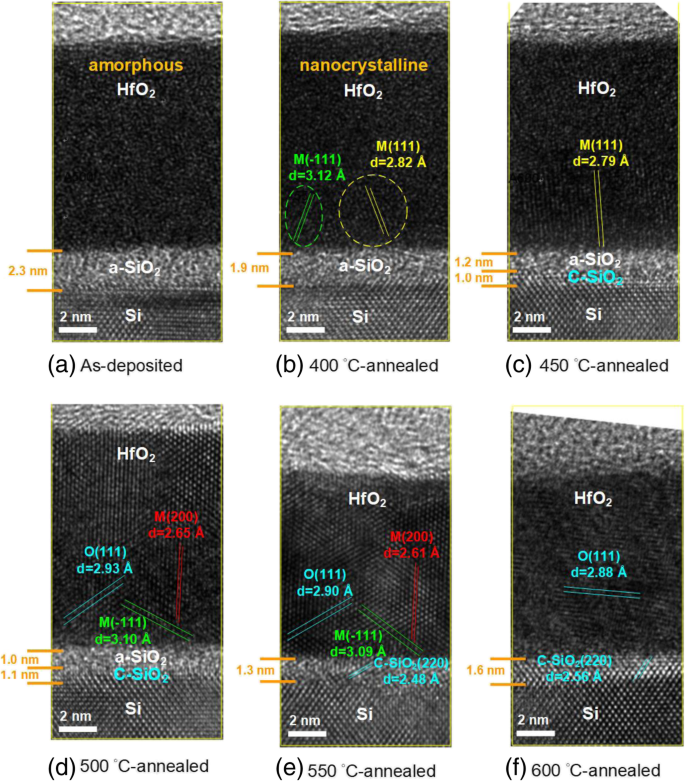
ПЭМ-изображения поперечного сечения a как депонированный, b 400 ° C, отожженный, c 450 ° C, отожженный, d 500 ° C, отожженный, e 550 ° C-отожженный, и f Отожженный при 600 ° C HfO 2 / Si
Основываясь на приведенных выше результатах, рис. 5 иллюстрирует механизмы HfO 2 пленки с разными температурами отжига. Учитывая, что температура отжига меньше 400 ° C (рис. 5а), пленка является аморфной, в которой атомы Hf и O расположены беспорядочно. Межфазный слой между HfO 2 а пластина c-Si представляет собой смешанный оксид, состоящий из a-SiO 2 и a-HfO 2 . При температуре отжига 450–550 ° C (рис. 5б) HfO 2 пленка получает тепловую энергию, приводящую к структурному изменению от аморфного к поликристаллическому с моноклинной и орторомбической фазами. Кристаллическая ориентация и d-интервал указаны в соответствии с результатами HR-TEM и GIXRD. Кристаллический SiO 2 слой формируется. В нескольких работах сообщалось об упорядоченном слое оксида кремния на границе раздела a-SiO 2 и (100) c-Si, но механизм и структура атомного масштаба остаются спорными. Термическое окисление кремния можно рассматривать как последовательные операции внедрения атомов кислорода в связи Si-Si, и это вызывает большое накопление деформаций сжатия в окисленных областях и, возможно, может вызвать структурное превращение в упорядоченный оксид в SiO 2 / c-Si [24]. Сообщалось также, что кристаллическая кислородсодержащая фаза могла образовываться в условиях высокого перенасыщения кислородом Si [25] или низкой плотности интерфейсных дефектов [26]. Судя по изображениям XPS и TEM в этой работе, HfO 2 слой кислородно-дефицитный. Значительное количество кислорода диффундирует из HfO 2 по направлению к кремниевой подложке, и это может привести к перенасыщению кислородом на границе c-Si и образованию кристаллического SiO 2 . В этом диапазоне температур кристаллический SiO 2 толщина слоя увеличилась бы, но a-HfO 2 + A-SiO 2 Толщина смешанного слоя уменьшается с увеличением температуры отжига. При температуре отжига выше 550 ° C (рис. 5в) HfO 2 В структуре преобладает поликристаллическая орторомбическая (111) однофазная. Межфазный слой полностью определяется кристаллическим SiO 2 . . Для ромбического HfO 2 расстояние d уменьшается. слой и увеличивается для c-SiO 2 . Хотя отжиг HfO 2 необходим для достижения высокой пассивации кремниевой пластины и диэлектрической проницаемости, при высоких температурах, в результате кристаллизации HfO 2 и межфазный SiO 2 может снизить свойства пленки. Установлено, что температура отжига 500 ° C обеспечивает наилучшую диэлектрическую проницаемость 17,2. Дальнейшее повышение температуры отжига приводит к снижению диэлектрической проницаемости, возможно, из-за изменения кристаллической фазы. Tomida et al. сообщил, что диэлектрическая проницаемость HfO 2 уменьшается при переходе структуры от поликристаллической к моноклинной однофазной [27]. Лучшая пассивация HfO 2 / Si также можно получить при температуре отжига 500 ° C, поскольку более высокие температуры могут привести к полному образованию c-SiO 2 межфазный слой и дегидрирование на границе раздела.
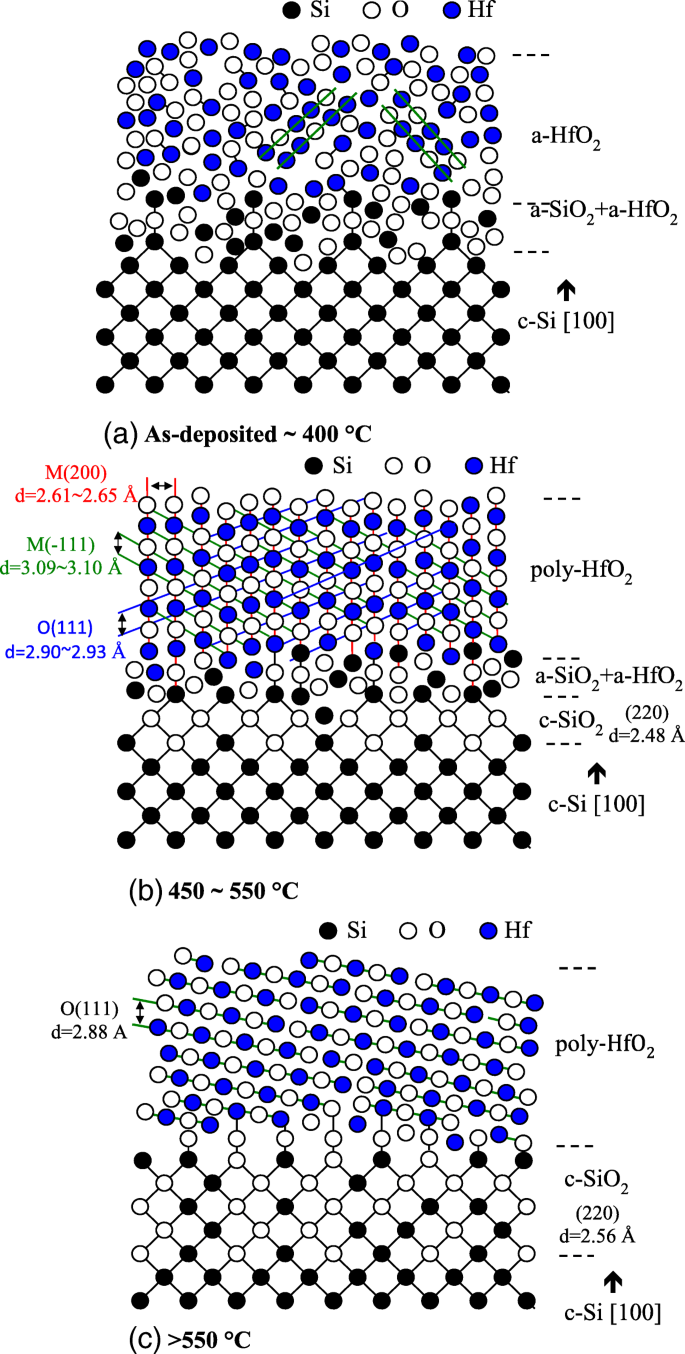
Диаграммы механизма кристаллизации HfO 2 пленки и межфазный слой в диапазонах температур а после осаждения до 400 ° C, b От 450 до 550 ° C и c выше 550 ° C. Также указываются значение d-интервала и кристаллическая ориентация
Заключение
HfO 2 пленки получают с использованием RP-ALD, и влияние температуры отжига на кристаллическую структуру HfO 2 был исследован. Для депонированного HfO 2 и отожженный ниже 400 ° C, HfO 2 и межфазный слой аморфны. С повышением температуры отжига d-интервал орторомбического соединения уменьшается, тогда как у c-SiO 2 межфазный слой увеличивается, что указывает на диффузию кислорода из HfO 2 к интерфейсу Si. Температура отжига выше 550 ° C показывает HfO 2 слой с поликристаллической орторомбической однофазной, а межфазный слой полностью превращается в c-SiO 2 . Хотя для HfO 2 требуется отжиг во многих приложениях, таких как достижение высокой пассивации кремниевых пластин и высокой диэлектрической проницаемости, кристаллизация может отрицательно сказаться на свойствах пленки. Температура отжига 500 ° C может обеспечить наилучшее качество пассивирования кремниевых пластин и диэлектрическую проницаемость.
Сокращения
- AFM:
-
Атомно-силовая микроскопия
- a-HfO 2 :
-
Аморфный оксид гафния
- ALD:
-
Осаждение атомного слоя
- a-SiO 2 :
-
Аморфный диоксид кремния
- c-SiO 2 :
-
Кристаллический диоксид кремния
- GIXRD:
-
Дифракция рентгеновских лучей при скользящем падении
- HfO 2 :
-
Оксид гафния
- HR-TEM:
-
Просвечивающая электронная микроскопия высокого разрешения
- N 2 :
-
Азот
- O 2 :
-
Кислород
- RMS:
-
Среднеквадратичное значение
- RP-ALD:
-
Дистанционное плазменное напыление атомного слоя
- RTA:
-
Быстрый термический отжиг
- TEMAH:
-
Тетракис (этилметиламино) гафний
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
Наноматериалы
- Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на по…
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Получение полимерных наносфер палладия (II) с ионным отпечатком и удаление палладия (II) из водного раствора
- Механизм проводимости и повышение выносливости в RRAM на основе HfO2 с лечением нитридом
- Изготовление тонких пленок SrGe2 на подложках Ge (100), (110) и (111)
- Исследование структурных, электронных и магнитных свойств кластеров Ag n V (n =1–12)
- Производство спиральных нановолокон из CA / TPU и анализ их механизма
- Зависимые от толщины характеристики магнитного и микроволнового резонанса пленок FeCoBSi с комбинированным пол…
- Теоретическое моделирование радиационного отклика сверхрешетки Si, Ge и Si / Ge на низкоэнергетическое облучение…
- Свойства контролируемого синтеза и селективной адсорбции нанолистов Pr2CuO4:обсуждение механизма



