Изучение из первых принципов точечных дефектов в сверхрешетке GaAs / AlAs:фазовая стабильность и влияние на зонную структуру и подвижность носителей
Аннотация
Усовершенствованные полупроводниковые сверхрешетки играют важную роль в важнейших будущих высокотехнологичных приложениях, таких как аэрокосмическая промышленность, физика высоких энергий, обнаружение гравитационных волн, астрономия и области, связанные с ядерной областью. В таких экстремальных условиях, как окружающая среда с высокой степенью облучения, эти полупроводниковые сверхрешетки имеют тенденцию генерировать различные дефекты, которые в конечном итоге могут привести к отказу устройств. Однако в сверхрешетке, такой как GaAs / AlAs, фазовая стабильность и влияние точечных дефектов на характеристики устройства до сих пор не выяснены. Настоящие расчеты показывают, что в сверхрешетке GaAs / AlAs антиструктурные дефекты энергетически более выгодны, чем вакансионные и межузельные дефекты. Как X (X =Al или Ga) и X As дефекты всегда вызывают металличность сверхрешетки GaAs / AlAs, а Ga Al и Al Ga антиструктурные дефекты незначительно влияют на электронную структуру. Для сверхрешетки GaAs / AlAs с межузельными или вакансионными дефектами обнаружено значительное уменьшение ширины запрещенной зоны или наведенной металличности. Дальнейшие расчеты показывают, что межузельные и вакансионные дефекты значительно снижают подвижность электронов, в то время как антиструктурные дефекты имеют относительно меньшее влияние. Полученные результаты углубляют понимание эффектов радиационного повреждения сверхрешетки GaAs / AlAs, что, таким образом, обеспечивает руководство для разработки высокостабильной и прочной электронной и оптоэлектроники на основе полупроводниковой сверхрешетки для применения в экстремальных условиях окружающей среды.
Фон
Сверхрешетка (SL) - это искусственный материал, состоящий из чередующихся тонких слоев двух или более различных компонентов. (GaAs) n / (AlAs) м является одним из наиболее важных SL с момента разработки транзисторов с высокой подвижностью электронов (HEMT) и квантовых каскадных лазеров (QCL) несколько десятилетий назад [1,2,3,4,5,6]. В последнее время с развитием технологий эпитаксии и нанопроизводства пленок (GaAs) n / (AlAs) м СЛ и наноустройства на основе (n + m) от 2 до 10 продемонстрировали захватывающие физические свойства, связанные с люминесценцией и оптическим поглощением, двухфононным поглощением и комбинационным рассеиванием света, а также инфракрасными спектрами, которые, таким образом, нашли многообещающие применения в оптоэлектронике, зондировании и т.д. Гражданские и промышленные районы, связанные со светодиодами, энергетикой и лазерами [7,8,9,10,11,12]. Между тем, в отношении других критически важных высокотехнологичных приложений, таких как аэрокосмическая промышленность, физика высоких энергий, обнаружение гравитационных волн, астрономия, космические путешествия, области, связанные с ядерной и национальной безопасностью, полупроводниковые SL и устройства подвергаются воздействию различных радиационных сред, т. Е. X- лучи, нейтроны, электроны, ионы и т. д., что может привести к образованию дефектов, содержащих примеси, вакансии, междоузлия, антиструктуры и их комплекс. Поскольку полупроводниковые материалы и связанные с ними физические свойства играют важную роль в эксплуатации и функционировании этих электронных устройств и интегральных схем, небольшое количество дефектов может резко изменить их оптические и транспортные свойства, особенно в многослойных системах [13].
Влияние посторонних примесей или собственных дефектов на полупроводниковые СР и материалы, из которых они состоят, широко исследовалось в последние десятилетия. Zollo et al. применили метод теории функционала плотности (DFT) для исследования стабильности точечных дефектов в GaAs и обнаружили, что антиструктурные дефекты были более предпочтительными [14]. Kahaly et al. исследовали структуру СЛ GaAs / AlAs методом DFT и обнаружили вакансию мышьяка (V As ) дефект на границе раздела и рядом с ним приводил к образованию проводящего квази-2-градуса между изолирующим диэлектрическим арсенидом [7]. Спасов и др. исследовали влияние примесей азота на транспорт носителей заряда и электронно-дырочную рекомбинацию в GaAs / AlAs SL-диодах [9]. Они сообщили, что примеси N модифицируют энергию электронной мини-зоны и препятствуют диффузии электронов через мини-зону SL, что может привести к сильной излучательной рекомбинации электронно-дырочных пар [9]. Wang et al. исследовали взаимную диффузию, индуцированную примесью Zn в структурах GaAs / AlAs SL с использованием ab initio метод молекулярной динамики (AIMD) [15]. Их результаты показали, что диффузии Zn способствуют элементы III группы, которые выбрасываются в межузельный канал и быстро диффундируют, разупорядочивая сверхрешетку [15]. Митра и Штарк обнаружили, что присутствие вакансий усиливает перемешивание Ga / Al в СР GaAs / AlAs в результате предложенного двухатомного кольцевого механизма диффузии [16]. Недавно было проведено AIMD-моделирование радиационного отклика GaAs / AlAs SL [17], в котором были определены минимальные энергии для каждого атома, который должен постоянно смещаться из узла его решетки, и указаны пути генерации дефектов, определены типы созданных дефектов. Выяснилось, что созданная пара Ga (или Al или As) Френкеля и As Ga -Ga Как антиструктурная пара оказывает сильное влияние на плотность распределения состояний и зонную структуру GaAs / AlAs SL [17].
Пока что стабильность точечных дефектов в структуре SL и транспортные свойства, такие как подвижность носителей, остаются неизвестными. Таким образом, очень важно исследовать, как наличие вакансионных, межузельных и антиструктурных дефектов влияет на структурную стабильность и электрические свойства GaAs / AlAs SL. В этом исследовании фазовая стабильность одиночной вакансии Ga (или Al или As), одиночного междоузельного Ga (или Al или As) и одиночного Ga As (или Al As или как Ga или как Al ) антиструктурные дефекты. Показано, что антиструктурные дефекты энергетически более выгодны, чем вакансионные и межузельные дефекты. Зонные структуры этих дефектных состояний были исследованы гибридным методом DFT, который включает в себя часть точного обмена из теории Хартри – Фока с остальной обменно-корреляционной энергией из других источников ( ab initio или эмпирический) [18], и ожидается, что он предложит более точное описание электронной структуры полупроводниковых материалов, чем стандартный DFT. В частности, предсказана подвижность электронов. Оказывается, межузельные и вакансионные дефекты значительно снижают подвижность электронов, в то время как антиструктурные дефекты имеют относительно меньшее влияние. Эта работа продвинет понимание эффектов радиационного повреждения полупроводниковой сверхрешетки и предоставит рекомендации по разработке высокостабильной и прочной электронной и оптоэлектроники на основе полупроводниковых сверхрешеток для приложений в экстремальных условиях окружающей среды.
Методы
В этом исследовании структурные релаксации выполняются в рамках стандартной структуры DFT, а зонные структуры рассчитываются с помощью гибридного DFT в рамках Heyd-Scuseria-Emzefhof (HSE) [19] на основе релаксированных структур. Все расчеты производятся с использованием Vienna Ab Initio Пакет моделирования (VASP) [20]. Псевдопотенциалы расширенной волны проектора используются для описания взаимодействия между ионами и электронами, а обменно-корреляционные эффекты обрабатываются с использованием приближения локальной плотности в параметризации Чеперли-Альдера [21]. Критерии сходимости для полных энергий и сил:10
−4
эВ и 10
−3
эВ / Å соответственно. Исходной точечной группой кристаллов AlAs и GaAs является T d группа цинковой обманки, как показано на рис. 1а. Иллюстрация рассматриваемых точечных дефектов представлена на рис. 1б. В данной работе рассматривается СР GaAs / AlAs, содержащая два монослоя GaAs, чередующихся с двумя монослоями AlAs, а геометрическая конфигурация вместе с рассматриваемыми точечными дефектами проиллюстрирована на рис.
Схематическое изображение геометрических структур а XAs (X =Ga или Al); б дефекты в XA. V X :(X =Ga, Al или As) X вакансия; X int :X межстраничное; X Как :X занимает узел решетки As; Как X :Как занимающий узел решетки X. Желтые и фиолетовые сферы представляют собой вакансию и межузельный дефект соответственно
Схематическое изображение геометрических структур а идеальная сверхрешетка GaAs / AlAs; б и c Сверхрешетка GaAs / AlAs с различными точечными дефектами. X Y :(X, Y =Ga, Al или As) X, занимающий узел решетки Y; V X :X вакансия; X int :X межстраничное. Желтые и карминовые сферы представляют собой вакансию и межузельный дефект соответственно 

Результаты и обсуждение
Свойства основного состояния GaAs и AlAs
Как показано в таблице 1, постоянные решетки объемных GaAs и AlAs определены равными 5,61 и 5,63 Å соответственно, что хорошо согласуется с экспериментальными и другими теоретическими значениями [22,23,24]. Кажется, что рассогласование решеток между GaAs и AlAs невелико, а постоянная решетки GaAs / AlAs SL установлена на промежуточное значение 5,62 Å. Модуль объемной упругости рассчитывается по формуле \ (B =\ frac {1} {3} \ left ({C} _ {11} +2 {C} _ {12} \ right) \) [25], где C 11 и C 12 представляют собой упругие постоянные. Расчетный объемный модуль упругости GaAs составляет 76,3 ГПа, что близко к результату 76,5 ГПа для AlAs. Эти результаты разумно согласуются с теоретическими и экспериментальными данными [22, 26, 27].
Энергия образования дефектов в сверхрешетке GaAs / AlAs
Для GaAs / AlAs SL и объемных состояний энергия образования дефектов рассчитывается как \ ({E} _f ={E} _ {def} - {E} _ {undef} + \ sum \ limits_i \ Delta {n} _i { \ mu} _i \) [28]. Здесь E def - полная энергия дефектной ячейки моделирования после релаксации, E undef - полная энергия релаксированной идеальной сверхъячейки, Δ n я изменение количества видов i ( я =Ga, Al или As) и μ я химический потенциал видов i [28].
Для объемных XAs (X =Al или Ga) химические потенциалы As и X подчиняются следующим ограничениям:\ ({\ mu} _X \ le {\ mu} _X ^ {bulk} \), \ ({\ mu} _ {As} \ le {\ mu} _ {As} ^ {bulk} \) и \ ({\ mu} _ {As} + {\ mu} _X ={\ mu} _ {XAs} ^ {bulk } \), где \ ({\ mu} _X ^ {bulk} \), \ ({\ mu} _ {As} ^ {bulk} \) и \ ({\ mu} _ {XAs} ^ {bulk } \) соответствуют полной энергии объемного X, объемного As и объемного XAs соответственно. Энергии образования дефектов при условии X-обогащения, т. Е. \ ({\ Mu} _X ={\ mu} _X ^ {bulk} \) и \ ({\ mu} _ {As} ={\ mu} _ {XAs } ^ {bulk} - {\ mu} _X ^ {bulk} \) и условие As-rich, т. е. \ ({\ mu} _ {As} ={\ mu} _ {As} ^ {bulk} \ ) и \ ({\ mu} _X ={\ mu} _ {XAs} ^ {bulk} - {\ mu} _ {As} ^ {bulk} \) сведены в Таблицу 2. Для GaAs в разделе As- богатые условия As Ga Антиструктурный дефект (занимающий узел кристаллической решетки Ga) оказался наиболее энергетически выгодным, на что указывает наименьшая энергия образования 1,57 эВ. Следующий благоприятный дефект - Ga As (Ga занимает узел решетки As) антиструктурный дефект с энергией образования 2.31 эВ. Межстраничное объявление As (As int ) имеет самую большую энергию образования 5,20 эВ, что позволяет предположить, что его образование труднее, чем других рассматриваемых точечных дефектов. В условиях, богатых Ga, V Ga , Как int и As Ga дефекты имеют большую энергию образования, и V As , Ga int и Ga As дефекты имеют меньшую энергию образования по сравнению с богатым As. Очевидно, что устойчивость дефекта зависит от химической среды. По сравнению с GaAs энергии образования дефектов в AlAs обычно больше, за исключением случаев As int и как X (X =Al или Ga) в условиях, богатых As. As Al и Al As антиструктурные дефекты определены как наиболее благоприятные дефекты в условиях, богатых As и Al, соответственно. Как и в случае с GaAs, As int также неблагоприятен в AlAs. Энергии образования дефектов в условиях с высоким содержанием As и X (X =Ga или Al) в объемных XAs показаны на рис. 3. На рис. 3a показано, что As Ga и Ga As антиструктурные дефекты более благоприятны в условиях, богатых As и Ga, соответственно. Отмечается, что As Al в большинстве случаев предпочтительнее антиструктурный дефект (см. рис. 3б). В условиях, богатых Al, фазовая стабильность Al As , V As и As Al дефекты близки друг к другу, на что указывают энергии образования 3,0, 3,16 и 3,24 эВ соответственно. Кроме того, мы обнаружили, что как в GaAs, так и в AlAs неблагоприятность As int не зависит от химической среды. Zollo et al. провели расчеты из первых принципов на GaAs и их результаты DFT показали, что энергии образования As Ga и Ga As были меньше, чем для вакансионных и межузельных дефектов [14], что согласуется с нашими результатами.
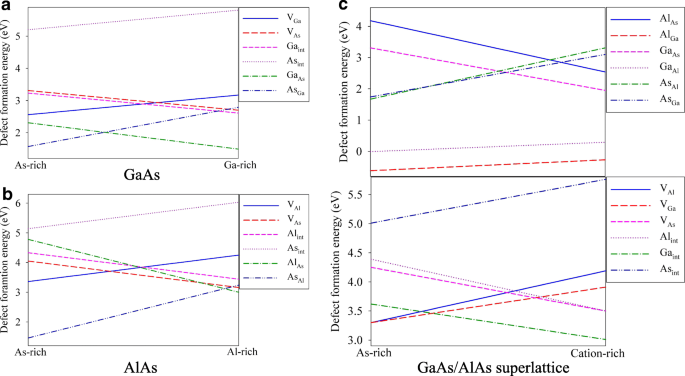
Энергии образования дефектов в богатых As и богатых катионами условиях в a GaAs, b AlAs и c Сверхрешетка GaAs / AlAs. X Y :(X, Y =Ga, Al или As) X, занимающий узел решетки Y; V X :X вакансия; X int :X межстраничное
E f в структуре GaAs / AlAs SL также вычисляются при условии As-rich, т. е. \ ({\ mu} _ {As} ={\ mu} _ {As} ^ {bulk} \), \ ({\ mu} _ {Al} ={\ mu} _ {Al As} ^ {bulk} - {\ mu} _ {As} ^ {bulk} \) и \ ({\ mu} _ {Ga} ={\ mu} _ {Ga As} ^ {bulk} - {\ mu} _ {As} ^ {bulk} \) и условие, богатое катионами, т. Е. \ ({\ Mu} _ {Al} ={\ mu} _ {Al } ^ {bulk} \), \ ({\ mu} _ {Ga} ={\ mu} _ {Ga} ^ {bulk} \) и \ ({\ mu} _ {As} =\ left ({\ mu} _ {SL} ^ {bulk} - {n} _ {Al} \ times {\ mu} _ {Al} ^ {bulk} - {n} _ {Ga} \ times {\ mu} _ {Ga} ^ {bulk} \ right) / {n} _ {As} \), где n Аль , n Га , и n Как представляют количество атомов Al, Ga и As в ячейке моделирования соответственно. Как показано в Таблице 3, Al Ga Дефект имеет отрицательную энергию образования, то есть -0,62 и -0,27 эВ в богатых As и богатых катионами условиях соответственно, что указывает на образование Al Ga противоугонный дефект - это экзотермический процесс. Что касается Ga Al В случае дефекта энергии образования составляют всего -0,01 эВ в условиях, богатых As, и 0,29 эВ в условиях, богатых катионами. Очевидно, образование Al Ga и Ga Al Антиструктурные дефекты в структуре GaAs / AlAs SL намного легче, чем другие точечные дефекты. В состоянии As-rich энергия образования второго благоприятного дефекта As Ga и As Al равны 1,67 и 1,74 эВ соответственно. Для межузельных слоев фазовая стабильность соответствует тенденции Ga int > Аль int > Как int в богатых As и богатых катионами условиях. Энергии дефектообразования в структуре GaAs / AlAs SL также представлены на рис. 3в. По сравнению с объемным GaAs точечные дефекты в СР GaAs / AlAs, как правило, сложнее сформировать, за исключением случая As int (см. рис. 3а, в). Энергии образования As int в объемном GaAs составляют 5,20 и 5,81 эВ в условиях богатых As и GaAs, что немного больше, чем соответствующие значения 5,01 и 5,76 эВ в GaAs / AlAs SL. Как показано на рис. 3б и в, стабильность точечных дефектов в объемной структуре AlAs и SL имеет разный характер. Аль As и как int В GaAs / AlAs SL дефекты энергетически более выгодны, чем объемный AlAs, тогда как V As В массивном AlAs дефект более предпочтителен, чем в структуре SL. Заметно, что в условиях богатых As и Al, энергии образования Al int в объемном AlAs сравнимы с таковым в GaAs / AlAs SL. Аналогично случаю с Al int , V Al дефект в объемной структуре AlAs и SL демонстрирует сходные преимущества, о чем свидетельствуют сравнимые энергии образования. В случае As Al В случае дефекта энергия образования в условиях, богатых As, меньше (1,46 эВ) в структуре SL, тогда как в условиях, богатых катионами, значение меньше (3,10 эВ) в массивном AlAs, что позволяет предположить, что стабильность As Al зависит от химической среды.
Сравнивая стабильность дефектов в объемных AlAs, GaAs и GaAs / AlAs SL, мы обнаруживаем, что антиструктурные дефекты всегда предпочтительнее вакансий и межузельных атомов, особенно для случаев Ga Al и Al Ga в GaAs / AlAs SL. Также отмечается, что в условиях, богатых As и богатых катионами, As int Дефект сложнее всего сформировать как в объемном состоянии, так и в структуре СР GaAs / AlAs.
Влияние точечных дефектов на зонную структуру сверхрешетки GaAs / AlAs
Первозданное состояние сверхрешетки GaAs / AlAs
Ширина запрещенной зоны для объемных GaAs, AlAs и GaAs / AlAs SL сведена в Таблицу 4, а их зонная структура представлена на Рис. 4. Гибридные вычисления методом DFT определяют, что прямая запрещенная зона GaAs составляет 1,44 эВ (см. Рис. 4a. ), что хорошо согласуется с экспериментальным значением 1.52 эВ [29] и другими расчетами [24]. Напротив, стандартный DFT предсказывает значение ширины запрещенной зоны 0,5 эВ, что в значительной степени занижает ширину запрещенной зоны GaAs. Для AlAs зонная структура носит косвенный характер, а ширина запрещенной зоны гибридного DFT составляет 2,16 эВ (см. Рис. 4b), что на 0,85 эВ больше, чем результат DFT, и хорошо согласуется с экспериментальным значением 2,22 эВ [23]. Как показано на рис. 4c, ширина запрещенной зоны GaAs / AlAs SL определена как прямая, и это согласуется с исследованием Botti et al., Которые обнаружили ширину запрещенной зоны (GaAs) m / (AlAs) м SL (m ≥ 2) должна быть прямой в точке Γ [3]. В наших расчетах прямая запрещенная зона для GaAs / AlAs SL определена гибридным методом DFT и составляет 2,06 эВ, что согласуется с экспериментальным значением 2,10 эВ [30].

Ленточные структуры a GaAs, b AlAs и c Сверхрешетка GaAs / AlAs. Значения гибридного ДПФ отображаются на левой панели, а результаты ДПФ - на правой панели.
Влияние антиструктурных дефектов на зонную структуру сверхрешетки GaAs / AlAs
В структуре СР GaAs / AlAs Ga Al и Al Ga антиструктурные дефекты более энергетически выгодны, чем другие точечные дефекты. Как показано на рис. 5a и b, зонные структуры Ga Al и Al Ga дефектные состояния очень похожи на исходное состояние, а ширина запрещенной зоны составляет 1,98 и 2,01 эВ соответственно. Это должно быть связано с тем, что химические элементы Al и Ga имеют одинаковую валентную электронную конфигурацию, то есть 3s 2 3р 1 для Al и 4s 2 4п 1 для Ga, и никакие дополнительные электроны или дырки не вводятся при образовании Ga Al и Al Ga антисайтовые дефекты. Зонные структуры для As Ga и As Al дефектные состояния изображены на рис. 5c и d. Оказалось, что эти два дефекта существенно модифицируют зонную структуру СР GaAs / AlAs. И As Ga и As Al антиструктурные дефекты вводят дополнительные электроны и действуют как легирующие примеси n-типа. Примесные уровни находятся далеко от валентных зон и пересекают уровень Ферми, как показано на рис. 5c и d. Эти глубокие уровни дефектов могут действовать как центр рекомбинации для носителей.

Зонная структура дефектной сверхрешетки GaAs / AlAs с различными антиструктурными дефектами. а :Ga, занимающий узел решетки Al; б :Al, занимающий узел кристаллической решетки Ga; c :As, занимающий узел кристаллической решетки Ga; г :Занимает узел решетки Al
На рисунке 6 представлены зонные структуры и парциальная плотность состояний (ППС) дефектных СЛ с Ga As . и Al As дефекты. Как показано на рис. 6а, зонная структура Ga As дефектный СЛ носит спин-расщепляющий характер. В подзонах со спином вниз уровень Ферми проходит через уровни дефектов, вносимых Ga As дефект, свидетельствующий о полуметаллическом характере дефектного СЛ. Согласно определению полуметаллической щели [31], запрещенная зона Ga As дефектное состояние составляет около 0,10 эВ. Как показано в PDOS неисправного SL с Ga As , подзоны со спином вниз вблизи уровня Ферми в основном формируются за счет p парциальные волны. Из-за схожих конфигураций валентных электронов между атомами Ga и Al, рассчитанные структуры зон со спином вверх и вниз для Al As дефектное состояние определяется (см. рис. 6b), и рассчитывается ширина запрещенной зоны 0,15 эВ. В целом, Al Ga и Ga Al Антиструктурные дефекты оказывают незначительное влияние на электронную структуру GaAs / AlAs SL. Также отмечается, что дефектный SL с As Al и As Ga дефекты проявляют металличность, а дефектные СР с Ga As и Al As полуметаллические.

Зонные структуры и парциальная плотность состояний дефектной сверхрешетки GaAs / AlAs с a Ga As и b Аль Как антисайтовые дефекты. X Как (X =Ga или Al) X, занимающий узел решетки As
Влияние дефектов вакансий на зонную структуру сверхрешетки GaAs / AlAs
Зонная структура структуры SL с различными вакансиями представлена на рис. 7, а соответствующие им ПДОС - на рис. 8. Характер спинового расщепления зонной структуры обнаруживается также в случае дефектной SL с V Ga. и V Al дефекты, как показано на рис. 7a и b. Действительно, удаление атомов с их исходных позиций оставляет четыре оборванных связи, связанных с sp 3 орбитали. Во время структурной релаксации ближайшие атомы вокруг вакансии одинаково смещаются к пустому узлу решетки, что приводит к узловой симметрии, определяемой тетрагональным элементом D 2 д точечная группа. Уровни наведенных дефектов возникают вблизи валентной зоны и располагаются в запрещенной области СР GaAs / AlAs. Ширина запрещенной зоны составляет 0,47 и 0,44 эВ для СР с V Ga . и V Al дефекты соответственно. Как показано в PDOS неисправного SL с V Ga и V Al (см. рис. 8а и б), основное влияние вакансий III группы оказывает на p состояния. Как показано на рис. 7в, зонная структура дефектной СЛ с V As Дефект распадается на части со спином вверх и вниз, и уровни дефекта появляются вблизи зоны проводимости. Поскольку V As Дефект действует как легирующая примесь n-типа, уровень Ферми смещается в сторону более высокой энергии и пересекает край уровня дефекта. Kahaly et al. исследовали электрические свойства гетерограниц GaAs-AlAs и обнаружили, что V As дефект на границе раздела приводит к квази-2-DEG [7], что согласуется с нашими результатами. Наши расчеты показывают, что вакансии по-разному влияют на зонную структуру СР GaAs / AlAs, т.е. дефект вызывает металличность СР GaAs / AlAs, а V Ga и V Al дефекты значительно уменьшают запрещенную зону SL-структуры.

Зонные структуры дефектной сверхрешетки GaAs / AlAs с a V Ga , b V Al и c V Как вакансионные дефекты. V X (X =Ga, Al или As) X вакансия

Парциальная плотность состояний дефектной сверхрешетки GaAs / AlAs с a V Ga , b V Al и c V Как вакансионные дефекты. V X (X =Ga, Al или As) X вакансия
Влияние межузельных дефектов на зонную структуру сверхрешетки GaAs / AlAs
На рис.9 представлены зонные структуры SL-структуры с межузельными дефектами. Отмечается, что уровень Ферми смещается в область высоких энергий и пересекает край зоны проводимости (см. Рис. 9a и b) из-за того, что межузельные атомы III группы являются дефектами донорного типа. Следовательно, неисправные SL с Ga int и Al int показать металлический характер. Как показано на рис. 9c, в областях со спином вверх и со спином вниз зонной структуры примесные уровни появляются вблизи зоны проводимости, а уровень Ферми пересекает край примесного уровня, что указывает на наведенную металличность дефектной СР GaAs / AlAs с Как int . Очевидно, что межузельные дефекты существенно изменяют электронную структуру GaAs / AlAs SL и в целом вызывают металличность дефектной структуры SL.

Зонные структуры дефектной сверхрешетки GaAs / AlAs с a Ga int дефект, b Аль int дефект и c Как int дефект. X int (X =Ga, Al или As) X межстраничное объявление
Сравнивая зонные структуры и типичные PDOS СР GaAs / AlAs с антиструктурами, вакансиями и междоузлиями, мы обнаруживаем, что дефекты значительно изменяют электронные структуры, за исключением случаев Ga Al и Al Ga антисайтовые дефекты. Кроме того, индуцируется сужение запрещенной зоны и даже металличность, что существенно влияет на характеристики GaAs / AlAs SL.
Влияние точечных дефектов на подвижность электронов в сверхрешетке GaAs / AlAs
Подвижность электронов при 0 K можно рассчитать по уравнению μ = eτ / м ∗ , где e - заряд электрона, τ - время релаксации, а м ∗ - эффективная масса носителя [32]. Эффективные массы электронов можно оценить по кривизне зонных структур с помощью соотношения \ ({m} ^ {\ ast} ={\ mathrm {\ hslash}} ^ 2 {\ left (\ frac {d ^ 2 \ varepsilon } {dk ^ 2} \ right)} ^ {- 1} \) [32], где ℏ - приведенная постоянная Планка, k - волновой вектор, а ε - энергия минимума зоны проводимости. Как показано на рис. 4a и b, мы получаем m * =0,057 м e для GaAs и m * =0,19 м e для AlAs, что хорошо согласуется с экспериментальными значениями 0,057 м e для GaAs [33] и 0,124 м e для AlAs [34], где m e - статическая масса электрона. Время релаксации для AlAs и GaAs принято равным 0,17 и 0,48 пс соответственно [35]. Подвижность электронов в GaAs и AlAs при 0 K составляет 1,48 × 10 4 . см 2 / Vs и 1,57 × 10 3 см 2 / Vs соответственно, что сопоставимо с экспериментальными значениями 0,94 × 10 4 см 2 / Vs для GaAs [36] и 0,28 × 10 3 см 2 / VS для AlAs [37].
Как показано в Таблице 5, эффективная масса электрона в точке Г (\ ({m} _ {\ Gamma} ^ {\ ast} \)) определена равной 0,113 m e для исходной СР GaAs / AlAs и времени релаксации τ принимается равным 0,4 пс [38]. Подвижность электронов вдоль направления z, т. Е. Направления Γ-X в зоне Бриллюэна ( μ Γ - X ) рассчитывается как 0,623 × 10 4 см 2 / Vs для идеальной СР GaAs / AlAs, что сравнимо с экспериментальным значением 1.0 × 10 4 см 2 / Вс [38]. Что касается дефектного SL с антиструктурными дефектами, то значение μ Γ - X сравнимо с таковым для идеальной SL, за исключением случаев Ga As и Al As дефекты. Подвижность электронов в направлении Γ-X определена равной 0,263 × 10 4 . см 2 / Vs и 0,311 × 10 4 см 2 / Vs для Ga As и Al As дефектные состояния, соответственно, которые намного меньше, чем для идеального состояния. Отмечается, что Ga int , Al int и как int дефекты также значительно снижают подвижность электронов, на что указывают значения 0,225 × 10 4 см 2 / Vs для Ga int , 0,243 × 10 4 см 2 / VS для Al int и 0,315 × 10 4 см 2 / Vs для As int . По сравнению с антиструктурным и межузельным дефектом, вакансии оказывают наиболее сильное влияние. Для V Ga и V Al дефектов, значения μ Γ - X примерно в шесть раз меньше, чем в первозданном состоянии. V As дефект также значительно снижает подвижность электронов, на что указывает 0,127 × 10 4 см 2 /Против. Tanaka et al. исследовали влияние электронного облучения на электрические свойства гетероструктур GaAs / AlGaAs и обнаружили, что подвижность электронов снижается при дозах более 5 × 10 20 см −2 [10]. Especially, the defect creation in GaAs channel region, rather than n-AlGaAs layer, is thought to be the main cause of the mobility degradation [10]. Recently, it has been suggested that the electrons are possibly trapped by defects or impurity and produce metastable states accompanied by lattice relaxation [39]. Consequently, the electronic structure and carrier mobility of GaAs/AlAs SL are influenced significantly by the point defects. Therefore, it is necessary to enhance the radiation tolerance of GaAs/AlAs SL to improve its electronic performance under radiation environment.
Выводы
In this work, a hybrid density functional theory study is performed to investigate the effects of point defect on the electrical properties of GaAs/AlAs superlattice (SL). The calculated defect formation energies show that the antisite defects are the most favorable in bulk GaAs and AlAs. In GaAs/AlAs SL structure, the antisite defects are always dominant under cation-rich and As-rich conditions and the interstitial defects are very difficult to form during the whole range of chemical potentials. It is shown that the different point defects have various effects on the electronic structures of GaAs/AlAs SL. The AsX (X =Al or Ga) and XAs antisite defects always induce metallicity, although the defective SLs with XAs antisites show spin splitting. As for vacancies, the defective SL with VAs shows metallicity character, and the group III vacancy defects reduce the band gap of the superlattice significantly. The metallicity is also found in the defective GaAs/AlAs SL with the interstitial defects. The further carrier mobility calculations show that the interstitial and vacancy defects reduce the electron mobility significantly, while the antisite defects have relatively smaller influence.
Сокращения
- 2-DEG:
-
Two-dimensional electron gas
- AIMD:
-
Ab initio molecular dynamics
- Al:
-
Алюминий
- AlAs:
-
Aluminum arsenide
- As:
-
Arsenic
- AsX :
-
As occupying the X lattice site
- DFT:
-
Функциональная теория плотности
- Ga:
-
Галлий
- GaAs:
-
Gallium arsenide
- HEMT:
-
High electron mobility transistors
- HSE:
-
Heyd-Scuseria-Emzefhof
- LED:
-
Light-emitting diode
- N:
-
Азот
- PDOS:
-
Partial density of state
- QCLs:
-
Quantum cascade lasers
- SL:
-
Superlattice
- VASP:
-
Vienna Ab Initio Simulation Package
- VX (X =Ga, Al or As):
-
X vacancy
- XAs :
-
X occupying the As lattice site
- Xint :
-
X interstitial
- Zn:
-
Zinc
Наноматериалы
- Раскрытие атомной и электронной структуры углеродных нановолокон с набором чашек
- Ультратонкий идеальный поглотитель и его применение в качестве плазмонного датчика в видимой области
- Исследование первых принципов стабильности и STM-изображения борофена
- Влияние отжига in situ на подвижность и морфологию органических полевых транзисторов на основе TIPS-пентацена
- Влияние отношения Li / Nb на получение и фотокаталитические характеристики соединений Li-Nb-O
- Влияние воды на структуру и диэлектрические свойства микрокристаллической и наноцеллюлозы
- Влияние толщины бислоя на морфологические, оптические и электрические свойства наноламинатов Al2O3 / ZnO
- Экспериментальное исследование характеристик потока и теплопередачи наножидкостей TiO2-вода в трубке со спир…
- Эффекты взаимодействия поверхностных плазмонных поляритонов и магнитных дипольных резонансов в метаматери…
- Исследование многоуровневой памяти с переключением сопротивления и зависящей от состояния памяти фотоэдс в…



