Исследование изменчивости контактной резистивной оперативной памяти с помощью стохастической модели вакансий
Аннотация
Изменчивость в резистивной ячейке памяти с произвольным доступом была одной из критических проблем при разработке массивов RRAM высокой плотности. Хотя источники изменчивости во время резистивного переключения различаются для разных пленок оксидов переходных металлов, обычно считается, что стохастическая генерация / рекомбинация кислородных вакансий является доминирующей причиной. Путем анализа экспериментальных данных устанавливается стохастическая модель, которая связывает последующие характеристики переключения с начальными состояниями контактных ячеек RRAM. Комбинируя модель проводящей сети и механизм туннелирования с помощью ловушек, влияние концентрации и распределения собственных кислородных вакансий в диэлектрической пленке RRAM демонстрируется с помощью моделирования методом Монте-Карло. Данные измерений на контактных массивах RRAM хорошо согласуются с характеристиками, прогнозируемыми моделью на основе наличия случайно распределенных собственных вакансий. Подтверждена сильная корреляция между характеристиками формования и начальными состояниями, которая связывает поведение формования с предварительным образованием кислородных вакансий. Это исследование обеспечивает всестороннее понимание источников изменчивости в контактных устройствах RRAM и схему обучения сбросу, чтобы уменьшить поведение изменчивости в последующих состояниях RRAM.
Фон
Резистивная память с произвольным доступом (RRAM) была расценена как многообещающее решение для энергонезависимого хранения данных из-за ее желаемых характеристик, таких как низкое энергопотребление, высокая скорость P / E и превосходная совместимость с логическим процессом CMOS [1,2,3 , 4]. Однако еще предстоит преодолеть множество препятствий, чтобы легко реализовать массивы памяти RRAM в современных КМОП-схемах [5, 6]. Одна из ключевых проблем в большом массиве RRAM заключается в различиях, существующих между ячейками и внутри них [7,8,9,10]. Было предложено множество моделей и имитаций для описания процесса стохастической генерации / рекомбинации кислородных вакансий (Vo-) в пленке оксида переходного металла (TMO) [11,12,13,14]. Ким и Бривио предложили модели сети случайных выключателей для имитации типичных электрических характеристик униполярной и биполярной RRAM соответственно [11, 12]. Однако все резисторы в этих исследованиях были настроены на постоянство без учета переноса электронов в пленке RRAM. Кроме того, поскольку представленные модели обсуждают стохастические процессы RRAM с одного уровня устройства, а не статистический анализ, изменчивость поведения RRAM в массиве не рассматривается и обсуждается в предыдущей работе [11,12,13,14]. Кроме того, наличие дефектов в диэлектрической пленке во время изготовления широко изучалось в течение многих лет [15, 16], но их влияние на резистивные характеристики переключения в RRAM все еще необходимо всесторонне проанализировать, чтобы технология могла быть применена в макросах памяти большого размера. Чтобы исследовать влияние внутреннего распределения Vo на характеристики RRAM, сеть резисторов, смоделированная на основе механизма туннелирования с помощью ловушек, построена для дальнейшего статистического анализа изменений и во время операций в этом исследовании [11,12,13,14,17 ]. Кроме того, процесс стохастической генерации Vo- моделируется методом Монте-Карло для установления корреляции между RRAM в его начальных состояниях и следующими характеристиками формирования [18,19,20]. Сильная корреляция между собственным Vo- и формирующим напряжением устанавливается путем проверки результата моделирования с данными измерений на контактных массивах RRAM [21]. Наконец, различные типы генерируемой токопроводящей нити (CF) и изменение состояния сопротивления после операций формования в результате внутреннего распределения Vo спроектированы и всесторонне исследованы. Кроме того, в этом исследовании предложено и продемонстрировано решение для уменьшения влияния преформинга на изменчивость Vo.
Методы
Данные измерений для дальнейшего статистического анализа изменчивости собираются с массивов 16 × 16 контактов RRAM (CRRAM), которые были изготовлены с помощью 28-нм логических процессов CMOS, где процесс изготовления CRRAM показан на рис. 1 [21]. Слой защитного оксида резистора (RPO) и межслойный диэлектрик (ILD) сначала наносятся после того, как процесс предварительной обработки завершен с сформированными транзисторами. Чтобы создать функциональную резистивную переключающую пленку, правильный размер контактного отверстия, размер контакта 30 нм × 30 нм, выполняется для предотвращения короткого замыкания W-вилки и диффузионной области n +. Наконец, по отдельности наносятся барьерный слой, TiN и вольфрамовая пробка. Поперечное сечение TEM-изображения CRRAM показано на рис. 2а. Как показано на рисунке, CRRAM последовательно соединен с n-канальным транзистором выбора. Структура 1T1R принята для обеспечения правильного выбора в массиве и предотвращения выбросов. На рисунке 2b показано отображение состава CRRAM. Его слой оксида переходного металла (TMO) толщиной 9 нм, состоящий из TiN / TiON / SiO 2 Пакет формируется между верхним вольфрамовым и нижним кремниевыми электродами. После изготовления устройства электрический анализ и построение физической модели в этом исследовании завершаются анализатором параметров полупроводников Aglient 4156C и программной платформой MATLAB соответственно.
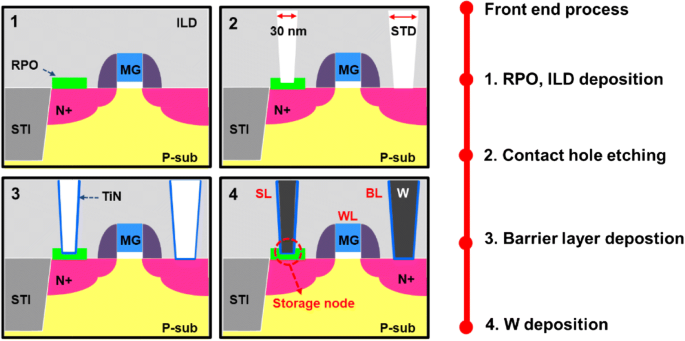
Последовательность операций контактной RRAM на 28-нм технологической платформе CMOS с металлическим затвором и высоким коэффициентом разрешения. Меньший размер контакта для CRRAM предназначен для контроля толщины травления для формирования функционального резистивного переключающего слоя
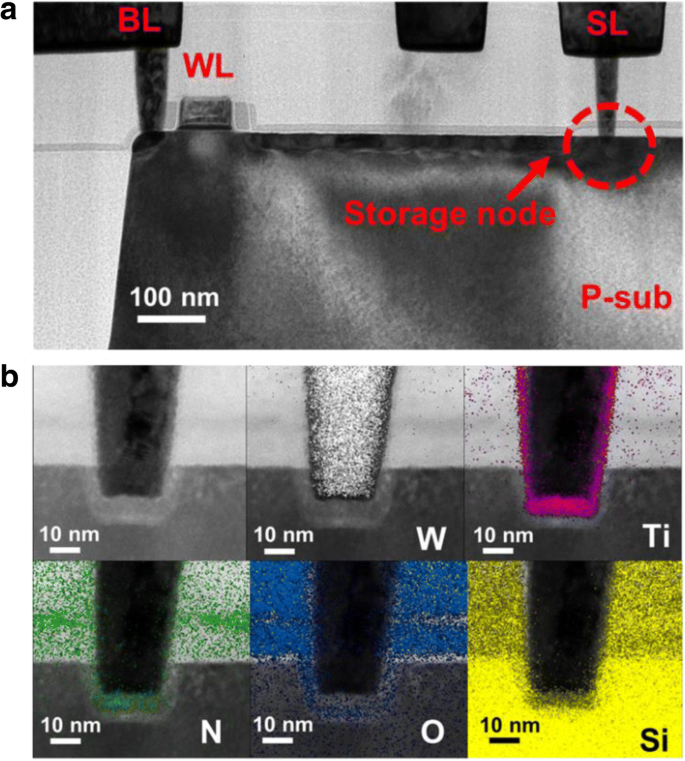
а ПЭМ-изображение поперечного сечения структуры 1T1R CRRAM. б Составное отображение CRRAM. Резистивная переключающая пленка состоит из TiN / TiON / SiO 2 . зажат между верхней вольфрамовой пробкой и нижним кремниевым электродом
Как сообщалось в предыдущем исследовании [22], в массиве CRRAM обнаружено широкое распределение начальных состояний. Чтобы исследовать причину изменения начального состояния, сначала на рис. 3 сравниваются толщины слоя TMO с различным начальным сопротивлением. Данные свидетельствуют об отсутствии значительной разницы в толщине между двумя ячейками с большой разницей в начальных уровнях сопротивления. Сообщалось о многих исследованиях, что Vo- генерируются в диэлектрической пленке или пленке RRAM во время изготовления [23,24,25,26], что означает, что разница в количестве и плотности Vo-, как ожидается, будет ответственна за начальные изменения проводимости.
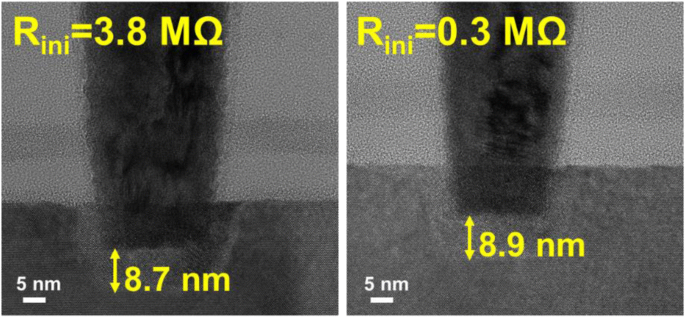
Сравнение толщины слоя TMO между двумя ячейками CRRAM с большой разницей начального сопротивления. Обе ячейки наблюдаются с толщиной диэлектрического слоя около 9 нм
Результаты и обсуждение
Внутренняя модель распределения вакансий
Чтобы имитировать взаимодействия между внутренними Vo-, была создана модель сети резисторов, показанная на рис. 4a [11,12,13,14]. Сопротивления в каждой сетке рассчитываются с помощью потока моделирования, показанного на рис. 4b, в то время как соответствующие используемые физические параметры перечислены в таблице 1. На основе ПЭМ-изображения CRRAM двухмерная структура шириной 30 нм и толщиной 10 нм. , определена для описания уровня TMO, как показано на рис. 5a. Сопротивление оксидного сайта, R оксид , и сетка сетки определяются свойством материала анатаз-TiO 2 , который использовался в качестве резистивного переключающего материала во многих исследованиях [27,28,29,30]. Из-за его тетрагональной структуры постоянные решетки анатаза-TiO 2 варьируются в зависимости от кристаллографической оси. Для простоты сетка в нашей модели настроена на 1 нм путем введения постоянной решетки в направлении c анатаза-TiO 2 [31,32,33]. Кроме того, сопротивления сеток также определяются путем ссылки на удельное сопротивление анатаза-TiO 2 [34, 35]. Как показано на рис. 5a, изначально внутри 2-мерной сетки задаются случайно распределенные Vo-. Зависимости тока проводимости CRRAM от температуры и электрического поля приведены на рис. 6a, b, соответственно. Ключевые характеристики туннельного тока с помощью ловушек (ТАТ) демонстрируются его слабым температурным эффектом и линейной зависимостью между ln (J) и 1 / E [17, 36]. Используя модель проводимости ТАТ, сначала необходимо рассчитать профиль потенциала внутри пленки TMO, чтобы в дальнейшем получить каждое локализованное сопротивление Vo. Ожидается, что распределение Vo- будет в основном влиять на ток проводимости, поскольку расстояние туннелирования изменяется между кислородными вакансиями. Сопротивление Vo-, R ij , затем рассчитывается по формуле. 1, который учитывает вероятности присутствия Vo на объекте и принимает модель ТАТ для вычисления вероятности туннелирования между состояниями вакансии.
$$ {R} _ {\ mathrm {ij}, N} =\ frac {R _ {\ mathrm {оксид}}} {\ alpha \ {C} _ {\ mathrm {Vo} -} ^ {\ kern0.75em \ beta} \ \ exp \ left (\ frac {\ phi} {d} \ right)} $$ (1)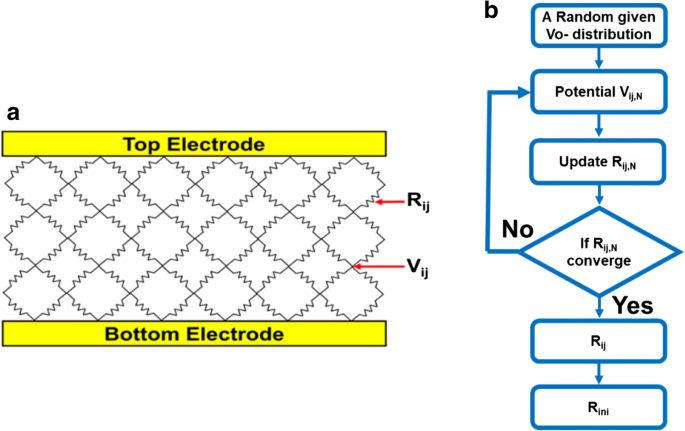
а Схема модели резисторной сети, состоящей из переменного локализованного сопротивления Vo-. Узлы в этой сети подключены друг к другу, чтобы моделировать взаимодействие между Vo-. б Поток моделирования изменчивости начального уровня сопротивления. Стохастическое распределение собственной Vo-эмерджи в процессе изготовления рассматривается методом Монте-Карло

а Случайное распределение собственного Vo- изначально дается в фильме RRAM. б Распределение локализованного сопротивления Vo, рассчитанное с учетом туннелирования с помощью ловушек. c R ini Распределение свежих клеток, собранных из массивов CRRAM, хорошо согласуется с данными моделирования с учетом механизма проведения ТАТ при преформинге Vo-
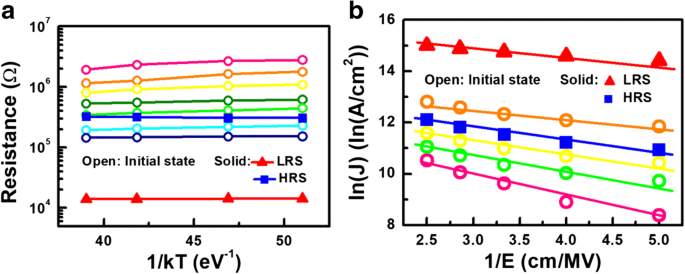
Механизм проведения CRRAM определяется проверкой a температурная зависимость и b зависимость от электрического поля. Считается, что туннелирование с помощью ловушек с последующим CRRAM связано с двумя характеристиками проводимости, слабой температурной зависимостью и линейным соответствием между ln (J) и 1 / E
Каждый R ij, N обновляется на каждой итерации до тех пор, пока результат в конечном итоге не сойдется. В качестве финального R ij распределение получается, как показано на рис. 5b, полное сопротивление, R ini , свежей клетки также можно спроецировать впоследствии, как показано на рис. 5c. Как видно на рис. 5c, изменение смоделированного R ini распределение, полученное предложенным потоком моделирования с учетом стохастического распределения и концентрации собственного Vo, хорошо согласуется с распределением R ini измеряется на массивах CRRAM. Следовательно, случайно распределенные внутренние слои Vo-in TMO, создающие несколько путей туннелирования, вносят свой вклад в широко распространенное начальное сопротивление, обнаруживаемое при предварительном формировании массивов CRRAM.
Анализ неоднородного процесса формования
После моделирования причин, связанных с изменением от ячейки к ячейке в свежем состоянии, анализируется операция формирования, инициализирующая характеристики резистивного переключения. Схема моделирования операции формовки в режиме развертки постоянного тока показана на рис. 7 [18,19,20]. Как изображено на рис. 8а, ячейка подключена к транзистору выбора последовательно с сопротивлением канала примерно 5 кОм в линейной области и током насыщения примерно 80 мкА. Из-за низкого формирующего напряжения необходимо учитывать механизмы проводимости и напряжения диэлектрика в режиме низкого электрического поля. На основе термохимической модели, предложенной в предыдущих исследованиях, было продемонстрировано точное предсказание разрушения диэлектрика [37,38,39,40]. Теоретические характеристики разрушения TiO 2 смоделированная термохимической моделью [41], показала характеристики, аналогичные наблюдаемым в CRRAM. Таким образом, скорость генерации Vo получается здесь на основе термохимической модели [42,43,44]. Согласно термохимической модели, точки сетки рядом с Vo- определяются как слабое место в непосредственной близости от дефектов. Присутствие Vo- также вызывает локализованное усиленное поле, показанное на рис. 8b, и ускоряет процесс генерации Vo- [45]. Учитывая время до процесса пробоя диэлектрика в термохимической модели с полевой зависимостью exp. (- E), вероятность образования Vo P ij рассчитывается по следующему уравнению [42].
$$ {P} _ {\ mathrm {ij}} =\ gamma \ \ exp \ left (\ mathrm {E} \ right) \ \ left \ {\ begin {array} {c} \ kern1.75em \ upgamma =0, \ mathrm {if} \ \ mathrm {site} \ \ mathrm {is} \ \ mathrm {not} \ \ mathrm {weak} \ \ mathrm {spot} \\ {} \ upgamma =1, \ mathrm {если } \ \ mathrm {site} \ \ mathrm {is} \ \ mathrm {weak} \ \ mathrm {spot} \ end {array} \ right. $$ (2)
Последовательность моделирования процесса формовки на основе термохимической модели, предполагая время разрушения диэлектрика с зависимостью от электрического поля, равной exp. (- E)
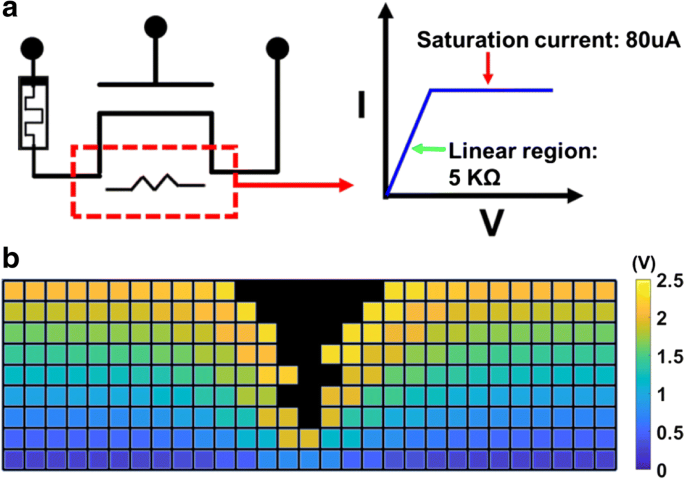
а Операция формования моделируется CRRAM, последовательно соединенной с идеальным транзистором. б Неравномерное распределение электрического потенциала, возникающее из-за ранее существовавшего Vo-, индуцирует локализованное поле и ускоряет образование новых дефектов
Критический уровень, P g , и критерий P ij > P g , определяются для того, генерируется ли новый Vo-. Для обновления нового распределения Vo- на каждой итерации применяется процесс линейного изменения до тех пор, пока формирующее напряжение не достигнет 2,7 В. Наконец, со случайным распределением собственного Vo-, низкий уровень сопротивления R формирование после операции формования можно получить. На основе приведенной выше модели смоделированный R формирование распределение прогнозировало широкие вариации, как показано на рис. 9a, и рассчитанный I-V характеристики хорошо согласуются с данными измерений. Кроме того, также исследуется корреляция между характеристиками формования и начальными состояниями. Более высокая концентрация и локализованное распределение Vo ускоряют процесс формования. Следовательно, положительная корреляция между формовочным напряжением и R ini находятся как в результатах моделирования, так и в данных измерений, как показано на рис. 9b.
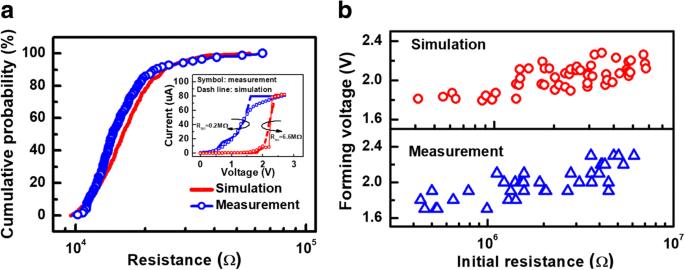
а Моделируемое распределение сопротивления формовочной операции хорошо согласуется с результатом измерения. б Положительная корреляция между начальным сопротивлением и формовочным напряжением обнаруживается как в измеренных, так и в смоделированных данных из-за большего количества слабых мест и более высокой напряженности электрического поля, создаваемого предварительным формованием. Во-
Более того, Vo-, генерируемый в процессе формования, индуцирует проводящий путь и приводит к изменению CF в ячейках, где эволюция CF в процессе формирования изображена на рис. 10. Для ячеек с высоким R ini , меньше собственных Vo- и слабых мест, как показано на рис. 10a. После операции формовки между электродами с большей вероятностью появится единственный токопроводящий путь. Однако рост CF в клетках с большим количеством собственного Vo-, показанный на рис. 10b, имеет тенденцию к более широкому распространению; следовательно, дендритные CF образуются после формирования. Корреляция между различными топографиями CF и распределением Vo в свежем состоянии также подтверждается данными измерений. Vo- и CF в слое TMO, как известно, приводят к характерному случайному телеграфному шуму (RTN) во время процесса захвата / снятия захвата электронов [46]. Колебания сопротивления возникают, если проводящий путь блокируется захваченными электронами, и сопротивление уменьшается, когда электроны освобождаются от ловушек. RTN-анализ CRRAM после формирования представлен на рис. 11. Регулярные двухступенчатые колебания сопротивления обнаруживаются в ячейках с высоким R . ini , когда захват / отвод электронов происходит в устройстве с одним доминирующим КФ. С другой стороны, многоуровневое RTN встречается в ячейках с низким R ini который, как ожидается, будет препятствовать дендритному МВ более чем одним путем. Статистические результаты RTN суммированы на рис. 12, путем анализа измерения RTN более 200 ячеек CRRAM. Данные показывают, что ячейки с высоким R ini имеют тенденцию демонстрировать только двухуровневую RTN, что более вероятно в устройствах с одним доминирующим CF [46,47,48,49]. Изменение сопротивления после операции формования показано на рис. 13. Данные показывают, что более высокие колебания сопротивления обнаруживаются как в результате измерения, так и в результате моделирования в ячейках с низким R ini . Поскольку менее ограниченные CF подталкивают транзистор выбора раньше, входящий в область насыщения, ячейка может быть неправильно сформирована, что приведет к более широким уровням сопротивления в состояниях с низким сопротивлением.

Развитие МВ в ячейке с а высокое начальное сопротивление и b низкое начальное сопротивление. Более высокая собственная концентрация Vo в слое TMO приводит к случайной генерации Vo в слабых местах. Эти Vo- также соединяются друг с другом, образуя дендритные пути

Топографии CF в ячейке с a высокое начальное сопротивление и b низкое начальное сопротивление анализируется соответствующими данными RTN. Возникновение множественных колебаний сопротивления в клетках с низким начальным сопротивлением и более внутренним. Подтверждает существование дендритных CF в слое TMO

Обобщена корреляция между исходным уровнем резистентности и уровнем RTN на клетках CRAM. Более высокая вероятность двухуровневого колебания сопротивления ожидается для ячеек с одним доминирующим проводящим путем, который сильно коррелирует с ячейками с высоким R ini
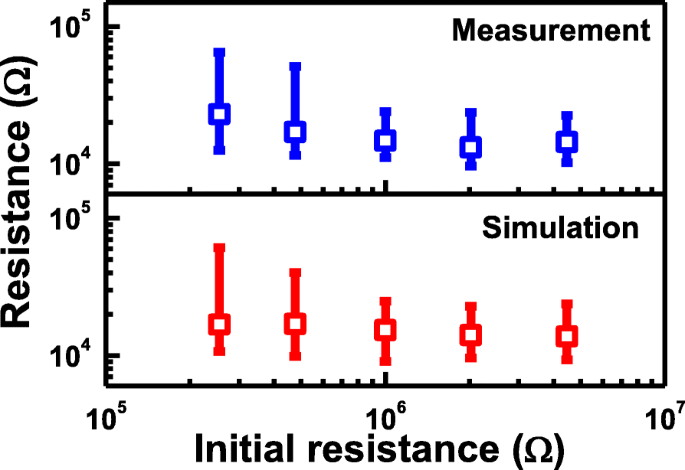
Анализ изменения уровня сопротивления после операции формования исследуется посредством моделирования и измерения. Более высокая вариабельность, вызванная генерацией дендритного CF, обнаруживается в клетках с низким исходным сопротивлением
Чтобы уменьшить изменчивость формирования, вызванную внутренним Vo- в слое TMO, перед формированием предлагается применять операцию обучения сбросу, которая разворачивает SL до 1,4 В при фиксированном напряжении WL 2 В, вслепую ко всем ячейкам памяти в массиве CRRAM. Ожидается, что эта операция устранит ранее существовавшие дефекты, существующие в ячейках с низким R ini и для обеспечения более ограниченного роста CF во время последующего процесса формования. Из-за низкого приложенного напряжения нет изменений в элементах с высоким R ini после тренировочного процесса. При тренировочной операции бланкетного сброса сопротивление ячеек с низким R ini , увеличивается, не нарушая ячеек с высоким R ini , как показано на рис. 14. Впоследствии можно получить более однородные характеристики формования.

Предлагается применить обучающую операцию по общему сбросу к массиву CRRAM. Сопротивление в ячейках с низким R ini увеличивается за счет уничтожения внутренних дефектов, но ячейки с высоким R ini не беспокоит
Выводы
Модель резисторной сети, учитывающая эффект локального поля и туннельную проводимость с помощью ловушек между Vo-, была успешно создана. С помощью моделирования методом Монте-Карло исследуется изменчивость клеток в зависимости от их начального сопротивления, а также процесс формирования. Изменение свежих состояний CRRAM может быть успешно объяснено случайным образом заданным распределением собственного Vo-. Прогнозируемое распределение сопротивления после формовки также хорошо согласуется с результатом измерения за счет применения термохимической модели. Обсуждается рост CF во время формования, и он связан с изменчивостью, наблюдаемой в этом процессе. Наконец, предлагается операция настройки сброса для дальнейшего уменьшения изменчивости формования, вызванной внутренним Vo- в слое TMO. Сильная корреляция между начальными состояниями и характеристиками формирования обеспечивает руководство для новых адаптивных операций для будущего развития технологий RRAM.
Сокращения
- CF:
-
Проводящая нить
- CRRAM:
-
Контактная резистивная оперативная память
- C Vo- :
-
Vo- концентрация
- d:
-
Расстояние туннелирования
- E:
-
Электрическое поле
- ILD:
-
Межслойный диэлектрик
- N :
-
Время итерации
- P g :
-
Вероятность переключения порога
- P ij :
-
Вероятность Vo-генерации
- R формирование :
-
Сопротивление после операции формования
- R ij :
-
Локализованное сопротивление Vo-сайта
- R ini :
-
Начальное состояние сопротивления
- R оксид :
-
Локальное сопротивление оксидного участка
- RPO:
-
Оксид защиты резистора
- RRAM:
-
Резистивная память с произвольным доступом
- RTN:
-
Случайный телеграфный шум
- ТАТ:
-
Туннелирование с помощью ловушек
- TMO:
-
Оксид переходного металла
- V f :
-
Формовочное напряжение
- V ij :
-
Возможный
- Vo-:
-
Кислородная вакансия
- α :
-
Параметр подгонки
- β :
-
Параметр подгонки
- γ :
-
Параметр подгонки
- ϕ :
-
Разность электрических потенциалов
Наноматериалы
- ПРИМЕР:путь Honda
- Янтракрафт и Золотой храм
- Модель удержания TaO / HfO x и TaO / AlO x RRAM с характеристиками самовосстанавливающегося переключателя
- Исследование новой червеобразной мицеллярной системы, усиленной наночастицами
- Интегрированная RRAM 4T SRAM с самоторможением резистивной коммутационной нагрузки с помощью логического процес…
- Исследование первых принципов стабильности и STM-изображения борофена
- Влияние контактной неравновесной плазмы на структурные и магнитные свойства шпинелей Mn Х Fe3 - X О4
- Исследование многоуровневой памяти с переключением сопротивления и зависящей от состояния памяти фотоэдс в…
- Коллективное исследование моделирования и имитации резистивной оперативной памяти
- Двухэтапная методология изучения влияния агрегации / агломерации наночастиц на модуль Юнга полимерных нанок…



