Туннелирование оксида алюминия, осажденного атомным слоем:коррелированное исследование структурных / электрических характеристик для поверхностной пассивации кремниевых переходов
Аннотация
Пассивация - ключевой процесс оптимизации кремниевых p-n-переходов. Среди различных технологий, используемых для пассивирования поверхности и контактных поверхностей, широко используется оксид алюминия. Одним из ключевых параметров является толщина пассивирующего слоя, который обычно наносится с использованием метода атомно-слоистого осаждения (ALD). Цель данной статьи - представить коррелированные структурные / электрические исследования пассивирующего эффекта оксида алюминия на Si-переходы для получения оптимальной толщины пассивирующего слоя оксида алюминия. Наблюдения с помощью просвечивающего электронного микроскопа высокого разрешения (HRTEM) в сочетании с измерениями энергодисперсионного рентгеновского излучения (EDX) используются для определения толщины оксида алюминия в атомном масштабе. Коррелированные электрические параметры измеряются как с помощью симулятора солнечного излучения, так и с помощью Suns-Voc компании Sinton. измерения. Наконец, оптимальная толщина оксида алюминия составляет 1,2 нм.
Введение
Снижение потерь на поверхностную рекомбинацию в кремниевых p-n-переходах имеет первостепенное значение для повышения эффективности поглощения света и его преобразования в фототок с солнечными элементами в качестве одного из основных приложений [1, 2]. Среди ключевых процессов, которые могут улучшить рекомбинацию дефектов в кремниевых переходах, пассивация поверхности и контактов была и всегда имеет первостепенное значение. Пассивация передней и задней поверхности была разработана как для освещенных неметаллизированных областей, так и для металлических кремниевых контактов [3, 4]. Интерфейс металл-кремний отличается большой рекомбинацией, поэтому были разработаны два варианта минимизации потерь в области контакта:небольшая площадь контакта, связанная с низким локальным уровнем легирования, или локальная пассивация границы раздела металл-кремний за счет введения тонкого туннелирования. диэлектрический слой. Недавно был предложен новый путь с многообещающим потенциалом с использованием слоя пассивирования, селективного по отношению к носителям [5]. В этом случае одна полярность носителей заряда может пройти к металлу, тогда как другая полярность заблокирована.
Среди всех пассивирующих слоев оксид алюминия (Al 2 О 3 ), осажденный методом атомно-слоистого осаждения (ALD), является одним из наиболее часто используемых методов, даже если может быть применен процесс плазменного химического осаждения из паровой фазы (PECVD) [6, 7]. ALD позволяет хорошо контролировать толщину вплоть до атомного масштаба, в то время как использование оксида алюминия приводит к хорошей химической пассивации интерфейсных состояний, а также к эффективной пассивации эффекта поля за счет локализованных зарядов в оксидном слое [8]. Например, Elmi et al. показали, что введение внедренных наночастиц Ag в тонкий слой оксида алюминия может эффективно усилить пассивацию эффекта поля [9]. Известно, что знак и плотность локализованных зарядов, а также толщина слоя оксида алюминия являются важными параметрами для пассивации поверхности. Было опубликовано множество работ по изучению влияния толщины глинозема на характеристики устройства; однако нет единого мнения об оптимальной толщине оксида алюминия, поскольку в литературе она варьируется от 0,24 до 30 нм, как это обобщено в таблице 1. Таблица 1 иллюстрирует разброс оптимизированной толщины оксида алюминия. Фактически, многие данные касаются скорости поверхностной рекомбинации (Se), которая не соответствует измерениям на изготовленных солнечных устройствах. Общая тенденция заключается в уменьшении содержания Se для больших значений толщины из-за лучшей химической пассивации за счет присутствия водорода в слое оксида алюминия, который пассивирует пограничные состояния во время постростового термического отжига.
Richter et al. сообщил, что ток насыщения эмиттера снизился до 30 фА / см 2 может быть получен для тонкого слоя (от 0,5 до 3 нм), но с пакетной структурой, состоящей из оксида алюминия и 70 нм SiN x [17]. Наилучший пассивированный контакт металл-кремний наблюдается с Al 2 толщиной 0,24 нм. О 3 [18]. Наконец, что касается уровней допирования и типов, пассивация более эффективна на n + но SiO 2 Структура пакета / оксид алюминия дает возможность настраивать плотность локализованных зарядов и может использоваться как с n-, так и с p-типом [23]. Тем не менее, лишь несколько работ продемонстрировали корреляцию между качеством поверхности раздела подложка / оксид алюминия и электрическими характеристиками устройств. Таким образом, необходимо проводить систематические наблюдения в атомном масштабе за пассивирующим слоем оксида алюминия и получать оптимальное значение толщины оксида алюминия, коррелирующее с электрическими характеристиками.
В этой статье для пассивирования имплантированного Si n + использовались слои оксида алюминия, нанесенные методом ALD с различной толщиной от 0,24 до 1,9 нм. -p переходы. Граница раздела слоя оксида алюминия на передней поверхности Si-перехода изучалась с помощью просвечивающего электронного микроскопа высокого разрешения (HRTEM), в то время как толщина слоя оксида алюминия коррелировала с соответствующими электрическими параметрами, такими как последовательное сопротивление, коэффициент идеальности, срок службы, внешний вид. квантовая эффективность (EQE) и эффективность преобразования энергии (PCE). Suns-Voc Синтона были проведены измерения для устранения влияния последовательного сопротивления. Наконец, была получена оптимизированная толщина оксида алюминия 1,2 нм. Следует отметить, что мы сосредоточимся здесь только на пассивации переднего контакта кремниевых p-n-переходов; эффективность устройства не оптимизирована полностью, что не входит в цель данной работы.
Методы
Изготовление устройства
На рисунке 1а показан процесс изготовления имплантированного Si n + . -p переходы с пассивацией поверхности Al 2 О 3 / SiN x :H стеки. В качестве подложек использовались четырехдюймовые пластины кремния p-типа (100), легированного бором, с удельным сопротивлением 5–10 Ом · см. Перед проведением n + образцы очищали раствором пираньи и дистиллированной водой. верхний слой. Имплантация ионов фосфора проводилась с использованием дозы 10 14 ат / см 2 при 180 кэВ с последующим отжигом при 900 ° C в течение 5 мин для активации легирующих примесей. Подробное описание технологического процесса можно найти в наших предыдущих работах [24, 25].

а Схема процесса изготовления имплантированного Si n + -p переход пассивирован Al 2 О 3 / SiN x куча. б Изображение HRTEM, снятое вдоль направления [011] кремниевой подложки. Профиль интенсивности, соответствующий белому прямоугольнику (поверх слоя кремнезема видна пленка оксида алюминия толщиной около 0,9 нм). c , d STEM-изображения HAADF двух слоев оксида алюминия, выращенных методом ALD, с соответствующими картами STEM EDX для Al, O и Si. Более яркие контрасты на изображениях HAADF в верхней части слоя кремнезема обусловлены более высокой плотностью (более высокое среднее значение Z значение) по сравнению с кремнеземом или нитридом кремния. Профили интенсивности дают толщину слоев оксида алюминия ~ 1,2 нм и 1,9 нм соответственно
Ультратонкий Al 2 О 3 туннельный слой с ожидаемой толщиной d Диапазон от 0,24 до 1,9 нм был нанесен с использованием метода ALD. Обратите внимание, что эта толщина была выведена из средней толщины, определенной с помощью эллипсометрической спектроскопии, полученной для тонких пленок оксида алюминия, выращенных с разным числом циклов. За один цикл ALD нанесен один монослой, равный 0,12 нм. Соединения без глинозема ( d =0), т.е. с непассивированными контактами металл-кремний, но КПД очень низкий, всего 0,4% [9]. Осаждение оксида алюминия проводили в системе PICOSUN R200 термическим способом. Используемые реагенты:триметилалюминий (ТМА) и H 2 . O, а температура роста - 290 ° C. Во время процесса ALD для окисления предшественника ТМА использовались водные циклы. В результате тонкий SiO 2 Оксидный слой был нанесен между поверхностью кремния и слоем оксида алюминия из-за естественного окисления поверхности кремния. Толщина такого естественного оксидного слоя, наблюдаемая с помощью ПЭМ, была близка к 1,5 нм. Во-вторых, SiN x толщиной 80 нм Слой:H, который соответствует значению, обычно используемому в промышленности Si-солнечных элементов, был нанесен на образец с использованием подхода PECVD со смесью SiH 4 и NH 3 . Температура осаждения составляла 340 ° C, давление - 1 торр, мощность - 10 Вт. Затем образец отжигали при 650 ° C в течение 10 минут, чтобы H диффундировал в Si.
Пальцевые электроды из Ti / Au (20/800 нм) были нанесены на лицевую сторону путем напыления с теневой маской после открытия SiN x :H покрытие с использованием реактивного ионного травления (RIE). Затем наносился задний контакт путем испарения пленки Ti / Au толщиной 400 нм. Наконец, образцы были отожжены при 400 ° C в течение 10 минут для образования омического контакта.
Характеристика
ПЭМ-анализ проводился с использованием тонких фольг поперечного сечения, полученных с помощью сфокусированного ионного пучка (FIB) на двухлучевом Nanolab 600i FEI Helios. Перед ионным утонением были нанесены углеродная пленка и слой платины для защиты верхней поверхности образца. Наблюдения с помощью ПЭМ, многоугольного кольцевого темного поля (HAADF) и STEM-рентгеновского излучения (EDX) проводились с помощью холодного микроскопа FEG JEOL ARM200F с двойной коррекцией, работающего при 200 кВ и оснащенного спектрометром EDX (CENTURION от JEOL. ). Обработка изображений производилась с помощью DIGITALMICROGRAPH (GATAN). Изображения были получены электронным пучком, параллельным направлению [011] подложки с ориентацией Si (100). В этой ориентации электронный луч параллелен границе раздела оксид алюминия / подложка.
Электрические параметры при освещении были измерены с использованием имитатора солнечного излучения (Oriel®Sol3ATM) при освещении AM 1.5G, в то время как спектры внешней квантовой эффективности (EQE) были измерены в стандартных условиях измерения на системе 7-SCSpec производства 7-STAR Co. Чтобы преодолеть влияние последовательного сопротивления, Sinton's Suns-Voc измерения были выполнены [26,27,28]. Suns-Voc Синтона Методика представляет собой метод разомкнутой цепи для определения характеристик p-n-перехода или солнечного элемента, который позволяет сравнивать электрические параметры, заданные имитатором солнечной энергии, с параметрами, рассчитанными без влияния последовательного сопротивления. Установка включает в себя ксеноновую лампу-вспышку с полным набором фильтров нейтральной плотности и пластинчатый столик с регулируемой температурой 25 ° C. Стандартный формат кривой I-V с оценкой Jsc может выполняться либо путем прямого зондирования областей p + и n +, либо путем зондирования слоя металлизации. Эти данные могут использоваться непосредственно для определения материала и качества пассивации солнечных элементов.
Результаты и обсуждение
Рисунок 1 (b) представляет собой типичное изображение ПЭМВР, полученное вдоль направления [011] кремниевой подложки. В этом направлении электронный пучок обязательно параллелен границе раздела пленочной подложки. Обратите внимание, что верхняя поверхность подложки не идеально ровная. Это наблюдение подразумевает, что границы раздела между различными вышеупомянутыми аморфными слоями (диоксид кремния, оксид алюминия и нитрид кремния) также являются грубыми, что делает их определение очень сложной задачей. Действительно, измерение толщины всегда завышается из-за этой шероховатости. Вставка на рис. 1 (b) представляет собой профиль интенсивности, перпендикулярный подложке и в области шириной 10 нм, как показано белым прямоугольником изображения HRTEM. Этот профиль свидетельствует о различии в контрасте между тремя аморфными слоями наверху подложки Si. Действительно, из-за Z-контраста над слоем диоксида кремния можно наблюдать более темный слой толщиной 0,9 нм, который, скорее всего, является слоем оксида алюминия, выращенным методом ALD. Чтобы подтвердить этот результат, было выполнено формирование изображения в темном поле с большим углом на двух разных слоях оксида алюминия в сочетании с химическим картированием, полученным с помощью сканирующей просвечивающей электронной микроскопии в сочетании с энергодисперсионным рентгеновским спектрометром. На рис. 1 (c) и (d) представлены два набора данных, иллюстрирующих две разные толщины слоя оксида алюминия.
Оба набора состоят из изображения HAADF, представляющего верхнюю поверхность подложки Si (вдоль направления [011]) и трех аморфных слоев, а именно кремнезема (темная область), оксида алюминия (более белая область) и, наконец, нитрида кремния (промежуточный контраст). Обратите внимание, что некоторые яркие точки видны особенно на рис. 1 (d). Эти особенности обусловлены наличием платиновой пыли, поступающей из защитного слоя во время подготовки тонкой фольги методом ФИП. Для обеих структур химические карты алюминия, кислорода и кремния STEM EDX приведены в верхней части рисунков 1 (c) и (d). Карты алюминия хорошо показывают присутствие алюминия, что соответствует более белым областям изображений HAADF. Было обнаружено, что некоторые яркие точки присутствуют в соседних областях, но они соответствуют некоторому «шуму» на заднем плане во время съемки. На кислородных картах видны более широкие области, поскольку они отображают слои оксида алюминия и кремнезема. Наконец, карты кремния изображают темную линию, соответствующую слоям оксида алюминия, единственному слою без кремния. Из-за явлений диффузного рассеяния химические карты не являются наилучшими данными для правильной оценки значений толщины.
Чтобы более четко показать различный контраст, вызванный присутствием слоя оксида алюминия, мы построили профили интенсивности для обоих изображений, как показано на рис. 1 (c) и (d). Как ясно демонстрируют эти профили, широкая полоса указывает более яркие области, соответствующие слою оксида алюминия. Учитывая, что оксид алюминия имеет определенную шероховатость, разумно оценить толщину слоя, измерив расстояние между двумя вертикальными линиями, расположенными в середине скатов с каждой стороны слоя. Результаты составляют примерно 1,2 нм и 1,9 нм соответственно.
Эволюция последовательного сопротивления R s
Как показано на рис. 2a, R s почти постоянный ( R s =1,1 ± 0,15 Ом) от d =От 0,24 до 1,2 нм и резко увеличивается до 3,1 ± 0,2 Ом для d =1,9 нм. Измеренное сопротивление R s представляет собой сложение эмиттерной и базовой зон, металлических пальцев и сопротивления, связанного с тонким SiO 2 оксидный слой, вместе обозначенный R я , плюс сопротивление R чт связанный со слоем оксида алюминия. Для всех образцов в пределах воспроизводимости технологической процедуры, представленной планками погрешностей (± 0,15 Ом) на рис. 4, R я считается постоянным, поскольку применяется один и тот же технологический процесс. г - единственный измененный параметр. Итак, как R s постоянно до d =1,2 нм и как туннельное сопротивление R чт очевидно, зависит от d , заключаем, что до d =1,2 нм, R чт варьируется, но его вариация меньше разброса измерений, т.е. 0,15 Ом. R чт напрямую связана с обратной величиной коэффициента переноса γ для туннелирования, то есть с вероятностью туннелирования носителей через прямоугольный барьер, заданной формулой [29]:
$$ \ gamma \ приблизительно \ kern0.5em \ exp \ left (- \ frac {2d \ sqrt {2q {m} ^ {\ ast} {\ upphi} _ {\ mathrm {B}}}} {\ overline { h}} \ right) $$ (1)где м * эффективная масса барьера из оксида алюминия ( м * =0,75 м 0 [30], с м 0 как масса электрона), h постоянная Планка, q - заряд электрона, а ϕ B эффективная высота барьера, равная смещению зоны проводимости ΔE C между диэлектриком и n + силиконовый контакт. Туннельное сопротивление определяется по формуле:
$$ {R} _ {\ mathrm {thu}} =Ax {\ gamma} ^ {- 1} $$ (2)где A является константой. Для d =1,9 нм, R чт соответствует шагу, измеренному на R s , и поэтому мы выводим R чт (1,9 нм) =2 Ом. Исходя из этого значения, A можно рассчитать. Для этого нам нужно знать ϕ B который равен смещению зоны проводимости между Si и диэлектрическим слоем, поскольку уровень Ферми находится в пределах минимума зоны проводимости в сильно легированном n + силиконовый контакт. Фактически, диэлектрический слой представляет собой SiO 2 размером несколько нанометров. / Al 2 О 3 стека, поэтому смещение полосы зависит от этих двух диэлектрических слоев. Смещение зоны проводимости находится в диапазоне 3,13–3,5 эВ и 2,08–2,8 эВ для SiO 2 . и Al 2 О 3 [31] соответственно. В таблице 2 приведены значения A префактор, выведенный из значения R s измерено на d =1,9 нм, для двух крайних значений ϕ Б.
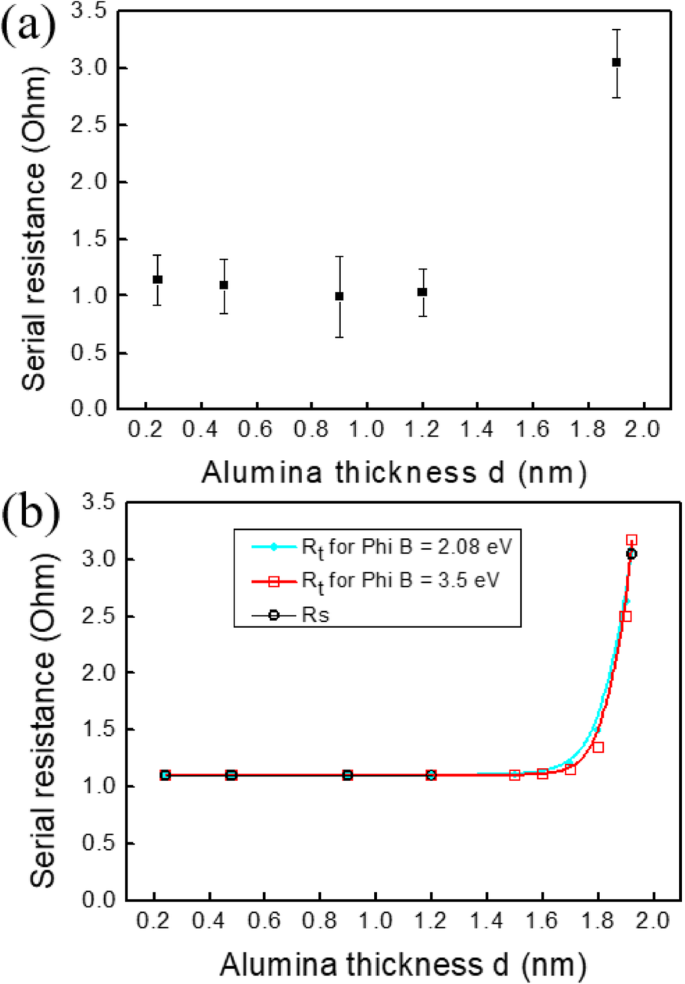
а Эволюция последовательного сопротивления R s от толщины глинозема. б Экспериментальные значения R s и смоделировал один R simu рассчитано для ϕ B =2,08 и 3,5 эВ в зависимости от толщины оксида алюминия d (нм)
На рис. 2b мы построили R s и полное моделируемое сопротивление R simu = R я + R чт для двух ϕ B значения по сравнению с d ( R s было принято к своему среднему значению 1,1 Ом между d =0,24 и 1,2 нм). Как бы то ни было ϕ B , для d ≤ 1,2 нм, R чт незначительно. Это подтверждает нашу исходную гипотезу:ступенька, наблюдаемая при 1,9 нм в эволюции R s связано с эволюцией туннельного барьера. Для d менее 1,2 нм, основной эффект слоя оксида алюминия заключается в пассивировании n + контактов и p-поверхности за счет полевой пассивации, связанной с фиксированными зарядами, локализованными в оксиде. Для больших d значения, слой оксида алюминия создает паразитное последовательное контактное сопротивление, которое снижает электрические характеристики ячеек.
Наконец, мы можем оценить удельное сопротивление ρ слоя оксида алюминия. Для этого считаем измеренное сопротивление R для значения толщины 1,9 нм. Эффект туннелирования уменьшается, и слой начинает иметь «объемное» поведение (грубое приближение). При такой толщине глинозема ( d =1.9 нм) и с учетом поверхности S контакта (10,54 мм 2 ), выводим ρ используя следующее уравнение:
$$ R =\ rho \ \ frac {d} {S} $$ (3)Это приводит к ρ =1,1 × 10 6 Ом · см. Для сыпучих материалов, представленных на рынке, в зависимости от температуры роста и примесей в оксиде алюминия значение удельного сопротивления варьируется от 10 5 до 10 14 Ом · см (от Kyocera ™). Итак, наше расчетное значение показывает, что у нас есть «псевдо-объемный» материал на границе между тонким и объемным слоями.
Эволюция фактора идеальности n
При наличии последовательного сопротивления ВАХ солнечного элемента имеет вид:
$$ I ={I} _ {\ mathrm {L}} - {I} _0 \ \ exp \ left (\ frac {q \ left (V + I \ {R} _ {\ mathrm {s}} \ right )} {n \ k \ T} \ right) $$ (4)где I - выходной ток ячейки, I L ток, генерируемый светом, V напряжение на ячейке, T - температура, k постоянная Больцмана, n - коэффициент идеальности, а R S - последовательное сопротивление ячеек. Для низкого уровня впрыска, только с межполосной рекомбинацией или рекомбинациями Шоттки-Рид-Холла, коэффициент идеальности n меньше 2. Оно достигает значения 1, когда рекомбинация ограничивается неосновными носителями [31]. Увеличение на n указывает на то, что имеет место необычный механизм рекомбинации с участием как неосновных, так и основных носителей [32]. Итак, n является сигнатурой рекомбинации (или пассивации) устройства. Кроме того, n также связан с R s что увеличивает коэффициент идеальности [33]. Эволюция n в зависимости от толщины глинозема показана на рис. 3а.

а Эволюция фактора идеальности n от толщины глинозема d . б Эволюция времени жизни τ от толщины глинозема d
Для небольшого значения толщины (0,24 нм) n больше 2, что является признаком непассивированной поверхности. По мере увеличения толщины глинозема n уменьшается и стабилизируется на уровне около 1,5, что свидетельствует об эффективном пассивировании через оксид алюминия. Для значения толщины оксида алюминия 1,9 нм n резко возрастает до 4, что соответствует резкому увеличению R s . Итак, оба R s и н показывают, что слой оксида алюминия хорошо пассивирует Si-переход, связанный с низким туннельным барьером. Для d =1.9 нм, туннельный барьер увеличивается с последующей деградацией на R s и, следовательно, фактора идеальности.
Срок службы
Еще один ключевой параметр, который иллюстрирует эффект пассивации, - это срок службы фотоносителей τ . Действительно, время жизни напрямую связано со скоростью рекомбинации носителей, связанной с концентрацией поверхностных дефектов (центров рекомбинации). Он был рассчитан на основе измеренного напряжения холостого хода, его производной по времени и фактического уровня освещенности. Его эволюция в зависимости от толщины глинозема представлена на рис. 3б. Изменение времени жизни согласуется с предыдущими результатами. Среднее значение низкое, в основном из-за непассивированного заднего контакта. Однако он явно демонстрирует увеличение с толщиной оксида алюминия, соответственно лучшей пассивации переднего контакта и с оптимальным значением толщины 1,2 нм. Для d =1.9 нм время жизни уменьшается. Возможно, что по мере увеличения толщины оксида алюминия из SiN x диффундирует меньше водорода. слой к контакту во время термического отжига, и, следовательно, эффект химической пассивации уменьшается.
На рис. 4 представлены результаты измерения EQE в зависимости от толщины глинозема. Наилучший EQE наблюдается для d =1,2 нм. Основное улучшение наблюдается при длине волны от 600 до 900 нм. Во всех случаях EQE далек от идеальной прямоугольной формы в ИК-диапазоне, что является признаком рекомбинации на непассивированном заднем контакте.
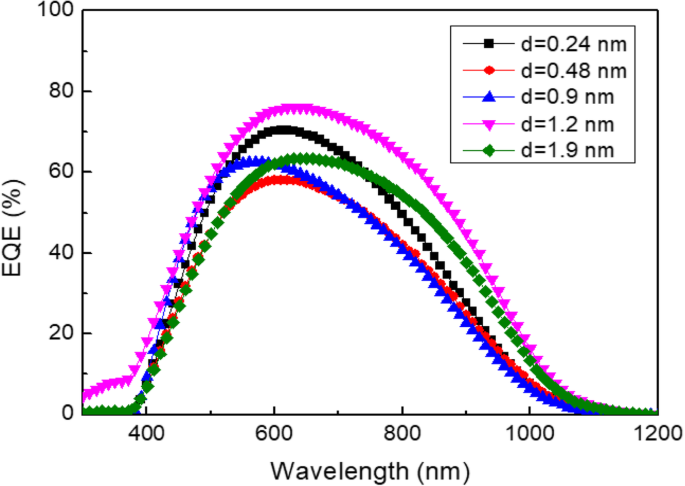
Измеренный EQE в зависимости от длины волны для глинозема разной толщины
Чтобы завершить анализ, мы изучили электрические параметры при освещении, измеренные как на солнечном симуляторе, так и с использованием метода Синтона. На рисунке 5 показана зависимость энергоэффективности солнечных элементов от толщины глинозема:измеренная с имитатором солнечной энергии и оптимизированная без R s . По мере увеличения толщины глинозема измеренный PCE увеличивается из-за лучшего эффекта пассивации, достигая максимального значения 5% для d =1,2 нм, перед уменьшением на d =1,9 нм. Исправленный PCE для R s =0 имеет довольно постоянное значение около 11%. Это разумное значение, учитывая только пассивирование заднего контакта. Для d =1,9 нм, скорректированный выход снижается до 6% из-за паразитного шунтирующего сопротивления.
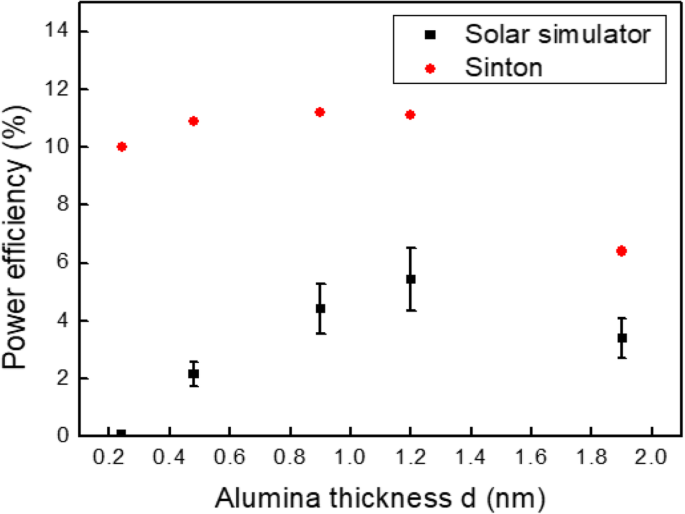
Измеренная и экстраполированная энергоэффективность в зависимости от толщины глинозема d
Выводы
Оксид алюминия, нанесенный методом ALD, является эффективным методом пассивирования электрических контактов, что является ключевым параметром кремниевых p-n-переходов. В данной работе для пассивирования имплантированного Si n + использовался туннельный слой оксида алюминия, осажденный атомными слоями различной толщины от 0,24 до 1,9 нм. -p переходы. Мы провели систематический структурный анализ HRTEM, STEM HAADF и STEM EDX, коррелированный с полным набором электрических измерений с использованием симулятора солнечного излучения и анализа Синтона. Этот оригинальный подход позволяет утверждать, что оптимальная толщина оксида алюминия для достижения эффективного эффекта пассивации составляет 1,2 нм. Хотя эффективность устройства не была полностью оптимизирована в этой работе, оптимальная пассивация оксидом алюминия может быть полезной для разработки высокоэффективных солнечных элементов на основе кремния.
Сокращения
- ALD:
-
Осаждение атомного слоя
- EDX:
-
Энергодисперсионное рентгеновское излучение
- EQE:
-
Внешняя квантовая эффективность
- FIB:
-
Сфокусированный ионный пучок
- HAADF:
-
Круговое темное поле под большим углом
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- PCE:
-
Эффективность преобразования энергии
- PECVD:
-
Химическое осаждение из паровой фазы с применением плазмы
- RIE:
-
Реактивное ионное травление
- ТЕМ:
-
Просвечивающий электронный микроскоп
- TMA:
-
Триметилалюминий
Наноматериалы
- Оценка преимуществ DevOps для тестирования производительности Интернета вещей
- Атомная перестройка множественных квантовых ям на основе GaN в смешанном газе H2 / NH3 для улучшения структурных …
- Синтез композита из электропроводных кремнеземных нановолокон / наночастиц золота с помощью лазерных импуль…
- Формирование и люминесцентные свойства нанокомпозитов Al2O3:SiOC на основе наночастиц оксида алюминия, модифици…
- Эволюция области контакта при нормальной нагрузке для шероховатых поверхностей:от атомных к макроскопическ…
- Влияние различных связующих на электрохимические характеристики металлооксидного анода для литий-ионных ба…
- Исследование многоуровневой памяти с переключением сопротивления и зависящей от состояния памяти фотоэдс в…
- Оптимизация проектирования спейсеров для безконденсаторной DRAM на основе туннельного транзистора с двумя за…
- Анионное поверхностно-активное вещество / ионные жидкости с интеркалированным восстановленным оксидом граф…
- Эффективное поглощение света с использованием решеток двусторонней пирамиды для тонкопленочных кремниевых…



