Пакетное производство широкополосных металлических плоских микролинз и их матриц, сочетающих самосборку наносферы с традиционной фотолитографией
Аннотация
Продемонстрирован новый недорогой способ серийного производства, сочетающий в себе литографию наносфер с центрифугированием (NSL) с традиционной фотолитографической техникой, позволяющий эффективно производить плоские металлические микролинзы и их массивы. Разработанные микролинзы состоят из субволновых наноотверстий и могут эффективно фокусировать свет во всем видимом спектре с размерами фокусов, близкими к дифракционному пределу Рэлея. Изменяя расстояние и диаметр наноотверстий, можно настроить эффективность фокусировки. Хотя случайные дефекты обычно существуют во время самосборки наносфер, основные характеристики фокусировки, например фокусное расстояние, глубина резкости (DOF) и полная ширина на полувысоте (FWHM), остаются почти неизменными. Это исследование обеспечивает дешевый способ реализации интегрированных нанофотонных устройств на уровне пластины.
Фон
Микролинзы как класс наиболее распространенных оптических компонентов, предназначенных для манипулирования и фокусировки света на микро- / наноуровне, имеют важные приложения, такие как технология отображения [1], коллимация лазерного луча [2], молекулярное обнаружение [3] и оптическое хранение информации [4]. Хотя преломляющие микролинзы широко используются в коммерческих устройствах с высокой оптической пропускной способностью, они неизбежно страдают от больших размеров, хроматических и сферических аберраций [5]. С другой стороны, дифракционные микролинзы демонстрируют меньшую аберрацию, но их физический размер и сложные трехмерные (3D) профили поверхности делают их менее полезными в миниатюрных и крупномасштабных устройствах. Кроме того, их изготовление требует точного выравнивания во время нескольких литографических процессов, что также ограничивает их применение в высокоинтегрированных микро- / нанооптических устройствах [6, 7].
Существенные усилия были направлены на изучение плазмоники в последние годы [8,9,10] из-за уникальной способности направлять свет и управлять им в нанометровом масштабе. В качестве важной категории плазмонных устройств были предложены и разработаны плазмонные линзы на основе тонких наноструктурированных металлических пленок [11,12,13,14,15,16,17]. Поверхностные плазмоны (ПП) на металлических пленках возбуждаются взаимодействием падающего света с колебаниями заряда на входной поверхности линзы и вжимаются в наноапертуры. Пройдя через целые металлические пленки в определенных волноводных модах, СП снова переходят в распространяющиеся волны. Субволны, проходящие через все наноапертуры, будут интерферировать друг с другом и образовывать световое пятно с максимальной интенсивностью на определенном расстоянии от выходной поверхности линзы, которые также называются пятном фокусировки и фокальной плоскостью. Следовательно, металлические плоские микролинзы, состоящие из матриц наноапертур, являются потенциальными кандидатами на роль традиционных преломляющих линз на основе диэлектрика, выделяя субволновую длину, но при этом обеспечивая широкополосную фокусировку и позволяющую полностью оптическую или оптоэлектронную интеграцию на одном кристалле. Однако все микролинзы, состоящие из наноструктур, требуют высокоточных методов нанопроизводства, таких как электронно-лучевая литография (EBL) и фрезерование сфокусированным ионным пучком (FIB). Хотя они являются мощными инструментами для создания прототипов микролинз, эти процессы дороги, требуют много времени и не подходят для параллельного изготовления больших площадей.
Недавно было сообщено о разновидности микролинз на основе наноотверстий, способных фокусировать все длины волн видимого спектра в единое пятно с использованием серийного метода мягкой интерференционной литографии (SIL) с последующей процедурой создания нанопаттернирований [18]. К сожалению, этот метод не идеален для микролинз, потому что наноотверстия по периферии имеют значительно меньший диаметр, чем у центральных, а некоторые даже заблокированы, вызывая большое отклонение фокусного расстояния от конструкции. Следовательно, разработка универсальной технологии изготовления микролинз с большой площадью имеет решающее значение для их практического применения; Тем не менее, эффективный метод с использованием нынешних подходов «сверху вниз» или «снизу вверх» по-прежнему остается большой проблемой. Кроме того, стоит изучить случайные дефекты, влияющие на производительность фокусировки и эффект связи между соседними микролинзами.
Перспективные методы изготовления больших площадей, такие как фотолитография, лазерная интерференционная литография (LIL) и наносферная литография (NSL), позволяют создавать различные наноструктуры. Фотолитография широко используется в микроэлектронике для производства интегральных схем (ИС). Комбинация коротковолновых источников света, в том числе глубокого ультрафиолета (DUV) и экстремального ультрафиолета (EUV), а также инноваций, таких как иммерсионная литография и маски с фазовым сдвигом, позволили увеличить размер элемента до нанометрового масштаба [19, 20]. Хотя традиционная оптическая литография на основе масок хорошо зарекомендовала себя и широко используется в индустрии ИС, она также очень дорога как в установке, так и в эксплуатации. Как гораздо более простая и дешевая методология масштабирования, LIL основана на интерференции нескольких когерентных лазерных лучей и может создавать одномерные (1D), двумерные (2D) и трехмерные периодические структуры с размерами элементов, приближающимися к 20 нм [21] . Но страдая от ограничений технологии, LIL затрудняет создание узоров в масштабе сантиметра [22]. NSL - это типичный коллоидный метод самосборки, который соответствует эффективному нанофабрикации высокопараллельным, недорогим способом в масштабе пластины и использует гексагональные плотноупакованные наносферы, в основном из полистирола (PS) или диоксида кремния в качестве масок или шаблонов для фотолитографии, испарения, напыление, травление, импринтинг и др. [23, 24]. Из-за гексагонального плотноупакованного расположения наносфер это приводит к аналогичному массиву наноструктур. Более того, в таких структурах могут наблюдаться эффекты решетки, например, исключительное оптическое пропускание (EOT) массивов наноотверстий, как правило, в результате возбуждения поверхностных плазмонных поляритонов (SPP) [25]. Это особенно важно для многих возможных приложений, таких как поверхностное комбинационное рассеяние (SERS), улучшенное обнаружение инфракрасных (ИК) колебаний, солнечные элементы и усиленная флуоресценция [26,27,28,29].
В этой работе наш подход сочетает в себе преимущества модифицированного NSL, например, большую площадь и дешевизну изготовления, с традиционной фотолитографической техникой для получения желаемых металлических плоских микролинз, которые похожи на «пятна» Odom. Продемонстрированные реализованные микролинзы могут фокусировать световые волны одной длины во всем видимом спектре, а также широкополосный белый свет с минимальной расходимостью. Кроме того, посредством моделирования и экспериментальной проверки случайные дефекты, обычно существующие во время процедуры самосборки наносфер в массивах наноотверстий, не обнаруживают значительного влияния на характеристики фокусировки микролинз, что означает, что фокальные пятна от разных микролинз на одной и той же пластине имеют идентичные поперечные размеры, близкие к дифракционному пределу Рэлея. Представленные здесь металлические микролинзы на основе наноотверстий и разработанный таким образом метод NSL могут открыть дверь для разработки и производства микролинз нового типа для миниатюрных пропускающих планарных микро- / нанооптических устройств.
Методы
Самосборка снизу вверх диэлектрических наносфер PS как простой и недорогой способ формирования субволновых наноотверстий часто страдает серьезными дефектами, например дислокациями, многослойностью, точечными или площадными вакансиями. Чтобы решить эти проблемы, мы проводим экспериментальные исследования параметров центрифугирования, включая скорость вращения, ускорение, дозирование суспензии и гидрофильную модификацию поверхностей подложки, на качество сформированных самоорганизующихся массивов по всей длине 4 дюйма. . стеклянная вафля. Хотя оптимизированные параметры приняты для уменьшения основных дефектов (вакансий и многослойности) и создания соответствующих массивов наноотверстий за счет переноса рисунка, некоторые дислокации и вакансии по-прежнему неизбежны и смещаются в конечные структуры с наноотверстиями.
На рис. 1 показано сочетание восходящей (самосборка полистироловых наносфер методом центрифугирования) и нисходящей методики (фотолитография) для недорогого параллельного изготовления микролинз и их массивов. Во-первых, наносферы PS (от microParticles GmbH) наносятся методом центрифугирования на стеклянные подложки, образуя однослойную маску из наносфер с гексагональной решеткой (рис. 1а). После осаждения наносфер их размер изменяется с помощью кислородной плазмы в реакторе с параллельными пластинами (Plasma Reactor, 0,75 Па, O 2 100 sccm, 80 Вт), как показано на рис. 1b. На следующем этапе на однослойные наносферы ПК напыляют слой золота толщиной 100 нм (рис. 1в). После этого выполняется процесс отрыва путем ультразвуковой очистки в тетрагидрофуране (ТГФ), и, таким образом, достигается крупномасштабный массив наноотверстий (рис. 1d). Затем пленка хрома (Cr) напыляется на первую перфорированную золотую пленку (рис. 1e) и формируется с помощью желаемых микролинз и их массивов с помощью фотолитографии (рис. 1f), что определяет фокусирующие характеристики микролинз, в конечном итоге полученных. Затем удаляется слой Cr, обнаженный открытыми областями, оставляя дырявые золотые наноотверстия для пропускания падающего света (рис. 1g). После очистки остаточного фоторезиста реализуются разработанные микролинзы и их матрицы (рис. 1h).
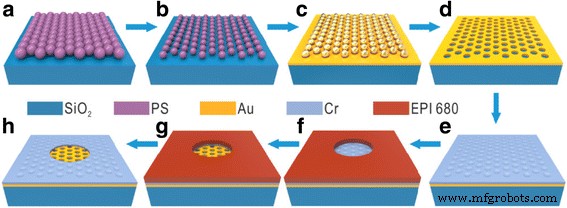
Схема основных этапов процесса изготовления микролинз и их массивов. а Спиновое покрытие однослойных наносфер ПС. б размерная усадка наносфер ПС. c Осаждение золота. г удаление наносфер ПС. е Осаждение Cr. е перенос рисунков микролинз на фоторезист. г мокрое травление. ч удаление фоторезиста
На рис. 2 показаны типичные изображения, полученные с помощью сканирующего электронного микроскопа (СЭМ), демонстрирующие различные морфологии самособирающихся наносфер PS с шагом решетки P =900 нм, т.е. диаметр используемых наносфер ПК. Самоорганизованные монослои наносфер ПК упорядоченно упакованы в гексагональную решетку на стеклянных подложках на рис. 2а, г. Однако дислокации, которые показаны как «трещины», все еще присутствуют из-за электростатического отталкивания между частицами [30], а также точечных вакансий. На рис. 2b, c показаны области вакансий, многослойные и беспорядочно упакованные дефекты, которые распределены в определенных областях с плохой управляемостью, когда параметры центрифугирования не оптимизированы или не нарушены.

Изображения SEM показаны для a самоорганизующиеся упорядоченно упакованные однослойные наносферы PS диаметром 900 нм, ( b ) Уменьшение размера ПС на O 2 плазма, содержащая дефекты вакансий и многослойные, ( c ) случайно упакованные наносферы ПС и ( d ) увеличенный вид блока ПС с гексагональной упаковкой
На рис. 3 показан результат дифракции видимого света на маске наносфер и изображения 4-дюймовой цифровой камеры. пластина и чип размером 10 мм × 10 мм с различными ячейками микролинз. Отдельные микролинзы и их массив показаны на рис. 3d, на котором четко видны нижележащие наноотверстия и отслоившиеся микролинзы. Он также выявляет существующие случайные дефекты в отдельных микролинзах.
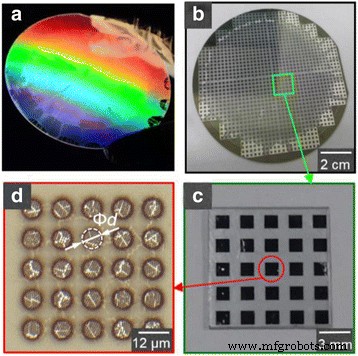
а Дифракционное изображение изготовленных 4-дюймовых. однослойная наносферная маска на уровне пластины. Фотографии изготовленных микролинз и их массивов на стеклянной подложке в ( b ) уровень пластины и ( c ) уровень чипа. г Изображение с помощью оптического микроскопа микролинзы 8 мкм и ее решетки 5 × 5, расположенной на расстоянии 4 мкм друг от друга
Чтобы изучить характеристики фокусировки полученных микролинз, мы сравниваем результаты трехмерного моделирования во временной области (FDTD) с экспериментальными испытаниями. Наша экспериментальная установка, как показано на рис. 4, с использованием инвертированного оптического микроскопа Nikon в качестве основной рабочей платформы, используется для картирования оптических полей, генерируемых плоской волной, падающей на микролинзу. После прохождения через микролинзу высококачественный масляно-иммерсионный объектив микроскопа (100 ×, NA =1,49) отображает спекл-паттерны на камеру CCD и управляется пьезоконтроллером E-816 (Physik Instrumente (PI)) с пошаговым регулированием. длина 100 нм. После сбора сотен двумерных световых срезов можно таким образом построить трехмерное оптическое поле вдоль оси распространения микролинзы.

Экспериментальная установка для определения характеристик оптической фокусировки микролинз и их массивов. Лазер непрерывного действия (CW) с длиной волны 532 нм расширяется с помощью телескопа для получения однородного луча. Проходя через микролинзу, передаваемый спекл-узор улавливается объективом микроскопа и измеряется ПЗС-матрицей
Результаты и обсуждение
- И.
Фокусирующая характеристика микролинз
3D модель микролинзы диаметром d наличие круглых наноотверстий, расположенных в гексагональной решетке, устанавливается с помощью метода FDTD. Коллимированный, x -поляризованный свет с рабочей длиной волны 532 нм освещается, четко определенное фокусное пятно (место максимальной интенсивности) наблюдается в x - z самолет (то же, что и y - z плоскости, поскольку электромагнитное поле распределяется симметрично) через центр микролинз размером 4 мкм, а полная ширина на полувысоте (FWHM) пятна в фокальной плоскости составляет 1,25 мкм (рис. 5a), что близко до дифракционного предела Рэлея 0,912 мкм, рассчитанного по 0,61 λ / NA [31]. Кроме того, моделируются оптические диаграммы дальнего поля с шагом решетки 522 и 900 нм, и выбраны рабочие длины волн 532 и 633 нм. Смоделированные фокусные расстояния составляют 12 и 10,4 мкм для микролинзы 4 мкм при λ =532 и 633 нм, соответственно, и значение увеличивается до 46 мкм для 8-мкм микролинзы при λ =532 нм, как показано на рис. 5а, в. Поскольку их фокусирующие эффекты не являются следствием инженерии волнового фронта, микролинзы размером 4 мкм с шагом решетки 522 или 900 нм имеют почти идентичные фокусные пятна, что подтверждает, что фокусное расстояние зависит в основном от размера линзы и рабочей длины волны. / P> 
а Отображение оптического поля микролинзы 4 мкм для смоделированных случаев a1 λ =633 нм, P =522 нм; a2 λ =532 нм, P =522 нм; a3 λ =532 нм, P =900 нм; и a4 результат измерения λ =532 нм, P =900 нм. б Осевая интенсивность света рассчитанного интеграла R-S, моделирования FDTD и оптических измерений для разработанной микролинзы d =4 мкм. c Разница напряженности поля для c1 смоделировано и c2 измеренные результаты, когда d =8 мкм при λ =532 нм, P =900 нм. г Осевая интенсивность для микролинзы d =8 мкм. Поля интенсивности вдоль y-z самолеты одинаково распределены как x-z самолеты
Фокальное пятно подчиняется классическому дифракционному пределу Рэлея, потому что фокусировка в дальней зоне не возникает из-за восстановления затухающего поля [32] или суперсолебаний [33]. Следовательно, зависимость фокусного расстояния от рабочей длины волны может быть выражена соотношением, полученным из интеграла Рэлея-Зоммерфельда (R-S) [18]. Из рис. 5b, d видно, что рассчитанные с помощью интеграла R-S распределения оптического поля очень хорошо согласуются с результатами моделирования FDTD для обоих случаев. Однако результаты измерений показывают небольшую разницу из-за различных ошибок, вносимых во время процедуры изготовления и оптических измерений. Стоит отметить, что для случая 4 мкм отклонение измерения в отличие от моделирования составляет 8,3% по сравнению с 1,1% для случая 8 мкм. Другими словами, микролинзы большего диаметра менее чувствительны к нормальным ошибкам.
Поскольку характеристики фокусировки не имеют отношения к инженерии волнового фронта, оптическая пропускная способность фокального пятна зависит от SP-усиленной передачи через субволновые апертуры [18]. Когда результаты на фиг. 6 сравниваются со спектрами пропускания от различных микролинз, улучшенные пропускания и подавленные пропускания присутствуют на разных длинах волн в зависимости от шага решетки. Согласно предыдущим сообщениям [34], селективный спектральный отклик был обнаружен как результат комбинированного эффекта распространяющегося поверхностного плазмонного резонанса (PSPR), поддерживаемого на границе раздела металл / диэлектрик, и локализованного поверхностного плазмонного резонанса (LSPR) вокруг наноотверстий. Как видно на рис. 6c, места провалов пропускания, обозначенные кружками, имеют красное смещение вдоль x -координатная ось по мере увеличения шага решетки, так же как и с пиками пропускания. Это наделяет микролинзы необычными способностями управлять оптической пропускной способностью на определенных длинах волн и обеспечивает легкость конструирования микролинз с высокоэффективной фокусировкой. На рис. 6а, б показаны распределения поля микролинзы 4 мкм для случая P =400 нм при длине волны провала 581 нм и пике 681 нм соответственно. За исключением уменьшения фокусного расстояния, вызванного увеличением длины волны, интенсивность фокусного пятна для длины волны 681 нм почти в 100 раз больше, чем у λ =581 нм.

а , b Результаты моделирования диаграмм электрического поля микролинзы 4 мкм при P =400 нм на рабочей длине волны λ =581 нм (провал пропускания) и 681 нм (пик) соответственно. c Смоделированные спектры полного пропускания для микролинз, соответствующие шагам решетки P =400, 530 и 600 нм в диапазоне частот 400 ~ 800 нм, а вставка показана модель микролинзы 4 мкм. Провалы и пики пропускания отмечены кружками . и треугольник соответственно
- II.
Влияние случайных дефектов
Несмотря на то, что NSL представляет собой высокопараллельный метод изготовления для создания массивов наноотверстий большой площади в микролинзах и их массивах, одна воспринимаемая проблема этого метода состоит в том, что дефекты случайным образом распределяются по всему слою наноотверстий микролинз. Дефекты почти неизбежны во время процесса самосборки наносфер, который, как обычно считается, фундаментально ограничивает разрешение и глубину проникновения оптических методов. Однако удивительно, что дефекты предлагают необычную альтернативу обычным периодическим структурам для управления светом. В конкретном оптическом эксперименте продемонстрировано, что некоторые случайные дефекты улучшают, а не ухудшают резкость фокуса [35, 36]. Таким образом, влияние дефектов, порожденных нашим производственным процессом, на фокусирующие характеристики исследуемых здесь микролинз имеет важное значение для практических приложений и дальнейших исследований случайных фотонных кристаллов.
Помимо вышеупомянутых вакансий, дислокаций и многослойных дефектов, которые возникают в результате процедуры самосборки наносфер, деформация формы наноотверстий может также существовать в конечных микролинзах во время усадки ПК и удаления ПК в результате несбалансированного O 2 плазменное травление. Поэтому рассмотренные нами дефекты можно отнести к дефектам формы и положения. Чтобы продемонстрировать влияние дефектов формы на качество фокусировки микролинз, мы представляем микролинзы с различной овальностью σ в наноотверстиях при их общем факторе заполнения 0,33 и соответствующих оптических фокусирующих изображениях, представленных на рис. 7а. Очевидно, эти схемы фокусировки для случаев σ =0,4 и σ =0,7 практически такие же, за исключением небольшого изменения интенсивности очагов. Более очевидно, что, как видно на рис. 7a, аналогичные узоры фокусов на фигурах a1, a2 и a3 указывают на то, что повышенная степень деформации и изменение направления деформации оказывают незначительное влияние на фокусирующие свойства микролинз.

а Фокальные пятна от микролинз не зависят от ошибки овальности σ наноотверстий. Свойства фокусировки не показывают явного изменения, когда σ =0 (закругленные наноотверстия) на рис. 5 увеличивается до a1 σ =0,4, a2 σ =0,7 при горизонтальном искаженном направлении и a3 σ =0,7 при перпендикулярном искаженном направлении. б Введение пространственной хаотичности в положение наноотверстий. Направления отклонения случайным образом различаются от отверстия к отверстию, но длина отклонения δ остается постоянным для каждого отверстия. Такие же картины фокусировки получаются при длине отклонения b1 δ =0, b2 δ =50 нм, и b3 δ =100 нм
Чтобы изучить влияние позиционных дефектов, мы отклоняем положение наноотверстий в разные стороны на длину δ . . Направление отклонения каждого отверстия случайным образом распределяется от отверстия к отверстию и сохраняется постоянным для каждого δ (см. рис. 7b). При увеличении δ , наноотверстия отклоняются от состояния идеально плотной упаковки и становятся «более случайными». Три одинаковых шаблона фокусировки микролинз относительно различных случайных положений наноотверстий, δ =0, 50 и 100 нм. Кроме того, наблюдается небольшое уменьшение интенсивности очагов на профиле поля с более случайным массивом наноотверстий. Прежде всего, это показывает, что дефекты формы и положения внутри микролинз мало влияют на производительность фокусировки и в основном просто модулируют интенсивность фокусов.
- III.
Характеристики фокусировки массивов микролинз
На рисунке 8 показана изготовленная матрица микролинз размером 3 × 3 с различными расстояниями и экспериментально измеренные оптические структуры при λ =532 нм, а также широкополосное освещение. Обратите внимание, что фокусные пятна от микролинз с большим количеством дислокаций в массиве более слабые, чем от других микролинз на рис. 8b. Это связано с тем, что дислокационные дефекты эффективно уменьшают количество наноотверстий, вносящих вклад в оптическую интерференционную картину. Кроме того, результаты показывают отличное согласие с результатами, полученными при моделировании FDTD, о том, что дефекты в основном влияют на интенсивность очагов. Кроме того, микролинзы могут фокусировать широкополосный белый свет (рис. 8 (a2) и (b2)) благодаря минимальной хроматической аберрации. Фокусные пятна при освещении белым светом имеют такие же поперечные размеры, как и пятна на одной длине волны, в то время как широкополосное фокусное расстояние приблизительно равно среднему значению фокусных расстояний на длинах волн с усилением SP. Кроме того, эффект фокусирующей связи в массиве микролинз, который мы проанализировали в нашем предыдущем исследовании [37], проявляется в полученных картинах фокусировки в виде областей C, D и E, отмеченных на рис. 8 (b1) и (b2).

а Изображения с оптического микроскопа изготовленной матрицы микролинз 3 × 3 с расстоянием 8 мкм друг от друга при d =8 мкм и измеренные оптические структуры ( A - А ) под (a1) единственная длина волны λ =532 нм и (a2) широкополосное освещение. Наблюдаются идентичные очаги от отдельных микролинз. б Результаты экспериментов ( B - Б ) для матрицы микролинз 3 × 3 с шагом 4 мкм под (b1) единственная длина волны λ =532 нм и (b2) широкополосное освещение. Эффект связи между двумя соседними микролинзами, обозначенный областями C , D , и E , можно наблюдать
Выводы
Подводя итог, мы впервые продемонстрировали, что метод NSL как высокопараллельный и недорогой метод может быть использован для изготовления металлических планарных микролинз, функционирующих во всем видимом спектре. Фокусирующие свойства микролинз, подтвержденные результатами моделирования и эксперимента, можно объяснить комбинацией эффектов оптической интерференции и поверхностных плазмонов. Принимая во внимание шаг решетки и диаметр наноотверстий, микролинзы могут быть адаптированы для обеспечения высокого пропускания на определенных длинах волн. Фокусирующая способность микролинз от идеального до дефектного состояния используется методом FDTD. Как моделирование, так и эксперименты проясняют, что случайные дефекты в массивах наноотверстий просто влияют на эффективность фокусировки микролинз, а эффект фокусирующей связи, как и предсказывалось, происходит как при освещении с одной длиной волны, так и при широкополосном освещении. Возможность широкополосной фокусировки, миниатюрный размер и универсальная технология изготовления - все вместе открывают большой потенциал для компактных и недорогих полностью оптических или оптоэлектронных устройств, таких как фотоэлектрические [26], цветные фильтры [38] и датчики показателя преломления [39]. .
Сокращения
- 3D:
-
Трехмерный
- CCD:
-
Устройство с зарядовой связью
- FDTD:
-
Конечная разность во временной области
- FWHM:
-
Полная ширина на полувысоте
- LIL:
-
Лазерная интерференционная литография
- NA:
-
Числовая апертура
- NSL:
-
Наносферная литография
- PS:
-
Полистирол
- SEM:
-
Сканирующий электронный микроскоп
Наноматериалы
- Произведите впечатление на друзей и семью проектами из эпоксидной смолы
- Цифровое производство и Интернет вещей - успех с единой платформой
- Широкополосный идеальный абсорбер с однослойным MoS2 и массивом нанодисков из гексагонального нитрида титана
- Простое изготовление многоиерархического пористого полианилинового композита в качестве датчика давления …
- Свойства продольных электромагнитных колебаний в металлах и их возбуждение на плоских и сферических поверхн…
- Изготовление наноразмерных ямок с высокой производительностью на полимерной тонкой пленке с использованием…
- Изготовление, характеристика и биологическая активность систем нано-доставки авермектина с различными разм…
- Экологичный и простой синтез нанопроволок Co3O4 и их перспективное применение с графеном в литий-ионных батаре…
- Генерация активных форм кислорода в водных растворах, содержащих наночастицы GdVO4:Eu3 + и их комплексы с метилен…
- Преобразование современного производства с помощью визуальной коммуникации и сотрудничества



