Анализ травления оксида перовскита с использованием плазмы с индуктивно связанной аргоном для фотоники
Аннотация
Мы проанализировали сухое травление оксидов перовскита с использованием индуктивно-связанной плазмы (ICP) на основе аргона для приложений фотоники. Различные условия камеры и их влияние на скорость травления были продемонстрированы на основе ниобата лития Z-среза (LN). Результаты измерений предсказуемы и воспроизводимы и могут быть применены к другим оксидам перовскита, таким как X-cut LN и оксид бария-титана (BTO). Шероховатость поверхности как у травленых LN, так и у BTO лучше по сравнению с их аналогами после осаждения, что подтверждается атомно-силовой микроскопией (АСМ). Методы энергодисперсионной рентгеновской спектроскопии (EDS) и рентгеновской фотоэлектронной спектроскопии (XPS) использовались для качественного и количественного сравнения химических компонентов поверхности, и по результатам измерений не наблюдается явных изменений состояния поверхности. Оптический волновод, изготовленный с помощью оптимизированного травления ICP на основе аргона, показал потери -3,7 дБ / см на длине волны 1550 нм для LN с Z-срезом, что подтверждает этот метод травления оксидов перовскита в фотонике.
Введение
Кремниевая фотоника в последние десятилетия получила большое развитие из-за ее низкой стоимости и возможности крупномасштабной интеграции [1]. Однако отсутствие эффекта Поккельса ограничивает некоторые его применения из-за его центросимметричной кристаллической структуры [2]. Оксиды перовскита, такие как LiNbO 3 (LN) и BaTiO 3 (BTO), таким образом, привлекли большое внимание для приложений фотоники из-за их больших эффектов Поккельса [3,4,5,6,7,8,9,10]. Различные фотонные устройства на основе LN и BTO продемонстрировали превосходные характеристики [3,4,5,6,7,8,9,10]. Для такого применения волновод с высоким контрастом показателя преломления является основным компонентом ограничения света [11]. Традиционно волноводы формировались в LN посредством ионной диффузии [12], что позволяло получить только низкий контраст показателя преломления и плохое оптическое ограничение. Прорыв в создании интегральных устройств на основе LN основан на прямом сухом травлении тонких пленок LN [3, 6,7,8,9,10]. Однако до сих пор не было опубликовано подробного анализа методов сухого травления LN. С другой стороны, BTO имеет даже более высокий коэффициент Поккельса 1640 пм / В, чем LN (~ 30 пм / В) [2], который может поддерживать гораздо лучшие фотонные устройства. Однако устройства фотоники на основе BTO с прямым травлением еще не были продемонстрированы, что, вероятно, связано с трудностями при травлении. Наиболее распространенный в литературе метод создания волноводов с более высоким показателем преломления из этих материалов состоит в том, чтобы сначала нанести слой материала, легко поддающегося травлению, а затем перенести рисунок на этот слой путем сухого травления. Результирующая оптическая мода только частично перекрывается с нижним нетравленым слоем BTO, что ухудшает его характеристики; такой метод не может максимизировать эффект Поккельса [4, 5]. Хотя плазменное травление BTO на основе фтора и хлорида было предложено для применения в полупроводниковой памяти [13,14,15], продукты реакции, которые могут повторно осаждаться на поверхностях и боковых стенках во время процесса травления, снижают пригодность такой химии травления для приложений фотоники.
Поэтому травление перовскитных оксидов LN и BTO с помощью индуктивно-связанной плазмы (ICP) на основе аргоновой плазмы всесторонне проанализировано в данной рукописи. Различные факторы и их влияние на скорость травления сравниваются как для LN, так и для BTO. Шероховатость поверхности до и после травления анализируется с помощью атомно-силовой микроскопии (АСМ). Для характеристики изменений химического состояния поверхности используются методы энергодисперсионной рентгеновской спектроскопии (EDS) и рентгеновской фотоэлектронной спектроскопии (XPS). Наблюдается, что поверхность намного более гладкая без следов травления как в протравленных образцах LN, так и в образцах BTO. На основе оптимизированных условий травления оптические волноводы травятся на образце LN с Z-срезом с измеренными потерями -3,7 дБ / см, что подтверждает пригодность метода ICP на основе аргона для обычного травления оксидов перовскита в фотонике.
Эксперимент и результаты
Методы
Oxford PlasmaPro 100c Cobra с частотой 13,56 МГц используется для эксперимента по травлению методом ICP на основе аргона, и схематическая структура травления показана на рис. 1а. Входящий газ ионизируется под действием изменяющихся во времени электромагнитных полей, которые создаются индуктивно связанной катушкой под первым источником радиочастоты (RF ICP ). Генерируемые ионы плазмы ускоряются вертикально к нижней пластине под действием напряжения смещения, которое контролируется вторым источником RF (RF bias ), подключенный к держателю подложки / электроду. Летучие продукты травильного газа выводятся через вентиляционное отверстие. Z-cut LN используется в качестве примера для демонстрации взаимосвязи между различными условиями процесса и скоростью травления; эпитаксиальная структура ЛН представлена на рис. 1б. Толщина верхнего слоя ниобата лития и оксида кремния составляет 700 нм и 2 мкм соответственно. Слой хрома (Cr) толщиной 50 нм сначала наносится на образец электронно-лучевым (электронно-лучевым) испарением для облегчения литографии. Затем примерно 1 мкм фоторезиста ma-N 1400 наносят центрифугированием на поверхность с помощью фотолитографии с использованием лазерного пишущего устройства. После проявления и последующего влажного травления Cr узорчатая структура служит теневой маской для сухого травления. После травления ICP эту маску обрабатывают горячим N-метил-2-пирролидоном и травителем Cr. Глубина элементов до травления, после травления и после удаления теневой маски записывается с помощью профилометра поверхности в фиксированных точках, и соответственно рассчитываются скорости травления фоторезиста и Z-образного LN.

а Схематическая структура процесса ICP. Структуры эпитаксии и СЭМ-изображения b Z-образный разрез LN и c BTO, использованный в эксперименте (Pt и Cr наносятся в качестве защитных слоев для резки FIB)
Анализ скорости травления
В ходе эксперимента проверяются четыре фактора:давление в камере, расход газа, мощность смещения и мощность ICP. Перед каждым травлением проводится 5-минутная обработка плазменным чистым кислородом для очистки камеры. Во время травления используется только газообразный аргон, и основные условия травления следующие:давление в камере 5 мТорр, поток газа 20 см3 / см3, мощность смещения 150 Вт и мощность ICP 500 Вт. Измеренные скорости травления LN с Z-образным срезом и фоторезиста в зависимости от различных комбинированных условий показаны на рис. 2. Из рисунка 2а видно, что скорость травления LN с Z-образным срезом увеличивается, когда давление в камере уменьшается, и Увеличение скорости травления LN Z-образного среза является относительно линейным (крутизна составляет около 0,95 нм / мин на уменьшение давления в мТорр) и предсказуемо. Следует отметить, что измерение глубины профиля поверхности LN с Z-образным вырезом более точное, чем с фоторезистом, потому что поверхность фоторезиста после травления не такая плоская, как LN с Z-образным вырезом. Когда давление в камере ниже, случайное столкновение уменьшается, и ионы аргона транспортируются более упорядоченно, что может объяснить, почему более высокие скорости травления наблюдаются при более низком давлении в камере. Скорость травления увеличивается линейно для LN с Z-срезом в зависимости от условий потока газа, как показано на рис. 2b, что означает, что при увеличении потока газа активируется больше аргоновой плазмы. Наклон скорости травления LN Z-среза составляет около 0,11 нм / мин на единицу увеличения расхода газа на куб. См, как можно заключить из рис. 2b. Как видно из рис. 2c, d, скорость травления LN и фоторезиста увеличивается при увеличении смещения и мощности ICP. Когда мощность ICP составляет всего 100 Вт, ионизируется несколько атомов аргона и скорость травления LN с Z-срезом довольно мала, как показано на рис. 2d. При увеличении мощности ICP будет ионизировано больше атомов аргона, что приведет к увеличению скорости травления. С увеличением смещения скорость ускорения ионов также будет больше, поскольку электрическое поле сильнее. Как увеличение плотности плазмы, так и ускорение ионов приведут к более высокой скорости травления, что можно найти на рис. 2c, d. Наклоны составляют примерно 0,072 и 0,059 нм / мин на ватт смещения и мощности ICP, соответственно. Нелинейная кривая скорости травления фоторезиста в зависимости от мощности смещения, вероятно, связана с ошибкой измерения, возникающей из-за неровной поверхности.
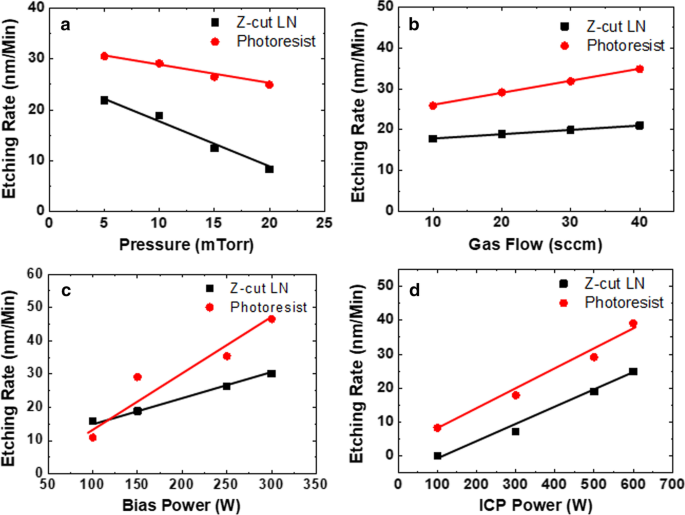
Степень травления LN Z-cut и фоторезиста при различных a давление, b расход газа, c мощность смещения и d Мощность ICP
На рис. 2а скорость травления 21,87 нм / мин получена в условиях давления в камере 5 мТорр, потока газа 20 см3 / мин, мощности смещения 150 Вт и мощности ICP 500 Вт. Скорость травления около 37 нм / мин измерена в условиях давления в камере 10 мТорр, потока газа 30 см3 / см3, мощности смещения 300 Вт и мощности ICP 700 Вт, что хорошо согласуется с расчетными результатами (40,4 нм / с), основанными на данных измерений. показано на рис. 2. Таким образом, можно сделать вывод, что скорость травления LN Z-среза является регулярной и предсказуемой.
На основе тех же базовых условий (давление в камере 5 мТорр, поток газа 20 см3 / см3, мощность смещения 150 Вт и мощность ICP 500 Вт) был проведен аналогичный эксперимент по травлению с использованием X-cut LN и BTO для изучения влияния давления в камере. (в качестве примера различных условий), а измеренные данные показаны на рис. 3. Используемый здесь LN X-среза представляет собой объемный кристалл, тогда как BTO представляет собой эпитаксиальный слой, выращенный на подложке из скандата диспрозия (DSO) с использованием импульсного лазерное напыление (PLD), структура которого показана на рис. 1c. Когда давление в камере уменьшается, скорость травления BTO и X-cut LN увеличивается, что хорошо согласуется с результатами Z-cut LN. Несколько иной наблюдаемый наклон можно объяснить небольшими различиями в качестве кристаллов. Таким образом, можно сделать вывод, что параметры травления на рис. 2 также в целом подходят для оксидов перовскита типа X-cut LN и BTO.

Результат сравнения скоростей травления по отношению к давлению в камере для LN BTO, Z-образной и X-образной резки
Анализ морфологии поверхности
Чтобы оценить любые возможные изменения морфологии поверхности, вызванные травлением, здесь используется АСМ с областью сканирования, установленной на \ (1 \ times 1 {\ mathrm {\ mu m}} ^ {2} \). АСМ-изображения после осаждения и после травления для LN с Z-образным срезом, LN с X-образным срезом и BTO показаны на рис. 4. Из рисунков 4a, b видно, что протравленный LN с Z-образным срезом имеет почти один порядок более низкая среднеквадратичная шероховатость (RMS) поверхности по сравнению с наплавленным образцом. Для LN и BTO X-cut такая же более гладкая поверхность после травления может быть найдена на рис. 4c – f. Немного большая среднеквадратичная шероховатость для осажденного BTO обусловлена исходным качеством роста, поскольку образец LN является коммерческим продуктом, а пленка BTO выращивается в нашей лаборатории на подложке (DSO), которая сама по себе не может минимизировать шероховатость поверхности. Более низкая среднеквадратичная шероховатость протравленного образца может быть отнесена на счет физических свойств травления ИСП на основе аргоновой плазмы, что делает процесс травления немного похожим на шлифовку / полировку.
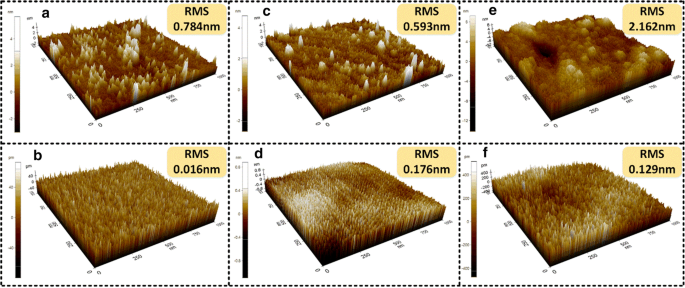
Трехмерный вид морфологии поверхности LN с разрезом Z, LN с разрезом по X и BTO, измеренных с помощью АСМ. а На хранении и b травленый Z-образный вырез LN. c На хранении и d травленый X-образный вырез LN. е На хранении и е травленый BTO
Анализ состояния поверхности
EDS-анализ выполняется для образцов LN с Z-образным срезом, LN с X-образным срезом и BTO после травления и после осаждения для качественного анализа любых возможных изменений поверхностных компонентов, результаты измерений показаны на рис. 5. Во время измерения литий (Li), ниобат (Nb), кислород (O), углерод (C), аргон (Ar) и хром (Cr) регистрируются для LN с Z-разрезом и X-разрезом, как показано на рис. 5a – d, в то время как для образца BTO анализируются барий (Ba), титан (Ti), O, C, Ar и Cr, как показано на рис. 5e, f. По сравнению с образцами в момент осаждения, на рис. 5 не наблюдается значительных различий в элементной составляющей. В протравленной области нет остаточного аргона ни в одном из протравленных образцов, что показывает, что ИСП на основе аргоновой плазмы является чисто физическим процессом. не вызывают неожиданных вторичных химических изменений и не образуются реагенты травления.

Измеренные результаты EDS. а На хранении и b протравленные образцы ЛН Z-среза; c в качестве депозита и d протравленные образцы ЛН с разрезом X; е в качестве депозита и е протравленные образцы BTO
Для дальнейшего анализа любых изменений химического состава поверхности был проведен анализ XPS. Измерения проводились в системе Thermo Fisher Scientific Theta Probe, оснащенной монохроматическим микро-сфокусированным источником рентгеновского излучения Al K \ (\ alpha \) (1486,6 эВ), а спектры XPS регистрировались при угле обнаружения (q) 50. , относительно поверхности образца. Базовое давление аналитической камеры составляет \ (5 \ times {10} ^ {- 10} \) мбар. На рисунке 6 показаны обзорные XPS-спектры образцов LN с Z-срезом, LN с X-срезом и BTO в диапазоне значений энергии связи (BE) от 0 до 1000 эВ. Есть Li 1 s, Nb 3p 1/2 , Nb 3p 3/2 , Nb 3d 5/2 , Nb 4p 3/2 , O 1 s и C 1 s для LN с разрезом Z и LN с разрезом X, как показано на рис. 6a, b. На рис. 6в показаны Ba 4d, Ba 4p 3/2 , C 1 s, Ti 2p, O 1 s, Ba 3d 5/2 и Ba 3d 3/2 для BTO. Представленные здесь XPS-спектры относятся к BE пика компонента C – C / C-H C 1 s-спектров при 285,0 эВ [13, 16]. Из рис. 6 видно, что нет большой разницы в обзорных спектрах для образцов после нанесения и травления. Некоторые небольшие пики после травления вызваны незначительным загрязнением во время обработки и хранения образцов.

Обзорные XPS-спектры a Z-образный вырез LN, b X-разрез LN и c БТО до и после травления. Нижняя (красная) и верхняя (черная) линии представляют образцы после наплавки и травления.
Для дальнейшей детальной идентификации химического состояния каждого элемента спектры высокого разрешения всех элементов, представленных на поверхности, были получены и подогнаны после вычитания вторичного электронного фона по типу Ширли [13]. Результаты подгонки показаны на рис. 7. На рис. 7a – d показаны Li 1 s, Nb 3d 5/2 . , O 1 s и Ar для LN с Z-разрезом. Нет очевидных изменений для пика Li 1 s, как показано на рис. 7a. По сравнению с осажденным образцом пики Nb 3d 5/2 и O 1 с изменяются, соответственно, на 0,1 и 0,2 эВ в сторону более высоких УЭ в протравленном случае, как показано на рис. 7b, c. Такие небольшие изменения близки к ошибке измерения и указывают на отсутствие очевидного изменения химического состояния для Nb и O. Отмечено, что есть двухкомпонентные пики для аппроксимации спектра O 1 s, а основной пик около 530,2 эВ от Nb –O облигации. Другой субпик около 532,5 эВ можно отнести к загрязнению, так как он удаляется физическим ударом в вакуумной камере и, таким образом, приводит к более слабой силе сигнала [13]. Никаких явных пиков аргона не наблюдается как в осажденных, так и в протравленных образцах, что подтверждает, что ICP-травление на основе аргона не привело к образованию остатков от травления.

Спектры высокого разрешения для образцов LN с Z-срезом, LN с X-срезом и BTO после нанесения и травления. а в d представляют собой Li, Nb, O, Ar для Z-образной LN. е - ч представляют собой Li, Nb, O, Ar для X-разреза LN. я в л представляют собой Ba, Ti, O, Ar для BTO. Нижняя (красная) и верхняя (черная) линии представляют результаты как нанесенные, так и вытравленные на каждом отдельном изображении
На рисунках 7e – h показаны Li 1 s, Nb 3d 5/2 . , O 1 s и Ar для LN с разрезом X. Вывод такой же, как и в Z-разрезе LN. Все пики Li 1 s, Nb 3d 5/2 и O 1 с смещают 0,2 эВ в сторону более высоких значений BE для протравленных образцов по сравнению с образцами после осаждения. Для спектра Ar 2p имеется один небольшой пик в протравленном образце около 239,0 эВ, который может быть отнесен к остаточному аргону. Хотя Ar не будет химически реагировать с протравленным материалом, ион высокой энергии будет имплантирован в протравленную поверхность во время процесса травления. Ожидается, что такая имплантация будет слабой в нашем эксперименте, поскольку сигнал настолько мал и не окажет значительного влияния на производительность фотонных устройств.
На рис. 7i – l показаны спектры Ba 3d, Ti 2p, O 1 s и Ar 2p, полученные для BTO. На рис. 7i, Ba 3d 5/2 осажденного образца (нижняя красная линия) можно сопоставить с двумя пиками при BE 778,7 и 780,0 эВ с соотношением 47%:53%. После травления Ba 3d 5/2 соответствует двум пикам при BE 778,8 и 780,1 эВ с соотношением 80%:20%. Смещения БЭ после учета погрешности эксперимента (± 0,2 эВ) не наблюдалось. Однако поверхностный оксид был удален из-за процесса травления из-за изменения соотношения пиков. Для Ti 2p УБ Ti 2p 3/2 до и после травления составляют 458,1 и 458,2 эВ соответственно, что также находится в пределах экспериментальной ошибки. Для спектров O 1 s перед травлением его можно подогнать с помощью двух пиков с BE 529,4 и 531,4 эВ, отнесенных к BTO и поверхностному загрязнению, с соотношением 45%:55%. После травления BE пиков составляют 529,6 и 531,5 эВ с соотношением 60%:40%, что свидетельствует об удалении поверхностного загрязнения. После травления в BTO не наблюдается явного пика РФЭС от Ar, что хорошо согласуется с случаями LN с Z-разрезом и X-разрезом.
Характеристика оптических характеристик и обсуждение
На основе оптимизированного метода ICP на основе аргона в качестве примера применения реализованы LN-волноводы с Z-вырезом. Волновод частично травлен с глубиной травления 420 нм из общей толщины 700 нм, а его ширина составляет 4 мкм для облегчения литографии. Геометрические размеры волновода определяются на основе метода трехмерных конечных разностей во временной области (FDTD) [17] после учета потерь при передаче и технологического процесса. Верхний слой LN и подложка изолированы оксидом кремния толщиной 2 мкм для образования высокой разницы показателей преломления (показатели преломления LN и SiO 2 равны соответственно 2,3 и 1,44) для оптического ограничения, как показано на рис. 1б. Потери при распространении около -3,7 дБ / см измерены с вычетом потерь связи (метод сокращения) вблизи расчетной длины волны 1550 нм для входного света с поперечной магнитной (TM) поляризацией, как показано на рис. 8a. На вставке показан свет, хорошо удерживаемый внутри волновода. Стоит отметить, что существуют и другие методы для характеристики потерь в волноводе, такие как методы скользящей призмы, резонансов Фабри – Перо и методы рассеянного света [18]. Здесь используется метод сокращения. На рисунке 8b показано изображение травленого волновода, полученное с помощью сканирующей электронной микроскопии (СЭМ). Прозрачные боковые стенки подтверждают высокий результат травления. Угол боковой стенки составляет около 50 градусов, как показано на изображении фокусирующего ионного пучка (FIB), показанном на рис. 8c. Измеренные потери приемлемы для TM поляризации (где поле правильно выровнено для максимизации эффекта Поккельса для ориентации Z-среза); и большие, чем типичные значения потерь для поперечно-электрического (TE) поляризованного света в ниобате лития X-среза [3, 6] из-за обычной анизотропии шероховатости боковых стенок. Такие потери могут быть уменьшены за счет использования более тонкой верхней LN толщины [19] и более оптимизированной конструкции [3, 6, 20]. Стоит отметить, что нет никакой постобработки или дополнительной оболочки измеряемого волновода. Таким образом, потери могут быть уменьшены за счет оптимизации такой обработки, как в случае с добавлением термического окисления в кремниевых волноводах [20, 21], или с использованием сглаживания пучка кластерных ионов газа [22]. В случае BTO уменьшение контрастности показателя преломления между подложкой DSO и верхним слоем BTO (показатели преломления BTO и DSO составляют, соответственно, 2,38 и 2,13, как определено методом призменной связи), приведет к более плохому удержанию света, даже если травление глубже; потерю нельзя напрямую сравнивать с потерей в LN.

а Измеренные потери протравленного волновода LN с Z-образным вырезом. (На вставленном изображении показан свет, проходящий внутри изгибного волновода во время измерения.) b СЭМ-изображение травленого волновода. c Изображение FIB поперечного сечения волновода
По сравнению с типичным методом ионной диффузии [12] для оксидов перовскита в фотонике, ИСП на основе аргона, продемонстрированный в этой рукописи, позволяет реализовать компактные и высокопроизводительные интегрированные устройства. Поскольку в этом методе отсутствуют продукты реакции травления, на оптические характеристики кристалла оксида перовскита это никак не влияет. Следовательно, он, вероятно, превосходит травление ICP на основе фтора или хлорида [13,14,15], которое было продемонстрировано для других видов применения, таких как полевые транзисторы. Машины ICP широко используются в промышленности, поэтому эффективность предлагаемого метода будет высокой, если каждый этап процесса будет контролироваться с небольшой погрешностью.
Выводы
В заключение, в этой рукописи подробно демонстрируется ICP-травление перовскитных оксидов на основе аргона. Скорость травления и ее взаимосвязь с давлением в камере, потоком газа, смещением и мощностью ICP анализируются в Z-cut LN, X-cut LN и BTO. Результаты измерений являются регулярными и предсказуемыми, что будет полезно для тестирования всего процесса травления оксидов на основе перовскита, особенно для приложений фотоники. Измеренные результаты АСМ показывают, что шероховатость поверхности после травления ICP на основе аргона лучше, чем до этого. Результаты как EDS, так и XPS показывают, что такой метод травления является чисто физическим процессом, и на протравленной поверхности не обнаруживается никаких остатков травления. Наблюдаются некоторые разумные небольшие сдвиги пиков после травления, но во время эксперимента не наблюдается значительного ухудшения характеристик фотонных устройств. Измеренные потери TM -3,7 дБ / см около 1550 нм для волновода LN с Z-образным вырезом также подтверждают пригодность ИСП на основе аргона для травления оксидов перовскита при изготовлении фотонных устройств.
Доступность данных и материалов
Все данные полностью доступны без ограничений.
Сокращения
- ICP:
-
Индуктивно-связанная плазма
- LN:
-
Ниобат лития
- BTO:
-
Оксид бария и титана
- AFM:
-
Атомно-силовая микроскопия
- EDS:
-
Энергодисперсионная рентгеновская спектроскопия
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
- Cr:
-
Хром
- электронный луч:
-
Электронный луч
- DSO:
-
Скандат диспрозия
- PLD:
-
Импульсное лазерное напыление
- RMS:
-
Среднеквадратичное
- BE:
-
Связующая энергия
- Pt:
-
Платина
- Ли:
-
Литий
- Nb:
-
Ниобате
- O:
-
Кислород
- C:
-
Углерод
- Ar:
-
Аргон
- Ba:
-
Барий
- Ti:
-
Титан
- SEM:
-
Сканирующая электронная микроскопия
- FIB:
-
Фокус ионного пучка
- TM:
-
Поперечный магнитный
- TE:
-
Поперечный электрический
Наноматериалы
- Использование станка начального уровня с ЧПУ для изготовления прицепов, крышных багажников и приложений для…
- Использование анализа вибрации для проверки износа подшипников
- Достижения и проблемы флуоресцентных наноматериалов для синтеза и биомедицинских приложений
- Доставка лекарств на основе клеток для онкологических приложений
- Прогресс в наноструктурах на основе оксидов железа для приложений в накоплении энергии
- Графен и полимерные композиты для суперконденсаторов:обзор
- Нанопетали из мезопористого оксида никеля (NiO) для сверхчувствительного определения уровня глюкозы
- Преимущества использования Robotic Vision для приложений автоматизации
- 5 больших преимуществ использования клапанов из нержавеющей стали для промышленного применения
- Библиотека управления сообщениями для приложений ПЛК с использованием IEC-61131 и eHMI



