Исследование методом моделирования туннельного полевого транзистора с двойным затвором с толщиной ступенчатого канала
Аннотация
Ожидается, что туннельный полевой транзистор с двойным затвором (DG TFET) расширит ограничения по току утечки и подпороговой крутизне. Однако он также страдает амбиполярным поведением с симметричной архитектурой истока / стока. Чтобы преодолеть амбиполярный ток, необходимо внести асимметрию между истоком и стоком. В этой статье мы исследуем характеристики DG TFET с толщиной ступенчатого канала (SC TFET) с помощью 2D-моделирования. Асимметрия между истоком и стоком вносится толщиной ступенчатого канала; следовательно, ожидается ослабление амбиполярного поведения. Результаты показывают, что SC TFET демонстрирует значительное снижение амбиполярного тока по сравнению с обычным DG TFET. Механизмы SC TFET подробно обсуждаются для изучения физических свойств. Влияние параметров структуры на начальное напряжение, подпороговую крутизну, ток стока в открытом и амбиполярном состоянии также проявляется при определении оптимальной структуры.
Фон
По мере продолжения процесса экстремального масштабирования технология CMOS с обычным MOSFET сталкивается с различными проблемами, такими как возрастающий ток утечки и подпороговая крутизна ( SS ). Ожидается, что туннельный полевой транзистор (TFET), использующий механизмы межполосного туннелирования (BTBT), расширит ограничения по току утечки и SS [1,2,3,4,5,6,7,8]. TFET на основе кремния демонстрирует такие преимущества, как высокая надежность и низкая стоимость. Однако обычный TFET на основе кремния демонстрирует относительно низкий ток по сравнению с MOSFET из-за ограниченной скорости BTBT [9,10,11]. Чтобы раскрыть потенциал TFET на основе кремния, недавно были предложены различные новые структуры TFET для увеличения тока в открытом состоянии. TFET с двойным затвором (DG TFET) показывает улучшенную скорость BTBT, что приводит к увеличению тока включения [12,13,14]. Однако амбиполярный ток DG TFET также увеличивается, поскольку улучшение скорости BTBT активируется также в амбиполярном состоянии [15]. Для дальнейшего преодоления амбиполярного тока необходимо ввести асимметрию между истоком и стоком [16]. DG TFET с перекрытием затвор-сток и меньшей концентрацией легирования в стоках являются обычными методами решения амбиполярной проблемы [17,18,19]. Но нижнее перекрытие затвор-сток требует большего S / D расстояния, а меньшая концентрация легирования стока увеличивает последовательные сопротивления [15]. Предыдущая работа показала, что амбиполярные эффекты в TFET с перекрытием дренажа могут быть дополнительно уменьшены за счет использования прокладок с низким k и размещения контактов в верхней и нижней конфигурации [15], предполагая, что комбинированные стратегии асимметрии могут иметь смысл в повышение производительности TFET. В нашей предыдущей работе было продемонстрировано, что FinFET с асимметричной шириной ребра улучшает характеристики FinFET [20]. Также считается, что толщина канала t si оказывает значительное влияние на скорость BTBT DG TFET [21]; следовательно, асимметрия между толщиной истока и толщиной стока может дополнительно ослабить амбиполярный ток и требует тщательного изучения.
В этой статье мы исследуем различные характеристики DG TFET с толщиной ступенчатого канала (SC TFET), асимметрия между истоком и стоком вводится через толщину ступенчатого канала, поэтому ожидается, что амбиполярный ток будет уменьшен. Остальная часть этого документа организована следующим образом:Раздел 2 представляет структуру устройства и настройки моделирования. В разделе 3 подробно обсуждаются механизмы SC TFET. Подробное обсуждение влияния параметров структуры на кривые перехода, начальное напряжение ( В начало ), среднее СС и ток стока во включенном / амбиполярном состоянии также представлен. Наконец, в разделе IV изложены выводы, сделанные в этой статье.
Структура и моделирование
Принципиальная схема рассматриваемого в данной статье СК ТФЭТ представлена на рис. 1а. Толщина канала вблизи области истока не равна толщине канала вблизи области стока. В определенной точке области канала толщина канала изменяется скачкообразно. Высота и положение ступеньки обозначаются как H . и L s соответственно. т si1 и t si2 - толщина канала вблизи области истока и области стока соответственно. Эффективная толщина оксида (EOT) в нашем моделировании составляет 1 нм. Область источника сильно легирована p-примесью (10 20 атомов / см 3 ), а сток сильно легирован n (10 20 атомов / см 3 ) для уменьшения последовательного сопротивления [15] область канала слегка легирована n-примесью (10 17 атомов / см 3 ). Для анализа начального напряжения при различных настройках толщины канала работа выхода металлического затвора фиксируется на уровне 4,5 эВ, длина затвора равна длине канала L ch и установите на 50 нм [22,23,24,25]. Моделирование выполнено с использованием Sentaurus TCAD выпуска I-2013.12 [26, 27]. Модель зависимости от допинга и модель подвижности, зависящей от поля, представляют собой унифицированную модель подвижности Philips и модель подвижности Ломбарди, соответственно. Также используются статистика Ферми – Дирака, модель рекомбинации Шокли – Рида – Холла и Оже. Чтобы учесть высоколегированные области истока / стока, активируется модель сужения запрещенной зоны. Нелокальная модель BTBT, основанная на приближении Вентцеля – Крамера – Бриллюэна (ВКБ), настроенная на экспериментальные результаты [28], и модель квантования градиента плотности позволяют достичь точного моделирования [29, 30]. Начальное напряжение определяется как напряжение затвора, при котором подпороговая крутизна максимальна. Средняя СС извлекается из тока в закрытом состоянии в I d =10 −11 А / мкм.
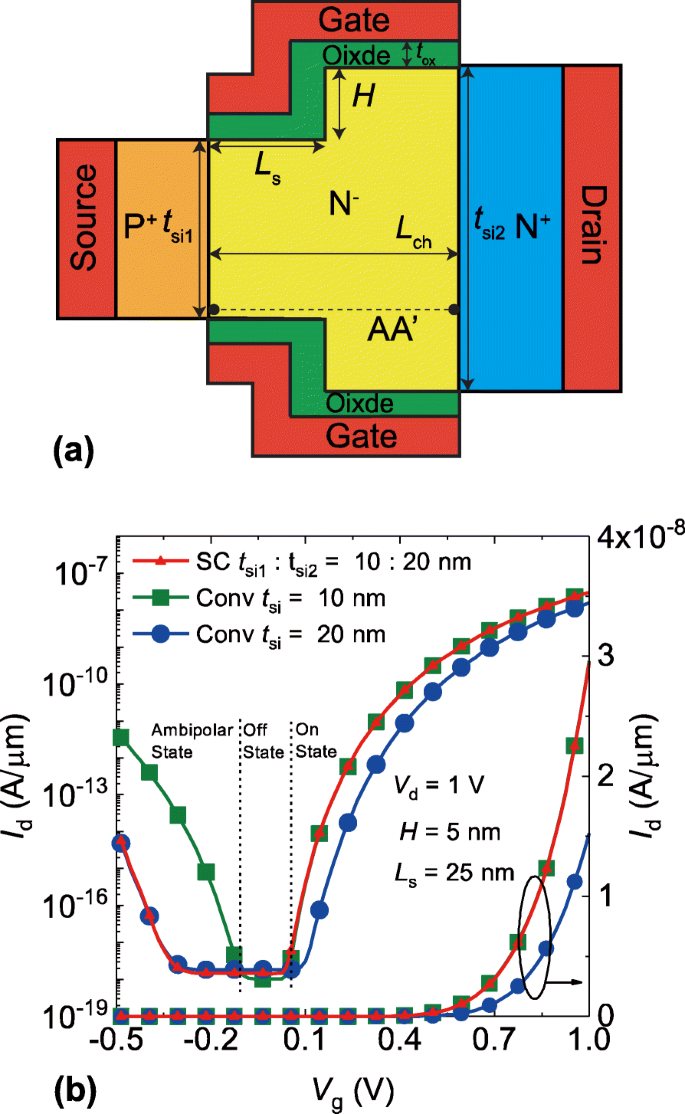
а 2D принципиальная схема СК ТФЭТ, t si1 и t si2 - толщина канала в области истока и стока, очевидно, что вносится асимметрия между истоком и стоком. Линия пореза AA ’- это линия пореза в горизонтальном направлении. Расстояние по вертикали между линией реза и поверхностью области источника составляет 0,5 нм. б Передаточные кривые SC TFET и обычных DG TFET в логарифмическом и линейном масштабе
Результаты и обсуждение
Кривые и механизм переноса
На рис. 1b показаны кривые передачи SC TFET и обычного DG TFET в логарифмическом и линейном масштабе соответственно. Мы выделяем включенное, выключенное и амбиполярное состояние на рис. 1b. Для TFET всегда желательны более высокий ток в открытом состоянии и более низкий ток в амбиполярном состоянии, что требует, чтобы V начало и SS должен быть низким, а в выключенном состоянии должен быть широкий диапазон напряжений. Как показано на рис. 1b, V начало обычного DG TFET с толщиной канала 10 нм меньше, чем у DG TFET с толщиной канала 20 нм. Извлеченный V начало DG TFET с t si =10 нм составляет 0,04 В, а его извлеченное среднее SS составляет 44,8 мВ / дек, V начало и средний СС обычного DG TFET с t si =20 нм составляет 0,1 В и 50,6 мВ / дек соответственно. Ток стока обычного DG TFET с t si =10 нм улучшается на 94,7% по сравнению с обычным DG TFET с t si =20 нм. Основная причина такого улучшения тока стока - уменьшенная SS и V начало . Однако диапазон выключенного состояния обычного DG TFET с t si =10 нм составляет всего 0,17 В. Обычный DG TFET с t si =20 нм, для сравнения, диапазон в закрытом состоянии составляет 0,45 В. В результате ток в амбиполярном состоянии обычного DG TFET с t si =20 нм уменьшается на 3 порядка по сравнению с обычным DG TFET с t si =10 нм.
Для честного сравнения: t si1 и t si2 SC TFET равны толщине канала вышеупомянутых обычных DG TFET, соответственно. Толщина более узкого канала t si1 SC TFET составляет 10 нм и более широкая толщина канала t si2 СК ТФЭТ составляет 20 нм. Положение ступеньки предполагается в середине канала, а L s составляет 25 нм. Можно заметить, что SC TFET показывает многообещающие характеристики, включая высокий ток стока во включенном состоянии, а также широкий диапазон значений в выключенном состоянии. Ток стока SC TFET во включенном состоянии аналогичен по сравнению с обычным DG TFET с t si =10 нм, среднее SS составляет 45,8 мВ / дек, а V начало составляет 0,03 В. Однако диапазон выключенного состояния SC TFET увеличен до 123,5%, а ток в амбиполярном состоянии также снижен на 3 порядка по сравнению с обычным DG TFET с t si =10 нм. В результате характеристики включенного состояния SC TFET аналогичны характеристикам обычного DG TFET с узкой толщиной канала, SC TFET также показывает почти параллельные кривые выключенного / амбиполярного состояния традиционному DG TFET с большой толщиной канала. Следовательно, SC TFET может достичь низкого SS , уменьшенное V начало , и широкий диапазон состояний одновременно.
Чтобы исследовать физический механизм SC TFET, мы сравниваем скорости BTBT и диаграммы энергетических зон в включенном состоянии, вблизи начальной точки и амбиполярном состоянии, соответственно. На рисунке 2a показаны скорости BTBT SC TFET и обычных DG TFET. Видно, что скорость BTBT сильно зависит от толщины канала. Фактически, соотношение между толщиной канала и током BTBT I BTBT можно выразить как [31].
$$ {I} _ {BTBT} \ propto \ exp \ left (- \ frac {4 \ lambda \ sqrt {2 {m} ^ {\ ast} {E_g} ^ {2/3}}} {3 \ mathrm {\ hslash} \ left (\ Delta \ Phi + {E} _g \ right)} \ right) $$ (1)
а Ставки BTBT и b Диаграмма энергетических зон SC TFET и обычных DG TFET во включенном состоянии, расстояние - это поперечное положение линии разреза AA ’на рис. 1
Где λ =( ε si т si т бык / 2 ε бык ) 1/2 - естественная длина, ε si и ε бык - диэлектрическая проницаемость кремния и оксида соответственно и t бык толщина оксида. Δ Φ - диапазон энергий, в котором может происходить туннелирование, E g ширина запрещенной зоны в туннельном переходе, а m * - тоннельная масса. Уравнение (1) указывает, что I BTBT должен увеличиваться как t si уменьшает. Следовательно, скорость BTBT обычного DG TFET с t si =10 нм должно быть больше, чем у обычного DG TFET с t si =20 нм. SC TFET показывает аналогичное распределение скорости BTBT с обычным DG TFET с t si =10 нм. Это связано с тем, что BTBT в основном происходит рядом с переходом источника в открытом состоянии, следовательно, толщина канала около перехода к источнику будет определять скорость BTBT в открытом состоянии. На рисунке 2b показана диаграмма энергетических зон SC TFET и обычных DG TFET. Поскольку скорость BTBT в основном зависит от расстояния туннелирования, диаграмма энергетических зон, которая может четко представлять расстояние туннелирования, объяснит причину изменения скорости BTBT. На рис. 2b минимальное расстояние туннелирования SC TFET расположено рядом с переходом источника и более или менее равно таковому у обычного DG TFET с t si =10 нм. Минимальное расстояние туннелирования обычного DG TFET с t si =20 нм значительно шире; следовательно, его скорость BTBT снижена по сравнению с SC TFET и обычным DG TFET с меньшей толщиной канала.
На рисунке 3a показаны скорости BTBT, когда напряжение затвора равно нулю и близко к начальному напряжению. Видно, что SC TFET имеет самую высокую скорость BTBT, за ним следует обычный DG TFET с t si =10 нм. Обычный DG TFET с t si =20 нм показывает самую низкую скорость BTBT. На рис. 3б представлена соответствующая зонная диаграмма. Можно заметить, что минимальное расстояние от валентной зоны до зоны проводимости находится в центре области канала. Кроме того, минимальное расстояние обычного DG TFET с большей толщиной канала больше, чем у SC TFET и обычного DG TFET с меньшей толщиной канала. Это указывает на то, что толщина канала также оказывает значительное влияние на скорость BTBT в начальной точке. Следовательно, V начало также зависит от толщины канала. Другой факт заключается в том, что SC TFET демонстрирует большую скорость BTBT, чем у обычного DG TFET с t si =10 нм даже при одинаковой минимальной толщине каналов. Это явление объясняется изменением распределения потенциала, вносимым углом электрода затвора, что также можно наблюдать в других работах [32, 33]. В результате SC TFET показывает самое низкое V начало , за которым следует обычный DG TFET с тонкой толщиной канала, а обычный DG TFET с большой толщиной канала показывает самый высокий V начало .

а Ставки BTBT и b диаграмма энергетических зон SC TFET и обычных DG TFET в ближней начальной точке, расстояние - это поперечное положение линии разреза AA ’на рис. 1
На рисунке 4а показано сравнение показателей BTBT в амбиполярном состоянии. Поскольку скорость BTBT сильно зависит от толщины канала, обычный TFET с t si =10 нм показывает наиболее значительную скорость BTBT по сравнению с двумя другими структурами TFET. SC TFET, однако, показывает аналогичную скорость BTBT с обычным DG TFET с t si =20 нм. Это связано с тем, что туннелирование в основном создается вблизи области стока, а SC TFET имеет более широкую толщину канала вблизи области стока. На рис. 4b также показана диаграмма энергетических зон в амбиполярном состоянии. Хорошо видно, что минимальное расстояние туннелирования находится вблизи области стока. Кроме того, расстояния туннелирования SC TFET и обычного DG TFET с большей толщиной канала больше, чем у обычного DG TFET с меньшей толщиной канала, что приводит к низкому амбиполярному току SC TFET и обычного DG TFET с большей толщиной канала.

а Ставки BTBT и b Диаграмма энергетических зон SC TFET и обычных DG TFET в амбиполярном состоянии, расстояние - это поперечное положение линии разреза AA ’на рис. 1
Воздействие H и L S по характеристикам постоянного тока
На рисунке 5a показаны кривые передачи SC TFET с различными значениями H и t si1 =10 нм. Видно, что H имеет меньшее влияние на ток в открытом состоянии. Однако амбиполярный ток значительно уменьшается по мере того, как H увеличивается, диапазон выключенного состояния улучшается с увеличением H также. Также видно, что уменьшение амбиполярного тока уменьшается по мере уменьшения H увеличивается. Причина этого в том, что эффект связи структуры с двумя затворами имеет тенденцию быть менее значительным при большей толщине канала [31]. Следовательно, поскольку H увеличивается, скорости BTBT становятся более независимыми от толщины канала, что приводит к насыщению амбиполярного тока. Для дальнейшего изучения оптимального параметра структуры, эффекты H варьируется от 0 до 15 нм на устройстве, характеристики извлечены и показаны на рис. 5b – d. На рис. 5b показан знак V . начало и изменение ставки BTBT с разными H и t si1 . Видно, что V начало монотонно убывает с увеличением H . Это связано с тем, что угол электрода затвора привнесет изменение распределения потенциала в области канала [32, 33], что приведет к изменению скорости BTBT и V начало . Рисунок 5b демонстрирует, что скорость BTBT увеличивается по мере того, как H улучшается. В результате уменьшилось V начало можно найти с увеличенным H . Также можно заметить, что V начало увеличивается по мере того, как t si1 увеличивается. Основная причина в том, что увеличение t si1 снижает коэффициент BTBT, что приводит к более высокому V начало . На рис. 5c извлеченное среднее значение SS СК ТФЭТ с различными H и t si1 Показано. Тенденция SS с разными H противоположен V начало . Другими словами, SS поднимается по мере того, как H увеличивается. Мы упоминали, что ток стока в открытом состоянии зависит от t si1 , так что SC TFET с разными H но с тем же t si1 должен иметь аналогичный ток стока во включенном состоянии. Кроме того, также известно, что V начало уменьшается с увеличением H . Это означает, что диапазон напряжения затвора для управления таким же током стока улучшен по сравнению с H увеличивается. В результате средняя СС монотонно увеличивается с ростом H . Также видно, что увеличение t si1 подорвет СС , что связано с уменьшением возможности управления воротами. На рисунке 5d показан ток стока в открытом и амбиполярном состоянии с разными значениями H . и t si1 , соответственно. Ток в открытом состоянии почти не зависит от H , но на него сильно влияет t si1 , что соответствует нашему предыдущему результату о том, что туннелирование в открытом состоянии в основном происходит вблизи области источника и сильно зависит от толщины канала вблизи области источника. Однако амбиполярный ток уменьшается по мере того, как H увеличивается. Поскольку туннелирование в амбиполярном состоянии преобладает вблизи области стока, увеличение H улучшит толщину канала на стороне стока и, таким образом, ослабит амбиполярный ток. Также видно, что амбиполярный ток падает более значительно, когда H меньше 10 нм, что связано с большим эффектом связи при меньшей толщине канала.

Воздействие H на а переходные кривые, b V начало и курс BTBT, c средний СС , и d ток стока во включенном / амбиполярном состоянии, H высота ступеньки и H =0 нм представляет собой обычный DG TFET
На рис. 6а показаны передаточные кривые SC TFET с разными L s представлены соответственно. L s =0 нм представляет собой обычный DG TFET с соответствующим t si2 и L s =50 нм представляет собой обычный DG TFET с соответствующим t si1 . Видно, что расположение ступеньки оказывает значительное влияние на амбиполярный ток и диапазон выключенного состояния. SC TFET с L s менее 30 нм показывают аналогичный амбиполярный ток и диапазон в закрытом состоянии. Поскольку L s превышает 30 нм, амбиполярный ток значительно увеличивается. На рис. 6b показан V начало и изменение ставки BTBT при различных L s и t si1 , тенденция, что V начало увеличивается по мере того, как t si1 улучшения также можно отчетливо наблюдать. Точка перегиба изменения на L s =10 нм является результатом разнообразия t si1 . Поскольку L s =0 нм - это обычный DG TFET с большей толщиной канала, скорость BTBT уменьшится, что приведет к увеличению V начало и пониженный ток в открытом состоянии. За исключением случая обычного DG TFET, V начало SC TFET монотонно увеличивается как L s повышается, что связано с уменьшением скорости BTBT, вызванным ступенчатой структурой канала. На рисунке 6c показано влияние L s и t si1 на СС СК ТФЭЦ. Повышенный t si1 приводит к ухудшенному состоянию SS . Согласно формуле. (1), увеличенная толщина канала снизит эффекты связи между электродами затвора, что приведет к уменьшению возможности управления затвором и увеличению SS [12]. Поскольку L s падает, область с большей толщиной канала будет расширяться и ослабит общую способность управления затвором. В результате уменьшенная L s подорвет СС СК ТФЭТ, что хорошо видно на рис. 6в. На рисунке 6d показан ток стока в открытом и амбиполярном состоянии с разными значениями L . s и t si1 , соответственно. Можно заметить, что ток в открытом состоянии SC TFET более или менее равен току обычного DG TFET с соответствующим t si1 . Что касается амбиполярного тока, то SC TFET с L s менее 30 нм показывают ток, аналогичный току обычных DG TFET с соответствующим t si2 . Когда L s увеличивается до 40 нм, резко возрастает амбиполярный ток. Фактически, для случая SC TFET с L s =40 нм и t si1 =20 нм, его амбиполярный ток даже больше, чем у обычного DG TFET с t si1 =20 нм. Это связано с тем, что вертикальная часть электрода затвора может увеличивать зону туннелирования, особенно когда вертикальная часть электрода затвора находится близко к PN-переходу [34]. Это означает, что L s должно быть меньше 40 нм для уменьшения амбиполярного тока.

Воздействие L s на a переходные кривые, b V начало и курс BTBT, c средний СС , и d ток стока во включенном / амбиполярном состоянии, L s - поперечное расстояние от исходной области до ступеньки, L s =0 нм представляет собой обычный DG TFET с соответствующим t si2 и L s =50 нм представляет собой обычный DG TFET с соответствующим t si1.
Для определения оптимальных структурных параметров SC TFET проводится ортогональное моделирование путем изучения комбинированного воздействия H и L s по производительности устройства. t si1 фиксируется на 10 нм для достижения большего тока в открытом состоянии. На рис. 7a амбиполярный ток извлекается как функция L s с различными H . Хорошо видно, что амбиполярный ток значительно уменьшается по мере того, как H уменьшается, что говорит о том, что более высокое значение H перспективен с точки зрения достижения более низкого амбиполярного тока. Однако можно заметить, что выгода от более высокого H менее значимо. Следовательно, H =15 нм было бы оптимальным значением, учитывая, что большее значение H можно было только увеличить площадь устройства. Между тем, уменьшилось L s также снизит амбиполярный ток, особенно с большим значением H . Следовательно, более низкий L s желательно с целью минимального амбиполярного тока. Тем не менее, более низкий L s также может привести к увеличению подпороговой крутизны, как это видно на рис. 7b. Наклон подпорога медленно увеличивается с увеличением L s но быстро возрастает при более низком L s , что указывает на то, что L s около 25 нм было бы компромиссным значением. В результате оптимальные параметры устройства будут H =15 нм и L s =25 нм, где и амбиполярный ток, и подпороговая крутизна относительно невелики.
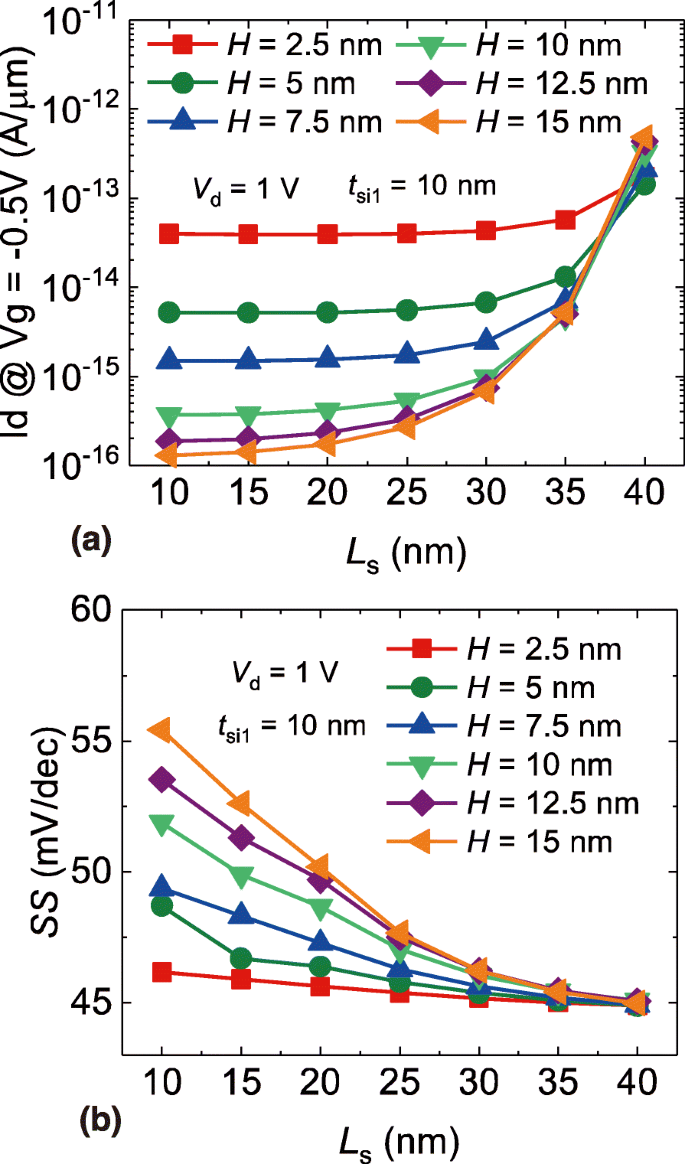
а Амбиполярный ток и b подпороговый наклон SC TFET как функция L S с различными H
Метод изготовления
Возможный процесс изготовления SC TFET показан на рис. 8. Благодаря уникальной форме канала, толщина ступенчатого канала может быть легче достигнута за счет использования вертикальной конструкции. Процесс начинается с подготовки кремниевой подложки с нанесением SiN и фоторезиста, как показано на рис. 8а. На рис. 8b формирование рисунка SiN достигается литографией с последующим травлением для формирования области канала, затем N + область вводится вертикальной имплантацией и отжигом As [35]. После этого наносится изолирующий оксид, чтобы предотвратить травление области стока в следующем процессе, как показано на рис. 8c. На рис. 8d озоление и обрезка приняты за счет использования реакционного ионного травления [36] для уменьшения толщины и ширины SiN. Толщина ступенчатого канала затем вводится травлением, как показано на рис. 8e. Остальные процессы аналогичны традиционному вертикальному TFET, включая формирование оксида затвора, осаждение затвора, экспонирование кремния и имплантацию области источника [35, 37], как показано на рис. 8f.
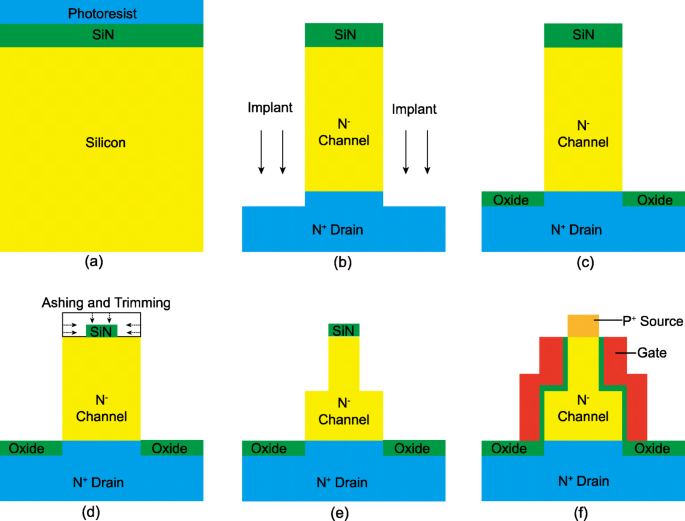
Процесс изготовления СК ТФЭТ. а Изготовление кремниевой подложки с нанесением SiN и фоторезиста. б Травление, имплантация и отжиг. c Осаждение изолирующего оксида. г Уменьшение толщины и ширины SiN за счет озоления и обрезки. е Введена толщина ступенчатого канала. е Формирование оксида затвора, осаждение затвора, планаризация затвора и имплантация области источника
Заключение
Мы исследуем электрические характеристики DG TFET с толщиной ступенчатого канала (SC TFET) с помощью 2D-моделирования. Асимметрия между истоком и стоком вносится толщиной ступенчатого канала; следовательно, амбиполярное поведение значительно облегчается. SC TFET демонстрирует аналогичные характеристики в открытом состоянии обычного DG TFET с соответствующим t si1 и параллельные выключенные / амбиполярные кривые обычного DG TFET с соответствующим t si2 . В результате SC TFET может достигать широкого диапазона в выключенном состоянии, низкого амбиполярного тока и поддерживать низкий SS одновременно. Механизмы SC TFET подробно обсуждаются для изучения физических свойств. Влияние параметров структуры на начальное напряжение, подпороговую крутизну, ток стока во включенном и амбиполярном состоянии также изучается для определения оптимальной структуры. SC TFET с H 15 нм и L s 25 нм показывает оптимальные характеристики. Более того, архитектура ступенчатой толщины канала обеспечивает альтернативный метод асимметрии. Поскольку комбинированные стратегии асимметрии доказали свою эффективность, наша работа может еще больше повысить производительность TFET.
Доступность данных и материалов
Все данные полностью доступны без ограничений.
Сокращения
- DG TFET:
-
Туннельный полевой транзистор с двойным затвором
- SC TFET:
-
ДГ ТФЭТ с толщиной ступенчатого канала
- SS :
-
Наклон подпорога
- BTBT:
-
Межполосное туннелирование
- EOT:
-
Эффективная толщина оксида
- V начало :
-
Начальное напряжение
- H :
-
Высота ступени
- L s :
-
Положение шага
- L ch :
-
Длина канала
- t si :
-
Толщина канала
- t si1 :
-
Толщина канала около исходной области
- t si2 :
-
Толщина канала около дренажной области
Наноматериалы
- Соединение частей:интеграция портативного компонента, совместимого с FACE, в среду моделирования
- Соединительный полевой транзистор (JFET) в качестве переключателя
- Понимание компонентов тока утечки в МОП-транзисторах с коротким каналом
- В гармонии с сердцем атома меди
- MoS2 с контролируемой толщиной для электрокаталитического выделения водорода
- Поверхностный эффект на транспортировку нефти в наноканале:исследование молекулярной динамики
- Исследование новой червеобразной мицеллярной системы, усиленной наночастицами
- Оптимизация программирования безконденсаторной 1T DRAM на основе TFET с двумя затворами
- Сегнетоэлектрические полевые транзисторы на основе одностенных углеродных нанотрубок с преобладанием микр…
- Канальные плазмонные нанопроволочные лазеры с полостями с V-образной канавкой



