Измерения локальных летучих органических соединений с помощью зондовой силовой микроскопии Кельвина применительно к кремниевым нанопроволям радиального перехода P-I-N
Аннотация
В этой работе основное внимание уделяется извлечению напряжения холостого хода ( В OC ) на фотоэлектрических нанопроводах методом поверхностного фотоэдс (SPV) на основе измерений зондовой силовой микроскопии Кельвина (KPFM). В первом подходе устройства кремниевых нанопроволок (SiNW) с радиальным переходом (RJ) P-I-N были исследованы при освещении с помощью KPFM и вольт-амперного анализа (I-V). В пределах 5% извлеченная SPV хорошо коррелирует с V OC . Во втором подходе локальные измерения SPV применялись к одиночным изолированным КНН с радиальным переходом, указывая на эффекты затенения от наконечника АСМ, которые могут сильно повлиять на оценку SPV. Чтобы свести к минимуму этот эффект, было разработано несколько стратегий с точки зрения формы наконечника АСМ и ориентации освещения. Локальные измерения SPV на изолированных КНН с радиальным переходом логарифмически увеличиваются с увеличением мощности освещения и демонстрируют линейное поведение с V OC . Результаты показывают, что бесконтактные измерения V OC становятся возможными в масштабе отдельных фотоэлектрических устройств SiNW.
Введение
Полупроводниковые наноструктуры привлекают большой исследовательский интерес из-за их наноразмерных свойств, которые открывают большой потенциал для улучшения характеристик существующих устройств. Матрицы нанопроволок на основе радиальных переходов (RJ) являются многообещающими наноструктурами для фотоэлектрических (PV) приложений из-за их свойств захвата света и сбора носителей [1, 2], которые специально объединены для повышения солнечной эффективности по сравнению с обычными планарными структурами. Эффективность солнечных элементов с нанопроволокой может быть ограничена из-за поврежденных переходов нанопроволоки в матрице; тем не менее, эффективность до 9,6% уже была продемонстрирована для RJ кремниевых нанопроволок (SiNW) на основе технологии тонких пленок Si [3]. Определение характеристик таких структур остается критическим вопросом, и, в частности, возможность охарактеризовать фотоэлектрические характеристики отдельных нанопроволок является дополнительной ценностью для улучшения конечного устройства.
В настоящем исследовании мы использовали зондовую силовую микроскопию Кельвина (KPFM) для оценки местного напряжения холостого хода ( V OC ) на SiNW RJ. Анализ V OC был успешно протестирован KPFM на нескольких типах фотоэлектрических технологий, в основном на планарных структурах [3, 4]. Однако анализ KPFM на фотоэлектрических наноустройствах непрост, в частности, из-за того, что может потребоваться выполнение измерений как в темноте, так и в условиях освещения для определения изменения поверхностного потенциала, называемого поверхностным фотоэдс (SPV).
Наш первый подход к исследованию местного V OC RJ SiNW должен был анализировать готовые устройства. Термин завершенный относится к солнечным элементам RJ SiNW, в которых в качестве переднего электрода используется ITO. Следующие завершенные устройства были последовательно охарактеризованы измерениями тока-напряжения (I-V) и KPFM. Оба измерения были выполнены в темноте и в условиях освещения с конечной целью извлечь и сравнить V OC и SPV. Наш второй подход заключался в анализе одиночных изолированных RJ SiNW, которые не были покрыты ITO. Мы особенно стремились оптимизировать сигнал KPFM при освещении, избегая множества артефактов, которые могут привести к занижению значения SPV. Каждый изолированный RJ SiNW будет обозначаться как изолированное устройство.
Наконец, чтобы завершить результаты, метод макроскопического зонда Кельвина также был применен к законченному устройству RJ и к группе изолированных устройств. Это было сделано при освещении на разных длинах волн для проведения спектроскопии поверхностного фотоэдс (SPS).
Материалы и методы
Изготовление устройства для наращивания SiNW и радиального соединения P-I-N
КНН RJ были приготовлены на подложке из стекла Corning, покрытого ZnO:Al (Cg). Рост SiNW проводился при температуре подложки 500 ° C с помощью плазменного химического осаждения из паровой фазы (PECVD) с использованием наночастиц Sn в качестве катализаторов. P-I-N RJ получали путем нанесения тонких конформных слоев собственного (80 нм), а затем n-типа (10 нм) гидрированного аморфного Si (a-Si:H) также с помощью PECVD при 175 ° C на ядро SiNW p-типа. Завершенные устройства были завершены конформным осаждением ITO с образованием круглых верхних контактов диаметром 4 мм, ограниченных маской во время напыления. Полные подробности изготовления объяснены в [1, 5,6,7].
Датчик Кельвина и поверхностное фотоэдс
Измерения KPFM могут выполняться с использованием двух различных режимов:амплитудной модуляции (AM) и частотной модуляции (FM). Оба режима позволяют получить одинаковое значение свойства контактной разности потенциалов (CPD), существующее между зондом и поверхностью образца. В данном исследовании был выбран режим AM, причина которого заключалась в его большей стабильности измерений в присутствии значительных изменений высоты, таких как наблюдаемые на краях нанопроволоки образца.
Измерения KPFM и SPV были выполнены с использованием системы сканирующей зондовой микроскопии от HORIBA / AIST-NT (платформа TRIOS), которая дает несколько преимуществ. Действительно, для этого атомно-силового микроскопа (AFM) система отклонения на основе лазерного луча (LBBDS) использует длину волны лазера 1310 нм, которая минимизирует возможные фотоэлектрические взаимодействия с образцом [8,9,10 ] . Это будет подчеркнуто здесь путем сравнения данных, полученных с использованием этой платформы, с данными, полученными с помощью системы AFM, которая использует длину волны 690 нм для LBBDS.
Платформа TRIOS хорошо подходит для изучения фотоэлектрических свойств материалов, поскольку она включает в себя три объектива микроскопа, позволяющих освещать образец с разных сторон (сверху, сбоку и снизу). Измерения SPV в масштабе микро / нано здесь получены путем вычитания CPD в темноте из CPD при освещении. Этот вид измерения ранее использовался для выполнения V OC измерения фотоэлектрических устройств [5, 11]. Освещение образца осуществлялось с помощью стабилизированного лазерного диода OXXIUS с длиной волны 488 нм с модулем регулируемой мощности.
Для измерений сканирующим зондом использовались два типа проводящих наконечников AFM:ARROW-EFM и ATEC-EFM. Оба они имеют кантилевер из легированного кремния и покрытие из PtIr. Их отличие заключается в их форме от обычной формы наконечника для ARROW и наклонной формы для ATEC.
Наконец, измерения SPV на наноуровне были дополнены макроскопическими измерениями зонда Кельвина с возможностью изменения длины волны освещения для выполнения измерений SPS, то есть измерений SPV со спектральным разрешением. Для этой цели использовалась установка ASKP200250 Kelvin Probe от KPTechnology, оснащенная стальным наконечником диаметром 2 мм. Эта установка включает освещение со стороны, соединяющей источник галогенной лампы с монохроматором, который охватывает диапазон длин волн от 400 нм до 1000 нм. Обратите внимание, что эта конфигурация не позволяет проводить измерения SPV при постоянном потоке, и по этой конкретной причине могут быть сделаны только качественные наблюдения.
Макроскопические измерения ВА в сочетании с KPFM
Как указывалось ранее, наш первый подход заключался в выполнении макроскопических измерений ВАХ на готовом устройстве SiNW RJ. Для этой цели мы использовали измеритель источника KEITHLEY 2450 и микропозиционер с вольфрамовой иглой, который позволяет контактировать с устройством, находясь под настройкой АСМ, как схематически показано на рис. 1.
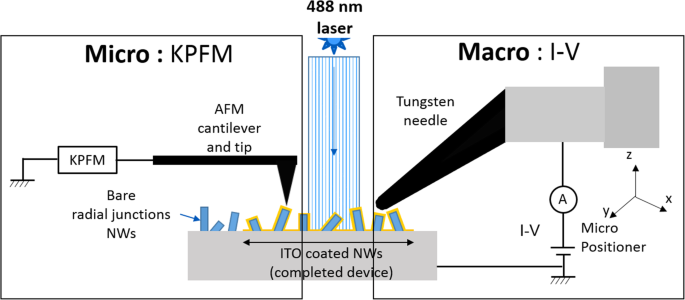
Схема измерительной установки как для КПФМ, так и для макроскопических измерений ВАХ
Измерения I-V и KPFM проводились в темноте, а затем с использованием того же освещения, что описано в предыдущем подразделе, а именно лазерного источника на 488 нм с регулируемой мощностью. Освещение осуществлялось сверху через объектив MITUTOYO 10X, а падающая мощность освещения была откалибрована в диапазоне 70–1000 мкВт.
Далее измерения KPFM проводились на изолированных устройствах с двумя типами наконечников AFM, ARROW и ATEC. Освещение образца во время измерения производилось с двух сторон, сверху и сбоку, и с использованием той же номинальной мощности, что и те, которые использовались ранее на готовом устройстве.
Результаты и обсуждение
Перед началом измерений I-V и KPFM было исследовано влияние LBBDS AFM. Действительно, уже было показано, что длина волны LBBDS может иметь значительное взаимодействие с фотоэлектрическими образцами [8,9,10] и, таким образом, может влиять на измерения электрических свойств с помощью АСМ. На рисунке 2 показаны макроскопические измерения ВАХ завершенного Устройство SiNW RJ работает в темноте (LBBDS выключена) и когда LBBDS остается включенной. Как упоминалось ранее, измерения также проводились в другой установке AFM с использованием длины волны 690 нм вместо 1310 нм для LBBDS. Кривые ВАХ, полученные в темноте и с LBBDS при 1310 нм, практически идентичны. Только при масштабировании вокруг начала координат можно наблюдать очень небольшой сдвиг для измерений, выполненных с включенной LBBDS, который может быть выражен очень маленькими значениями в терминах V OC (0,5 мВ) и ток короткого замыкания, I SC, (1 нА). Для сравнения, кривая ВАХ, измеренная с помощью системы, использующей длину волны 690 нм для LBBDS, демонстрирует значительный фотоэлектрический эффект со значениями V OC и я SC 545 мВ и 28 мкА соответственно. Это ясно свидетельствует о разрушительном эффекте LBBDS с длиной волны лазера в видимом диапазоне. Эти результаты показывают трудности выполнения измерений KPFM в реальных условиях темноты, когда, в частности, длина волны LBBDS может взаимодействовать с образцом. Следующие проиллюстрированные результаты были получены с LBBDS АСМ, работающей на длине волны 1310 нм, описанной в подразделе Кельвина-Зонд.
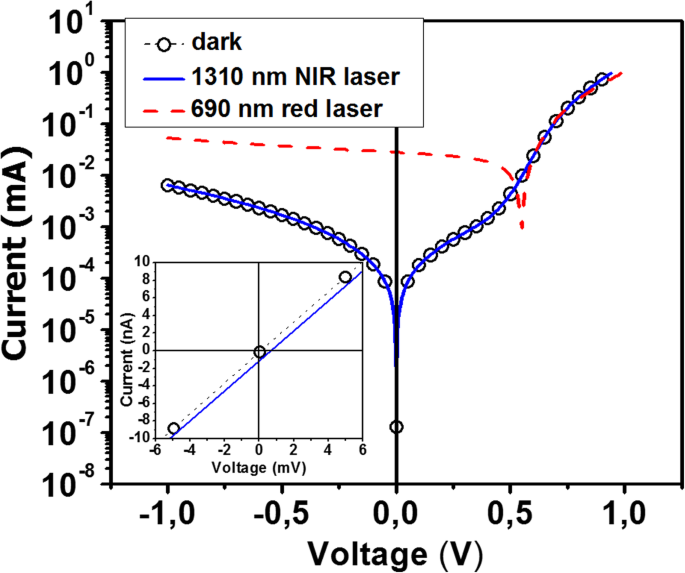
ВАХ, полученные на приборе SiNW RJ в темных условиях (черные кружки), с использованием лазерного луча 1310 нм TRIOS AFM (синяя сплошная линия) и лазерного луча 690 нм Enviroscope AFM (красная пунктирная линия). На основном графике показаны кривые log | I | -V в диапазоне от - 1 В до + 1 В, а на вставленном графике показано увеличение линейных кривых I-V в диапазоне от - 5 мВ до + 5 мВ
Пример фотоэлектрических измерений в готовом устройстве SiNW RJ показан на рис. 3. В частности, макроскопические измерения ВАХ при различной мощности освещения (70, 150, 270 и 560 мкВт) представлены на рис. 3.a. Кривые ВАХ показывают типичное рабочее поведение фотоэлемента, когда I SC и V OC увеличиваются с мощностью падающего света. На рисунке 3.b показан пример отображения KPFM, которое представляет слева направо топографию, CPD в темноте и CPD при освещении 488 нм. Сканирование топографии выявляет ННК высотой в несколько сотен нанометров и показывает плотность на единицу площади около 10 9 см -2 . Сканирование CPD показывает локальные вариации потенциала около ± 10 мВ, происходящие в основном на северо-западных краях. Эти вариации можно рассматривать как артефакты из-за быстрого изменения топографии, через которое проходит наконечник АСМ во время сканирования и, в частности, когда он проходит между двумя NW. Места, которые не подвержены влиянию такого артефакта, - это вершины северо-западных районов, где изменение высоты рельефа остается незначительным. Все значения CPD, представленные ниже, были извлечены в верхней части NW.
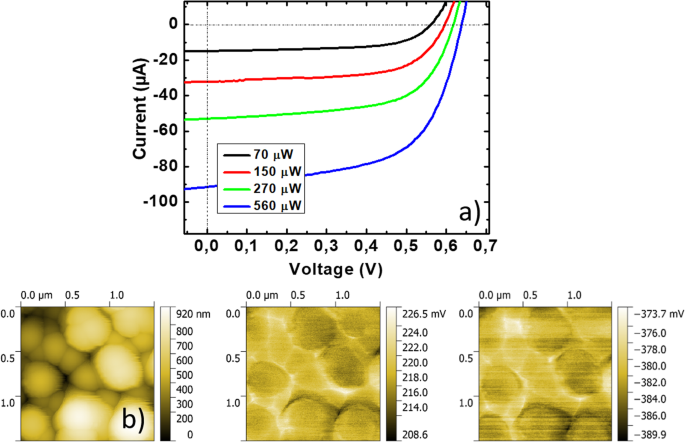
а Макроскопические ВАХ, измеренные при освещении различной мощности (66, 5, 149, 268 и 555 мкВт при 488 нм); б слева направо:топография, CPD в темноте и CPD при освещении (270 мкВт при 488 нм) соответственно
На рисунке 4 сравнивается V OC . и значения SPV, извлеченные из макроскопических измерений I-V и KPFM, как функции мощности падающего освещения. Это сравнение было выполнено для двух разных завершенных устройств и проиллюстрировано в полулогарифмическом масштабе. Максимальная разница между кривыми Voc и SPV составляет менее 5% для самой низкой мощности освещения (~ 70 мкВт) и становится менее 2% для более высокой мощности освещения. Важно отметить, что шкала ошибок, связанная с экспериментальной оценкой мощности падающего света, увеличивается при уменьшении мощности освещения, что может объяснить разницу в 5% между V OC и SPV, упомянутые ранее. Для обоих графиков SPV и V OC значения соответствуют логарифмическому поведению со значениями в диапазоне 500-600 мВ. Наклоны Voc и SPV дают коэффициент идеальности (n) 1,5 ± 0,1 для устройства 1 и 1,75 ± 0,25 для устройства 2 соответственно. Эти значения хорошо согласуются со значениями, указанными в литературе для перехода a-Si:H P-I-N, которые находятся в диапазоне 1,5–2 [12,13,14]. На рис. 5 показаны измерения зависимости SPV от мощности света, выполненные на изолированных устройствах SINW RJ. Термин изолированный здесь относится к тому факту, что RJ нанопроволоки не покрыты ITO, поэтому они не связаны электрически через верхний проводящий слой. В качестве справочного руководства кривая SPV, полученная ранее для готового устройства RJ на рис. 4.a, также была показана на рис. 5. Сообщенные значения SPV соответствуют среднему значению, полученному в результате нескольких NW для размеров сканирования 3x3 мкм². Измерения SPV на изолированных устройствах сначала были выполнены с наконечником AFM в форме стрелки (ARROW-EFM) и освещением, исходящим сверху, так же, как измерение SPV выполнялось на готовом устройстве. Очень низкие значения SPV для этой кривой (рис. 5.a, квадраты), а также ее наклон ниже 1 (~ 0,4) указывают на эффект затенения из-за наконечника АСМ. Действительно, сохранение того же верхнего освещения и изменение наконечника АСМ с помощью наклонного зонда (ATEC-EFM) позволило нам наблюдать увеличение на 40% значений SPV для того же диапазона мощности освещения (рис. 5.b, треугольник). Аналогичные результаты были получены при изменении освещенности сверху в сторону и замене наконечника АСМ ATEC на исходную СТРЕЛКУ на наконечнике АСМ (рис. 5.c, синие точки). Хотя значения SPV значительно увеличились по сравнению с измерениями с верхним освещением и наконечником ARROW-EFM, они остаются ниже эталонного значения, сохраняя при этом одинаковые наклоны (~ 1,3–1,4). Обратите внимание, что этот эффект затенения не наблюдался в случае готовых устройств, потому что для этой конфигурации SPV отображает фото-напряжение всего устройства:тысячи нанопроволок, соединенных вместе передним контактом ITO.
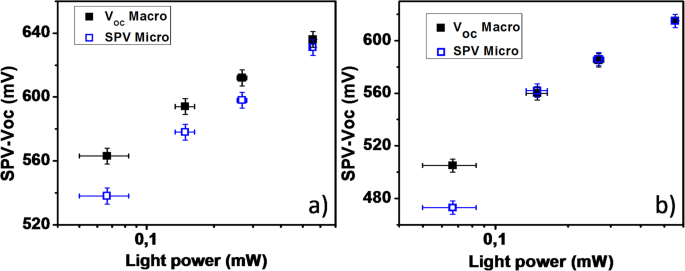
V OC и SPV в сравнении с мощностью света для двух разных устройств:dev 1 ( a ) и разработчик 2 ( b )

SPV в зависимости от мощности света, полученной на изолированных RJ NW. Измерения проводились с разной формой наконечника АСМ (ARROW-EFM и ATEC-EFM) и разными направлениями освещения (верхнее и боковое). Ссылочное устройство RJ обозначает устройство 1, показанное на фиг. 4a. Изображение AFM в правом нижнем углу показывает пример топографии, измеренной на изолированных NW
Чтобы дополнить эти результаты, качественный SPS-анализ был проведен над группой изолированных устройств, а затем над законченным устройством. На рис. 6.а показаны полученные спектры SPV с четкими различиями по всему спектру. Интересно подчеркнуть, что законченное устройство показывает пренебрежимо малую SPV (~ 10 мВ) в ближней инфракрасной (NIR) области с порогом SPV, имеющим место около 800 нм, ниже которого SPV быстро увеличивается, достигая максимума 560 мВ при 630 мВ. нм. И наоборот, группа изолированных устройств показывает значительную SPV 80–260 мВ в ближнем ИК-диапазоне (800–1000 нм), которая постепенно увеличивается с уменьшением длины волны до 435 мВ для 665 нм. Ниже 665 нм и 630 нм обе кривые SPV уменьшаются с уменьшением длины волны, что может быть связано с ожидаемым уменьшением освещенности галогенной лампы, используемой в этой установке (как упоминалось выше, подход SPS здесь основан на качественных измерениях, поскольку поток не может быть постоянным). Во втором подходе измерения SPS были выполнены на готовом устройстве и после локального удаления верхнего контакта ITO с 1% раствором HF, нанесенным в виде капли на устройство. Рисунок 6.b иллюстрирует эти измерения, и спектры SPV были специально собраны сразу после удаления ITO и 72 часа спустя. Удаление слоя ITO имеет большое влияние на спектр SPV по сравнению с законченным устройством. Сильное уменьшение SPV-сигнала наблюдается в диапазоне 400-750 нм сразу после удаления ITO. Через 72 часа сигнал SPV стабилизируется на более высоком уровне, который может отличаться в зависимости от длины волны более чем в 2 раза. Также оказывается, что сигнал SPV немного увеличивается на более длинных волнах (λ> 750 нм). Сравнивая спектры SPV на рис. 6, кажется, что после удаления ITO, показанного на рис. 6.b, и особенно после 72-часовой стабилизации, устройства NW показывают такое же состояние, как и те, которые обозначены как группа изолированных NW на рис. 6.a, последний никогда не имел покрытия ITO. Другое важное наблюдение касается сигнала SPV, измеренного на длине волны 488 нм, значение которого в ~ 1,7 раза ниже для группы изолированных NW, чем для готового устройства. Это наблюдение подтверждает результаты SPV на рис. 5, выполненные KPFM на изолированных NW RJ с освещением 488 нм. Действительно, несмотря на оптимизацию формы наконечника АСМ и условий освещения, измеренные значения SPV также были ниже, чем у готового устройства, на коэффициент, варьирующийся от 1,5 до 2, в зависимости от мощности освещения.
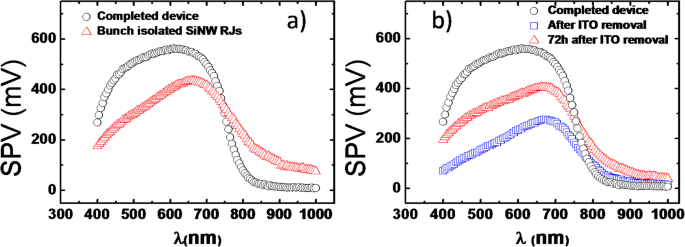
Измерения SPS, выполненные a готовое устройство и связка изолированных КНН; б готовое устройство сразу после удаления ITO и 72 часа спустя
Результаты на рис. 6 ясно показывают, что верхний контакт ITO требуется для получения более высоких значений SPV (т. Е. V OC ), а точнее, ключевым моментом остается интерфейс (n) a ‑ Si:H / ITO. Этот интерфейс характеризуется очень тонким слоем a-Si:H n-типа (~ 10 нм), что способствует оптическому пропусканию. Уровень легирования этого слоя и работа выхода ITO могут, в частности, вызвать полное истощение слоя a-Si:H. Таким образом, внезапное падение потенциала может произойти на границе раздела до достижения потенциала плоской полосы в ITO. Такое падение потенциала на границе с верхним контактом ITO уже было проиллюстрировано в структурах P ‑ I ‑ N a-Si:H, которые были проанализированы с помощью профилирования SPV [12, 15]. Те же границы раздела со сверхтонкими слоями a-Si:H также были исследованы в технологии солнечных элементов гетероперехода a-Si:H / кристаллический Si, снова подчеркивая влияние уровня легирования и толщины слоя a-Si:H на V OC с ITO и без [16, 17].
Предыдущие соображения показывают, что локальный анализ SPV с помощью KPFM на изолированных NW RJ не может количественно отразить оптимальное значение V OC из-за отсутствия ITO. Извлеченный локальный V OC здесь ограничивается изгибом поверхностной полосы как следствием полного истощения слоя a-Si:H n-типа и степени его поверхности окисления. Измеренная SPV включает не только V OC но также и фотоиндуцированное изменение изгиба полосы вблизи поверхности слоя a-Si:H n-типа [18].
Заключение
Готовые устройства на основе RJ SiNW были совместно проанализированы при освещении с помощью измерений I-V и KPFM. Это первое сравнение, проведенное для различных мощностей освещения, показывает, что локальные значения SPV, извлеченные из KPFM, очень близки к V OC значения, полученные в результате анализа I-V. Локальные измерения SPV на изолированных RJ SiNW, напротив, показывают существенное отличие от предыдущего V OC ценности. Эффект затенения наконечника АСМ был подтвержден и сведен к минимуму, изменяя форму наконечника и / или ориентацию освещения. Оптимизированные значения SPV, собранные для изолированных RJ SiNW, показывают логарифмическое поведение с мощностью освещения, но остаются значительно ниже V OC справочные значения. SPS-анализ, выполненный на связках изолированных устройств SiNW, подчеркивает отсутствие интерфейса (n) a-Si:H / ITO как причину потери потенциала, особенно потому, что исследованные изолированные устройства SiNW не имеют ITO в качестве верхнего контакта. Несмотря на это, локальная SPV, выделенная на изолированных устройствах КНИН при различных условиях освещения, показывает линейное соответствие с V OC измеряется на готовых устройствах, подтверждая, в частности, что локальный SPV может отражать V OC .
Доступность данных и материалов
Наборы данных, использованные и / или проанализированные в ходе текущего исследования, доступны у соответствующего автора по разумному запросу.
Сокращения
- AFM:
-
Атомно-силовая микроскопия
- AM:
-
Амплитудная модуляция
- a-Si:H:
-
Гидрированный аморфный кремний
- Cg:
-
Стекло Corning
- CPD:
-
Контактная разность потенциалов
- FM:
-
Частотная модуляция
- ITO:
-
Оксид индия-олова
- I-V:
-
Ток-напряжение
- КПФМ:
-
Зондовая силовая микроскопия Кельвина
- LBBDS:
-
Система отклонения на основе лазерного луча
- n:
-
Фактор идеальности
- NW:
-
Нанопроволока
- PECVD:
-
Химическое осаждение из паровой фазы с применением плазмы
- PV:
-
Фотоэлектрические
- RJ:
-
Радиальный стык
- SiNW:
-
Кремниевая нанопроволока
- SPS:
-
Спектроскопия поверхностного фотоэдс
- SPV:
-
Фотоэдс на поверхности
- V OC :
-
Напряжение холостого хода
Наноматериалы
- Отображение атомов на двумерных атомных кристаллах в жидкостях
- Материаловеды учат нанопроволоки "танцевать"
- Плазмонно-усиленное поглощение света в (p-i-n) переходных GaAs-нанопроводных солнечных элементах:исследование ме…
- Аморфные кремниевые нанопроволоки, выращенные на пленке оксида кремния путем отжига
- Теоретическое исследование двухосно-деформированных германиевых нанопроволок
- Изучение силы адгезии и стеклования тонких пленок полистирола с помощью атомно-силовой микроскопии
- Нанопроволочные нанопроволоки из оксида меди с ультрафиолетовым светом
- Низкотемпературное восстановление оксида графена:электрическая проводимость и сканирующая силовая микроск…
- Потенциальный провал в органических фотоэлектрических элементах, подтвержденный с помощью поперечной микро…
- Что такое радиальная сила?



