Сегнетоэлектрические полевые транзисторы с нанокристаллическим изолятором (NEI) для устройств с отрицательной емкостью и энергонезависимой памяти
Аннотация
Мы сообщаем о новом сегнетоэлектрическом полевом транзисторе со встроенным изолятором (NEI) (FeFET) с очень тонким изолирующим слоем из унифицированного сегнетоэлектрика / диэлектрика (FE / DE), который является многообещающим для низковольтной логики и энергонезависимой памяти ( NVM) приложений. Сегнетоэлектрическая природа слоев NEI, содержащих ромбический ZrO 2 нанокристаллы, внедренные в аморфный Al 2 О 3 подтверждается измерениями поляризационного напряжения, силовой микроскопией пьезоотклика и электрическими измерениями. Исследованы температурно-зависимые характеристики и долговечность полевого транзистора NEI с отрицательной емкостью (NCFET). FeFET с FE / DE толщиной 3,6 нм обеспечивает окно памяти, превышающее 1 В, открывая путь для максимального масштабирования толщины FE для создания трехмерных FeFET с очень малым шагом ребер.
Фон
Полевые транзисторы с сегнетоэлектрическим слоем изолятора затвора (FeFET) вызывают значительный интерес для различных приложений интегральных схем. Из-за присущих ему свойств отрицательной емкости (NC) FeFET может обеспечить более крутые характеристики переключения, чем обычный MOSFET, что позволяет работать при более низком напряжении [1]. Различные структуры каналов [2,3,4] и материалы [5,6,7] имеют подпороговое колебание (SS) ниже 60 мВ / декада. Кроме того, гистерезис вольт-амперной характеристики ( I - V ) характеристика из-за остаточной поляризации ( P r ) может использоваться для приложения энергонезависимой памяти (NVM) [8]. В последнее время разработка материалов для FeFET была сосредоточена на поликристаллическом HfO 2 . благодаря лучшей масштабируемости по толщине [9] и совместимости с КМОП-процессами [2]. Однако все еще существует фундаментальный предел для HfO 2 . масштабирование толщины, чтобы избежать нежелательного тока утечки затвора; это, в свою очередь, ограничивает FinFET [2]. Вдохновленный концепцией нанокристаллических МОП и запоминающих устройств [10, 11], в этой работе представлен изолирующий диэлектрический (ДЭ) слой с внедренными сегнетоэлектрическими (СЭ) нанокристаллами. Получившаяся новая конструкция устройства, показанная на рис. 1, называется FeFET «нанокристаллический встроенный изолятор» (NEI). Основным преимуществом этой конструкции является более тонкий слой унифицированного FE / DE, который отвечает требованиям низкой утечки затвора.
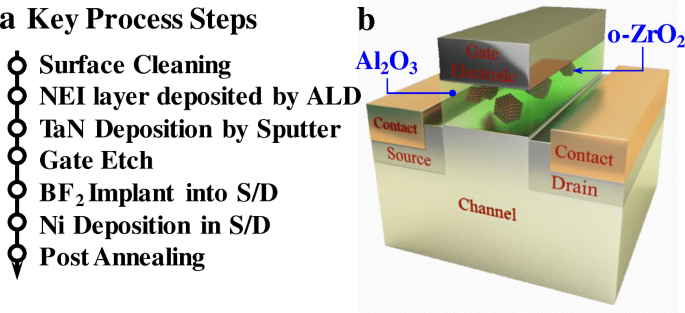
а Основные этапы процесса изготовления сегнетоэлектрических полевых транзисторов NEI. б Трехмерная схема изготовленного NEI FeFET
В этой работе описаны NEI FeFET. Охарактеризованы физические свойства и сегнетоэлектричество слоев НЭВ разной физической толщины. Электрические характеристики NEI FeFET исследуются для низковольтной логики и приложений NVM.
Методы
Основные этапы процесса изготовления NEI FeFET показаны на рис. 1a. В качестве исходных подложек использовались четырехдюймовые пластины Ge (001) n-типа с удельным сопротивлением 0,088–0,14 Ом · см. После предварительной очистки с использованием разбавленной HF пластины Ge (001) загружали в камеру для осаждения атомных слоев (ALD) для осаждения слоя NEI, содержащего ZrO 2 нанокристаллы, внедренные в аморфный Al 2 О 3 матрица. В работе использовались слои NEI различной толщины. Металлический затвор TaN был нанесен на NEI FeFET с помощью реактивного распыления. После паттерна затвора и травления BF 2 + ионы были имплантированы в области истока / стока с энергией 20 кэВ и дозой 1 × 15 см −2 . Тридцать нанометровый никель (Ni) был нанесен в области истока / стока с использованием процесса отрыва. Наконец, изготовление устройства было завершено с помощью быстрого термического отжига (RTA). Управление полевыми транзисторами металл-оксид-полупроводник (MOSFET) с чисто диэлектрическим Al 2 О 3 Также изготовлен изолирующий слой ворот.
На рисунке 1b показана трехмерная схема изготовленного NEI FeFET, который содержит нанокристаллы FE, внедренные в аморфный изолирующий слой затвора DE. Хотя объем материала FE небольшой, его достаточно для приложений NCFET и NVM. Изолирующий материал DE является ключом к достижению низкой утечки затвора и низкого рабочего напряжения; он должен иметь как большую ширину запрещенной зоны, так и высокую диэлектрическую проницаемость ( κ ). Он также должен обеспечивать высокое коэрцитивное поле ( E c ) внедренных нанокристаллов СЭ.
Изображение поперечного сечения просвечивающего электронного микроскопа (XTEM) на рис. 2a показывает области истока / стока, канала и краев затвора изготовленного FeFET. На рисунках 2б и в показано, что толщины исследованных в данной работе слоев НЭИ составляют 3,6 и 2,1 нм соответственно. Обратите внимание, что межфазный слой GeO x существует между слоем NEI и Ge, хотя его нельзя увидеть.
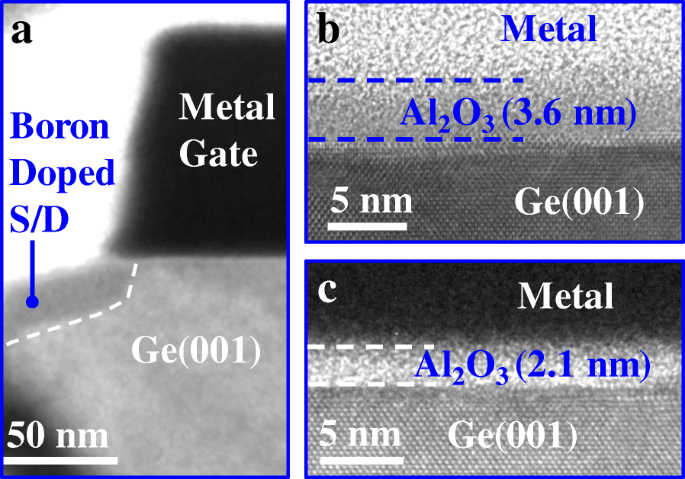
а Изображение XTEM, показывающее области затвора, канала и истока / стока NEI-FeFET. б и c XTEM-изображения стопки затвора из FeFET со слоями NEI толщиной 3,6 и 2,1 нм соответственно
Изображения ПЭМ высокого разрешения (ПЭМВР) на рис. 3 демонстрируют ZrO 2 нанокристаллы, внедренные в аморфный Al 2 О 3 на Ge (001) в образцах НЭИ толщиной 3,6 и 6 нм. В нашей предыдущей работе мы показали, что атомный процент Zr в слое NEI составляет менее 0,5% [12]. На основании дифракционных картин межплоскостное расстояние d в нанокристаллах, по расчетам, составляет 0,173 нм, что соответствует орторомбическому ZrO 2 с ориентацией (111). фаза [13].
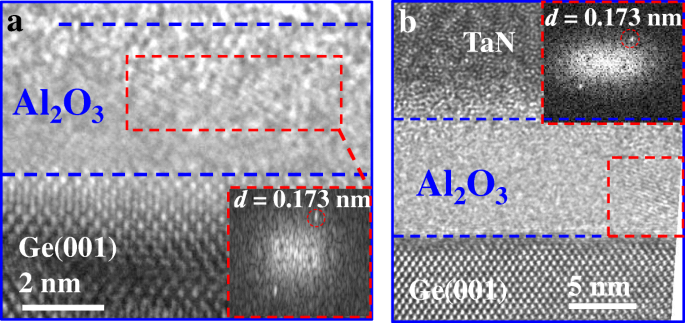
Изображения HRTEM, показывающие нанокристаллы, внедренные в аморфный Al 2 О 3 для образцов толщиной а 3,6 нм и b 6 нм. На вставках показано, что межплоскостное расстояние d в нанокристалле 0,173 нм, что соответствует o-ZrO 2 (111) этап
Поляризация в зависимости от напряжения ( P - V ) и измерения с помощью силовой микроскопии пьезоотклика (PFM) были выполнены на образцах NEI разной толщины. Чтобы охарактеризовать сегнетоэлектричество слоя NEI, P - V кривые TaN / NEI (3,6 нм) / Ge, TaN / NEI (6 нм) / Si 0,7 Ge 0,3 , и конденсаторы TaN / NEI (10 нм) / TaN показаны на рис. 4a, b и c соответственно. Слой NEI показывает более низкое значение P чем заявленные значения HfZrO 2 (HZO) [14], что связано с тем, что объемная доля ZrO 2 нанокристалл в Al 2 О 3 матрица довольно низкая. Видно, что остаточная поляризация P r пленки NEI увеличивается с увеличением толщины пленки. P-V Кривые на рис. 4в показывают, что сегнетоэлектричество слоя NEI вырождается при увеличении температуры отжига от 450 до 550 ° C. Отмечается, что причина незакрытого P-V петли, потому что утечка действительно существует. Сообщалось, что результирующий сдвиг при нулевом электрическом поле уменьшается по мере уменьшения диапазона качания напряжения [3, 15, 16]. Были измерены амплитудное (верхнее) и фазовое (нижнее) изображения NEI 3,6 нм, 6 нм и 10 нм, как показано на рис. 5a, b и c соответственно. Как показано на рис. 6, рисунки, обозначающие противоположную полярность, написанные на поверхности NEI на TaN, демонстрируют более четкий контраст с увеличением толщины пленки.
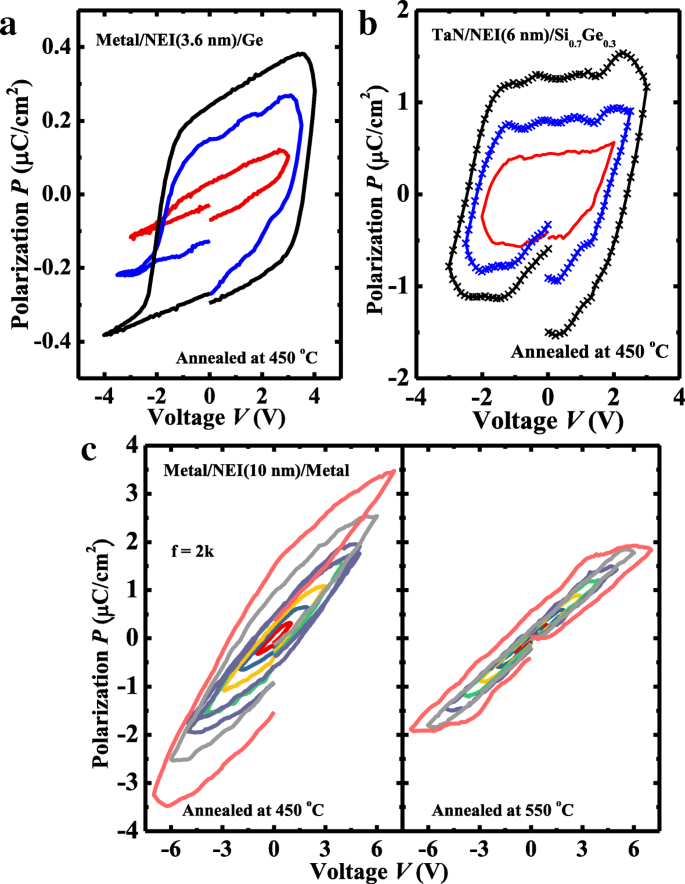
а - c Измерено P - V кривые TaN / NEI (3,6 нм) / Ge, TaN / NEI (6 нм) / Si 0,7 Ge 0,3 , и TaN / NEI (10 нм) / TaN соответственно
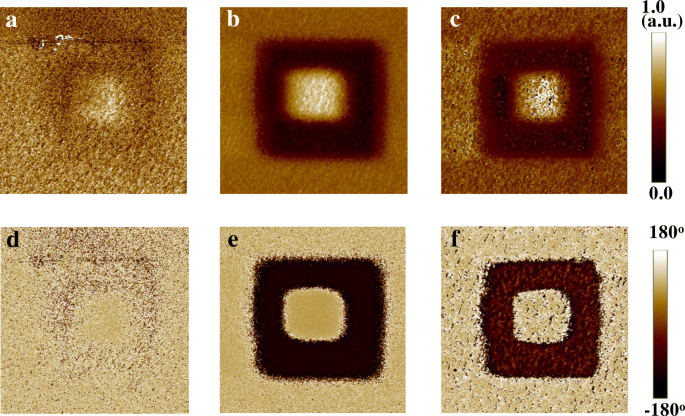
а - c Амплитудное (верхнее) и фазовое (нижнее) изображения измерения PFM для 3,6, 6 и 10 нм NEI на TaN, соответственно
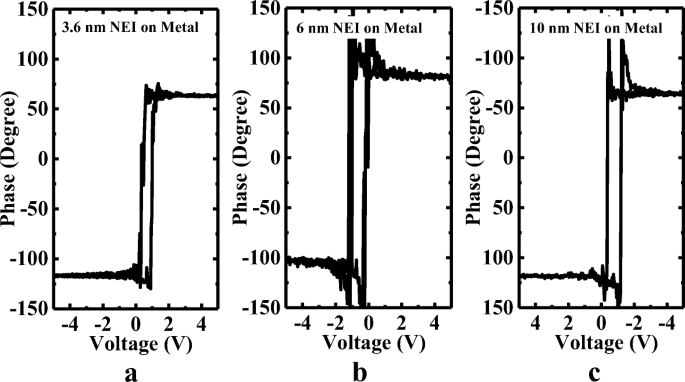
а - c Характеристики фазового перехода 3,6, 6 и 10 нм NEI на TaN соответственно. Замечено, что противоположная полярность может быть записана на поверхности слоя NEI
Результаты и обсуждение
NEI NCFET
На рис. 7а показаны измеренные значения I DS - V GS кривые NEI NCFET с толщиной NEI 3,6 нм, отожженных при 450 ° C и 500 ° C. NCFET демонстрируют небольшой гистерезис, что указывает на хорошее согласование между сегнетоэлектрической емкостью и емкостью MOS в транзисторах. NCFET показывает NC-эффект, индуцированный по часовой стрелке I-V петли, которые отличаются от петель против часовой стрелки захватом / снятием заряда [17]. Затвор утечки I G как функция от V GS той же пары устройств демонстрирует, что образование нанокристаллов в Al 2 О 3 не увеличивает утечку затвора. Рисунок 7b показывает, что NCFET достигают точек крутой SS менее 60 мВ / декаду для прямой и обратной развертки. Флуктуации SS в NEI NCFET, также наблюдаемые в NC FinFET [2, 18], могут быть связаны с переключением поляризации различными сегнетоэлектрическими нанокристаллами или доменами. Измеренный I DS - V DS кривые для той же пары устройств на рис. 7в показывают, что при ∣ V GS - V TH ∣ =∣ V DS ∣ =1,0 В, NCFET с RTA при 500 ° C достигает на 29% больше I DS по сравнению с транзистором, отожженным при 450 ° С. Это связано с тем, что подвижность носителей заряда в канале и характеристики контактного сопротивления могут быть улучшены с увеличением температуры отжига [19]. Типичная характеристика, индуцированная сегнетоэлектрическим слоем, отрицательное дифференциальное сопротивление (NDR), наблюдается в I DS - V DS кривые для NCFET, отожженных при различных температурах.
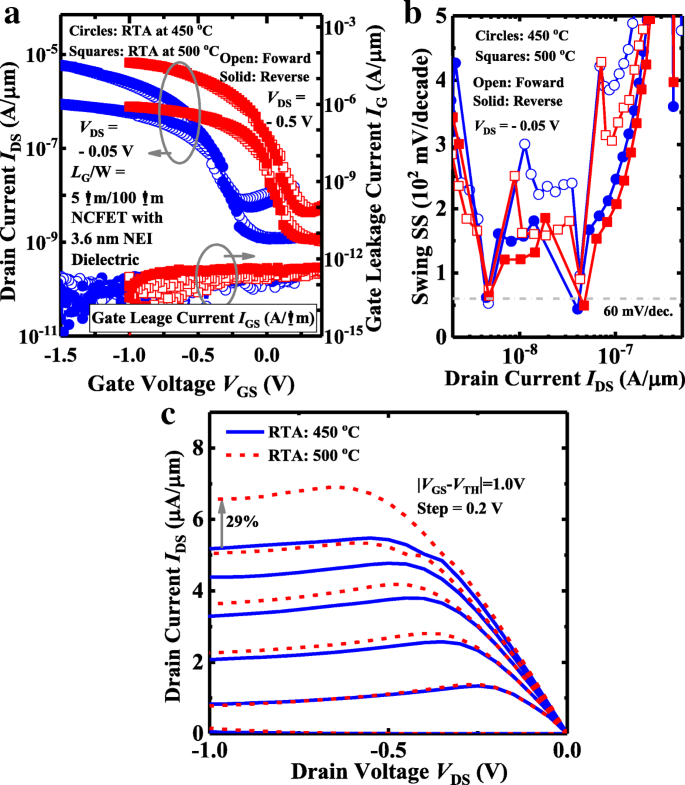
а Измерено I DS - V GS и я G - V GS кривые NCFET с 3,6 нм NEI, отожженных при 450 ° C и 500 ° C. б NEI NCFET имеет точки ниже 60 мВ / декаду для V DS значение - 0,05 В. c Я DS - V DS кривые для NEI NCFET, демонстрирующие очевидные явления NDR. NC-транзистор, отожженный при 500 ° C, дает 29% I DS улучшение по сравнению с устройством с RTA при 450 ° C при напряжении питания 1,0 В
На рис. 8а показаны измеренные значения I DS - V GS кривые NEI NCFET и контрольного MOSFET с одинаковой толщиной изолятора 2.1 нм. У устройств есть L G 6 мкм. NCFET демонстрирует характеристики без гистерезиса. На вставке показана точка SS и I . DS кривые для устройств, демонстрирующие, что в NCFET достигается улучшенная SS по сравнению с устройством управления, вплоть до порогового напряжения. На рисунке 8b показан I DS - V DS кривые NEI NCFET и управляющего MOSFET. NCFET демонстрирует феномен NDR для низкого V GS . Эффект NDR соответствует улучшенным характеристикам снижения барьера, вызванного стоком (DIBL) в NCFET по сравнению с контрольным MOSFET, как показано на рис. 8a. В ∣ V GS - V TH ∣ =∣ V DS ∣ =1,0 В, 16% I DS В NCFET получено улучшение по сравнению с устройством управления. NCFET с NEI 2,1 нм имеет менее значительный NDR по сравнению с транзистором с NEI 3,6 нм, что согласуется с выводом в [20].
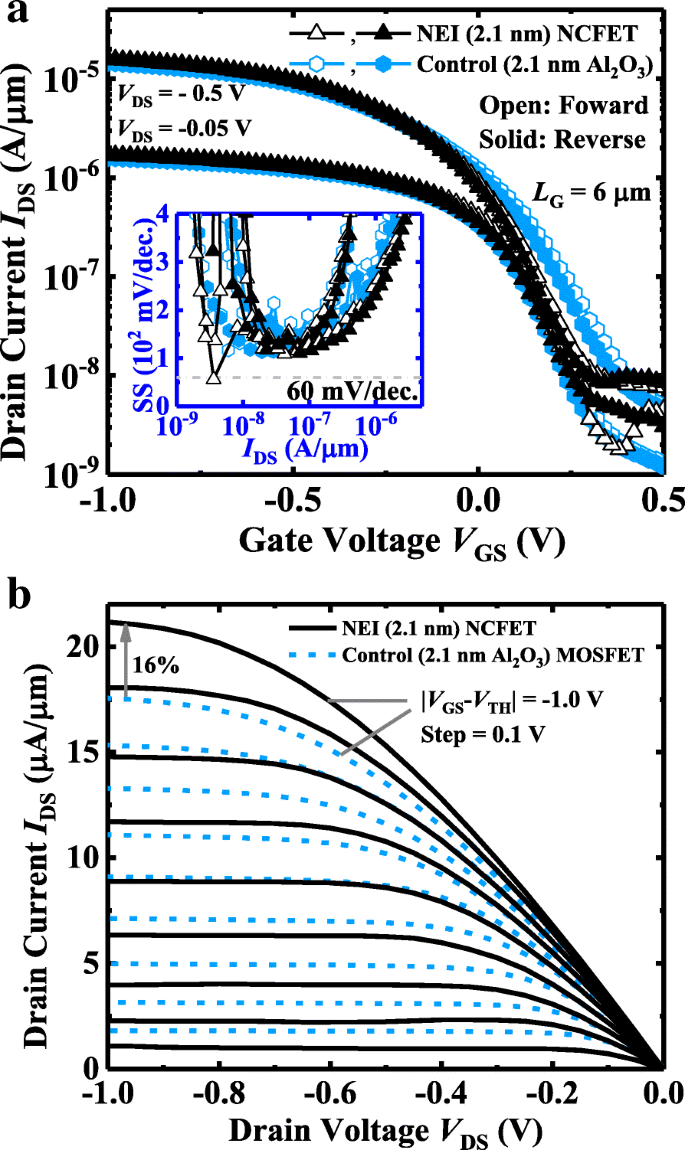
а Я DS - V GS кривые NEI NCFET и управляющего MOSFET с чистым Al 2 О 3 диэлектрик. Оба устройства имеют изолятор затвора с длиной волны 2,1 нм. На вставке показано, что NCFET имеет более крутой SS, чем контрольное устройство, вплоть до порогового напряжения. б Измерено I DS - V DS кривые для NCFET и управляющего MOSFET. NDR наблюдается для NCFET при очень низком V GS . В ∣ V GS - V TH ∣ =∣ V DS ∣ =1,0 В, NCFET достигает 16% I DS улучшение по сравнению с устройством управления
Исследована температурная зависимость NCFET с NEI толщиной 3,6 нм. На рисунке 9a показан I DS - V GS кривые измерены при 10 ° C и 30 ° C. На вставке указано, что характеристики транзистора SS не ухудшаются при повышенных температурах. По мере повышения температуры I - V кривая смещается в сторону более отрицательного V GS из-за преобладающего эффекта сегнетоэлектричества, что противоположно тенденции для обычных полевых МОП-транзисторов. На рисунке 9b показаны изменения напряжения гистерезиса и порогового напряжения прямого переключения в зависимости от температуры. Нападающий V GS смещается к более отрицательным значениям при повышении температуры, что может быть связано с увеличением E c НЭИ.
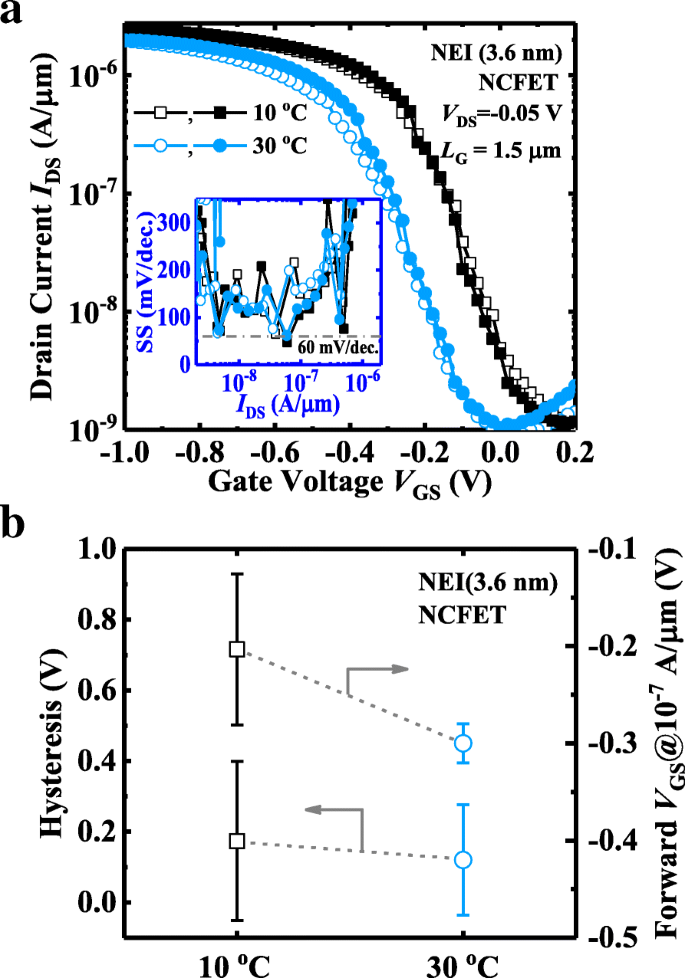
а Я DS - V GS NCFET NEI (3,6 нм), измеренный при 10 ° C и 30 ° C. Кривые показывают сдвиг в сторону более отрицательного напряжения с повышением температуры, как и ожидалось. На вставке - крутая точка SS. б Статистические графики гистерезиса (слева) и вперед V GS @ 10 −7 А / мкм (справа) для NCFET со слоем NEI 3,6 нм. Нападающий V GS смещается в отрицательную сторону при повышении температуры
NEI FeFET для приложения энергонезависимой памяти
Увеличивая диапазон V GS При развертке напряжение гистерезиса NEI FeFET может быть увеличено для достижения большого и стабильного окна памяти (MW) для операций чтения и записи. Как показано на рис. 10, FeFET с 3,6-нм NEI демонстрирует, что MW увеличивается с 0,2 до 1,14 В как V GS Диапазон развертки варьируется от (0,1 В, - 0,1 В) до (1 В, - 2 В). Продолжительность свипирования по постоянному току другого запоминающего устройства на FeFET показана на рис. 11а, а на рис. 11b показаны характеристики гистерезиса как функция количества циклов свипирования по постоянному току. Стабильный I-V видно окно гистерезиса ~ 0,65 В.
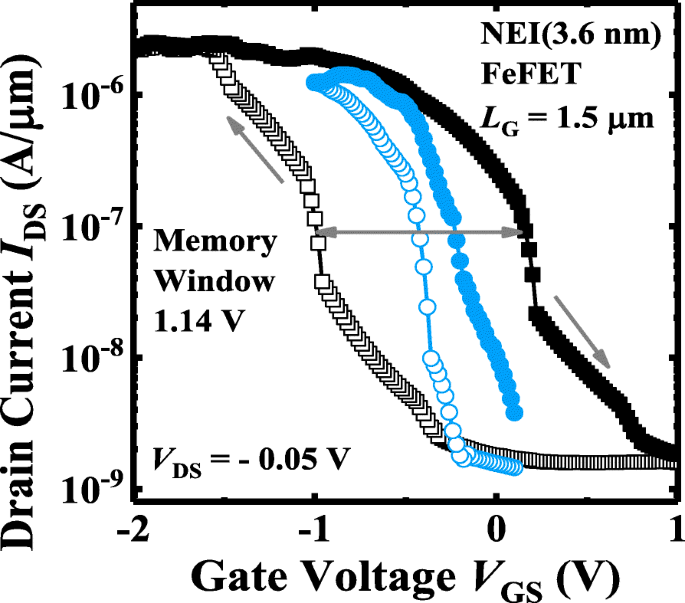
Для большого V GS Диапазон качания по постоянному току, для FeFET NEI (3,6 нм) наблюдается МВ 1,14 В
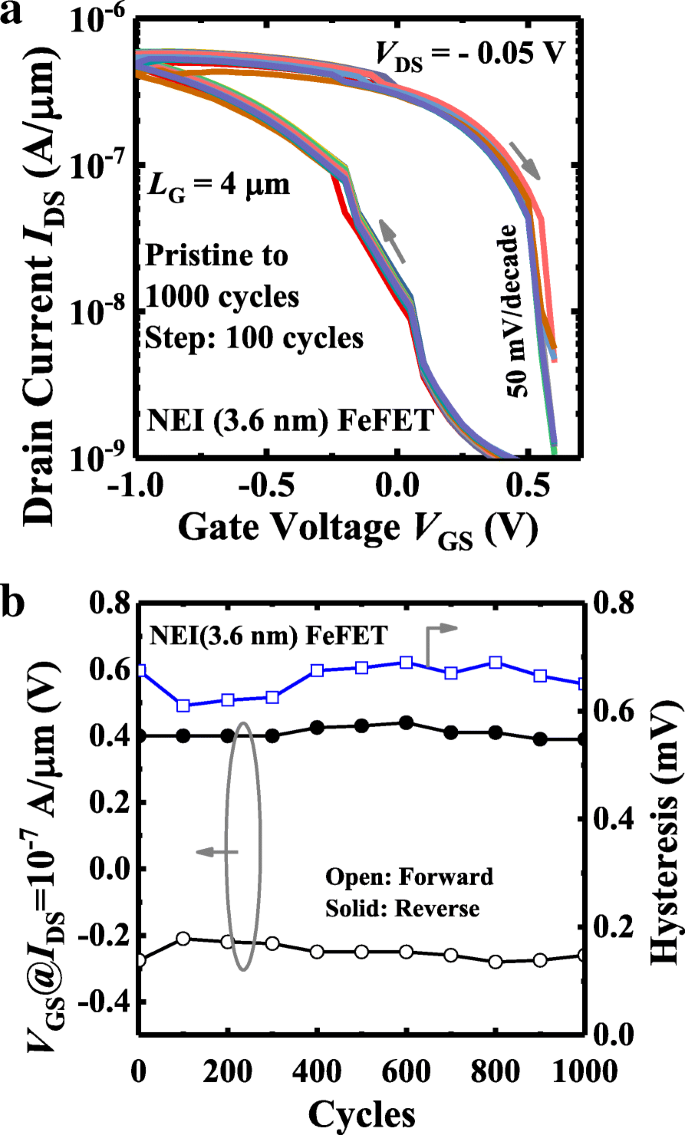
а Измерено I DS - V GS кривые для NEI (3,6 нм) FeFET через 1000 циклов свипирования по постоянному току. б Измерения долговечности при качании постоянного тока показывают, что NEI FeFET имеет стабильную молекулярную массу в течение 1000 циклов
Рисунок 12 сравнивает устройство памяти NEI FeFET с известными FeFET в отношении толщины слоя MW и FE [8, 21–24]. Следует отметить, что устройство NEI FeFET в этой работе обеспечивает значительную (> 1 В) МВт при наименьшей заявленной толщине FE 3,6 нм. Мы предполагаем, что в NEI с меньшей толщиной легче достичь стабильной СЭ-фазы по сравнению с легированным HfO 2 [28,29,30].
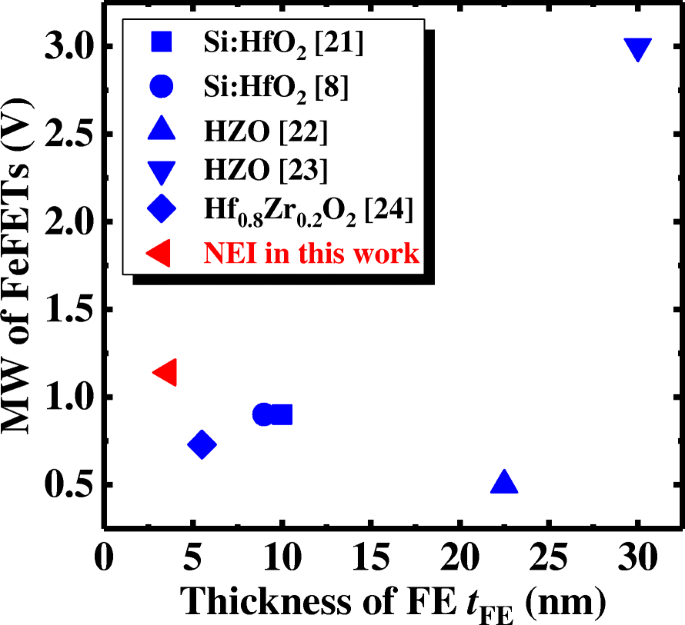
Сравнительный анализ запоминающего устройства NEI FeFET с заявленными FeFET в отношении MW и t FE . Самая тонкая КЭ достигается за счет устройства памяти NEI FeFET
Наконец, преимущества NEI FeFET, предоставляемые ZrO 2 обсуждаются нанокристаллы, внедренные в аморфный изолятор затвора. Рисунок 13 сравнивает слой NEI с зарегистрированным допированным HfO 2 . фильмы [2, 3, 21, 25–27], с учетом E c и P r . NEI может достичь гораздо более низкого P r по сравнению с допированным HfO 2 для аналогичного E c . Наши эксперименты показали, что P r ниже 1 мкКл / см 2 может обеспечить требуемую МВт в FeFET. Чрезмерная поляризация может привести к большей деполяризации, что приведет к ухудшению удерживающих характеристик, о чем сообщалось в [25]. Кроме того, свойства FE и DE слоя NEI можно настраивать отдельно: P r увеличивается / уменьшается за счет увеличения / уменьшения объема нанокристаллов FE, а κ увеличивается за счет включения других элементов в аморфную матрицу (например, . , LaAlO 3 ), чтобы оптимизировать производительность FeFET.

Сравнение слоев NEI с зарегистрированным допированным HfO 2 фильмы, в отношении E c и P r . NEI достигает гораздо более низкого P r по сравнению с допированным HfO 2 при сохранении аналогичного E c. [2, 3, 21, 25,26,27]
Выводы
Новые FeFET с ZrO 2 нанокристаллы, внедренные в аморфный Al 2 О 3 сообщается о слое изоляционного затвора. Физический анализ показывает, что менее 0,5% Zr в Al 2 О 3 производит достаточное количество сегнетоэлектричества для приложений NCFET и NVM. Стабильный эффект НК наблюдается при различных температурах измерения. Продемонстрирована стабильная работа памяти FeFET с рекордно тонким (общая толщина 3,6 нм) изолятором затвора. Стабильная молекулярная масса достигается в течение 1000 рабочих циклов постоянного тока. Предлагаемая конструкция NEI FeFET обеспечивает возможность уменьшения толщины слоя изолятора затвора FE / DE для обеспечения совместимости с FinFET-транзисторами с очень малым шагом ребер.
Сокращения
- Al 2 О 3 :
-
Оксид алюминия
- ALD:
-
Осаждение атомного слоя
- BF 2 + :
-
Ион фторида бора
- DC:
-
Постоянный ток
- Ec:
-
Принудительное поле
- FeFET:
-
Сегнетоэлектрический полевой транзистор
- Ge:
-
Германий
- GeO x :
-
Оксид германия
- HF:
-
Плавиковая кислота
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- I DS :
-
Слить ток
- МОП-транзисторы:
-
Полевые транзисторы металл-оксид-полупроводник
- MW:
-
Окно памяти
- NC:
-
Отрицательная емкость
- отчет о недоставке:
-
Отрицательное дифференциальное сопротивление
- NEI:
-
Нанокристаллический изолятор
- Ни:
-
Никель
- Pr:
-
Остаточная поляризация
- RTA:
-
Быстрый термический отжиг
- SS:
-
Подпороговое колебание
- TaN:
-
Нитрид тантала
- V GS :
-
Напряжение затвора
- V TH :
-
Пороговое напряжение
- ZrO 2 :
-
Диоксид циркония
Наноматериалы
- Датчики и процессоры объединяются для промышленного применения
- Многофункциональные наночастицы золота для улучшенных диагностических и терапевтических применений:обзор
- Достижения и проблемы флуоресцентных наноматериалов для синтеза и биомедицинских приложений
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Графен и полимерные композиты для суперконденсаторов:обзор
- Оценка структур графен / WO3 и графен / CeO x как электродов для применения в суперконденсаторах
- Двойные функции устройства V / SiOx / AlOy / p ++ Si в качестве селектора и памяти
- Приводы для промышленного охлаждения и промышленного охлаждения
- Токарно-карусельные станки для расточной и токарной обработки
- Специальные металлы для медицинских устройств



