Экспериментальные и теоретические исследования контакта Mo / Au Шоттки на механически отслоившейся тонкой пленке β-Ga2O3
Аннотация
Мы изучили механизм обратного тока эмиссии Mo / β-Ga 2 О 3 Диод с барьером Шоттки через температурно-зависимые вольт-амперные (ВА) характеристики от 298 до 423 К. Изменение обратного тока в зависимости от электрического поля указывает на то, что эмиссия Шоттки является доминирующим механизмом переноса носителей при обратном смещении, а не методом Френкеля – Пула. модель выбросов с ловушкой. Кроме того, напряжение пробоя 300 В было получено в среде Fluorinert со средним электрическим полем 3 МВ / см в Mo / β-Ga 2 О 3 Диод с барьером Шоттки. Влияние поверхностных состояний на распределение электрического поля также было проанализировано с помощью моделирования TCAD. С увеличением плотности отрицательного поверхностного заряда максимальное электрическое поле монотонно уменьшается. Кроме того, обсуждалась неоднородность высоты барьера Шоттки при прямом смещении.
Фон
В последнее время полупроводник со сверхширокой запрещенной зоной β-Ga 2 О 3 привлек большое внимание благодаря своим превосходным характеристикам, таким как высокая химическая стабильность, большая прямая широкая запрещенная зона 4,8–4,9 эВ, высокое теоретическое электрическое поле пробоя ( E BR ) 8 МВ / см и высокая добротность Балиги, равная 3400, что примерно в десять раз больше, чем у SiC, и в четыре раза больше, чем у GaN [1,2,3]. Сочетание всех этих свойств с высоким качеством, большой площадью и экономичным β-Ga 2 О 3 субстрат, выращенный методами выращивания из расплава, делает β-Ga 2 О 3 предпочтительный материал для высоковольтных и мощных электронных устройств [4,5,6,7,8,9]. В качестве перспективного электронного устройства β-Ga 2 О 3 Диоды с барьером Шоттки (SBD) изготавливались из различных металлов анодных электродов, включая Cu [8], Pd [10], Pt [5, 6, 11,12,13], Au [10, 14], Ni [13, 15]. , 16,17,18] и TiN [12], а также его прямые и обратные электрические характеристики, такие как удельное сопротивление в открытом состоянии, I на / Я выкл соотношение, высота барьера, обратный ток утечки и напряжение пробоя были всесторонне исследованы. Неоднородная высота барьера Шоттки и ненасыщающий ток обратного смещения были зарегистрированы в β-Ga 2 О 3 SBD [6, 8, 11, 18, 19], в то время как гораздо меньше информации было известно о механизме переноса носителей при обратном смещении, что важно для повышения напряжения пробоя.
Кроме того, не было проведено никаких исследований для анализа механизмов эмиссии Mo / β-Ga 2 О 3 контакт. Если в β-Ga 2 есть ловушки или дефекты О 3 На подложке будет обнаружено, что ток утечки соответствует модели эмиссии Френкеля – Пула, а обратный ток представляет собой эмиссию электронов из захваченного состояния вблизи границы раздела металл-полупроводник. В противном случае в основном процессе обратного тока будет преобладать эмиссия Шоттки, так как электроны через барьер Шоттки вызывают обратный ток. β-Ga 2 О 3 Кристалл также обладает одним уникальным свойством, большой постоянной решетки 12,23 Å вдоль направления [100], что позволяет легко расщепляться на тонкие ленты или наномембраны [9, 20]. Итак, в этой работе мы механически расслоили крупномасштабный β-Ga 2 О 3 из объемной подложки с низкой плотностью дислокаций, и впервые в качестве металла анодного электрода для изготовления β-Ga 2 был выбран термостойкий молибден (Mo). О 3 диоды с вертикальным барьером Шоттки. Механизм электропроводности при обратном смещении обсуждался в диапазоне температур от 298 до 423 К. Эта работа дает представление о механизмах переноса носителей, которые могут помочь улучшить функциональные возможности β-Ga 2 О 3 на базе устройств.
Методы / экспериментальные
Как показано на рис. 1а, б, диод с барьером Шоттки был изготовлен на β-Ga 2 О 3 (100) пленка, механически отслаивающаяся от легированного оловом β-Ga 2 О 3 подложка толщиной 15 мкм и концентрацией электронов 2 × 10 17 см - 3 . Как показано на рис. 1d, e, полная ширина на полувысоте (FWHM) и среднеквадратичное значение (RMS) были оценены в 51,9 угловых секунд и 0,19 нм, соответственно, с помощью дифракции рентгеновских лучей высокого разрешения (HRXRD) и атомных рентгеновских лучей. силовой микроскоп (АСМ) измерения. Измерения подтвердили превосходное качество кристаллов и гладкую поверхность. После влажной химической очистки металлический пакет Ti / Au (20 нм / 100 нм) был осажден с использованием электронно-лучевого испарения на обратной стороне с последующим быстрым термическим отжигом (RTA) при 600 ° C в течение 60 с в атмосфере азота для образуют омический контакт. Круглые анодные электроды Шоттки диаметром 100 мкм были сформированы на лицевой стороне путем испарения металлов Mo / Au (40 нм / 100 нм) и процесса отрыва. На рисунке 1c показана структура схематического поперечного сечения β-Ga 2 О 3 SBD в этой работе.
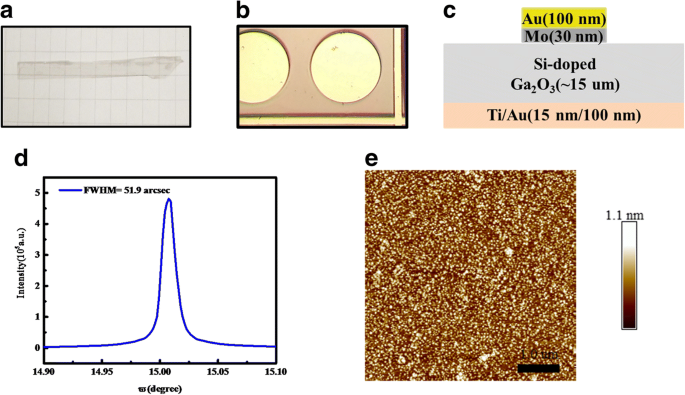
а Легированный оловом β-Ga 2 О 3 подложка толщиной 300 мкм. б На лицевой стороне сформированы анодные электроды Шоттки диаметром 100 мкм. c Структура схемы поперечного сечения β-Ga 2 О 3 SBD. г Кривая качания XRD и e АСМ изображение β-Ga 2 О 3 дрейфовый слой, механически отслоившийся от (100) β-Ga 2 О 3 субстрат
Результаты и обсуждение
Вольт-амперные характеристики Au / Mo / β-Ga 2 О 3 Диоды с барьером Шоттки были исследованы с использованием системы определения характеристик полупроводников Keithley 4200 между 298 и 423 К. Как показано на рис. 2a, I на / Я выкл соотношение близко к 10 10 при 298 K, что указывает на хорошие характеристики выпрямления. Для прямого смещения от 0,1 до 0,7 В полулогарифмические ВАХ имеют почти линейный вид и сильно зависят от температуры. При дальнейшем увеличении прямого смещения отклонение от линейности ВАХ приписывается последовательному сопротивлению диода с барьером Шоттки, а соотношение между приложенным напряжением и током может быть выражено как \ (I ={I} _s \ left \ {\ exp \ left [\ frac {q \ left (V- {IR} _s \ right)} {nkT} \ right] -1 \ right \} \) [21,22,23], где V приложенное напряжение, R s последовательное сопротивление, T абсолютная температура, k постоянная Больцмана, n фактор идеальности, и I s - обратный ток насыщения. n и я s можно определить по наклону и пересечению ln I-V участки соответственно. Для идеального диода с барьером Шоттки коэффициент идеальности n должен быть равен единице. Чем выше n , тем больше отклонение от модели термоэмиссии (ТЕ). Кроме того, согласно уравнению \ ({\ phi} _b =\ frac {kT} {q} \ ln \ left [\ frac {AA ^ {\ ast} {T} ^ 2} {I_s} \ right] \ ) [21,22,23], значения ϕ б при различных температурах также были определены, как показано на рис. 2b, где ϕ б высота барьера, A - площадь диода и A * - эффективная постоянная Ричарда 40,8 А · см −2 K - 2 с β-Ga 2 О 3 эффективная масса м * = 0,34 м 0 [5, 24]. При повышении температуры от 298 до 423 К значение ϕ б увеличивается, пока n уменьшается, что указывает на другой механизм переноса, также вносящий вклад в перенос тока и приводящий к отклонению ВАХ от чистой модели TE, о чем ранее сообщалось в β-Ga 2 О 3 Диоды с барьером Шоттки [25] и другие устройства с широкой запрещенной зоной [26,27,28,29,30]. Анализ неоднородности высоты барьера может быть описан распределением Гаусса по высоте барьера,
$$ {\ phi} _b =\ overline {\ phi_ {b0}} \ left (T =0 \ right) - \ frac {q {\ sigma} _s ^ 2} {2 kT} $$ (1) <изображение>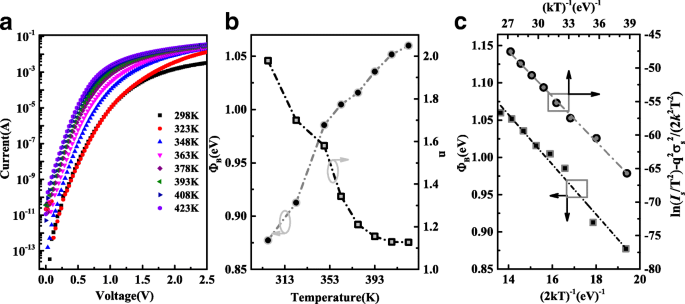
а Прямые ВАХ Mo / β-Ga 2 О 3 Диоды с барьером Шоттки при разных температурах. б Температурная зависимость фактора идеальности и высоты барьера Шоттки β-Ga 2 О 3 Диод с барьером Шоттки. c Графики ϕ ap против q / 2 k T и модифицированный график Ричардсона в зависимости от 1 / k T для β-Ga 2 О 3 Диоды с барьером Шоттки
Значения средней высоты барьера \ (\ overline {\ phi_ {b0}} \) и стандартного отклонения σ s извлечены как 1,55 эВ и 0,186 эВ, соответственно, из рис. 2c. Кроме того, с учетом неоднородностей высоты барьера, обычный график Ричардсона видоизменяется следующим образом:
$$ \ ln \ left (\ frac {I _ {\ mathrm {s}}} {T ^ 2} \ right) - \ left (\ frac {q ^ 2 {\ sigma} _ {\ mathrm {s}} ^ 2} {2 {k} ^ 2 {T} ^ 2} \ right) =\ ln \ left ({AA} ^ {\ ast} \ right) - \ frac {q \ overline {\ phi_ {b0}}} {kT} $$ (2)Как показано на рис. 2c, измененный \ (\ ln \ left ({I} _ {\ mathrm {s}} / {T} ^ 2 \ right) - \ left ({q} ^ 2 {\ sigma} _ {\ mathrm {s}} ^ 2/2 {k} ^ 2 {T} ^ 2 \ right) \) по сравнению с 1 / kT прямая линия. Пересечение кривой используется для получения A * 44,7 А см −2 К −2 , что очень близко к теоретическому значению β-Ga 2 О 3 40,8 А см −2 к −2 . Следовательно, неоднородности барьера на границе раздела металл / полупроводник для β-Ga 2 О 3 SBD можно объяснить TE с гауссовым распределением барьера по SBH.
Измерение обратного пробоя при комнатной температуре также проводилось с использованием системы высоковольтного полупроводникового анализатора Agilent B1505A, как показано на рис. 3. Напряжение пробоя составляло 260 В, тогда как оно составляло 300 В с образцом, погруженным в Fluorinert ™ производства компании 3M. что может предотвратить пробой воздуха при высоком обратном смещении. Чтобы понять распределение электрического поля, было проведено численное моделирование с помощью программного обеспечения ATLAS, как показано на рис. 4a, b. С увеличением расстояния от границы между полупроводником и анодом примерно до 1 мкм электрическое поле постепенно уменьшается. На позиции x =4 мкм, среднее электрическое поле составляет 3 МВ / см, рассчитанное по рис. 4в. Также показано на рис. 4d в позиции y =1 нм максимальное электрическое поле при напряжении пробоя составляло около 8 МВ / см на краю контакта Шоттки, что примерно в 2,7 раза больше среднего электрического поля. Как сообщают AJ Green et al [31] и K. Zeng et al [32], максимальное электрическое поле и среднее электрическое поле края электрода составляли 5,3, 3,8 МВ / см и 6,1, 4,4 МВ / см, соответственно, и пиковое электрическое поле Mo / Ga 2 О 3 Диод Шоттки относительно высокий. Предполагается, что β-Ga 2 О 3 наномембрана, полученная путем механического расслоения, имеет большое количество оборванных связей и поверхностных состояний, которые будут захватывать электроны для истощения носителей от анода к катоду при обратном смещении [33]. С учетом отрицательного поверхностного заряда результат моделирования показал, что электрическое поле на краю контакта Шоттки уменьшается с увеличением отрицательной поверхностной плотности заряда с 0,5 × 10 13 см −2 до 3 × 10 13 см −2 , соответственно. Особенно с отрицательной поверхностной плотностью заряда 3 × 10 13 см −2 пиковое электрическое поле на краю контакта Шоттки составляет около 5,2 МВ / см. Следовательно, обратное напряжение пробоя 300 В может быть достигнуто на β-Ga 2 О 3 наномембрана с N D =3 × 10 17 см −2 без каких-либо оконечных конструкций. Как показано на рис. 4d, из-за наличия состояния интерфейса в X -положении ниже 2 мкм электроны могут быть захвачены, и может образоваться обедненная область, в результате чего электрическое поле будет в Y направление. По мере увеличения концентрации состояний интерфейса электрическое поле в Y направление увеличивается, хотя электрическое поле в X направление приближается к нулю. Таким образом, электрическое поле увеличивается на X -положение менее 2 мкм.
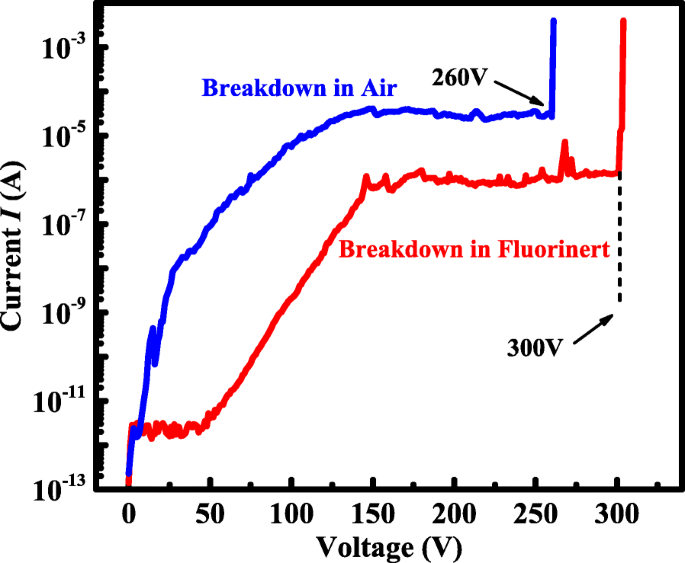
Обратные ВАХ β-Ga 2 О 3 образцы при комнатной температуре соответственно во флюоринерте и на воздухе

а Моделирование электрического поля диодов с барьером Шоттки с помощью TCAD в закрытом состоянии при напряжении смещения - 300 В. б Моделирование электрического поля выбранных областей в зеленой пунктирной рамке. Потенциал вдоль y ось в точке x =4 мкм присутствует в ( c ), а электрическое поле на краю контакта Шоттки, уменьшенное с помощью различных эффективных отрицательных плотностей поверхностного заряда, представлено в ( d )
С другой стороны, при обратном смещении V re увеличиваясь, ток утечки I re увеличивается, а не насыщается для | V |> 3 тыс. B Т / кв , как показано на рис. 5a, что не согласуется с теорией TE. Таким образом, термоэлектронная эмиссия, усиленная электрическим полем, была рассмотрена для обсуждения зависимости I re на V re , включая эмиссию Пула – Френкеля и эмиссию Шоттки [34, 35]. В эмиссии Пула – Френкеля электроны переносятся из металла в полупроводник через захваченное состояние, а I re дается
$$ {I} _ {re} \ propto E \ exp \ left (\ frac {q} {kT} \ sqrt {\ frac {qE} {{\ pi \ varepsilon} _S}} \ right) $$ (3 )в то время как при эмиссии Шоттки электроны получат достаточно энергии, чтобы преодолеть барьер в металле / полупроводнике, чтобы сформировать ток и I re может быть выражено
$$ {I} _ {re} \ propto {T} ^ 2 \ exp \ left (\ frac {q} {2 kT} \ sqrt {\ frac {qE} {{\ pi \ varepsilon} _S}} \ right ) $$ (4)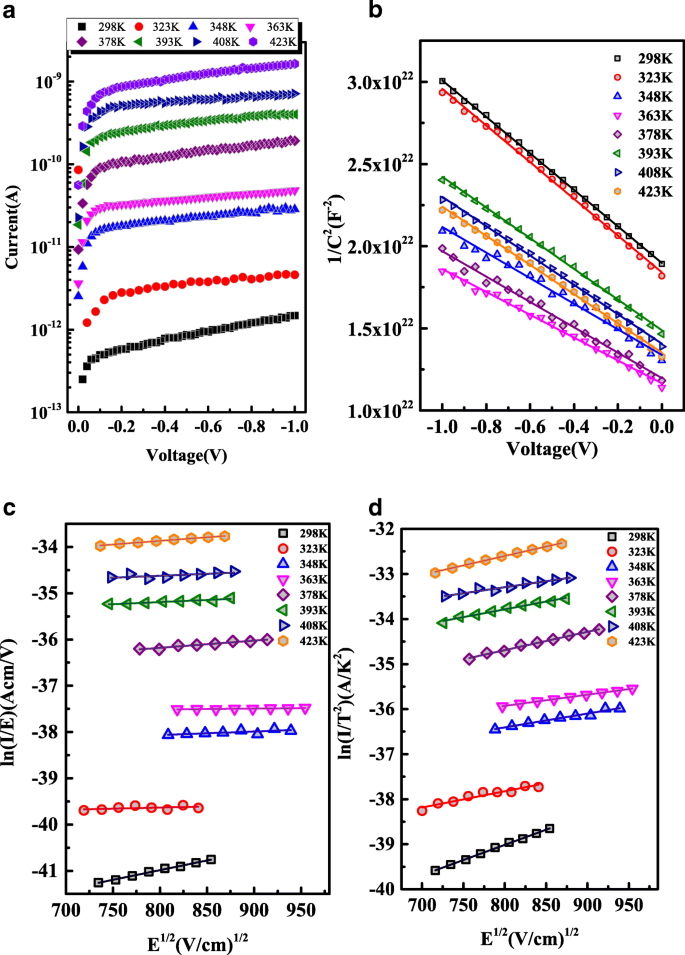
а Обратные ВАХ Mo / β-Ga 2 О 3 Диоды с барьером Шоттки при разной температуре. б Температурная зависимость 1 / C 2 характеристики Mo / β-Ga 2 О 3 Диоды с барьером Шоттки. Анализ зависимости Mo / β-Ga 2 от электрического поля О 3 Шоттки контактируют с другим механизмом. c Механизм Пула – Френкеля ( I / E ) по сравнению с E 1/2 и d Механизм Шоттки ln ( Я / Т 2 ) по сравнению с E 1/2
где ε s - диэлектрическая проницаемость β-Ga 2 О 3 (~ 10 ε 0 ) и E - приложенное электрическое поле, рассчитанное по формуле \ (E \ kern0.5em =\ kern0.5em \ sqrt {\ frac {2 {qN} _D} {\ varepsilon_S} \ left (V + {V} _ {bi} - \ frac {k_BT} {q} \ right)} \), N Д донорная плотность β-Ga 2 О 3 , и V би это встроенный потенциал. Как показано на рис. 5b, N Д и V би можно извлечь из наклона и точки пересечения обратной квадратичной емкости (1 / C 2 ) по сравнению с V re графики с использованием следующего выражения
$$ \ frac {1} {C ^ 2} =\ frac {2 \ left ({V} _ {\ mathrm {bi}} - kT / qV \ right)} {q {\ varepsilon} _s {A} ^ 2 {N} _D} $$ (5)Если кривая ln ( И / Т 2 ) по сравнению с E 1/2 линейна, доминирует эмиссионный механизм Шоттки. И если сюжет ln ( Я / E ) по сравнению с E 1/2 является лайнером, эмиссия Пула – Френкеля доминирует над переносом обратного тока. На рис. 5c, d изображены графики ln ( Я / E ) и ln ( Я / Т 2 ) по сравнению с E 1/2 , соответственно. Оба набора кривых являются линейными, что указывает на присутствие не только излучения Пула – Френкеля, но и излучения Шоттки. Чтобы прояснить доминирующий механизм переноса носителей, наклон кривых или коэффициент эмиссии можно выразить как [34,35,36].
$$ S =\ frac {q} {nkT} \ sqrt {\ frac {q} {\ pi \ varepsilon}} $$ (6)где n =1 для излучения Пула – Френкеля ( S ПФ ) и n =2 для излучения Шоттки ( S S ). Экспериментальные значения S обозначаются как S м-ПФ и S м-с для эмиссии Пула – Френкеля и Шоттки, определяемой наклоном кривых на рис. 5в, г соответственно. Отношение экспериментального значения к теоретическому значению, N ПФ (= S м-ПФ / S ПФ ) и N S (= S м-с / S S ), показаны на рис. 6. Поскольку значения N S ближе к единице, чем у N ПФ , в обратном токе преобладает эмиссия Шоттки.

Графики относительных коэффициентов выбросов Пула – Френкеля N ПФ (= S м-ПФ / S ПФ ) и излучения Шоттки N S (= S м-с / S S ) от температуры
Выводы
Мы исследовали электрические характеристики диодов с барьером Шоттки Mo / Au, изготовленных на (100) β-Ga 2 О 3 пленка, механически отслаивающаяся от легированного оловом β-Ga 2 О 3 субстрат. На основе модели TE извлеченные ϕ б и н увеличивается и уменьшается с повышением температуры соответственно. Предполагая гауссово распределение неоднородной высоты барьера, были получены средняя высота барьера 1,55 эВ и стандартное отклонение 0,186 эВ . Наконец, согласно ln ( Я / Т 2 ) и ln ( Я / E ) по сравнению с E 1/2 графиков, параметр N S излучения Шоттки близко к единице, что свидетельствует о том, что излучение Шоттки является доминирующим механизмом переноса обратного тока. Напряжение пробоя 300 В с образцами из Fluorinert получается в диодах с барьером Шоттки из Mo / Au со средним электрическим полем 3 МВ / см, что указывает на большой потенциал β-Ga 2 О 3 для силовой электроники.
Сокращения
- I-V:
-
Ток-напряжение
- Мо:
-
Молибден
- RTA:
-
Быстрый термический отжиг
- SBD:
-
Диод с барьером Шоттки
- TE:
-
Термоэмиссия
Наноматериалы
- Экспериментальные исследования стабильности и естественной конвекции наножидкости TiO2-вода в корпусах с раз…
- Влияние контактной неравновесной плазмы на структурные и магнитные свойства шпинелей Mn Х Fe3 - X О4
- Экспериментальное исследование характеристик потока и теплопередачи наножидкостей TiO2-вода в трубке со спир…
- Изготовление тонких пленок SrGe2 на подложках Ge (100), (110) и (111)
- Наносборки 5-аминолевулиновой кислоты и сквалена для фотодетекции и терапии опухолей:исследования in vitro
- Изучение силы адгезии и стеклования тонких пленок полистирола с помощью атомно-силовой микроскопии
- Получение и термоэлектрические характеристики ITO / PtRh:PtRh тонкопленочной термопары
- Исследования TEM и STEM морфологии поперечного сечения двух- / трехслойных широкополосных антиотражающих пленок…
- Теоретические исследования InGaAs / InAlAs SAGCM лавинные фотодиоды
- Теоретическое моделирование радиационного отклика сверхрешетки Si, Ge и Si / Ge на низкоэнергетическое облучение…



