Атомное осаждение нанопленок оксида индия для тонкопленочных транзисторов
Аннотация
Атомно-слоистое осаждение (ALD) In 2 О 3 нанопленки были исследованы с использованием циклопентадиенилиндия (InCp) и перекиси водорода (H 2 О 2 ) в качестве предшественников. В 2 О 3 Пленки можно осаждать предпочтительно при относительно низких температурах 160–200 ° C, демонстрируя стабильную скорость роста 1,4–1,5 Å / цикл. Шероховатость поверхности осажденной пленки постепенно увеличивается с ростом температуры осаждения, что объясняется усилением кристаллизации пленки при более высокой температуре осаждения. При повышении температуры осаждения от 150 до 200 ° C оптическая запрещенная зона (E g ) осажденной пленки возрастает с 3,42 до 3,75 эВ. Кроме того, с повышением температуры осаждения атомное отношение In к O в осажденной пленке постепенно смещается в сторону стехиометрического In 2 . О 3 , и содержание углерода также постепенно снижается. При температуре осаждения 200 ° C осажденная пленка имеет соотношение In:O 1:1,36 и отсутствие включения углерода. Кроме того, высокопроизводительный In 2 О 3 тонкопленочные транзисторы с Al 2 О 3 Диэлектрик затвора был получен путем пост-отжига на воздухе при 300 ° C в течение соответствующего времени, демонстрируя полевую подвижность 7,8 см 2 / V⋅s, подпороговое колебание 0,32 В / дек и коэффициент включения / выключения 10 7 . Это было связано с пассивацией кислородных вакансий в канале устройства.
Фон
Оксид индия (In 2 О 3 ) представляет собой прозрачный металлооксидный полупроводник, который демонстрирует широкую запрещенную зону ~ 3,7 эВ при комнатной температуре, высокую прозрачность для видимого света и превосходную химическую стабильность [1, 2]. Следовательно, В 2 О 3 был исследован для различных приложений, таких как фотоэлектрические устройства, электрохимические датчики и плоские дисплеи [3,4,5]. К настоящему времени было разработано несколько методов осаждения для подготовки In 2 О 3 тонких пленок, включая напыление [6, 7], золь-гель [8, 9] и химическое осаждение из газовой фазы (CVD) [10, 11]. Однако методы распыления и золь-гель обычно страдают плохой однородностью по большой площади, а также неточным элементным составом; технология CVD обычно требует относительно высоких температур осаждения> 300 ° C. Эти недостатки затрудняют достижение единообразия в 2 О 3 пленка с точным контролем толщины и состава при низкой температуре осаждения.
В последние годы осаждение атомных слоев (ALD) стало многообещающим подходом, который может обеспечить превосходное покрытие ступеней, управляемость толщины в атомном масштабе, хорошую однородность и относительно низкую температуру осаждения. Соответственно рост In 2 О 3 тонкие пленки были исследованы с помощью ALD с различными прекурсорами, включая InCl 3 -H 2 O [12], InCl 3 -H 2 О 2 [13], InCp-O 3 [14], InCp-O 2 -H 2 O [15] и In (CH 3 ) 3 -H 2 O [16]. Что касается предшественников InCl 3 -H 2 O и InCl 3 -H 2 О 2 , температуры осаждения In 2 О 3 пленки необходимо нагреть до ~ 300–500 ° C [13]; между тем, InCl 3 емкость следует нагреть до 285 ° C, чтобы получить достаточное количество InCl 3 пар [15]. Кроме того, побочный продукт коррозии HCl может повредить оборудование ALD и травить осажденный In 2 О 3 фильм [17], и скорость роста In 2 О 3 составляет всего 0,25–0,40 Å / цикл. Хотя другие предшественники, такие как TMIn-H 2 O и TMIn-H 2 О 2 были приняты для ALD в 2 О 3 пленки, температуры осаждения все еще высоки (т.е. 200–450 ° C), несмотря на относительно большие скорости роста (1,3–2 Å / цикл) [18].
В этой работе InCp и H 2 О 2 были предложены в качестве предшественников ALD In 2 О 3 тонкие пленки, таким образом, In 2 О 3 тонкие пленки успешно осаждались при более низких температурах, демонстрируя удовлетворительную скорость роста. Дополнительно были охарактеризованы физико-химические свойства нанесенных пленок. Кроме того, In 2 О 3 тонкопленочные транзисторы (TFT) с ALD Al 2 О 3 изготовлены затворные диэлектрики, демонстрирующие хорошие электрические характеристики, такие как подвижность полевого эффекта 7,8 см 2 V -1 s −1 и коэффициент текущей ликвидности 10 7 и т. д.
Экспериментальный
Пластины Si (100) очищали с использованием стандартного процесса Radio Corporation of America, который служил исходными подложками. В 2 О 3 тонкие пленки наносились на предварительно очищенные подложки Si (100) с использованием оборудования ALD (Wuxi MNT Micro Nanotech Co., LTD, Китай) при относительно низких температурах 150–210 ° C, где температуры InCp (Fornano Electronic Technology Co., LTD, Китай, примеси:99,999%) и H 2 О 2 (30% водный раствор) предшественники поддерживали при 130 и 50 ° C соответственно. В качестве продувочного газа использовался газообразный азот. Чтобы продемонстрировать функцию ALD In 2 О 3 тонкопленочный, In 2 О 3 Тонкопленочные транзисторы на основе канала были изготовлены следующим образом. Во-первых, 38-нм Al 2 О 3 Диэлектрическая пленка затвора была выращена на предварительно очищенной подложке Si (100) p-типа (<0,0015 Ом · см) при 200 ° C методом ALD с использованием триметилалюминия и H 2 O, и такая кремниевая подложка с низким сопротивлением служила задним затвором. Затем 20-нм In 2 О 3 канальный слой выращивали на Al 2 О 3 пленка при 160 ° C. Контакты исток / сток пакетов Ti / Au (30 нм / 70 нм) были сформированы, в свою очередь, с помощью оптической литографии, испарения электронным пучком и процесса отрыва. Наконец, изготовленные устройства были отожжены при 300 ° C на воздухе в течение разного времени.
Кристалличность, морфология поверхности, элементный состав, коэффициент поглощения и толщина In 2 О 3 Пленки были охарактеризованы методами рентгеновской дифракции (XRD) (Bruker D8 Discover), атомно-силовой микроскопии (AFM) (Bruker Icon), рентгеновской фотоэлектронной спектроскопии (XPS) (Kratos Axis Ultra DLD), ультрафиолетовой и видимой спектроскопии (UV- VIS) и эллипсометра (Sopra GES-SE, Франция) соответственно. Электрические измерения устройств проводились с использованием анализатора параметров полупроводников (B1500A, Agilent Technologies, Япония) с каскадной зондовой станцией в окружающем воздухе при комнатной температуре.
Результаты и обсуждение
На рисунке 1а показана скорость роста In 2 О 3 пленка как функция температуры подложки. Обнаружено, что стабильная скорость роста ~ 1,46 Å / цикл достигается в диапазоне 160 ~ 200 ° C, что указывает на быструю скорость роста и четко определенное температурное окно для ALD In 2 О 3 фильмы. При понижении температуры подложки до 150 ° C или повышении до 210 ° C результирующая скорость роста увеличивалась [19, 20]. Первое связано с конденсацией InCp на подложке, а второе - с термическим разложением InCp при более высокой температуре. Далее эволюция депонированного In 2 О 3 Толщина пленки была оценена как функция циклов ALD, как показано на рис. 1b. Понятно, что In 2 О 3 Толщина пленки линейно увеличивается с количеством циклов осаждения, что свидетельствует о достаточно равномерном росте.

а Скорость роста ALD в 2 О 3 пленка на подложке Si в зависимости от температуры подложки, и b зависимость В 2 О 3 толщина пленки от количества циклов ALD при 160 ° C
Чтобы наблюдать за эволюцией In 2 О 3 текстуры пленки с температурой осаждения, рентгенограммы In 2 О 3 Пленки, осажденные при различных температурах, представлены на рис. 2. Когда температура осаждения не превышает 160 ° C, дифракционный пик не наблюдается. Это указывает на то, что депонированные в 2 О 3 пленки при более низких температурах аморфны. При повышении температуры осаждения до 170 ° C начинают появляться дифракционные пики. Кроме того, при постепенном повышении температуры осаждения до 210 ° C интенсивность дифракционных пиков резко возрастает, что обычно проявляется пиками при 2θ =30,3 ° и 35,4 °. Это указывает на то, что кристалличность и размер зерна осажденного In 2 О 3 пленка улучшается постепенно с увеличением температуры осаждения. На рисунке 3 показаны морфологии поверхности типичного In 2 О 3 пленки, осажденные при разных температурах. Обнаружено, что поверхность пленки становится все более шероховатой с увеличением температуры осаждения, т. Е. Результирующая среднеквадратичная шероховатость (RMS) увеличивается с 0,36 до 1,15 нм при увеличении температуры осаждения от 160 до 210 ° C. Это должно быть связано с кристалличностью In 2 О 3 фильм. При температуре осаждения 160 ° C нанесенный In 2 О 3 пленка аморфная, с очень гладкой поверхностью. Когда температура осаждения достигает 180 ° C, осаждаемая пленка становится поликристаллической. Это означает, что полученная пленка содержит много кристаллических зерен, и размеры зерен становятся все больше и больше с увеличением температуры осаждения, как показано на рис. 2. Это хорошо согласуется с нашим наблюдением, что размеры холмиков на поверхности пленки постепенно увеличиваются с повышением температуры осаждения, что приводит к увеличению среднеквадратичного значения.
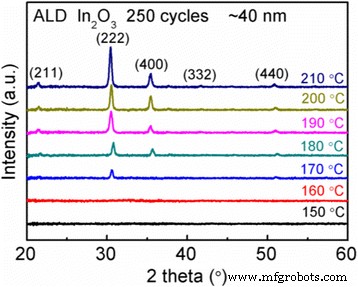
Рентгенограммы In 2 О 3 пленки, нанесенные при разных температурах за 250 циклов

АСМ изображения In 2 О 3 пленки, осажденные при разных температурах: a 160 ° С, b 180 ° С, с 200 ° C и d 210 ° С. Циклы осаждения были зафиксированы на 250 для каждой пленки
На рисунке 4 показаны XPS-спектры высокого разрешения C 1 s, In 3d и O 1s In 2 . О 3 пленки, осажденные при разных температурах. Что касается XPS-спектров C 1 s, показанных на рис. 4a, пленка, осажденная при 160 ° C, показывает пик при 289,8 эВ, который должен соответствовать C-O [21]. При повышении температуры осаждения до 180 ° C пик становится намного слабее. Кроме того, при температуре осаждения 200 ° C пик, равный 1 секунде, исчезает. Таким образом, показано, что чем выше температура осаждения, тем меньше примеси C в осажденном In 2 О 3 фильм. На рисунке 4b показаны спектры In 3d XPS In 2 . О 3 пленки, четко демонстрирующие однодуплетные гауссовы пики при 444,7 и 452,3 эВ, которые связаны с In 3d 5/2 и в 3D 5/2 основные уровни для In 2 О 3 [22, 23]. XPS-спектры O 1 s показаны на рис. 4в. Обнаружено, что спектр O 1 s для каждого образца может быть хорошо разделен на три пика, которые расположены при 529,8, 531,0 и 532,0 эВ соответственно. Эти пики соответствуют O 2− ионы, связанные с металлом (O1), кислородными вакансиями (O2) и –OH / CO (O3) соответственно [24, 25]. Когда температура осаждения увеличивается со 160 до 200 ° C, относительное процентное содержание O1 увеличивается с 76 до 92%; и относительный процент O2 постепенно снижается с 16 до 4%. Более того, относительное процентное содержание O3 также имеет тенденцию к снижению. Эти результаты показывают, что более высокая температура осаждения способствует снижению концентрации кислородных вакансий в осажденной пленке, а также гидроксильных групп и связей C-O. Далее, элементные составы In 2 О 3 пленки, осажденные при различных температурах, перечислены в таблице 1. Интересно, что атомное отношение In / O в осажденной пленке постепенно уменьшается с увеличением температуры осаждения. Однако даже для чистого In 2 О 3 пленке, осажденной при 200 ° C, атомное соотношение (1:1,36) In / O все еще больше, чем (1:1,5) стехиометрического In 2 О 3 . Это показывает, что ALD In 2 О 3 пленка обычно богата кислородными вакансиями.

Высокое разрешение a C 1s, b В 3D и c O 1 s XPS-спектры In 2 О 3 пленки осаждали при 160, 180 и 200 ° C соответственно. Чтобы удалить случайные поверхностные загрязнения, все образцы были протравлены ионной бомбардировкой на месте в течение 6 минут перед сбором сигнала
На рисунке 5а показано изменение (αhν) 2 как функция энергии фотона для осажденного In 2 О 3 пленки при различных температурах осаждения. Оптическая ширина запрещенной зоны (E g ) из In 2 О 3 пленка может быть определена соотношением Таука:αhν =A (hν-E g ) n [26], где α - коэффициент поглощения, A постоянная, h постоянная Планка, ν - частота, а показатель степени n характеризует характер полосового перехода. Здесь n =1/2, что означает, что In 2 О 3 полупроводник с прямо разрешенным переходом. E g извлекается путем экстраполяции участка прямой линии на смещение энергии при α =0. Извлеченное E g для In 2 О 3 пленка показана на рис. 5б. Видно, что E g возрастает с 3,42 до 3,75 эВ при повышении температуры осаждения от 150 до 200 ° C. Увеличенный E g при более высоких температурах осаждения может происходить из-за уменьшения кислородных вакансий и примеси C в осаждаемой пленке. Фактически, другие исследователи также сообщили, что, когда в ZnO существовало много кислородных вакансий, примесные состояния становились более делокализованными и перекрывались краем валентной зоны, что приводило к сужению запрещенной зоны [27]. Кроме того, постепенно увеличивающаяся кристалличность как функция температуры осаждения может влиять на оптическую ширину запрещенной зоны In 2 О 3 фильм. Это можно объяснить следующим образом. При повышении температуры осаждения размер зерна осажденного In 2 О 3 пленка увеличивается, как показано на рис. 2. Это, таким образом, приводит к уменьшению плотности границ зерен в пленке. Поскольку электроны легко захватываются на границах зерен, количество свободных электронов должно увеличиваться в In 2 О 3 пленка с меньшими границами зерен [28, 29]. Следовательно, такая повышенная концентрация электронов приводит к большей оптической ширине запрещенной зоны из-за сдвига Бурштейна-Мосса [30].

а Построение (αhν) 2 против энергии фотона для In 2 О 3 пленки, осажденные при разных температурах; б зависимость извлеченной запрещенной зоны (E g ) из In 2 О 3 от температуры осаждения
Чтобы продемонстрировать функцию ALD In 2 О 3 фильм, выступающий в качестве канала TFT, In 2 О 3 -канальные TFT с атомарным осаждением Al 2 О 3 Изготовлены затворные диэлектрики. На рисунке 6а показаны передаточные характеристики In 2 . О 3 TFT. Было обнаружено, что устройство в заводском исполнении не обладает характеристиками переключения, типичными для полевых транзисторов, а имеет тип проводника между истоком и стоком. Это следует отнести к наличию большого количества кислородных вакансий в In 2 О 3 канал, потому что кислородные вакансии могут поставлять свободные электроны. Следовательно, ради снижения концентрации кислородных вакансий в In 2 О 3 канал, последующий отжиг на воздухе проводился при 300 ° С. Понятно, что In 2 О 3 TFT показывает типичное поведение переключения после 2-часового отжига. Это указывает на то, что последующий отжиг на воздухе может значительно улучшить характеристики устройства. Далее, когда время отжига постепенно увеличивается до 10 ч, пороговое напряжение (V th ) TFT сдвигается в направлении положительного смещения, и подпороговое колебание (SS) постепенно улучшается. Однако при увеличении времени отжига до 11 ч производительность устройства начинает ухудшаться. Отмечается, что водород может быть включен в пленку в процессе изготовления, действуя как ловушка для электронов, образуя связи –ОН в канале или на границе раздела между каналом и диэлектриком [31]. Эти электронные ловушки, возможно, приводят к деградации SS. После отжига на воздухе связи ОН были восстановлены за счет введения O 2 молекулы [32]. Это могло привести к уменьшению плотности ловушек и, таким образом, к улучшению SS устройства. При 10-часовом отжиге на воздухе In 2 О 3 TFT демонстрирует полевую подвижность (μ EF ) 7,8 см 2 V -1 s −1 , V th −3,7 В, SS 0,32 В / дек, и коэффициент включения / выключения (I on / I выкл ) из 10 7 . Соответствующие выходные характеристики также представлены на рис. 6b, демонстрируя четкое поведение отсечки и насыщения тока при различных положительных напряжениях затвора. Кроме того, выходные кривые также указывают на n -тип режима улучшения. Для сравнения в Таблице 2 обобщены характеристики сообщенных ALD In 2 О 3 пленки и TFT от различных исследовательских групп [33,34,35,36,37]. Показано, что наш In 2 О 3 пленка показывает превосходную скорость роста при относительно низкой температуре, а изготовленное устройство также демонстрирует небольшую SS. Однако общая производительность устройства не так идеальна, что можно улучшить с помощью некоторых оптимизаций процессов и структуры устройства.
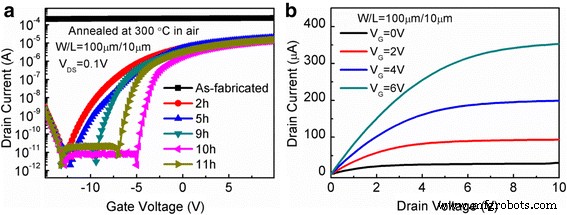
а Передаточные характеристики В 2 О 3 ТПТ, отожженные при 300 ° С на воздухе в течение разного времени; б Выходные характеристики In 2 О 3 TFT, отожженный при 300 ° C на воздухе в течение 10 ч
Чтобы хорошо понять влияние пост-отжига на воздухе на состав In 2 О 3 канал, In 2 О 3 Пленки были отожжены при 300 ° C в течение разного времени, а затем проанализированы с помощью XPS. В таблице 3 приведены процентные содержания элементов в различных отожженных пленках. По мере увеличения времени отжига с 2 до 11 ч атомное соотношение In:O уменьшается с 1:1,22 до 1:1,48, постепенно приближаясь к таковому (1:1,5) стехиометрического In 2 О 3 . Это еще раз подтверждает, что увеличение времени отжига на воздухе эффективно снижает плотность кислородных вакансий в In 2 О 3 фильм. Следовательно, улучшение производительности In 2 О 3 TFT следует в основном связывать с пассивацией кислородных вакансий, которые могут располагаться в объемном канале и / или на границе раздела между каналом и диэлектриком [25]. Однако чрезмерный отжиг ухудшил характеристики устройства, как показал 11-часовой отжиг. Это можно приписать изменению кристаллизации In 2 О 3 канального слоя, а также возможное окисление титановых электродов при избыточном пост-отжиге на воздухе. Таким образом, для достижения хороших характеристик In 2 требуется соответствующее время отжига. О 3 TFT.
Выводы
Быстрый рост ALD In 2 О 3 пленки были получены при относительно низких температурах (160–200 ° C) с InCp и H 2 О 2 прекурсоры, демонстрирующие равномерную скорость роста 1,46 Å / цикл. По мере увеличения температуры осаждения кристаллизация осажденной пленки постепенно усиливалась. При этом как кислородные вакансии, так и примеси углерода в осаждаемых пленках также были значительно уменьшены. Таким образом, это привело к увеличению E g из В 2 О 3 . Далее, с ALD In 2 О 3 канальный слой, TFT с ALD Al 2 О 3 диэлектрики. По мере увеличения времени после отжига на воздухе электрические характеристики In 2 О 3 TFT заметно улучшился до 10 ч отжига. В основном это связано с пассивацией кислородных вакансий, находящихся в объемном канале и / или на границе раздела между каналом и диэлектриком после отжига на воздухе. Что касается 10-часового отжига, устройство показало хорошие характеристики, например полевую подвижность 7,8 см 2 . / V⋅s, подпороговое колебание 0,32 В / дек и коэффициент включения / выключения 10 7 . Что касается температуры осаждения 200 ° C, осажденная пленка показывает соотношение In:O 1:1,36 без обнаруживаемого углерода, что свидетельствует о существовании кислородных вакансий в пленке после осаждения.
Наноматериалы
- Воздушные прокладки для 10-нм чипов
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Оптимизация высокоотражающей тонкой пленки для полноугольных микро-светодиодов
- Влияние различных связующих на электрохимические характеристики металлооксидного анода для литий-ионных ба…
- Нанопетали из мезопористого оксида никеля (NiO) для сверхчувствительного определения уровня глюкозы
- Нанокристаллический пленочный анод Fe2O3, полученный методом импульсного лазерного осаждения для литий-ионных…
- Нечувствительный к поляризации поверхностный плазмонный поляризационный модулятор электропоглощения на ос…
- Разработка электропряденого биокомпозита хитозан-полиэтиленоксид / фибриноген для потенциального заживлен…
- Анионное поверхностно-активное вещество / ионные жидкости с интеркалированным восстановленным оксидом граф…
- Тонкопленочная высокочастотная антенная решетка для беспроводной связи



