Регистратор расщепления заряда на месте (CSIR) для исследования в реальном времени эффекта плазменного заряда в процессах FinFET BEOL
Аннотация
Впервые предложено и продемонстрировано новое устройство для мониторинга повреждений, вызванных плазмой, в технологическом процессе (BEOL) с возможностью разделения заряда. Этот новый регистратор расщепления заряда на месте (CSIR) может независимо отслеживать количество и полярность эффектов заряда плазмы в процессе производства схем усовершенствованных полевых транзисторов (FinFET). Он не только показывает уровни заряда плазмы на антеннах в реальном времени и на месте, но также разделяет положительный и отрицательный зарядный эффект и обеспечивает два независимых показания. Поскольку КМОП-технологии стремятся к созданию более тонких металлических линий в будущем, новая схема разделения заряда предоставляет мощный инструмент для оптимизации процесса BEOL и дальнейшего повышения надежности устройства.
Фон
Процессы с плазменным усилением широко используются при формировании цепей на полевых транзисторах с плавниками (FinFET), которые состоят из множества структур с высоким аспектным отношением и тонких металлических линий [1]. На этапе изготовления, травления и осаждения для реализации этих трехмерных композиций могут возникнуть значительные плазменные напряжения в устройствах FinFET [2,3,4]. По мере развития технологии CMOS FinFET ширина и шаг линии металла сокращаются более агрессивно, чем его высота, что вызывает необходимость в формировании канавок с высоким соотношением сторон, определяемых чрезвычайно тонкими линиями. Это неизбежно увеличивает серьезность плазменных повреждений (PID) транзисторов, и соответствующее влияние на надежность схемы становится одной из ключевых проблем при разработке технологий FinFET [5,6,7]. При формировании небольших контактов, переходных отверстий и тонких металлических линий обычно применяется мощная и высокоселективная плазма [8]. Более того, при травлении объемного ребра распыление реактивных ионов на поверхность ребра может привести к дефектам в массивном ребре, критичным для характеристик транзисторов [9]. Для создания металлических затворов с ребрами и плотных межсоединений сложные металлические стопки чаще используются в передовых технологиях FinFET [10, 11]. Кроме того, высокий k затворный диэлектрик, используемый в передовых технологиях, обычно приводит к усиленному улавливанию под напряжением после плазменного процесса [12,13,14]. Во время плазменной зарядки путь разряда через узкие ребра к подложке может привести к более неравномерным уровням напряжения по всей пластине [15]. Вызванное плазмой напряжение на оксиде затвора транзистора, как известно, приводит к дальнейшему ухудшению диэлектрической целостности затвора [16, 17].
Вызванное плазмой повреждение диэлектрической пленки затвора может привести к ухудшению характеристик в сценариях сильно неоднородной зарядки, даже к потере урожая [18,19,20] в результате отказов надежности [21, 22]. Таким образом, в передовых технологиях FinFET для мониторинга эффектов PID обычно используются испытательные устройства с увеличенными антенными структурами, которые обеспечивают обратную связь для дальнейшей оптимизации процесса.
Наиболее распространенным и широко используемым показателем ФИД является время до пробоя тестовых образцов с большими антенными структурами. Скрытые повреждения на этих диаграммах PID обычно отражаются путем измерения зависящей от времени деградации диэлектрических слоев затвора, следовательно, не обеспечивается обратная связь плазменных процессов в реальном времени [23]. Кроме того, обычные испытательные устройства не могут определить источники и полярность индуцированной плазмой скорости заряда и / или максимального накопления потенциала на антенне. Регистратор PID с плавающим затвором, соединенным антенной структурой, был предложен с возможностью обнаружения на месте в нашем предыдущем исследовании [24, 25]. В этой работе мы предложили доработанный регистратор ФИД с функцией разделения заряда. Благодаря прямому и обратному диодам, подключенным к общей структуре антенны, новая конструкция обеспечивает отдельные пути для положительных и отрицательных зарядов. Следовательно, уровни заряда обеих полярностей можно регистрировать независимо. Этот новый регистратор разделения заряда на месте (CSIR), требующий только небольших антенн, позволяет в будущем изучить влияние заряда плазмы в процессах среднего звена (MEOL).
Методы
Полярность заряда плазмы
В предыдущих исследованиях сообщалось, что во время процесса травления при формировании поли- или металлических слоев неоднородность плазмы, а также вариации потенциала антенны могут привести к резкой разнице в скорости зарядки или даже полярности могут измениться в разных местах [24, 25]. Как макросреда в плазменной камере, так и микроструктуры могут влиять на распределение скорости зарядки на пластине [26]. А именно, скорость заряда плазмы при травлении в конце линии (BEOL) изменяется в пространстве и по времени. Во время процессов высокочастотной (RF) плазмы поверхность пластины собирает зарядный ток, Дж p , который состоит из ионного тока Дж я и ток электронов Дж e [26]. Ионный ток практически постоянен во времени и определяется плотностью ионов Дж . я и скорость Бома [26]. Поскольку потенциал плазмы V p ( т ) выше, чем потенциал затвора V G в большинстве случаев электронный ток течет только в короткие периоды, когда потенциал плазмы близок к минимуму. Во время Q FG В процессе, напряжение затвора может увеличиваться или уменьшаться в течение многих РЧ-циклов, в зависимости от того, какая составляющая токов больше, до тех пор, пока не будет достигнуто установившееся напряжение затвора, когда туннельный ток уравновесится Дж p на антенне. Как показано на рис. 1, распределение скорости заряда плазмы, Дж P ( x , y , t ), поперек пластины во время процесса травления на разных этапах изменяется как по величине, так и по полярности, что может быть выражено как в формуле. (1) где J e представляет плотность электронного тока, а Дж я представляет плотность ионного тока.
$$ {J} _ {\ mathrm {p}} ={J} _ {\ mathrm {e}} + {J} _ {\ mathrm {i}} \ dots $$ (1)
Распределение скорости плазменной зарядки по центральной линии пластины в процессе травления в разное время. Полярность зарядки плазмы в определенном месте может измениться со временем
Различная полярность заряда плазмы приводит к положительному или отрицательному заряду антенны, Q P , накопленные в другое время и в другом месте. Чтобы уточнить, в момент t 1 , отрицательный J p приводит к отрицательному заряду антенны Q -. В t 2 , положительный J p индуцирует положительный заряд антенны Q + в идентичном месте на пластине, как показано на рис. 1. Таким образом, положительный или отрицательный заряд может накапливаться на одной и той же антенне в разное время во время процесса травления. Из предыдущих отчетов [27], пиковые уровни J e и Дж я около - 0,15 и 0,35 мА / см 2 , соответственно. Было обнаружено [28, 29], что постоянное и переменное / двунаправленное напряжение затвора на n-канальном и p-канальном FinFET приводит к различным скрытым повреждениям диэлектрической пленки затвора. Высокие напряжения с положительным или отрицательным постоянным смещением и переменное напряжение с частотой переключения 0,1 Гц прикладываются к обычным испытательным образцам FinFET соответственно. Как показано на рис. 2, время до выхода из строя ( T BD ) транзистора, испытывающего положительное, отрицательное напряжение и напряжение затвора в обоих направлениях. Результаты показывают, что напряжение затвора постоянного тока вызовет более серьезные повреждения образцов, в то время как напряжение затвора переменного тока приведет к менее серьезным повреждениям этих транзисторов, как предполагает более длинный T BD для образцов, подвергнутых двунаправленной нагрузке. На рисунке 2 также показано, что деградация оксида зависит не только от полярности заряда, но и от типа ямок под n-канальными и p-канальными транзисторами, что, как ожидается, будет вызвано разницей в путях разряда в этих испытаниях. устройства во время процесса. Следовательно, обычный детектор PID, который использует T BD поскольку индикатор степени повреждения не может отражать уровень заряда плазмы во время процесса. С другой стороны, регистратор заряда плазмы, предложенный в нашей предыдущей работе, регистрирует уровень напряжения путем инжекции или выброса электронов в / из плавающего затвора (FG), связанного с антенной, собирающей заряд. Записанные данные, заряд плавающего затвора ( Q FG ), читается впоследствии после изготовления [24, 25]. Затем запись измеряется по сдвигу порогового напряжения на считывающем транзисторе, канал которого управляется и направляется тем же плавающим затвором. Повышенный потенциал на антенне с Q P от плазменной зарядки может индуцировать как положительное, так и отрицательное напряжение антенны во время формирования единого металлического слоя. Далее, для разных металлических слоев используются разные параметры изготовления. Например, время травления, используемый химикат и температура камеры могут изменяться. Эти параметры могут влиять на распределение заряда антенны по пластине во время травления. В других случаях транзистор, подключенный к нескольким металлическим слоям, подвергается еще более сложной последовательности плазменной зарядки, как показано на рис. 3а.
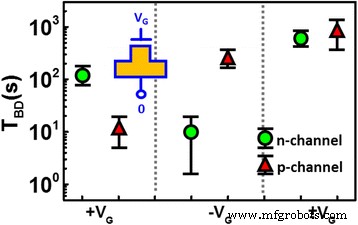
Время до поломки ( T BD ) n-канальных и p-канальных FinFET-транзисторов, подвергнутых воздействию положительного, отрицательного и положительного + отрицательного заряда на электродах затвора. Т BD устройств при напряжениях разной полярности свидетельствует о том, что повреждения, накопленные на диэлектрике затвора, зависят не только от полярности зарядки, но и от лунок под соответствующими полевыми транзисторами FinFET
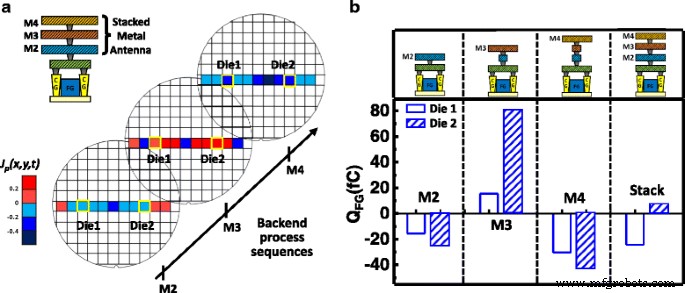
а Эффект заряда плазмы для разных металлических слоев различается в разных местах пластины. б Положительные и отрицательные заряды могут компенсировать друг друга в уложенных друг на друга металлических слоях
На разных этапах процесса BEOL зарядный ток плазмы в конкретной антенне может переключаться между ионным и электронным током, то есть чистым Q P также может переходить с положительного на отрицательный. Записи на образцах с антенной, состоящей из металла 2, металла 3, металла 4 и нескольких металлических слоев, приведены на рис. 3б. Данные предполагают чистую зарядку одного металлического слоя [24] при определенном изменении полярности от слоя к слою. Кроме того, эффект усреднения обнаружен на Q FG образцов с антенными структурами из нескольких металлических слоев дополнительно подтверждается данными измерений на рис. 3б. И с положительным, и с отрицательным V G на антенне последний Q FG затем будут усреднены инжекцией электронов и выбросом в / из FG, которые могут происходить последовательно. Этот эффект компенсации ограничивает самописец, чтобы он мог выявлять реальные условия нагрузки, которые устройство испытывает во время плазменных процессов. Пересмотренный CSIR разработан для решения проблемы индивидуальной регистрации положительных и отрицательных эффектов зарядки без помех и для предоставления более подробных данных о ситуации зарядки в плазменной камере.
Тестовый образец для разделения заряда
В этом исследовании заряд положительных ионов и заряд отрицательных электронов на антенне можно разделить с помощью предлагаемого нового регистратора расщепления заряда на месте (CSIR), как показано на рис. 4a. CSIR состоит из двух плавающих ворот, FG 1 и FG 2 которые записывают различные типы эффекта зарядки по отдельности. Антенная структура соединяется с двумя затворами через прямой диод (D1) и обратный диод (D2) соответственно. В левой половине конструкции положительные заряды будут течь в соединительный вентиль 1 (CG 1 ) через D1. Когда CG 1 положительно заряжен, напряжение передается на плавающий затвор через контактные щели с обеих сторон. Плавающий затвор будет заряжаться отрицательно, поскольку электроны выбрасываются из подложки. Правая половина структуры, с другой стороны, представляет собой путь отрицательной зарядки, позволяющий току течь от антенны в соединительный вентиль 2 (CG 2 ) через D2, что дает положительный результат Q FG . На рисунке 4b также показано поперечное сечение CSIR со встроенными pn-диодами, направляя положительный и отрицательный зарядные пути к отдельным затворам связи, CG 1 и CG 2 , которые связывают потенциал антенны с FG 1 и FG 2 соответственно.
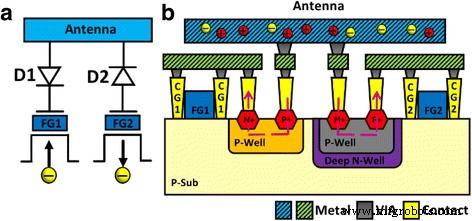
а Регистратор разделения заряда на месте с двумя отдельными плавающими затворами путем подключения к прямому диоду (D1) и обратному диоду (D2) для обнаружения заряда электронов / ионов, соответственно. б Поперечное сечение нового регистратора расщепления заряда на месте со встроенными pn-диодами, направляя положительный и отрицательный заряд к разделенным затворам связи, CG 1 и CG 2
Когда левая половина регистратора включена в CSIR под положительно заряженной антенной, правая половина неактивна, поскольку заряд блокируется обратным диодом, и наоборот. Оба диода на кристалле состоят из n + / p-колодцев. Для D2, чтобы поддерживать отрицательное напряжение в своей p-яме, p-область должна быть окружена глубокой n-ямой, блокирующей путь зарядки непосредственно к подложке. Смоделированное распределение потенциала в поперечном сечении в CSIR при положительном и отрицательном периодах зарядки антенны показано на рис. 5a и b соответственно. Предполагая, что потенциал на антенне достигает 5 В, через диод слева положительный заряд течет к управляющему вентилю слева, что приводит к высокому положительному напряжению ( V CG1 ). В то же время положительный заряд блокируется диодом справа, в результате чего V близок к нулю. CG2 . Разность потенциалов на двух управляющих вентилях подтверждается смоделированными контурами потенциала на рис. 5а. Влияние отрицательной зарядки на антенну показано на рис. 5b. Смоделированные профили потенциала подтверждают, что pn-диоды на кристалле могут эффективно направлять и блокировать потенциал CG 1 и CG 2 , комплимент, как и задумано. Таким образом, положительные и отрицательные эффекты зарядки, соответствующие различным источникам при плазменной обработке, могут быть получены независимо, предотвращая компенсацию заряда и проблемы с помехами на детекторе.

Моделирование распределения потенциала в CSIR с положительным и отрицательным напряжением на затворе антенны. Прямой и обратный pn-диоды успешно разделяют полярность заряда антенны
Результаты и обсуждение
Измеренный сдвиг порогового напряжения (Δ V T ) на устройстве, управляемом FG 1 с прямым диодом и с FG 2 с обратным диодом и образцы без диода сравниваются на рис. 6. Данные вдоль центральной линии пластины показывают, что записывающее устройство с одним плавающим затвором действительно подвергается нейтрализации заряда даже при обработке одного металлического слоя. Эффект усреднения записывающего устройства без диода доказывает, что пиковая скорость зарядки не будет отражена правдиво. С другой стороны, показания нового CSIR могут независимо обеспечивать положительный и отрицательный уровни заряда. Для дальнейшего исследования эффекта заряда плазмы при образовании металла 2 (M2) собранный заряд на FG 1 и FG 2 CSIR каждого штампа можно независимо рассчитать по формуле. (2),
$$ {Q} _ {\ mathrm {FG}} ={C} _ {\ mathrm {T}} \ times \ Delta {V} _ {\ mathrm {T}} \ times {\ alpha} _ {\ mathrm {RG}} \ dots $$ (2)где Q FG это заряд в плавающем затворе. C T - полная емкость плавающего затвора, как показано на рис. 7. Δ V T - сдвиг порогового напряжения, обнаруженный на входе считывания записывающего устройства, а α RG коэффициент связи от считывающего элемента.
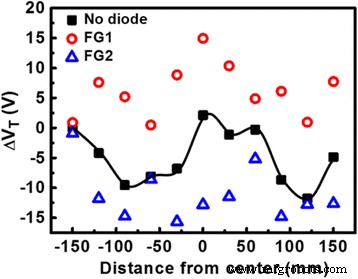
Распределение дельты V T на ФГ 1 с прямым диодом и ФГ 2 с обратным диодом и FG без диода по средней линии пластины
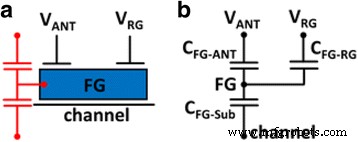
а Принципиальная схема модели емкостной сети в устройстве CSIR. б Общая емкость плавающего затвора представляет собой все упомянутые емкости последовательно и параллельно
Когда заряд плавающего затвора изначально равен нулю и Q FG достигает уровня насыщения, когда электрическое поле через диэлектрический слой затвора уменьшается до нуля, конечный потенциал затвора антенны в конце плазменного процесса можно выразить следующим образом:
$$ {V} _ {\ mathrm {ANT}} =\ frac {V _ {\ mathrm {FB}} - \ frac {Q _ {\ mathrm {FG}}} {C _ {\ mathrm {T}}}} { \ alpha _ {\ mathrm {ANT}}} \ dots $$ (3)в котором, V ANT потенциал затвора антенны при плазменном заряде и α ANT представляет собой коэффициент связи с плавающим затвором от затвора антенны. V FB - напряжение плоской полосы от металлического затвора до ребристой подложки. При заданном времени процесса средняя плотность зарядного тока плазмы Дж p затем можно спроецировать по формуле. (4).
$$ {J} _ {\ mathrm {p}} =\ frac {V _ {\ mathrm {ANT}} \ times {C} _ {\ mathrm {ANT}}} {A _ {\ mathrm {ANT}} \ times \ Delta t} \ точки $$ (4)где Δ t - продолжительность плазменного процесса [28, 29] и C ANT - полная емкость металлической антенны, а A ANT площадь зарядки антенны. Все параметры, использованные в приведенных выше расчетах, сведены в Таблицу 1.
Распределение положительных и отрицательных скоростей заряда по пластине во время обработки верхнего (металл 9) и нижнего металлического (металл 2) слоев дополнительно сравнивается на рис. 8. Это означает, что заряд в структуре антенны более заметен при более высоком содержании металла. уровней (металл 9), потому что на металле 9 его более высокая энергия плазмы вызывает Дж p быть больше J p металла 2 по величине. Кроме того, данные свидетельствуют о том, что в обоих случаях скорость заряда как электронов, так и ионов достигает максимума около центра. Как и ожидалось, матрицы, расположенные близко к центру пластины, испытывают высокий уровень заряда, что можно объяснить более длинным путем разряда во время плазменной обработки. Этот эффект местоположения идентичен как для условий, в которых преобладает заряд электронов, так и ионов. Прогнозируемая скорость зарядки плазмы, Дж P ( x, y ), усредненные по формированию одного металлического слоя, металла 2 (M2) и металла 9 (M9), далее сравниваются на рис. 9. Эти карты пластин показывают, что скорость зарядки электронов, по-видимому, находится на плато, за исключением края. , в то время как скорость зарядки ионов показала более высокую вариацию в средней части пластины. Ожидается, что в будущем эти карты пластин при различных условиях обработки дадут представление о плазменной камере или дадут дополнительные рекомендации по оптимизации за счет лучшей компенсации эффектов зарядки.

Сравнение скорости положительной и отрицательной зарядки на центральной линии пластины для процессов металла 2 и металла 9. Скорость зарядки достигает пика около центра, что означает, что повреждение, вызванное плазмой, более серьезно в центре пластины

Прогнозируемая скорость зарядки электронов и ионов, Дж e ( x , y ) и J я ( x , y ) получаются регистраторами разделения заряда по поверхности травления во время формирования металла 2 и металла 9
Эффект соотношения антенн
Традиционные устройства контроля PID обычно предназначены для усиления эффекта PID путем подключения затворов транзистора непосредственно к большой антенне, оценивая уровни напряжения по увеличению общего Q P Предполагается, что разряд должен проходить через небольшую область канала [30, 31]. Коэффициент антенны (AR) пропорционален плотности тока напряжения через диэлектрик затвора во время плазменных процессов [32]. Большой Q P на антенне, как известно, вызывает скрытые повреждения и / или ловушки в диэлектрическом слое, что в конечном итоге приводит к снижению надежности [33]. Как и ожидалось, более высокий AR на обычных FinFET-транзисторах действительно значительно повышает уровень стресса, вызывая более серьезное T BD деградация, а именно отказ устройства в течение более короткого периода работы, см. рис. 10. С другой стороны, в CSIR уровень заряда плазмы записывается как заряд плавающего затвора, Q FG , показывает очень небольшой антенный эффект. А именно, он не реагирует на увеличение площади антенны, как показывают данные, приведенные на рис. 11.

а Время до выхода из строя I G от времени обычных детекторов ФИД при увеличении размера антенны. б Т BD резко уменьшается, когда AR превышает 1000
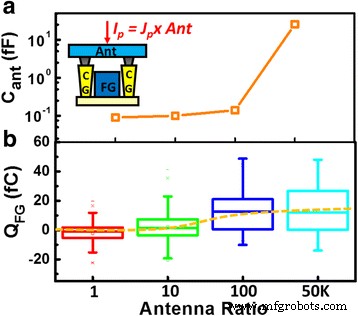
а По мере увеличения емкости антенны В CG становится независимым от AR. б Q FG насыщается, когда AR превышает 100 ×
В новом CSIR на основе плавающих затворов соотношение антенн (AR) будет влиять на пиковый потенциал затворов связи во время зарядки плазмы. В масштабируемых технологиях ожидается уменьшение паразитных емкостей на соединительной и соединительной структуре, что приведет к меньшей чувствительности AR к результатам записи. Причины такого очевидного различия эффекта AR между CSIR и обычными детекторами следующие. В этих регистраторах с плавающим затвором на антенне накапливается заряд Q P не будет разряжаться через зону канала. Повышенный Q P повышает V CG , что приводит к инжекции или выбросу электронов в / из плавающих затворов. Как показано на смоделированной емкости на рис. 11a, емкость антенны C муравей , увеличивается пропорционально площади антенны, A муравей . Поскольку общий зарядный ток прямо пропорционален площади антенны, увеличенное AR в CSIR не повлияет на потенциал антенны. Данные измерений показывают, что Q FG уровень остается примерно таким же для SCIR с AR, превышающим 100 ×.
Эта функция не только сохраняет область тестового шаблона, но также позволяет находить J P ( x , y ) с более высоким пространственным разрешением для изучения эффекта формирования паттерна на ФИД. Кроме того, детектор с небольшой антенной может облегчить разработку тестовых шаблонов для понимания PID в средней части линии (MEOL) и контактных процессов.
Наконец, сводные характеристики нового CSIR для мониторинга PID в усовершенствованном процессе BEOL FinFET приведены в таблице 2. Диапазон измерения традиционного детектора - AR, а диапазон измерения нового регистратора in situ основан на длине плавающего затвора. Кроме того, площадь нового регистратора на месте может быть очень маленькой. Что наиболее важно, новый CSIR может обеспечивать в реальном времени обратную связь по плазменному процессу и независимо друг от друга разделять уровни заряда ионов и скорость заряда электронов.
Выводы
Впервые предложен и продемонстрирован новый регистратор расщепления заряда на месте (CSIR) для мониторинга повреждений, вызванных плазмой. CSIR представляет собой мощный инструмент для одновременного понимания скорости заряда электронов и ионов в плазменной камере. Карты пластин могут облегчить дальнейшее изучение взаимосвязи между надежностью устройства и этими отдельными эффектами зарядки.
История изменений
Наноматериалы
- Рыба-данио:многообещающая модельная система в реальном времени для доставки нейроспецифических лекарств, оп…
- Замещающее легирование для алюмосиликатного минерала и превосходное расщепление воды
- Биофлавоноиды, содержащие генистеин, наночастицы хитозана, нацеленные на фолатные рецепторы, для усиления пр…
- Влияние контактной неравновесной плазмы на структурные и магнитные свойства шпинелей Mn Х Fe3 - X О4
- Влияние отжига in situ на подвижность и морфологию органических полевых транзисторов на основе TIPS-пентацена
- Синтез биметаллических вольфрам-медных наночастиц in situ с помощью реактивной радиочастотной (RF) тепловой плаз…
- Точное осаждение на месте с помощью электрического поля электропряденых γ-Fe2O3 / полиуретановых нановолокон д…
- Волокнистые сетки на основе йода с электропрядением на месте для антибактериальной перевязки ран
- Портативный трибоэлектрический наногенератор для мониторинга дыхания в реальном времени
- Синаптическое устройство для захвата заряда ReS2 для приложения для распознавания лиц



