Изменение поверхностной проводимости упруго деформированных кристаллов p-Si, облученных рентгеновскими лучами
Аннотация
В работе исследовано изменение проводимости облученных и необлученных монокристаллов p-Si под действием упругих одноосных механических напряжений. Предложено аналитическое выражение для описания зависимости поверхностной проводимости от механического напряжения и дозы рентгеновского облучения. Было показано, что четырехугольные наночастицы на поверхности «солнечного» кремния влияют на изменение электропроводности при механическом воздействии. Установлено, что рентгеновское облучение вызывает генерацию точечных дефектов в кремнии. Эти дефекты подавляют движение дислокаций. Было показано, что удельное сопротивление ранее облученных образцов «электронного» кремния мало чувствительно к влиянию одноосного сжатия при определенной скорости деформации.
Фон
Широкое использование полупроводниковых приборов в области современных электронных технологий требует исследования новых полупроводниковых материалов, обладающих высокой стабильностью к внешним воздействиям, таким как рентгеновское облучение и механическая деформация. В настоящее время кремний активно используется в высокочувствительных детекторах и других полупроводниковых сенсорах, работающих в полях излучения [1].
Большинство статей посвящено влиянию пластической деформации на проводимость n-Si [2, 3]. Поэтому влияние упругой деформации на свойства кристаллов p-Si до сих пор считается важной научной задачей. Перераспределение концентрации носителей и примесей в деформированных кристаллах часто характеризуется наличием дислокаций, которые являются эффективными геттерами дефектов, особенно на поверхности кристалла [4, 5]. Известно [3,6], что возбуждение электронных подсистем кристалла также сопровождается соответствующими изменениями подвижности дислокаций. Возбуждение электронных подсистем может быть результатом внешнего воздействия, например излучения и электростатического поля. Характерной особенностью дислокаций в кристаллах кремния является наличие точечных дефектов (облако Коттрелла) с высокой концентрацией вокруг дислокаций.
Поверхность кристаллов наиболее чувствительна к ионизирующему излучению. Поэтому исследование радиационно-индуцированных процессов на поверхностных слоях кристаллов кремния остается актуальным. Поверхность с нанесенными Al-контактами является эффективным геттером структурных дефектов [5,6,7]. Под наплавленной металлической пленкой возникают механические напряжения из-за несоответствия параметров решетки пленки и полупроводника [5,7]. Эти напряжения стимулируют процессы геттерирования дефектов (примесных атомов, межузельных атомов кремния и вакансий) в контактном слое.
Методы
Монокристаллы кремния p-типа проводимости, выращенные методом Чохральского ( ρ =10–20 Ом · см). Эти монокристаллы бывают двух типов:(1) кремний для электроники - так называемые бездислокационные (или электронные) монокристаллы, на поверхности (111) которых концентрация треугольных ямок травления не превышает 10 2 см −2 (Рис. 1а и 2), а (2) «солнечные» монокристаллы кремния, на поверхности (111) которых обнаружены дефекты в виде четырехугольных пирамид (рис. 1б) из-за относительно большая концентрация фонового углерода (≈5 × 10 16 см −3 ) и кислород (≈1,8 × 10 18 см −3 ) примеси. Так же расположены четырехугольные пирамиды. Размер основания пирамиды от 10 нм до 10 мкм.
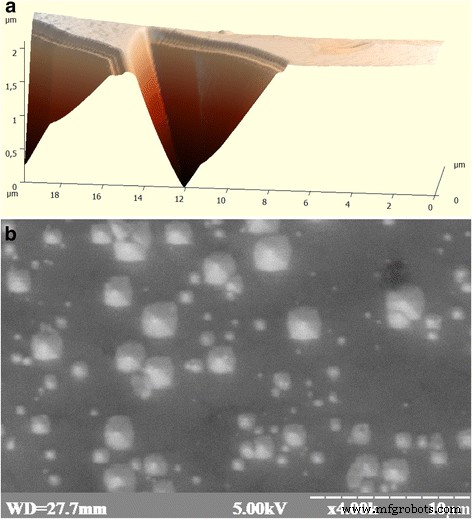
Внешний вид поверхности экспериментальных образцов: а появление дислокационных ямок травления на поверхности кристалла p-Si, полученного в поле атомно-силового микроскопа и b внешний вид субмикроскопической поверхности (111) солнечных кристаллов

Зависимость продольного сопротивления первичного бездислокационного образца при упругой деформации со скоростью деформации 8 мкм / мин
Было показано [8, 9], что в образовании кластеров, которым соответствуют 4-угольные пирамидальные отверстия травления, могут участвовать оксидные слои кремния, точечные дефекты и слои с различным структурным состоянием кремния, в частности альфа-кремний.
Получены экспериментальные образцы размерами 4 × 3,7 × 7,6 мм после шлифовки и химической полировки. Омические контакты в виде двух полос шириной 1,5 мм на концах поверхностей образцов (111) создавались термическим испарением алюминия в вакууме (10 −4 Па) при нагревании образца до 593 К. Измерение электропроводности проводилось в вакуумном криостате при давлении остаточных газов 10 −3 . Па при приложении одноосного сжатия к концам (в направлении [\ (11 \ overline {2} \)]) с силой от 15 до 40 МПа и скоростью деформации 8 или 32 мкм / мин. Образцы облучали рентгеновским излучением в полном диапазоне ( Вт -анод, 50 кВ, 10 мА), с двух сторон, на которые были нанесены алюминиевые контакты. Расстояние между источником рентгеновского излучения и кристаллами было минимальным (1-2 мм). Установлено, что поглощенная доза увеличивается на 130 Гр каждые 30 мин. В работе мы сначала облучали экспериментальные образцы, а затем измеряли сопротивление в процессе деформации.
Результаты и обсуждение
Результат исследования по изменению наведенной механической проводимости вдоль направления деформации ( ρ ( σ )) «бездислокационных» образцов p-типа проводимости под действием одноосного напряжения ( σ ) представлена на рис. 2. Повышение нагрузки от 0 до 40 МПа (при скорости деформации 8 мкм / мин) длится 45 мин.
В процессе деформации сопротивление бездислокационных образцов незначительно увеличивается. Следует отметить, что в случае необлученных кристаллов изменение скорости деформации практически не повлияло на общий вид зависимостей ρ ( σ ) [10, 11]. Аналогичные зависимости были получены для облученных образцов (рис. 3). Повышение сопротивления наблюдалось после действия рентгеновского излучения. Однако характер зависимости ρ ( σ ) было замечено несколько иначе, чем для необлученных образцов.
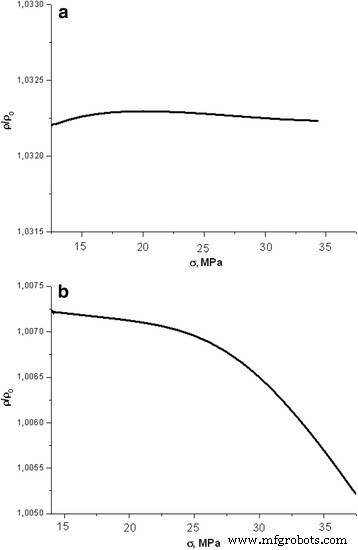
Зависимость продольного сопротивления облучаемого ( D =130 Гр) бездислокационный образец кремния при упругой деформации с нарастанием прочности на сжатие со скоростью 8 мкм / мин ( a ) и 32 мкм / мин ( b )
Видно, что сопротивление остается практически неизменным (рис. 3а) при сжатии со скоростью 8 мкм / мин из-за воздействия рентгеновского излучения. Аналогичный вид имели графики зависимостей образцов, подвергнутых воздействию 260 и 480 Гр. В предыдущих исследованиях [11] было показано, что сопротивление увеличивается пропорционально квадратному корню из поглощенной дозы в процессе облучения.
Увеличение скорости сжатия в 4 раза (с 8 до 32 мкм / мин) приводит к изменению характера зависимости удельного сопротивления от нагрузки (рис. 3б). Наблюдается небольшое (<0,2%) снижение сопротивления облученных образцов в процессе сжатия. Следует отметить, что все измерения изменений проводимости проводились с высокой степенью точности (± 0,045%), так что можно было правильно проанализировать небольшие изменения удельного сопротивления в эксперименте.
Следует отметить, что зависимость, представленная на рис. 3, была получена через 7 дней после измерения изменений продольного сопротивления ( D =130 Гр) бездислокационных образцов со скоростью 8 мкм / мин (рис. 3а). В течение заданного периода времени сопротивление почти вернулось к своему первоначальному значению, то есть значению сопротивления, которое наблюдалось после облучения и приложения механического напряжения.
Аналогичные исследования по измерению зависимости сопротивления от действия упругого сжатия и после воздействия излучения были проведены (рис. 4) и для экспериментальных образцов на основе «солнечного кремния» p-типа проводимости, которым присущи 4-угольные пирамиды на поверхность (111).
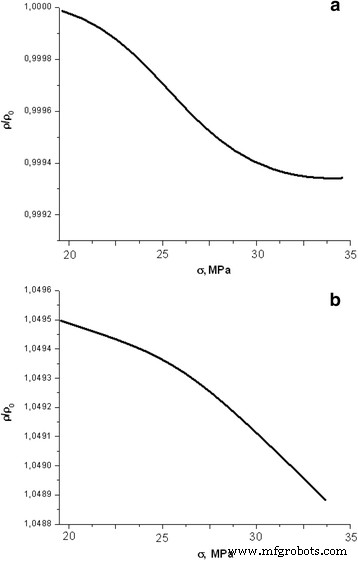
Зависимость продольного сопротивления солнечного кремния при упругой деформации с ростом прочности на сжатие: a Д =0 Гр, скорость сжатия 32 мкм / мин; б Д =130 Гр, скорость сжатия 8 мкм / мин
Прежде всего, было установлено, что характер изменения сопротивления «солнечного» кремния типа p-Si от величины механического напряжения не зависит от скорости сжатия. Аналогичная особенность наблюдалась как в необлученных, так и в облученных образцах. Зависимость продольного сопротивления от механического напряжения изменяется на относительно небольшую величину (<0,5%), и она несколько уменьшается при увеличении нагрузки (рис. 4а).
Облучение экспериментальных образцов рентгеновским излучением (480 Гр) практически не влияет на общий характер изменения продольного сопротивления «солнечного» кремния при упругой деформации (рис. 4б). Что касается электронных образцов, то сопротивление пропорционально корню квадратному из поглощенной дозы [11]. Во время механического воздействия удельное сопротивление уменьшается на очень небольшую величину (± 0,1%).
Как было показано в наших предыдущих исследованиях [12, 13], диэлектрическая пленка SiO 2 имеет положительный заряд. Следовательно, поверхностный слой пространственного заряда обеднен дырками (с высоким сопротивлением) и имеет толщину w (Рис. 5) создается из кремния. Чем ближе Si-SiO 2 к интерфейсу, тем меньше дыр будет.

Искажение энергетических зон в проводнике p-типа при наличии положительного заряда на границе раздела полупроводник-изолятор
Концентрация дырок в поверхностном слое кремния и, следовательно, его проводимость изменяются при изменении поверхностного потенциала ( φ S ). Рассмотрим плоскую квадратную пластину (рис. 6). Пусть ток течет параллельно плоскости пластины в направлении одного из ее краев.

Расчеты электропроводности
Был взят тонкий параллельный слой толщиной dy и площадь поперечного сечения dS [14] на некотором расстоянии ( y ) с поверхности. Этот слой можно рассматривать как однородный полупроводник, сопротивление которого можно определить по следующей формуле:
$$ d R =\ rho \ frac {l} {dS}, $$ (1) $$ d S =a d y. $$ (2)Поскольку тарелка квадратная ( l = а ) проводимость слоя
$$ d \ lambda =\ frac {1} {dR} =\ sigma d y, $$ (3)где \ (\ sigma =\ frac {1} {\ rho} \) - электропроводность слоя с dy толщина в y расстояние от поверхности. Для полупроводника p-типа проводимость можно записать как \ (\ sigma \ приблизительно e p (y) {\ mu} _p \). Тогда получаем
$$ d \ lambda =e p (y) {\ mu} _p dy. $$ (4)Найдем полную поверхностную проводимость ( λ ). Вам нужно интегрировать последнее выражение в диапазоне от нуля до толщины нескольких устойчивых дебаевских экранов или, например, ограничить ширину области пространственного заряда w :
$$ \ lambda ={\ displaystyle \ underset {0} {\ overset {w} {\ int}} ep (y) {\ mu} _p dy =e {\ mu} _p {\ displaystyle \ underset {0} { \ overset {w} {\ int}} p (y) dy}}. $$ (5)В общем, концентрация дырок в обедненном поверхностном слое зависит не только от координат ( y ), но также от приложенного механического напряжения ( σ меня ). Он определяется двумя составляющими: p ( г , σ меня ) = p 1 ( г ) - p 2 ( σ меня ), где p 1 ( г ) - составляющая, соответствующая изменению концентрации носителей заряда с изменением расстояния от поверхности полупроводника и p 2 ( σ меня ) - составляющая, показывающая, насколько снижается концентрация дырок из-за их захвата дислокациями при механическом воздействии. Кроме того, подвижность дырок не является постоянной величиной. Это зависит от механического воздействия. Следовательно, выражение для полной поверхностной проводимости можно записать в следующем виде:
$$ \ lambda =e {\ mu} _p \ left ({\ sigma} _ {meh} \ right) {\ displaystyle \ underset {0} {\ overset {w} {\ int}} \ left ({p} _1 (y) - {p} _2 \ left ({\ sigma} _ {meh} \ right) \ right) dy}. $$ (6)Механически индуцированное изменение проводимости можно записать следующим образом:
$$ \ lambda \ left ({\ sigma} _ {meh} \ right) =e {\ mu} _p \ left ({\ sigma} _ {meh} \ right) \ cdot \ Big ({\ displaystyle \ underset { 0} {\ overset {w} {\ int}} {p} _1 (y) dy - {\ displaystyle \ underset {0} {\ overset {w} {\ int}} {p} _2 \ left ({\ sigma} _ {meh} \ right) dy} \ Big) =e {\ mu} _p \ left ({\ sigma} _ {meh} \ right) \ cdot \ left \ {{\ beta} _1 - {\ beta } _2 \ left ({\ sigma} _ {meh} \ right) \ right \}}, $$ (7)где \ ({\ beta} _1 ={\ displaystyle \ underset {0} {\ overset {w} {\ int}} {p} _1 (y) dy; \ kern1em {\ beta} _2 \ left ({\ sigma } _ {meh} \ right) ={\ displaystyle \ underset {0} {\ overset {w} {\ int}} {p} _2 \ left ({\ sigma} _ {meh} \ right) dy}} ={p} _2 \ left ({\ sigma} _ {meh} \ right) {\ displaystyle \ underset {0} {\ overset {w} {\ int}} dy =} w \ cdot {p} _2 \ left ( {\ sigma} _ {meh} \ right) \).
Следует отметить, что поскольку p 1 ( г ) и p 2 ( σ меня ) также зависят от воздействия облучения, коэффициенты β 1 , β 2 , и μ p зависят от дозы рентгеновского облучения. Следовательно, формула для поверхностной проводимости до ( λ ( σ меня , 0 )) и после ( λ ( σ меня , D )) облучение можно записать так:
$$ \ lambda \ left ({\ sigma} _ {meh}, 0 \ right) =e {\ mu} _p \ left ({\ sigma} _ {meh}, 0 \ right) \ cdot \ Big ({\ displaystyle \ underset {0} {\ overset {w} {\ int}} {p} _1 \ left (y, 0 \ right) dy- w \ cdot {p} _2 \ left ({\ sigma} _ {meh} , 0 \ right) \ Big) =e {\ mu} _p \ left ({\ sigma} _ {meh}, 0 \ right) \ cdot \ left \ {{\ beta} _1 (0) - {\ beta} _2 \ left ({\ sigma} _ {meh}, 0 \ right) \ right \}}. $$ (8) $$ \ lambda \ left ({\ sigma} _ {meh}, D \ right) =e {\ mu} _p \ left ({\ sigma} _ {meh}, D \ right) \ cdot \ Большой ({\ displaystyle \ underset {0} {\ overset {w} {\ int}} {p} _1 \ left (y, D \ right) dy- w \ cdot {p} _2 \ left ({\ sigma } _ {meh}, D \ right) \ Big) =e {\ mu} _p \ left ({\ sigma} _ {meh}, D \ right) \ cdot \ left \ {{\ beta} _1 (D) - {\ beta} _2 \ left ({\ sigma} _ {meh}, D \ right) \ right \}}. $$ (9)Если образец имеет прямоугольную форму длиной ( l ) и шириной ( a ), мы можем записать окончательную формулу для полной поверхностной проводимости следующим образом:
$$ \ lambda \ left ({\ sigma} _ {meh}, D \ right) =\ frac {a} {l} e {\ mu} _p \ left ({\ sigma} _ {meh}, D \ right ) \ left \ {{\ beta} _1 (D) - {\ beta} _2 \ left ({\ sigma} _ {meh}, D \ right) \ right \}, $$ (10)где
$$ {\ beta} _1 (D) ={\ displaystyle \ underset {0} {\ overset {w} {\ int}} {p} _1 \ left (y, D \ right) dy, \ kern1em} {\ бета} _2 \ left ({\ sigma} _ {meh}, D \ right) =w \ cdot {p} _2 \ left ({\ sigma} _ {meh}, D \ right). $$ (11)Изменение поверхностной проводимости облученных кристаллов p-Si под действием механического напряжения в основном определяется изменением трех параметров: β 1 , β 2 , и μ p .
Согласно нашим предыдущим исследованиям [10,11,12,13], воздействие рентгеновского излучения на электронный кремний сопровождается небольшим увеличением положительного заряда в диэлектрическом поверхностном слое SiO 2 . В результате коэффициент β 1 : β 1 ( Д )> β 1 ( 0 ) немного увеличивается. Для «солнечного» кремния наблюдаются противоположные зависимости: β 1 ( Д ) < β 1 ( 0 ).
По фактору β 2 , его изменения в основном определяются изменением p 2 ( σ меня , D ) при радиационном воздействии. Эти изменения намного более существенны по сравнению с изменением параметра β 1 . Рентгеновское облучение вызывает образование точечных дефектов в кремнии, которые действуют как стопоры для движения дислокаций. В результате после воздействия радиации коэффициент β 2 для этих образцов резко уменьшается (уменьшается количество захваченных дислокаций дырок) для обоих типов экспериментальных образцов p-Si: β 2 ( Д ) < β 2 ( 0 ).
В необлученных кристаллах «солнечного» кремния существующие дефекты, которым соответствуют четырехугольные пирамидальные ямки травления, играют роль стопоров для движения дислокаций. Дополнительные дефекты, возникшие в результате облучения, не играли существенной роли на фоне сильной концентрации существующих поверхностных дефектов.
Подвижность дырок несколько снижается при воздействии излучения из-за увеличения рассеяния на радиационных дефектах: μ p ( Д ) < μ p ( 0 ). Этим механизмом можно объяснить экспериментально подтвержденное уменьшение проводимости облученных образцов кремния. Таким образом, анализ формул (8) и (9) подтверждает рост сопротивления при увеличении величины поглощенной дозы рентгеновского излучения в основном за счет снижения подвижности ( μ p ( Д ) < μ p ( 0 )) и концентрации свободных носителей заряда - дырок ( β 2 ( Д ) < β 2 ( 0 )).
Если рассматривать данные уравнения при фиксированной дозе, можно сделать следующие выводы, подтверждающие приведенные выше экспериментальные зависимости устойчивости к механическому воздействию:
- 1.
Сопротивление необлученных образцов электронного кремния увеличивается при сжатии (рис. 2). Это происходит из-за значительного роста фактора β 2 под действием механических нагрузок. При сжатии изменение (рост) фактора β 2 значительно превышает изменение (увеличение) подвижности отверстий при увеличении механического напряжения. Что касается параметра β 1 , его значение не зависит от σ меня .
Итак, в нашем случае увеличение сопротивления (сжатие) и уменьшение (декомпрессия) нагрузки для необлученных кристаллов на основе электронного кремния можно объяснить движением дислокаций, захватывающих основные носители. В упруго деформированной кристаллической решетке возникают силы, вызывающие движение дефектов, коагуляцию кластеров и конденсацию кластеров на дислокациях [15]. Дефекты становятся центрами захвата основных носителей заряда, коагулируя в более крупные кластеры, такие как микропоры, кластеры кремния между узлами и примеси. Накопление дефектов в поверхностном слое кремния приводит к снижению его проводимости. Об этом свидетельствует соответствующий коэффициент роста β 2 в формуле для поверхностной проводимости.
- 2.
Сопротивление облученных образцов электронного кремния при сжатии меняется незначительно (рис. 3а). Это вызвано уменьшением изменения (роста) фактора β 2 , из-за затрудненного движения дислокации. Другими словами, взаимно конкурирующие изменения параметров β 2 и μ p соизмеримы при сжатии облученных образцов электронного кремния.
Уменьшение сопротивления электронных кристаллов кремния в сочетании с увеличением напряжения (рис. 3б) происходит за счет уменьшения продольной эффективной массы тяжелых дырок [16,17] и соответствующего увеличения их подвижности при сжатии. Об этом свидетельствует соответствующее увеличение подвижности μ . p в формуле для поверхностной проводимости.
- 3.
Сопротивление облученных и необлученных образцов солнечного кремния незначительно снижается при сжатии (рис. 4). Для этих экспериментальных образцов процесс движения дислокации очень затруднен. Более того, дополнительные дефекты, перемещающиеся от середины к поверхности кремния, вносят несущественный вклад в перенос тока на фоне высокой концентрации существующих поверхностных дефектов в кристаллах солнечного кремния. Воздействие излучения дополнительно увеличивает концентрацию поверхностных дефектов в кристаллах солнечного кремния. Таким образом, взаимно конкурирующие изменения параметров β 2 и μ p соизмеримы при сжатии облученных и необлученных образцов солнечного кремния.
Воздействие излучения (рис. 4б) дополнительно увеличивает концентрацию поверхностных дефектов в кристаллах солнечного кремния. Следовательно, дополнительные дефекты, которые перемещаются за счет геттерирования, вносят меньший вклад в перенос тока, чем для необлученных кристаллов.
Выводы
При механической нагрузке необходимо учитывать два основных фактора, которые влияют на сопротивление кристалла p-Si. Первый фактор - это увеличение сопротивления при увеличении нагрузки (сжатие) и уменьшение сопротивления при уменьшении нагрузки (разжатие) из-за процесса движения дислокаций, захватывающего основные носители. Второй фактор - уменьшение сопротивления кристаллов кремния с увеличением нагрузки за счет уменьшения эффективной массы дырок и соответствующего увеличения их подвижности.
Рентгеновское облучение вызывает образование вакансий и межузельных атомов в кремнии, которые действуют как стопоры для движения дислокаций. Из-за увеличения рассеяния радиационных дефектов подвижность дырок при рентгеновском облучении несколько снижается. В необлученных кристаллах солнечного кремния существующие дефекты играют роль стопоров для движения дислокаций.
Предварительно облученные экспериментальные кристаллы p-Si (электронный и «солнечный» кремний) обладают свойством незначительно изменять свое удельное сопротивление (± 0,2%) под действием одноосного сжатия (скорость приложения напряжения 8 мк / мин) в пределах упругая деформация вдоль потока [\ (11 \ overline {2} \)].
В предварительно облученных образцах электронного кремния p-типа зависимость сопротивления от одноосного механического напряжения существенно зависит от скорости сжатия. При низкой скорости приложения напряжения (8 мкм / мин) сопротивление возрастает с увеличением механического напряжения; на высоких скоростях (32 мкм / мин) уменьшается. Для кристаллов на основе солнечного кремния p-типа зависимость сопротивления при механической нагрузке не зависит от степени сжатия.
Сокращения
- ρ ( σ ):
-
Изменение наведенной механической проводимости вдоль направления деформации
Наноматериалы
- Кремний
- Сменить машину
- Отображение атомов на двумерных атомных кристаллах в жидкостях
- Нанокремний для производства водорода
- Нанографема, гибкая прозрачная память на основе кремния
- Поверхностный эффект на транспортировку нефти в наноканале:исследование молекулярной динамики
- Трибохимический износ безоксида кремния, зависящий от скорости скольжения,
- Синтез композита из электропроводных кремнеземных нановолокон / наночастиц золота с помощью лазерных импуль…
- Зависимость локализованного поверхностного плазмонного резонанса от смещенного усеченного димера наноприз…
- Аморфные кремниевые нанопроволоки, выращенные на пленке оксида кремния путем отжига



