Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на подложках, покрытых Pt и TiN, изготовленных методом атомно-послойного осаждения
Аннотация
HfO 2 / TiO 2 / HfO 2 Устройства с трехслойной резистивной оперативной памятью (RRAM) были изготовлены на Si-подложках, покрытых Pt и TiN, с верхними электродами из Pt методом осаждения атомных слоев (ALD). Исследовано влияние нижних электродов из Pt и TiN на резистивные коммутационные свойства блоков с трехслойной структурой. Оба Pt / HfO 2 / TiO 2 / HfO 2 / Pt и Pt / HfO 2 / TiO 2 / HfO 2 / TiN демонстрируют типичное биполярное резистивное переключение. Доминирующими механизмами проводимости в состояниях с низким и высоким сопротивлением (LRS и HRS) обеих ячеек памяти являются омическое поведение и ток, ограниченный пространственным зарядом, соответственно. Установлено, что нижние электроды из Pt и TiN имеют большое влияние на предпочтение полярности гальванопластики, соотношение высокого и низкого сопротивления и дисперсию рабочих напряжений ячеек памяти с трехслойной структурой. По сравнению с использованием симметричных верхних / нижних электродов из платины, ячейки RRAM, в которых используются асимметричные верхние / нижние электроды из Pt / TiN, показывают меньшее отрицательное формирующее напряжение --3,7 В, относительно узкое распределение напряжений установки / сброса и более низкое соотношение высокого и низкого сопротивлений, равное 10. 2 . Электрод-зависимая полярность гальванопластики может быть интерпретирована с учетом химической активности электродов по отношению к кислороду, связанных реакций на аноде и неоднородного распределения концентрации кислородных вакансий в трехслойной структуре HfO 2 / TiO 2 / HfO 2 на Si, покрытом Pt и TiN. Более того, для Pt / HfO 2 / TiO 2 / HfO 2 / TiN-электроды, TiN-электрод в качестве резервуара для кислорода играет важную роль в снижении формирующего напряжения и улучшении однородности параметров резистивного переключения.
Фон
Резистивная память с произвольным доступом (RRAM) привлекла большое внимание из-за ее потенциала для замены флэш-памяти в энергонезависимой памяти следующего поколения [1,2,3]. Явление резистивного переключения (RS) широко обнаружено в оксидах переходных металлов, твердых электролитах и органических полимерах [4,5,6,7]. Устройства RRAM на основе оксидов переходных металлов широко исследуются из-за их простого состава и совместимости обработки с традиционным производством дополнительных металл-оксид-полупроводник (CMOS) [8,9,10]. Филаментная модель миграции кислородных вакансий используется для объяснения поведения переключения [1, 11]. Предлагается единый микроскопический принцип для количественной оценки как униполярных, так и биполярных характеристик переключения RRAM на основе оксидов переходных металлов, которые коррелируют с распределением локализованных кислородных вакансий в слое переключения оксидов [12, 13].
Однако ячейки памяти, в которых используются оксиды переходных металлов, страдают от неоднородности параметров резистивного переключения, таких как нестабильные значения сопротивления в состояниях с низким и высоким сопротивлением (LRS и HRS), рассредоточенные напряжения установки и сброса, что затрудняет коммерческое применение. Недавно было продемонстрировано, что устройства RRAM на основе оксида с трехслойной структурой улучшают разброс параметров резистивного переключения. Ячейки со структурой Al 2 О 3 / HfO 2 / Al 2 О 3 продемонстрировал фантастическую однородность напряжения установки и сброса, а также отличную устойчивость при переключении между LRS и HRS [14]. Связывание или разрыв проводящих нитей легче происходило в двух межфазных слоях между Al 2 О 3 / IL / HfO 2 / IL / Al 2 О 3 . Между тем, блок трехслойной структуры TaO x / TiO 2 / TaO x показали хорошие характеристики в матрице резисторов типа один селектор-один, что было приписано тому факту, что энергетический диапазон TiO 2 пленка была симметрично изогнута вверху и внизу TaO x / TiO 2 поверхности раздела и модифицирован как гребенчатый оксидный барьер из-за диффузии некоторых атомов Ta в TiO 2 фильм [15].
Более того, на поведение RS данной оксидной накопительной среды могут существенно влиять электродные материалы [1, 16, 17]. Однако существующих моделей, основанных на свободной энергии образования оксида на границе раздела фаз и работе выхода металла, недостаточно для полного объяснения результатов. Между тем, работы по изучению явления RS, зависящего от электродов, в RRAM с трехслойной структурой в настоящее время также практически отсутствуют.
Осаждение атомного слоя (ALD) - это новый тип технологии осаждения тонких пленок, основанный на последовательных самоограниченных и дополнительных реакциях хемосорбции на поверхности с использованием пара прекурсора с простым и точным контролем толщины, однородностью большой площади и превосходной трехмерной конформностью, особенно для осаждения. наноламинированной структуры [18, 19].
В этой работе HfO 2 / TiO 2 / HfO 2 Устройства RRAM с трехслойной структурой были изготовлены на Si / SiO 2 Подложки / Ti / Pt и Si / TiN с верхними электродами из Pt методом ALD. Влияние нижних электродов из Pt и TiN на поведение RS HfO 2 / TiO 2 / HfO 2 устройства были тщательно исследованы. Было предложено связанное объяснение.
Методы
В этом эксперименте мы использовали два разных нижних электрода, включая коммерческий Si / SiO 2 . / Ti / Pt и самодельный Si / SiO 2 /Банка. Проводящий TiN был нанесен методом плазменного осаждения атомных слоев (PEALD) в нашей лаборатории.
ALD выполнялась в коммерческой программе Picosun SUNALE TM Усовершенствованный реактор Р-200 (Picosun, Финляндия). P В качестве исходных подложек использовались пластины типа Si (100) с удельным сопротивлением 1 ~ 10 Ом · см. После обычной очистки пластин Si методом RCA без удаления естественного оксида, TiN толщиной 30 нм был нанесен на Si в качестве нижнего электрода при 400 ° C с помощью PEALD с использованием TiCl 4 комнатной температуры. и NH 3 плазменный газ в качестве прекурсоров Ti и N соответственно. Жидкий NH 3 был выбран как NH 3 источник плазмы при комнатной температуре. Мощность плазмы и NH 3 расход газа составлял 2500 Вт и 150 куб. см соответственно.
Впоследствии 5 нм HfO 2 / 10 нм TiO 2 / 5 нм HfO 2 Укладочные структуры осаждали по очереди на Si-подложки, покрытые Pt и TiN, при 250 ° C с помощью термического ALD с использованием Hf [N (C 2 H 5 ) CH 3 ] 4 (TEMAH), TiCl 4 , и H 2 O в качестве предшественников Hf, Ti и O соответственно, где один оксидный цикл состоит из 0,1 с закачка источника металла, 4 с N 2 продувка, 0,1 с H 2 O впрыск и 4 s N 2 продувка. ТЕМАГ упаривали при 150 ° С. Чистый N 2 (99,999%) использовался в качестве газа-носителя и продувочного газа. Затем на верхние платиновые электроды толщиной 100 нм напыляли постоянным током через теневую маску диаметром 150 мкм с использованием системы Q150T.
Рост за цикл (GPC) чистого HfO 2 или TiO 2 на Si определяли спектроскопическим эллипсометром (ГЭС-5, Sopra). Топография и шероховатость поверхности пленок и нижних электродов были проанализированы с помощью атомно-силовой микроскопии (AFM, Cypher, Asylum Research). Среднеквадратичные (RMS) значения шероховатости регистрировались с площадей размером 1 мкм × 1 мкм. Состав и химическое состояние пакетных структур исследовали с помощью рентгеновской фотоэлектронной спектроскопии (XPS, Thermo Fisher K-Alpha) с монохроматическим Al K α источник (hν =1486,6 эВ) для возбуждения фотоэлектронов. Эффект заряда был откалиброван установкой C 1 s фотоэмиссия при 284,6 эВ. Профиль глубины XPS HfO 2 / TiO 2 / HfO 2 на Si, покрытом Pt и TiN, получали ионным травлением Ar. Электрические свойства HfO 2 / TiO 2 / HfO 2 Устройства RRAM с трехслойной структурой измерялись системой определения характеристик полупроводников Keithely 4200 на станции датчиков (CasCade Summit 12000 B-M). Соответствие току 10 мА было введено для защиты изготовленных узлов устройства от повреждений сильным током во время процессов установки. Напряжение смещения подавалось на верхний электрод Pt с заземленными нижними электродами из Pt или TiN.
Результаты и обсуждение
Схема устройства RRAM HfO 2 / TiO 2 / HfO 2 Трехслойная структура, полученная методом ALD, проиллюстрирована на рис. 1. Морфология поверхности и шероховатость нижних электродов и трехслойная структура HfO 2 / TiO 2 / HfO 2 на Si, покрытом Pt и TiN. Нижний платиновый электрод имеет меньшее среднеквадратичное значение 0,39 нм, чем TiN, полученный из PEALD, равный 0,87 нм. Следовательно, образец HfO 2 / TiO 2 / HfO 2 Si, покрытый Pt, также имеет относительно более гладкую поверхность со среднеквадратичным отклонением 0,68 нм, чем поверхность Si, покрытого TiN, толщиной 1,3 нм.
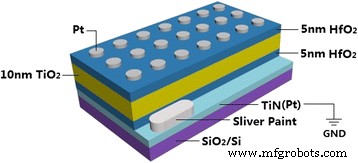
Схема устройства RRAM HfO 2 / TiO 2 / HfO 2 трехслойная структура от ALD
ВАХ постоянного тока для Pt / HfO 2 / TiO 2 / HfO 2 / Pt и Pt / HfO 2 / TiO 2 / HfO 2 Устройства / TiN, содержащие начальный процесс гальванопластики, показаны на рис. 2a, b соответственно, что указывает на типичную биполярную характеристику резистивного переключения. Почти для всех образцов требуется большее формовочное напряжение для образования проводящих нитей перед испытанием на переключение. При приложении положительного напряжения смещения на верхнем электроде Pt, Pt / HfO 2 / TiO 2 / HfO 2 Блок устройства / Pt показывает формирующее напряжение +7 В на рис. 2а. При продолжении качания напряжения измеряется напряжение сброса -0,8 В для единичной ячейки от LRS к HRS и заданное напряжение 2,0 В от HRS к LRS. Соответствующее соотношение высокого и низкого сопротивлений составляет примерно 10 5 . . Процесс гальванопластики и покоя также может быть завершен путем подачи отрицательного напряжения -11 В и положительного напряжения +4 В, соответственно, что намного больше, чем положительное формирующее и отрицательное напряжения сброса. Более того, ячейка устройства переключается с LRS на HRS только в течение нескольких циклов после процесса отрицательного формирования, а затем не может выполнить сброс на HRS из-за необратимой поломки (здесь не показано). На рис. 2b, по сравнению с симметричными верхним и нижним электродами из Pt, устройства RRAM с трехслойной структурой с асимметричным нижним электродом из TiN и верхним электродом из Pt показывают противоположное нижнее формирующее напряжение около -3,7 В, заданное напряжение -1,5 В. , напряжение сброса +1,5 В и относительно меньшее соотношение высокого и низкого сопротивлений 10 2 . При приложении положительного напряжения гальванопластики явление RS не может наблюдаться в Pt / HfO 2 / TiO 2 / HfO 2 Ячейка / TiN и устройство постоянно выходят из строя при +14 В без последующего эффективного сброса с LRS на HRS при отрицательном напряжении (здесь не показано).
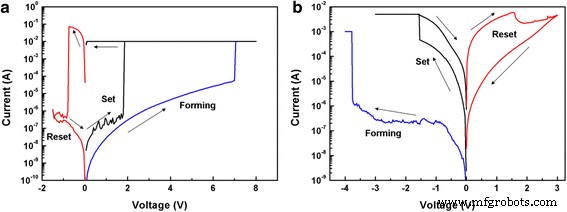
Типичные характеристики биполярного резистивного переключения устройств RRAM. а Pt / HfO 2 / TiO 2 / HfO 2 / Pt. б Pt / HfO 2 / TiO 2 / HfO 2 / TiN
Устройства RRAM с трехслойной структурой с симметричными верхним / нижним электродами из Pt и асимметричным нижним электродом из TiN / верхними электродами из Pt демонстрируют такое различное предпочтение полярности гальванопластики. Ключевую роль играет нижний электрод из химически инертной Pt или относительно активного TiN. Связанная с этим причина полярности электролитической формовки, зависящей от электродов, будет обсуждаться позже после рассмотрения профилей глубины XPS трехслойных структур HfO 2 / TiO 2 / HfO 2 на Si, покрытом Pt и TiN
Для приложений с высокой плотностью памяти очень важна единообразие параметров RS. На рис. 3a, b показаны статистические результаты распределения напряжений срабатывания и сброса, измеренных с одного устройства Pt / HfO 2 . / TiO 2 / HfO 2 / Pt и Pt / HfO 2 / TiO 2 / HfO 2 / TiN для 200-кратных испытаний соответственно. На рис. 3c, d записаны ВАХ 10 случайно выбранных единиц устройства Pt / HfO 2 / TiO 2 / HfO 2 / Pt и Pt / HfO 2 / TiO 2 / HfO 2 / TiN соответственно. Устройства RRAM с трехслойной структурой с симметричными верхним и нижним электродами из Pt демонстрируют широкое распределение для заданного напряжения от 1,2 до 2,8 В и напряжения сброса от −0,5 до −1 В (рис. 3a) и дисперсионных ВАХ (рис. 3в). В то же время блоки устройства с асимметричными нижними электродами из TiN и верхним Pt-электродами демонстрируют лучшее поведение RS, такое как относительно концентрированное распределение установленного напряжения от −0,8 до −1,8 В и напряжения сброса от 1,3 до 1,8 В, а также стабильную воспроизводимость на ВАХ. (Рис. 3б, г). В то же время, по сравнению с устройствами на Si, покрытом Pt, различные устройства на Si, покрытом TiN, также демонстрируют улучшенную монодисперсию параметров RS, что способствует практическому применению RRAM.

Статистические результаты распределения уставок и сбросов напряжений, измеренных с одного устройства в 200-кратном испытании. а Pt / HfO 2 / TiO 2 / HfO 2 / Pt. б Pt / HfO 2 / TiO 2 / HfO 2 /Банка. ВАХ 10 случайно выбранных единиц устройства. c Pt / HfO 2 / TiO 2 / HfO 2 / Pt. г Pt / HfO 2 / TiO 2 / HfO 2 / TiN
Долговечность и удерживающие свойства единиц устройства Pt / HfO 2 / TiO 2 / HfO 2 / Pt и Pt / HfO 2 / TiO 2 / HfO 2 / TiN, как показано на рис. 4a – d, соответственно. В Pt / HfO 2 / TiO 2 / HfO 2 / Pt, напряжение качания подавалось от 0 до 3 В для установки и от 0 до -1,5 В для сброса. В Pt / HfO 2 / TiO 2 / HfO 2 / TiN, напряжение качания подавалось от 0 до -2 В для установки и от 0 до 2 В для сброса. Значения сопротивления включения и выключения считывались с использованием 0,2 В при комнатной температуре. Тесты на удерживание проводились при комнатной температуре с напряжением считывания 0,2 В. После 200 циклов программирования / стирания Pt / HfO 2 / TiO 2 / HfO 2 Устройства / Pt показывают относительно стабильное соотношение сопротивлений в состояниях ВЫКЛ / ВКЛ выше 10 5 (Рис. 4а); однако характеристики выносливости Pt / HfO 2 / TiO 2 / HfO 2 Ячейки памяти / TiN кажутся не такими хорошими, как у Pt / HfO 2 / TiO 2 / HfO 2 / Pt (рис. 4б). Состояния ВКЛ и ВЫКЛ в устройствах с электродами из Pt-TiN не очень устойчивы с меньшим соотношением сопротивлений состояний ВЫКЛ / ВКЛ около 10 2 . во время теста цикла переключения, особенно значительные колебания HRS, чем у LRS. На основе физической модели в [5]. [12], долговечность будет улучшена за счет увеличения энергии образования кислородной вакансии и границы раздела O 2− количество. Мы предполагаем одно правдоподобное объяснение. В нашей предыдущей работе [14] отличные биполярные резистивные коммутационные свойства Al 2 , полученного методом ALD, О 3 / HfO 2 / Al 2 О 3 Были продемонстрированы трехслойные структуры с асимметричными нижними электродами из TiN и верхними Pt электродами, в том числе улучшенная коммутационная стойкость до 10 3 циклы со стабильным соотношением сопротивлений ВКЛ / ВЫКЛ. Здесь мы приняли HfO 2 / TiO 2 / HfO 2 configure вместо Al 2 О 3 / HfO 2 / Al 2 О 3 . Ионы металлов в HfO 2 и TiO 2 имеют одинаковую химическую валентность +4, что приводит к менее заряженным дефектам интерфейса, таким как кислородные вакансии между двумя межфазными слоями (ИЖ) трехслойного HfO 2 / TiO 2 / HfO 2 . В то время как ионы металлов в Al 2 О 3 и HfO 2 имеют различную химическую валентность Al 3+ и Hf 4+ , создавая больше интерфейсных заряженных дефектов кислородных вакансий между двумя ИЖ Al 2 О 3 / HfO 2 / Al 2 О 3 . Можно сделать вывод, что интерфейс O 2− количество добавлением двух ИЖ между Al 2 О 3 / HfO 2 / Al 2 О 3 должно быть выше, чем между HfO 2 / TiO 2 / HfO 2 . Кроме того, энергия образования кислородной вакансии в накопительном слое Al 2 О 3 / HfO 2 / Al 2 О 3 также выше, чем у HfO 2 / TiO 2 / HfO 2 (энергия образования кислородной вакансии 7,08 эВ (Al 2 О 3 ), 6.53 эВ (HfO 2 ) и 4,35 эВ (TiO 2 ) [20, 21]). После рассмотрения этих факторов ячейка памяти Pt / HfO 2 / TiO 2 / HfO 2 / TiN демонстрирует снижение выносливости по сравнению с Pt / Al 2 О 3 / HfO 2 / Al 2 О 3 / TiN.

Выносливость и удерживающие характеристики единиц устройства. а , c Pt / HfO 2 / TiO 2 / HfO 2 / Pt. б , d Pt / HfO 2 / TiO 2 / HfO 2 / TiN.
Для Pt / HfO 2 / TiO 2 / HfO 2 / Pt и Pt / HfO 2 / TiO 2 / HfO 2 / TiN, уровень сопротивления состояний ВКЛ и ВЫКЛ не имеет явных изменений после совокупного времени ожидания 10 4 s при комнатной температуре на рис. 4c – d, что указывает на лучшую удерживающую способность обеих ячеек памяти в течение 10 лет на основе метода экстраполяции.
Pt / HfO 2 / TiO 2 / HfO 2 Устройства / TiN имеют гораздо более низкое соотношение сопротивлений в состояниях ВЫКЛ / ВКЛ, чем Pt / HfO 2 / TiO 2 / HfO 2 / Pt, что можно объяснить различием работы выхода и проводимости нижних электродов. Работа выхода нижних электродов из Pt и TiN составляет 5,65 и 4,5 эВ соответственно; следовательно, межфазный барьер между TiN и лежащим в основе HfO 2 относительно ниже по Pt / HfO 2 / TiO 2 / HfO 2 / Устройство TiN. Во время процесса сброса электронам также требуется меньше энергии, чтобы пересечь барьер. Итак, Pt / HfO 2 / TiO 2 / HfO 2 / TiN показывает более низкое значение сопротивления в выключенном состоянии, чем Pt / HfO 2 / TiO 2 / HfO 2 / Pt соответственно. В процессе установки устройство RRAM переходит из HRS в LRS из-за образования проводящих каналов. Нижний электрод из Pt имеет более высокую проводимость, чем нижний из TiN; соответственно, значение сопротивления во включенном состоянии для Pt / HfO 2 / TiO 2 / HfO 2 / TiN выше, чем для Pt / HfO 2 / TiO 2 / HfO 2 / Pt. В результате Pt / HfO 2 / TiO 2 / HfO 2 Устройства / TiN показывают меньшее соотношение сопротивлений в состояниях ВЫКЛ / ВКЛ, равное 10 2 . . Однако коэффициент сопротивления 10 2 уже отвечает требованиям приложений RRAM.
Чтобы прояснить механизм проводимости при резистивном переключении, типичные ВАХ построены в двойном логарифмическом масштабе. На рис. 5a, b показана линейная аппроксимация ВАХ для областей качания напряжения Pt / HfO 2 . / TiO 2 / HfO 2 / Pt и Pt / HfO 2 / TiO 2 / HfO 2 / Устройства TiN. Обе ячейки памяти ведут себя схожим проводящим механизмом. Когда устройство переключается на LRS, кривые log (I) -log (V) линейны с наклоном, близким к 1 (0,94 на рис. 5a, 0,98 на рис. 5b), что указывает на то, что I – V на LRS подчиняется закону Ома. Филаментная модель миграции кислородных вакансий может быть использована для объяснения поведения переключения. Для HRS в области низкого напряжения (абсолютное значение <0,11 В) в I – V преобладает закон Ома с линейной зависимостью тока и напряжения (наклон 1,05 на рис. 5a, 1,09 на рис. 5b). В области более высокого напряжения (6,8 В> абсолютное значение> 0,11 В на рис. 5a, 1,85 В> абсолютное значение> 0,11 В на рис. 5b) наклон линий log (I) -log (V) составляет около 2 и ток зависит от приблизительного квадрата приложенного напряжения (I / V 2 ). При критическом напряжении (абсолютное значение 6,8 В на рис. 5a, 1,85 В на рис. 5b) внезапно появляется резкий рост тока с очень большим наклоном. Этот результат состоит из трех областей в HRS, в основном подчиняющихся типичной инъекции, контролируемой ловушкой, ограниченной пространственным зарядом (SCLC) [11].
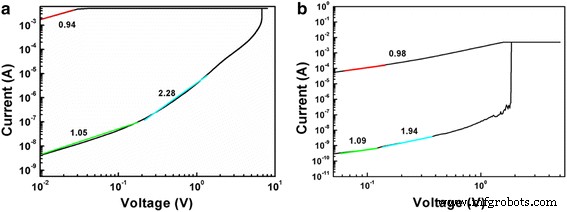
Типичные ВАХ, построенные в двойном логарифмическом масштабе a Pt / HfO 2 / TiO 2 / HfO 2 / Pt и b Pt / HfO 2 / TiO 2 / HfO 2 / TiN
Чтобы лучше понять лежащий в основе резистивный механизм переключения HfO 2 / TiO 2 / HfO 2 На Si с покрытием Pt и TiN мы выполнили узкое сканирование XPS и анализ глубины на трехслойных структурах с симметричными и асимметричными нижними / верхними электродами. Спектры XPS были подогнаны к функциям Гаусса-Лоренца (G-L) после вычитания фона интеллектуального типа.
На рис. 6a – d показаны XPS-спектры Hf 4 f с узким сканированием. , Ti 2 p , и O 1 s пики в HfO 2 и TiO 2 слоев на Si, покрытом TiN. Модель Hf 4 f и Ti 2p спектры от HfO 2 и TiO 2 слои можно разложить на две группы пиков. Более сильный Hf 4 f 5/2 и Hf 4 f 7/2 пики при 18,4 и 16,7 эВ со спин-орбитальным расщеплением 1,7 эВ отнесены к связи Hf – O (Hf 4+ ) из HfO 2 (Рис. 6а). Более слабые пики спин-орбитального дублета при более низкой энергии связи 17,6 и 14,8 эВ, возможно, являются результатом низкохимического валентного состояния Hf n + –O ( n <4), что свидетельствует о наличии кислородных вакансий в HfO 2 слой. Расчетная процентная концентрация Hf n + ( нет <4) составляет около 3,7% в ионах Hf. На рис. 6б более сильный дублет соответствует Ti 2 p 3/2 и 2 p 1/2 при 458,8 и 464,5 эВ, принадлежащих связи Ti – O (Ti 4+ ) из TiO 2 . Более слабый дублет находится при 456,1 и 462,0 эВ, что соответствует Ti 3+ –O соединение. Расчетная процентная концентрация Ti 3+ составляет около 21% в ионах Ti. Это означает наличие кислородных вакансий в TiO 2 . слой.
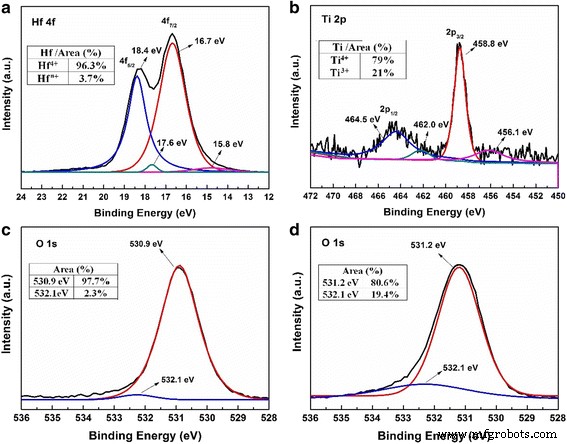
XPS-спектры узкого сканирования от трехслойной структуры HfO 2 / TiO 2 / HfO 2 на Si, покрытом TiN. а Hf 4f, b Ti 2 p пики HfO 2 / TiO 2 / HfO 2 O 1 с пики c HfO 2 и d TiO 2 слои
О 1 s спектры от HfO 2 и TiO 2 слои также можно деконволютировать на два пика, как показано на рис. 6c, d. Относительно более низкие энергии связи O 1 s пик при ~ 530,9 и 531,2 эВ относится к связи Ti-O и Hf-O в TiO 2 и HfO 2 слоев, соответственно, принадлежащих решеточному кислороду без кислородных вакансий. В то время как немного более высокая энергия 532,1 эВ в O 1 s Спектры рис. 6в, г приписываются атомам кислорода вблизи кислородных вакансий в HfO 2 и TiO 2 слои на основе литературных отчетов [22,23,24,25]. Относительную концентрацию кислородных вакансий в оксидном слое можно приблизительно оценить, вычислив долю площади каждого пика [22, 23]. Расчетная процентная концентрация кислородной вакансии в HfO 2 и TiO 2 слоев составляет около 2,3 и 19,4% соответственно, в соответствии с результатами Hf n + и Ti 3+ .
На рис. 7a, b показаны профили глубины HfO 2 с помощью XPS. / TiO 2 / HfO 2 образцы на Si, покрытом Pt и TiN, ионным травлением Ar соответственно. Трехслойная структура HfO 2 / TiO 2 / HfO 2 на Si, покрытом Pt и TiN, можно легко распознать, хотя значительная межфазная диффузия между HfO 2 / TiO 2 и HfO 2 / TiN наблюдается. Обычно филаментная модель миграции кислородных вакансий доминирует в поведении КР в устройствах RRAM на основе оксидов переходных металлов [11]. Однако простое увеличение содержания кислородных вакансий не полностью эффективно. Как эффективно контролировать распределение нитей кислородных вакансий - ключевой вопрос для окончательного улучшения однородности RS [20]. Многочисленные исследования показали, что обычно неравномерное распределение кислородных вакансий благоприятно сказывается на поведении RS, включая снижение формирующего напряжения, улучшение стабильности переключения и выносливости [1, 14, 20, 26, 27, 28, 29]. Первоначальное неоднородное распределение кислородных вакансий в слое накапливающего оксида часто достигается за счет использования химически активного электрода с относительно высоким сродством к кислороду (например, Ta, Ti, Al или TiN) или путем преднамеренного введения богатого кислородными вакансиями электрода. межфазный слой путем проектирования интерфейсов [1, 17, 30].
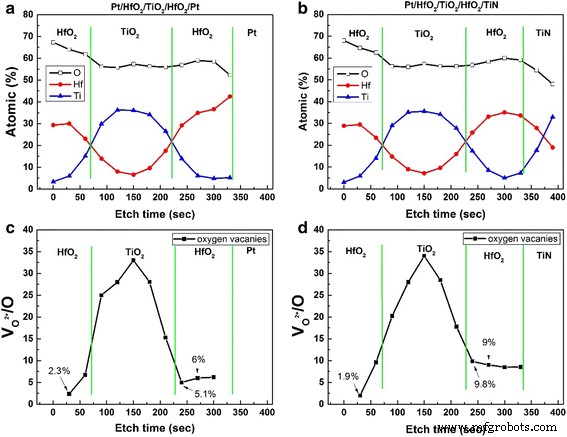
Профили глубины XPS HfO 2 / TiO 2 / HfO 2 на Si, покрытом Pt и TiN, методом ионного травления. а HfO 2 / TiO 2 / HfO 2 на Si, покрытом Pt. б HfO 2 / TiO 2 / HfO 2 на Si, покрытом TiN. Распределение концентрации кислородных вакансий по глубине ( V О 2+ / O) определено из спектров РФЭС для HfO 2 / TiO 2 / HfO 2 на Si, покрытом Pt и TiN. c HfO 2 / TiO 2 / HfO 2 на Si, покрытом Pt. г HfO 2 / TiO 2 / HfO 2 на Si с покрытием TiN
На рис. 7в, г представлены кривые распределения концентрации кислородных вакансий HfO 2 . / TiO 2 / HfO 2 на Si, покрытом Pt и TiN, на основе указанных выше профилей XPS по глубине соответственно. Концентрация кислородных вакансий оценивалась указанным выше методом. Обнаружено, что наибольшая концентрация кислородных вакансий (~ 34%) наблюдается в TiO 2 . промежуточный слой. Еще одна примечательная особенность заключается в том, что лежащий в основе HfO 2 слой около нижних электродов Pt или TiN имеет более высокую концентрацию кислородных вакансий, чем верхний HfO 2 слой (~ 2%). Кроме того, концентрация кислородных вакансий (~ 9%) нижележащего HfO 2 слой на Si, покрытом TiN, очевидно выше, чем (~ 6%) на Si, покрытом Pt.
На рисунке 8 показаны принципиальные схемы гальванопластики и сброса Pt / HfO 2 . / TiO 2 / HfO 2 / Pt при положительном и отрицательном напряжениях смещения. Для химически инертных платиновых верхнего и нижнего электродов явления гальванопластики, зависящие от полярности смещения, связаны с O 2 газ, выделяющийся из оксидного слоя на аноде как продукт электровосстановления. Как известно, во время процесса гальванопластики кислородные вакансии создаются сильным электрическим полем и мигрируют к катоду, образуя локализованные проводящие нити в оксидном слое, то есть O О → V О 2+ + O 2– , V О 2+ + 2 e - → V О [12] (рис. 8б, д). Одновременно O 2− ионы дрейфуют к аноду, высвобождая свой заряд и выделяя O 2 газ, т.е. O 2– → 1/2 O 2 + 2 e - (Рис. 8б, д), которые могут вызвать физическую деформацию ячейки и даже образование трещины или отверстия [31]. При подаче положительного формирующего напряжения на верхний электрод Pt мы постулируем O 2 газ, выпущенный над верхним слоем HfO 2 пленка легко выходит на краю верхнего электрода или через небольшие нанопоры в верхнем электроде из Pt (рис. 8b), что вызывает слабую физическую деформацию. Между тем, учитывая относительно более высокую концентрацию кислородных вакансий в нижележащем HfO 2 (~ 6%) рядом с нижним платиновым электродом, чем верхний HfO 2 слоя (~ 2,3%) (рис. 7c), проводящая нить легко образуется, что приводит к меньшему положительному формирующему напряжению +7 В. При обратном напряжении −0,8 В обратная реакция приводит к разрыву нити накала, и устройство перестает работать. легко переключился обратно в состояние HRS (рис. 8d).

Принципиальные схемы гальванопластики и сброса трехслойной структуры HfO 2 / TiO 2 / HfO 2 с симметричными верхним и нижним электродами из платины. а - г Электроформование при положительном напряжении и сброс при отрицательном напряжении. е - г Электроформование при отрицательном напряжении и сброс при положительном напряжении
И наоборот, при отрицательном формирующем напряжении на верхнем электроде газообразный кислород образуется под нижележащим HfO 2 . слой и выше Pt нижний электрод (рис. 8д). О 2 высвобождение становится более трудным, что препятствует образованию токопроводящих нитей. Более того, поскольку концентрация кислородных вакансий в верхнем слое HfO 2 слой (~ 2,3%) ниже, чем у нижележащего HfO 2 (~ 6%) (рис. 7c), более высокое отрицательное формирующее напряжение -11 В необходимо для формирования волокон. Когда больше O 2 накапливается до определенного давления под нижележащим HfO 2 , возможно, он извергается из наиболее механически слабой части тонких пленок, что приводит к образованию дыр в оксидных пленках или к разделению оксидных пленок и нижнего электрода, вызванному растрескиванием пузырьков. Хотя устройство можно сбросить в режим HRS при подаче напряжения смещения +4 В (рис. 8g), размер ячейки памяти ухудшается после нескольких циклов переключения. В наших образцах после формовки часть верхнего электрода оторвалась. Подобный сценарий предпочтения полярности гальванопластики также наблюдался в Pt / TiO 2− x / Pt биполярные клетки RRAM с различной физической деформацией, свидетельствующей о переходах [31, 32].
Pt / HfO 2 / TiO 2 / HfO 2 / Устройства TiN демонстрируют совершенно иную полярность гальванопластики, чем Pt / HfO 2 / TiO 2 / HfO 2 / Pt. LRS, вызванная гальванопластикой, может наблюдаться как при отрицательном, так и при положительном напряжении смещения; однако эффективный сброс с LRS на HRS может быть достигнут только при положительном напряжении смещения в Pt / HfO 2 / TiO 2 / HfO 2 / Устройство TiN. Подобное предпочтение гальванопластики с асимметричными электродами из Pt и TiN наблюдалось в некоторых публикациях с различными слоями накопительного оксида, такими как HfO 2 [33, 34], TiO 2 [35], ZrO x / HfO y бислой [22], и Al 2 О 3 / HfO 2 / Al 2 О 3 трехслойный [14]. Однако соответствующие объяснения расходятся или отсутствуют.
После рассмотрения химической активности TiN-электрода по отношению к кислороду [1, 30, 36] и нераспределения концентрации кислородных вакансий в трехслойной структуре HfO 2 / TiO 2 / HfO 2 на основе профилей глубины XPS (рис. 7), возможный механизм предпочтения полярности гальванопластики Pt / HfO 2 / TiO 2 / HfO 2 / Предлагаются элементы TiN. На рисунке 9 показаны принципиальные схемы гальванопластики и сброса Pt / HfO 2 . / TiO 2 / HfO 2 / TiN при отрицательном и положительном напряжениях смещения. Нижний электрод из TiN играет ключевую роль в полярности гальванопластики. Kwak et al. сообщил, что относительно активный электрод TiN будет легко поглощать ионы кислорода из оксидных пленок с образованием TiO x N 1− x (TiON) межфазный слой [36]. Сильная диффузия кислорода нижележащего HfO 2 слой в нижний электрод TiN был подтвержден в нашем образце профилем глубины XPS (рис. 7b). Для Pt / HfO 2 / TiO 2 / HfO 2 / TiN, электрод из TiN с высоким сродством к кислороду [34, 36] создает множество кислородных вакансий в нижележащем HfO 2 слой у нижнего электрода TiN. Концентрация кислородных вакансий ~ 9% от нижележащего HfO 2 слой намного выше, чем ~ 6% в Pt / HfO 2 / TiO 2 / HfO 2 / Pt устройство.
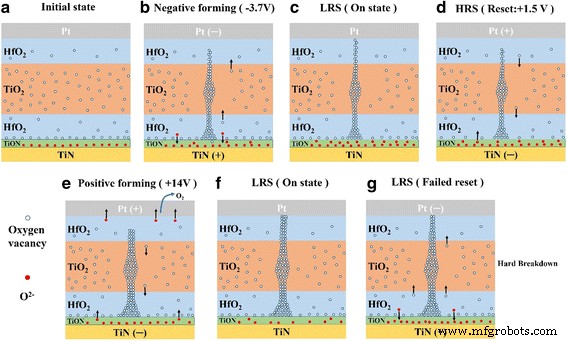
Принципиальные схемы гальванопластики и сброса трехслойной структуры HfO 2 / TiO 2 / HfO 2 с асимметричным верхним электродом из Pt и нижним электродом из TiN. а - г Электроформование при отрицательном напряжении и сброс при положительном напряжении. е - г Электроформование при положительном напряжении и сброс при отрицательном напряжении
Для химически инертного верхнего электрода из Pt и относительно активного нижнего электрода из TiN при подаче отрицательного формирующего напряжения O 2- ионы дрейфуют к аноду TiN и поглощаются с образованием TiO x N 1− x слой (рис. 9б), т.е. TiN + x O 2 - → TiO x N 1-x + x 2 e , избегая O 2 высвобождение и возможное повреждение клеток. Электрод из TiN может действовать как резервуар для ионов кислорода, дрейфующих под действием приложенного напряжения [1, 36]. Одновременно из-за более высокой кислородной вакансии в нижележащем HfO 2 слой (~ 9%) и промежуточный TiO 2 слой (~ 10–34%), чем верхний HfO 2 слой (~ 1.9%), миграция богатых кислородных вакансий из нижележащего HfO 2 слой через TiO 2 слой к верхнему HfO 2 слой, непосредственно производящий проводящие нити кислородных вакансий с меньшим формирующим напряжением -3,7 В (рис. 9b). При выполнении процесса обратного сброса при +1,5 В нижний электрод слоя TiN, действующий как резервуар кислорода, подает ионы кислорода для реакции с кислородной вакансией, то есть O 2 - + V О 2 + → О О (решеточный кислород), что полезно для операции сброса с LRS на HRS с разрывом проводящей нити (рис. 9d). Прежде всего, эффект резервуара кислорода нижнего электрода из TiN способствует снижению напряжения формования, а также лучшему изменению напряжения установки / сброса [1, 29, 36].
С другой стороны, при приложении положительного формирующего напряжения к верхнему электроду Pt кислородные вакансии мигрируют из верхнего слоя HfO 2 в основной HfO 2 на TiN, накапливаются поблизости и превращаются в нити. Из-за более низкой концентрации кислорода в верхних слоях HfO 2 (~ 1,9%), чем базовый HfO 2 слой (~ 9%) и промежуточный TiO 2 слоя (~ 10–34%), это приводит к дальнейшему увеличению концентрации кислородных вакансий в нижележащем HfO 2 и промежуточный TiO 2 слой. В то же время из-за небольшого присутствия кислорода в пленках TiN, полученных из PEALD (около 10%), некоторые ионы кислорода в TiN дрейфуют в нижележащий HfO 2 слой, чтобы сформировать изолирующий решеточный кислород с близлежащей кислородной вакансией, предотвращая рост проводящих нитей (рис. 9e). Наконец, когда напряжение смещения достигает +14 В, в оксидах образуются огрубляющиеся проводящие нити. Однако, когда на устройство подается отрицательное напряжение, проводящая нить в трехслойной структуре слишком велика, чтобы ее можно было разорвать (рис. 9g). Следовательно, устройство не может переключиться на HRS, подав отрицательное напряжение, что указывает на необратимый жесткий пробой в Pt / HfO 2 / TiO 2 / HfO 2 / Устройство TiN.
Наконец, в связи с тем, что вставленный TiO 2 в слое больше кислородных вакансий, чем в HfO 2 слой, распределение кислородных вакансий в трехслойной структуре неоднородно, особенно в двух межфазных слоях между HfO 2 / IL / TiO 2 / IL / HfO 2 , что может повлиять на положение, направление роста и перекрытие проводящих нитей. Связывание или разрыв проводящих нитей соответствует процессу установки от HRS к LRS или процессу сброса от LRS к HRS, соответственно, что легче происходит в двух межфазных слоях. Кроме того, форма и положение проводящих нитей в HfO 2 и TiO 2 слои меньше меняются в процессах установки и сброса.
Выводы
Таким образом, устройства RRAM на основе трехуровневой структуры Pt / HfO 2 / TiO 2 / HfO 2 / Pt и Pt / HfO 2 / TiO 2 / HfO 2 / TiN были подготовлены ALD. Обе ячейки памяти демонстрируют типичные биполярные резистивные коммутационные характеристики и доминирующие механизмы проводимости омического и SCLC в LRS и HRS, соответственно. Установлено, что нижние электроды из Pt и TiN имеют большое влияние на предпочтение полярности гальванопластики, соотношение высокого и низкого сопротивлений и дисперсию рабочего напряжения ячеек памяти с трехслойной структурой. По сравнению с симметричными верхними / нижними электродами из Pt, ячейки RRAM с асимметричными верхними / нижними электродами из Pt / TiN демонстрируют меньшее отрицательное формирующее напряжение -3,7 В, относительно узкое распределение рабочих напряжений установки / сброса и более низкое соотношение высокого и низкого сопротивлений 10 2 . Электрод-зависимая полярность гальванопластики может быть объяснена рассмотрением химической активности электродов по отношению к кислороду, соответствующих реакций на аноде и неоднородного распределения концентрации кислородных вакансий в трехслойной структуре HfO 2 / TiO 2 / HfO 2 на Si, покрытом Pt и TiN. Кроме того, электрод из TiN как резервуар кислорода играет важную роль в формировании снижения напряжения и лучшего разброса параметров RS для Pt / HfO 2 / TiO 2 / HfO 2 / Устройства TiN. Учитывая влияние модуляции электрода и трехслойной структуры на характеристики резистивной коммутации, эта работа обеспечивает новый путь проектирования устройств для будущих приложений RRAM.
Наноматериалы
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Модель удержания TaO / HfO x и TaO / AlO x RRAM с характеристиками самовосстанавливающегося переключателя
- Межфазные, электрические характеристики и характеристики совмещения полос стопок HfO2 / Ge с прослойкой SiO2, сфор…
- Иерархические антибактериальные полиамидные 6-ZnO нановолокна, полученные путем осаждения атомных слоев и гид…
- Интегрированная RRAM 4T SRAM с самоторможением резистивной коммутационной нагрузки с помощью логического процес…
- Влияние распределения наночастиц золота в TiO2 на оптические и электрические характеристики сенсибилизирован…
- Фотокаталитические свойства порошков TiO2 с покрытием Co3O4, полученных методом плазменного осаждения атомного …
- Настройка уровня Ферми пленок ZnO посредством суперциклического осаждения атомного слоя
- Коллективное исследование моделирования и имитации резистивной оперативной памяти
- Зависимость толщины от межфазных и электрических свойств в атомарном слое, нанесенном на GaN c-плоскости



