Резистивная память с произвольным доступом (RRAM):обзор материалов, механизма переключения, производительности, многоуровневого хранилища ячеек (MLC), моделирования и приложений
Аннотация
В этой рукописи рассказывается о последних достижениях в области технологии резистивной оперативной памяти (RRAM), которая считается одной из самых выдающихся новых технологий памяти благодаря ее высокой скорости, низкой стоимости, повышенной плотности хранения, потенциальным приложениям в различных областях и отличному качеству. масштабируемость всесторонне рассмотрена. Во-первых, дается краткий обзор области новых технологий памяти. Обсуждаются свойства материала, механизм переключения сопротивления и электрические характеристики RRAM. Также прорабатываются различные вопросы, такие как долговечность, удержание, однородность и влияние рабочей температуры и случайного телеграфного шума (RTN). Представлено обсуждение возможностей хранения многоуровневых ячеек (MLC) RRAM, которые привлекательны для достижения повышенной плотности хранения и низкой стоимости. Были предоставлены различные схемы работы для достижения надежной работы MLC, а также их физические механизмы. Кроме того, в этой работе содержится подробное описание методологий переключения и соотношения текущего напряжения для различных популярных моделей RRAM. Кратко рассматриваются перспективные применения RRAM в различных областях, таких как безопасность, нейроморфные вычисления и энергонезависимые логические системы. Настоящая обзорная статья завершается обсуждением проблем и будущих перспектив RRAM.
Введение
Память с произвольным доступом, называемая ОЗУ, может быть энергозависимой или энергонезависимой. Энергозависимая память теряет свои предыдущие сохраненные данные при отключении источника питания, как в случае динамической памяти с произвольным доступом (DRAM) и статической памяти с произвольным доступом (SRAM). В энергонезависимой памяти содержимое, которое было сохранено ранее, будет сохраняться даже после удаления источника. Флэш-память - типичный пример энергонезависимой памяти. Технологии памяти сочетают в себе преимущества и недостатки для достижения более высокой производительности, например DRAM, используемые в компьютерной системе, обладают высокой емкостью и плотностью, но они непостоянны, что означает необходимость обновления каждые несколько миллисекунд. Из-за этого обновления увеличивается потребление энергии устройством, что нежелательно. С другой стороны, SRAM работает быстро, но также энергозависимо, как и DRAM; Кроме того, ячейки SRAM имеют больший размер, что затрудняет их реализацию в больших масштабах. Флэш-память, которая по существу состоит из полевого транзистора металл-оксид-полупроводник (MOSFET) в дополнение к плавающему затвору в каждой ячейке памяти, в настоящее время широко используется, особенно для встраиваемых приложений, из-за ее низкой стоимости и высокой плотности. . В зависимости от того, как организованы ячейки памяти, Flash-память классифицируется как NOR Flash и NAND Flash [1]. В NOR Flash ячейки считываются и программируются индивидуально, поскольку они подключаются параллельно к битовым линиям. Это похоже на параллельное соединение транзисторов в архитектуре затвора CMOS NOR. В случае флэш-памяти NAND архитектура напоминает архитектуру логического элемента CMOS NAND, поскольку ячейки подключаются последовательно к битовым линиям. Следует отметить, что последовательное соединение занимает меньше места по сравнению с параллельным, что приводит к снижению стоимости флэш-памяти NAND. Однако оба типа флэш-памяти страдают рядом недостатков, таких как низкая скорость работы (время записи / стирания:1 мс / 0,1 мс), ограниченный срок службы (10 6 циклы записи / стирания) и высокое напряжение записи (> 10 В) [2].
Упомянутые выше технологии памяти, то есть DRAM, SRAM и Flash, являются запоминающими устройствами на основе заряда. DRAM хранит информацию в виде заряда на конденсаторе, а SRAM основана на хранении заряда в узлах инверторов с перекрестной связью, тогда как технология флэш-памяти использует плавающий затвор транзистора для хранения заряда. Все эти существующие технологии памяти на основе платных хранилищ в настоящее время сталкиваются с проблемами, связанными с масштабированием до узла 10 нм или выше. Это связано с потерей накопленного заряда в наномасштабе, что приводит к снижению производительности, надежности и запаса шума. Кроме того, требования большой динамической мощности обновления для DRAM и мощности утечки для SRAM и DRAM создают серьезные проблемы для проектирования будущей иерархии памяти.
Таким образом, новый класс памяти, обычно называемый развивающимися технологиями памяти, в настоящее время находится в стадии разработки и активно исследуется в первую очередь в отрасли с целью революционизировать существующую иерархию памяти [3]. Эти новые технологии памяти призваны объединить скорость переключения SRAM, плотность хранения, сравнимую с плотностью памяти DRAM, и энергонезависимость флэш-памяти, что делает их очень привлекательными альтернативами для будущей иерархии памяти.
Чтобы отнести запоминающее устройство к идеальному, оно должно обладать следующими характеристиками:низкое рабочее напряжение (<1 В), долговечность при длительной циклической работе (> 10 17 циклов), увеличенное время хранения данных (> 10 лет), низкое энергопотребление (фДж / бит) и превосходная масштабируемость (<10 нм) [4]. Однако на сегодняшний день нет ни одной памяти, которая бы удовлетворяла этим идеальным характеристикам. Различные новые технологии памяти активно исследуются, чтобы соответствовать части этих идеальных характеристик памяти. Эти технологии памяти, которые зависят от изменения сопротивления, а не заряда для хранения информации, следующие:(i) память с фазовым переходом (PCM), (ii) магниторезистивная память с произвольным доступом с передачей вращения (STT-MRAM) и ( iii) резистивная оперативная память (RRAM). В памяти с фазовым переходом коммутационная среда состоит из халькогенидного материала (обычно Ge 2 -Sb 2 -Те 5 , GST) [5–7]. PCM полагается на разницу в сопротивлении между кристаллической фазой и аморфной фазой для эффективного хранения данных. Кристаллическая фаза обозначает состояние с низким сопротивлением (LRS) или состояние ВКЛ устройства, тогда как аморфная фаза обозначает состояние с высоким сопротивлением (HRS) или состояние ВЫКЛ. Операция SET соответствует LRS, обычно относящейся к хранению логического значения «1», тогда как операция RESET соответствует сохранению логического значения «0» в устройстве HRS. Для операции SET PCM нагревается выше температуры кристаллизации при приложении импульса напряжения, в то время как для операции RESET через ячейку проходит больший электрический ток, который затем резко отключается, чтобы расплавить, а затем закалить материал, чтобы достичь аморфного состояния.
В магниторезистивной памяти с произвольным доступом с передачей крутящего момента способность хранения обеспечивается за счет магнитного туннельного перехода (MJT) [8–10], который состоит из двух ферромагнитных слоев и туннельного диэлектрика, зажатого между ними. Магнитное направление опорного слоя фиксировано, в то время как приложение внешнего электромагнитного поля может изменить магнитное направление свободного ферромагнитного слоя. Если опорный слой и свободный слой имеют одинаковое направление намагничивания, MTJ упоминается как LRS. Чтобы MTJ находился в HRS, направление намагничивания двух ферромагнитных слоев антипараллельно. RRAM состоит из изолирующего слоя (I), зажатого между двумя металлическими (M) электродами [11, 12]. RRAM основан на образовании и разрыве проводящих нитей, соответствующих LRS и HRS, соответственно, в изоляторе между двумя электродами [13–15].
Подробное сравнение существующих и новых технологий памяти показано в таблице 1. Как видно из таблицы, STT-MRAM и PCM имеют преимущества меньшей площади по сравнению с SRAM. В то время как STT-MRAM предлагает высокую скорость записи / чтения, длительный срок службы и низкое напряжение программирования, с другой стороны, недостатком PCM является значительная задержка записи. RRAM имеет более низкое напряжение программирования и более высокую скорость записи / чтения по сравнению с флэш-памятью и рассматривается как потенциальная замена флэш-памяти. Среди всех появляющихся кандидатов на технологию памяти RRAM имеет значительные преимущества, такие как простота изготовления, простая структура металл-изолятор-металл (MIM), отличная масштабируемость, наносекундная скорость, длительное хранение данных и совместимость с современной технологией CMOS, что обеспечивает конкурентоспособность. решение для цифровой памяти будущего [16]. Наиболее значительные преимущества RRAM изображены на рис. 1.
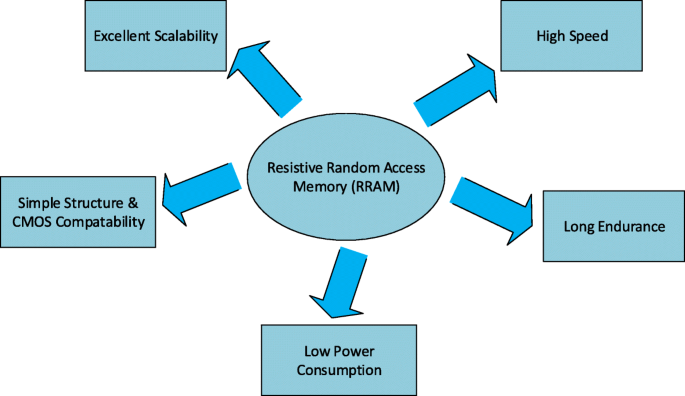
Преимущества RRAM
В этой работе представлены последние достижения и подробный обзор технологии RRAM. Обзор коммутационных материалов вместе с классификацией режимов коммутации и деталями механизма коммутации обсуждается в разделе «Резистивная оперативная память (RRAM)». В разделе «Показатели производительности резистивной оперативной памяти (RRAM)» освещены различные показатели производительности RRAM. Характеристики многоуровневых ячеек (MLC) RRAM вместе с различными схемами работы MLC и их физическими механизмами анализируются в разделе «Многоуровневая резистивная оперативная память (RRAM)». Подробное обсуждение моделирования устройства RRAM представлено в разделе «Моделирование устройств RRAM». В разделе «Приложения RRAM» обсуждаются различные приложения RRAM. Наконец, проблемы и перспективы RRAM представлены в разделе «Проблемы и перспективы на будущее». Распределение статей по категориям, использованных при подготовке рукописи обзора, представлено на рис. 2.

Распределение статей по категориям, с которыми консультировались для подготовки обзора по RRAM
Резистивная память с произвольным доступом (RRAM)
Материалы для переключения сопротивления
Было замечено, что в некоторых изоляторах изменение сопротивления происходит под действием приложенного электрического поля. Это свойство изменения сопротивления недавно было исследовано для разработки будущих энергонезависимых запоминающих устройств [17]. Явление переключения сопротивления наблюдалось в различных оксидах, но бинарные оксиды металлов были тщательно изучены как предпочтительный переключающий материал для будущих приложений энергонезависимой памяти, в первую очередь из-за их совместимости с обработкой CMOS BEOL. Различные материалы на основе оксидов металлов, демонстрирующие переключение нелетучих сопротивлений, такие как оксид гафния (HfO x ) [18–23], оксид титана (TiO x ) [24–31], оксид тантала (TaO x ) [32–36], оксид никеля (NiO) [37–40], оксид цинка (ZnO) [41–46], титанат цинка (Zn 2 TiO 4 ) [47], оксид марганца (MnO x ) [48, 49], оксид магния (MgO) [50], оксид алюминия (AlO x ) [51–53] и диоксид циркония (ZrO 2 ) [54–58] привлекли наибольшее внимание и активно изучались в течение последних нескольких лет. Эти оксиды металлов обычно наносят методом импульсного лазерного осаждения (PLD), осаждения атомных слоев (ALD) и реактивного распыления. Однако ALD является широко предпочтительным методом из-за его способности точно контролировать толщину и однородность тонкой пленки [59].
В обычных электронных устройствах выбор материала электродов важен, поскольку они действуют как пути транспортировки носителей. Для RRAM выбор материала электродов сильно влияет на коммутационные характеристики устройства. Например, в структуре медь / поли (3-гексилтиофен):метиловый эфир [6,6] -фенил-C61-масляной кислоты / оксид индия-олова (Cu / P3HT:PCBM / ITO) наблюдается стабильное поведение резистивного переключения.; однако он исчез после замены медного электрода на платиновый [60]. В качестве электродов для RRAM использовались самые разные материалы. Электродные материалы можно разделить на пять категорий на основе их состава, включая электроды из элементарного вещества, электроды на основе кремния, электроды из сплава, оксидные электроды и электроды на основе нитрита. Наиболее распространенными и обычно используемыми электродами являются электроды из элементарного вещества, которые включают Al [51], Ti [49], Cu [30], графен [61], углеродные нанотрубки [62], Ag [41], W [36], и Pt [44]. Для электродов на основе кремния используются только Si p-типа и Si n-типа [63]. Электроды из сплава обычно стабилизируют резистивное переключение и в основном включают Cu-Ti [64], Cu-Te [65] и Pt-Al [66]. Наиболее распространенными электродами на основе нитридов являются TiN и TaN [67, 68]. Электроды на основе оксидов относительно многочисленны, включая ZnO, легированный Al [69], ZnO, легированный Ga [70], и ITO [71].
Список металлооксидных материалов, которые недавно использовались при изготовлении устройства RRAM, наряду с различными комбинациями материалов, используемых для верхнего и нижнего электродов, показан в таблице 2. Также представлено подробное сравнение различных параметров. Из большого разнообразия используемых материалов можно предсказать, что переключение энергонезависимого сопротивления широко наблюдается в различных типах оксидов. Выбор материала для изготовления RRAM дает ему преимущество, поскольку структуры из оксидов металлов (MOM) могут быть легко изготовлены с использованием оксидов, используемых в настоящее время в полупроводниковой технологии. Материал нижнего электрода в RRAM обычно - платина, которую трудно травить. Для структуры с одним устройством RRAM может совместно использовать один и тот же нижний электрод, тогда как для архитектуры с перекладиной используются отдельные нижние электроды для каждого устройства. Их можно получить последовательным физическим осаждением из паровой фазы и отрывом. Верхний электрод и резистивный переключающий слой наносятся либо с использованием осаждения атомных слоев (ALD), либо с помощью физического осаждения из паровой фазы (PVD).
Режимы переключения сопротивления
Резистивная память с произвольным доступом (RRAM) состоит из ячейки памяти с резистивной коммутацией, имеющей структуру металл-изолятор-металл, обычно называемую структурой MIM. Структура состоит из изолирующего слоя (I), зажатого между двумя металлическими (M) электродами. Схема и вид в разрезе ячейки RRAM показаны на рис. 3a и b соответственно.
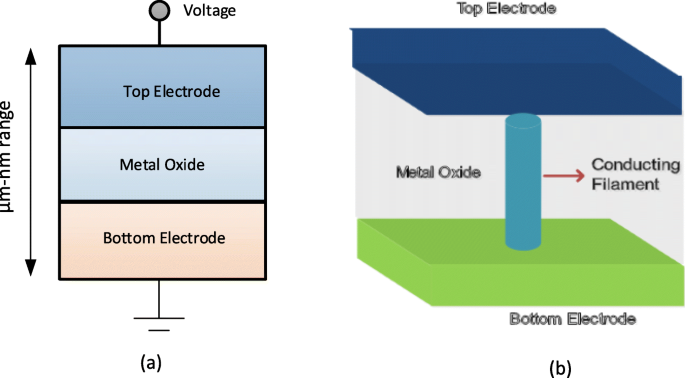
а Схема конструкции металл-изолятор-металл для RRAM. б Поперечное сечение RRAM
Приложение внешнего импульса напряжения к ячейке RRAM обеспечивает переход устройства из состояния с высоким сопротивлением (HRS) или состояния ВЫКЛ, обычно называемого логическим значением '0', в состояние низкого сопротивления (LRS) или состояние ВКЛ. называется логическим значением «1» и наоборот. Явление резистивного переключения (RS) считается причиной такого изменения значений сопротивления в ячейке RRAM. Свежеприготовленная RRAM изначально находится в состоянии высокого сопротивления (HRS), чтобы переключить устройство с HRS на LRS, приложение импульса высокого напряжения позволяет формировать проводящие пути в коммутационном слое, и ячейка RRAM переключается. в LRS [72]. Этот процесс, который происходит из-за мягкого разрушения структуры металлического изолятора (MIM), обычно называется «гальванопластикой», а напряжение, при котором происходит этот процесс, называется напряжением формования ( V f ). Следует отметить, что напряжение формирования зависит от площади ячейки [73] и толщины оксида [74]. Теперь, чтобы переключить ячейку RRAM с LRS на HRS, импульс напряжения называется напряжением сброса ( V сброс ), который позволяет этот переход переключения, и этот процесс называется процессом «СБРОС» [75–78]. При подаче импульса напряжения HRS RRAM может быть изменен на LRS. Напряжение, при котором происходит переход от HRS к LRS, называется напряжением SET ( V установить ), и этот процесс называется процессом «SET» [79]. Для эффективного чтения данных из ячейки RRAM применяется небольшое напряжение чтения, которое не нарушает текущее состояние ячейки, чтобы определить, находится ли ячейка в состоянии логического 0 (HRS) или логической 1 (LRS). Поскольку и LRS, и HRS сохраняют свои соответствующие значения даже после снятия приложенного напряжения, RRAM является энергонезависимой памятью. В зависимости от полярности приложенного напряжения RRAM можно разделить на два типа режимов переключения:(i) униполярное переключение и (ii) биполярное переключение [80]. При униполярном переключении переключение (процесс установки и сброса) устройства между различными состояниями сопротивления не зависит от полярности приложенного напряжения, то есть переключение может происходить при приложении напряжения той же полярности, но разной величины, как показано на рис. 4а. С другой стороны, при биполярном переключении переключение (процесс установки и сброса) устройства между различными состояниями сопротивления зависит от полярности приложенного напряжения, то есть переход от HRS к LRS происходит при одной полярности (положительной или отрицательный), а противоположная полярность переключает ячейку RRAM обратно в HRS, как показано на рис. 4b. При униполярном переключении джоулев нагрев интерпретируется как физический механизм, ответственный за разрыв проводящей нити во время операции сброса. С другой стороны, при биполярном переключении миграция заряженных частиц является основной движущей силой растворения проводящей нити, хотя джоулев нагрев все еще способствует ускорению миграции. Чтобы гарантировать отсутствие постоянного пробоя диэлектрического коммутационного слоя во время процесса формирования / установки RRAM, ток согласования ( I копия ) принудительно применяется для устройства RRAM. Ток соответствия ( I копия ) обычно обеспечивается устройством выбора ячейки (транзистор, диод, резистор) или анализатором параметров полупроводников во время тестирования вне кристалла.
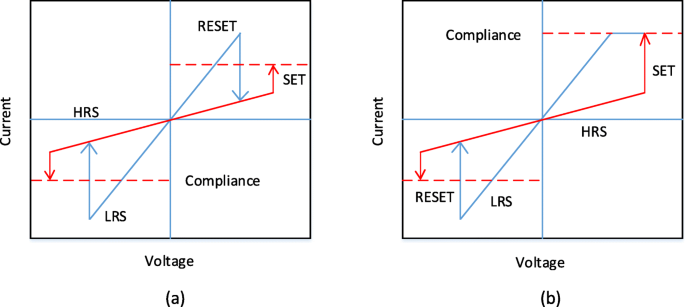
ВАХ для RRAM. а Униполярное переключение и b биполярное переключение [4]
Резистивный механизм переключения
Переключение ячейки RRAM основано на росте проводящей нити (CF) внутри диэлектрика. CF представляет собой канал с очень меньшим диаметром порядка нанометров, который соединяет верхний и нижний электроды ячейки памяти. Состояние низкого сопротивления (LRS) с высокой проводимостью достигается, когда нить подсоединена, а высокое сопротивление (HRS) возникает, когда нить отключена с зазором между электродами [91]. Основываясь на составе проводящей нити, RRAM можно разделить на следующие два типа:(i) RRAM на основе ионов металлов, также называемая памятью произвольного доступа с проводящим мостом (CBRAM), и (ii) RRAM на основе кислородных вакансий, называемая RRAM. как "OxRRAM". Здесь необходимо отметить, что CBRAM иногда называют памятью электрохимической металлизации (ECM), тогда как OxRRAM иногда также называют памятью изменения валентности (VCM).
В RRAM на основе ионов металлов, также называемом «CBRAM», физический механизм, ответственный за резистивное переключение, основан на миграции ионов металлов и последующих реакциях восстановления / окисления (окислительно-восстановительных) [92, 93]. Структура CBRAM состоит из окисляемого верхнего электрода (анода), такого как Ag, Cu и Ni, относительно инертного нижнего электрода (катода), например W, Pt и слой оксида металла между двумя электродами. Формирование нити в таких ячейках памяти происходит из-за растворения активных металлических электродов (чаще всего Ag или Cu), переноса катионов (Cu + или Ag + ), а также их последующее осаждение или восстановление на инертном нижнем электроде [94]. Таким образом, резистивное переключение этого типа RRAM определяется образованием и растворением металлических нитей.
Чтобы лучше понять механизм переключения CBRAM на основе ионов металлов, рассмотрим пример ячеек Ag / a-ZnO / Pt RRAM [41]. Общая схематическая иллюстрация, изображающая процесс переключения ячейки памяти с произвольным доступом проводящего моста, показана на фиг. 5. Исходное состояние ячейки памяти CBRAM изображено на фиг. 5a. Верхний электрод из серебра (ТЕ) является активным компонентом в формировании нити, в то время как нижний электрод из платины инертен. При приложении положительного напряжения смещения к верхнему электроду из серебра окисление (Ag → Ag + + e - ) возникает на верхнем электроде, из-за чего Ag + катионы образуются и осаждаются в диэлектрическом слое (a-ZnO) из Ag-электрода. Отрицательное смещение на нижнем Pt электроде (BE) притягивает Ag + катионы, и, как таковые, реакция восстановления (Ag + + e - → Ag) возникает на нижнем электроде. Таким образом, Ag + катионы восстанавливаются до атомов Ag и накапливаются до тех пор, пока не образуется проводящий мостик (рис. 5b – d) и, как говорят, устройство RRAM демонстрирует LRS. Этот процесс называется «SET». Когда полярность приложенного напряжения меняется на противоположную, высокопроводящая нить накала почти полностью растворяется, и говорят, что устройство находится в состоянии высокого сопротивления (HRS). Этот процесс называется «СБРОС» и изображен на рис. 5e.
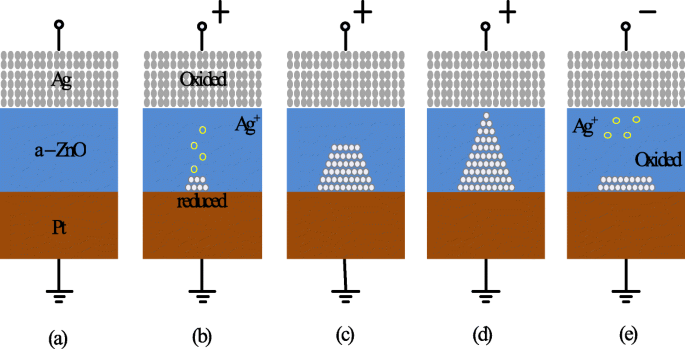
Схема коммутационного механизма токопроводящего моста RRAM. а Безупречное состояние устройства RRAM. б , c Окисление Ag и миграция Ag + катионы к катоду и их восстановление. г Накопление атомов Ag и Pt электрода приводит к росту высокопроводящей нити. е Растворение нити происходит при приложении напряжения противоположной полярности [41]
В RRAM на основе кислородных вакансий (OxRRAM) физический механизм, ответственный за резистивное переключение, обычно связан с генерацией кислородных вакансий ( V \ (_ {o} ^ {2 +} \)) и последующее перемещение ионов кислорода (O 2− ), что позволяет сформировать токопроводящую нить между верхним и нижним электродами ячейки RRAM [59]. Первоначально для уже изготовленной ячейки RRAM важен процесс формовки, то есть мягкий пробой диэлектрика. Как только происходит мягкий пробой диэлектрика, атомы кислорода выбиваются из решетки при приложении сильного электрического поля к поверхности раздела анода и становятся ионами кислорода (O 2− ), тогда как кислородные вакансии ( V \ (_ {o} ^ {2 +} \)) остаются в оксидном слое. Ионы кислорода (O 2− ) вступают в реакцию с анодными материалами или выделяются в виде нейтрального нерешетчатого кислорода, если благородные металлы используются в качестве материалов для анода с образованием межфазного оксидного слоя. Таким образом, граница раздела электрод / оксид ведет себя как «резервуар кислорода» [85]. Далее накопление кислородных вакансий ( V \ (_ {o} ^ {2 +} \)) в массивном оксиде переключает ячейку RRAM в состояние с низким сопротивлением (LRS), поскольку формируется проводящая нить (CF) и в устройстве протекает значительный ток. Чтобы переключить устройство обратно в состояние высокого сопротивления (HRS), происходит процесс сброса, во время которого ионы кислорода (O 2− ) мигрируют обратно в объемный оксид с поверхности раздела анода и либо объединяются с кислородными вакансиями ( V \ (_ {o} ^ {2 +} \)) или для окисления металлических выделений CF и, таким образом, частичного разрыва нити, тем самым переключая ячейку RRAM обратно в HRS. Для клеток RRAM, демонстрирующих механизм униполярного переключения, диффузия ионов кислорода (O 2- ) активируется термически током джоулева нагрева, и поэтому ионы кислорода диффундируют от границы раздела или области вокруг CF из-за градиента концентрации. Также следует отметить, что в униполярной коммутационной RRAM требуется относительно более высокий ток сброса, чтобы повысить локальную температуру вокруг CF. С другой стороны, при биполярном переключении RRAM ионы кислорода (O 2− ) требуется обратное электрическое поле, так как межфазный слой может представлять собой значительный диффузионный барьер, а чистой термодиффузии недостаточно. Следует отметить, что в обоих случаях происходит частичный разрыв CF, переводя ячейку RRAM в состояние высокого сопротивления (HRS). В первую очередь это связано с образованием кислородных вакансий ( V \ (_ {o} ^ {2 +} \)) и плохая область, приводящая к туннельной щели для электронов. Чтобы переключить устройство обратно в LRS (процесс SET), CF повторно соединяет электроды в результате мягкого пробоя в области зазора. Подобный процесс установки / сброса может повторяться в течение многих циклов.
Основываясь на приведенном выше обсуждении, CBRAM, также известный как память электрохимической металлизации (ECM), основан на электрохимически активном металлическом электроде, таком как Ag, Cu или Ni, для образования CF на основе катионов металлов [95]. КФ в кислородных вакансиях на основе волокна RRAM «OxRRAM», также известного как память с изменением валентности (VCM), состоит из кислородных вакансионных дефектов, а не из атомов металла, из-за миграции анионов внутри самого накопительного материала [96]. Хотя механизм переключения как «OxRRAM», так и «CBRAM» обсуждается подробно, до сих пор ведутся споры о механизмах переключения обоих типов RRAM [97]. Например, где CF начинает расти в заданном процессе и где прерывается в процессе сброса, и как эти кислородные вакансии / атомы металла собираются, чтобы сформировать CF. ВАХ 20 последовательных циклов переключения Ta / TaO x Была исследована структура RRAM на основе / Pt [98], и было обнаружено явное изменение как LRS, так и HRS для последовательных циклов переключения. В результате общее окно памяти уменьшается, что снижает общую производительность RRAM. Эта изменчивость сопротивления от цикла к циклу в первую очередь объясняется случайным образованием CF, а также его разрывом во время операций установки и сброса соответственно.
Сравнение OxRRAM с CBRAM на основе различных рабочих параметров показано в таблице 3 [81, 84, 86–88, 99, 100]. Это сравнение показывает поразительную разницу в характеристиках выносливости этих типов памяти RRAM. Это различие связано с тем, что проводящие нити CBRAM состоят в основном из атомов металлов, которые относительно легче дрейфовать и диффундировать по сравнению с кислородными вакансиями, что приводит к ухудшению времени удерживания и характеристик выносливости CBRAM по сравнению с OxRRAM. Хотя механизм переключения обоих типов RRAM различен, у них есть много общих характеристик. Единственное существенное отличие состоит в том, что выносливость OxRRAM значительно выше, чем CBRAM.
Показатели производительности резистивной оперативной памяти (RRAM)
Выносливость
Резистивная память с произвольным доступом включает частые переходы между состоянием с высоким сопротивлением (HRS) и состоянием с низким сопротивлением (LRS). Каждое переключение между резистивными состояниями может привести к необратимому повреждению и снижению производительности RRAM. Таким образом, выносливость определяется как количество раз, когда устройство RRAM может переключаться между HRS и LRS, обеспечивая при этом надежно различимое соотношение между ними [101]. Таким образом, испытание на долговечность определяет максимальное количество циклов установки / сброса, которое может быть эффективно переключено до того, как HRS и LRS перестанут различаться. Характеристики выносливости RRAM получаются путем выполнения последовательности I-V разверток в резистивной коммутационной ячейке и последующего извлечения R HRS и R LRS при приложении напряжения считывания (обычно 0,1 В) [41]. Этот метод надежен, так как позволяет добиться правильного переключения устройства в каждом цикле; однако этот метод очень медленный, потому что время, необходимое для получения развертки ВАХ, может быть очень большим, особенно если задействованы более низкие токи.
Циклы выносливости в H е О x Ячейка RRAM демонстрирует сильную зависимость от размера ячейки, как показано на фиг. 6a, где сообщается о лучшей стойкости в устройстве RRAM с большим размером ячейки. Кроме того, уменьшение толщины слоя по вертикали приводит к ухудшению характеристик выносливости для напряжения SET при 2,5 В, как показано на рис. 6b [102]. Это снижение долговечности при уменьшении размера коммутирующего слоя является результатом уменьшения количества ионов в активной области. H е О x RRAM на основе RRAM демонстрирует отличные показатели выносливости 10 6 циклы на массиве размером 1 КБ с размером ячейки 30 нм менее 0,18 μ m технология и то же показано на рис. 6в [103]. Добавив дополнительный слой A l О x над нижним электродом (BE) стабильность матрицы может быть дополнительно улучшена за счет повышения устойчивости к помехам при считывании для HRS. Для T а О x на основе RRAM, в Ta / Ta 2 наблюдалось ухудшение показателей выносливости с увеличением ширины импульса и амплитуды напряжения RESET. О 5 / Структура TiN RRAM [105]. Сравнение нижнего электрода из TiN и Ru в Ta / Ta 2 О 5 / TiN RRAM показывает, что основная причина снижения износостойкости связана с реакцией ионов кислорода с электродом TiN. Кроме того, повышенная выносливость на 10 9 циклы переключения были получены без проверки в аналогичной структуре RRAM за счет уменьшения Ta 2 О 5 слой до 3 нм [106] и использование треугольного импульса длительностью <5 нс. Для производительности крупномасштабных массивов сравнение Ta 2 размером 2 Мб О 5 память до и после 10 5 Циклы испытаний на выносливость показаны на рис. 6г [104]. Распределение тока в ячейке показывает небольшое изменение для начального и конечного циклов. Кроме того, ток ячейки для LRS падает ниже 50 μ A, что указывает на низкое энергопотребление массива. Резистивные коммутационные аппараты с выносливостью более 10 12 сообщалось о циклах в различных типах ячеек RRAM с участием оксида тантала (TaO x коммутационные среды на основе) [32, 36, 59]. Таким образом, RRAM-устройства на основе оксида тантала, по-видимому, демонстрируют наивысший ресурс.

а Циклы выносливости H е О x на основе RRAM при разном напряжении SET и размере ячейки b различной толщины (T5 =2 нм, T20 =10 нм) при заданном напряжении 2,5 В. c Распределение устойчивости массива размером 1 т.п.н., полученное из графиков Вейбулла при различных циклах выносливости. г 100 тыс. Циклов, выдержка 2-Mb-Ta 2 О 5 -основной массив; Печатается по ссылкам [102–104]
Хранение
Сохранение данных устройства RRAM включает исследование стабильности в течение определенного периода времени как для LRS, так и для HRS после выполнения переходов установки и сброса. Другими словами, период времени, в течение которого ячейка памяти будет оставаться в определенном состоянии после операции установки / сброса, определяет способность ячейки памяти сохранять свое содержимое [11]. Приложение напряжения постоянного напряжения (CVS) с течением времени с использованием низкого напряжения считывания (0,1 В) и измерения кривой зависимости тока от времени (I-t) как для LRS, так и для HRS позволяет измерять сохранение состояния. Из-за дисперсионного характера атомных перегруппировок, индуцированных в RRAM из-за установленного напряжения, длительное время удерживания в LRS трудно получить, тогда как в HRS удерживание не вызывает беспокойства, поскольку обычно это естественное состояние устройства, и RRAM будет продолжать оставаться в этом состоянии, если не применяется систематическая ошибка (или низкая систематическая ошибка). Сохранение в LRS зависит от предела соответствия во время перехода SET, например в RRAM, основанных на механизме переключения проводящей нити, больший ток податливости создает более прочную проводящую нить, которая более стабильна во времени [28, 41] по сравнению с меньшим податливым током. Прогнозируемый срок службы 10 лет при 85 ∘ C был продемонстрирован в Ti / HfO 2 / TiN [18]. Обычно используемый метод определения долговечности устройства заключается в применении импульса считывания при высокой температуре через определенные интервалы времени (например, каждые 1 с) и экстраполяции сопротивления на 10-летний период. Хотя этот метод легко реализовать, он имеет определенные ограничения, в первую очередь из-за напряжения считывания, приложенного к ячейке. Альтернативный метод - изменить температуру и записать время до выхода устройства из строя. Энергия активации извлекается путем построения графика Аррениуса и экстраполируется до рабочей температуры. Однако ограничение этого метода состоит в том, что необходимо ждать, пока в ячейке RRAM не произойдет сбой, и, следовательно, этот метод более трудоемкий и дорогостоящий.
Характеристики устройства H е О x RRAM на основе RRAM [81, 103], разработанная в Институте промышленных технологий на Тайване, демонстрирует дальнейшее понимание работы устройства RRAM. Изображение TiN / Ti / H , полученное с помощью просвечивающей электронной микроскопии (ПЭМ) е О x Устройство / TiN RRAM с размером ячейки 30 нм показано на рис. 7а. Устройство демонстрирует характеристики биполярного переключения и кривую ВАХ, полученную при 200 μ . Установленный ток согласования показан на рис. 7b. Устройство имеет выносливость 10 6 циклы переключения с коэффициентом включения / выключения более 100 при условиях программирования установки / сброса + 1,5 В / - 1,4 В, импульс с 500 μ s ширины импульса и то же показано на рис. 7c.

а Изображение TiN / Ti / HfO x , полученное с помощью просвечивающей электронной микроскопии (ПЭМ) / Устройство TiN RRAM. б Типичные вольт-амперные характеристики прибора с размером ячейки 30 нм. c 10 6 циклы переключения на выносливость, полученные от 500 μ с пульс. г Ожидается, что срок хранения составит 10 лет при тестировании при 150 ∘ C; перепечатано из исх. [81, 103]
Единообразие
В ячейке RRAM плохая однородность различных характеристик устройства является одним из существенных факторов, ограничивающих производство в более широком масштабе. Напряжения переключения, а также сопротивления HRS и LRS относятся к параметрам, которые могут сильно изменяться. Вариации переключения сопротивления включают временные колебания (от цикла к циклу) и пространственные колебания (от устройства к устройству). Стохастический характер образования и разрыва токопроводящей нити считается основной причиной этих вариаций. Изменчивость от цикла к циклу и от устройства к устройству является основным препятствием для хранения информации в устройствах RRAM [59]. Наблюдение изменчивости от цикла к циклу зависит от изменения количества кислородных вакансионных дефектов, которые возникают в КФ из-за его стохастической природы образования и разрушения во время переключения [107]. Из-за такой случайной природы CF прогнозирование и точное управление формой CF становятся чрезвычайно сложными. Эта изменчивость ухудшается по мере того, как предел соответствия (т. Е. Ток соответствия ‘ I копия ') уменьшен. С другой стороны, для более высокого значения « I копия ’, Коэффициент стандартного отклонения ( σ ) и среднее сопротивление ( μ ) низкий, что приводит к меньшему разбросу сопротивления LRS. Это объясняется большим количеством дефектов в КФ, таким образом формируя четко определенный путь для прохождения тока.
RRAM также демонстрирует неоднородность между устройствами (от ячейки к ячейке), что также снижает производительность памяти за счет уменьшения запаса памяти между двумя состояниями. Причина этой изменчивости объясняется неоднородностями в процессе изготовления, такими как толщина переключающей пленки, повреждения от травления и шероховатость поверхности электродов. Было проведено много исследований для улучшения единообразия RRAM, и несколько методов были изучены для того же самого. В одном из методов используется концепция вставки зародышей нанокристаллов, которые ограничивают пути проводящей нити за счет усиления эффекта локального электрического поля [82, 90, 108]. В Ti / TiO 2− x / RRAM на основе Au [28], индукция нанокристаллов платины (Pt) в тонком TiO 2− x приводит к повышенной однородности ячейки RRAM. Нанокристаллы Pt ограничивают эффект переключения областями с высокой вероятностью образования кислородных вакансий, что приводит к улучшенной однородности. В другом подходе создание границы раздела электрод / оксид путем встраивания соответствующих буферных слоев очень полезно для достижения единообразной работы RRAM. В HfO x на основе RRAM [109] тонкий буферный слой Al вставляется между электродом из TiN и HfO x оксидный слой. Это приводит к значительному улучшению установленного распределения напряжения, а также распределения сопротивления, таким образом повышая однородность устройства. Улучшение напряжения SET и распределения сопротивления устройства RRAM после вставки тонкого буферного слоя Al между электродом TiN и HfO x объемный оксид и тот же изображен на рис. 8 [59]. Предполагается, что атомы Al диффундируют в HfO 2 тонкие пленки, и они имеют тенденцию локализовать кислородные вакансии из-за пониженной энергии образования кислородных вакансий, тем самым стабилизируя образование проводящих нитей, что помогает улучшить однородность переключения сопротивления.
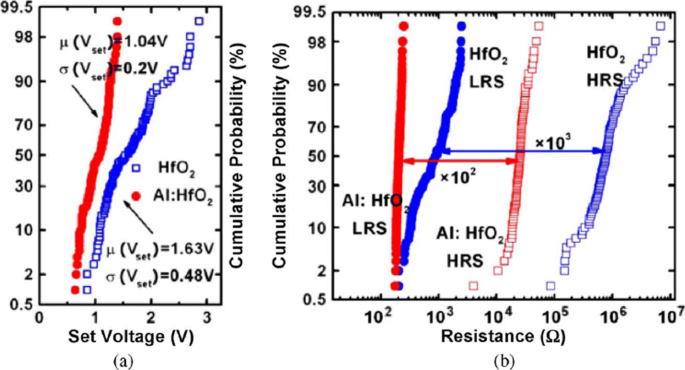
Улучшение однородности HfO с буферизацией Al x RRAM по сравнению с HfO x массив RRAM. а Статистическое распределение напряжения SET ( V установить ), полученный из 100 циклов развертки постоянного тока. б Статистическое распределение HRS и LRS для 100 циклов развертки импульсов; перепечатано из исх. [59]
В дополнение к подходу к инженерии материалов был также предложен новый метод программирования для уменьшения колебаний. В W / HfO 2 реализована технология многоступенчатого формования. RRAM на основе / Zr / TiN [22] для минимизации тока перегрузки из-за паразитных эффектов. Многоступенчатая техника формования приводит к постепенному формированию нити; таким образом достигается низкий ток установки / сброса, улучшая характеристики переключения устройства. Различные другие методы, такие как формование при постоянном напряжении и горячее формование (обычно называемое формованием при более высокой температуре), также были исследованы для эффективного уменьшения колебаний сопротивления [110]. Другой метод достижения высокой однородности - применение последовательности импульсов, а не одиночного импульса к ячейке RRAM [23]. Такой подход не только приводит к улучшенной однородности, но также расширяет возможности многоуровневой ячейки RRAM.
Влияние рабочей температуры и случайного телеграфного шума
Для достижения надежной работы устройства RRAM исследуется влияние рабочей температуры и случайного телеграфного шума (RTN). Обнаружено, что сопротивление как LRS, так и HRS-состояний претерпевает изменения из-за изменения рабочей температуры. Температурные исследования TiN / HfO 2 / Ti / TiN [111]. Положительное напряжение развертки величиной <3 В и ток согласования 1 μ Применялся для гальванопластики. После формования напряжение сброса ( В сброс ) <–1 В переключает устройство обратно в HRS (состояние ВЫКЛ.). Чтобы переключить устройство обратно в LRS (состояние ON), установите напряжение ( В установить ) <1 В приложено.
Операция сброса в устройстве RRAM имеет тенденцию показывать управляемое напряжением отрицательное дифференциальное сопротивление (NDR). Операция сброса происходит внезапно при низких температурах, в то время как при температурах выше комнатной, процесс сброса происходит более постепенно. Сопротивление устройства RRAM в исходном состоянии, а также во включенном и выключенном состояниях в зависимости от температуры показано на рис. 9a. Полупроводниковое поведение наблюдается как в исходном состоянии, так и в выключенном состоянии, то есть сопротивление уменьшается с повышением температуры. Для включенного состояния наблюдается металлическая характеристика, т. Е. Сопротивление увеличивается с повышением температуры. Из-за изменения сопротивления при изменении температуры R OFF / R ВКЛ также уменьшается со значения 20 примерно до 5 в диапазоне температур 213–413 К. В Ti / HfO x / Pt устройства, уменьшение R OFF / R ВКЛ наблюдалось при циклическом изменении температуры. Это уменьшение коэффициента сопротивления было связано с образованием ловушек, связанных с кислородными вакансиями, внутри HfO 2 слой оксида металла [112, 113]. Кроме того, были проведены температурно-зависимые измерения без операции установки / сброса для оценки влияния циклического изменения напряжения и напряжения на R OFF / R ВКЛ соотношение. Напряжение развертки на устройстве RRAM было остановлено до достижения V установить и V сброс ценности. Для сопротивления в выключенном состоянии (зеленые прямоугольники) наблюдалась более слабая температурная зависимость по сравнению с сопротивлением в состоянии включения (зеленые кружки), которое показало аналогичные характеристики по сравнению со случаем циклического включения. Из этих наблюдений мы заключаем, что смена напряжения I-V вызывает более сильную температурную зависимость, что снижает R ВЫКЛ / R ВКЛ соотношение. Влияние изменения температуры на коммутируемые напряжения V установить и V сброс изображен на рис. 9b. Небольшое изменение в V установить с изменением температуры указывает на отсутствие значительной разницы температур. В случае V сброс , общая тенденция состоит в том, что наблюдается уменьшение значения напряжения примерно на 0,2 В при повышении температуры в диапазоне 233–333 К. Кроме того, медленное увеличение V сброс наблюдается в диапазоне температур 353–413К.

Влияние переменной температуры на а первичное сопротивление (левая ось) и сопротивления в выключенном состоянии, а также сопротивления в открытом состоянии (правая ось) в диапазоне температур 213–413 К и b коммутируемые напряжения В установить и V сброс ; перепечатано из исх. [111]
Случайный телеграфный шум (RTN) - еще один фактор, влияющий на производительность RRAM. RTN долгое время использовался как индикатор производительности и надежности устройства. RTN уменьшает запас памяти между HRS и LRS из-за значительных колебаний тока чтения во время операции чтения. Из-за эффекта RTN, это сильно влияет на предел чтения, потенциал масштабирования и возможности многоуровневых ячеек ячейки RRAM [114]; таким образом, его необходимо исследовать, чтобы добиться надежной работы. Чтобы исследовать влияние нижнего электрода на RTN, анализ Ta 2 О 5 / TiO 2 RRAM [115] был выполнен. Примеры сложных сигналов RTN в LRS и HRS изображены на рис. 10. RTN вызывает нестабильность чтения в устройстве RRAM, тем самым уменьшая запас чтения, реализацию многобитной памяти и препятствуя масштабированию устройства. RTN объясняется захватом и снятием захвата электронов вблизи CF в LRS, тогда как это происходит в туннельной щели в HRS-состоянии. Хотя физика RTN все еще не ясна и активно обсуждается, захват и снятие ловушек электронов, которые временно препятствуют переносу заряда, широко признается как механизм, ответственный за флуктуации из-за RTN. Замечено, что с уменьшением рабочего тока амплитуда RTN увеличивается, что сильно влияет на уровень HRS. Следовательно, необходимо обеспечить дополнительный запас сопротивления для достижения надежной работы. RTN в RRAM был тщательно исследован, хотя физический механизм RTN до сих пор не определен явно. RTN может использоваться в качестве инструмента для отображения перемещений активных вакансий в RRAM из-за его изменения во времени. Это может быть весьма полезно для понимания механизмов отказа других проблем с надежностью.

Сложные RTN-сигналы в LRS и HRS Ta 2 О 5 / TiO 2 - RRAM на основе нормализованной амплитуды шума и среднего тока; перепечатано из исх. [114]
Многоуровневая резистивная оперативная память (RRAM)
Многоуровневое хранилище на ячейку (mlc)
Благодаря небольшому физическому размеру и низкому энергопотреблению устройства RRAM могут использоваться в будущих приложениях памяти и логики. Повышенная плотность хранения - один из наиболее важных аспектов технологии памяти, позволяющий проектировать ячейки памяти с многоразрядной емкостью [89]. Множественные резистивные состояния могут быть достигнуты в ячейках RRAM, что обеспечивает преимущества недорогих и высокоплотных решений для энергонезависимого хранения данных. В настоящее время проводится множество исследований в области RRAM для уменьшения размеров и увеличения структурной плотности массивов памяти. Ранее плотность хранения RRAM увеличивалась за счет уменьшения размера устройства; однако сложность экспериментальных процедур ограничивает ее успешное выполнение. Другой предлагаемый метод - использование трехмерных (3D) архитектур с перекладинами. Было предложено два типа архитектур:«вертикальная» и «поперечная RRAM» [116, 117]; однако для обоих этих типов архитектуры требуются расширенные процедуры изготовления, что нежелательно. Гораздо более простой альтернативой увеличению плотности хранения в устройствах RRAM является использование технологии хранения многоуровневых ячеек (MLC), которая позволяет хранить более одного бита на ячейку без уменьшения размеров физического устройства. Этот MLC - одно из наиболее многообещающих свойств RRAM, которое может значительно увеличить плотность хранения памяти [83, 118–125]. Таким образом, вместо одного состояния с высоким и низким сопротивлением (HRS и LRS) мы можем достичь нескольких HRS и LRS без изменения размеров устройства. Однако для достижения надежной работы MLC необходимо обеспечить точный контроль сопротивления различных уровней сопротивления RRAM; в противном случае устройство будет страдать от непостоянства сопротивления и проблем с надежностью, главным образом из-за случайного характера образования токопроводящей нити во время процесса переключения [126].
Способы получения многоуровневых режимов для каждой ячейки (mlc) в RRAM
Поведение MLC в RRAM делает его очень полезным для приложений с высокой плотностью. Чтобы получить поведение MLC в RRAM, используются следующие три метода:(i) изменение тока согласования, (ii) управление напряжением сброса и (iii) изменение ширины импульса операции программирования / стирания.
MLC путем изменения текущего соответствия
Устройство RRAM обычно работает с конфигурацией ячеек 1-RRAM (1R) [41] или с конфигурацией ячеек с 1 транзистором 1-RRAM (1T-1R) [18]. Характеристики MLC в конфигурации 1R можно получить, изменив текущее соответствие ( I копия ) во время операции «установка», тогда как характеристики MLC в структуре ячеек 1-транзистор 1-RRAM (1T-1R) управляются путем изменения напряжения на затворе транзистора, что позволяет контролировать ток согласования (I cc ) во время установленной работы ячейки RRAM. Типичные ВАХ MLC для Ti / Ta 2 О 5 Ячейка RRAM на основе / Pt [127] показана на рис. 11. В качестве тока соответствия ( I копия ) увеличено со 150 μ От 1 до 1 мА, шесть различных LRS получаются при I копия =150 мкм А, Я копия =200 мкм А, Я копия =300 мкм А, Я копия =500 мкм А и Я копия =700 мкм А, Я копия =1 мА из-за увеличения соответствующего тока LRS (I LRS ), в то время как HRS поддерживается постоянным, а ток HRS (I HRS ) остается неизменным для всех уровней LRS. Для Ti / Ta 2 О 5 / Pt RRAM, с увеличением I копия , максимальный ток сброса (I reset ) также увеличивается, в то время как установленное напряжение почти поддерживается постоянным. Также было замечено, что сопротивление LRS (R LRS ) уменьшается, а (I reset ) увеличивается за счет более сильного образования филаментов с увеличением I копия .
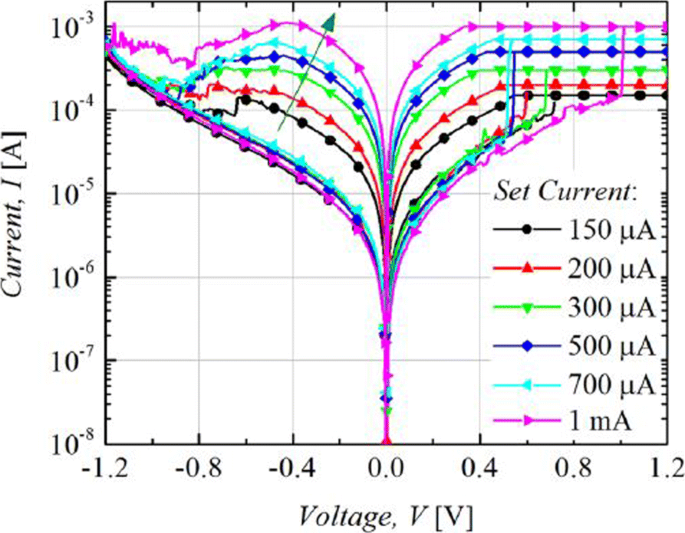
Многоуровневые характеристики Ti / Ta 2 О 5 / Pt RRAM, полученный путем контроля тока соответствия. «Воспроизведено из [127] с разрешения AIP Publishing»
Формирование КФ и соответствующее ей расширение с увеличением I копия - это приписанный механизм многоуровневого на ячейку (MLC) в соответствии с током ( I копия ), как схематично изображено на рис. 12. С увеличением размера CF из-за увеличения I копия , сопротивление CF уменьшается и, следовательно, приводит к нескольким уровням LRS для разных значений I копия . Также замечено, что я reset увеличивается с увеличением I копия поскольку требуется более высокая мощность для разрыва CF, имеющего больший диаметр.
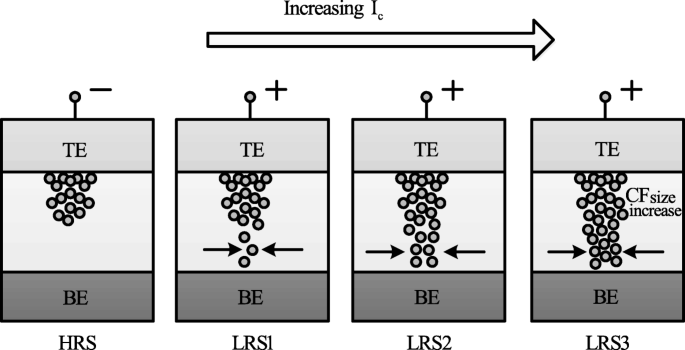
Схематическое изображение нескольких состояний сопротивления в ячейке RRAM, полученных при изменении тока согласования ‘ I копия ’[98]
MLC путем управления напряжением сброса
Характеристики MLC в ячейке RRAM также можно получить, управляя напряжением сброса ( V сброс ) в то время как ( I копия ) поддерживается постоянной. В этом случае типичные ВАХ MLC для TiN / HfO x / AlO x / Ячейка RRAM на основе Pt [128] путем применения различных ( V сброс ) от - 2,1 В, - 2,7 В и - 3,3 В показаны на рис. 13.

Многоуровневые характеристики TiN / HfO x / AlO x / Pt RRAM, полученная путем управления напряжением сброса. «Воспроизведено из [128] с разрешения AIP Publishing»
Замечено, что с увеличением ( V сброс ), ток HRS ( I HRS ) уменьшается; таким образом, получают несколько уровней HRS с одинаковым сопротивлением LRS. Кроме того, установленное напряжение ( В установить ) также увеличивается как V сброс увеличивается, в то время как I сброс остается почти постоянным.
Уменьшение I HRS с увеличением напряжения сброса происходит в первую очередь из-за увеличения зазора между металлическим электродом и острием CF, как показано на рис. 14. Чем больше величина V сброс , тем больше зазор и, следовательно, выше значение сопротивления. Следовательно, увеличение зазора между наконечником CF и нижним электродом (BE) с увеличением напряжения сброса приводит к появлению нескольких уровней сопротивления HRS. Замечено, что устройства, в которых I сброс показывает постепенное изменение тока вместо резкого изменения во время операции «сброса», изменение сопротивления HRS в таких устройствах может быть связано с уменьшением размера токопроводящей нити (CF) как V сброс увеличена. Этот подход более жизнеспособен на практике для архитектур с перекрестными точками, так как требует относительно более простых схем.
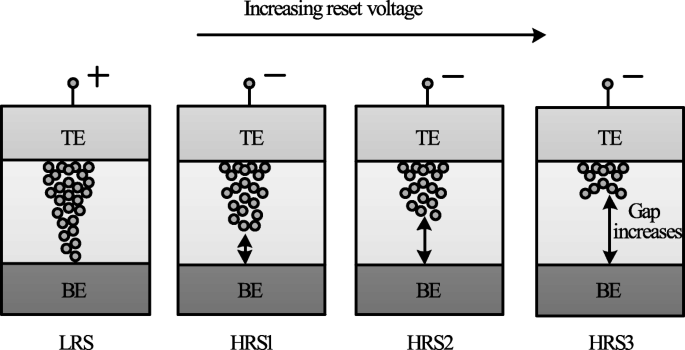
Схематическое изображение нескольких состояний сопротивления в ячейке RRAM, полученных при изменении напряжения сброса ‘V reset ’[98]
MLC путем изменения ширины импульса программы / стирания
Характеристики MLC также могут быть получены путем изменения ширины импульса программы / стирания, при этом амплитуда импульса поддерживается постоянной [23]. В HfO x на основе RRAM [128], три уровня HRS были продемонстрированы путем изменения ширины импульса сброса от 50 нс до 5 μ с. Этот метод получения характеристик MLC в RRAM относительно проще; однако эта схема энергоэффективна. Этот недостаток ограничивает применение этого метода для получения надежных характеристик в ячейке RRAM. Более высокое потребление энергии устройством RRAM было подтверждено сравнением переходных характеристик между амплитудой импульса сброса и контролем ширины импульса. Это, в частности, связано с более высоким нежелательным рассеянием энергии в виде тепловой энергии в резистивном переключающем материале.
Сводка устройств RRAM, демонстрирующих несколько состояний сопротивления, приведена в таблице 4. Как видно из таблицы, сообщалось о различных устройствах RRAM с несколькими состояниями сопротивления. Однако до настоящего времени только 8 состояний сопротивления были продемонстрированы в одной ячейке RRAM либо путем изменения I копия или V сброс . Следовательно, есть огромные возможности для увеличения количества состояний сопротивления в ячейке RRAM, тем самым увеличивая ее плотность хранения.
Моделирование устройств RRAM
Моделирование играет очень важную роль в разработке устройств, использующих полупроводниковые технологии. Для полного понимания работы устройства и оптимизации производительности большое значение имеет точная модель. Было предложено несколько моделей RRAM с различными характеристиками и точностью [129]. В этом разделе обсуждаются характеристики и атрибуты различных широко используемых популярных моделей RRAM.
Модель Стэнфорда / Американского университета
Одной из самых популярных моделей RRAM, основанных на физике, является модель RRAM Стэнфордского университета / Американского университета в США [130–132], предложенная Гуаном и др. и Chen et al. Эта модель была применена для проверки характеристик переключения I-V HfO 2 RRAM [128] и включает влияние джоулева нагрева и изменения температуры на переключение устройств RRAM.
Эта модель зависит от роста CF внутри диэлектрического переключающего слоя. Зазор между нитью накала, то есть зазор между концом CF и верхним электродом, является переменной внутреннего состояния для этой модели. Рост CF внутри диэлектрика объясняется перемещением иона кислорода, регенерацией и рекомбинацией кислородных вакансий [133]. Таким образом, скорость изменения зазора нити накала (g) задается как [130]:
$$ {\ frac {dg} {dt}} =V _ {\ tiny {0}}. \ exp \ bigg ({{\ frac {-E_ {a}, m} {k_ {b} .T}}} \ bigg). {\ text {Sinh}} \ bigg ({\ frac {qa_ {h} \ gamma V} {L.k_ {b} .T}} \ bigg) $$ (1)где E а - энергия активации, V - величина напряжения, приложенного к устройству, L толщина материала переключения, a h - расстояние прыжка, γ - коэффициент усиления местного поля, V 0 - скорость, содержащая частоту попытки ускользнуть, K б постоянная Больцмана, q - заряд элементарной единицы и T - температура токопроводящей нити.
В этой модели учитывается пространственное изменение размера зазора в дополнение к вариациям, которые возникают из-за стохастических свойств ионного процесса. Шумовой сигнал добавляется к расстоянию зазора для учета этих изменений как [130]:
$$ g_ {| t + \ Delta t} =F \ Big [g_ {| t}, {\ frac {dg} {dt}} \ Big] + \ delta_ {g} \ times \ tilde {X} (n) \ Delta t, n ={\ frac {t} {T_ {GN}}} $$ (2)где Δ t - временной шаг моделирования, функция F представляет временную эволюцию размера разрыва от t в Δ т. \ (\ tilde {X} \) (n) - последовательность гауссовского шума с нулевым средним. Т GN - временной интервал, по истечении которого \ (\ tilde {X} \) ( n ) меняется на следующее случайное значение.
Изменение размера зазора δ г зависит от кинетической энергии ионов и температуры нити как [130]:
$$ \ delta_ {g} (T) ={\ frac {\ delta ^ {\ tiny {0}} _ {g}} {\ bigg \ {1+ \ exp \ Big ({\ frac {T _ {\ text {crit}} - T} {T _ {\ text {smith}}}} \ Big) \ bigg \}}} $$ (3)где \ (\ delta ^ {0} _ {g} \) и T кузнец являются коэффициентами подгонки, чтобы согласовать кривые распределения сопротивления с экспериментами и T крит - пороговая температура, выше которой размер зазора значительно изменяется.
Эта модель показывает сильную зависимость от температуры; таким образом, необходимо учитывать изменение ‘T’ . При изменении характеристик ячейки динамическая температура внутренней области T существенно меняется, в то время как внешняя область предположительно имеет однородную и стабильную температуру (T ванна ), относится как [130]:
$$ c_ {p} {\ frac {dT} {dt}} =V (t) .I (t) - k (T-T _ {\ text {ванна}}) $$ (4)где C p эффективная теплоемкость внутренней области, V (t) Я (t) представляет собой джоулева нагревание, а k - эффективная теплопроводность.
Используя обобщенный механизм проводимости, проводимость по току определяется как [130]:
$$ I (g, v) =I _ {\ tiny {0}}. \ Exp \ bigg ({{\ frac {-g} {g _ {\ tiny {0}}}}} \ bigg) {\ text { Sinh}} \ bigg ({\ frac {V} {V _ {\ tiny {0}}}} \ bigg) $$ (5)где I 0 , г 0 и V 0 - параметры подгонки, соответствующие экспериментальным результатам.
Одной из важных особенностей этой модели является ее реализация в нейроморфных приложениях и конструкции синаптических устройств RRAM [134], что придает модели большую степень гибкости и дополнительные возможности для реализации в различных нейроморфных системах.
Физическая электротермическая модель
Физическая электротермическая модель была разработана Kim et al. [135] и реализован с использованием пятиокиси тантала (Ta 2 О 5 ) -слойный двухслойный RRAM [136–138]. Эта физическая модель решает дифференциальные уравнения на основе метода конечных элементов. В этой модели также используется подход электротермической физики для моделирования [139], что дает ей преимущество с точки зрения гибкости за счет включения решателя метода конечных элементов (FEM) для очень точного моделирования системы. Однако недостатком этого подхода является сложность его реализации для вычислителей схем SPICE и Verilog.
Эта модель описывает CF как легированную область, содержащую кислородные вакансии в качестве легирующих примесей, при этом CF распространяется от верхнего к нижнему электроду устройства. To describe the drift-diffusion of vacancy migration, this model assumes the same equation can be used to describe both the processes of oxygen ions and vacancies. The ion model by Mott and Gurney [140] is employed here to describe the process given as [135]:
$$ {\frac{dn_{D}}{dt}} =\Delta \times \bigg(D_{s}.\Delta_{n\tiny{D}}- \mu v n_{D} \bigg) + G $$ (6)где D s describes the diffusion process, v gives the drift velocity of vacancies and G is the CF growth rate which actually describes the SET process. The parameters are defined as [135]:
$$ D_{s} ={\frac{1}{2}} \times a^{2} \times f_{e} \times \exp \bigg({\frac{- E_{a}}{k_{B}T}} \bigg) $$ (7) $$ v =a_{h} \times f \times \exp \bigg({\frac{- E_{a}}{k_{B}T}} \bigg) \times {\text{Sinh}} \bigg({\frac{q a_{h}E}{k_{B}T}} \bigg) $$ (8) $$ G =A \times \exp \bigg({\frac{- (E_{a}-ql_{m}E)}{k_{B}T}} \bigg) $$ (9)where l m is the mesh size.
These equations govern the physical transformation of the device during SET and RESET transition, thus essentially controlling the CF growth and rupture.
Huang’s Physical Model
Huang’s physical model developed by Huang et al. [141, 142] is a very comprehensive physical model for RRAM device as it takes into account both the CF width and the gap of filament to electrode as the factors affecting the state variable dynamics. In addition, temperature distribution is also accounted for in this model.
SET/RESET process is considered as a result of generation/recombination process of oxygen ions (O 2– ) and oxygen vacancies (V 0 ). During the SET process, CF starts to evolve from the tip of the top electrode (T.E) and elongates in radius with increase in voltage, resulting in final width ‘W’ of the C.F. This model assumes symmetrical cylindrical shape of the C.F. During RESET process, CF ruptures starting from TE till it dissolves completely with increase in voltage. The filament gap distance ‘x’ is defined as the gap between active electrode layer (T.E) and the tip of the C.F.
Thus, for the SET process, parameter ‘W’ acts as state variable, while for RESET, parameter ‘x’ acts as state variable. Therefore, \(\frac {dx}{dt}\) and \(\frac {dw}{dt}\) define the dynamics of the device during the SET/RESET transition.
During the first reset process, CF reduction rate, i.e. release of O 2– , is by the electrode is expressed as [142]:
$$ {\frac{dx}{dt}} =a \times f\times \exp \bigg({\frac{- E_{i}-\gamma Z_{e}V}{k_{B}T}} \bigg) $$ (10)For O 2– hopping within the oxide layer, the CF reduction rate with ‘a’ being the distance between two V0 is given as [142]:
$$ {\frac{dx}{dt}} =a \times f\times \exp \bigg({\frac{- E_{h}}{k_{B}T}} \bigg) {\text{Sinh}} \bigg({\frac{ a_{h}Z_{e}E}{k_{B}T}} \bigg) $$ (11)For the case of RESET process when dominated by recombination between O 2– and V0 is expressed as [142]:
$$ {\frac{dx}{dt}} =a \times f\times \exp \bigg({\frac{- \Delta E_{r}}{k_{B}T}} \bigg) $$ (12)In the initial step of the SET process dominated by recombination of oxygen vacancies with thin CF initially grown is given by [142]:
$$ {\frac{dx}{dt}} =-a \times f_{e}\times \exp \bigg({\frac{- E_{a}-\alpha_{a} Z_{e}E}{k_{B}T}} \bigg) $$ (13)Here, Z и α г are the fitting parameters.
For the second step, CF grows along its radial direction and is defined as [142]:
$$ {\frac{dw}{dt}} =\bigg(\Delta w + {\frac{\Delta w^{2}}{2w}} \bigg) \times f_{e}\times \exp \bigg({\frac{- E_{a}-\gamma Z_{e}v}{k_{B}T}} \bigg) $$ (14)The current flowing through the device is modeled as a correlation of hopping current with voltage and gap distance expressed by [134] as:
$$ i =i_{0}. \exp \bigg({\frac{-x}{x_{T}}} \bigg) {\text{Sinh}} \bigg({\frac{v}{v_{T}}} \bigg) $$ (15)This model is validated in HfO x /TiO x system [141, 142], and a pretty accurate match between the experimental and simulation results is obtained. Although this model accounts for the significant processes which affect the RRAM operation, however, it has some limitations. The most critical one is being incompatible with the SPICE and Verilog-A.
Filament Dissolution Model
This model was developed exclusively for unipolar RRAM devices by Russo et al. [143–145], however was later modified for bipolar RRAM devices [139, 146] also. Filament dissolution model is based on rupture of CF under the effect of significant temperature change caused due to Joule heating.
One of the significant advantages of this model is that it utilizes the simple partial differential equations to account for the device current and temperature changes due to Joule heating as well as the dissolution velocity. The conduction of current within the device is described by Poisson’s equation [144] as:
$$ \triangledown \times \bigg({\frac{1}{\varphi}\triangledown_{v}} \bigg) =0 $$ (16)Here, φ is the oxide resistivity and v defines the electric potential due to the application of external bias voltage to one of the electrodes while the other electrode is connected to ground.
The CF is divided into a number of mesh grids and at each point of the mesh grid the temperature is calculated to describe the rupture of CF. The Fourier steady-state heat equation describes this effect as [144]:
$$ -\triangledown \times \bigg(k \triangledown T \bigg) =\varphi J^{2} $$ (17)где k represents the oxide layer thermal conductivity, J is the current density and T is the device temperature.
The temperature ‘T’ of the device increases to the critical temperature, after which the device is reset and the CF dissolution takes place. The dissolution factor is modeled as [144]:
$$ V_{\text{DIS}} =V_{\text{DIS}-F}. \exp \bigg({\frac{- E_{a}}{k_{B}T}} \bigg) $$ (18)где E а is the activation energy, k б is the Boltzmann constant, V DIS−F is a fitting parameter and V DIS is velocity of CF boundary towards symmetry axis.
The resistivity of CF is temperature-dependent and is described as [144]:
$$ \varphi_{\text{CF}} (T) =\varphi_{\mathrm{CF-RT}} \Big[ 1 + C (T-T_{0}) \Big] $$ (19)где C is the experimentally calculated temperature coefficient of resistivity and φ C F −R Т is the standard CF resistivity at room temperature.
COMSOL Multiphysics Software [147] is used for solving the coupled equations for this RRAM model due to its multiphysics capabities and ability to handle such simulations.
Bocquet Bipolar Model
Bocquet bipolar model [148] describes the bipolar oxide-based resistive switching memories utilizing a physics-based modeling approach. Bocquet bipolar model describes the electroforming process of RRAM device, inaddition to utilizing some of the characteristics from Bocquet unipolar model [149] and modifies them significantly according to the bipolar switching characteristics. In this model, the radius of the CF is the internal state variable which effectively governs the switching rate.
To model the electroforming stage, Bocquet bipolar model utilizes electroforming rate (τ Form ) which details the mechanism of conversion to switchable sub-oxide from pristine oxide. The electroforming stage is modeled as [148]:
$$ \tau_{\text{form}} =\tau_{\text{form}0} \times \exp \bigg({\frac{E_{a\text{Form}}-q \times \alpha_{s} \times V_{\text{cell}}}{k_{B}\times T}} \bigg) $$ (20) $$ {\frac{dr_{\text{CFmax}}}{dx}} ={\frac{r_{\text{work}}-r_{\text{CFmax}}}{\tau_{\text{form}}}} $$ (21)где E а Form is the activation energy for electroforming, τ form0 is the nominal forming rate, α s is the charge transfer coefficient, V cell is the voltage applied between the top and bottom electrodes, r CF is the radius of CF which varies from 0 to r CFmax , q is the elementary charge of electron, T is the temperature of the device and k B is the Boltzmann constant.
The electrochemical redox reaction derived from Butler-Volmer equation [150] is used to describe the SET/RESET operation as [148]:
$$ \tau_{\text{Red}} =\tau_{\text{Redox}} \times \exp \bigg({\frac{E_{a}-q \times \alpha_{s} \times V_{\text{cell}}}{k_{B} \times T}} \bigg) $$ (22) $$ \tau_{Ox} =\tau_{\text{Redox}} \times \exp \bigg({\frac{E_{a}+q \times (1 - \alpha_{s}) \times V_{\text{cell}}}{k_{B} \times T}} \bigg) $$ (23)Here, τ Red и τ Ox are the reduction and oxidation rates, respectively. τ Redox is the effective reaction rate considering both reduction and oxidation reactions.
The switching rate is obtained by coupling the above two equations as [148]:
$$ {\frac{dr_{CF}}{dt}} ={\frac{r_{\text{CFmax}}-r_{\text{CF}}}{\tau_{\text{red}}}} - {\frac{r_{\text{CF}}}{\tau_{\text{Ox}}}} $$ (24)Bocquet bipolar model is a quite comprehensive model as it includes the temperature effects as well. The local filament temperature is coupled using heat equation and is given in Eq.(25), the temperature considering a cylindrical-shaped filament is given in Eq. (26). The maximum temperature reached into CF at x =0, the middle of the filament is given in Eq. (27) and the equivalent electrical conductivity in the work area (σ eq ) is given in Eq. (28).
$$ \sigma_{x} \times F(x)^{2} =- k_{th}.{\frac{d^{2}T(x)}{dx^{2}}} $$ (25) $$ T(x) =T_{\text{amb}}+{\frac{V^{2}_{\text{cell}}}{2. L^{2}_{x}.k_{th}}} \bigg({\frac{L^{2}_{x}}{4}- x^{2}} \bigg) \sigma_{eq} $$ (26) $$ T =T_{\text{amb}}+{\frac{V^{2}_{\text{cell}}}{8. k_{th}}} \sigma_{eq} $$ (27) $$ \sigma_{eq} =\sigma_{CF}.{\frac{r^{2}_{\text{CF}}}{r^{2}_{\text{work}}}} - \sigma_{Ox}. {\frac{r^{2}_{\text{CFmax}}-r^{2}_{\text{CF}}}{r^{2}_{\text{work}}}} $$ (28)where (σ x ) is the local electrical conductivity, F ( x ) is the local electric field, σ CF is the electrical conductivity of the conductive filament, k th is the thermal conductivity and T amb is the ambient temperature.
It must be mentioned here that temperature increases with increase in radius of the CF, resulting in self-accelerated reaction due to a positive feedback loop. The self-limited reaction also referred to as SOFT reset [151], on the other hand, occurs due to the decrease in temperature and radius of the CF during RESET operation.
The total current flowing in OxRRAM is the sum of currents flowing in the conductive area (I CF ), the conduction through switchable sub-oxide (I sub−oxide ) and conduction through unswitched pristine oxide (I pristine ). The total current is as [148]:
$$ I_{\text{cell}} =I_{\mathrm{sub-oxide}} + I_{\text{CF}} + I_{\text{Pristine}} $$ (29) $$ I_{\text{CF}} =F.\pi. \sigma_{CF}.r^{2}_{CF} $$ (30) $$ I_{\mathrm{sub-oxide}} =F.\pi. \sigma_{Ox}. \big(r^{2}_{\text{CFmax}}- r^{2}_{CF}\big) $$ (31) $$ I_{\text{Pristine}} =S_{cell}.A.F^{2}. \exp {\frac{-B}{F}} $$ (32) $$ A ={\frac{m_{e}.q^{3} }{8\pi.h.m^{ox}_{e}.\phi_{b} }} $$ (33)The parameter B e is the metal-oxide barrier height (ϕ б )-dependent and is given as [148]:
$$ if \phi_{b}\geq qL_{x}F:B_{e} ={\frac{8 \pi \sqrt{2m^{ox}_{e} }}{3\times h\times q}} \Big[ \phi^{{\frac{3}{2}}}_{b}- (\phi_{b}-qL_{x}E)^{{\frac{3}{2}}} \Big] $$ $$ \text{otherwise}, B_{e} ={\frac{8 \pi \sqrt{2m^{ox}_{e} }}{3\times h\times q}} \times \phi^{{\frac{3}{2}}}_{b} $$ (34)where m e and \(m^{ox}_{e}\) are the effective electron masses into the cathode and oxide respectively, F =\(\frac {V_{\text {cell}} }{L_{x}}\) is the electric field across the active layer, h is the Planck constant and S cell is the section of the RRAM cell.
Discrete solutions are required to implement the model in an electrical simulator. This model accounts well in that aspect, making it suitable for simulation involving electrical circuits. This model implements equations in Eldo circuit simulator [152]. The discrete solutions are given as [148]:
$$ r_{\text{CFmax}_{i+1}} =\big(r_{\text{CFmax}_{i}}- r_{\text{work}} \big) \times e^{ {\frac{-\Delta t}{{\tau}_{\text{form}}}} } + r_{\text{work}} $$ (35) $$ r_{CF_{i+1}} =\bigg(r_{CF_{i}}- r_{\text{CFmax}_{i}} \times {\frac{\tau_{eq}}{\tau_{\text{Red}}}} \bigg) \times e^{ {\frac{-\Delta t}{{\tau}_{eq}}} } + r_{\text{CFmax}_{i}} \times {\frac{\tau_{eq}}{\tau_{\text{Red}}}} $$ (36) $$ \text{where} { \tau_{eq}} =\frac{\tau_{\text{Red}}\times \tau_{\text{Ox}} }{\tau_{\text{Red}}+\tau_{\text{Ox}}} $$ (37)This model has been verified against electrical characterization from an HfO2 -based system [153]. An important feature of this model is that it can account effectively for device to device variability [154, 155]. One of the major limitations of this model is the lack of current or voltage threshold.
This section presents in detail various characteristics and features of the RRAM models. A comparative analysis of the RRAM models discussed in this work is presented in Table 5.
Applications of RRAM
RRAM is seen as one of the standout candidates among the emerging memory technologies that has the potential for reforming the memory hierarchy primarily due to its high speed, the capability of non-volatile data storage, enhanced storage density and logic computing function. The various novel applications of RRAM are discussed in this section.
>Non-volatile Logic
The instruction codes and the data are transferred by making use of buses between various units in a computer system having von Neumann architecture because of the separate computing and memory unit. This data transferring process results increased energy consumption and time delay, which is commonly referred to as ‘von Neumann bottleneck’. For reducing the impact of von Neumann bottleneck [156], the computing process which utilizes RRAM crossbar array is suggested which alters the memory and computing operations in the same core. In addition, to obtain high integration density and low cost [157], two-terminal compact device structure of RRAM and its 4F 2 array architecture are highly beneficial. For example, to obtain simple Boolean logic functions such as ‘logic NOT’, ‘logic AND’, and ‘logic OR’, we require multiple transistors and each single transistor takes 8−10F 2 площадь. These logic functions can be realized by making use of two or three RRAM cells, resulting in total approximate area of around 10F 2 only [158].
Till date, several methods have been suggested for realizing Boolean logic functions [159, 160]. Boolean computing is significantly more established compared to existing non-Boolean computing paradigms such as neuromorphic computing and quantum computing. Therefore, energy and cost-efficiency of CPU or MCU can be enhanced without the need to develop new algorithms or software, although there is still a lack of technical solution on how to implement complex computing tasks in a crossbar array. Thus, most of research to date focusses on only basic logic level demonstration as it becomes quite complex to implement a whole computing unit using RRAM array.
Neuromorphic Computing
To overcome ‘von Neumann bottleneck’, one of the effective ways is brain-inspired neuromorphic computing which has shown promising potential in a wide range of complex and cognitive tasks like visual/audio recognition, self-driving, and real-time big-data analytics. Compared to CMOS-based neuromorphic network, neuromorphic computing based on RRAM-array offers advantages in terms of on-chip weight storage, online training, and scaling up to much larger array size [161–163]. In addition, the processing speed of RRAM improves by three orders of magnitude, whereas the power consumption rate is reduced by four orders of magnitude [164].
For realizing hardware-implemented neuromorphic computing paradigms, two methods are suggested:one among the strategies mimics the structure and working mechanism of biological neural networks while the other method works on accelerating the existing artificial neural network (ANN) algorithms. In a neural network, a synapse is used to transfer spikes between different neurons in addition to storing information about the transferring weights. The information regarding weights can be acquired through certain learning rules such as spike-time-dependent plasticity (STDP) and spike-rate-dependent plasticity (SRDP) [165–167]. Although some of the works reported in the literature have tried to emulate such learning rules on RRAM devices, it is however quite complicated to extend such types of bioinspired learning rules to a complex task as the theoretical algorithm is still lacking.
A practically viable approach is to map an ANN to a RRAM-based neuromorphic network directly. Some advanced tasks such as pattern and speech recognition have been demonstrated based on this method [166–169]. Although very promising, RRAM-based synapse is still far from being applied as various issues such as material optimization, variation suppressing, control circuit design, architecture, and algorithms design for analog computing need to be addressed effectively.
Security Application
The security aspect has become more prominent with rapid developments in the field of information technology; thus, there is a need for hardware-based security-integrated circuits. In contrast to security circuits based on CMOS logic which exploits the random nature of the semiconductor manufacturing process, security circuits based on RRAM are more robust to attacks of various types due to its completely random switching mechanisms [170, 171]. It must be noted that for security applications, larger variation of RRAM device parameters such as random telegraph noise (RTN), resistance variations and probabilistic switching is desirable, which is quite different from memory applications that require a smaller degree of variation among numerous parameters.
A novel security feature commonly referred to as physical unclonable function (PUF) [172], based on RRAM is proposed for device authentication (strong PUF) and key generation (weak PUF) applications. Significantly larger number of input-output pairs [also called challenge-response pair (CRP) are required for strong PUF, while only a small amount of CRPs of extremely higher reliability are required for weak PUF [173]. Although, PUFs based on RRAM have demonstrated remarkable performance; however, still more practical demonstrations and further evaluations are required to work out the maturity of this new primitive within the field of hardware security.
Non-volatile SRAM
Volatile memory technologies like SRAM and DRAM may consume over half of the static power within the current mobile SoC chips. Thus, to attain fast parallel memory operations, reduced area and low-energy consumption, RRAM-based non-volatile SRAM (nvSRAM) was proposed [174] in which two RRAM cells are stacked on eight transistors, forming an 8T2R structure. Also, non-volatile ternary content-addressable memory (TCAM) having 4T2R cell structure [175] and non-volatile flip flops having reduced stress time and write power based on RRAM have been demonstrated recently [176].
Challenges and Future Outlook
During the past several years, research in the field of emerging memory technologies has grown significantly and several prototype RRAM products have been developed demonstrating the potential for high-speed and low-power embedded memory applications. RRAM is one of the most promising memory technologies because of the advantages of simple structure, compatibility with the existing CMOS technology, good switching speed and ability to scale to the smallest dimensions. As a matter of fact, currently the Flash memory technology is facing difficulties to reduce to lower dimensions and as such RRAM is emerging as a potential replacement especially for fast operation and medium size storage density memory applications.
One of the most critical aspects that needs to be thoroughly investigated is that of the reliability of RRAM. A mechanism must be developed to ensure the detection of the operation failure of the device. Also designing circuits, e.g. a test element group (TEG) design for robust signal sensing, is one of the critical challenges for the emergence of RRAM devices. To achieve high-density memory operation in RRAM, the 1D1R operation is essential. This can be realized by operating the RRAM device in the unipolar mode. However, in the unipolar operation, higher current is needed for the reset process as compared to that of the bipolar operation. This is due to the fact that thermal effect plays a significant role in the unipolar reset process. Thus, to realize a high-density 1D1R RRAM array, the thermal effects both inside and outside a memory element needs to be considered. Also note that till date, in a single RRAM device, no technology has simultaneously reported fast switching, low power, and stable operation. Although, the endurance of RRAM has been reported as high as 10 12 [59], it is still not enough to be able to replace DRAM. The RRAM possesses the switching speed fast enough for DRAM replacement and the materials used in the fabrication for RRAM are very similar to that of DRAM, it becomes a critical challenge to improve the endurance characteristics of RRAM. To improve the endurance characteristics, it is necessary to control the oxygen movement between the electrode and the oxide layer at the interface. It is suggested to insert the second metal layer at the interface which can be easily oxidized and acts as an oxygen reservoir to prevent oxygen from penetrating into the electrode during the resistance switching. The most critical challenge hindering RRAM development till date is the proper understanding of the device switching mechanism which is since long being debated by researchers across the globe. The inconsistent switching mechanism of various reported RRAM devices is believed to be because of variation in the fabrication process, and thus, more rigorous analysis is needed in the future for obtaining a better understanding of the switching mechanism of RRAM devices. The aforesaid issues need to be handled effectively before implementing RRAM in future memory applications. Although, RRAM is highly attractive for use in neuromorphic computations, the biggest challenge to industrialize RRAM lies in its ability to tackle the variability issues, not only at nominal operating conditions but also at high temperatures before they can be used in a wide variety of applications.
Conclusion
This review article provides a brief introduction into the advancement of the memory architecture, the current trends and the limitations while providing a valuable insight into the field of emerging memory technologies. A detailed discussion, highlighting the importance of RRAM, its structure, working mechanism, and classification, has been presented. The key performance parameters and their effect on the RRAM operation has also been detailed within the current manuscript. An elaborate study on the MLC capability of RRAM, along with the methodology have been presented. The manuscript also discusses the important features of the widely accepted RRAM models. The implementation of RRAM for various important applications such as non-volatile logic, neuromorphic computing, security, and non-volatile SRAM have been highlighted. Although, significant success has been achieved in RRAM technology; however, more work is needed as RRAM still suffers from various challenges in terms in terms of high operation current, lower resistance ratios, and reliability issues. More efforts in research should aim to develop methods to achieve faster programming/erasing, lower power consumption, enhancing the storage density by implementing multilevel storage capability and improvement in the fabrication process for enhanced uniformity. In addition, renewed focus should be towards use of RRAM in embedded memory and non-volatile logic applications as breakthroughs in these fields are much more exciting and significant. With continued work and improvements, it is imperative that RRAM devices will be a standout technology for future non-volatile memory applications.
Доступность данных и материалов
Не применимо.
Сокращения
- RRAM:
-
Резистивная память с произвольным доступом
- MLC:
-
Multilevel cell
- RTN:
-
Random telegraph noise
- DRAM:
-
Dynamic random access memory
- SRAM:
-
Static random access memory
- PCM:
-
Phase change memory
- STT-MRAM:
-
Spin-transfer torque resistive random access memory
- LRS:
-
Low resistance state
- HRS:
-
High resistance state
- MTJ:
-
Magnetic tunneling junction
- MIM:
-
Металл-изолятор-металл
- MoM:
-
Metal-oxide-metal
- PLD:
-
Pulse laser deposition
- ALD:
-
Осаждение атомного слоя
- V set :
-
Set voltage
- V reset :
-
Reset voltage
- V f :
-
Forming voltage
- I CC :
-
Compliance current
- CBRRAM:
-
Conductive bridge resistive random access memory
- OxRRAM:
-
Oxygen vacancies resistive random access memory
- ECM:
-
Electrochemical metallization memory
- VCM:
-
Valence change memory
- CF:
-
Conductive filament
- BE:
-
Bottom electrode
- ТЕМ:
-
Просвечивающая электронная микроскопия
- I-V:
-
Ток-напряжение
- 1T-1R:
-
1-Transistor 1-RRAM
- ANN:
-
Artificial neural network
- STDP:
-
Spike-time-dependent plasticity
- SRDP:
-
Spike-rate-dependent plasticity
- PUF:
-
Physical unclonable function
- CRP:
-
Challenge-response-pair
- nvSRAM:
-
Non-volatile SRAM
- TCAM:
-
Ternary content addressable memory
- TEG:
-
Test element group
Наноматериалы
- 13 типов огнеупорных материалов и их применение
- Повышение производительности и безопасности носимых устройств Интернета вещей
- Cervoz:выбор подходящего флеш-хранилища для промышленных приложений
- Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на по…
- Резистивная память ZrO2 / ZrO2 - x / ZrO2 без соблюдения нормативных требований с управляемым межфазным режимом перек…
- Интегрированная RRAM 4T SRAM с самоторможением резистивной коммутационной нагрузки с помощью логического процес…
- Механизм проводимости и повышение выносливости в RRAM на основе HfO2 с лечением нитридом
- Коллективное исследование моделирования и имитации резистивной оперативной памяти
- Иерархически макропористые графитовые нановебы, демонстрирующие сверхбыструю и стабильную производительно…
- Синтез и характеристики суперконденсатора упорядоченных мезопористых углеродных композитов, легированных …



