Дизайн тестовой таблицы для плазменного повреждения межметаллического диэлектрика в процессах FinFET Cu BEOL
Аннотация
Межблочные соединения высокой плотности, обеспечиваемые передовыми технологиями CMOS Cu BEOL, приводят к близко расположенным металлическим слоям. Металлические линии с высоким аспектным отношением требуют обширных процессов плазменного травления, что может вызвать проблемы с надежностью межметаллических диэлектрических слоев (IMD). В этом исследовании представлены недавно предложенные тестовые образцы для оценки эффекта индуцированного плазмой заряда на целостность интермодуляционных искажений между близко расположенными металлическими линиями. Обнаружены и всесторонне проанализированы сильные корреляции между интенсивностью заряда плазмы и повреждениями, обнаруженными в слоях IMD.
Введение
Внутренние процессы на основе меди (BEOL) широко используются по мере того, как технологии переходят на режим менее 100 нм. Плотно упакованные межсоединения состоят из переходных отверстий с высоким соотношением сторон, а металлические линии стали возможными благодаря серии процессов плазменного травления [1,2,3]. Хорошо известно, что обработка высокоэнергетической плазмой может привести к значительной деградации и скрытым повреждениям в диэлектрических пакетах затворов транзисторов, которые, как полагают, являются основным путем разряда во время процессов зарядки, вызванной процессом. Чтобы избежать проблем, связанных с надежностью диэлектрика затвора, производители ИС обычно предоставляют правила и рекомендации для разработчиков, которые ограничивают размер и длину металлических слоев межсоединений [4, 5]. При увеличении количества металлических слоев в сложных системах электропроводки трудно избежать пути разряда через межметаллическую диэлектрическую пленку во время индуцированной процессом зарядки. С введением материала с низким k в процессы BEOL [6, 7], уменьшилось ухудшение проблемы задержки RC, изоляционные пленки могут быть более восприимчивыми к зарядным напряжениям [8, 9]. Повреждения, возникающие в результате индуцированных плазменным зарядом напряжений на компактных межкомпонентных структурах, ответственных за создание сложных разводок BEOL, могут сильно повлиять на производительность и надежность современных КМОП ИС. В это исследование мы включаем ранее описанные регистраторы ПИД-регулирования на месте [10,11,12] с недавно предложенными схемами дифференциального тестирования для мониторинга возможного повреждения интермодуляционных искажений, когда дополнительный путь разряда становится возможным в рамках усовершенствованных процессов Cu BEOL. Уровни заряда плазмы, сообщаемые записывающим устройством в разных местах на пластине, могут быть соотнесены с повреждением плазменной зарядки на IMD-пленках с помощью новых тестовых шаблонов. Поведение при отказе, вызванном напряжением, в структурах IMD можно затем легко выявить с помощью этих тестовых шаблонов, которые можно использовать в стандартной тестовой структуре для регулярного мониторинга новых режимов отказа и возможных проблем с надежностью IMD.
Структура и методология устройства
Результаты анализа отказов интегральных схем FinFET предполагают, что могут возникать скрытые повреждения, связанные с увеличением состояний ловушек внутри межметаллических диэлектрических слоев между двумя близко расположенными изолированными межсоединительными структурами, как показано на рис. 1. Поскольку ширина линии и расстояние между сквозными и металлическими межсоединениями заранее решительно сокращают процессы CMOS BEOL, заряды, собираемые на больших металлических проводах, служат в качестве антенн, могут разряжаться через интермодуляционные искажения через металлы и переходные отверстия / затворы и металлические провода, что приводит к возникновению сильнополевых и / или сильноточных напряжений на этих диэлектрических пленках. Поместив встроенный ПИД-регистратор [10,11,12] рядом с двумя дифференциальными тестовыми образцами на каждом кристалле, можно сначала установить эталонные уровни заряда плазмы на 12-дюймовой пластине.
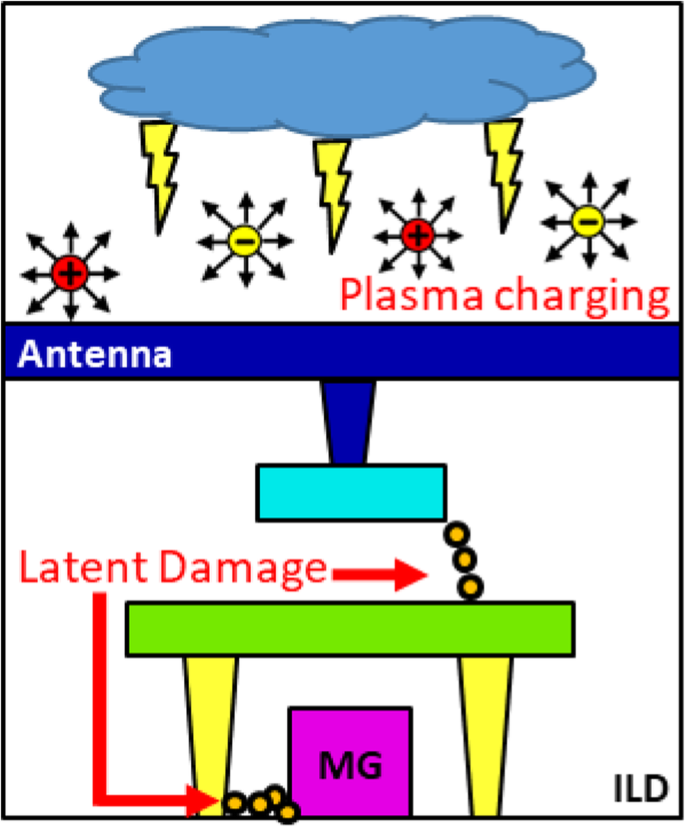
Вызванные плазмой повреждения межметаллических диэлектрических слоев между плотно упакованными схемами межсоединений могут быть связаны со скрытой деградацией целостности изоляции
Чтобы обеспечить прохождение зарядного тока плазмы через диэлектрический слой между металлическими слоями, узел M2 на тестовой таблице на рис. 2 изолирован до изготовления антенной структуры. Предлагаются две новые конструкции дифференциальной испытательной таблицы, направленные на увеличение вероятности возникновения скрытых повреждений во время плазменных зарядов напряжений, которые показаны на рис. 2a, b. Устройство с диаграммой направленности типа I будет испытывать сильное напряжение тока только тогда, когда электроны собираются на соответствующей антенне. Это связано с тем, что разрядный ток выпрямляется последовательно переходом n + / p на проводящем пути. Тогда как устройство с рисунком типа II подвергается нагрузкам I в обоих направлениях [13]. А именно, зарядка ионов и электронов будет регистрироваться на этом контрольном устройстве. Следовательно, образцы в этом исследовании изготавливаются по стандартному процессу FinFET / Cu BEOL в технологическом узле 16 нм. Антенные конструкции ПИД-регистратора, а также устройства с диаграммами направленности типа I и II, размещенные на каждом кристалле, спроектированы с использованием большой металлической 3 конструкции. Оба типа устройств мониторинга спроектированы с дифференциальной конфигурацией, которая может усилить и впоследствии свести к минимуму шум несоосности, который может привести к ошибочным показаниям на эффектах ПИД-регулятора.
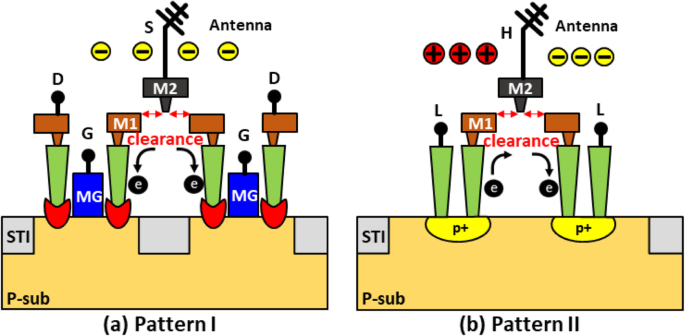
Иллюстрации недавно предложенных шаблонов дифференциальных тестов, предназначенных для подчеркивания эффекта скрытого повреждения, вызванного плазмой, a отрицательный и b двунаправленные напряжения, при которых зазор между металлическим слоем установить равным 14 нм
Экспериментальные результаты и обсуждение
Данные на рис. 3 получены путем применения развертки напряжения на металле 2 от 0 до 20 В со скоростью развертки 0,7 В / с, при этом напряжение пробоя и ток утечки интермодуляционных искажений с обеих сторон нескольких различных устройств с испытательной таблицей Затем меня можно будет получить и сравнить. При изготовлении большой антенны М3 82000 мкм 2 , плазменный процесс вызовет заряд антенны. Ожидается, что накопленный заряд будет разряжаться по пути с наименьшим сопротивлением. Данные показывают, что некоторые образцы демонстрируют ранний пробой диэлектрика, в то время как интермодуляционные искажения на других устройствах остаются относительно неповрежденными с низкой утечкой.
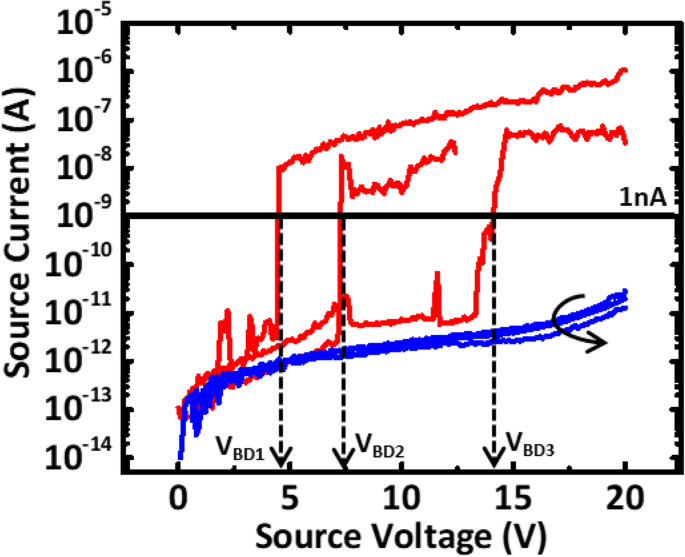
Ток утечки измерен на устройствах с дифференциальными тестовыми таблицами, подключенными к антенне Metal-3 82000 мкм 2 . V BD определяется как напряжение при достижении током 1 нА при длине переходного отверстия 32 нм
В случае зарядки ожидается, что более слабая сторона будет обслуживать доминирующий путь разряда, что приведет к более заметному дисбалансу в уровне повреждений между левой и правой сторонами. Следовательно, только устройства с большим V BD разница между левой и правой сторонами, скорее всего, связана с зарядкой плазмы. Следовательно, меньшее V BD в IMD разбивка по паре регистрируется как уровень, коррелированный с уровнем напряжения PID. На рис. 4а показаны три типичных типа характеристик, которые обнаруживаются на образцах на разных штампах на пластине. Эти образцы можно разделить на категории без разбивки на одну сторону, на одностороннюю разбивку или на группы с двухсторонней разбивкой. Часть устройств, показывающая конкретные характеристики каждой группы, показана на круговой диаграмме на рис. 4b. Мы обнаружили, что на образцах без антенны изменение характеристик одностороннего пробоя значительно меньше. Симметричное поведение с обеих сторон наблюдается в большинстве устройств, которые не испытывают напряжения плазменной зарядки. Это также предполагает, что большая часть асимметричных характеристик в дифференциальной паре возникает из-за зарядных напряжений при прикреплении антенной конструкции.
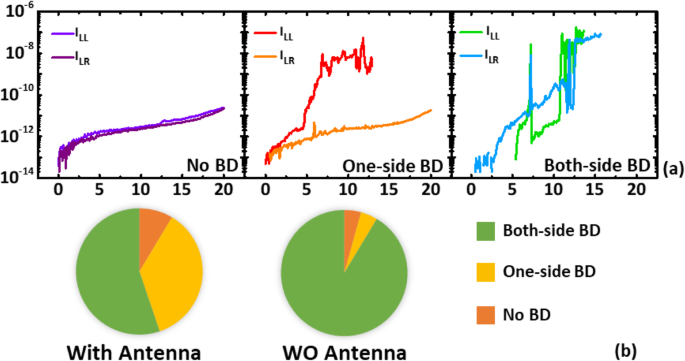
а Различные типы характеристик пробоя тестовых пар на пластине и b сравнение процентной доли образцов, демонстрирующих характерные типы характеристик пробоя на парах устройств более 60 штампов
Используя V BD полученные описанным выше способом карты пластин уровня PID и V BD от устройств типа I и II сравниваются схемы на рис. 5. Высокое сходство между картами пластин V BD от устройств мониторинга обоих типов, а соответствующие контрольные уровни зарядки получаются от записывающего устройства PID, см. рис. 5a. Считается, что напряжение ФИД регистрирует события зарядки как электронов, так и ионов во время процессов с металлом [14]. Однако было обнаружено, что образцы на пластине в основном подвержены большему заряду электронов, чем ионам [14]. Мы полагаем, что между пластиной на рис. 5а, б прослеживается некоторая региональная корреляция. В то время как карта пластины на рис. 5c из схемы II, которая не имеет очевидного сходства с рис. 5a, предполагает, что двунаправленное напряжение [15] может привести к вторичному воздействию на диэлектрические слои, что требует дальнейшего исследования. Измеренные напряжения пробоя из новых тестовых шаблонов в сравнении с эталонными уровнями ПИД-регулятора, сравниваемые на рис. 6, дополнительно показывают, что чем выше уровень ПИД-регулятора на кристалле, тем ниже его V BD новые тестовые шаблоны. Кроме того, значительная отрицательная корреляция между V BD и уровни заряда плазмы могут быть установлены. Чтобы исследовать влияние однонаправленных и двунаправленных напряжений на повреждение IMD, V BD Результаты измерений, полученные с помощью шаблонов типа I и II, суммированы и сопоставлены на рис. 7. V BD Распределение, полученное от устройств на 60 кристаллах по пластинам, указывает на то, что устройства, испытывающие двунаправленные зарядные напряжения, с большей вероятностью покажут пробой IMD при более низком напряжении. Это можно объяснить асимметричным уровнем напряжения при изменении полярности в IMD [16]. Более того, ток утечки, вызванный напряжением (SILC), измеренный при напряжении 10 В через диэлектрический слой, является еще одним показателем увеличения состояний ловушек [17] в пленке IMD. Чтобы дополнительно минимизировать эффект отклонения от кристалла к кристаллу, вызванный изменением процесса, коэффициент утечки из каждой пары используется в качестве показателя для дальнейшей оценки повреждения IMD. На рисунке 8 показано, что по существу нет корреляции между коэффициентом тока утечки на двух типах устройств на одном кристалле. То есть несоосность между слоями металла 1 и переходного отверстия 2 оказывает минимальное влияние на оба рисунка. Отметил этот коэффициент текущей ликвидности, R , определяемый как I LR / Я LL , является лучшим показателем для удаления шума из-за вариаций этих шаблонов от кристалла к кристаллу. На полностью несмещенных устройствах основное напряжение зарядки возникает справа или слева, что должно быть полностью случайным. Здесь некоторые эффекты смещения обнаруживаются в отношениях тока, когда его распределительная среда не равна 1. Чтобы гарантировать, что учитываются только повреждения, вызванные эффектами заряда плазмы, R - нормализованный коэффициент тока, как показано на рис. 9. На графике распределения по центру пластины R N от устройств типа I следует образец с достаточно близким уровнем напряжения плазмы от записывающих устройств ФИД. С другой стороны, R N от устройств, чувствительных к двунаправленному напряжению, нельзя полностью объяснить зарегистрированными уровнями PID. Это может быть вызвано значительно более высоким R N уровень в устройствах схемы II, в результате событий зарядки дополнительных ионов через пластину.

Схемы и карты пластин, показывающие распределение ( a ) напряжение PID и VBD из ( b ) тестовый шаблон I и ( c ) II, демонстрирующий региональный эффект в области, обведенной кружком, вызванный плазмой повреждения заднего диэлектрического слоя, который может быть отнесен к региональным уровням заряда плазмы
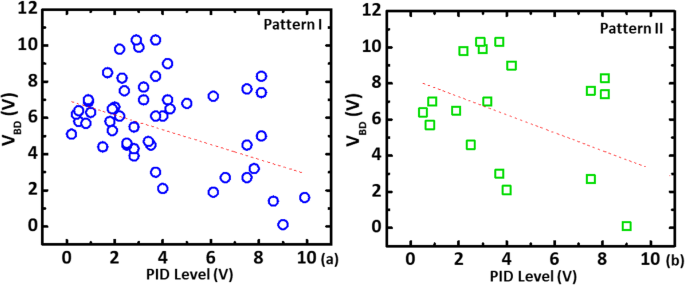
Корреляции между VBD от уровней PID для a образец I и b образцы образца II, соответственно [10,11,12]
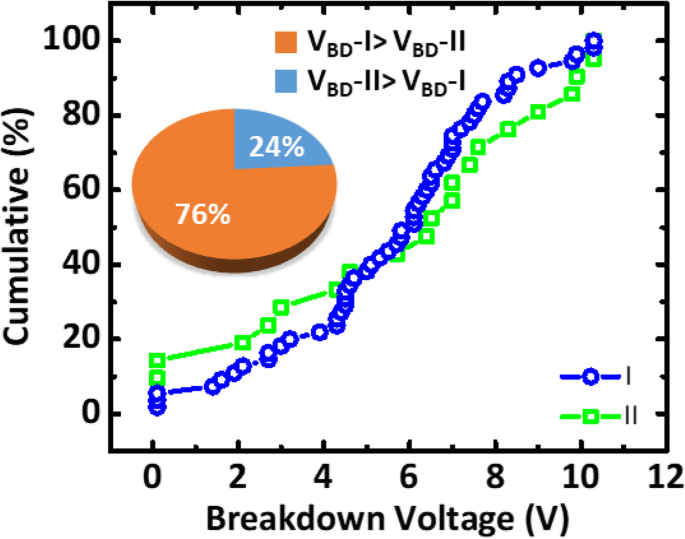
Сравнение совокупного распределения V BD от 60 штампов на пластине и части образцов, показывающей более высокое напряжение пробоя в схеме I по сравнению с шаблоном II

Коэффициент тока утечки левой и правой стороны схем I и II показывает отсутствие эффекта систематического рассогласования этих образцов
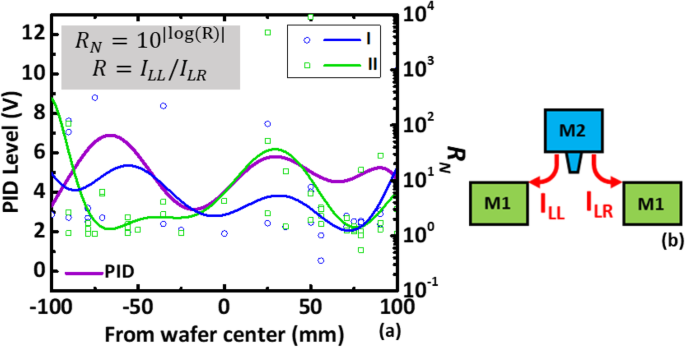
а Нормализованные отношения тока из образцов схемы I и II в центре пластины по сравнению с соответствующими уровнями PID и b определение тока утечки слева ( I LL ) и вправо ( I LR )
Выводы
Влияние индуцированной плазмой зарядки на целостность IMD-пленок исследуется с помощью недавно предложенных схем дифференциального тестирования на усовершенствованных платформах FinFET Cu BEOL. Установлено, что повреждения в виде раннего пробоя и увеличения SILC в слоях IMD напрямую коррелируют с уровнями заряда плазмы на 12-дюймовых пластинах.
Доступность данных и материалов
Не применимо.
Наноматериалы
- Введение в производство металлов
- 6 Важные соображения при проектировании для 3D-печати из металла
- Руководство по проектированию для обеспечения технологичности – Часть 1
- 5 советов по проектированию листового металла
- 6 советов по оптимизации конструкции для проекта по изготовлению металлоконструкций
- Что такое идентификация металлов? - Тесты и советы по идентификации
- Как оптимизировать проекты для проектов по изготовлению металлоконструкций
- Вопросы проектирования импеданса гибко-жесткой печатной платы
- Советы по проектированию гибки листового металла
- Советы по проектированию для 3D-печати с прямым лазерным спеканием металла



