Зависимое от полярности программирование поведения памяти на аморфных тонкопленочных транзисторах In – Ga – Zn – O с захватом заряда ZnO, осажденным атомным слоем Слой
Аннотация
Память на тонкопленочных транзисторах (TFT) на основе аморфного In – Ga – Zn-O (a-IGZO) привлекает много внимания для будущих приложений системы на панели; однако они обычно обладают низкой эффективностью стирания. В этой статье мы исследуем поведение программирования в зависимости от полярности напряжения a-IGZO TFT-памяти с нанесенным на атомный слой слоем захвата заряда ZnO (CTL). Оригинальные устройства демонстрируют электрически программируемые характеристики не только при положительном смещении затвора, но и при отрицательном смещении затвора. В частности, последний может обеспечить гораздо более высокую эффективность программирования, чем первый. При подаче импульса смещения затвора +13 В / 1 мкс устройство показывает сдвиг порогового напряжения (ΔV th ) 2 В; и ΔV th составляет -6,5 В для импульса смещения затвора -13 В / 1 мкс. В случае программирования 12 В / 1 мс (P) и -12 В / 10 мкс стирания (E), окно памяти размером 7,2 В может быть достигнуто при 10 3 циклов P / E. Путем сравнения ZnO CTL, отожженных в O 2 или N 2 с свежеосажденной, делается вывод, что кислородная вакансия (V O Связанные с этим дефекты доминируют в характеристиках биполярного программирования устройств памяти TFT. Для программирования при положительном напряжении на затворе электроны инжектируются из канала IGZO в слой ZnO и предпочтительно захватываются на глубоких уровнях однократно ионизированной кислородной вакансии (V O + ) и дважды ионизованной кислородной вакансии (V O 2+ ). Что касается программирования при отрицательном напряжении затвора, электроны легко освобождаются от нейтральных кислородных вакансий из-за мелких доноров и туннелируют обратно в канал. Таким образом, это приводит к высокоэффективному стиранию за счет образования дополнительных вакансий ионизированного кислорода с положительным зарядом.
Фон
Тонкопленочный транзистор (TFT) на основе аморфного индия-галлия-цинка-оксида (a-IGZO) широко изучался для применения в гибких и прозрачных электронных системах [1,2,3,4,5,6,7 , 8,9,10,11,12]. Это объясняется некоторыми специфическими свойствами пленок a-IGZO, такими как хорошая однородность, низкая температура обработки, прозрачность для видимого света и высокая подвижность электронов [13]. Помимо этого, также были предложены энергонезависимые запоминающие устройства a-IGZO TFT, и их возможности энергонезависимого хранения данных расширяют область применения устройства a-IGZO TFT. Как типичная архитектура устройств энергонезависимой памяти, память a-IGZO TFT с плавающим затвором интенсивно исследуется в последние годы. До сих пор в качестве плавающего затвора (т. Е. Среды накопления заряда) исследовались различные материалы, такие как диэлектрики [14, 15], металлические нанокристаллы [16, 17] и полупроводниковые материалы [18,19,20,21] . Поскольку a-IGZO является естественным полупроводником n-типа, а инверсия дырок вряд ли реализуется в a-IGZO TFT при отрицательном смещении затвора, следовательно, память a-IGZO TFT обычно имеет низкую эффективность стирания. Другими словами, большая часть памяти a-IGZO TFT не может быть электрически стерта посредством инжекции дырок из канала [14,15,16]. Тем не менее Zhang et al. [21] изготовили TFT-память с использованием a-IGZO как в качестве слоя улавливания заряда (CTL), так и в качестве канального слоя, который продемонстрировал электрически программируемые и стираемые характеристики, а также хорошее сохранение данных. Между тем, Yun et al. также исследовали характеристики памяти a-IGZO TFT с различным составным IGZO CTL, выявив уменьшающееся окно памяти с увеличением O 2 парциальное давление (P O2 ) при напылении ЦТЛ [18]. Кроме того, Bak et al. сообщили о производительности памяти a-IGZO TFT с ZnO CTL различной проводимости и сделали вывод, что оптимизированная электронная природа структуры запрещенной зоны для ZnO CTL может быть одним из наиболее важных факторов для реализации высокофункциональной памяти TFT на оксиде [20]. Хотя вышеупомянутые запоминающие устройства a-IGZO TFT на основе оксидных полупроводников на основе CTL демонстрируют превосходные скорости электрического программирования / стирания, характеристики биполярного программирования вышеупомянутых устройств не сообщаются, и соответствующие процессы захвата различных зарядов в CTL оксидных полупроводников не приводятся. пока ясно, особенно для улавливания положительных зарядов.
В этой работе биполярная программируемая память a-IGZO TFT была изготовлена с использованием пленки ZnO, осажденной атомными слоями, в качестве CTL. Сравнивая характеристики биполярного программирования запоминающих устройств TFT с данными на момент депонирования, O 2 - или N 2 -отожженных ЦТЛ ZnO обсуждались процессы захвата различных зарядов в слое ZnO. Выявлено, что дефекты, связанные с кислородными вакансиями, доминируют в характеристиках биполярного программирования устройств памяти a-IGZO TFT.
Методы
Пластины Si (100) P-типа с удельным сопротивлением 0,001–0,005 Ом · см очищались с использованием стандартного процесса очистки RCA и использовались в качестве заднего затвора устройства. Затем 35-нм Al 2 О 3 пленки ZnO и 20 нм были нанесены последовательно методом осаждения атомных слоев (ALD) при 250 ° C и 200 ° C, которые служили блокирующим слоем и CTL памяти TFT, соответственно. Следует отметить, что пленка ZnO имеет среднеквадратичную шероховатость 0,553 нм. Впоследствии были выполнены фотолитография и влажное травление для определения CTL ZnO. После этого 8-нм Al 2 О 3 туннельный слой был выращен методом ALD. Прекурсоры диэтилцинка (DEZ) / H 2 O и TMA / H 2 O использовались для выращивания ZnO и Al 2 О 3 фильмы соответственно. После этого пленка a-IGZO толщиной 40 нм была нанесена методом радиочастотного магнетронного распыления в качестве канального слоя при комнатной температуре с использованием InGaZnO 4 цель. Затем активный канал шириной (W) / длиной (L) 100/10 мкм был определен с помощью фотолитографии и травления разбавленной HCl. Контакты истока и стока из Ti / Au (30 нм / 70 нм) были сформированы электронно-лучевым испарением с последующим процессом отрыва. Наконец, все изготовленные устройства были отожжены при 250 ° C в O 2 на 5 мин для улучшения его производительности. Электрические характеристики были выполнены с использованием анализатора параметров полупроводников (Agilent B1500A) при комнатной температуре. Пороговое напряжение (V th ) определяется как напряжение затвора, при котором ток стока равен W / L × 10 −9 A. Концентрация носителей в пленках ZnO была определена из измерений эффекта Холла (Ecopia HMS-3000) при комнатной температуре.
Результаты и обсуждение
На рисунке 1 показаны принципиальные схемы изготовленного устройства памяти a-IGZO TFT при программировании положительного и отрицательного смещения соответственно. Во время электрического программирования на задний затвор подается электрический импульс, и электроды истока и стока заземляются. На рисунке 2 показаны программные характеристики первичных запоминающих устройств в различных условиях. Для безупречного запоминающего устройства он показывает коэффициент включения / выключения ( I на / Я выкл ) 1,5 × 10 7 , полевая подвижность 7,1 см 2 V -1 s −1 и допороговое колебание (SS) 0,67 В / дек. Что касается программирования 80 мс при различных положительных смещениях, I d - V g кривая постепенно перемещается в направлении положительного смещения в зависимости от напряжения программирования, например, результирующий V th сдвиг относительно исходного устройства (ΔV th ) увеличивается с 1,3 до 4,8 В при увеличении напряжения программирования с 8 до 13 В, демонстрируя насыщение программирования при 12 В, как показано на рис. 2a. Такой значительный ΔV th предполагает, что значительные электроны из канала a-IGZO n-типа инжектируются в ZnO CTL. Более того, когда напряжение программирования фиксировано на уровне 13 В, ΔV th медленно увеличивается с 2 до 3,1 В с увеличением времени программирования с 1 мкс до 30 мс, как показано на рис. 2c. Интересно, что когда исходное запоминающее устройство запрограммировано на отрицательное смещение затвора, V th показывает заметный сдвиг в сторону отрицательного смещения, показанного на рис. 2b. При постоянном времени программирования 80 мс ΔV th увеличивается с -5,2 до -7,4 В с увеличением программного смещения с -8 до -13 В. Даже если исходное запоминающее устройство запрограммировано на -13 В на 1 мкс, оно также может демонстрировать ΔV th до −6,5 В, как показано на рис. 2d. Это означает, что очень большое количество электронов освобождается от CTL, в результате чего остается много положительных зарядов.
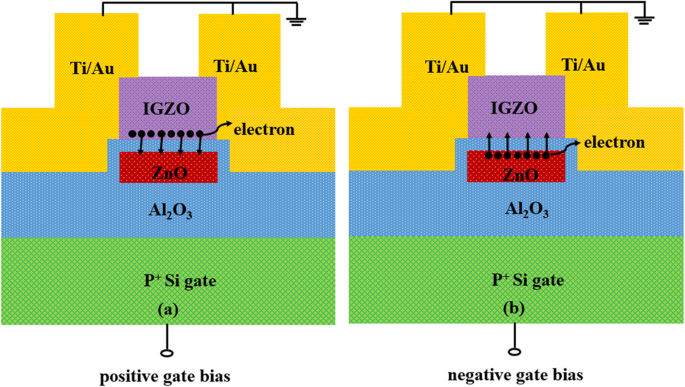
Схематические диаграммы поперечного сечения запоминающего устройства a-IGZO TFT, запрограммированного при положительном смещении затвора ( a ) и отрицательное смещение затвора ( b ) соответственно.
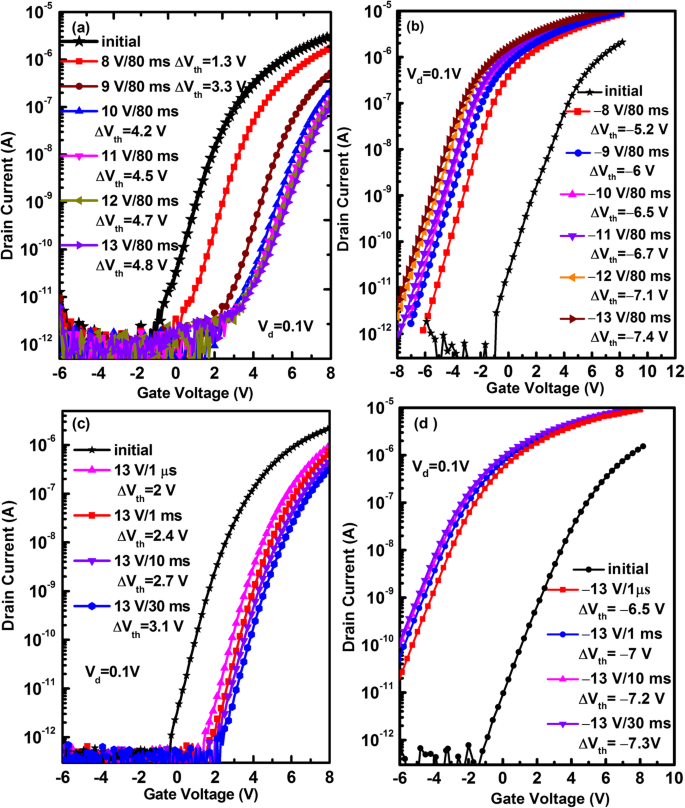
Передаточные кривые устройства памяти a-IGZO TFT и запрограммированные a при различных положительных смещениях затвора в течение постоянного времени 80 мс, b при различных отрицательных смещениях затвора в течение постоянного времени 80 мс, c при 13 В для различного времени программирования и d при −13 В для различного времени программирования. Все кривые передачи для каждой фигуры были измерены на одном устройстве, и все операции программирования выполнялись последовательно.
Чтобы понять эффект захвата заряда слоем ZnO, TFT a-IGZO без ZnO CTL также изготавливаются в качестве управляющих устройств для сравнения. На рисунке 3 показаны передаточные характеристики устройств управления при программировании при различных положительных и отрицательных смещениях соответственно. Обнаружено, что устройство не показывает заметного ΔV th независимо от полярности и амплитуды напряжения программирования. Это указывает на то, что вышеупомянутые отдельные ΔV th для устройств памяти следует отнести к ZnO CTL. С другой стороны, следует отметить, что IGZO является естественным полупроводником n-типа, поэтому электроны в канале IGZO могут быть легко введены в ZnO CTL при положительном смещении затвора (например, . , +9 В). Однако, когда к электроду затвора устройства прикладывается отрицательное программирующее смещение, канал a-IGZO имеет тенденцию к истощению, и дырочная проводимость практически не достигается [15]. В этом случае устройство не может быть запрограммировано с помощью инжекции дырок из канала, и, таким образом, уникальная возможность электрического программирования должна быть реализована путем снятия улавливания собственных электронов в исходном ZnO CTL. Фактически, наши экспериментальные результаты показывают, что устройство может быть легко запрограммировано при отрицательном смещении затвора, см. Рис. 2d. На рисунке 4 показаны характеристики выносливости памяти в зависимости от циклов программирования / стирания (P / E). Устройство показывает окно памяти 3,7 В на 10 3 циклов P / E в случае программирования 11 В / 1 мс и стирания −9 В / 10 мкс. Кроме того, окно памяти размером 7,2 В может быть достигнуто при 10 3 циклов P / E относительно программирования 12 В / 1 мс и стирания −12 В / 10 мкс. В таблице 1 сравниваются характеристики программирования и стирания различных запоминающих устройств a-IGZO TFT [14, 22, 23]. По сравнению с другими устройствами, наше устройство демонстрирует гораздо более высокую эффективность стирания даже при более низком смещении (−12 В) и гораздо более короткое время (10 мкс), несмотря на заметное превосходство в эффективности программирования.
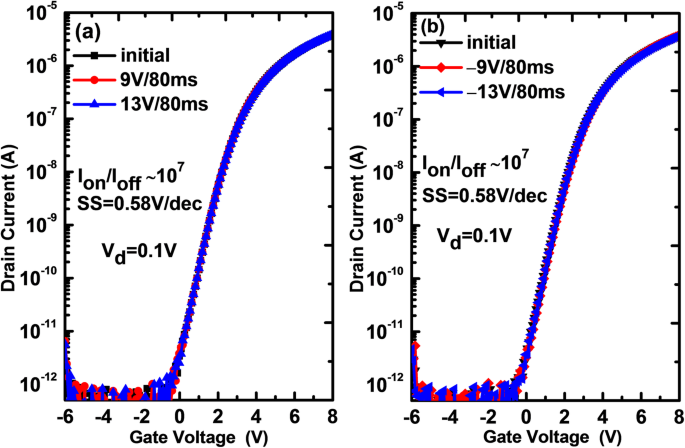
Передаточные кривые устройства a-IGZO TFT и запрограммированные a при различных положительных смещениях затвора в течение постоянного времени 80 мс и b при различных отрицательных смещениях затвора на постоянное время 80 мс
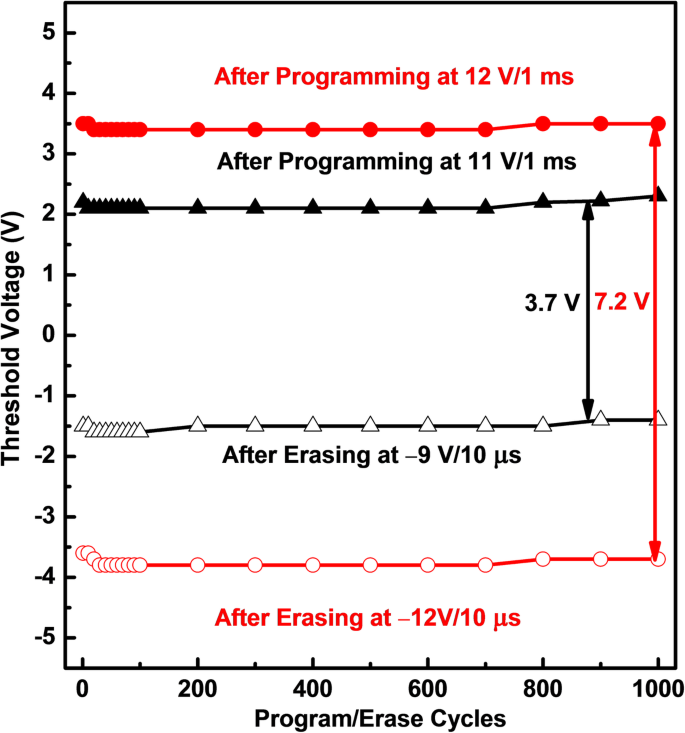
Характеристики выносливости устройства памяти a-IGZO TFT в зависимости от циклов P / E
Чтобы прояснить происхождение электронов, освобожденных от первичных ZnO CTL, различные обработанные ZnO CTL сравниваются в устройствах памяти a-IGZO TFT. На рисунке 5 показана зависимость напряжения программирования V th . для устройств с разными ТТЛ ZnO. Замечено, что для запоминающих устройств с исходным депонированием и N 2 -отожженные ЦТЛ ZnO, в результате чего ΔV th демонстрирует аналогичную тенденцию к увеличению с повышением напряжения программирования, несмотря на полярность напряжения. Однако для устройства памяти с O 2 -отожженный ZnO CTL, абсолютное значение ΔV th показывает значительное уменьшение при тех же условиях программирования, например, абсолютное значение ΔV th уменьшается на 2 и 3 В, соответственно, в случае импульсов программирования 13 В / 80 мс и -12 В / 1 мкс. Более того, насыщенное поведение программирования наблюдается для O 2 -отожженный ZnO CTL в случае положительного и отрицательного смещения затвора. Это следует отнести к ограниченным ловушкам в CTL. Одним словом, пост-отжиг в O 2 при 250 ° C уменьшает количество центров захвата в пленке ZnO, что приводит к снижению способности захвата заряда.

Пороговые сдвиги напряжения запоминающих устройств a-IGZO TFT с различными обработанными слоями улавливания заряда ZnO в зависимости от a положительное напряжение программирования для постоянного времени программирования 80 мс и b отрицательное напряжение программирования для постоянного времени программирования 1 мкс. Для каждого условия было измерено пять устройств.
Чтобы исследовать влияние пост-отжига на свойства пленки ZnO, осажденные и обработанные пленки ZnO характеризуются измерениями эффекта Холла и РФЭС. Как показано на рис. 6, пленка ZnO, отожженная в N 2 при 250 ° C показывает концентрацию носителя 4,4 × 10 19 см −3 , что очень близко к этому (4.5 × 10 19 см −3 ) осажденной пленки ZnO; однако пленка ZnO, отожженная в O 2 при 250 ° C наблюдается заметное уменьшение концентрации носителей, равное 1,8 × 10 18 см −3 . Сообщается, что собственными донорами в полупроводниковых пленках ZnO n-типа являются кислородные вакансии [24]. Kwon et al. также сообщили, что атомное отношение O / Zn в пленке ALD ZnO постепенно уменьшалось с 0,90 до 0,78 с увеличением температуры осаждения от 70 до 130 ° C [25]. Это свидетельствует о существовании кислородных вакансий в пленках ALD ZnO. Следовательно, O 2 -индуцированное отжигом уменьшение концентрации носителей (электронов) должно быть связано с уменьшением кислородных вакансий в пленке ZnO. Кроме того, O1s XPS-спектры высокого разрешения пленки ZnO после осаждения и пленки, отожженной в N 2 или O 2 анализируются, как показано на рис. 7. Три развернутых пика центрированы при 530,0, 531,6 и 532,4 эВ, что соответствует O 2- ионы, связанные с Zn 2+ (O1), кислородные вакансии (O2) и хемосорбированный кислородный элемент (–OH и др.) (O3) соответственно [26]. По сравнению с пленкой ZnO после осаждения, отжиг в O 2 вызывает снижение относительного процента O2 на 2,1%. Тем не менее, для пленки ZnO, отожженной в N 2 , относительное процентное содержание O2 практически не изменилось. Эти результаты показывают, что O 2 отжиг может пассивировать кислородные вакансии в пленке ZnO, но N 2 отжиг не может. Это еще раз подтверждает корреляцию между кислородными вакансиями и концентрацией носителей.

Концентрации носителей в пленке ZnO после осаждения и пленке, отожженной в различных условиях.
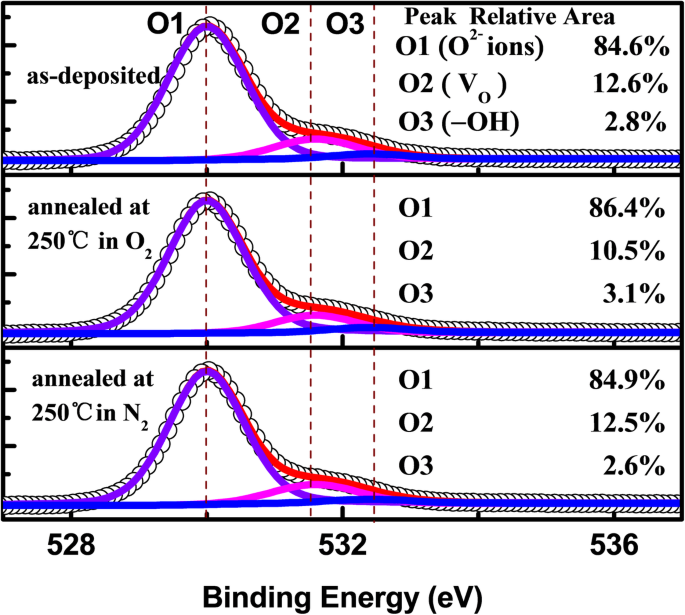
O1s XPS-спектры высокого разрешения пленки ZnO после осаждения и пленки, отожженной при 250 ° C в O 2 и N 2 , соответственно. O1 и O2 соответствуют O 2− ионы, связанные с Zn 2+ и кислородные вакансии соответственно. O3 относится к хемосорбированному элементу кислорода (–OH и др.). Чтобы случайно удалить поверхностные загрязнения, все образцы были протравлены ионной бомбардировкой на месте
На основании вышеупомянутых экспериментальных результатов можно сделать вывод, что программные характеристики первичных запоминающих устройств определяются концентрацией дефектов, связанных с кислородными вакансиями, в ZnO CTL. Другими словами, кислородные вакансии в пленке ZnO в первую очередь служат центрами захвата положительных и отрицательных зарядов. Сообщается, что дефекты, связанные с кислородными вакансиями в ZnO, включают нейтральную кислородную вакансию (V O ), однократно ионизованная кислородная вакансия (V O + ) и дважды ионизованной кислородной вакансии (V O 2+ ), энергетические уровни которых расположены на 0,02–0,04, 0,3–0,45 и 0,61 эВ соответственно ниже минимума зоны проводимости ZnO [27, 28]. Поскольку в нашем случае в свежеосажденной пленке ZnO наблюдается высокая концентрация электронов, концентрация нейтральных кислородных вакансий, служащих мелкими донорами, должна быть намного выше, чем концентрация ионизированных кислородных вакансий (V O + и V O 2+ ). С точки зрения программирования при положительном смещении затвора, электроны в слое накопления канала a-IGZO инжектируются в слой ZnO посредством туннельного механизма Фаулера-Нордхейма (FN), что демонстрируется увеличением ΔV th с повышением напряжения программирования на рис. 2а. Между тем ожидается, что эти электроны захватываются преимущественно на глубоких уровнях V O + и V O 2+ , как показано на рис. 8а. Это вызывает сдвиг V th в сторону положительного уклона. Конечно, помимо кислородных вакансий, которые захватывают электроны, другие дефекты также могут захватывать электроны. Однако наши экспериментальные данные показывают, что кислородные вакансии играют решающую роль в захвате электронов, а также в захвате положительного заряда, как показано на рис. 5. При отрицательном программном напряжении нейтральные кислородные вакансии в исходном ZnO CTL в основном отдают электроны из-за самый мелкий энергетический уровень [27, 28], и высвободившиеся электроны туннелируют из ZnO CTL в канал, что приводит к образованию положительно заряженных кислородных вакансий (например, V O + ), как показано на рис. 8б. Это вызывает сдвиг V th в направлении отрицательного смещения, как показано на рис. 2b. Кроме того, из-за более высокой концентрации вакансий нейтрального кислорода (V O ) в осажденном CTL ZnO исходное запоминающее устройство демонстрирует гораздо более высокую эффективность программирования при отрицательном смещении затвора, чем при положительном смещении затвора. Например, абсолютное значение ΔV th достигает 6,5 В после программирования при −13 В в течение 1 мкс (см. рис. 2d); однако ΔV th равен 2 В после программирования при 13 В в течение 1 мкс (рис. 2c). Это связано с тем, что первое в основном определяется концентрацией V O , а в последнем преобладают концентрации V O + и V O 2+ .
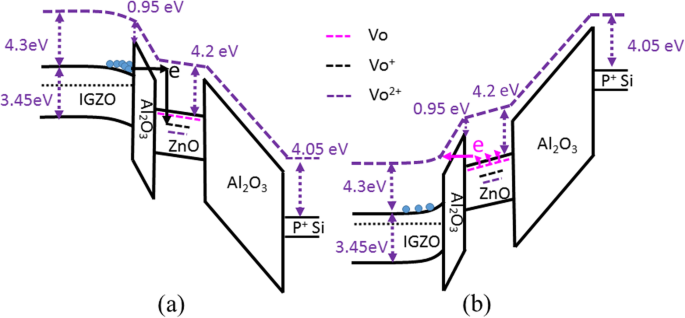
Диаграммы энергетических диапазонов запоминающих устройств a-IGZO TFT, запрограммированных на a положительное смещение затвора и b отрицательное смещение затвора соответственно. V o , V o + , и V o 2+ обозначают нейтральную кислородную вакансию, однократно ионизованную кислородную вакансию и дважды ионизованную кислородную вакансию, соответственно
Выводы
Таким образом, мы изготовили биполярную программируемую память a-IGZO TFT с нанесенным атомным слоем ZnO CTL. По сравнению с программированием при положительном смещении затвора, программирование при отрицательном смещении затвора может обеспечить гораздо более высокую эффективность. Это связано с тем, что во время программирования, зависящего от полярности напряжения, действуют различные дефекты кислородных вакансий. То есть глубокие дефекты V O + и V O 2+ играют ключевую роль в захвате электронов при программировании положительного смещения, а мелкие дефекты V O в основном отдают электроны во время программирования отрицательного смещения, что приводит к образованию положительно заряженных кислородных вакансий.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой рукописи, включены в рукопись.
Сокращения
- a-IGZO:
-
Аморфный оксид индия-галлия-цинка
- ALD:
-
Осаждение атомного слоя
- CTL:
-
Слой улавливания заряда
- TFT:
-
Тонкопленочный транзистор
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
Наноматериалы
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Настройка уровня Ферми пленок ZnO посредством суперциклического осаждения атомного слоя
- Высокоэффективные солнечные элементы из инвертированного перовскита с квантовыми точками CdSe / слоем перенос…
- Исследование солнечного элемента из кристаллического кремния с черным слоем кремния на задней панели
- Повышение производительности устройства a-IGZO TFT с использованием процесса чистого интерфейса через нано-слои…
- Снижение контактного сопротивления между металлом и n-Ge за счет введения ZnO при обработке аргоновой плазмой
- Влияние двухслойных гетероструктур CeO2 − x / ZnO и ZnO / CeO2 − x и полярности электроформования на коммутационные свой…
- Исследование энергетической зоны гетеропереходов ZnO / β-Ga2O3 (\ (\ overline {2} 01 \)), осажденных атомным слоем
- Боковой транзистор металл-оксид-полупроводник со сверхнизким удельным сопротивлением в открытом состоянии …
- Python — программирование расширений с помощью C



