Снижение контактного сопротивления между металлом и n-Ge за счет введения ZnO при обработке аргоновой плазмой
Аннотация
Мы исследуем контакты металл-диэлектрик-полупроводник на n-Ge с использованием межфазного слоя (IL) ZnO для преодоления эффекта пиннинга уровня Ферми (FLP) на границе раздела металл / Ge и уменьшения высоты барьера для электронов. Получен небольшой сдвиг зоны проводимости на 0,22 эВ на границе раздела между ZnO и n-Ge, а IL ZnO приводит к значительному снижению контактного сопротивления ( R c ) в металле / ZnO / n-Ge по сравнению с контрольным устройством без ZnO из-за исключения ФЛП. Было замечено, что обработка ZnO плазмой аргона (Ar) может дополнительно улучшить R c характеристики устройства Al / ZnO / n-Ge, что связано с тем, что обработка Ar плазмой увеличивает концентрацию кислородных вакансий V о , действующие как легирующие примеси n-типа в ZnO. Омический контакт демонстрируется в Al / ZnO / n-Ge с концентрацией легирующей примеси 3 × 10 16 см −3 в ге. На сильно легированном n + -Ge с ионом люминофора (P + ) имплантации, удельное контактное сопротивление 2,86 × 10 - 5 Ом см 2 достигается в Al / ZnO / n + -Ge с обработкой Ar плазмой.
Фон
Германий (Ge) привлек большое внимание в усовершенствованных полевых транзисторах металл-оксид-полупроводник (MOSFET) из-за его более высокой подвижности носителей по сравнению с Si [1, 2]. Для полевых МОП-транзисторов с р-каналом Ge большой прогресс был достигнут в создании напряженного канала Ge [3,4,5], пассивации поверхности [6,7,8,9] и контактов исток / сток (S / D) [ 10], а сверхмасштабированные Ge pFinFET [11] продемонстрировали превосходные электрические характеристики по сравнению с Si-устройствами. Ge n-канальные транзисторы, напротив, все еще сталкиваются с проблемами, которые создают препятствия для интеграции Ge CMOS, включая плохое качество интерфейса, что приводит к низкой подвижности электронов и высокому S / D-сопротивлению из-за ограниченной активации. скорость примесей n-типа в Ge [12] и пиннинг уровня Ферми (FLP) на границе раздела металл / n-Ge [13]. FLP приводит к высоте барьера Шоттки около 0,5 эВ для электронов для большинства металлов на n-Ge, создавая очень большое контактное сопротивление R c [13,14,15].
Депиннинг на уровне Ферми может быть выполнен путем введения тонкого межфазного слоя (IL), например TiO 2 [16] и ZnO [17], между металлами и n-Ge [18], из-за этого тонкая IL может блокировать волновую функцию металла в Ge, чтобы уменьшить индуцированные металлом щелочные состояния [19, 20]. ZnO имеет небольшой сдвиг зоны проводимости (CBO) по отношению к Ge, что может привести к меньшему R c в металле / ZnO / n-Ge по сравнению с металлом / TiO 2 / n-Ge с TiO 2 / Ge, имеющий положительный CBO [16]. Диэлектрическая проницаемость ZnO меньше, чем у TiO 2 . , так что ZnO IL может получить более тонкую обедненную область между металлом и n-Ge по сравнению с TiO 2 . Кроме того, легко реализовать легирование n-типа в ZnO путем введения нестехиометрических дефектов, таких как кислородные вакансии V о [21, 22], что приводит к еще меньшей области обеднения ZnO между металлом и n-Ge. Пока что в контактах металл / ZnO / n-Ge легирование ZnO V о проводился путем отжига в атмосфере азота [16], что, однако, могло привести к взаимной диффузии ZnO и Ge во время отжига [23] и диффузии атомов легирующей примеси в n-Ge во время отжига [24, 25], вызывая ухудшение текущих характеристик устройства. Поскольку необходимо разработать низкотемпературный процесс осаждения и легирования ZnO.
В этой работе мы исследуем депиннинг уровня Ферми на границе раздела между металлом и n-Ge путем введения осажденного методом ALD ZnO IL. Изучено влияние обработки слоя ZnO плазмой аргона (Ar) на характеристики контактного сопротивления Al / ZnO / n-Ge.
Методы
Металлические контакты формировались как на слаболегированных, так и на сильнолегированных пластинах n-Ge (001). Легированные образцы Ge имеют концентрацию легирования около 3 × 10 16 . см −3 . Чтобы получить сильно легированный n-Ge, ион люминофора (P + ) имплант с дозой 1 × 10 15 см −2 и энергия 30 кэВ была выполнена на n-Ge (001), после чего последовал быстрый термический отжиг при 600 ° C в течение 60 с. После очистки пластины с использованием нескольких циклов деионизованной воды и разбавленной HCl пластины Ge сразу загружали в камеру ALD (Beneq TSF-200) для осаждения ZnO, а затем наносили алюминиевые (Al) контакты напылением на Ge с использованием процесса отрыва. . Здесь использовались три толщины ZnO:1, 2 и 3 нм, что было подтверждено спектроскопической эллипсометрией (SE) (J. A. Woollam M2000). Во время осаждения ZnO диэтилцинк (DEZn) и деионизированная вода (H 2 O) использовались в качестве прекурсоров Zn и O соответственно, а температура подложки поддерживалась 150 ° C, чтобы исключить образование GeO x . Подробный процесс осаждения ZnO с использованием ALD был описан в наших предыдущих работах в исх. [26, 27]. Для дальнейшего улучшения проводимости пленки ZnO некоторые образцы ZnO на Ge обрабатывали плазмой аргона (Ar). Также был изготовлен контрольный образец Al / n-Ge без ZnO IL. R c Al на ZnO / Ge был извлечен с использованием метода круговой линии передачи (CTLM), который был сформирован отрывом. Открытый ZnO был полностью травлен плазменным травлением, чтобы гарантировать полную изоляцию между соседними устройствами [16].
Keithley 4200 SCS использовался для измерения электрических характеристик контрактов Al / ZnO / n-Ge и структур CTLM, просвечивающий электронный микроскоп высокого разрешения (HRTEM) и рентгеновская фотоэлектронная спектроскопия (XPS) использовались для определения микроструктуры и границы раздела фаз. свойств образцов, и спектрофотометр UV-VIS (LAMBDA 950, PerkinElmer) был использован для определения ширины запрещенной зоны E g наплавленной пленки ZnO.
Результаты и обсуждение
Характеристика материалов Al / ZnO / n-Ge
XPS-спектры валентной зоны Ge / ZnO и спектр пропускания ZnO представлены на рис. 1 и 2, соответственно, которые были использованы для исследования механизма эффекта депиннинга уровня Ферми на границе раздела Al / ZnO / n-Ge. Мы провели измерения XPS для толстого образца ZnO, образца интерфейса ZnO / n-Ge и образца чистого Ge, чтобы получить смещение валентной зоны (VBO) ZnO / Ge, как показано на рис. 1. Zn 2 р Положение пика и VBM для толстого образца ZnO составляют 1021,9 эВ и 2,59 эВ соответственно. Zn 2 p и Ge 3 d Положение пика для образца интерфейса ZnO / Ge составляет 1021,7 и 29,1 эВ соответственно. Ge 3 d положение пика и VBM для образца чистого Ge составляют 29 эВ и 0,06 эВ соответственно. Это указывает на то, что VBO ZnO / Ge составляет 2,33 эВ [30].

XPS-спектры валентных зон образца ZnO / Ge. а Zn 2 p и b Спектры валентной зоны толстого образца ZnO c ZnO 2 p и d Ge 3 d спектры образца интерфейса ZnO / Ge и e Ge 3 d и е спектры валентной зоны объемного образца Ge
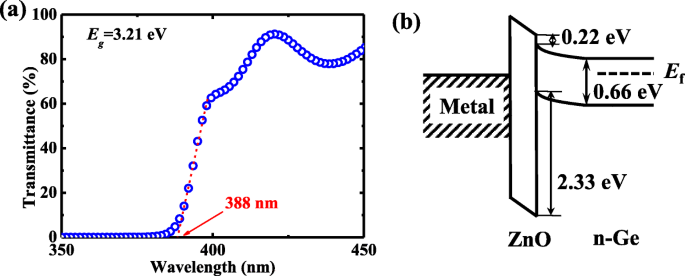
а Спектр пропускания для осажденной пленки ZnO, демонстрирующий E g 3,21 эВ. б Регулировка полосы для контакта Al / ZnO / Ge
На рис. 2а показан график пропускания, полученный с помощью УФ-видимой спектроскопии для толстого образца ZnO, а E g ZnO определено равным 3,21 эВ, что согласуется со значениями, приведенными в [28, 29]. Используя полученное E g ZnO и VBO выше, CBO 0,22 эВ между ZnO и Ge определяется, как показано на рис. 2b. Это указывает на то, что депиннинг на уровне Ферми может быть достигнут на границе раздела Al / n-Ge с использованием слоя вставки ZnO, который может давать низкий R c для контакта Al / ZnO / n-Ge.
На рис. 3 показано ПЭМ-изображение структуры Al / ZnO / n-Ge с толщиной ZnO 3 нм. Между Al и n-Ge наблюдается однородный и конформный слой ZnO. На вставке в правом верхнем углу показано изображение HRTEM увеличенного изображения интерфейса Al / ZnO / n-Ge. Измеренная толщина пленки ZnO составляет 3 нм, что согласуется с результатом, полученным методом SE, и пленка ZnO находится в аморфной форме.
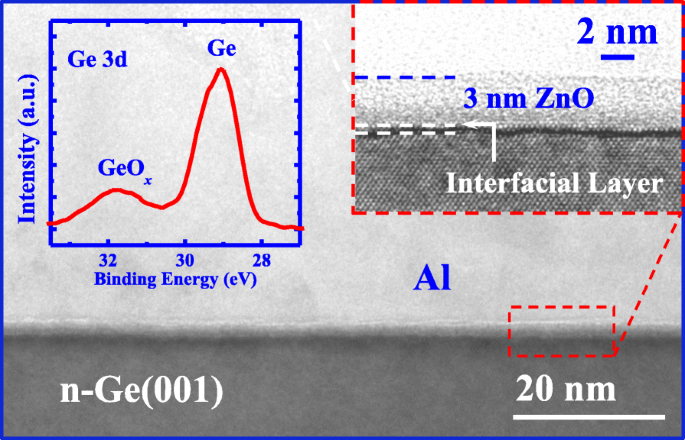
ПЭМ-изображение образца Al / ZnO / n-Ge, показывающее однородный слой ZnO между Al и Ge. Верхняя правая вставка показывает HRTEM-изображение интерфейса Al / ZnO / n-Ge, а верхняя левая вставка показывает XPS Ge 3 d результат образца, демонстрирующий существование GeO x межфазный слой
Тонкий GeO x Между Ge и ZnO образуется межфазный слой, который намного меньше по сравнению с [31] из-за более низкой температуры осаждения, используемой в данной работе. Это связано с тем, что во время осаждения ZnO Ge реагирует с прекурсором O, что приводит к образованию GeO x IL. Гео x также демонстрируется XPS Ge 3 d в результате появится вставка в верхнем левом углу.
Электропроводность пленки ZnO может быть улучшена обработкой Ar плазмой, что приводит к увеличению концентрации кислородных вакансий V о , выступающие донорами в ZnO [32, 33]. На рисунке 4 показаны результаты XPS за O 1 s для ZnO после осаждения и образца с обработкой плазмой Ar мощностью 50 Вт, потоком газа Ar 60 sccm и продолжительностью 45 с. О 1 s пик деконволюции на два пика с использованием гауссовой аппроксимации. Пик при ~ 530 эВ соответствует решеточному кислороду ZnO [34, 35]. Для образца после осаждения пик при 531,7 эВ соответствует V о (~ 531,5 эВ) и хемосорбированный кислород на поверхности тонких пленок ZnO, например карбонильные и гидроксильные группы [35, 37]. Для образца с обработкой плазмой Ar пик находится при ~ 531,5 эВ, который смещается в сторону более низкой энергии связи и становится намного более выраженным по сравнению с образцом после осаждения, указывая на то, что больше V о образуются в результате обработки плазмой Ar, и хемосорбированный кислород эффективно удаляется. Увеличение примесей n-типа в ZnO приводит к более тонкому туннельному барьеру и более низкому последовательному сопротивлению на границе раздела, что отвечает за уменьшение R c [36].

Результаты XPS O 1 s и результаты деконволюции для образцов ZnO (3 нм) / n-Ge после осаждения (вверху) и после обработки плазмой Ar (внизу)
Мы провели измерения XPS с использованием толстого образца ZnO и образца интерфейса ZnO / Ge с обработкой плазмой Ar и без нее, как показано на рис. 5. Мы обнаружили, что после обработки плазмой Ar произошел сдвиг на 0,05 эВ. Это может указывать на то, что VBO ZnO / Ge составляет около 2,38 эВ после обработки Ar плазмой, а CBO - 0,17 эВ.

VBM для образца интерфейса ZnO / Ge с обработкой плазмой Ar и без нее. а Zn 2 p и b Спектры валентной зоны толстого образца ZnO c ZnO 2 p спектры образца интерфейса ZnO / Ge. г Диаграмма выравнивания полос для металла, подвергнутого плазменной обработке Ar / ZnO / n-Ge
Электрические характеристики контактов Al / ZnO / n-Ge
На рисунке 6а показана измеренная плотность тока Дж . как функция приложенного напряжения В характеристики Al-контактов на слаболегированном n-Ge. Al / ZnO / n - -Ge устройства имеют разную толщину слоя ZnO. Схема устройства представлена на вставке к рис. 6.
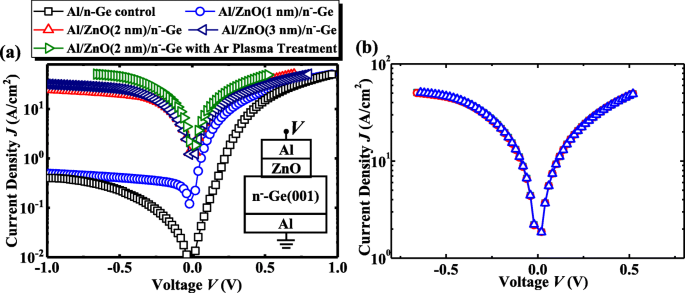
а Дж - V характеристики для Al / n - -Ge контроль, Al / ZnO / n - -Ge с толщиной ZnO 1 нм, 2 нм и 3 нм, и ZnO / Ge, обработанный плазмой Al / 2 нм Ar, b Дж -V характеристики для трех устройств ZnO / Ge с плазменной обработкой Al / 2 нм Ar
Как и предполагалось, устройство управления Al / n-Ge без ZnO демонстрирует выпрямляющие характеристики с высокой высотой барьера для электронов из-за пиннинга уровня Ферми при Al / n - -Ge [38]. По сравнению с контрольным образцом Al / n-Ge без ZnO, устройства Al / ZnO / n-Ge демонстрируют улучшенный обратный J , который происходит из-за депиннинга уровня Ферми, вызванного уменьшением индуцированных металлом щелевых состояний (MIGS) на границе раздела металл / Ge [18,19]. Это улучшение усиливается при использовании более толстого ZnO, что связано с тем, что удаляется больше MIGS. Но плотность прямого тока для вставленного устройства из ZnO 3 нм меньше, чем у устройства 2 нм. Это можно объяснить следующим образом. Основная плотность тока для Al / ZnO / n-Ge - это туннельный ток. Если ZnO недостаточно толстый, MIGS не будет эффективно устранен, и он все равно будет показывать выпрямляющие свойства. Но если ZnO слишком толстый, последовательное сопротивление ZnO будет преобладать над всем сопротивлением, и ток станет меньше. Таким образом, существует компромисс между устранением MIGS и увеличением последовательного сопротивления ZnO, и, таким образом, существует критическая толщина для IL [19]. В заключение, оптимальной толщиной контакта Al / ZnO / n-Ge считается 2 нм.
При обработке плазмой Ar производительность Al / ZnO / n - -Ge устройство доработано. Независимо от обратного или прямого качания приложенного напряжения В , Al / 2 нм ZnO / n - -Ge устройство с плазменной обработкой Ar обеспечивает повышенную J по сравнению с устройством с 2 нм ZnO или 3 нм ZnO, что связано с большим количеством V о образуются в пленке ZnO во время плазменной обработки Ar. Более высокая концентрация легирования в ZnO может эффективно снизить последовательное сопротивление ZnO и уменьшить туннельный барьер для электронов на границе раздела между ZnO и Al, улучшая плотность туннельного тока.
На рисунке 6b показан J . - V характеристики для трех Al / 2 нм ZnO / n - -Ge устройство с плазменной обработкой Ar. Понятно, что J для разных устройств примерно одинаково, что указывает на то, что как процесс ALD, так и плазменная обработка Ar оказывают одинаковое влияние на улучшение плотности тока.
Омические контакты получены для Al / 2 нм ZnO / n - -Ge без и с различной продолжительностью обработки плазмой Ar:15 с, 30 с, 45 с и 60 с, соответственно, которые показаны на рис. 7.

Я - V кривые при Al / 2 нм ZnO / n - -Ge с разными d а без обработки плазмой аргона и с обработкой плазмой аргона продолжительность b 15 с, c 30 с, д 45 с, и e 60 с
Необработанное полное сопротивление R малыш между двумя контактами уменьшается с уменьшением d , и последний R малыш модифицируется поправочным коэффициентом C, который рассчитывается по формуле C =( L / d ) · Ln (1 + d / L ) [39], где L =25 мкм представляет радиус внутренней подушки, как показано на вставке на рис. 8а. Построив R малыш как функция от d на рис. 8а сопротивление листа R sh из n - -Ge можно получить из наклона прямой, а затем ρ c вычисляется от пересечения прямой аппроксимирующей линии с вертикальной осью. Для Al / 2 нм ZnO / n - -Ge устройство без обработки Ar плазмой, ρ c равно 6,87 × 10 −2 Ом см 2 , но после 45 с плазменной обработки Ar наблюдается уменьшение в 17,2 раза по сравнению с обработкой без обработки плазмой Ar, и имеет контактное сопротивление ρ c из 3,66 × 10 −3 Ом см 2 . Сравниваем значения ρ c для Al / 2 нм ZnO / n - -Ge-устройства с различной продолжительностью обработки Ar-плазмой на рис. 8б. Замечено, что ρ c аппарата уменьшается со временем обработки до 30 с. Однако, поскольку время обработки превышает 30 с, ρ c почти остается прежним. Уменьшение ρ c может быть объяснено легированием ZnO, таким образом, уменьшением туннельного барьера и последовательного сопротивления, как упоминалось ранее. Но нет заметного изменения сопротивления листа на n - -Ge, что указывает на отсутствие влияния на проводимость n - -Ge с обработкой Ar плазмой.
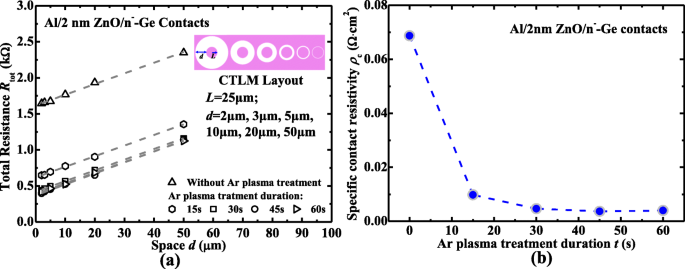
а R малыш по сравнению с d кривые для CTLM с Al / 2 нм ZnO / n - -Ge-контакты с различной продолжительностью плазменной обработки Ar, вставка на рис. 5а - информация о структуре CTLM, использованной в данной работе. б ρ c по сравнению с различной продолжительностью обработки аргоном в плазме
Структура CTLM с контактами Al на сильно легированном Ge используется для исследования контактного сопротивления, характерного для Al / 2 нм ZnO / n + -Ge. Слой ZnO подвергался обработке Ar плазмой в течение 45 с. На рисунке 9а показано измеренное значение I - V кривые между контактами Al с разными d , показывающий отличные омические характеристики. На рисунке 9b показан график R малыш как функция от d для Al / 2 нм ZnO / n + -Ge CTLM и R sh и ρ c извлекаются как 64 Ом / □ и 2,86 × 10 −5 Ом см 2 соответственно.
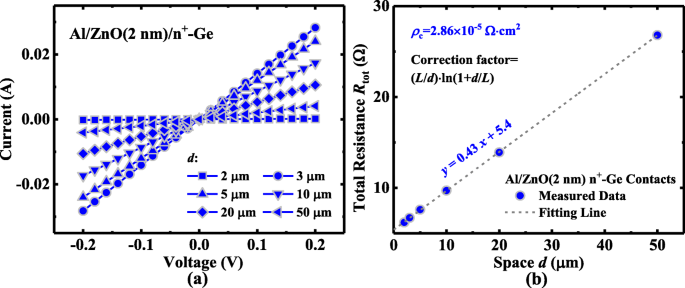
а Я - V кривые при Al / ZnO (2 нм) / n + -Ge с разными d с ZnO, обработанным плазмой Ar. б R малыш по сравнению с d кривые для CTLM с Al / ZnO (2 нм) / n + -Ge контакты
Сравниваем ρ c ZnO, обработанного Ar плазмой Al / ZnO / n + -Ge устройства в этой работе с теми, о которых сообщается в литературе, как показано на рис. 10. Для сильно легированных n + -Ge контактный образец, Al / ZnO / n + -Ge контакты показаны меньшие ρ c по сравнению с Ni / GeSn [40, 41], Ni / Ge [42], Ti / n + -Ge в исх. [31], и Ti / TiO 2 / GeO 2 / Ge [31], имплантированный углеродом Ni / Ge [42] и Ti / n + -SiGe / n-Ge [43]. Металлические омические контакты, такие как Ni / Ge, Ni / GeSn, Ti / Ge и имплантированный углеродом Ni / Ge, страдают от сильного закрепления на уровне Ферми, что приводит к большому ρ c . Для Ti / TiO 2 / GeO 2 / Ge, большое туннельное сопротивление создавал бислой 1 нм TiO 2 /1,5 нм GeO 2 ИЛ, ухудшающие характеристики контактного сопротивления. Но ρ c в этой работе больше, чем в исх. [44]. Мы предполагаем, что это может быть связано с четырехкратным увеличением P + доза имплантации, чем в нашей работе. Более высокая доза имплантации обеспечит более сильное легирование поверхности n + -Ge, что приводит к более тонкому барьеру Шоттки и меньшему ρ c . Мы полагаем, что при более сильном допировании n + -Ge в Al / ZnO / n + -Ge устройства, меньше ρ c приведет к.
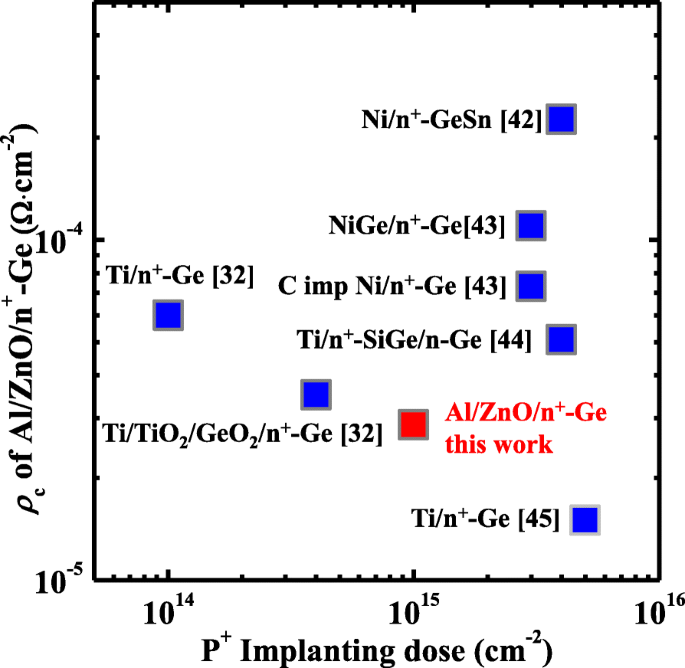
Сравнение ρ c из Al / ZnO / n + -В этой работе используйте P + для других контактов, о которых сообщили доза имплантации как x ось
Выводы
Исследован эффект депиннинга уровня Ферми, индуцированный ИЖ ZnO в структурах Al / ZnO / n-Ge. Измерение XPS продемонстрировало небольшой CBO 0,22 эВ на ZnO / n-Ge, то есть происходит устранение FLP, что приводит к омическим металлическим контактам на n-Ge. Также сообщается, что обработка ZnO плазмой Ar приводит к увеличению концентрации V о , действуя как легирующие примеси n-типа в ZnO, что улучшает R c производительность в устройствах Al / ZnO / n-Ge. Омические металлические контакты получаются на n - и n + -Ge с обработанным плазмой Ar ZnO IL. На основе структур CTLM значения ρ c 3,66 × 10 −3 Ом см 2 и 2,86 × 10 - 5 Ом см 2 достигаются в Al / 2 нм ZnO / n - -Ge и Al / 2 нм ZnO / n + -Ge, соответственно, с обработкой ZnO Ar-плазмой при мощности 50 Вт в течение 45 с.
Сокращения
- Al:
-
Алюминий
- ALD:
-
Осаждение атомного слоя
- Ar:
-
Аргон
- CBO:
-
Смещение зоны проводимости
- CTLM:
-
Метод круговой линии передачи
- DEZn:
-
Диэтилцинк
- E g :
-
Ширина запрещенной зоны
- FLP:
-
Пиннинг на уровне Ферми
- Ge:
-
Германий
- GeO x :
-
Оксид германия
- GeSn:
-
Германий олово
- HCl:
-
Соляная кислота
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- IL:
-
Межфазный слой
- MIGS:
-
Щелочные состояния, индуцированные металлами
- МОП-транзисторы:
-
Полевые транзисторы металл-оксид-полупроводник
- Ни:
-
Никель
- P + :
-
Ион фосфора
- R c :
-
Контактное сопротивление
- R малыш :
-
Грубое общее сопротивление
- SE:
-
Спектроскопическая эллипсометрия
- Si:
-
Кремний
- Ti:
-
Титан
- TiO 2 :
-
Диоксид титана
- UV-VIS:
-
Ультрафиолет - видимый
- VBO:
-
Смещение полосы валентности
- V о :
-
Кислородная вакансия
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
- ZnO:
-
Оксид цинка
- ρ c :
-
Удельное контактное сопротивление
Наноматериалы
- В чем разница между инконелем и инколоем?
- В чем разница между металлическим листом, пластиной и фольгой?
- Разница между структурой и классом:объяснение на примере C++
- Разница между while и do-while:объяснение с примерами
- Настройка химического состава поверхности полиэфирэфиркетона с помощью золотого покрытия и плазменной обра…
- Влияние контактной неравновесной плазмы на структурные и магнитные свойства шпинелей Mn Х Fe3 - X О4
- Что такое термическая обработка? - Процесс и методы
- В чем разница между изготовлением металла и сваркой металла?
- В чем разница между изготовлением металла и сваркой?
- Разница между отпуском и отжигом



