Альтернативная стратегия уменьшения поверхностной рекомбинации для микросветодиодов InGaN / GaN - уменьшение квантовых барьеров для управления распространением тока
Аннотация
Из-за высокого отношения поверхности к объему микросветодиоды (μLED) на основе InGaN сильно страдают от поверхностной рекомбинации, которая вызвана дефектами боковых стенок. Более того, по мере уменьшения размера кристалла соответственно увеличивается растекание тока, что, таким образом, дополнительно ограничивает инжекцию носителей и внешний квантовый выход (EQE). В данной работе мы предлагаем снизить скорость безызлучательной рекомбинации на дефектах боковых стенок, управляя эффектом растекания тока. Для этого мы должным образом уменьшаем вертикальное удельное сопротивление, уменьшая толщину квантового барьера, чтобы ток меньше распространялся по горизонтали на дефекты боковых стенок. В результате на безызлучательную рекомбинацию на поверхности расходуется гораздо меньше носителей. Результаты наших расчетов показывают, что подавленная поверхностная безызлучательная рекомбинация может лучше способствовать эффективности инжекции дырок. Мы также производим μLED, которые выращиваются на подложках Si, и результаты измерений согласуются с численными расчетами, так что EQE для предлагаемых μLED с достаточно тонкими квантовыми барьерами может быть улучшен благодаря меньшему эффекту растекания тока и уменьшению поверхностная безызлучательная рекомбинация.
Введение
Благодаря отличительным характеристикам высокой яркости, низкому энергопотреблению и длительному сроку службы [1] светодиоды (СИД) на основе III-нитрида вызывают большой исследовательский интерес [2, 3]. К настоящему времени достигнуты огромные успехи в производстве синих светодиодов большого размера на основе InGaN / GaN [3], которые нашли применение в твердотельном освещении и панельных дисплеях большого размера. Однако обычные светодиоды на основе InGaN / GaN имеют небольшую полосу модуляции, что делает их непригодными, например, для связи в видимом свете (VLC) [4,5,6]. Между тем, большой размер чипа снижает емкость пикселей, например, для дисплеев сотовых телефонов или дисплеев носимых часов. Таким образом, на текущем этапе микро-светодиоды InGaN / GaN (например, μLED) с размером кристалла менее 100 мкм привлекли к себе пристальное внимание. Несмотря на вышеупомянутые преимущества, остается еще много проблем, которые необходимо решить для дальнейшего развития μLED, таких как высокоточный массообмен [7,8,9] и эффективность в зависимости от размера [10]. Зависимая от размера эффективность возникает из-за повреждений поверхности, вызванных сухим травлением при изготовлении мезы, и, следовательно, возникает большое количество дефектов, вызывающих безызлучательную рекомбинацию поверхности. Обратите внимание, что для различных типов оптоэлектронных устройств качество кристаллов и перенос заряда являются одними из основных параметров, влияющих на фотоэлектронные свойства [11,12,13,14,15,16]. Уникально для μLED, поверхностная рекомбинация в дефектных областях может значительно снизить внутреннюю квантовую эффективность (IQE) для μLED [17]. Недавно Kou et al. далее выяснилось, что по мере уменьшения размера кристалла дыры легче захватываются дефектами, и способность микронных светодиодов может стать еще хуже при уменьшении размера кристалла [18]. Таким образом, важно снизить плотность дефектов боковины. Очень удобный метод пассивирования дефектов боковых стенок - это нанесение диэлектрического пассивирующего слоя [19], что можно сделать с помощью метода плазменного химического осаждения из паровой фазы (PECVD) или метода осаждения атомных слоев (ALD). Показано, что диэлектрический пассивирующий слой может лучше уничтожать дефекты боковых стенок при использовании метода ALD из-за еще более высокого качества выращенного слоя [20]. Затем количество дефектов боковой стенки может быть дополнительно уменьшено путем термического отжига пассивирующего слоя [21], который демонстрирует улучшенное EQE даже для μLED 6 мкм × 6 мкм. Как хорошо известно, растекание тока может стать еще лучше, когда размер кристалла продолжает уменьшаться из-за пониженного бокового удельного сопротивления [22]. Поэтому мы предлагаем уменьшить вертикальное удельное сопротивление, чтобы лучше ограничить ток в пределах столешницы, что затем удерживает носители на расстоянии от дефектов боковых стенок и помогает подавить безызлучательную рекомбинацию на поверхности.
Следовательно, для достижения цели мы предлагаем уменьшить толщину квантовых барьеров, чтобы управлять энергетическими барьерами и вертикальным сопротивлением. Наши численные расчеты показывают, что ток может быть ограничен латерально в мезе, что, таким образом, снижает потребление дырок из-за поверхностной безызлучательной рекомбинации. Уменьшение поверхностной безызлучательной рекомбинации также помогает облегчить инжекцию дырок в соответствии с нашим предыдущим отчетом [18]. Кроме того, более тонкие квантовые барьеры гомогенизируют распределение дырок по множеству квантовых ям (МКЯ). Экспериментальные результаты показывают, что EQE для μLED с уменьшенной толщиной квантового барьера улучшается.
Методы исследования и физические модели
Чтобы доказать эффективность предложенных структур в подавлении поверхностной рекомбинации, стимулировании инжекции дырок и улучшении EQE для InGaN-μLED, разработаны различные наборы μLED, которые выращиваются на подложках Si с ориентацией [111] с использованием металлоорганических соединений. система химического осаждения из паровой фазы (MOCVD) [23, 24]. Все приборы имеют слой n-GaN толщиной 4 мкм с концентрацией электронов 5 × 10 18 . см −3 . Затем четыре пары In 0.18 Ga 0,82 МКЯ N / GaN используются для получения фотонов. Структурная информация представлена в таблице 1. Затем p-Al толщиной 26 нм 0,15 Ga 0,85 Слой N служит слоем блокировки электронов p-типа (p-EBL), для которого уровень концентрации дырок составляет 3 × 10 17 см −3 , p-EBL затем покрывается слоем p-GaN толщиной 100 нм с концентрацией дырок 3 × 10 17 см −3 . Наконец, оба образца μLED покрыты слоем p-GaN толщиной 20 нм. Все исследованные синие μLED на основе InGaN имеют размер кристалла 10 × 10 мкм 2 . . ITO 200 нм используется в качестве слоя, распространяющего ток, который отжигается при температуре 500 ° C в течение 120 с для образования омического контакта со слоем p-GaN. Затем Ti / Al / Ni / Au / сплав одновременно наносится на токопроводящий слой и слой n-GaN, служащий p-электродом и n-электродом, соответственно.
Чтобы раскрыть физику устройства на более глубоком уровне, исследуемые устройства рассчитываются с использованием APSYS [25, 26], который может самосогласованно решать уравнения дрейфа-диффузии, уравнения Шредингера и Пуассона. Эффективность вывода света установлена на 88,1% для устройств flip-chip [27]. Коэффициент смещения энергетической зоны между зоной проводимости и валентной зоной в МКЯ InGaN / GaN установлен равным 70:30 [28]. В наших расчетах также учитываются потери носителей из-за безызлучательной рекомбинации, включая оже-рекомбинацию с коэффициентом рекомбинации 1 × 10 −30 см 6 s −1 рекомбинация Шокли-Рида-Холла (СРГ) с временем жизни носителей 100 нс [29]. Безызлучательная рекомбинация, происходящая на меза-поверхностях, не может быть проигнорирована для μLED. Для точного моделирования поверхностной рекомбинации уровни ловушек для электронов и дырок устанавливаются на 0,24 эВ ниже зоны проводимости (т. Е. E c - 0,24 эВ) и на 0,46 эВ выше валентной зоны (т. Е. E v + 0,46 эВ) соответственно. Поперечное сечение захвата 3,4 × 10 −17 см 2 и плотность ловушки 1 × 10 13 см −3 установлены для электронных ловушек [30]. Поперечное сечение захвата 2.1 × 10 −15 см 2 и плотность ловушек 1,6 × 10 13 см −3 установлены для отверстий [31]. Остальные параметры можно найти в [32].
Результаты и обсуждения
Доказательство лучшего удержания тока внутри области Мезы за счет уменьшения квантовых барьеров для микронных светодиодов
Хорошо известно, что более благоприятная инжекция дырок может быть получена, когда квантовые барьеры становятся тонкими [33]. Однако неясно, помогают ли тонкие квантовые барьеры удерживать ток внутри столешницы для μLED. Для обращения к точке у нас есть μLED A, B и C, для которых толщина квантового барьера, согласно таблице 1, установлена на 6 нм, 9 нм и 12 нм соответственно. Чтобы исключить влияние поверхностной рекомбинации на распределение носителей [18], мы не рассматриваем какие-либо ловушки на периферии мезы исследуемых μLED. На рисунке 1 показаны рассчитанные EQE и оптическая мощность с точки зрения уровня плотности тока инжекции для μLED A, B и C соответственно. Как показано на рис.1, и EQE, и оптическая мощность увеличиваются при уменьшении толщины квантового барьера, так что значения EQE для μLED A, B и C составляют 28,8%, 24,0% и 22,2% при 40 A / см 2 .
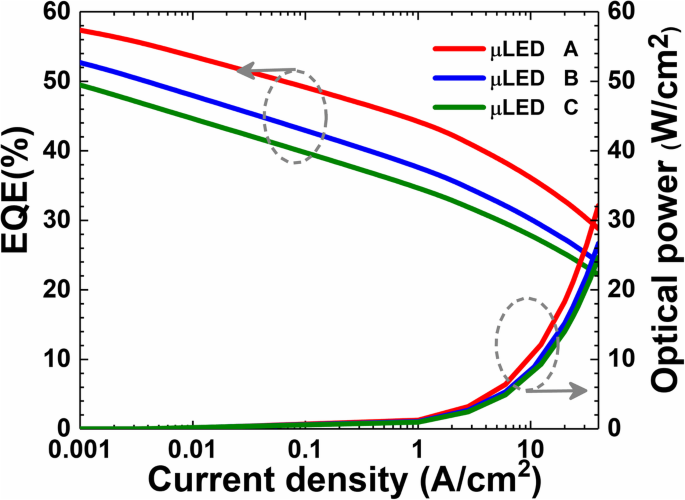
Расчетный EQE и плотность оптической мощности с точки зрения плотности тока инжекции для светодиодов A, B и C соответственно
На рисунке 2 показаны профили концентрации дырок в области МКЯ для μLED A, B и C при плотности тока 40 А / см 2 . . Мы видим, что при уменьшении толщины квантового барьера концентрация дырок в квантовых ямах увеличивается. Между тем, пространственная однородность распределения дырок в четырех квантовых ямах также может быть улучшена. Таким образом, полученные здесь результаты для μLED согласуются с результатами для светодиодов большого размера, так что достаточно тонкие квантовые барьеры могут способствовать переносу дырок [33]. Как уже упоминалось, при использовании тонких квантовых барьеров ток может меньше распространяться на край мезы. Затем мы представляем распределение боковых дырок в первой квантовой яме, которая наиболее близка к p-EBL, на рис. 3a. Мы обнаружили, что концентрация дырок уменьшается вместе с боковым положением относительно p-электрода. Затем мы вычисляем уровень наклона отверстий, который определяется как p left -p вправо / p left . Здесь p left и p right обозначены как концентрация дырок на левом и правом краях мезы соответственно. Уровни спада составляют 10,7%, 10,3% и 9,8% для μLED A, B и C соответственно. Для лучшей иллюстрации мы нормализуем концентрацию боковых отверстий, которая изображена на рис. 3b. Это также показывает, что уровень спада увеличивается по мере того, как квантовый барьер становится тонким.
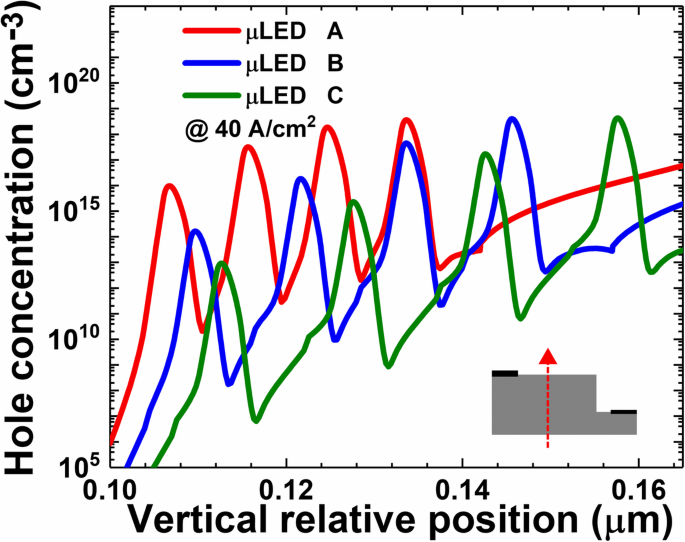
Профили концентрации дырок в областях МКЯ, рассчитанные численно для μLED A, B и C. Данные рассчитаны при плотности тока 40 А / см 2 . На вставном рисунке показано положение, в котором фиксируются профили дат
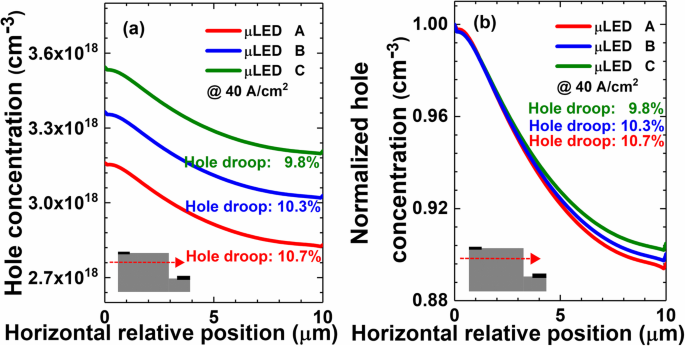
( а ) Профили концентрации дырок, рассчитанные численно, и ( b ) нормированные профили концентрации дырок в первой квантовой яме вблизи p-EBL для μLED A, B и C соответственно. На вставке показано положение, в котором фиксируются профили концентрации дырок. Данные рассчитаны при плотности тока 40 А / см 2 .
Затем мы показываем диаграммы энергетических зон для μLED A, B и C на рис. 4a – c. Это показывает, что высота барьера валентной зоны для всех квантовых барьеров уменьшается при уменьшении толщины квантового барьера. Уменьшение высоты барьера с валентной полосой может лучше облегчить перенос дырок через область МКЯ, что согласуется с рисунком 2. С другой стороны, когда квантовые барьеры истончаются, соответственно создается пониженное вертикальное удельное сопротивление. Согласно отчету Che et al. [34], когда вертикальное сопротивление уменьшается, распространение тока в поперечном направлении может быть подавлено, так что ток стремится быть дальше от края мезы. Это предположение также подтверждается, если мы обратимся к рис. 3a и b.
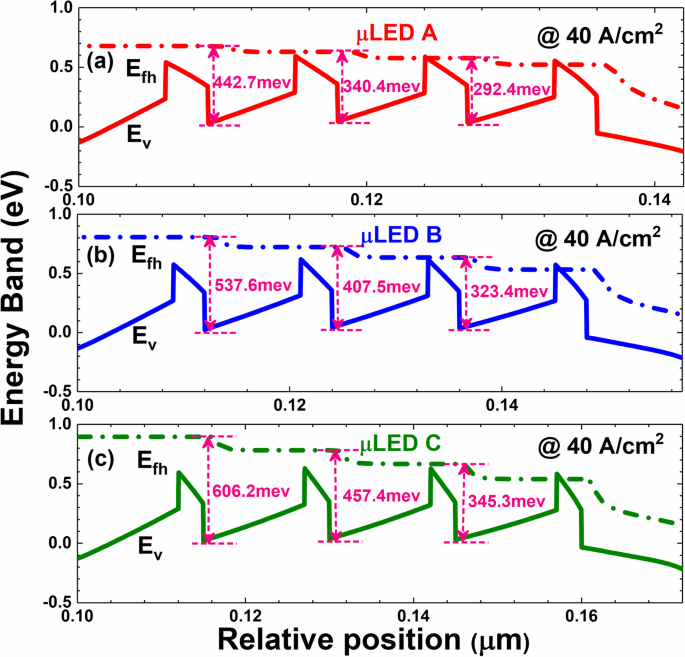
Диаграммы энергетических зон для μLED ( a ) A, ( b ) B и ( c ) C. E v , и E fh обозначают валансную зону и квазиуровень Ферми для дырок соответственно. Данные ухода рассчитаны при плотности тока 40 А / см 2
Как уже упоминалось выше, растекание тока будет усилено за счет утолщения квантовых барьеров, что обязательно повлияет на процессы рекомбинации носителей заряда. Затем мы показываем отношения между рекомбинацией SRH и излучательной рекомбинацией на краю для столовых мез (см. Рис. 5). Отношение рассчитывается с использованием \ ({R} _ {\ mathrm {SRH}} / {R} _ {\ mathrm {rad}} ={\ int} _0 ^ {{\ mathrm {t}} _ {\ mathrm {M} \ mathrm {QW}}} {R} _ {\ mathrm {SRH}} (x) \ times \ mathrm {dx} / {\ int} _0 ^ {{\ mathrm {t}} _ {{{ } _ {\ mathrm {M}}} _ {\ mathrm {QW}}}} {R} _ {\ mathrm {rad}} (x) \ times \ mathrm {dx} \), где R SRH (x) представляет скорость рекомбинации SRH, R рад (x) обозначает скорость излучательной рекомбинации, а t MQW - полная толщина области МКЯ. На рисунке 5 показано, что отношения R SRH / R рад оба на краю мезы уменьшаются по мере увеличения толщины квантового барьера, что означает, что скорость излучательной рекомбинации может быть увеличена за счет улучшения эффекта растекания тока для идеальных архитектур μLED. Это означает, что μLED могут обладать отличным распределением тока из-за значительно уменьшенного размера кристалла [21, 22]. Обратите внимание, что мы еще не рассмотрели поверхностную рекомбинацию для рис. 5. Таким образом, мы можем предположить, что гораздо лучший эффект растекания тока для реалистичных μLED может принести в жертву излучательную рекомбинацию носителей, которую можно смоделировать, принимая во внимание поверхностные несовершенства, и подробные обсуждения будут проведены позже.
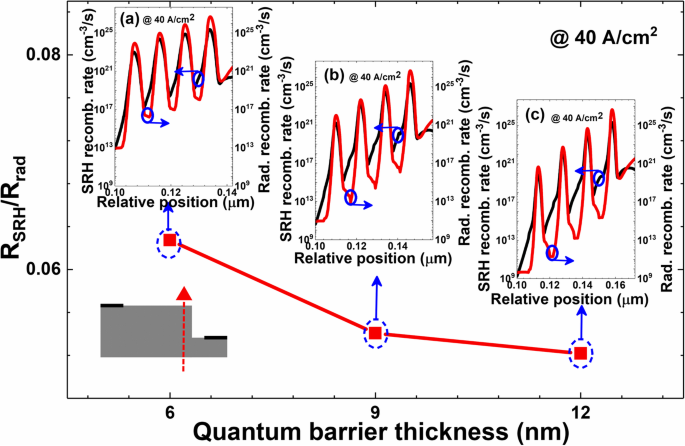
Отношения интегрированной скорости рекомбинации SRH (SRH) и интегральной скорости излучательной рекомбинации для μLEDs A, B и C. Вставки ( a ), ( b ) и ( c ) представляют собой профили скорости рекомбинации СРГ (SRH) и скорости излучательной рекомбинации на краю мезы для μLED A, B и C соответственно. Данные рассчитаны при плотности тока 40 А / см 2 .
Уменьшение рекомбинации поверхностей за счет использования MQW с тонкими квантовыми барьерами
Чтобы исследовать влияние поверхностной рекомбинации на инжекцию дырок для μLED с разной толщиной квантового барьера, мы дополнительно проектируем μLED I, II и III. Структурная информация МКЯ для μLED I, II и III идентична таковой для μLED A, B и C (см. Таблицу 1), соответственно, за исключением того, что поверхностные дефекты учитываются для μLED I, II и III, например что ширина дефектной области для μLED I, II и III установлена на 0,5 мкм от протравленного края мезы.
Численно рассчитанные EQE и оптическая мощность как функция плотности тока показаны на рис. 6. На рис. 6 показано, что, когда учитывается безызлучательная рекомбинация на поверхности, оптическая интенсивность может быть значительно уменьшена. Таким образом, это еще раз подтверждает, что поверхностной безызлучательной рекомбинацией нельзя пренебрегать для μLED [10, 17, 18]. Между тем, что хорошо согласуется с наблюдениями на рис.1, EQE и оптическая мощность также увеличиваются при уменьшении толщины квантового барьера, например, μLED I с самым тонким квантовым барьером имеет самый большой EQE и оптическую мощность. Экспериментально измеренные EQE для μLED I и III показаны на вставке рис. 6a, которая показывает ту же тенденцию, что и результаты численных расчетов. Кроме того, мы измеряем и показываем нормированные спектры электролюминесценции (EL) для μLED I и III на рис. 6b и c, соответственно. Пиковая длина волны излучения для всех протестированных μLED составляет ~ 450 нм. Измеренное значение EL может быть воспроизведено нашими моделями. Это указывает на то, что используемые нами физические параметры установлены правильно, например, уровень поляризации и состав InN в МКЯ, которые определяют длину волны излучения, были правильно установлены.
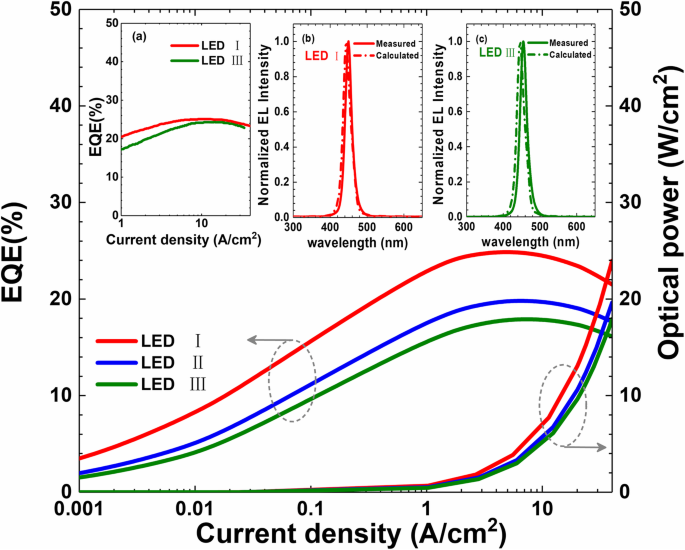
Расчетный EQE и плотность оптической мощности с точки зрения плотности тока инжекции для μLED I, II и III соответственно. Вставка рис. Из ( a ) показывает экспериментально измеренный EQE для μLED I и III соответственно. Фигуры на вставке:( b ) и ( c ) представлены измеренные и численно рассчитанные спектры ЭЛ для μLED I и III. Данные для вставки фиг. ( b ) и ( c ) собираются при плотности тока 40 А см 2
Чтобы выявить влияние дефектов боковой стенки на эффективность инжекции дырок для μLED I, II и III, концентрации дырок показаны на рис. 7. Обратите внимание, что концентрация дырок на рис. 7а проверяется в средней области для устройства [как показано красной стрелкой на вставке к рис. 7a]. На рис. 7b показана концентрация дырок в дефектной области для устройств (как показано красной стрелкой на вставке к рис. 7b). Как показано на рис. 7a и b, как для неповрежденной области, так и для области боковой стенки уменьшенная толщина квантовых барьеров способствует переносу дырок через МКЯ. Результаты здесь согласуются с рис. 2. Дальнейшее сравнение между рис. 7a и b показывает, что эффективность впрыска дырок в дефектных областях боковой стенки, очевидно, ниже, чем в неповрежденных областях. Наблюдения здесь хорошо согласуются с Kou et al. [18], что дополнительно демонстрирует, что по существу необходимо уменьшить распространение тока на дефектные боковые стенки за счет надлежащего уменьшения толщины квантового барьера (см. Рис. 3a и b).

Профили концентрации дырок в области МКЯ, рассчитанные численно ( a ) в центре, ( b ) на краю столов для μLED I, II и III соответственно. Данные рассчитаны при плотности тока 40 А / см 2 . . На вставных рисунках показано положение, в котором фиксируются профили концентрации дырок
Затем мы повторяем наш анализ, как это было сделано на рис. 5, значения для которого теперь показаны на рис. 8. Мы видим, что отношение для R SRH / R рад на краю мезы увеличивается с увеличением толщины квантового барьера, что однозначно объясняется значительным увеличением скорости поверхностной безызлучательной рекомбинации. Как мы и предполагали, толстые квантовые барьеры позволяют току достигать краев мезы и запускать безызлучательную рекомбинацию на поверхности. В результате на вставке рис. A – c также видно, что поверхностная безызлучательная рекомбинация становится чрезвычайно сильной на краях мезы. Скорость безызлучательной рекомбинации на боковых стенках даже превосходит скорость излучательной рекомбинации.

Отношения интегральной скорости рекомбинации СРГ (SRH) и интегральной скорости излучательной рекомбинации для μLED I, II и III. Фигуры на вставке ( a ), ( b ) и ( c ) представляют собой профили скорости рекомбинации СРГ (СРГ) и скорости излучательной рекомбинации на краю мезы для μLED I, II и III соответственно. Данные рассчитаны при плотности тока 40 А / см 2 .
Выводы
Таким образом, мы численно исследовали и продемонстрировали влияние различной толщины квантового барьера на инжекцию дырок и распространение тока для μLED на основе InGaN. Результаты показывают, что за счет уменьшения толщины квантового барьера может быть обеспечено лучшее удержание тока в меза-области. Соответственно, можно хорошо управлять растеканием тока отдельно от краев мезы, что затем подавляет безызлучательную рекомбинацию на поверхности. Как численно, так и экспериментально мы наблюдаем улучшенную внешнюю квантовую эффективность для μLED на основе InGaN с достаточно тонкими квантовыми барьерами. Мы считаем, что предлагаемый подход является многообещающим для устранения узкого места, ограничивающего разработку высокопроизводительных μLED. Более того, физика устройства, представленная в этой работе, расширит понимание μLED на основе InGaN.
Доступность данных и материалов
Данные и анализ в текущей работе доступны у соответствующих авторов по разумному запросу.
Сокращения
- μLED:
-
Микросветодиоды
- EQE:
-
Внешняя квантовая эффективность
- светодиоды:
-
Светодиоды
- InGaN:
-
Нитрид индия-галлия
- GaN:
-
Нитрид галлия
- VLC:
-
Видимая световая коммуникация
- IQE:
-
Внутренняя квантовая эффективность
- PECVD:
-
Химическое осаждение из паровой фазы с применением плазмы
- ALD:
-
Осаждение атомного слоя
- MQW:
-
Множественные квантовые ямы
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- p-EBL:
-
слой блокировки электронов p-типа
- APSYS:
-
Расширенные физические модели полупроводниковых приборов
- SRH:
-
Шокли-Рид-Холл
Наноматериалы
- Решите эти проблемы реализации, чтобы снизить затраты на Skype для бизнеса
- N, N-диметилформамид, регулирующий флуоресценцию квантовых точек MXene для чувствительного определения Fe3 +
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…
- Оптимальные слои легирования кремнием квантовых барьеров в последовательности роста, формирующие потенциал…
- Рекомбинация с контролем деформации в множественных квантовых ямах InGaN / GaN на кремниевых подложках
- О слое распространения тока p-AlGaN / n-AlGaN / p-AlGaN для светодиодов глубокого ультрафиолетового излучения на основе…
- Взаимодействие температуры и интенсивности возбуждения на характеристики фотолюминесценции квантовых точе…
- Перераспределение носителей между двумя видами локализованных состояний в квантовых ямах InGaN / GaN, исследован…
- Советы дальнобойщикам по управлению стрессом в дороге
- Каковы наиболее распространенные области применения переменного тока?



