О слое распространения тока p-AlGaN / n-AlGaN / p-AlGaN для светодиодов глубокого ультрафиолетового излучения на основе AlGaN
Аннотация
В этом отчете были описаны и исследованы светодиоды глубокого ультрафиолета (DUV LED) на основе AlGaN с различными слоями распределения тока, структурированными p-AlGaN / n-AlGaN / p-AlGaN (PNP-AlGaN). Согласно нашим результатам, принятая структура PNP-AlGaN может создавать энергетический барьер в слое инжекции дырок, который может модулировать поперечное распределение тока. Мы также обнаружили, что на эффект растекания тока может сильно влиять толщина, концентрация легирования, петля PNP и состав AlN для вставленного слоя n-AlGaN. Следовательно, если структура PNP-AlGaN спроектирована должным образом, прямое напряжение, внешняя квантовая эффективность, оптическая мощность и эффективность настенной розетки для предлагаемых светодиодов DUV могут быть значительно улучшены по сравнению с обычными светодиодами DUV без PNP. -Структура AlGaN.
Введение
С момента первого появления в 2003 году глубокие ультрафиолетовые светодиоды на основе AlGaN (DUV-светодиоды) вызывают большой интерес из-за их широкого спектра применений, таких как стерилизация воды и очистка воздуха [1,2,3,4,5, 6,7]. Однако внешняя квантовая эффективность (EQE) для светодиодов DUV ниже 10%, когда длина волны излучения меньше 300 нм [8], что значительно ограничивает их дальнейшее применение. Низкий EQE частично является результатом плохой внутренней квантовой эффективности (IQE). Существенное внимание было обращено на то, что на IQE заметно влияет инжекция носителей и протяженные дислокации [8]. DUV-светодиоды на основе AlGaN, выращенные на изолирующих сапфировых подложках, используют структуру flip-chip для повышения эффективности вывода света. Тем не менее, структура светодиодов DUV с перевернутым кристаллом требует, чтобы n-электрод и p-электрод находились на одной стороне. Следовательно, легко возникает неоднородное поперечное распределение тока, т. Е. Эффект вытеснения тока [9]. Текущий эффект вытеснения может легко вызвать локальный эффект джоулева нагрева и неравномерное излучение света [10,11,12]. Стоит отметить, что локальный перегрев серьезно снижает срок службы светодиодов DUV. Более того, очень низкая эффективность легирования Mg для слоя с инжекцией дырок на основе p-AlGaN с высоким содержанием алюминия приводит к плохой электропроводности [13], что дополнительно демонстрирует важность улучшения распределения тока для светодиодов DUV. Хотя Хан и др. указали, что на нынешнее скопление нужно обратить внимание в их обзорной статье [14], подробный анализ текущего скопления и решения для него менее обсуждаются для светодиодов DUV до сих пор.
Для синих светодиодов на основе GaN описаны обширные методы стимулирования распространения тока, и распространение тока можно улучшить, например, путем выборочной ионной имплантации слоя p-GaN [15, 16], вставки слоя блокировки тока (CBL). [17,18,19], выборочно создавая вакансии азота для компенсации дырок в слое p-GaN [20], оптимизируя процесс отжига для омического контакта [21]. Помимо использования пост-производственных подходов, текущий растекающийся слой также может быть получен путем эпитаксиального роста in situ в системе химического осаждения из газовой фазы (MOCVD). Важными примерами являются:короткопериодическая сверхрешетка p-GaN / i-InGaN между структурой с множественными квантовыми ямами (МКЯ) и слоем p-GaN [22, 23], туннельные переходы [24, 25] и барьер переходы [10]. Тем не менее, отчеты об эпиструктурах для улучшения распространения тока для светодиодов DUV можно найти редко. В этом письме мы предлагаем использовать слой p-AlGaN / n-AlGaN / p-AlGaN (PNP-AlGaN) для лучшего распределения бокового тока для светодиодов DUV. Структура PNP-AlGaN может создавать энергетический барьер в валентной зоне слоя инжекции дырок p-типа. Энергетический барьер может модулировать электрическое сопротивление для слоя инжекции дырок p-типа, и, следовательно, путь прохождения тока может быть настроен. Правильно спроектировав слой распределения тока PNP-AlGaN, можно улучшить EQE, эффективность розетки (WPE) и прямое напряжение. Кроме того, в этой работе также всесторонне исследуются чувствительность растекания тока, EQE, WPE и прямого напряжения к петле PNP-AlGaN, концентрация легирования Si, толщина и состав AlN для вставленного слоя n-AlGaN. архитектуры PNP-AlGaN.
Методы исследования и физические модели
Чтобы лучше прояснить механизмы распространения тока для светодиодов DUV на основе AlGaN, были разработаны различные светодиодные устройства DUV (см. Рис. 1a). Все светодиоды DUV состоят из Al 0,60 n-типа толщиной 4 мкм. Ga 0,40 N слой с концентрацией легирования Si 5 × 10 18 см −3 . Затем пять периодов 3-нм Al 0,45 Ga 0,55 N / 12 нм Al 0,56 Ga 0,44 Далее следуют N MQW. Затем мы закрываем МКЯ слоем алюминия p-типа толщиной 18 нм 0,60 Ga 0,40 Слой блокировки электронов N (p-EBL), на котором расположен Al p-типа толщиной 198 нм 0,40 Ga 0.60 В качестве слоя инжекции дырок используются слой N и покрывающий слой GaN p-типа толщиной 50 нм. Концентрация дырок для слоев p-типа установлена на 3 × 10 17 см −3 . Для светодиодов DUV с предлагаемыми структурами PNP-AlGaN обычный объемный Al p-типа 0,40 Ga 0.60 Слой N заменен на p-Al 0.40 Ga 0.60 N / n-Al x Ga 1- x N / p-Al 0,40 Ga 0.60 N слой. На рис. 1б представлена структурная схема слоя PNP-AlGaN. На рисунке 1c показана схематическая диаграмма валентной зоны для структуры PNP-AlGaN, из которой мы можем видеть барьер для дырок. Барьер создается из-за истощения примесей Si в тонком n-Al x Ga 1- x N слой [26]. Этот барьер очень важен для определения пути прохождения тока и характеристик устройства для светодиодов DUV. Подробный анализ будет дан позже.
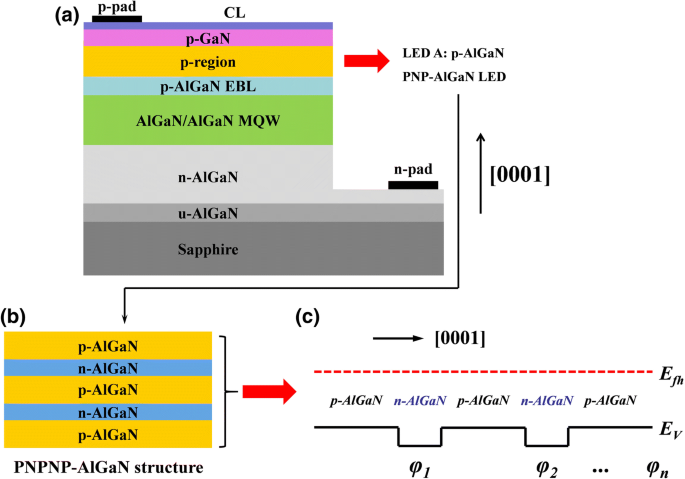
а Принципиальные схемы исследуемых устройств (эталонный светодиод А и светодиод ПНПНП-AlGaN), б принципиальные схемы структуры PNP-AlGaN с двумя переходами PNP-AlGaN, c схематическая диаграмма валентной зоны для структуры PNP-AlGaN с несколькими переходами PNP-AlGaN, в которой φ 1 , φ 2 , и φ n обозначают высоту барьера для каждого соединения PNP-AlGaN вдоль ориентации [0001] и n представляет номер соединения PNP-AlGaN
Чтобы дополнительно проиллюстрировать механизм распределения тока структурой PNP-AlGaN, мы показываем упрощенную эквивалентную схему и пути прохождения тока для светодиода DUV, выращенного на сапфировых подложках, на рис. 2а. Ток течет как вертикально, так и латерально от области p-AlGaN к области n-AlGaN. Обычно толщина текущего слоя (CL) (т.е. 200 нм для наших устройств) намного меньше, чем у слоя n-AlGaN (т.е. 4 мкм для наших устройств). Следовательно, электрическое сопротивление для CL намного больше, чем для слоя инжекции электронов n-AlGaN. Затем ток имеет тенденцию скапливаться под p-электродом, т.е. J 1 > Дж 2 > Дж 3 > Дж 4 > .....> Дж n , который известен как текущий эффект краудинга [27]. К счастью, эффект скопления тока можно подавить, включив переход PNP-AlGaN в слой инжекции дырок p-типа, а лежащий в основе механизм можно интерпретировать, используя рис. 2b, так что мы разделим полный ток на вертикальную часть ( Дж 1 ) и горизонтальная часть ( J 2 ). Согласно исх. [27], связь между J 1 и Дж 2 можно связать формулой. (1) следующим образом:
$$ \ frac {J_1} {J_2} \ cong \ frac {l} {\ frac {\ rho_p} {\ rho _ {\ mathrm {CL}}} {t} _p + \ frac {N \ cdot {\ rho} _ {\ mathrm {PNP}}} {\ rho _ {\ mathrm {CL}}}}, $$ (1)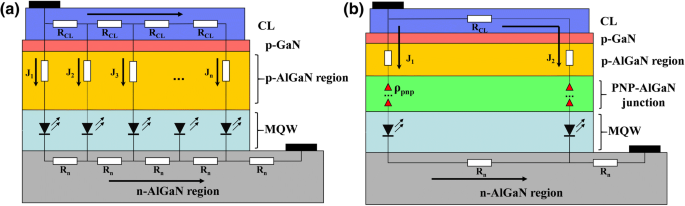
а Эквивалентная схема светодиодов DUV со схемой боковой подачи тока ( J 1 > Дж 2 > Дж 3 > Дж 4 > ……> Дж n ) и b упрощенная схема замещения светодиода со структурой PNP-AlGaN, токовые дорожки ( J 1 и Дж 2 ) также показаны
где l длина горизонтального пути тока, t p толщина, ρ p обозначает удельное сопротивление по вертикали для слоя закачки дырок p-типа, ρ CL обозначает удельное сопротивление нанесенного ex situ слоя распространения тока, ρ PNP означает удельное межфазное сопротивление, индуцированное в каждом переходе PNP-AlGaN, и N представляет собой номер соединения PNP-AlGaN. На основании уравнения. (1), мы заключаем, что можем увеличить J 2 уменьшив ρ CL . Уравнение (1) также указывает на то, что правильное увеличение вертикального сопротивления (т. Е. ρ p × т p ) также помогает улучшить J 2 . В качестве альтернативы вертикальное сопротивление можно увеличить, добавив N · ρ PNP . Однако значение N · ρ PNP может зависеть от количества переходов PNP-AlGaN. Кроме того, значение ρ PNP зависит от концентрации легирования, толщины и состава AlN n-Al x Ga 1- x N слой. Таким образом, подробности, касающиеся различных переходов PNP-AlGaN, будут обсуждаться позже.
Исследования по физике устройства проводятся с использованием APSYS [28]. Отношение смещения энергетической зоны между смещением зоны проводимости и смещением валентной зоны для гетероперехода AlGaN / AlGaN установлено равным 50:50 [29]. Уровень поляризации установлен на 40% для расчета поляризационно-индуцированных зарядов на границах раздела решеток с рассогласованием [30, 31]. Коэффициент оже-рекомбинации и время рекомбинации Шокли-Рида-Холла (SRH) установлены равными 1.0 × 10 −30 см 6 / с [27] и 10 нс [32] соответственно. Эффективность вывода света для светодиодов DUV установлена на уровне ~ 8% [33]. Другие параметры азотсодержащих полупроводников AIIIBV можно найти в другом месте [34].
Результаты и обсуждения
Доказательство эффективности соединения PNP-AlGaN в распространении тока для светодиодов DUV
Чтобы показать эффективность структуры PNP-AlGaN в распространении тока для светодиода DUV, эталонный светодиод DUV (то есть светодиод A) без структуры PNP-AlGaN и светодиод DUV со структурой PNP-AlGaN (то есть светодиод B) изучал. Обратите внимание, что архитектурная информация для светодиодов DUV приведена в разделе «Методы исследования и физические модели», за исключением конфигурации PNP-AlGaN для светодиода B. Светодиод B имеет две петли PNP-AlGaN, то есть структуру PNPNP-AlGaN. Каждый переход PNP-AlGaN содержит p-Al 0,40 Ga 0.60 N / n-Al 0,40 Ga 0.60 N / p-Al 0,40 Ga 0.60 Структура N, для которой концентрация легирования Si в n-Al толщиной 20 нм 0.40 Ga 0.60 N слой вставки 5,3 × 10 17 см −3 . Рассчитаем и покажем диаграмму энергетических зон для светодиода B при плотности тока 170 А / см 2 на рис. 3а. Мы можем видеть, что по сравнению со светодиодом A (полосы энергий здесь не показаны), дырки столкнутся с двумя препятствиями, прежде чем будут введены в МКЯ. Барьеры в валентной зоне здесь могут эффективно распространять ток и лучше гомогенизировать отверстия в поперечном направлении. Для дальнейшего рассмотрения нашей точки и в целях демонстрации мы показываем профиль концентрации боковых дырок в квантовой яме, ближайшей к p-EBL (т.е. последней квантовой яме (LQW)) на рис. 3b, который показывает, что распределение отверстий в светодиоде B действительно показывает более однородный профиль в LQW. Наблюдения на рис. 2b хорошо согласуются с диаграммами энергетических зон на рис. 3а и нашим предыдущим анализом, так что структура PNP-AlGaN оказывается полезной для улучшения эффекта растекания тока.
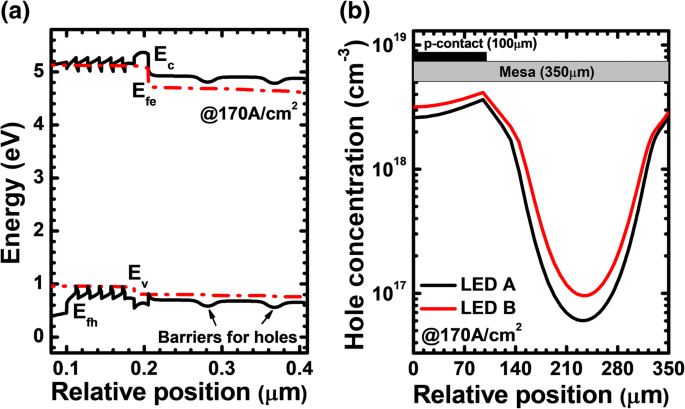
а Диаграмма энергетических зон для светодиода B при плотности тока 170 А / см 2 . E c , E v , E fe , и E fh обозначают зону проводимости, валансную зону и квазиуровни Ферми для электронов и дырок, соответственно, b латеральное распределение дырок в последней квантовой яме для светодиодов A и B при плотности тока 170 А / см 2 соответственно
Далее мы показываем профили концентрации дырок и скорости излучательной рекомбинации в области МКЯ для светодиодов A и B на рис. 4a, b соответственно. Обратите внимание, что для отслеживания эффекта растекания тока данные на рис. 4a, b собираются на расстоянии 230 мкм от левого края мезы. Обнаружено, что улучшенное распределение тока для светодиода B также делает возможным усиленную инжекцию дырок в MQW. Улучшение концентрации дырок в МКЯ приводит к увеличению скорости излучательной рекомбинации для светодиода B в соответствии с рис. 4b.

а Профили концентрации в отверстиях и b скорость излучательной рекомбинации в области МКЯ для светодиодов A и B при плотности тока 170 А / см 2 соответственно
Затем на рисунке 5a показаны EQE и плотность оптической мощности с точки зрения уровня плотности тока инжекции для светодиодов A и B. Уровни EQE для светодиодов A и B составляют 3,38% и 4,13%, соответственно, показывая повышение производительности на 22,2% при плотность тока 170 А / см 2 . Эти наблюдаемые улучшения объясняются лучшим эффектом растекания тока и улучшенной инжекцией дырок в область МКЯ для светодиода B. Как упоминалось ранее, принятие структуры PNP-AlGaN может привести к возникновению энергетического барьера в валентной зоне, который может повлиять на прямое напряжение. Это предположение подтверждается ссылкой на рис. 5b, который демонстрирует немного увеличенное прямое напряжение для светодиода B. Несмотря на более высокое прямое напряжение для светодиода B, эффективность подключения светодиода к настенной розетке все еще выше, чем для светодиода A согласно рисунку 5c. , так что числа составляют 3,56% и 4,27% для светодиодов A и B при уровне плотности тока 170 А / см 2 , соответственно. Если мы далее сравним рис. 5a, c, мы можем обнаружить, что WPE имеет более выраженный спад для светодиода B, и это связано с дополнительным падением напряжения на переходе PNP-AlGaN. Поэтому очень важно провести более всестороннее исследование, показывающее чувствительность EQE, прямого напряжения и WPE к различным конструкциям PNP-AlGaN.
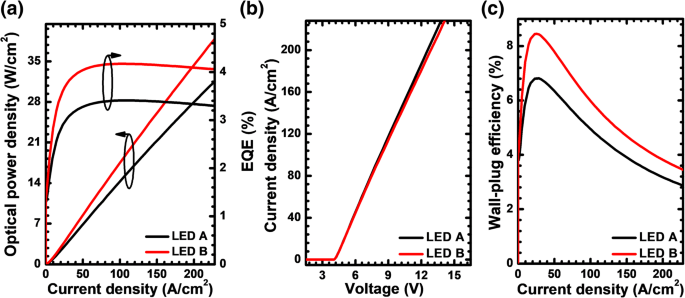
а Плотность оптической выходной мощности и EQE как функция тока инжекции, b вольт-амперная характеристика, c WPE с точки зрения инжектируемого тока для светодиодов A и B соответственно
Влияние толщины слоя n-AlGaN на производительность устройства
Согласно формуле. (1), мы можем сделать вывод, что усиление горизонтального протекания тока может быть получено путем увеличения значения N · ρ PNP . Высота барьера в переходе PNP-AlGaN увеличивается, когда n-Al 0,40 Ga 0.60 Слой N становится толстым, так что большее значение ρ PNP может быть получен, что полезно для улучшенного эффекта распределения тока. Однако, как только n-Al 0.40 Ga 0.60 Слой N слишком толстый, больше дырок в p-Al 0,40 Ga 0.60 Слой N может быть истощен, что может привести к снижению электропроводности. Поэтому, чтобы лучше проиллюстрировать взаимосвязь между толщиной n-Al 0,40 Ga 0.60 N-слой и характеристики светодиодов DUV, необходимо изучить влияние n-Al 0,40 Ga 0.60 Толщина слоя N для перехода PNP-AlGaN при растекании тока, инжекции дырок, EQE, прямом напряжении и WPE. Для этого мы меняем значения n-Al 0,40 Ga 0.60 Толщина слоя N составляет 6, 13, 20, 27 и 34 нм, и устройства называются светодиодами T1, T2, T3, T4 и T5 соответственно. Таблица 1 суммирует высоту барьера валентной зоны для каждого перехода PNP-AlGaN, которая показывает, что высота барьера увеличивается по мере увеличения n-Al 0,40 Ga 0.60 Толщина слоя N увеличивается, доказывая, что увеличение n-Al 0,40 Ga 0.60 Толщина слоя N обеспечивает большую N · ρ PNP , увеличивая горизонтальный ток J 2 . На рисунке 6а показаны профили концентрации боковых дырок в последней квантовой яме для светодиода A без структурированного слоя распределения тока PNP-AlGaN и светодиодов с различными n-Al 0,40 Ga 0.60 Толщина слоя N при плотности тока 170 А / см 2 . Видно, что дырки становятся более равномерно распределенными в последней квантовой яме, чем толщина для n-Al 0.40 Ga 0.60 N слой вставки увеличивается.
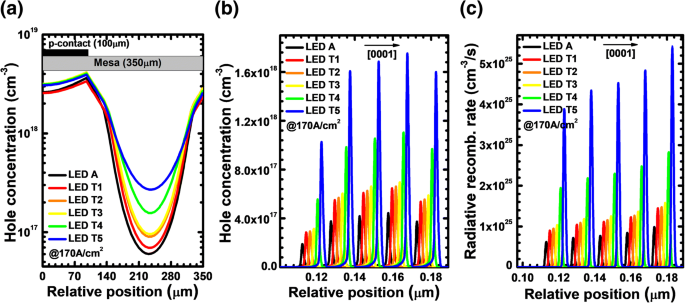
а Боковое распределение дырок в последней квантовой яме, b профили концентрации дырок и c Профили скорости излучательной рекомбинации в области МКЯ для светодиодов A, T1, T2, T3, T4 и T5 при плотности тока 170 А / см 2 . Построенные кривые для панелей b и c намеренно сдвинуты на 2 нм для лучшего разрешения
Затем мы показываем профили концентрации дырок и профили скорости излучательной рекомбинации в области МКЯ для всех исследованных устройств при плотности тока 170 А / см 2 на рис. 6б, в соответственно. Профили концентрации дырок и скорости излучения собираются на расстоянии 230 мкм от левого края мезы. Для лучшего визуального разрешения профили концентрации дырок и скорости излучательной рекомбинации для светодиодов A, T1, T2, T3, T4 и T5 сдвинуты в пространстве на 2 нм на рис. 6b, c, соответственно. Ясно видно, что светодиод A имеет самую низкую концентрацию дырок и, следовательно, самую низкую скорость излучательной рекомбинации в области МКЯ. Концентрация дырок и скорость излучательной рекомбинации в области МКЯ увеличиваются с увеличением толщины n-Al 0.40 Ga 0.60 N слой.
Наблюдаемые результаты, показанные на рис. 6c, хорошо согласуются с EQE и плотностью оптической мощности, которые представлены на рис. 7a, так что увеличивающаяся толщина n-Al 0,40 Ga 0.60 Слой N в переходе PNP-AlGaN может улучшить EQE и плотность оптической мощности. Однако высота барьера валентной зоны для отверстий в каждом переходе PNP-AlGaN становится большой, когда n-Al 0,40 Ga 0.60 Слой N утолщен в соответствии с таблицей 1, что, соответственно, увеличивает прямое напряжение для предлагаемых светодиодов DUV, как показано на рис. 7b. Следовательно, воздействие n-Al 0.40 Ga 0.60 Толщина слоя N для распространения тока PNP-AlGaN на характеристики светодиода должна быть оценена путем демонстрации взаимосвязи между WPE и плотностью тока инжекции (см. Рис. 8). Мы видим, что WPE не увеличивается монотонно с увеличением n-Al 0.40 Ga 0.60 Толщина слоя N. EQE и WPE с точки зрения n-Al 0,40 Ga 0.60 Толщина слоя N проиллюстрирована на вставке к рис. 8. Для архитектур устройств, предложенных в этой работе, WPE достигает наивысшего значения, когда n-Al 0,40 Ga 0.60 Слой внедрения N имеет толщину 20 нм и уменьшается по мере того, как n-Al 0,40 Ga 0.60 Вставной слой N становится толще. Мы связываем это явление с увеличением вертикального сопротивления, когда n-Al 0,40 Ga 0.60 Толщина слоя N становится больше, и на это расходуется больше электроэнергии. Следовательно, толщина вводимого слоя n-AlGaN для перехода PNP-AlGaN должна быть тщательно оптимизирована. В этом разделе мы устанавливаем состав AlN на уровне 40%, то есть n-Al 0,40 Ga 0.60 N в целях демонстрации, и мы считаем, что оптимизированная толщина слоя вставки n-AlGaN станет меньше, если увеличить состав AlN.
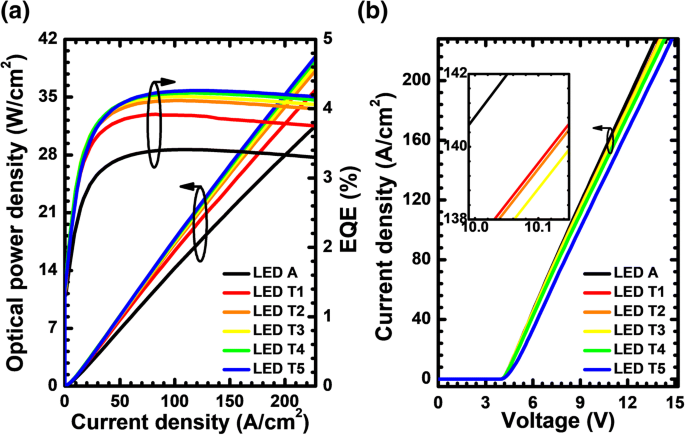
а Плотность оптической выходной мощности, b вольт-амперные характеристики светодиодов А, Т1, Т2, Т3, Т4, Т5. На вставке показаны кривые вольт-амперной характеристики в увеличенном масштабе
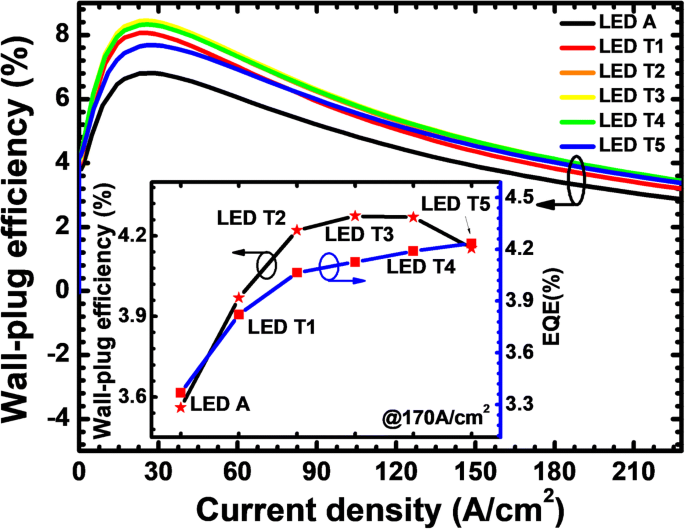
WPE как функция тока инжекции для светодиодов A, T1, T2, T3, T4 и T5. На вставке показаны WPE и EQE для исследуемых светодиодов с различной толщиной n-Al 0,40 Ga 0.60 Слой N для перехода PNP-AlGaN при плотности тока 170 А / см 2
Влияние концентрации допинга на уровне n-AlGaN на производительность устройства
Помимо толщины слоя n-AlGaN, концентрация легирования для слоя n-AlGaN может также изменять высоту барьера валентной зоны для дырок, тем самым влияя на N · ρ PNP . Чтобы более точно изучить влияние концентрации легирования для слоя n-AlGaN на эффект растекания тока и оптические характеристики светодиодов DUV с переходами PNP-AlGaN, мы установили концентрацию легирования 1,3 × 10 17 , 5,3 × 10 17 , 9,3 × 10 17 , 1,33 × 10 18 , и 1,73 × 10 18 см −3 слоев n-AlGaN для светодиодов D1, D2, D3, D4 и D5 соответственно. Толщина слоя n-AlGaN установлена равной 20 нм, и используются два перехода PNP-AlGaN. Состав AlN составляет 40%, т.е. n-Al 0,40 Ga 0.60 Н.
Таблица 2 показывает, что высота барьера валентной зоны для дырок увеличивается, когда концентрация легирования Si для n-Al 0,40 Ga 0.60 N-слой перехода PNP-AlGaN становится высоким. Увеличенная высота барьера валентной зоны указывает на большое значение N · ρ PNP , что одновременно дает высокий горизонтальный ток Дж 2 . Согласно формуле. (1), увеличенное растекание тока сопровождается более однородным профилем концентрации боковых дырок, и поэтому мы показываем на рис. 9a, что распределение латеральных дырок в последней квантовой яме становится более гомогенизированным, когда PNP-AlGaN переход легирован для светодиодов DUV по сравнению со светодиодом A. Кроме того, боковые отверстия становятся более равномерно распределенными, когда концентрация легирования Si для n-Al 0,40 Ga 0.60 N-слой соединения PNP-AlGaN увеличивается.
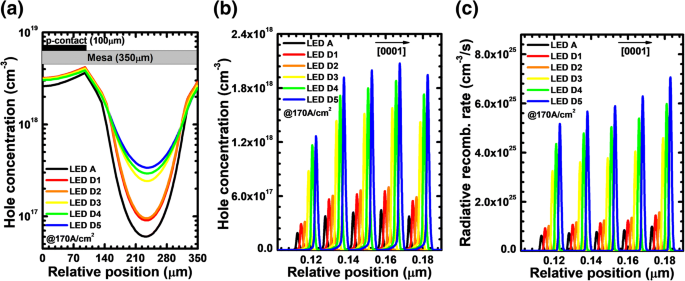
а Боковое распределение дырок в последней квантовой яме, b профили концентрации дырок и c профили скорости излучательной рекомбинации в области МКЯ или светодиоды A, D1, D2, D3, D4 и D5 при плотности тока 170 А / см 2 . Построенные кривые для панелей b и c намеренно сдвинуты на 2 нм для лучшего разрешения
Затем мы показываем профили концентрации дырок и профили скорости излучательной рекомбинации в области МКЯ для всех исследованных устройств при плотности тока 170 А / см 2 на рис. 9b, c, соответственно, которые собраны на расстоянии 230 мкм от левого края мезы. Ясно видно, что светодиод A имеет самую низкую концентрацию дырок и самую низкую скорость излучательной рекомбинации в области МКЯ. Концентрация дырок и скорость излучательной рекомбинации в области МКЯ увеличиваются с увеличением концентрации легирования n-Al 0,40 Ga 0.60 N слоев для светодиодов с переходами PNP-AlGaN. Повышенный уровень концентрации дырок в MQW для светодиодов D1, D2, D2, D3, D4 и D5 приписывается лучшему эффекту распространения тока благодаря переходу PNP-AlGaN.
Затем мы далее вычисляем и представляем EQE и плотность оптической мощности в терминах плотности тока инжекции для исследуемых устройств на рис. 10a. Наблюдаемый EQE согласуется с результатами на рис. 9b, c, так что EQE может быть улучшен после использования перехода PNP-AlGaN. Более того, поскольку концентрация легирования Si в n-Al 0,40 Ga 0.60 Уровень N для перехода PNP-AlGaN увеличивается, EQE может быть дополнительно продвинут благодаря лучшему распределению тока. На рисунке 10b сравнивается прямое рабочее напряжение исследуемых устройств. Показано, что прямое рабочее напряжение увеличивается с увеличением концентрации легирования в n-Al 0,40 Ga 0.60 N слой. Обратите внимание, что, поскольку концентрация легирования Si составляет 1,33 × 10 18 и 1,73 × 10 18 см −3 , напряжение включения значительно увеличивается, что указывает на то, что встроенный переход PNP-AlGaN ведет себя как паразитный диод, когда легирование Si в n-Al 0,40 Ga 0.60 Слой N увеличивается до очень высокого уровня. Для более точной оценки характеристик светодиодов DUV с различными переходами PNP-AlGaN на рис. 11 показан WPE как функция плотности тока инжекции для светодиодов A, D1, D2, D3, D4 и D5. Ясно, что мы можем видеть, что WPE является самым низким для светодиода D5, что связано с самым большим потреблением прямого напряжения. На вставке к рис. 11 также показано, что WPE более чувствителен к концентрации легирования кремнием n-Al 0,40 Ga 0.60 N, чем EQE. Следует сделать вывод, что высокая концентрация легирования кремнием n-Al 0,40 Ga 0.60 N-слой действительно может улучшить текущий слой растекания и увеличить скорость генерации фотонов. Тем не менее, дополнительное прямое падение напряжения на переходах PNP-AlGaN потребляет больше электроэнергии, тем самым ограничивая WPE. Результаты этого раздела также показывают, что концентрация легирования Si в n-Al x Ga 1- x Слой N должен быть должным образом уменьшен, если увеличить состав AlN и / или толщину n-Al x Ga 1- x Уровень N для соединения PNP-AlGaN, поскольку, поступая таким образом, можно получить как улучшенный EQE, так и достойный WPE.
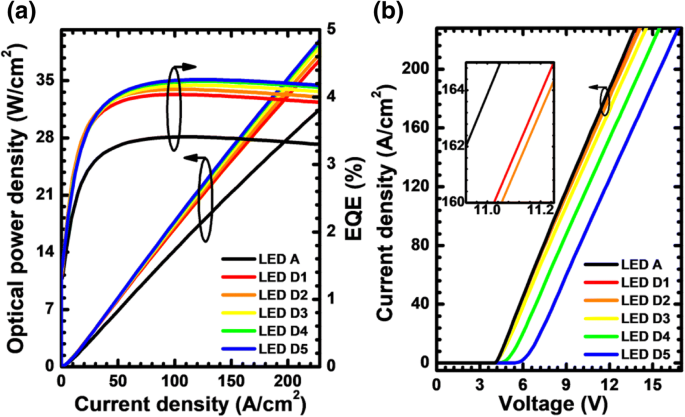
а Плотность оптической выходной мощности и EQE как функция тока инжекции, b вольт-амперные характеристики светодиодов A, D1, D2, D3, D4, D5. На вставке показаны кривые вольт-амперной характеристики в увеличенном масштабе
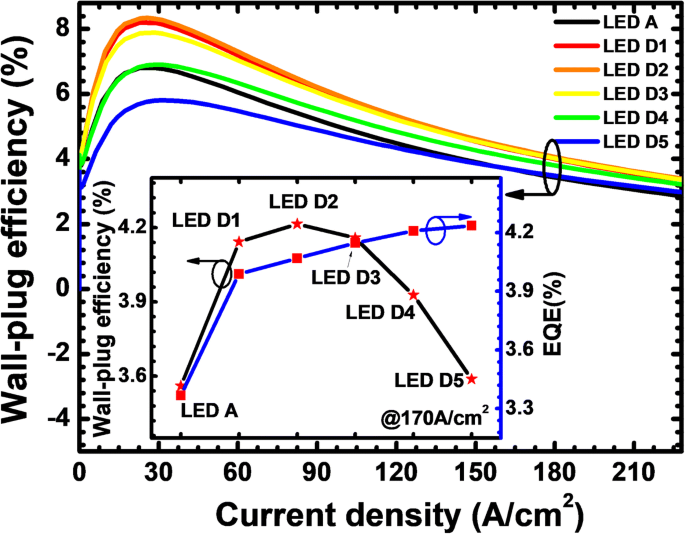
WPE как функция тока инжекции для светодиодов A, D1, D2, D3, D4 и D5. На вставке показаны WPE и EQE для исследуемых светодиодов с различными концентрациями легирования n-Al 0,40 Ga 0.60 Слой N при плотности тока 170 А / см 2
Влияние номера соединения PNP-AlGaN на производительность устройства
В этом разделе изучается влияние количества переходов PNP-AlGaN на электрические и оптические характеристики светодиодов DUV. В целях демонстрации мы зафиксировали концентрацию легирования и толщину слоя n-AlGaN равными 5,3 × 10 17 . см −3 и 20 нм соответственно. Состав AlN выбран равным 0,40, например n-Al 0,40 Ga 0.60 N. Мы применяем разные петли для соединения PNP-AlGaN, т.е. номера петель установлены на 1, 2, 3 и 4 для светодиодов N1, N2, N3 и N4 соответственно. Сначала мы рассчитываем и представляем высоту барьера валентной зоны для каждого перехода PNP-AlGaN в таблице 3. Очевидно, что увеличение числа переходов PNP-AlGaN приводит к общему значению N · ρ PNP высокий. Затем мы рассчитываем и демонстрируем поперечное распределение дырок в последней квантовой яме для светодиодов A, N1, N2, N3 и N4 при плотности тока 170 А / см 2 (см. рис. 12а). Это показывает, что распределение дырок в последней квантовой яме становится более однородным по мере включения большего количества переходов PNP-AlGaN. Результаты на рис. 12a дополнительно подтверждают прогнозы, сделанные по формуле. (1).
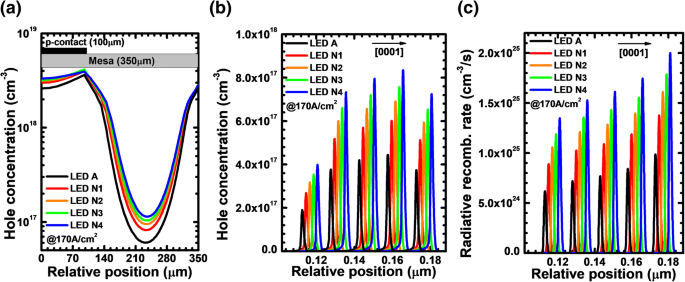
а Боковое распределение дырок в последней квантовой яме, b профили концентрации дырок и c Профили скорости излучательной рекомбинации в области МКЯ для светодиодов A, N1, N2, N3 и N4 при плотности тока 170 А / см 2 . Построенные кривые для панелей b и c намеренно сдвинуты на 2 нм для лучшего разрешения
Затем мы показываем профили концентрации дырок и скорости излучательной рекомбинации в области МКЯ для светодиодов A, N1, N2, N3 и N4 при плотности тока 170 А / см 2 на рис. 12б, в соответственно. Профили скорости дырочной и излучательной рекомбинации зондируются на расстоянии 230 мкм от левого края мезы. Показано, что концентрация дырок и скорость излучательной рекомбинации увеличиваются, если количество переходов PNP-AlGaN больше. Здесь стоит упомянуть, что мы не увеличиваем значение N больше 4, с тех пор как N дополнительно увеличивается, толщина оставшегося p-Al 0,40 Ga 0.60 Слой N становится настолько тонким, что дырки могут быть истощены ионизированными присадками Si, и количество дырок может быть недостаточным.
Благодаря улучшенному эффекту распространения тока, повышенной концентрации дырок в области МКЯ, светодиоды N1, N2, N3 и N4, следовательно, способствуют EQE и плотности оптической мощности по сравнению со светодиодом A (см. Рис. 13a). Рисунок 13b демонстрирует, что прямое рабочее напряжение для предлагаемых светодиодов DUV также увеличивается, если используется больше переходов PNP-AlGaN. К счастью, увеличение прямого напряжения для светодиодов N1, N2, N3 и N4 не снижает WPE в соответствии с рис. 14. Дальнейшие исследования вставки на рис. 14 могут проиллюстрировать, что как EQE, так и WPE имеют тенденцию приближаться к уровень насыщения по мере увеличения количества переходов PNP-AlGaN. Следовательно, мы считаем, что, как также указывалось ранее, дальнейшее увеличение количества переходов PNP-AlGaN может истощить дыры и, соответственно, ухудшить возможность подачи дырок, что, следовательно, внесет небольшой вклад в улучшение EQE и WPE для предлагаемые архитектуры устройств в этой работе.
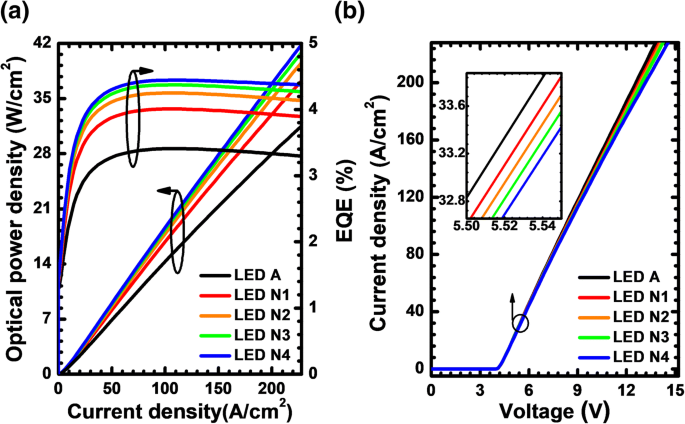
а Плотность оптической выходной мощности и EQE как функция тока инжекции, b вольт-амперная характеристика светодиодов A, N1, N2, N3, N4. На вставке показаны кривые вольт-амперной характеристики в увеличенном масштабе
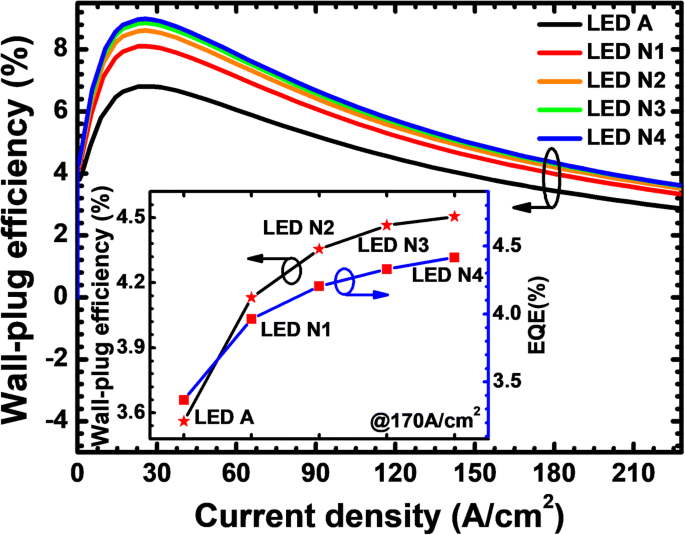
WPE как функция тока инжекции для светодиодов A, N1, N2, N3 и N4. На вставке показаны WPE и EQE для светодиодов с различным количеством переходов PNP-AlGaN при плотности тока 170 А / см 2 .
Влияние состава AlN для уровня n-AlGaN на производительность устройства
Наконец, мы модифицируем ρ PNP варьируя состав AlN слоя n-AlGaN для перехода PNP-AlGaN. Значения для состава AlN слоя n-AlGaN установлены равными 0,40, 0,43, 0,46, 0,49 и 0,51 для светодиодов C1, C2, C3, C4 и C5 соответственно. Толщина и концентрация легирования Si для слоя n-AlGaN установлены на 20 нм и 5,3 × 10 17 . см −3 , соответственно. Мы используем два перехода PNP-AlGaN для светодиодов C1, C2, C3, C4 и C5. Состав AlN для остальных слоев p-AlGaN зафиксирован на уровне 0,40. Таблица 4 демонстрирует высоту барьера валентной зоны для перехода PNP-AlGaN с различным составом AlN в слое вставки n-AlGaN. Легко понять, что повышенный состав AlN в слое n-AlGaN приводит к увеличению высоты барьера валентной зоны для дырок. На рисунке 15а показаны поперечные распределения дырок в последней квантовой яме для светодиодов A, C1, C2, C3, C4 и C5 при плотности тока 170 А / см 2 . . Эффект распространения тока значительно улучшается, поскольку состав AlN в слое n-AlGaN увеличивается до 0,43. Кажется, что отверстия не могут быть более надежно распределены, когда состав AlN в слое n-AlGaN превышает 0,43 для наших структур, потому что слишком высокий состав AlN в n-AlGaN может блокировать инжекцию дырок.

а Боковое распределение дырок в последней квантовой яме, b профили концентрации дырок и c Профили скорости излучательной рекомбинации в области МКЯ для светодиодов A, C1, C2, C3, C4 и C5 при плотности тока 170 А / см 2 . Построенные кривые для панелей b и c намеренно сдвинуты на 2 нм для лучшего разрешения
Профили концентрации дырок и скорости излучательной рекомбинации в области МКЯ для светодиодов A, C1, C2, C3, C4 и C5 при плотности тока 170 А / см 2 представлены на рис. 15б, в соответственно. Данные также собираются на расстоянии 230 мкм от левого края мезы. Выводы здесь аналогичны выводам для рис. 6b, рис. 9b и рис. 12b, т. Е. Использование слоя распределения тока PNP-AlGaN увеличивает инжекцию дырок, и концентрация дырок в области МКЯ становится еще более улучшенной. состав AlN в слое n-AlGaN увеличивается. Затем мы далее вычисляем и представляем EQE и плотность оптической мощности в терминах тока инжекции для исследуемых устройств на рис. 16a. Очевидно, мы видим, что EQE можно улучшить, если использовать соединение PNP-AlGaN. Кроме того, по мере того, как состав AlN в слое n-AlGaN для перехода PNP-AlGaN увеличивается, EQE может быть дополнительно усилен благодаря лучшему растеканию тока, которое гомогенизирует концентрацию дырок в каждой плоскости квантовой ямы, как было показано ранее. .
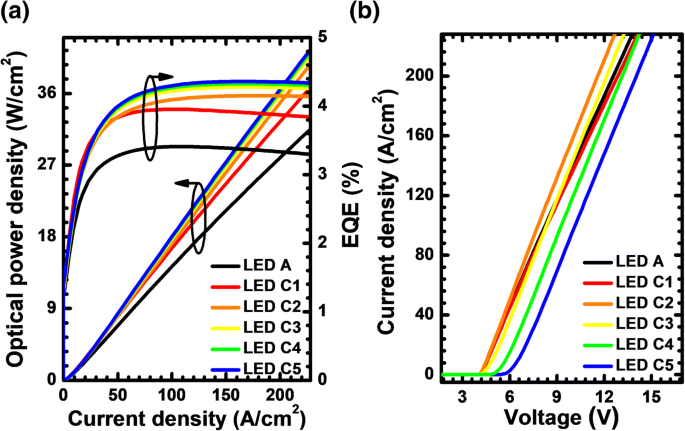
а Плотность оптической выходной мощности и EQE как функция тока инжекции и b вольт-амперные характеристики светодиодов A, C1, C2, C3, C4 и C5
На рисунке 16b исследуются вольт-амперные характеристики светодиодов A, C1, C2, C3, C4 и C5. Устройство демонстрирует небольшое увеличение прямого рабочего напряжения для светодиода C1 с PNP-Al 0,40 Ga 0.60 N-переход по сравнению со светодиодом A. Между тем, устройство потребляет больше прямого напряжения для светодиодов C4 и C5. Наблюдение здесь согласуется с наблюдениями на рис. 7b, 10b и 13b, так что переход PNP-AlGaN вызывает дополнительную высоту барьера валентной зоны для дырок, что, в результате, увеличивает прямое напряжение и даже напряжение включения (например, светодиоды C4 и C5). Однако стоит отметить, что прямое рабочее напряжение для светодиодов C2 и C3 уменьшается по сравнению со светодиодом A. На данный момент основной механизм не ясен. Однако мы предварительно связываем пониженное прямое напряжение для светодиодов C2 и C3 с эффектом ускорения отверстия [35].
На рисунке 17 показана взаимосвязь между WPE и плотностью тока инжекции для тестируемых светодиодов. Мы можем получить, что WPE может быть улучшен для всех предлагаемых светодиодов, особенно когда плотность тока инжекции превышает 89 А / см 2 . Подробное исследование светодиода C5 показывает, что WPE для светодиода C5 ниже, чем для светодиода A, когда плотность тока меньше 89 А / см 2 . Тем не менее, WPE для светодиода C5 превосходит WPE для светодиода A, когда плотность тока инжекции становится выше (т. Е.> 89 А / см 2 ). Как хорошо известно, ток легко накапливается, когда светодиодное устройство смещено на высоком уровне тока. WPE для светодиода C5 отражает, что PNP-Al 0,51 Ga 0,49 N-переход действительно эффективен для улучшения эффекта распространения тока. Однако, учитывая дополнительное потребление напряжения в переходе PNP-AlGaN, нужно быть очень осторожным при настройке состава AlN для слоя n-AlGaN, чтобы можно было максимизировать WPE, как показано на вставке на рис. 17.
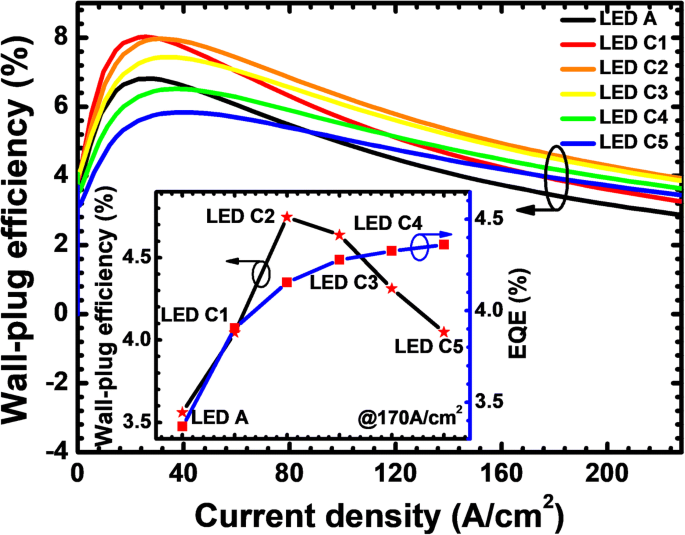
WPE как функция тока инжекции для светодиодов A, C1, C2, C3, C4 и C5. На вставке показаны ЭПЭ и ЭКВ для исследуемых светодиодов с различным составом AlN для слоя n-AlGaN при плотности тока 170 А / см 2
Выводы
Подводя итог, можно сказать, что соединение PNP-AlGaN для светодиодов DUV исследовано и продемонстрировано. С помощью предлагаемых переходов PNP-AlGaN эффект растекания тока может быть улучшен. Улучшенный эффект распространения тока хорошо объясняется повышенным вертикальным сопротивлением и усиленным горизонтальным током. Кроме того, мы также провели параметрическое исследование, чтобы выявить различные PNP-переходы на эффекте распространения тока, EQE и WPE. Мы обнаружили, что за счет надлежащего увеличения толщины, концентрации легирования, состава AlN для слоя вставки n-AlGaN и количества для перехода PNP-AlGaN эффект растекания тока может быть улучшен. С другой стороны, мы также обнаружили, что эффект распространения тока действительно может улучшить EQE. Однако прямое напряжение может быть увеличено, если переход PNP-AlGaN не полностью оптимизирован, стоимость чего заключается в уменьшении WPE. Также стоит отметить, что характеристика растекания тока - это кооперативная функция толщины, концентрации легирования, состава AlN для вводимого слоя n-AlGaN и числа для перехода PNP-AlGaN. В результате не существует однозначного ответа на вопрос о лучшей конструкции слоя распределения тока PNP-AlGaN для светодиодов DUV. Однако мы твердо верим, что результаты этой работы вводят дополнительное физическое понимание слоя распределения тока PNP-AlGaN и эффекта распространения тока для светодиодов DUV. Следовательно, эта работа очень полезна для сообщества оптических полупроводниковых устройств.
Сокращения
- APSYS:
-
Расширенные физические модели полупроводниковых приборов
- CBL:
-
Текущий блокирующий слой
- CL:
-
Текущий слой распространения
- Светодиоды DUV:
-
Светодиоды глубокого ультрафиолета
- EQE:
-
Внешняя квантовая эффективность
- IQE:
-
Внутренняя квантовая эффективность
- LQW:
-
Последняя квантовая яма
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- MQW:
-
Множественные квантовые ямы
- PNP-AlGaN:
-
п-AlGaN / n-AlGaN / п-AlGaN
- SRH:
-
Шокли-Рид-Холл
- WPE:
-
Эффективность розетки
Наноматериалы
- Обоснование использования нейроморфных чипов для вычислений ИИ
- Ученые IBM изобрели термометр для наномасштаба
- Дизайн эмиссионного слоя для электронных умножителей
- Зеленый синтез квантовых точек InP / ZnS Core / Shell для применения в светоизлучающих диодах, не содержащих тяжелых м…
- Оптимальный предшественник титана для изготовления компактного слоя TiO2 для перовскитных солнечных элементо…
- Ультрафиолетовые светодиоды на основе AlGaN с почти нулевым КПД и специально разработанным слоем блокировки эл…
- Перовскитовые светодиоды высокой яркости с высокополярным спиртовым растворителем, использующие PEDOT:PSS как с…
- Влияние ширины квантовых ям на электролюминесцентные свойства светодиодов AlGaN, излучающих глубокий ультрафи…
- Интеграция экологически чистых перовскитов для высокоэффективных белых светоизлучающих диодов
- Каковы наиболее распространенные области применения переменного тока?



